新しいSamsungH-Cube 2.5Dテクノロジーは、HPCアプリケーション用に6つのHBMを統合します
サムスン電子は、高性能で大面積のパッケージング技術を必要とするHPC、AI、データセンター、およびネットワーク製品向けの半導体に特化した2.5Dパッケージングソリューションであるハイブリッドサブストレートキューブ(H-Cube)テクノロジーを発表しました。
サムスン電機(SEMCO)とアムコアテクノロジーが共同開発したH-Cubeは、多数のシリコンダイを統合する必要のある高性能半導体に適しています。サムスンは、ファウンドリエコシステムを拡張および強化し、顧客が直面している課題に対処するためのさまざまなパッケージソリューションを提供すると述べました。
「システム統合がますます必要になり、基板の供給が制限されている今日の環境では、SamsungFoundryとAmkorTechnologyは、これらの課題を克服するためにH-Cubeの共同開発に成功しました」とAmkor TechnologyのグローバルR&DセンターのシニアバイスプレジデントであるJinYoungKimは述べています。 「この開発は、HPC / AI市場への参入障壁を低くし、ファウンドリとアウトソーシングされた半導体アセンブリおよびテスト(OSAT)企業間のコラボレーションとパートナーシップの成功を示しています。」
H-Cubeの構造と機能
2.5Dパッケージにより、ロジックチップまたは高帯域幅メモリ(HBM)を小さなフォームファクタでシリコンインターポーザの上に配置できます。サムスンのH-Cubeテクノロジーは、ハイブリッド基板とファインバンプ接続が可能なファインピッチ基板、および高密度相互接続(HDI)基板を組み合わせて、2.5Dパッケージに大きなサイズを実装することを特徴としています。
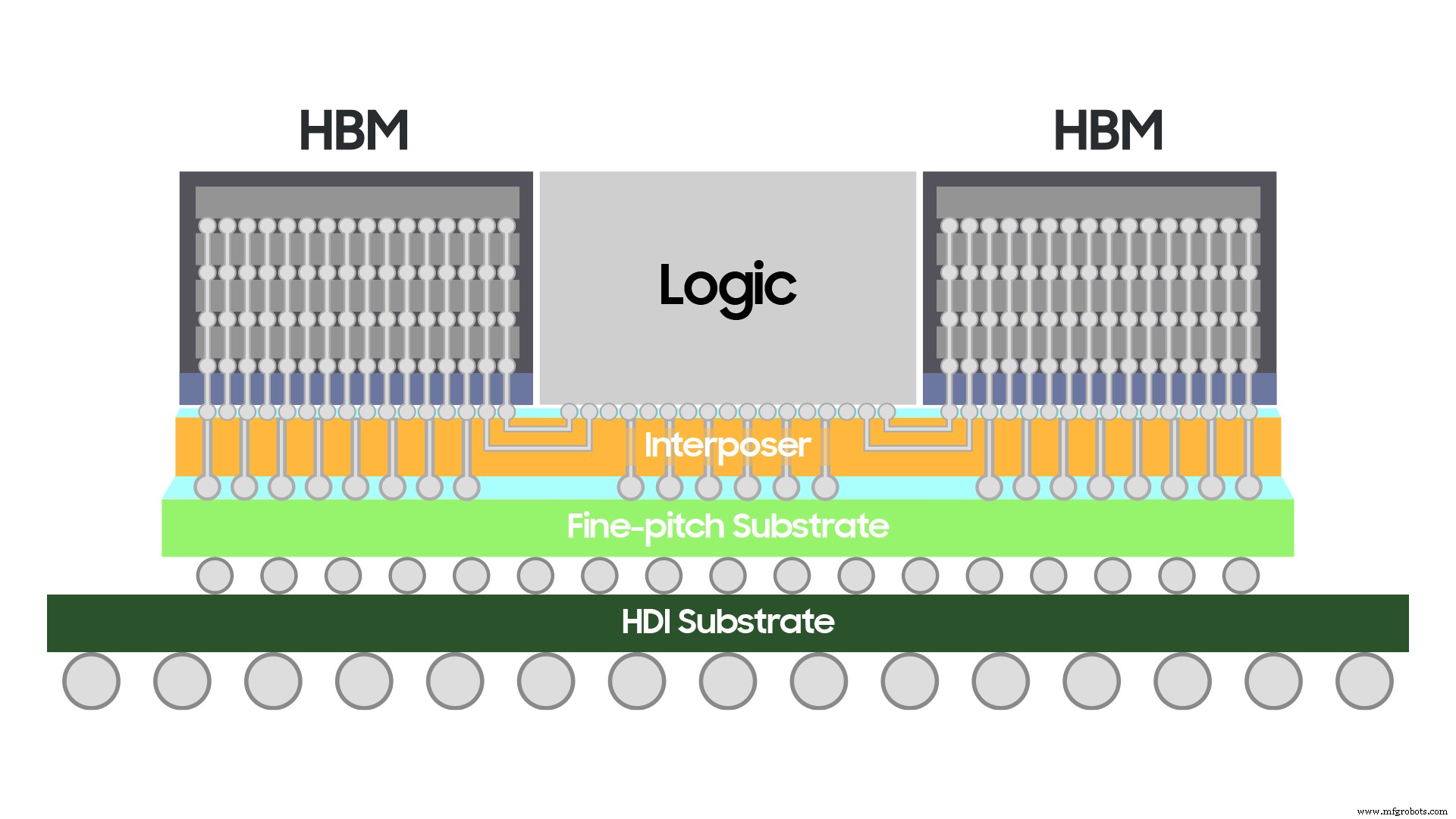
HPC、AI、およびネットワーキングアプリケーション市場セグメントで要求される仕様の最近の増加に伴い、1つのパッケージにマウントされるチップの数とサイズが増加するか、高帯域幅通信が必要になるため、大面積パッケージングが重要になります。インターポーザーを含むシリコンダイの取り付けと接続には、ファインピッチの基板が不可欠ですが、サイズが大きくなると価格が大幅に上昇します。
6つ以上のHBMを統合すると、大面積基板の製造が急速に困難になり、効率が低下します。サムスンは、大面積での実装が容易なHDI基板をハイエンドのファインピッチ基板の下に重ねるハイブリッド基板構造を適用することで、この問題を解決しました。
チップと基板を電気的に接続するはんだボールのピッチを従来のボールピッチに比べて35%小さくすることで、微細な基板の下にHDI基板(モジュール基板)を追加しながら、微細な基板のサイズを最小限に抑えることができます。システム基板との接続を確保するためのピッチ基板。
さらに、H-Cubeソリューションの信頼性を高めるために、Samsungは、複数のロジックチップやHBMをスタックする際の信号損失や歪みを最小限に抑えながら、安定して電力を供給できる独自の信号/電力整合性分析テクノロジーを適用しました。
埋め込み
- 産業技術の新黄金時代
- AMにとって新しい金属印刷技術が何を意味するかを考える
- 小売アプリケーションにおける社会的距離のテクノロジーの選択
- インフィニオン、ザイリンクス、ザイリンクスが協力して、セーフティクリティカルなアプリケーションの新しいマイクロコントローラーソリューションを開発
- インフィニオン:産業用アプリケーション向けの新しい電流センサーは、±25 A〜±120Aの範囲をカバーします
- データモジュール:大量プロジェクト向けの新しいボンディングテクノロジー
- DUAGON-MEN-GROUPはOEMTechnology SolutionsAustraliaを統合しています
- GEは、アプリケーションの制御と監視のための新製品を発表しました
- SMIは、軍事用途向けに最高品質の複合テクノロジーを提供します
- BASF、Paxisが新しい3D印刷技術の材料で協力
- DSMとNedcamが大型3Dプリント用の新しいアプリケーションを開発



