低エネルギー照射に対するSi、Ge、およびSi / Ge超格子の放射応答の理論的シミュレーション
要約
この研究では、Si、Ge、およびSi / Ge超格子の低エネルギー放射応答を、ab initio分子動力学法によって調査し、それらのさまざまな放射挙動の起源を調査します。 Si / Ge超格子の界面周辺にあるGe原子の放射線抵抗はバルクGeに匹敵するが、界面周辺のSi原子はバルクSiよりも変位しにくく、バルクSiと比較して。バルク構造と超格子構造での欠陥生成のメカニズムは、多少異なる特性を示し、超格子での関連する欠陥はより複雑です。欠陥の形成と移動の計算は、超格子構造では、点欠陥の形成がより困難であり、空孔の移動性が低いことを示しています。 Si / Ge超格子の強化された放射線耐性は、放射線環境下での電子およびオプトエレクトロニクスデバイスとしてのアプリケーションにメリットをもたらします。
背景
過去数十年の間に、Si / Ge超格子(SL)は、新しい電子および光電子デバイスの開発に貢献する可能性があるため、半導体研究で大きな注目を集めてきました[1,2,3,4,5,6]。たとえば、Si / Ge SLの光伝導性の研究は、高速光通信のエミッタおよびレシーバとしてのフォトダイオードにとって非常に重要です[5]。宇宙電子部品、マイクロ電子部品、太陽電池、宇宙ベースの電子機器[1、4、6]などのアプリケーションでは、Si / Ge SLの光学的および電子的特性は、高宇宙環境からのエネルギーイオンにより、電子デバイスの性能が低下します。したがって、この半導体材料の極端な動作条件下での放射応答を調査する必要があります。
最近、多くの研究者がSi / Ge超格子の放射線損傷効果を研究しました[7、8、9、10、11、12、13、14、15、16]。 Sobolev etal。純粋なGeの単分子層を含むSi / Ge SLのフォトルミネッセンス(PL)に対する電子照射の影響を調査し、バルクシリコンと比較してSL構造の耐放射線性が向上していることがわかりました[12]。 Fonseca etal。 2.0 MeVの陽子照射を使用してGe量子ドット(QD)を埋め込んだSi / Ge SLを照射し、QD-in-SL構造の非常に高い放射線抵抗を発見しました[13]。同様の結果がLeitãoetal。によって得られ、Si / Ge多層構造を含むダイオード構造上に堆積されたGe量子井戸(QW)は、単一のGeQWと比較して陽子照射に対してより耐性があると報告しました[14]。有望な熱電材料として、Si / Geシステムの熱電特性も放射環境下で影響を受ける可能性があります[11、15]。 Zheng etal。 Si 1 − x の複数の周期的な層を照射しました Ge x / Siは5MeVのSiイオンを使用しており、熱電性能指数はSiイオンのフルエンシーが増加するにつれて増加することを発見しました[11]。欠陥と構造の乱れは、格子に沿ってフォノンを吸収および放散することによって面間熱伝導率を低下させ、QD構造のミニバンドの電子状態密度は電気伝導率とゼーベック係数を増加させます。メリットの[11]。
理論的には、SayedとWindlはどちらも、古典的な分子動力学(MD)法を使用してバルクSiの原子変位を調査しました[17、18]。彼らは、はじき出しエネルギー(E d s)ノックオン方向に依存し、損傷状態は主にフレンケルペア(FP)欠陥です[17、18]。 Caturla etal。 MD法を用いてバルクSiの放射線損傷に対するイオン質量とエネルギーの影響を研究しました[19]。彼らは、アモルファス化、孤立点欠陥、小さなクラスターの生成は、イオン質量に強く依存し、イオンエネルギーとは弱い関係にあると報告しました[19]。 Holmströmetal。 E d を計算しました s MD法を使用したゲルマニウムの場合、安定した欠陥はFP欠陥であることがわかりました[20]。 Shaw etal。 ab initio法を適用して、アンチモンとゲルマニウムの欠陥がSi / Geヘテロ構造の電子構造に及ぼす影響を調べ、これらの欠陥がSi / Ge界面と相互作用して、界面に関連する局所的な共鳴と電子への大きな局所的な摂動をもたらすことを発見しました。構造[21]。これらの言及された調査にもかかわらず、Si / GeSLの放射線損傷の動的プロセスの理論的シミュレーションはこれまでの文献で報告されていません。半導体超格子における欠陥生成の微細構造の進化と根本的なメカニズムについての原子レベルの理解はまだ不足しています。
非経験的分子動力学(AIMD)法は、放射線損傷プロセスに光を当てるための重要なツールであることが実証されており、一連の半導体およびセラミック材料の反跳イベントのシミュレーションに実際に成功しています[22、23、24、 25、26、27]。従来のMD法と比較すると、原子間ポテンシャルは、実験結果の経験的なフィッティングではなく、電子構造計算から取得されます。その結果、E d のような多くの物理パラメータ sはabinitio精度で決定できます。この研究では、AIMD法を使用して、低エネルギー照射下でのバルクSi、Ge、およびSi / GeSLの応答挙動を比較します。はじき出しエネルギーが決定され、欠陥分布と欠陥生成の経路が提供されました。バルクSi(Ge)とSi / GeSLの間の放射線耐性の不一致の考えられる原因も調査されます。提示された結果は、バルクSi、Ge、およびSi / Ge SLの変位イベントの微視的メカニズムへの基本的な洞察を提供し、放射線環境下でのこれらの材料の放射線応答の理解を促進します。
メソッド
バルクSi、Ge、およびSi / Ge SLの低エネルギー変位イベントは、スペインの数千原子の電子シミュレーションイニシアチブ(SIESTA)コードによってシミュレートされます。ノルムを保存するTroullier-Matrins擬ポテンシャル[28]は、イオンと電子間の相互作用を決定するために使用され、交換相関ポテンシャルは、Ceperly-Alderパラメーター化[29]の局所密度近似(LDA)によって記述されます。原子価波動関数は、局在化した原子軌道の基底関数系によって拡張され、単一ζ基底関数系と分極軌道(SZP)が採用され、ブリルアンゾーンで1×1×1のK点サンプリングとカット- 60Ryのオフエネルギー。本研究では、Si 2 / Ge 2 2層のSiと2層のGeと合計288個の原子が交互に並んだSLが考えられます。図1は、バルクSiおよびSi / GeSLの幾何学的構成を示しています。特定の原子が一次ノックオン原子(PKA)として選択され、反跳イベントを開始するための運動エネルギーが与えられます。変位イベントの終了時にPKAが元の位置に戻ると、5eVのエネルギー増分でより高い反動エネルギーでシミュレーションが再開されます。 PKAがその格子サイトから恒久的に移動すると、精度を0.5 eVに向上させるために、追加の実行が実行されます。原子タイプごとに、バルクSi(Ge)とSi / GeSLにそれぞれ4つと5つの主入射方向が考慮されます。シミュレーションはNVEアンサンブルを使用して実行され、システムの不安定さを回避するために、各実行の最大期間は1.2psです。

a の幾何学的構造の概略図 バルクSiおよび b Si / Ge超格子。青と緑の球は、それぞれSi原子とGe原子を表しています
結果と考察
バルクシリコンとゲルマニウムの変位イベント
バルクSiの格子定数は5.50Åと決定されており、これは5.48Åの理論結果[30]および5.43Åの実験結果[31]とよく一致しています。バルクSiと比較すると、バルクGeの格子定数は5.71Åと大きく、計算結果5.65Å[30]と実験値5.77Å[31]と一致しています。バルクSiおよびGeについて計算されたしきい値変位エネルギーは、変位イベント後の関連する欠陥とともに表1にまとめられています。 SiおよびGe反跳の損傷終了状態の構成を図1および2にプロットします。それぞれ2と3。
<図>
a – d 反跳イベント後の損傷Siの幾何学的構造の概略図。緑と赤の球は、それぞれ空孔と格子間欠陥を表しています。 V Si :シリコン空孔; Si int :シリコンインタースティシャル

a – d 反跳イベント後の損傷Geの幾何学的構造の概略図。赤と青の球は、それぞれ空孔と格子間欠陥を表しています。 V Ge :ゲルマニウム空孔; Ge int :ゲルマニウムインタースティシャル
バルクSiの場合、 E d 値は、[001] [32]の21eV、[110] [33]の〜47.6 eV、[111] [34]方向の〜12.9 eVの実験結果、および実験と計算の両方よりもわずかに小さくなっています。損傷した最終状態がフレンケルペア(FP)欠陥であることを明らかにします。 E d 本研究の値は、Windlらによって報告されたMDの結果と一般的に同等です。 [18]、ただし[110]の場合を除き、47eVの計算値は24eVのMD結果よりもはるかに大きくなります。 SiCにおけるイオン-固体相互作用の以前のAIMDシミュレーションは、変位イベントが実際には電荷移動プロセスであり、反跳原子との間の電荷移動が安定した欠陥形成のためのエネルギー障壁とダイナミクスを変える可能性があることを明らかにしました[35]。 E の低い値 d 古典的なMDによって決定されたものと比較してAIMDによって発見されたのは、反跳イベント中に発生する電荷移動がAIMD法によって考慮されているのに対し、古典的なMDシミュレーションでは原子の電荷が固定されているためです。 Windl et al。の研究では、運動エネルギーがPKAに伝達され、1つのシリコン空孔(V Si )が生成されます。 )および1つのシリコンインタースティシャル(Si int )欠陥[18]。対照的に、私たちの研究では、Si [110]変位イベントに関連する欠陥には2つのV Si が含まれています および2つのSi int 欠陥、損傷状態の形成のためのより高いエネルギーをもたらします。 E d Si [111]とSi \(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)の値は互いに非常に近く、それぞれ9.5と10eVです。どちらの場合も、作成される欠陥はV Si です。 およびSi int (図2c、dを参照)が、欠陥生成のメカニズムは異なる特性を示します。 Si [111]の場合、Si PKAは反発相互作用により\(\ left [11 \ overline {1} \ right] \)方向に移動し、隣接するSi原子と衝突します。次に、Si PKAは散乱して、侵入型サイト(Si int )を占有します。 )、置き換えられたSiはPKAの格子サイトに戻ります。関連する欠陥は1つのV Si および1つのSi int 欠陥。 Si \(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)の場合、変位イベントは比較的単純です。つまり、SiPKAは格子サイトから4.69Å離れてSi int を形成する 欠陥。 Si [001]およびSi [110]の場合、E d sはそれぞれ20および47eVであると決定され、Si原子が[110]方向に沿って移動するのがより困難であることを示しています。 Si [001]とSi [110]の損傷終了状態は多少異なります。 Si [001]の場合、PKAは運動エネルギーを受け取り、[001]方向に沿って移動し、隣接する原子と衝突します。図2aに示すように、置換されたSi原子は動き続け、格子間サイトを占有します。 Si [110]の場合、PKAとその隣接原子との間の反発相互作用により、PKAは\(\ left [11 \ overline {1} \ right] \)方向に散乱し、隣接する1つのSi原子(Si1)に衝突します。 。次に、Si PKAは[111]方向に跳ね返り、別のSi原子(Si2)に置き換わり、Si2原子は最終的に格子間サイトを占有します。 Si1原子は、[110]方向に沿って移動するのに十分なエネルギーを受け取り、隣接するSi原子(Si3)に置き換わり、格子間欠陥を形成します。結局、関連する欠陥は2つのV Si および2つのSi int 図2bに示すように欠陥。
バルクGeの場合、 E の値 d 実験値〜18 eV [36]および[001]方向の理論値18.5eV [20]とよく一致しています。現在の値9.5eVは、Holmströmの結果である[111]方向の12.5 eV [20]に匹敵し、実験値の〜15 eV [36]よりも小さいことに注意してください。 Ge [111]およびGe \(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)の場合、決定された E d 値は9.5eVと小さく、Ge原子がこれらの2つの方向に沿って簡単に変位することを示しています。どちらの場合も、関連する欠陥はゲルマニウム空孔とゲルマニウム格子間原子です(図3c、dを参照)。 Ge \(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)の場合、Ge PKAは直線経路をたどりませんが、最近傍の1つによって強く偏向されて占有されます。インタースティシャルサイト(Ge int )。対照的に、Ge [111]の場合、Ge PKAは[111]方向に沿って4.92Å移動し、格子間欠陥(Ge int )。 E と比較して d Ge [001]の場合、Ge [110]の値は10eV大きく、Ge原子が[110]方向に沿って移動するのがより困難であることを示しています。 Ge [001]とGe [110]に関連する欠陥は類似していますが、欠陥生成のメカニズムは多少異なります。 Ge PKAは運動エネルギーを受け取り、[001]方向に沿って移動して、隣接する原子と衝突します。図3aに示すように、置き換えられたGe原子は動き続け、格子間サイトを占有します。 Ge [110]の場合、Geの反跳は[110]方向に沿って最初に隣接するGe原子(Ge1)と衝突し、[111]方向に沿って跳ね返り、Ge int が形成されます。 。 Ge1原子はその格子サイトを離れ、隣接するGe原子(Ge2)に置き換わります。その後、Ge2原子はGe1の格子サイトに戻り、最終的には1つのV Ge のみに戻ります。 および1つのGe int 図3bに示すように、欠陥が形成されます。これらの結果は、バルクのSiおよびGeでは、E d sは結晶学的方向に強く依存し、原子は[110]方向に沿って移動するのがより困難です。バルクSiおよびGeの放射線損傷の最終状態は、主にFP欠陥、つまり空孔および格子間欠陥です。
Si / Ge超格子の変位イベント
この研究では、Si 2 の変位イベント / Ge 2 2層のSiと2層のGeが交互に含まれるSL(図1bを参照)が考慮されます。 Si / Ge界面に隣接するSiおよびGe原子がPKAとして選択されます。 E d SiとGeの反跳とそれに関連する欠陥のsを表2に示します。SiとGeの反跳の欠陥構成を図1と図2に示します。それぞれ4と5。 Si [111]の場合、100eVまでのエネルギーでも欠陥が発生しないことに注意してください。計算上の制限により、100eVを超えるエネルギーでの反跳イベントのシミュレーションは実行しませんでした。正確な E d Si [111]の値は決定されていません。
<図>
a – d Si反跳イベント後の損傷Si / Ge超格子の幾何学的構造の概略図。青と緑の球は、それぞれSi原子とGe原子を表しています。 V X : X 空室( X =SiまたはGe); X int : X インタースティシャル( X =SiまたはGe); X Y : X Y を占める 格子サイト( X および Y =SiまたはGe)。紫と赤の球は、それぞれ空孔と間質の欠陥を表しています
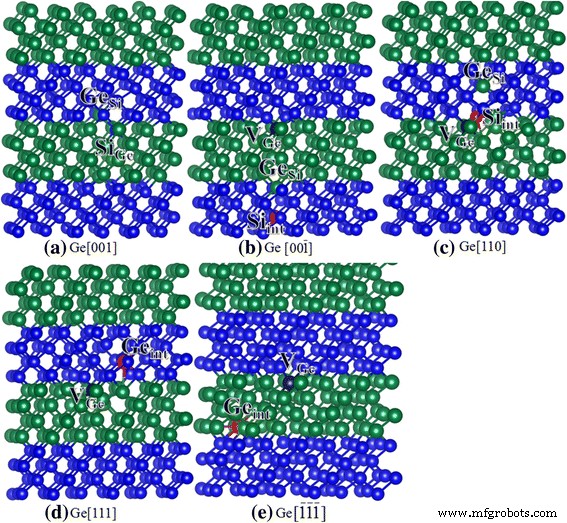
a – e Ge反跳イベント後の損傷Si / Ge超格子の幾何学的構造の概略図。青と緑の球は、それぞれSi原子とGe原子を表しています。 V X : X 空室( X =SiまたはGe); X int : X インタースティシャル( X =SiまたはGe); X Y : X Y を占める 格子サイト( X および Y =SiまたはGe)。紫と赤の球は、それぞれ空孔と間質の欠陥を表しています
Si / Ge SL構造では、Si PKAは、\(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)方向に沿って簡単に変位することがわかります。小さい E d 10eVの値。欠陥生成の経路は非常に単純です。つまり、Si PKAは格子サイトから4.61Å離れて移動し、Si int を形成します。 欠陥。 Si [001]およびSi \(\ left [00 \ overline {1} \ right] \)の場合、E d sはそれぞれ46.5eVと42.5eVであると判断され、損傷した欠陥は予想どおりに異なります。 Si [001]の場合、Si PKAは[001]方向に沿って移動し、隣接するGe原子(Si Ge )を置き換えます。 )、置換されたGe原子は隣接するSi原子と衝突し、その格子サイトを占有して、Ge Si を形成します。 アンチサイト欠陥。置換されたSi原子は十分なエネルギーを受け取り、さらに別のGe原子(Si Ge )、これは最終的にインタースティシャルサイトを占有します。最終的に、関連する欠陥は1つのV Si 、1つのGe int 、および3つのアンチサイト欠陥。 Si \(\ left [00 \ overline {1} \ right] \)に関しては、2つの隣接するGe原子と1つの隣接するSi原子も変位イベントに関与し、損傷状態には2つの空孔、2つの格子間原子、および2つの空孔が含まれます。図4bに示すように、アンチサイトの欠陥。 Si [110]の場合、Si原子は隣接するSi原子に衝突するように移動し、\(\ left [11 \ overline {1} \ right] \)方向に散乱します。次に、Si PKAは、最終的に格子間サイトを占める1つの隣接するGe原子を置き換えます。変位イベントの後、関連する欠陥には1つのV Si が含まれます。 、1つのSi Ge、 および1つのGe int 欠陥。バルクSiと比較して、Si / Ge SLのSi原子は[110]の場合を除いて一般に変位しにくく、欠陥生成のメカニズムはより複雑であり、バルクSiとSi / GeSLが示すことを示しています。照射に対する異なる放射線応答。私たちの結果は、Fonsecaらによって実施された実験と一致しています。およびLeitãoetal。 [13、14]、バルクシリコンと比較してSL構造の耐放射線性が向上していることも発見しました。
Si / Ge SLのGe反跳の場合、Ge原子は[111]および\(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)方向に沿って簡単に変位します。これは、バルクGeのGe反跳イベントに似ています。 Ge [111]とGe \(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)の放射線損傷の最終状態は非常に似ていますが、つまりGe FP欠陥、メカニズム欠陥生成の割合が異なります。 Ge [111]の場合、Ge PKAはその格子サイトから4.77Å離れて移動し、Ge int を形成します。 欠陥。 Ge \(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)の場合、Geアトムは\(\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \)隣接するGe原子を置き換える方向。衝突したGe原子はこの方向に沿って移動し、最終的に格子間サイトを占有します。 E d Ge [001]の16eVとGe \(\ left [00 \ overline {1} \ right] \)の17.5 eVの値は、バルクGeのGe [001]の18eVの値と同等ですが、欠陥は異なる性質を示します。 Ge [001]の場合、Ge PKAは十分なエネルギーを受け取りますが、[111]方向に沿って散乱し、隣接するSi原子を置き換えて、Ge Si を形成します。 アンチサイト欠陥。次に、置換されたSi原子がGe PKA格子サイトを占有し、アンチサイト欠陥(Si Ge )を形成します。 )。 Ge \(\ left [00 \ overline {1} \ right] \)の場合、Ge PKAは5.63Å離れて、隣接するSi原子を置き換えます。 Si原子はこの方向に沿って移動し、Si int を形成します。 欠陥。バルクGeのGe [110]と比較すると、E d Si / GeSLのGe [110]の場合、8.5 eV小さく、1つのV Ge で示されるように、関連する欠陥はより複雑です。 、1つのGe Si 、および1つのSi int 欠陥。バルクGeとSLのGe反跳イベントを比較すると、Si / GeSLのGe原子は[110]方向に沿ってより耐性があることがわかります。その他の変位イベントの場合、E d sは、一般的にバルク状態のものと同等です。ただし、バルクGeとSi / Ge SLの放射線損傷の最終状態は異なり、Si / GeSL構造にはいくつかのアンチサイト欠陥が生じます。これらの結果は、Si / GeSL構造のGe反跳が照射に対して異なる放射線応答を示すことを示唆しています。 SL構造のSiとGeの反跳を比較すると、Si原子の変位イベントはGeよりもはるかに影響を受けていることがわかります。つまり、E d SL構造のSi原子のsは一般に増加し、Si / GeSLの耐放射線性が向上する可能性があります。 Sobolev etal。 Si / Ge SLは、バルクSi [12]と比較して非常に高い耐放射線性を示すことがわかりました。これは、私たちの結果と一致しています。
バルクSi、Ge、およびSi / Ge超格子における欠陥形成エネルギーと移動障壁
バルクのSiとGeでは、損傷状態は主に空孔と格子間欠陥です。 Si / Ge SLの場合、関連する欠陥には空孔、格子間欠陥、アンチサイト欠陥が含まれ、欠陥生成のメカニズムは一般により複雑です。バルク部品材料とSi / Ge SLの間の欠陥形成に対する耐性の不一致は、それらの異なる放射線耐性をもたらす可能性があります。これらの半導体材料のさまざまな放射応答の起源をさらに調査するために、密度汎関数理論法を使用して、バルク状態およびSL構造における空孔、格子間およびアンチサイト欠陥の形成エネルギーと最も好ましい欠陥の移動障壁を計算します。計算は、64個の原子で構成されるスーパーセルに基づいており、実空間での6×6×6kポイントのサンプリングと500eVのカットオフエネルギーを備えています。
バルクSi、Ge、およびSi / Ge SLの欠陥形成エネルギーを、他の計算結果とともに表3に示します。バルクSiでは、V Si の形成エネルギー 、Si int 、およびSi FP欠陥は、それぞれ3.60、3.77、および4.62 eVと計算され、他の計算と合理的に一致しています[37、38、39、40]。私たちの結果は、V Si 欠陥はバルクSiで作成されやすくなります。同様に、V Ge バルクGeの欠陥は、Ge int よりもエネルギー的に有利です。 最小の欠陥形成エネルギー2.23eVで示されるように、Ge FP欠陥は、理論値2.09eVとよく比較されます[39]。 Si / Ge SLは、V Ge の生成エネルギー は2.73eVと決定されます。これは、他の欠陥の形成エネルギーよりも小さい値です。次の好ましい欠陥はV Si です 欠陥があり、形成エネルギーは2.85eVであると決定されます。 Ge int の3.52eVの値に注意してください。 Si int の3.77eVの値よりも小さい 欠陥。 FP欠陥については、形成エネルギーが明らかに大きく、SiFPでは5.19eV、GeFPでは5.01eVであり、FP欠陥の発生が困難であることを示しています。バルク状態と比較して、Si / Ge SL構造の欠陥形成エネルギーは、V Si の欠陥を除いて一般的に大きくなります。 およびSi int 、SL構造では、点欠陥は一般に形成がより困難であることを示しています。バルク状態とSi / Ge SL構造の間の欠陥形成に対する耐性のこのような不一致は、照射に対するそれらの異なる応答をもたらす可能性があります。
<図>最適化された構造に基づいて、V Ge の移行動作 およびV Si バルクおよびSi / GeSL構造で最も好ましい欠陥である欠陥をさらに調査します。 V Ge およびV Si Si / Geインターフェースに隣接する欠陥が考慮され、移行バリアが表4にまとめられています。V Ge 欠陥はV Si の欠陥よりも小さい 欠陥、およびV Ge のエネルギー障壁 [111]方向に沿った移動は、V Si の移動よりもわずかに大きくなります。 移行。これは、Cowern etal。によって報告された結果と一致しています。 [41]。
<図>[100]、[110]、および[111]方向に沿った欠陥移動のエネルギー地形を図6にプロットします。図6aでは、V Si の移動障壁を示しています。 [100]方向に沿った欠陥は、バルクSiおよびSi / GeSLでそれぞれ4.32および3.92eVであると決定されます。 [110]方向については、V Si の2.14eVの移行障壁 Si / Ge SL構造では、バルクSiの2.12eVの値に非常に近い値です。各方向に沿った移動障壁を比較すると、[111]方向が、移動障壁が大幅に小さいことからわかるように、SiとGeの両方の空孔にとって最も好ましい移動方向であることがわかります。特に、V Si バルク状態での0.11eVのエネルギー障壁ははるかに小さいため、欠陥はSi / Ge SLよりもバルクSiの[111]方向に沿って移動しやすくなります(図6eを参照)。 V Ge は 欠陥の場合、[100]方向に沿った移動障壁は、バルクGeで3.67 eV、Si / GeSLで2.87eVと計算されます。 [110]方向の場合、エネルギー障壁はバルク構造とSL構造でそれぞれ1.94と1.39eVであると決定されます。 Si空孔移動の場合と同様に、V Ge 欠陥は[111]方向に沿って移動しやすくなります。また、図6fに示すように、移行はSi / GeSLよりもバルクGeで発生しやすくなります。私たちの計算によると、SiとGeの両方の空孔は、バルク状態ではSL構造よりも移動性が高く、ボイドの形成や体積の膨張さえも引き起こす可能性があります。これは、バルク構造とSL構造の照射に対する異なる反応に寄与する可能性があります。
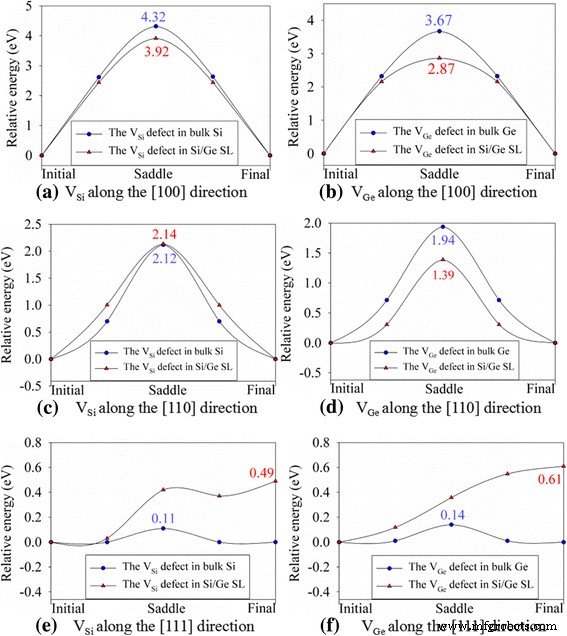
シリコン空孔の移動障壁(V Si )およびゲルマニウム空孔(V Ge )クラスターナッジドエラスティックバンド法で得られた欠陥。 a V Si [100]方向に沿って; b V Ge [100]方向に沿って; c V Si [110]方向に沿って; d V Ge [110]方向に沿って; e V Si [111]方向に沿って; f V Ge [111]方向に沿って
結論
要約すると、バルクSi、Ge、およびSi / Ge超格子(SL)の低エネルギー変位イベントは、abinitio分子動力学法によって調査されました。バルクSiおよびGeでは、はじき出しエネルギーは結晶学的方向に依存することが示され、原子は[110]方向に沿って変位するのがより困難です。バルク状態での損傷状態は、主に空孔と格子間欠陥です。 Si / Ge SL構造では、Si原子は[111]方向に沿ってより耐性があり、Ge原子は[110]方向に沿って変位するのがより困難です。私たちの計算によると、SL構造のGe反跳のエネルギーは一般にバルクGeのエネルギーに匹敵しますが、SL構造のSi反跳のエネルギーは一般にバルクSiのエネルギーよりもはるかに大きく、放射線耐性が向上していることを示しています。 Si / GeSLの。欠陥形成エネルギーの計算は、Si / Ge SLの点欠陥が一般に高い形成エネルギーを持っていることを示しており、SL構造では点欠陥の形成が一般に難しいことを示しています。また、[111]方向は、SiとGeの両方の空孔にとって最も好ましい移動経路であり、両方の空孔は、SL構造よりもバルク状態で移動しやすいことがわかります。私たちの計算によると、Si / Ge SLの強化された耐放射線性は、放射線などの極端な動作条件下での電子およびオプトエレクトロニクスデバイスとしてのアプリケーションに有益であることが示唆されています。
略語
- AIMD:
-
非経験的分子動力学
- E d :
-
はじき出しエネルギー
- FP:
-
フレンケルペア
- Ge:
-
ゲルマニウム
- Ge int :
-
ゲルマニウムインタースティシャル
- Ge Si :
-
シリコン格子サイトを占めるゲルマニウム
- LDA:
-
局所密度近似
- MD:
-
分子動力学
- NVE:
-
ミクロカノニカルアンサンブル
- PKA:
-
一次ノックオン原子
- PL:
-
フォトルミネッセンス
- QD:
-
量子ドット
- QW:
-
量子井戸
- Si:
-
シリコン
- SIESTA:
-
数千の原子を使用した電子シミュレーションのためのスペインのイニシアチブ
- Si Ge :
-
ゲルマニウム格子サイトを占めるシリコン
- Si int :
-
シリコンインタースティシャル
- SL:
-
超格子
- SZP:
-
単一ζ基底関数系と分極軌道
- V Ge :
-
ゲルマニウム空孔
- V Si :
-
シリコン空孔
ナノマテリアル
- IoTと5Gの影響の評価
- スタックカップカーボンナノファイバーの原子および電子構造を明らかにする
- セリウムのダイヤモンドカッティングの分子動力学モデリングとシミュレーション
- ボロフェンの安定性とSTM画像に関する第一原理研究
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- ヘリウム水素を順次注入したバナジウム合金の微細構造と硬化に及ぼす焼鈍の影響
- ポリオール媒介プロセスによるZnOナノクリップの製造と特性評価
- チタニアナノチューブの熱伝導率に及ぼす形態と結晶構造の影響
- 急速に進化するシミュレーションの世界
- DCモーターとACモーターの違い
- 3D モデリングとシミュレーションの力が製造プロセスの革新に拍車をかける



