金属支援化学エッチングによって製造されたAuキャップGaAsナノピラーアレイ
要約
GaAsナノピラーアレイは、Auナノドットアレイを使用した金属支援化学エッチングによって正常に製造されました。ナノドットアレイは、開口部の規則正しいアレイを備えた多孔質アルミナマスクを介した真空堆積によって基板上に形成された。比較的低温で酸濃度が高く酸化剤濃度が低いエッチャントを使用することにより、Au / GaAs界面周辺を選択的にエッチングすることができた。最適な条件下で、AuでキャップされたGaAsナノピラーアレイは、100nmの秩序ある周期性と50nmのピラー高さで形成されました。
背景
III–V化合物半導体は、優れたキャリア移動度や直接バンドギャップなどの優れた特性により、次世代材料として、またシリコンベースの半導体の代替候補として注目されています。規則正しい周期性および/または高アスペクト比のナノ構造は、従来の薄膜ベースのデバイスと比較して低コストで変換効率が高いため、光学およびオプトエレクトロニクスデバイスを含むさまざまなアプリケーションで重要な要素と見なされています[1,2,3,4] 。一般に、低次元半導体(ナノワイヤなど)を製造するには、分子線エピタキシー、気液固エピタキシー、有機金属気相エピタキシーなどの乾式プロセスが使用されます[1、5、6、7]。これらの方法には、高いパターニング精度を含む多くの利点がありますが、それらの欠点には、実際のアプリケーションでのパターニング領域の高いコストとサイズの制限が含まれます。したがって、ナノ構造のシンプルで費用効果の高い製造を可能にする代替方法が必要です。
2000年にLiとBohnによって提案された金属支援化学エッチング[8]は、比較的単純で低コストであるため、一般的に使用される製造方法です。最近の研究では、金属支援化学エッチングを適用して、深く真っ直ぐなナノポア、らせん状のナノポア、傾斜したチャネル、サイクロイド、スパイラルなどの複雑なナノ構造を製造できることが示されています[4、9、10、11、12]。しかし、Li et al。による報告以来、ほとんどの研究はシリコンナノ構造の製造を報告しています。 III-V化合物半導体のナノファブリケーションに焦点を当てた調査はほとんどなく[13、14]、GaAs基板上に秩序だったナノメートルスケールの構造が形成されることは特によくわかっていません。金属支援化学エッチングの応用範囲を拡大するために、得られるパターンの寸法に依存しないIII-V化合物半導体のナノファブリケーション法を開発することが望ましい。
以前の研究では、金属支援化学エッチングを使用して、InPのマイクロバンプアレイ[15]とGaAsのラインパターンおよびピラーアレイ[16]を製造しました。しかしながら、結果として生じるパターンの寸法(例えば、線パターンの周期性および幅)は、数マイクロメートルから数十マイクロメートルの範囲であった。私たちの知る限り、以下の理由により、金属支援化学エッチングを使用したサブミクロンスケール以下の周期性を持つ秩序化されたGaAsナノ構造の形成を報告した研究はありません:(1)貴金属の形状とサイズを制御することは困難ですナノメートルスケールの触媒として使用され、(2)GaAsのエッチング現象はシリコンの場合と比較してあまりよく理解されていません。そこで、GaAsのエッチングメカニズムをナノメートルスケールで解明することを試みました。この研究では、100 nmの周期性を持つ規則正しいナノピラーアレイが、パターン化されたAu触媒を使用した金属支援化学エッチングを使用してGaAs基板上に製造できることを示します。エッチングされたGaAs基板の形態に及ぼすエッチャント組成とエッチング時間の影響も調査されます。
メソッド
金属支援化学エッチングによるGaAsナノピラーアレイの製造原理を図1に模式的に示します。開口部の配列が規則正しいスルーホール多孔質アルミナマスクは、2段階の陽極酸化とそれに続く2層の陽極酸化によって作成されました[ 17]。最初の陽極酸化は、電気化学的に研磨されたアルミニウム(純度99.99%)で、0.3 mol dm -3 で40Vの定電圧で実行されました。 30°Cで3時間のシュウ酸。 40 Vの陽極酸化電圧は、陽極酸化アルミナに高度に秩序化された細孔配列を生成する自己秩序化条件として確立されています[18]。
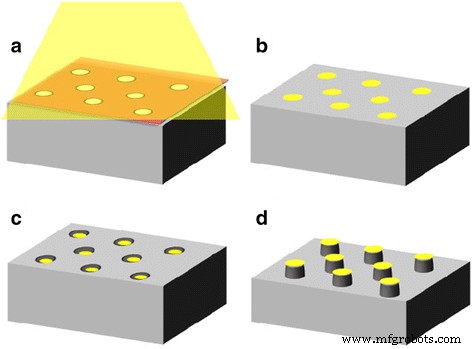
GaAsナノピラーアレイの製造の概略モデル。 a 多孔質アルミナマスクを介したGaAs基板へのAuの真空堆積。 b マスクの取り外し。 c 、 d 触媒としてAuナノドットアレイを使用したGaAsの化学エッチング
最初の陽極酸化後、最初の陽極酸化アルミナ層をリン酸とクロム酸の混合溶液で80°Cで除去しました。続いて、1回目の陽極酸化と同じ条件で2回目の陽極酸化を1.5分間行いました。 2層陽極酸化の原理に基づいて、試験片は12 mol dm -3 で40Vの定電圧で再度陽極酸化されました。 犠牲アルミナ層を準備するために5°Cで8分間硫酸。スルーホール多孔質アルミナマスクは、犠牲アルミナ層を2 wt%リン酸に30°Cで20分間溶解することによって形成されました。アルミナマスクの細孔径を大きくするために、5 wt%リン酸で30°Cで15分間、さらに化学エッチングを行いました。
得られたアルミナマスクを蒸留水ですすいだ後、n型GaAs基板上にセットした[Siドープ、2.35–2.67×10 -3 Ωcm、(100)結晶方位]。続いて、1×10 -3 Pa(図1a)。水晶振動子微量天秤を使用してAu層の厚さを測定し、Auの堆積速度は0.02 nm s -1 でした。 。金属蒸着後、アルミナマスクを5 wt%リン酸で、25°Cで30分間除去しました(図1b)。
AuコーティングされたGaAs基板は、KMnO 4 を含むHFで化学的にエッチングされました。 (図1c)。 KMnO 4 酸性溶液中で酸化剤として作用します[19、20、21、22]。アルミナマスク、堆積したAu層、およびエッチングされたGaAs基板の形態を、電界放出型走査電子顕微鏡(FE-SEM; JEOL JSM-6701F)によって評価しました。エッチングされたGaAs基板の化学組成は、オージェ電子分光法(AES; JEOL JAMP-9500F)によって評価されました。オージェ電子スペクトルは、表面の選択されたポイントまたは領域から簡単に取得されます。ここで、AES元素マッピング画像は、加速電圧と放出電流がそれぞれ30kVと15nAで取得されました。
結果と考察
金属支援化学エッチングでは、金属触媒の寸法を正確に制御して、基板表面に所望の設計を得ることが不可欠です。得られた構造の形態は、金属触媒の初期の幾何学的パターンと寸法に依存するため、半導体表面に規則正しいナノ構造を製造するには、パターン化された金属触媒が必要です。この研究では、開口部の規則正しい配列を備えたアルミナマスクを使用して、金属触媒のサイズと配置を制御しました。乾式金属蒸着プロセスの場合、開口部が狭い厚いマスクを介した金属蒸着は物理的に困難であるため、マスクの厚さは重要です。多孔質アルミナの場合、陽極酸化時間を変えることでマスクの厚みを再現性よく調整できます。ここでは、GaAs基板上に厚さ約300nmのスルーホール多孔質アルミナマスクを作製しました。アルミナマスクは、その表面が上を向くように設定されました。アルミナマスクの開口部の上部と下部の直径は、それぞれ約80nmと70nmでした。下部開口部と比較して上部開口部の直径がわずかに大きいのは、アルミナマスクの調製中の化学エッチングに起因していました。
図2は、GaAs基板上の典型的な秩序だったAuナノドットアレイを示しています。ナノドットアレイは、図2aに示すように、陽極酸化アルミナマスクの自己秩序化細孔アレイの構成に対応しています。金蒸着の可制御性はさらに改善されるべきですが、ここで示されるアルミナマスクを介した金属蒸着は、製造プロセスの単純さと効率の観点から、半導体基板上に規則正しい貴金属ドットパターンを大規模に製造するのに適しています。各Auナノドットの直径はほぼ同じで約70nmであることに注意してください。この直径はアルミナマスクの底部の細孔径によって決定され、Auナノドットの高さは主に堆積時間によって決定されました。この研究では、図2bに示すように、各Auナノドットの高さを約30nmに調整しました。
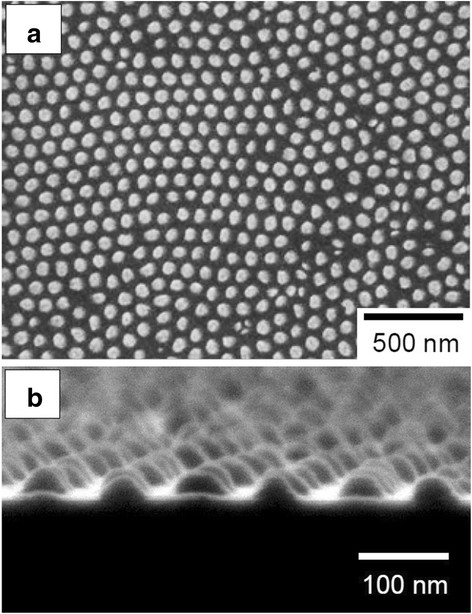
a 表面と b 陽極多孔質アルミナマスクを介してGaAs基板上に形成されたAuナノドットアレイの断面SEM画像
GaAs基板上にAuドットアレイを形成した後、試料をHFとKMnO 4 の溶液に浸しました。 金属支援化学エッチング用。従来の金属支援化学エッチングでは、エッチングは触媒と下にある基板との間の界面で局所的に進行し、その結果、基板に垂直な方向に細孔またはトレンチが形成され、金属触媒は、以下に示すように半導体に沈む。図1c。高い酸濃度と低い酸化剤濃度で構成されるエッチャントの使用は、生成された正極性の正孔(h + )のスムーズな消費を促進すると考えられます。 )金属/半導体界面で。この研究では、Au / GaAs界面でのGaAsの酸化は、生成されたh + によって直接進行すると予想されます。 。
図3は、パターン化されたAu触媒を使用してエッチングされたGaAs表面の典型的なSEM画像を示しています。化学エッチングは、0.001 mol dm -3 を含む溶液で実施しました。 KMnO 4 および20mol dm -3 45°Cの比較的高温でのHF。この研究では、KMnO 4 の濃度 低かった(0.001 mol dm -3 )横方向のエッチングを抑制します。 DeJarldらによる以前の報告によると。およびCheunget al。は、酸化剤(KMnO 4 )の増加に伴い、横方向のエッチング速度が増加しました。 )濃度[19、21]。

0.001 mol dm -3 を含む溶液中でのAu支援化学エッチング後のGaAs基板の上面のSEM画像 KMnO 4 および20mol dm -3 45°Cで600秒間のHF
図3に示すように、円形の輝点として検出されたAu触媒が、GaAs基板の多くの領域の細孔内に観察されました。図3で観察された細孔の直径は、示されている堆積したAuナノドットのサイズと一致しました。これらの結果は、図1cに概略的に示されている従来の金属支援化学エッチングがAu / GaAs界面でのみ発生し、基板に対して異方性に垂直に、つまり<100>方向に進行したことを示しています。
金属支援化学エッチングでは、エッチャントの組成とエッチング温度が、キャリアの拡散、酸化、および生成物の除去のダイナミクスに影響を与えます[19]。エッチングされたGaAs基板の新しいアプリケーションを開くために、金属支援化学エッチングの条件を変更することにより、GaAsナノピラーアレイの製造を試みました。図4は、パターン化されたAu触媒を使用して得られたエッチングされたGaAs表面の典型的な断面SEM画像を示しています。 KMnO 4 の濃度を上げることによって 、結果として得られる構造の形態が変化する可能性があります。いずれの場合も、試料領域全体に六角形に配置されたGaAsナノピラーが得られました。ピラーの先端は、横方向のエッチングの結果、わずかに先細になっています。 GaAsナノピラーアレイの周期性は約100nmであり、触媒として使用されるAuドットアレイの周期性と、初期マスクとして使用される多孔質アルミナの細孔に対応します。私たちの知る限り、この研究で金属支援化学エッチングを介してGaAsで得られた構造の寸法(周期性など)は、他のGaAs構造で報告されているものよりも小さい[19、20、21、22]。
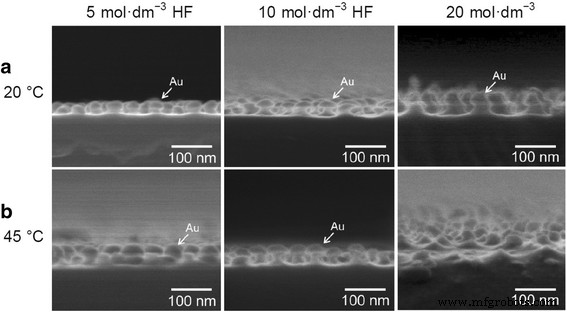
0.01 mol dm -3 を含む溶液中でAu支援化学エッチングによって製造されたGaAsナノピラーアレイのSEM画像 KMnO 4 および5、10、または20 mol dm -3 a で5秒間のHF 20および b 45°C
20℃という比較的低温でエッチングを行ったところ、矢印のように各柱の先端にAu触媒が観察されました。図4aは、同じ酸化剤濃度でHF濃度を上げると、エッチング速度が上がることを示しています。 20 mol dm -3 の高HF濃度で 、残りのGaAsピラーの高さが最も高かった。
Au / GaAs界面でのGaAsの酸化は、生成されたh + によって進行するという予想に反します。 、図4の場合、Au触媒と下にあるGaAs基板との接触領域での化学的溶解は観察されませんでした。エッチングパターンは、エッチャントの温度に依存すると考えられます。低温(例:20°C)では、h + の割合 Au / GaAs界面での消費量は、h + の速度よりも低いと考えられています。 注入;したがって、h + AuコーティングされたGaAsの周囲に拡散しました。最終的に、露出したGaAs表面でサイト選択的エッチングが発生したため、Au触媒と下にあるGaAs基板との接触領域の下にGaAsナノピラーが形成されました。言い換えれば、AuナノドットはGaAs基板の溶解を防ぐための保護マスクとしても機能しました。図1dに概略的に示されているこのエッチング現象は、逆金属支援化学エッチングと呼ばれます[19、22]。 2010年には、UV照射下での逆金属支援化学エッチングを使用したInPマイクロバンプアレイの形成も実証しました[15]。従来の金属支援化学エッチングとは対照的に、逆金属支援化学エッチングは、h + の拡散により、金属コーティングされた領域の周囲の露出したIII-V化合物半導体の表面で進行します。 金属触媒とそれに続く部位選択的化学エッチングから。このような独特のエッチング挙動は、シリコン材料では観察されていません。
45°Cの高温で金属支援化学エッチングを行うと、生成されたh + Au、GaAs、エッチャントの境界に達するとすぐに消費され、垂直エッチングが促進されると予想されます。ただし、この場合でも、逆金属支援化学エッチングが発生しました。図4bに示すように、エッチング速度は、図4aのエッチング動作と同じように、HF濃度の増加とともに増加しました。ただし、45°Cの高いエッチング温度と20 mol dm -3 の高いHF濃度では 、過剰なh + が原因で、Au触媒がGaAsピラーの先端から分離しました。 比較的高温で生成され、5秒という短いエッチング時間でも、Au触媒の存在下でGaAsの横方向のエッチングが促進されました。ピラーの形状制御性は、エッチング条件(エッチング液の組成、濃度、温度など)をさらに最適化することで改善されます。 h + の生成に対する酸化剤の濃度の影響を明らかにする試み エッチングされたGaAsの形態は現在進行中です。
エッチングされたGaAs構造の形状に対するエッチング時間の影響を調べるために、化学エッチングを20 mol dm -3 に延長しました。 HFおよび0.01mol dm -3 KMnO 4 20°Cの比較的低い温度で。図5aの断面画像に示されているように、GaAsナノピラーの深さは約50nmに達しました。この研究で得られたGaAsナノピラーアレイの注目すべき特徴の1つは、図5aの挿入図に示すように、各ピラーの先端がAuで覆われていることです。図6は、同じ標本のAES元素分析を示しています。エッチングされたGaAsのGaとAuのAESマップは、金属支援の化学エッチングを10秒間行った後でも、各ピラーの先端にAuが存在することを示しています。
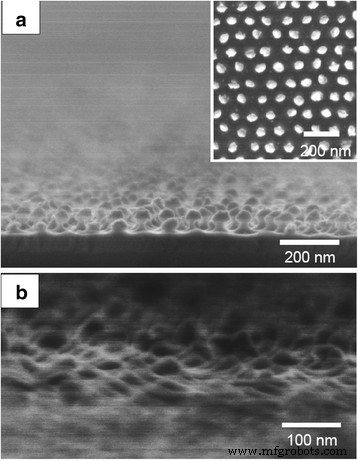
a の20°CでのAu支援化学エッチングによって製造されたGaAsナノピラーアレイの断面SEM画像 10および b 20 mol dm -3 を含む溶液で60秒 HFおよび0.01mol dm -3 KMnO 4 。 挿入図 は、AuでキャップされたGaAsナノピラーアレイの表面画像を示しています

a Au支援化学エッチング後のGaAs基板の画像と対応する b のAESマップ Gaと c Au。エッチング条件は図5aと同じです
ピラーの高さは主にエッチング時間によって決定されるため、エッチングをさらに10秒から1分に延長して、GaAs上に高いピラーのアレイを形成しました。ただし、図5bに示すように、エッチング時間が1分長くなると、ピラーの高さが低くなります。ピラーの高さの減少は、Au触媒の存在下での横方向のエッチングと、それに続く触媒として使用されたAuドットの剥離に起因していました。
ただし、h + の拡散を正確に制御する金属支援化学エッチング 金属触媒から、まだ完全には達成されていませんが、金属支援化学エッチングを使用したIII-V化合物半導体のナノファブリケーションは、乾式プロセスを使用せずに秩序だった3次元構造を設計するための有望な代替手段を提供します。さらに、得られたAuキャップ付きGaAsナノピラーアレイは、プラズモニックナノ構造を使用して光トラッピングを強化する太陽電池などのオプトエレクトロニクスデバイスにおいて、潜在的な技術的および科学的用途を持っています[23、24]。
結論
要約すると、Au支援化学エッチングによるGaAs(100)基板上での規則正しいGaAsナノピラーアレイの製造を実証しました。六角形の格子パターンと100nmの秩序ある周期性を備えた、Auナノドットアレイは、多孔質アルミナマスクを介した真空堆積によって形成されました。 Auナノドットの直径は約70nmで、これはアルミナマスクの下部の直径に対応し、触媒および保護マスクとして機能しました。比較的低温では、AuでキャップされたGaAsナノピラーアレイは、周囲の露出したGaAs表面でのサイト選択的エッチングによって形成できます。これらの発見は、金属支援化学エッチングに基づく実行可能なアプローチを使用して、GaAs基板上のナノ構造をより正確に制御するための最初の証拠を提供します。この通信で提示されたIII-V化合物半導体のナノファブリケーションのための非従来型のリソグラフィー技術は、従来の方法の欠点を克服し、さまざまな研究分野で潜在的な技術的および科学的応用があります。
略語
- AES:
-
オージェ電子分光法
- FE-SEM:
-
電界放出型走査電子顕微鏡
ナノマテリアル



