金属支援化学エッチング中の多孔質シリコンナノワイヤの形態進化とエッチング速度論の解明
要約
金属支援化学エッチングで製造された多孔質シリコンナノワイヤー(SiNW)の多くの潜在的なアプリケーションは、デバイス最適化のための形態の正確な制御に大きく依存しています。ただし、堆積した金属触媒の量、HF-酸化剤のモル比(χ)などの重要なエッチングパラメータの影響 )、およびSiNWの形態とエッチング速度に関する溶媒濃度は、まだ十分に調査されていません。ここでは、HF–H 2 に縮退してドープされたp型シリコンのナノ構造とエッチング速度の変化を示します。 O 2 –h 2 無電解銀触媒を用いたOエッチングシステムを系統的に調べた。表面形態は、ミクロポーラスでクレーターのある構造から、十分に高いχでSiNWの均一な配列に進化することがわかります。 値。ナノ構造のベースとチップでのエッチング速度は、それぞれ、Agによって誘発される一次エッチングと金属イオンと拡散正孔によって誘発される二次エッチングと相関しています。 H 2 O濃度もχに影響します 主に反応物の希釈と拡散速度を調整することにより、SiNWが形成されるウィンドウとエッチング速度。 χを介して二次エッチングと反応物の拡散を制御する およびH 2 それぞれO濃度は、長さから多孔性を独立して制御する高濃度にドープされたSiNWの製造が成功裏に実証されており、SiNWベースのデバイスの性能を向上させるために利用できる可能性があります。
背景
さまざまな新しい材料に関する研究の進歩にもかかわらず、シリコンは、その豊富な性質とデバイス統合のための十分に開発された技術の存在により、ナノ構造を製造するための最も魅力的な基板の1つです。近年、シリコンナノワイヤー(SiNW)やナノピラーなどの一次元シリコンナノ構造は、太陽光発電[1、2]、熱電[3、4]、エネルギー貯蔵などの幅広い用途で注目を集め続けています。 [5,6,7]、フレキシブルエレクトロニクス[8]、生化学的センシング[9]、および生物学的インターフェース[10]。そのようなナノ構造のユニークな電気的、光学的、熱的、および機械的特性とは別に、それらの持続的な魅力の主な推進力は、形態および物理的特性の優れた制御を維持しながら、ナノ構造の容易な形成を可能にする新しい製造技術の開発です。さまざまな製造技術の中で、金属支援化学エッチング(MACE)は、その単純さ、低コスト、および柔軟性のために、産業の観点から際立っています[11、12]。 MACEを使用すると、適切なSiウェーハ、エッチャント組成、反応温度、および反応時間を選択するだけで、定義された長さ、多孔性、導電率、ドーピングレベル、および結晶配向を備えたウェーハスケールの欠陥のないSiNWを得ることができます[13,14、 15,16,17,18,19,20,21,22,23]。 SiNWの直径、断面積、およびアレイピッチの制御は、ナノスフェアリソグラフィー[24]、干渉リソグラフィー[25]、ブロックコポリマーリソグラフィー[26]などの触媒パターン化技術によっても実現できます。これは、反応性イオンエッチングや気液固法など、高価な装置を必要とし、表面欠陥、制御されていない結晶学的配向、および限られた断面形状を持つナノワイヤを生成する可能性がある他の製造技術とは対照的です[11]。
過去10年間、MACEを使用して高濃度にドープされたSiウェーハからSiNWを製造することは、結晶品質の高い多孔質SiNWが得られるため、特に興味深いものでした[14、17、19]。多孔質構造により、ナノワイヤは、調整可能なフォトルミネッセンス[15]、低い熱伝導率[27]、高い比表面積[28]などの非常に望ましい特性を獲得できるため、オプトエレクトロニクス[14、16]、熱電[14、16]の有望な材料になります。 3、27]、光触媒[28、29]、およびエネルギー貯蔵[5]。それらのフォトルミネッセンスと高い表面積と組み合わせて、生理学的環境における多孔質SiNWの生体適合性と生分解性は、それらをバイオラベリング[15]およびドラッグデリバリーアプリケーション[30]の適切な候補にします。エッチャント中の高い酸化剤濃度を利用することにより、低ドープSiウェーハで比較的多孔質のSiNWを得ることができますが[15]、高ドープSiの使用は、エッチング後のドーピングの必要性をなくすため、高い導電率が必要な場合に有利です。ステップ。これは、性能指数の向上が電気伝導率の大幅な低下を伴わない熱伝導率の低下によるものである多孔質SiNWの熱電アプリケーションに特に当てはまります[27]。一方、多孔質SiNWの抵抗は固体SiNWに比べてかなり大きいことが報告されており[14]、多孔度と導電率のトレードオフを意味します。
上記のアプリケーションで多孔質SiNWの可能性を実現するには、高濃度にドープされたSiのMACE中のさまざまなエッチングパラメータの影響を完全に理解することが不可欠です。多くの研究[13、14、15、16、17、19、20、21、23]は、HF–H 2 でMACEを使用して、さまざまな長さと多孔性の高濃度にドープされたSiNWを製造することに成功しました。 O 2 エッチャント。彼らの調査により、H 2 の効果が明らかになりました。 O 2 濃度[14、15、16、17、20、21、23]、HF濃度[21]、HF–H 2 O 2 気孔率[14、16、17、19、20]の体積比[19]、エッチング時間[14、16、17、19、20、21、23]、およびエッチング温度[19、20、21、23]。 、長さ[16、17、19、20、21、23]、エッチング速度[15]、およびSiNWアレイの全体的な形態[15、16、21]。それにもかかわらず、エッチャントHF–H 2 の効果に関する体系的な研究 O 2 χとして定義されるモル比 =[HF] /([HF] + [H 2 O 2 ])、およびH 2 高濃度にドープされたSiナノ構造の形成におけるO濃度は制限されています。これは、χという事実にもかかわらずです。 は、Siナノ構造の形態とエッチング速度を決定する際の重要なパラメータです[18、31]。[H 2 O]は、微細パターン領域でのSiNWの形成において極めて重要です[18]。現在まで、Chiappini etal。 [15]およびBalasundarametal。 [19]は幅広いχを利用しています 高濃度にドープされたSiNWの製造における値(それぞれ0.4〜0.98および0.7〜0.99)ですが、エッチャントの効果を完全に調査したものはありません[H 2 O]。さらに、MACEで製造された低濃度および高濃度ドープSiNWの形態進化、多孔化、およびテーパーのメカニズムを解明する多くの研究にもかかわらず[15、17、32]、堆積金属の競合効果による長さ進化のメカニズムエッチング、再核化金属エッチング、正孔拡散、および反応物拡散は完全には調査されていません。この研究では、無電解蒸着されたAg触媒とH 2 を使用した、縮退ドープされたp型Siウェーハ上の2ステップMACE [33] O 2 酸化剤が実行されました。パターン化されたAu触媒を使用するMACEと比較して、無電解堆積はさまざまな直径のランダムに分布したSiNWのみを形成できます[13]。それにもかかわらず、MACEでの無電解堆積とAg触媒の使用は、SiNWを含むSiナノ構造を形成する最も簡単で安価な方法であると考えられています。得られるナノ構造とエッチング速度に対するエッチャント組成の影響を調査するために、比較的広い範囲のχを持つエッチャント および[H 2 O]値を利用した。 Siナノ構造の先端と基部でのエッチング速度を決定することにより、正孔注入とSi溶解速度の影響、溶解した金属イオンと拡散した正孔によって誘発される二次エッチング、および結果として生じる形態と長さに対する反応物の拡散速度に関する洞察ナノ構造が提供されます。同じ長さの高濃度にドープされたSiNWも、異なるχで構成されるエッチャントを使用して製造されました。 および[H 2 O]値。これにより、エッチング期間を変えても、エッチャント組成によって気孔率を効果的に調整できることがわかります。
メソッド
抵抗率が0.001〜0.005Ωcmで、研磨面に50 nmの熱酸化物層を備えた片面研磨ホウ素ドープp型Si(100)ウェーハを出発材料として使用しました。ウェーハを脱イオン(DI)水、アセトン、エタノールで完全に洗浄し、熱酸化物を希薄なHFで除去して、H終端Si表面を作成しました。研磨されたSi表面のエッチングを制限するために、Siウェーハの裏面にフォトレジスト(AZ5214)をコーティングしました。 MACE実験用のSiサンプルは、ウェーハを1×1cm 2 に劈開することによって得られました。 ピース。同じウェーハからのSiサンプルを各実験セットに使用しました。
MACEは、Ag触媒の無電解堆積と、HF–H 2 でのエッチングからなる2段階のエッチングプロセスを使用して実行されました。 O 2 図1に概略的に示されているように、溶液。最初にSi片を5%HFに3分間浸漬しました。次に、Si基板上へのAgナノ粒子(AgNP)の無電解堆積を、4.8 MHFと0.005M AgNO 3 を含む水溶液中で実行しました。 さまざまな期間(図1a)。 DI水で穏やかにすすいだ後、AgNPでコーティングされたSiサンプルをHF–H 2 水溶液でエッチングしました。 O 2 異なるχのソリューション および[H 2 さまざまな時間の長さに対するO]値(追加ファイル1:表S1を参照)(図1b)。エッチングされたSiサンプルをDI水で完全にすすぎ、1:1( v / v )HNO 3 AgNPを溶解するために10分間。さらにDI水で十分にすすいだ後、Siサンプルを5%HFに3分間浸して、形成された酸化物層をすべて除去し、次にDI水で複数回すすぎました。 Ag堆積とHF–H 2 O 2 エッチングは暗所で行った。すべてのサンプルは、15 mlの必要な溶液を含む別々のプラスチックビーカーで室温(22〜23°C)で処理されました。

2段階MACEを使用したSiナノ構造の製造の概略断面図。 a 最初のステップでは、AgNO 3 を含む水溶液中でAgNPをSi表面に無電解堆積させます。 とHF。 b 2番目のステップでは、AgNPは、HF、H 2 で構成される溶液中のSi基板のエッチングを触媒します。 O 2 、およびH 2 O、Siナノ構造の形成につながる
エッチングされたSi表面は、走査型電子顕微鏡(SEM、PhenomProまたはFEI / Philips XL-30)および透過型電子顕微鏡(TEM、Philips CM20)によって特徴づけられました。 SEM観察用のサンプルを準備するために、裏面のフォトレジストをアセトンで除去しました。次に、Siサンプルをエタノールですすぎ、ホットプレート上で乾燥させて、水の蒸発によるSiNWの凝集を最小限に抑えました[19]。
結果と考察
銀触媒の堆積と多孔質SiNWの形成
0.005 M AgNO 3 の溶液でのAg沈着時間(10秒から15分)の影響 また、高濃度にドープされたSiNWの形成に関する4.8 MHFが調査されました。 Agをロードしたサンプルを4.8M H 2 を含む溶液でエッチングした場合 Oとχ =0.95で30分間、堆積時間が短い(≤2分)と、図2aに示すように、いくつかの横方向のくぼみがある垂直方向の細孔が密集して配列しました。ただし、堆積時間が1分以下の場合、細孔は十分に分離されたナノワイヤ構造を形成するのに十分な密度ではありませんでした。一方、Agの堆積時間は4分でほとんど欠陥のないSiNWが得られ(図2b)、堆積時間が長くなるとピットのないSiNWが得られました。図2c(ひし形の記号)に示すように、SiNWの形態の変化とは別に、Agの堆積時間に対するSiNWのエッチング速度の非単調な変化も観察されました。 SiNWのエッチング速度は、堆積時間の10秒から4分に増加しましたが、4分から6分の間に予期せず減少しました。その後、エッチング速度の値は比較的低くなりますが、エッチング速度は15分まで再び増加しました。
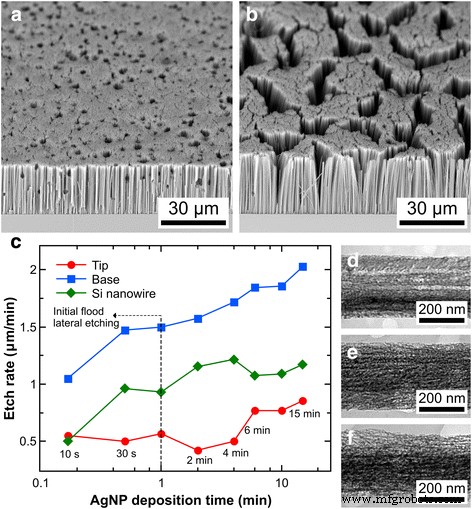
0.005 M AgNO 3 を含むAg堆積溶液を使用して製造されたSiNW 4.8 MHFおよび48M H 2 で構成されるエッチャント溶液 Oおよび0.95HF–H 2 O 2 モル比。 a のAg堆積時間のSiNWのSEM画像 30秒と b 4分 c さまざまなAg堆積時間に対するSiNWのエッチング速度。 d のAg堆積時間に対するSiNWの中央セクションのTEM画像 4、 e 10、および f 気孔率を示す15。すべてのサンプルのエッチング時間は30分でした
SiNWエッチング速度の特異な傾向を説明するために、SiNWの先端と基部のエッチング速度も、エッチングされたSiサンプルの顕微鏡写真をエッチングされていないSiの顕微鏡写真と位置合わせすることにより、断面SEM画像から決定されました。裏面の同じウェーハからのサンプル(追加ファイル1:図S1を参照)。図2cから、SiNWベース(四角の記号)でのエッチング速度は、AgNPの堆積時間とともに単調に増加することがわかります。一方、SiNWチップのエッチング速度の傾向線から3つのドメインを見ることができます(円の記号)。(a)≤1分。エッチング速度は比較的高い。 (b)エッチング速度が比較的遅い1〜6分。 (c)≥6分。エッチング速度が最も高くなります。したがって、10秒から1分の堆積時間からのSiNWエッチング速度の最初の増加は、ベースでのエッチング速度の一定の増加によるものでしたが、2分と4分の堆積時間でのその後のエッチング速度の増加はチップでの比較的低いエッチング速度。一方、6分の堆積時間でのSiNWエッチング速度の低下と、その後の堆積時間での比較的低いエッチング速度は、チップでのエッチング速度の増加が原因でした。
AgNPの表面被覆率はAgの堆積時間に直接関係しているため[22、34、35]、堆積時間が短い場合の横方向のピッチングは、いくつかの孤立したAgNPが移動するまばらなAgネットワーク[18、34、36]に起因する可能性があります。不規則な形状のためにランダムな<100>方向[37]。ベースでのSiNWエッチング速度は、H 2 による正孔注入のためのより多くの表面積を提供するAg触媒の量の増加により、Ag堆積時間とともに増加すると予想されます。 O 2 。さらに、Agの量が多いということは、H 2 によって酸化されたAgが多いことも意味します。 O 2 [15、17]、Ag + の濃度が高くなります ガルバニック置換反応を介してSiの溶解に寄与する可能性のあるイオン[31]。一方、Agの堆積時間が1分以下の場合のチップでの比較的高いエッチング速度は、まばらなAgネットワークからの不規則な形状のAgNPによって引き起こされる最初のフラッドラテラルエッチングによって説明できます。 Ag堆積時間の増加に伴うチップエッチング速度のその後の増加は、チップでの金属再核形成の速度の増加[17、38]、およびより少ない程度であるが、正孔拡散[31、39]に起因し得る。
図2d–fに示すように、Agの堆積時間が長くなると、製造されたSiNWの気孔率が全体的に増加しました。 (補足TEM画像については、追加ファイル1:図S2a–cを参照してください。)Ag + の濃度が高いため、このような多孔化の増加が予想されます。 イオンは、再核形成された金属とイオン誘起エッチングをもたらします[15、17、38]。さらに、より高い穴注入率は、より拡散した穴をもたらした可能性があり、これは細孔形成に寄与する可能性があります[19、39]。 SiNWの多孔質構造は、以前の研究で観察されたものと同様に、ほとんどのナノワイヤで多孔質シェルとして発生するようです[14、17]。 Ag堆積時間が15分の一部のSiNWの場合、おそらく再核形成されたAg粒子が大きいために、側壁がかなり粗く見え、比較的大きな(直径約20 nm)ダークスポットが発生します。ただし、気孔率の分布は明確ではありません。Agの堆積時間が4分のSiNWの中には、Agの沈着時間が10分のSiNWとほぼ同じ気孔率を持っているものがあります。 Agの堆積時間が10分と15分のSiNWについても同じことが言えます。これはおそらく、サンプルのさまざまな領域から得られたSiNWが、実際に堆積した(または再核化した)AgNPの量と、側面に向かって高くなると予想される未反応のエッチャントの濃度に応じてわずかに異なる多孔化速度を経験したためです。サンプルの。それにもかかわらず、ここで観察された一般的な傾向は、堆積したAgの総量が、SiNWの多孔性を制御する上で別の自由度を提供することを示しています。
多孔度は、以前の研究[16、19]と同様に、SiNWの基部から先端に向かって増加します(追加ファイル1:図S2d–lを参照)。これは、ナノワイヤの上部領域がエッチャントに長時間さらされることから予想されます[19]。一方、SiNWの大部分は、先細りの縦方向プロファイルを持っています。これは、SiNWベースでのAgNPの継続的な溶解と他のサイトでの再核形成により、Ag-MACEを使用して製造された高濃度ドープSiNWの特徴です[15、17 ]。それにもかかわらず、わずかに双晶または砂時計のプロファイルを有するいくつかのSiNWがありました。つまり、中央の断面は、上部と下部の両方の断面よりもそれぞれ大きいか小さいかのどちらかです。これは、モバイルAg + イオンは、ナノワイヤの上部だけでなく、基部の隣接するAgNPにも再堆積する可能性があります。
Siナノ構造のエンチャント組成と形態進化
縮退してドープされたSiで得られたナノ構造の形態は、χを使用して決定されました。 0.7から0.99までの値とH 2 O濃度は46、48、および50Mです。AgNPの無電解堆積は0.005AgNO 3 の溶液で実行されました。 HF–H 2 でエッチングしながら、4.8 MHFで4分間 O 2 –h 2 Oソリューションは30分間実行されました。図3は、SEMから見たSi表面の形態を示しています。 [H 2 の場合 O] =46Mおよび48M、エッチングされたSiの特徴は、クレーター(χ)を備えたミクロポーラスSiから進化します。 =0.7および0.75、図3d、e)、深い細孔(χ =0.75および0.80、図3f)、次にSiNW(χ ≥0.85)。 [H 2 の場合 O] =50 M、Si表面の変化はわずかに異なります:研磨されたSi(χ =0.7)、深い細孔を持つマクロ細孔(χ =0.75)、クレーターを備えたミクロポーラスSi(χ =0.8–0.85)、次にSiNW(χ ≥0.9)。 Chiappiniらの仕事とは対照的に。 [15]、0.7 <χの多孔質Si膜上のSiNW <0.95は観察されず、SiNWのみの構造がより大きなχで得られました。 範囲(χ χの代わりに≥0.85> 0.95)。これらの違いは、堆積したAgNPの量、エッチング時間、H 2 の違いが原因である可能性が最も高いです。 O濃度、およびHNO 3 およびHFエッチング後処理。

H 2 の溶液でエッチングされたSi表面のSEM画像 a のO濃度 46 M、 b 48 M、および c 50 MおよびHF–H 2 O 2 (i)のモル比 0.7、(ii) 0.75、(iii) 0.8、(iv) 0.85、(v) 0.9、(vi) 0.95、および(vii) 0.99。 d – g a のサンプルの高倍率SEM画像 (i) 、(ii )、( iii )、および(vii )、 それぞれ。サンプルはHF–H 2 でエッチングされました O 2 30分間
得られたSiの形態は、Ag–Si界面での電流密度とAg + の両方の観点から説明できます。 イオン誘起エッチング[15、17、31、38]。高いχでのSiNWの形成 値(≥0.85または0.9)は、低電流密度でのミクロポーラスSiの形成と、それに続く研磨によるミクロポーラスSiの溶解に起因する可能性があります[31、38]。同様のメカニズムが、より低いχに深い細孔を持つマクロポーラスSiの形成に関与した可能性が最も高いです。 細孔端でのより高い電流密度が酸化物の形成とそれに続く正孔拡散をもたらし[31]、上面に浅いマクロ細孔をもたらしたことを除いて、値。このような正孔拡散は、注入された正孔を金属-Si界面から引き離す正のショットキー障壁高さのため、高濃度にドープされたp型Siで特に重要であると予想されます[40]。比較的高い[H 2 O 2 ]と[HF]の比率により、Agが大幅に溶解し、その結果、Si基板の深い細孔の密度が低くなりました。一方、χにクレーターを有するミクロポーラスSiの出現 =0.7–0.85は、このχで低電流密度が発生していることを示します 範囲、これはChartier etal。の観察と一致しています。 [31]さらに、Ag + によるSiの同時多孔化 このレジームではイオンも発生すると予想されます。より高いχでのSiNWの形成 最も希薄なエッチャントの値(50 M H 2 O)Chiappiniらの観察と一致している。 [15]エタノール濃度が高いと、SiNWではなく多孔質で研磨されたSiの形成に有利に働きます。これらの結果は、HFとH 2 が低いため、ナノ構造ベースへの反応物の拡散が遅いことが原因である可能性があります。 O 2 Siナノ構造の深さに沿った濃度勾配。この場合、チップでのエッチングの影響は比較的大きくなり、金属粒子によって深い細孔を形成することはできませんでした。
χの値が比較的低い場合は注意が必要です。 (≤0.8)、Si表面全体の形態は均一ではありませんでした(追加ファイル1:図S3を参照)。 [H 2 の場合 O] =50 M、χでも不均一なエッチングが発生 =0.85。すべての場合において、均一にエッチングされた表面は、SiNWが形成されたときにのみ得られた。不均一にエッチングされた表面の場合、相同な形態のセクションは、サンプルの中心からほぼ同じ一般的な位置で発生する傾向があります。サンプルの異なる領域での不均一なエッチングダイナミクスは、溶液中の溶解した触媒イオンの濃度の増加と、その後のサンプルの他の領域への拡散および再核形成によって説明できます。これは、H 2 の同時外向き拡散によってある程度促進されました。 Siがエッチングされると気泡が発生します。
非常に高いχ 値(0.99)では、非常に高密度の微細なSiNWの配列が得られ、サンプル表面が黒くなりました(追加ファイル1:図S3a–c(vii)を参照)。ただし、これらのSiNWの多くには、傾斜した側壁といくつかの横方向のピットがあり、どちらもベースの近く(図3g)と長いエッチング時間(追加ファイル1:図S4d)で発生します。ナノワイヤの形成が時期尚早に終了した多くの隆起も見られます。このような機能は、おそらくH 2 の枯渇が原因でした。 O 2 AgNPフィルムのさまざまな部分の異なる沈下率をもたらしたエッチング溶液中。 Agネットワークが崩壊すると、一部のAgNPまたは小さなAgフィルムセクションが水平方向の<100>方向にエッチングを開始しました。
MACE中のSiナノ構造のエッチング速度論
χによるエッチング速度の変化 異なる[H 2 O]値を図4に示します。ナノ構造の見かけのエッチング速度は、一般にχとともに増加します。 χでピークになります =0.95、その後、エッチング速度は大幅に低下します。この傾向は、[H 2 に関係なく当てはまります。 O]およびSiナノ構造の形態。ただし、[H 2 O]はエッチング速度の大きさにかなり影響を及ぼし、[H 2 が減少すると大きさが増加することがわかります。 O]値(すなわち、より濃縮されたエッチャント)。図4bは、χの後にチップのエッチング速度が大幅に低下したことを示しています。 =0.85 for [H 2 O] =46および48M以降χ =0.9 for [H 2 O] =50M。一方、図4cは、ベースでのエッチング速度がχで大幅に増加したことを示しています。 =46 M H 2 の場合は0.85および0.9 Oエッチャントですが、48および50 M H 2 ではわずかです Oエッチャント。ベースでのエッチング速度はχで高いままでした =0.95ですが、χで大幅に減少しました =0.99。

異なるHF–H 2 で構成される溶液で、30分のエッチング後に観察された見かけのエッチング速度 O 2 モル比とH 2 O濃度。 a 得られた長さに基づくSiナノ構造のエッチング速度。 b 、 c それぞれSiナノ構造の先端と基部に対するバルクSiのエッチング速度
Siナノ構造のチップとベースでのエッチング速度の傾向から、[H 2 のSiNW長の増加が決定できます。 O] =46 Mは主にベースでのエッチングの加速によるものでしたが、[H 2 のSiNWが長くなったためです。 O] =48および50Mは、主に先端でのエッチングの抑制によって決定されました。さらに、全体的なナノ構造のエッチング速度の傾向は、ベースでのエッチング速度の傾向と正確に同じではない。特に、χ ベースでのピークエッチング速度が発生する値とχ 最大のナノ構造の高さが達成される値は、チップのエッチング速度の競合効果のために同じではありません(それぞれ0.9対0.95)。
χ ピークSiNW長が発生した値(0.95)は、Qi etal。によって得られた値に近い値です。 [21](χ =0.91)高濃度にドープされたn型Si基板の場合。 χ付近で発生するチップエッチング速度の最初の低下 =0.85は、Si表面の観察された形態変化と一致しており、低い正孔拡散とAgの再核形成により、χでSiNWが形成されました。 ≥0.85。 χ付近で、チップのエッチング速度がほぼ同時に低下し、ベースのエッチング速度が急上昇します。 =0.85は、穴とAg + を意味します 以前に低いχでエッチングフロントから拡散したイオン Ag-Si界面での酸化物形成が阻害されるため、値はベースで制約されていました。同時に、より高いχで[HF]が増加しました 値はSiの溶解を加速し、Agの浸透率を増加させました。 [HF]と[H 2 O 2 ] [H 2 のときに減少します O]は与えられたχに対して増加します 値(追加ファイル1:表S1を参照)、[H 2 が高い場合のチップとベースでのエッチング速度の低下 O]値が期待されます。 χ間のベースエッチング速度のわずかな増加 =[H 2 の場合は0.85および0.95 O] =48および50Mは、より希薄なエッチャントの場合、SiNWの長さを介した反応物の拡散が遅いためです。
χで =0.9、H 2 による最適な正孔注入速度により、ベースでのエッチング速度が最大になります。 O 2 HFによるSiの溶解。この値を下回ると、酸化されたSiの溶解が十分に速くないため、[HF]が律速因子になります。この値を超えると、[H 2 O 2 ]注入された正孔の数が少なすぎるため、反応速度を決定します。このH 2 の枯渇 O 2 ソリューションでは、ベースでのエッチング速度がχで減少し始める理由を説明しています =0.95で、χで急激に低下します =0.99。 [HF]と[H 2 の両方に対するエッチング速度のそのような依存性 O 2 ]は以前に観察され[21]、SiのMACEの反応速度の式では両方の反応物濃度を考慮する必要があることを意味します。一方、χの最大値 チップのエッチング速度からは明らかではありません。代わりに、チップのエッチング速度は主に[H 2 によって決定されます。 O 2 ]。 Siナノ構造の先端でのエッチングは、主に金属イオンの再核形成と正孔拡散に起因する可能性があるため、この相関関係は[H 2 O 2 ] [HF]に関する値は、モバイルAg + の濃度を高めます。 イオン[15、17]および注入された正孔[31、32]。
さまざまなエチャント組成の時間に伴うSiNWの長さの進化
SiNWの長さは、太陽光発電[2]、エネルギー貯蔵[6]、センシング[41]、および熱電アプリケーション[4]で重要なパラメーターです。指定された長さのSiNWを製造するために、χのエッチャントのSiNW長さの時間的変化を測定しました。 =0.9、0.92、0.95、0.98および[H 2 O] =46、48、および50M。これらの実験では、長いエッチング時間で製造されたSiNWの横方向のピッチングを最小限に抑えるために、AgNP堆積時間を10分に増やしました(追加ファイル1:図S4a–cを参照)。同様に、最高のχ χに対して傾斜した側壁と横方向のピットを持つSiNWが得られたため、使用された値は0.98でした。 =0.99、AgNPの堆積時間が10分であっても(追加ファイル1:図S4dを参照)。
図5aは、形成されたSiNWの長さがMACE反応時間とともに増加することを示しており、以前の研究[14、16、17、18、19、21、23]での観察と一致しています。ただし、SiNWの長さの増加は時間の経過とともに減少する、つまりエッチング速度が低下していることがわかります(追加ファイル1:図S5aを参照)。これは、SiNWチップでのエッチング速度の増加またはベースまたはその両方。図5dは、χの時間の経過に伴うチップエッチング速度の増加を示しています。 =0.92および0.95、前者の方が増加が顕著です(追加ファイル1:図S5bを参照)。これは、SiNWチップで再核化されたAgの量が増加していることを示しています。これは、χが低いほど重要になると予想されます。 値。一方、図5eは、5分を超えるエッチング時間では、SiNWベースでのエッチング速度がχでほぼ一定であることを示しています。 =0.9および0.92ですが、χでは減少します =0.95および0.98(追加ファイル1:図S5cを参照)。後者は、拡散長が長いために、反応物のSiNWベースへの拡散が妨げられたことが原因である可能性があります(χの場合、SiNWの長さが長くなりました。 =0.95および0.98)およびH 2 の枯渇 O 2 エッチング液中。

さまざまなHF–H 2 の時間に伴うSiNWの長さの変化 O 2 48 M H 2 でのモル比 O. a SiNWの長さに対するエッチング時間の影響。 b 、 c 48 M H 2 で構成される溶液で1時間エッチングした後のSiNWのSEM画像 OおよびHF–H 2 O 2 それぞれ0.9と0.98のモル比。 d 、 e 時間の経過に伴うSiNWのチップとベースに対するエッチングされたバルクSiの厚さ
図5から、χであることに注意してください。 =0.9、チップでのエッチング速度の非単調な傾向のため、時間の経過に伴う長さの変化は不安定です(追加ファイル1:図S5bを参照)。これは、移動性の高いAg + として、再核化されたAgの量が異なることが原因である可能性があります。 イオンが生成されました。それでも、χは低くなります 値には、χが高いほど欠陥のないSiNW(図5b)を形成できるという利点があります。 χの図5cに示すように、いくつかの横方向のくぼみが生じる可能性があります =0.98。 χに関するSiNWのチップとベースでの全体的なエッチング速度とエッチング速度の傾向 図4で観察されたものを反映しています。ただし、図5eでは、χであることがわかります。 =0.92(図4には含まれていません)は、実際にはχよりも高いベースエッチング速度をもたらします。 =0.9。
SiNWの長さは、より濃縮された場合(46 M H 2 )、エッチング時間とともに増加します。 O)および希釈(50 M H 2 O)図6aに示すように、エッチャント。同様に、すべてのH 2 について、エッチング速度はエッチング時間とともに減少します。 使用したO濃度(追加ファイル1:図S6aを参照)。図5d、eは、SiNWの先端と基部のエッチング深さが時間とともに増加する一方で、先端の増加量はほぼ一定ですが、基部の増加量は減少していることを示しています(追加ファイル1:図S6bを参照)。 c)。これらの傾向は、χで観察された傾向と一致しています。 =図5の0.95および追加ファイル1:図S5。したがって、χの場合 =0.95の場合、SiNWチップでの再核化Agの量の経時的な増加は無視できますが、SiNWの長さが増加すると、反応物のSiNWベースへの拡散が徐々に妨げられます。図6は、エッチングの時点に関係なく、[H 2 O]は一般に、図4で観察されたものと同様に、よりエッチングされたSiをもたらします。ただし、図6b、cは、[H 2 O]ソリューションでは、SiNWに横方向のピッチングが発生する可能性がありますが、[H 2 O]ソリューションはしません。これは、[H 2 が低い場合にAg粒子が再核化したサイトでの高速エッチングが原因である可能性があります。 O]エッチャント。

さまざまなH 2 の時間に伴うSiNWの長さの変化 固定HF–H 2 でのO濃度 O 2 0.95のモル比。 a SiNWの長さに対するエッチング時間の影響。 b 、 c HF–H 2 で構成される溶液で1時間エッチングした後のSiNWのSEM画像 O 2 0.95のモル比とH 2 O濃度はそれぞれ46Mと50Mです。 d 、 e 時間の経過に伴うSiNWのチップとベースに対するエッチングされたバルクSiの厚さ
気孔率が制御された高濃度ドープSiNWの製造
SiNWの多孔性は、SiNWベースのデバイスのもう1つの重要なパラメータであり[5、16、27、29]、SiNW製造中の制御された形成が非常に重要になります。 2段階MACEを使用して製造されたSiNWの多孔度は、H 2 に直接関係しています。 O 2 濃度[14、15、16、17、20]、エッチング時間[14、16、17、20]、および温度[20]であり、HF–H 2 に反比例します。 O 2 体積比[19]とウェーハ抵抗率[17]。私たちのAg堆積実験では、SiNWの多孔性も堆積したAgの量に直接関係していることがわかりました。ただし、SiNWの多孔化の程度は、他のパラメータに影響を与えずに簡単に調整することはできません。たとえば、[H 2 ]のいずれかを使用して調整した場合、長さと気孔率は一緒に変化すると予想されます。 O 2 ]、エッチング時間、または温度。特定の長さのSiNWの気孔率を高くする必要がある場合は、[H 2 O 2 ]を増やすことはできますが、[H 2 を高くすると、エッチング時間を短くする必要があります。 O 2 ]エッチング速度が速い場合があります。これは、エッチング時間が短い場合でも、所望の多孔性を達成できるかどうかという疑問を提起します。
ここで、χによって独立して引き起こされるSiNW多孔化の程度 および[H 2 O]はχについて比較されました =0.92、0.95、および0.98([H 2 O] 48 Mに固定)および[H 2 O] =46、48、および50 M(χ 0.95に修正)。 SiNWの長さは、それぞれのエッチャント組成のエッチング速度に基づいて異なるエッチング時間を使用することにより、20μmに固定されました(追加ファイル1:表S2を参照)。一般に、気孔率はχに反比例することがわかりました。 [H 2 に直接関連しています O]、それぞれ図7a〜cおよび図7d、b、eに示すように。 (傾向は、追加ファイル1:より多くのサンプルが示されている図S7でより明確になります。)χのSiNWの比較 =0.95およびχ =0.98(図7b、c)、χのサンプル =0.95は細孔密度が高いようで、ほとんどが薄い多孔質シェルに囲まれています[14、17]。一方、χの場合 =0.98、一部のSiNWは、多孔性ではなく粗くて固体であるように見えます。これは、多孔性の程度がはるかに低いことを示しています。一方、χで得られた全体的な気孔率 =0.92(図7aおよび追加ファイル1:図S7a)は、予想された傾向から逸脱しているように見えます。一部のSiNWは多孔質のシェルを備えていますが、他のSiNWは、χのSiNWに比べて程度は高いものの、粗面化されているだけのようです。 =0.98。対照的に、[H 2 による気孔率の増加 O]はより一貫性があります。 [H 2 については、粗い固体SiNWは得られませんでしたが O] =46 M、[H 2 に対して非常に多孔性のSiNWが形成されました O] =50 M χの場合とは異なり =0.92。

長さが約20μmの製造されたSiNWのTEM画像は、 a の中央セクションでの気孔率の変化を示しています。 – c HF–H 2 O 2 モル比と d 、 b 、 c H 2 O濃度。 a – c HF–H 2 O 2 エッチャントのモル比はそれぞれ0.92、0.95、0.98で、[H 2 O] =48 M. d 、 b 、 c H 2 エッチャントのO濃度は、HF–H 2 でそれぞれ46、48、50Mでした。 O 2 モル比=0.95。 f を使用したSiNWのTEM画像 – h 低く、 i – k c に示すものに対応する高い気孔率 および e 、それぞれ、ただし f を含む 、 i トップ および h 、 k 下 セクション。 スケールバー e で および k a の画像にも適用されます – d および f – j 、それぞれ
χで得られたより高いSiNW気孔率 =χより0.95 =0.98は、χが低いほど、金属の再核形成、金属イオンによるエッチング、および正孔の拡散が高いという事実と一致しています。 値。また、χに使用されるエッチング時間が長いことも示しています。 =0.98で20μmの長さのSiNWを得ると、エッチャントχによって引き起こされる多孔化を克服できませんでした。 価値。 χの多孔化の程度は一見低い =0.92は、χよりも長いエッチング期間が使用されたため、エッチング時間の違いによるものではありませんでした。 =0.95。 χでは、より多孔質のSiNWが実際に得られた可能性があります。 =0.92;ただし、気孔率が非常に高いため、HF–H 2 O 2 細孔壁の表面と内部の両方で多孔質Siがエッチングされ、多孔質シェルが急速に崩壊し[42]、その後、多孔性の低いSi表面が露出しました。より高い[H 2 に対して、より多孔性のSiNWが得られました。 O]値は、エッチング時間が多孔性に大きな影響を与えることを確認します[14、16、17、20]。 (追加ファイル1のエッチング時間の大きな違いに注意してください:異なる[H 2 の表S2 O]値。)50 M H 2 で得られた高度の気孔率 多孔質シェルが崩壊しないOは、HF–H 2 が最小化されていることが原因である可能性があります。 O 2 希薄なエッチャント中の反応物の拡散速度が遅いため、細孔壁の内側をエッチングします。
SiNWの長さに沿った表面粗さを調べると、図7f–k(追加ファイル1)に示すように、MACEで製造された高濃度ドープSiNWの基部から先端までの多孔性の特徴的な増加が明らかになります[16、19]。 :図S8)。 SiNWの先端に向かう多孔性の増加は、エッチャント溶液中のこれらの部分の露出時間が長いためです[19]。図6f–kおよび追加ファイル1:図S8は、SiNWが先細になっていることも示しており、より多孔質のSiNWでは先細りがより厳しくなっています(図7i–kおよび追加ファイル1:図S8a–c)。これは、多孔化がSiNWベースでの金属触媒の溶解量に直接関係していることを考慮すると予想されます[15、17]。ただし、SiNWを詳しく見ると、一部のナノワイヤがわずかに双晶または砂時計の縦方向のプロファイルを示していることがわかります。これは、多孔性の高いものの間でより頻繁に発生するようです。同様に、多孔性の高いSiNWは、一般に、多孔性の低いSiNWよりも直径が大きくなります(追加ファイル1:図S7を参照)。より小さな直径で高多孔性のSiNWを実現するには、Au [32]のようなより不活性な触媒を使用する必要があるかもしれません。
ここで得られた結果に基づいて、適切なエッチャント組成を使用することにより、所定の長さの高濃度にドープされたSiNWの多孔性制御が可能です。気孔率を低くするには、高いχを使用するのが最適です。 粗い固体ナノワイヤーとしての値を得ることができた。一方、高多孔性のSiNWを実現するには、中程度のχの希薄エッチャントを使用します。 χが低いエッチャントで発生する多孔質シェルの崩壊を回避するため、値(≈0.95)をお勧めします。 値。両方の高いχのエッチャントを使用して、より低い気孔率を達成できると考えられます。 低く[H 2 O]値と両方の(わずかに)低いχのエッチャントを使用したより高い気孔率 高い[H 2 O]値。低気孔率のSiNWの場合、最大のχ および最小[H 2 O]値は、おそらくかなりの横方向のピッチングが発生する値によって決定されます。一方、気孔率の高いSiNWの場合、最小のχ および最大[H 2 O]値は、多孔質シェルが溶解し、SiNW構造が失われる値によってそれぞれ決定されます。これらの方法は、広範囲のSiNW気孔率を得るために、堆積したAgの量を介した気孔率制御の以前の発見と組み合わせることができます。
結論
多孔質SiNWは、HF–H 2 での金属支援化学エッチングを使用して、縮退ドープされたp型Si基板から製造されました。 O 2 無電解堆積したAg触媒を使用。 Ag堆積時間の影響、エッチャントHF–H 2 O 2 モル比、およびエッチャントH 2 Siナノ構造の形態とエッチング速度に対するO濃度を系統的に研究した。損傷のないSiNWを形成するために必要な最適量の堆積Ag粒子があることが示された。さらに、堆積したAg粒子の量は、非単調な方法でSiNWエッチング速度に影響を与え、結果として生じるナノワイヤの多孔性を制御するための追加のメカニズムを提供します。同様に、エッチャント組成は、得られるナノ構造に大きな影響を及ぼします。適切なχがあります 均一なSiNWアレイを形成できるウィンドウ。 H 2 の場合 O濃度が46〜48 M、このχ 範囲は0.85〜0.98です。希薄なエッチャントが増えると、最小のχが増加します SiNWベースでのエッチングが遅いため。 Ag触媒化学エッチング中のSiナノ構造の形成は、さまざまな要因、すなわち、堆積したAg触媒Si溶解、再核化したAg触媒Si溶解、正孔拡散、およびエッチングされた細孔を介した反応物拡散の競合効果の結果です。 Siナノ構造の先端と基部でのエッチング速度に反映されます。これらの要因により、時間の経過とともにエッチング速度が徐々に低下し、χが低い場合は再核化されたAg触媒エッチングが支配的です。 χが高い場合、値と拡散の妨げがより顕著になります 値。これらのメカニズムを利用して、異なるエッチング時間で製造された同じ長さのSiNWの多孔性を制御できます。特に、より高いχを使用して、Agの再核形成と正孔拡散を抑制します。 値は細孔密度を効果的に減少させることができますが、反応物の拡散が遅く、エッチング時間が長いため、希薄なエッチャントを使用してより制御された多孔化を実現できます。 SiのAgおよびAu触媒MACEの一般的なメカニズムは類似しているため[11、33、35]、この研究の結果は、金属イオンによるエッチングが予想されることを除いて、Au金属触媒で製造された多孔質SiNWにも当てはまる可能性があります。大幅に抑制され、正孔拡散が多孔化とチップエッチングの主なメカニズムとして機能します。
略語
- AgNP:
-
Agナノ粒子
- DI:
-
脱イオン化
- MACE:
-
金属支援化学エッチング
- SEM:
-
走査型電子顕微鏡
- SiNW:
-
シリコンナノワイヤー
- TEM:
-
透過型電子顕微鏡
- χ :
-
HF-酸化剤のモル比
ナノマテリアル



