アルゴンプラズマ処理によるZnOの挿入による金属とn-Ge間の接触抵抗の低減
要約
金属/ Ge界面でのフェルミ準位ピンニング(FLP)効果を克服し、電子のバリア高さを下げるために、ZnO界面層(IL)を利用してn-Ge上の金属-絶縁体-半導体接触を調査します。 ZnOとn-Geの界面で0.22eVの小さな伝導バンドオフセットが得られ、ZnO ILにより接触抵抗( R )が大幅に減少します。 c )FLPの除去により、ZnOを含まない制御デバイスと比較して金属/ ZnO / n-Geで。 ZnOのアルゴン(Ar)プラズマ処理により、 R をさらに改善できることが観察されています。 c Al / ZnO / n-Geデバイスの特性。これは、Arプラズマ処理によって酸素空孔の濃度が増加するためです V o 、ZnOのn型ドーパントとして機能します。オーミック接触は、3×10 16 のドーパント濃度のAl / ZnO / n-Geで実証されています。 cm -3 Geで。高濃度にドープされたn + について -リン光イオンを含むGe(P + )埋め込み、2.86×10 − 5 の比接触抵抗率 Ωcm 2 Al / ZnO / n + で達成されます -Arプラズマ処理を施したGe。
背景
ゲルマニウム(Ge)は、Siに比べてキャリア移動度が高いため、高度な金属酸化物半導体電界効果トランジスタ(MOSFET)で大きな注目を集めています[1、2]。 Ge pチャネルMOSFETの場合、歪みGeチャネル[3,4,5]、表面パッシベーション[6,7,8,9]、およびソース/ドレイン(S / D)接点の成長に大きな進歩が見られました[3,4,5]。 10]、および超スケーリングされたGe pFinFET [11]は、Siデバイスよりも優れた電気的性能を示しています。対照的に、Ge nチャネルトランジスタは依然として課題に直面しており、インターフェイス品質が低く、電子移動度が低く、活性化が制限されているためにS / D抵抗が高いなど、GeCMOSの統合に障害が生じます。 Geにおけるn型ドーパントの割合[12]および金属/ n-Ge界面でのフェルミ準位ピンニング(FLP)[13]。 FLPにより、n-Ge上のほとんどの金属の電子のショットキー障壁の高さが約0.5 eVになり、非常に大きな接触抵抗が発生します R c [13,14,15]。
フェルミ準位のピン止め解除は、薄い界面層(IL)、たとえばTiO 2 を挿入することによって行うことができます。 [16]およびZnO [17]、金属とn-Ge [18]の間。これは、薄いILが金属波動関数をGeにブロックして、金属によって誘発されるギャップ状態を減らすことができるためです[19、20]。 ZnOは、Geに対して伝導バンドオフセット(CBO)が小さいため、 R が小さくなる可能性があります。 c 金属/ TiO 2 と比較して、金属/ ZnO / n-Geで / n-GeとTiO 2 / Geは正のCBOを持っています[16]。 ZnOの誘電率はTiO 2 の誘電率よりも小さい したがって、ZnO ILは、TiO 2 と比較して、金属とn-Geの間のより薄い空乏領域を得ることができます。 。さらに、酸素空孔 V などの非化学量論的欠陥を導入することにより、ZnOでのn型ドーピングを容易に実現できます。 o [21、22]、これは金属とn-Geの間にさらに小さなZnO空乏領域を生じさせます。これまでのところ、金属/ ZnO / n-Ge接点では、 V によるZnOのドーピング o 窒素雰囲気中でのアニーリング[16]によって実行されましたが、アニーリング中のZnOとGeの相互拡散[23]、およびアニーリング中のn-Ge内のドーパント原子の拡散[24、25]が発生する可能性があります。デバイスの現在のパフォーマンスの低下を引き起こします。それ以来、ZnOを堆積およびドーピングするための低温プロセスを開発する必要があります。
この研究では、ALDで堆積したZnO ILを挿入することにより、金属とn-Geの界面でのフェルミ準位のピン止め解除を調査します。 Al / ZnO / n-Geの接触抵抗特性に及ぼすZnO層のアルゴン(Ar)プラズマ処理の改善効果を研究しています。
メソッド
金属接点は、低濃度および高濃度にドープされたn-Ge(001)ウェーハの両方に形成されました。軽くドープされたGeサンプルのドーピング濃度は約3×10 16 cm -3 。高濃度にドープされたn-Geを実現するには、リン光イオン(P + )1×10 15 の線量でインプラントする cm −2 n-Ge(001)で30 keVのエネルギーを実行した後、600°Cで60秒間急速熱アニーリングを行いました。脱イオン水と希塩酸を数サイクル使用してウェーハを洗浄した後、GeウェーハをすぐにALD(Beneq TSF-200)チャンバーにロードしてZnOを堆積させ、リフトオフプロセスを使用してGeにスパッタリングすることでアルミニウム(Al)接点を堆積させました。 。ここでは、1、2、および3 nmの3つのZnOの厚さを使用しました。これは、分光エリプソメトリー(SE)(J。A. Woollam M2000)によって確認されました。 ZnOの堆積中、ジエチル亜鉛(DEZn)と脱イオン水(H 2 O)をそれぞれZnおよびO前駆体として使用し、GeO x の形成を排除するために、基板温度を150°Cに維持しました。 。 ALDを使用した詳細なZnO堆積プロセスは、参考文献の以前の研究で報告されています。 [26、27]。 ZnO膜の導電率をさらに向上させるために、Geサンプル上の一部のZnOをアルゴン(Ar)プラズマで処理しました。 ZnOILを含まないコントロールAl / n-Geサンプルも製造されました。 R c ZnO / Ge上のAlの量は、リフトオフによって形成された円形伝送線路法(CTLM)を使用して抽出されました。露出したZnOは、プラズマエッチングによって完全にエッチングされ、隣接するデバイス間の完全な分離が保証されました[16]。
Keithley 4200 SCSを使用してAl / ZnO / n-GeコントラクトとCTLM構造の電気的特性を測定し、高分解能透過型電子顕微鏡(HRTEM)とX線光電子分光法(XPS)を使用して微細構造と界面を決定しましたサンプルの特性、およびUV-VIS分光光度計(LAMBDA 950、PerkinElmer)を使用してバンドギャップを決定しました E g 堆積したZnO膜の。
結果と考察
Al / ZnO / n-Geの材料特性
Ge / ZnOのXPS価電子帯スペクトルとZnOの透過率スペクトルを図1と図2に示します。それぞれ、Al / ZnO / n-Ge界面でのフェルミ準位のピン止め解除効果のメカニズムを調査するために利用された1と2。図1に示すように、厚いZnOサンプル、ZnO / n-Ge界面サンプル、および純粋なGeサンプルのXPS測定を実行して、ZnO / Geの価電子帯オフセット(VBO)を取得しました。Zn2 p 厚いZnOサンプルのピーク位置とVBMは、それぞれ1021.9eVと2.59eVです。 Zn 2 p およびGe3 d ZnO / Geインターフェースサンプルのピーク位置はそれぞれ1021.7eVと29.1eVです。 Ge 3 d 純粋なGeサンプルのピーク位置とVBMは、それぞれ29eVと0.06eVです。これは、ZnO / GeのVBOが2.33eVであることを示しています[30]。

ZnO / Geサンプルの価電子帯のXPSスペクトル。 a Zn 2 p および b 厚いZnOサンプルの価電子帯スペクトル c ZnO 2 p および d Ge 3 d ZnO / Ge界面サンプルのスペクトル、および e Ge 3 d および f バルクGeサンプルの価電子帯スペクトル
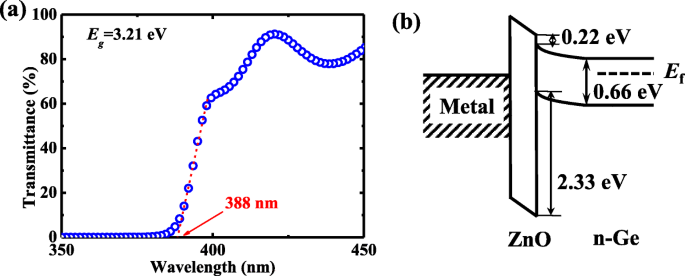
a E を示す堆積したZnO膜の透過率スペクトル g 3.21eVの b Al / ZnO / Geコンタクトのバンドアラインメント
図2aは、厚いZnOサンプルのUV-VIS分光法と E から得られた透過率プロットを示しています。 g ZnOの量は3.21eVであると判断され、[28、29]で報告されている値と一致しています。得られた E を使用して g 上記のZnOとVBOの場合、図2bに示すように、ZnOとGeの間のCBOは0.22eVと決定されます。これは、フェルミ準位のピン止め解除が、ZnO挿入層を使用してAl / n-Ge界面で達成できることを示しています。これにより、 R が低くなる可能性があります。 c Al / ZnO / n-Geコンタクト用。
図3は、ZnOの厚さが3nmのAl / ZnO / n-Ge構造のTEM画像を示しています。 Alとn-Geの間に均一で共形のZnO層が観察されます。右上隅の挿入図は、Al / ZnO / n-Ge界面の拡大図のHRTEM画像を示しています。 ZnO膜の厚さは3nmと測定されており、これはSE測定で得られた結果と一致しており、ZnO膜はアモルファスです。
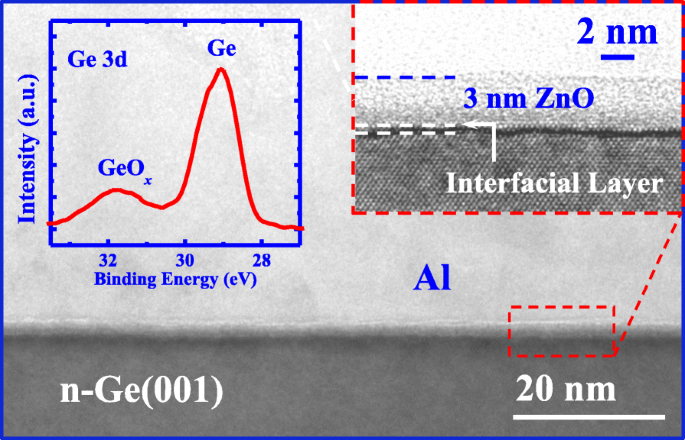
Al / ZnO / n-GeサンプルのTEM画像。AlとGeの間の均一なZnO層を示しています。右上の挿入図はAl / ZnO / n-Ge界面のHRTEM画像を示し、左上の挿入図はXPS Ge 3 d を示しています。 GeO x の存在を示すサンプルの結果 界面層
薄いGeO x GeとZnOの間に界面層が形成されますが、この作業で使用される堆積温度が低いため、[31]と比較してはるかに小さくなっています。これは、ZnOの堆積中に、GeがO前駆体と反応し、GeO x の形成につながるという事実に起因します。 IL。 GeO x XPS Ge 3 d でも示されています 左上隅に挿入図が表示されます。
ZnO膜の導電率は、Arプラズマ処理によって改善できます。これにより、酸素空孔の濃度が増加します V o 、ZnOのドナーとして機能します[32、33]。図4は、O 1 s のXPS結果を示しています。 堆積したままのZnOと、電力50 W、Arガス流量60 sccm、持続時間45秒のArプラズマ処理を施したサンプルの場合。 O 1 s ピークは、ガウスフィッティングを使用して2つのピークにデコンボリューションされます。 〜530 eVのピークは、ZnOの格子酸素に対応します[34、35]。堆積したままのサンプルの場合、531.7eVのピークは V に対応します。 o (〜531.5 eV)およびZnO薄膜の表面に化学吸着された酸素(カルボニル基やヒドロキシル基など)[35、37]。 Arプラズマ処理を施したサンプルの場合、ピークは〜531.5 eVにあり、結合エネルギーが低くなり、堆積したままのサンプルと比較してはるかに顕著になり、 V が多いことを示しています。 o Arプラズマ処理により発生し、化学吸着した酸素を効果的に除去します。 ZnO中のn型ドーパントの増加により、トンネル障壁が薄くなり、界面での直列抵抗が低くなり、 R の減少に関与します。 c [36]。

O 1 s のXPS結果 堆積したままの(上)およびArプラズマ処理した(下の)ZnO(3 nm)/ n-Geサンプルのデコンボリューションされた結果
図5に示すように、Arプラズマ処理の有無にかかわらず厚いZnOサンプルとZnO / Ge界面サンプルを使用してXPS測定を行いました。Arプラズマ処理後、-0.05eVシフトがあることがわかりました。これは、Arプラズマ処理後のZnO / GeVBOが約2.38eVであり、CBOが0.17eVであることを示している可能性があります。

Arプラズマ処理ありとなしのZnO / Ge界面サンプルのVBM。 a Zn 2 p および b 厚いZnOサンプルの価電子帯スペクトル c ZnO 2 p ZnO / Ge界面サンプルのスペクトル。 d Arプラズマ処理された金属/ ZnO / n-Ge
のバンドアライメント図Al / ZnO / n-Ge接点の電気的性能
図6aは、測定された電流密度 J を示しています。 印加電圧の関数として V 軽くドープされたn-Ge上のAl接点の特性。 Al / ZnO / n - -GeデバイスのZnO層の厚さは異なります。デバイスの概略図を図6の挿入図に示します。
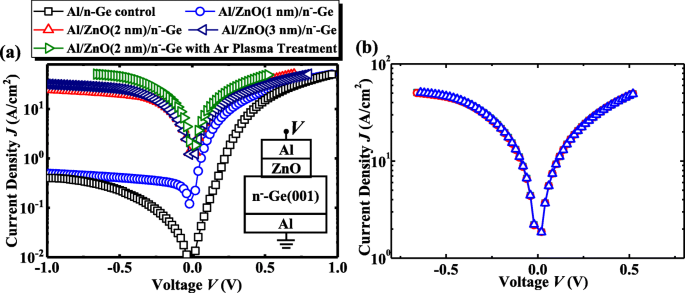
a J - V Al / n − の特性 -Geコントロール、Al / ZnO / n - -ZnOの厚さが1nm、2 nm、3 nmのGe、およびAl / 2 nmArプラズマ処理されたZnO / Ge、 b J -3つのAl / 2 nmArプラズマ処理ZnO / GeデバイスのV特性
予想通り、ZnOを含まないAl / n-Ge制御デバイスは、Al / n - でのフェルミ準位のピン止めにより、電子のバリア高が高い整流特性を示します。 -Ge [38]。 ZnOを含まないコントロールのAl / n-Geサンプルと比較して、Al / ZnO / n-Geデバイスは改善された逆 J を示します。 これは、金属/ Ge界面での金属誘起ギャップ状態(MIGS)の還元によって誘発されるフェルミ準位のピン止め解除によるものです[18、19]。この改善は、より多くのMIGSが排除されるという事実により、より厚いZnOでさらに強化されます。ただし、3 nm ZnO挿入デバイスの順方向電流密度は、2nmデバイスの順方向電流密度よりも小さくなります。これは次のように説明できます。 Al / ZnO / n-Geの主な電流密度はトンネル電流です。 ZnOが十分に厚くない場合、MIGSは効果的に除去されず、それでも整流特性を示します。しかし、ZnOが厚すぎると、ZnOの直列抵抗が抵抗全体を支配し、電流が小さくなります。したがって、MIGSの除去とZnOの直列抵抗の増加の間にはトレードオフがあり、したがってILには臨界的な厚さがあります[19]。結論として、2nmがAl / ZnO / n-Ge接触に最適な厚さであると考えられています。
Arプラズマ処理により、Al / ZnO / n - の性能 -Geデバイスがさらに改善されました。印加電圧の逆方向または順方向の掃引に関係なく V 、Al / 2 nm ZnO / n − -Arプラズマ処理を施したGeデバイスは、強化された J を実現します 2 nmZnOまたは3nm ZnOを備えたデバイスと比較すると、これは大量の V が原因です。 o Arプラズマ処理中にZnO膜に生成されます。 ZnOのドーピング濃度を高くすると、ZnOの直列抵抗を効果的に低減し、ZnOとAlの界面での電子のトンネル障壁を低減して、トンネル電流密度を向上させることができます。
図6bは、 J を示しています - V 3つのAl / 2 nm ZnO / n - の特性 -Arプラズマ処理を施したGeデバイス。 J であることは明らかです 異なるデバイスの場合はほぼ同じであり、ALDプロセスとArプラズマ処理の両方が電流密度の改善に均一な効果をもたらすことを示しています。
オーミック接触は、Al / 2 nm ZnO / n - で得られます。 -Geは、それぞれ15秒、30秒、45秒、60秒の異なるArプラズマ処理期間がある場合とない場合で、図7に示されています。

私 – V Al / 2 nm ZnO / n - での曲線 -異なる d のGe a Arプラズマ処理なしおよび b のArプラズマ処理期間あり 15秒、 c 30秒、 d 45秒、および e 60秒
生の総抵抗 R tot d が減少すると、2つの接点間の距離が減少します。 、および最後の R tot は、式 C で計算される補正係数Cによって変更されます。 =( L / d )・ln(1 + d / L )[39]、ここで L =25μmは、図8aの挿入図に示されているように、内側パッドの半径を表します。 R をプロットする tot d の関数として 図8aでは、シート抵抗 R sh n − の -Geはラインスロープから取得でき、次にρ c は、垂直軸との線形フィッティングラインの切片から計算されます。 Al / 2 nm ZnO / n - の場合 -Arプラズマ処理なしのGeデバイス、ρ c は6.87×10 −2 Ωcm 2 、ただし、45秒のArプラズマ処理後は、Arプラズマ処理なしの場合と比較して17.2倍の減少があり、接触抵抗率はρです。 c 3.66×10 -3 の Ωcm 2 。 ρの値を比較します c Al / 2 nm ZnO / n - の場合 -図8bのArプラズマ処理期間が異なるGeデバイス。 ρが観察されます c デバイスの割合は、最大30秒の治療時間で減少します。ただし、治療時間は30秒を超えるため、ρ c ほぼ同じままです。 ρの減少 c 前述のように、ZnOのドーピング、したがってトンネル障壁と直列抵抗の減少に起因する可能性があります。しかし、n - のシート抵抗に観察可能な変化はありません。 -Ge、n - の導電率に影響がないことを示します -Arプラズマ処理を施したGe。
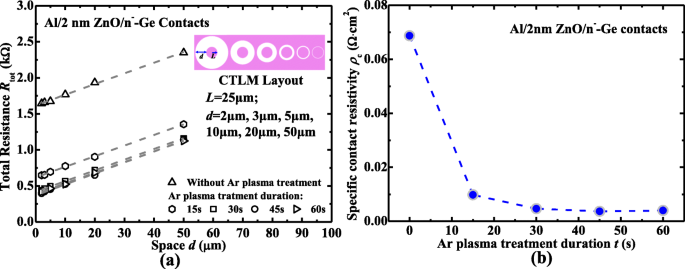
a R tot 対 d Al / 2 nm ZnO / n − を使用したCTLMの曲線 -異なるArプラズマ処理期間のGe接触、図5aの挿入図は、この作業で使用されたCTLM構造の情報です。 b ρ c 対異なるArプラズマ処理期間
高濃度にドープされたGeにAl接点を備えたCTLM構造を使用して、Al / 2 nm ZnO / n + の接触抵抗特性を調査します。 -Ge。 ZnO層は45秒間Arプラズマ処理を受けました。図9aは、測定された I を示しています。 - V d が異なるAl接点間の曲線 、優れたオーム性能を示しています。図9bは、 R をプロットしたものです。 tot d の関数として Al / 2 nm ZnO / n + の場合 -Ge CTLM、および R sh およびρ c 64Ω/□および2.86×10 -5 になるように抽出されます Ωcm 2 それぞれ。
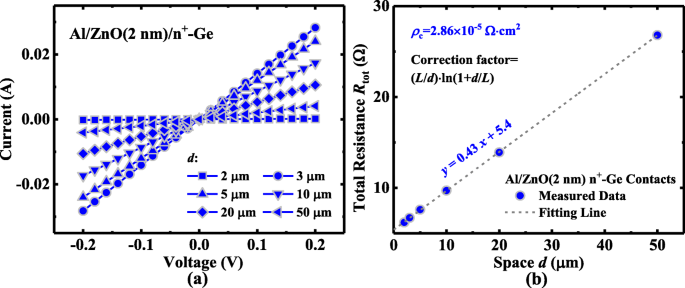
a 私 – V Al / ZnO(2 nm)/ n + での曲線 -異なる d のGe Arプラズマを使用して処理されたZnOで。 b R tot 対 d Al / ZnO(2 nm)/ n + を使用したCTLMの曲線 -Geの連絡先
ρを比較します c ArプラズマAl / ZnO / n + で処理されたZnOの -この中のGeデバイスは、図10に示すように、文献で報告されているデバイスと連携します。高濃度にドープされたn + の場合 -Ge接触サンプル、Al / ZnO / n + -Geの連絡先は小さいρを示しています c Ni / GeSn [40、41]、Ni / Ge [42]、Ti / n + との比較 -参照のGe。 [31]、およびTi / TiO 2 / GeO 2 / Ge [31]、炭素注入Ni / Ge [42]、およびTi / n + -SiGe / n-Ge [43]。 Ni / Ge、Ni / GeSn、Ti / Ge、および炭素が注入されたNi / Geなどの金属オーミック接触は、フェルミ準位のピン止めが激しく、ρが大きくなります。 c 。 Ti / TiO 2 の場合 / GeO 2 / Ge接触、1 nm TiO 2 の二重層によって大きなトンネリング抵抗が導入されました /1.5 nm GeO 2 IL、接触抵抗特性を低下させます。しかし、ρ c この作品のそれは参考文献のそれよりも大きいです。 [44]。これは、P + が4倍大きいことが原因であると考えられます。 私たちの仕事よりも着床線量。より大きな注入量は、n + のより重い表面ドーピングを可能にします -Ge、ショットキー障壁が薄くなり、ρが小さくなります。 c 。 n + をより多くドーピングすると、 -Al / ZnO / n + 中のGe -Geデバイス、小さいρ c 結果になります。
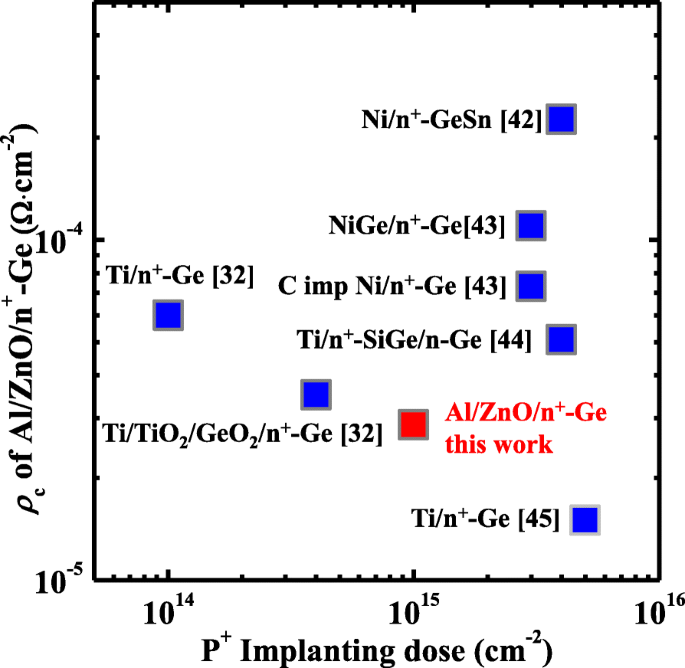
ρの比較 c Al / ZnO / n + の -この作業のGeは、P + を使用して、他の報告された連絡先のGeと連携します。 x としての着床線量 軸
結論
Al / ZnO / n-Ge構造においてZnOILによって誘発されるフェルミ準位のピン止め解除効果を調査します。 XPS測定では、ZnO / n-Geで0.22eVの小さなCBOが示されました。つまり、FLPの除去が発生し、n-Geのオーム金属接触につながります。さらに、ZnOのArプラズマ処理により V の濃度が上昇することが報告されています。 o 、ZnOのn型ドーパントとして機能し、 R を改善します。 c Al / ZnO / n-Geデバイスの性能。オーミック金属接点はn - で得られます およびn + -Arプラズマ処理されたZnOILを使用したGe。 CTLM構造に基づいて、ρの値 c 3.66×10 −3 Ωcm 2 および2.86×10 − 5 Ωcm 2 Al / 2 nm ZnO / n - で達成 -GeおよびAl / 2 nm ZnO / n + -Ge、それぞれ、50Wの電力で45秒間のZnOのArプラズマ処理。
略語
- Al:
-
アルミニウム
- ALD:
-
原子層堆積
- Ar:
-
アルゴン
- CBO:
-
伝導バンドオフセット
- CTLM:
-
循環伝送線路方式
- DEZn:
-
ジエチル亜鉛
- E g :
-
バンドギャップ
- FLP:
-
フェルミ準位のピン止め
- Ge:
-
ゲルマニウム
- GeO x :
-
酸化ゲルマニウム
- GeSn:
-
ゲルマニウムスズ
- HCl:
-
塩酸
- HRTEM:
-
高分解能透過型電子顕微鏡
- IL:
-
界面層
- MIGS:
-
金属誘起ギャップ状態
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- Ni:
-
ニッケル
- P + :
-
リン光イオン
- R c :
-
接触抵抗
- R tot :
-
生の総抵抗
- SE:
-
分光エリプソメトリー
- Si:
-
シリコン
- Ti:
-
チタン
- TiO 2 :
-
二酸化チタン
- UV-VIS:
-
紫外可視
- VBO:
-
ヴァランスバンドオフセット
- V o :
-
酸素空孔
- XPS:
-
X線光電子分光法
- ZnO:
-
酸化亜鉛
- ρ c :
-
比接触抵抗率
ナノマテリアル



