LaベースのRRAMデバイスの性能に対するCuドーピングの影響
要約
この論文では、Laベースの抵抗変化型アクセスメモリ(RRAM)デバイスの抵抗変化型動作に及ぼすCu挿入層と急速熱アニーリングの影響を調査しました。ドープされていないコントロールサンプル(Cu / LaAlO 3 / Pt)、Cu埋め込みデバイスは、より高いデバイス歩留まりとリセット停止電圧を示します。これは、LaベースのRRAMの信頼性が効果的に改善されたことを示しています。ただし、アニールされていないCu / LaAlO 3 :Cu / Pt RRAMデバイスは、依然としてパラメータの深刻な分散に悩まされています。 Cu挿入層とアニーリング処理を施したRRAMデバイスは、低い形成電圧、高いオン/オフ比、微細な電気的均一性など、最高の抵抗スイッチング特性を示すことが証明されました。これらの改善は、拡散したCu原子とCu-NCが局所電場を増強し、形成のランダム性を弱める可能性があるため、アニーリングプロセス後のCu原子の拡散とCuナノ結晶(Cu-NC)の形成に起因する可能性があります。導電性フィラメントの破裂。
はじめに
抵抗変化型メモリ(RRAM)は、そのシンプルな構造、低消費電力、高スケーラビリティ、高速動作速度、マルチバリューにより注目を集めている次世代不揮発性メモリデバイスの開発の方向性と考えられています。ストレージ容量[1]。 RRAMは、多くの場合、金属-絶縁体-金属(M-I-M)サンドイッチ構造に製造され、中間誘電体層は、その抵抗スイッチング(RS)性能に大きな影響を与えます。したがって、多くの一般的に使用される高誘電率(high- k )を含む多種多様な材料 )材料(HfO 2 など) [2]、Al 2 O 3 [3]、およびZrO 2 [4])、RRAMアプリケーションについて広範囲に調査されています。すべての酸化物材料の中で、ランタンベースの酸化物は最も有望な高 k の1つです。 k が高いため、研究の関心が高まっている誘電体 値、大きなバンドギャップ、および微細な熱安定性[5]。最近、低動作電圧、高抵抗ウィンドウ、長い保持時間、長いサイクル耐久性、優れた一貫性などの優れた抵抗スイッチング特性がLaベースのRRAMで発見され、Laベースのhigh-
また、優れた均一性、正確な厚さ制御、およびCMOSプロセスとの互換性の利点により、原子層堆積(ALD)技術は、Laベースの誘電体膜を製造するために最も一般的に使用される成長方法の1つです[8]。残念ながら、ALD蒸着RRAMデバイスでは、高品質の誘電体膜のために、望ましくない高い形成電圧が常に必要になります。これは、高い故障率、低いオン/オフ比、低い耐久性、およびデバイスの広い分散につながる可能性があります[9]。 。より優れたRS性能を備えたRRAMデバイスを取得するには、イオン注入[10]、ドーパント拡散[11]、またはナノ結晶(NC)の挿入[12]を含む材料/デバイス構造エンジニアリングをALDで準備したLaに採用する必要があります。ベースのRRAM。
最近の報告では、従来の高 k のRS動作を改善するためのさまざまなドーピング技術 材料(HfO 2 [13]、ZrO 2 [14]など)は広く研究されてきました。ただし、LaベースのRRAMデバイスのNCで改善されたRSの動作は、これまで報告されていません。したがって、Cuが埋め込まれたLaAlO 3 Cu / LaAlO 3 の構造を持つデバイス / Cu / LaAlO 3 / Ptはメモリアプリケーション用に製造されており、LaベースのRRAMデバイスのパフォーマンスとスイッチングメカニズムに対するCuドーピングの影響に注目が集まっています。
メソッド
Cu / LaAlO 3 の構造を持つ製造されたデバイスの概略図 / Cu / LaAlO 3 / Ptを図1に示します。LaベースのRRAMデバイスの製造プロセスは次のとおりです。最初に2インチに100nm Pt / 10 nmTiの2層金属を堆積しました。 SiO 2 電子ビーム蒸着による下部電極(BE)としての/ Siウェーハ。続いて、Picosun R-150 ALDリアクターの温度を300°C、約10 nm LaAlO 3 に設定しました。 (La / Al比3:1)Pt / Ti / SiO 2 上に薄膜を堆積させた / Si基板、La( i- を使用 PrCp) 3 La前駆体として、Al(CH 3 ) 3 Al前駆体およびO 3 として 酸化剤として。次に、LaAlO 3 上に約2nmのCu層を成長させました。 電子ビーム蒸発器(EBE)を使用して0.1Å/ sの速度で。繰り返しますが、〜10 nmLaAlO 3 (La / Al比は3:1)薄膜は、300°CでALDによって堆積されました。 LaAlO 3 の後 / Cu / LaAlO 3 スイッチング層はALD-EBE-ALDプロセスを使用して作成され、ラピッドサーマルアニーリング(RTA)プロセスはN 2 で実行されました。 600°Cで30秒間周囲温度。 10 nmAu / 150 nmCuの上部電極(TE)がLaAlO 3 に堆積されました。 リソグラフィー後の電子ビーム蒸着による誘電体、続いて剥離して、50×50μm 2 のサイズのデバイスを製造します。 〜250×250μm 2 。 LaベースのRRAMデバイスのパフォーマンスに対するCuドーピングの影響をさらに理解するために、2つのコントロールサンプル、S1:Au / Cu / LaAlO 3 / Pt(アニールなし)およびS2:Au / Cu / LaAlO 3 :Cu / Pt(アニールなし)が設定されました。そして、Au / Cu / LaAlO 3 のサンプル :Cu-NC / Pt構造がS3として割り当てられました。
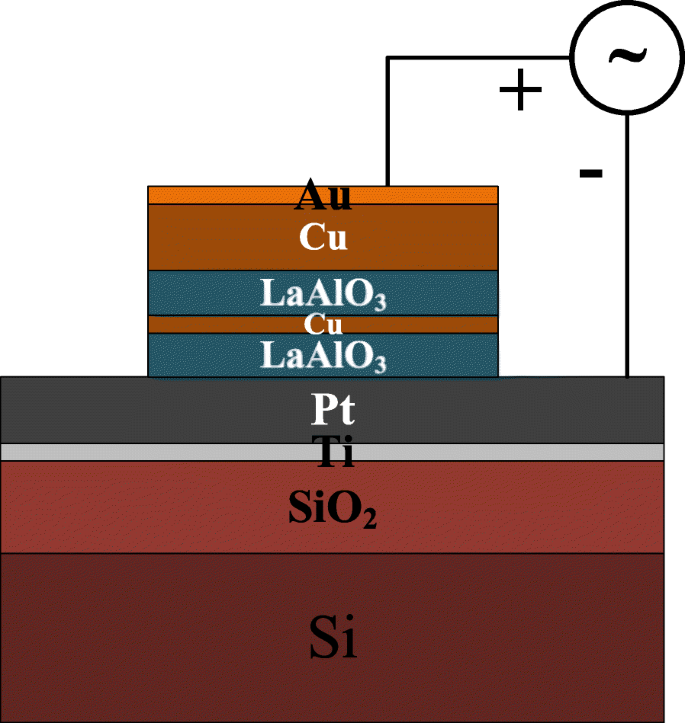
Cuを埋め込んだLaAlO 3 の概略図 Cu / LaAlO 3 の構造を持つデバイス / Cu / LaAlO 3 / Pt
X線光電子分光法(XPS)を使用して、ドープされたCu原子の分布を分析し、断面透過型電子顕微鏡法(TEM)を使用して、製造されたRRAMデバイスの微細構造を観察しました。 RS特性は、AgilentB1500A半導体パラメータアナライザを使用してさまざまなモードで測定されました。成形および硬化プロセス中の大電流による損傷から製造されたデバイスユニットを保護するために、1mAの電流コンプライアンスが課されました。
結果と考察
図2は、CuをドープしたLaAlO 3 のCu2pスペクトルのX線光電子分光法(XPS)深度分析を示しています。 フィルム(エッチングパラメータ:2 KVM Arイオン、〜1Å / sエッチング速度)。図2に示すように、30秒または60秒のエッチング後のアニールされていないサンプル(S2)にはCu 2pピークがほとんど見られませんが、90秒のエッチング後に顕著なCu 2pピークが現れ、Cuを示しています。原子は主にCu埋め込み層に集中します。これとは異なり、Cu原子はLaAlO 3 全体で観察されます。 アニーリング処理後、つまり30秒間、60秒間、90秒間エッチングした後、S3に明らかなCu2pピークが観察されます。 XPSの結果は、高温アニーリングがドープされたCu原子の再分布につながることを確認しており、LaベースのRRAMの電気的特性を改善するのに役立つ可能性があります。
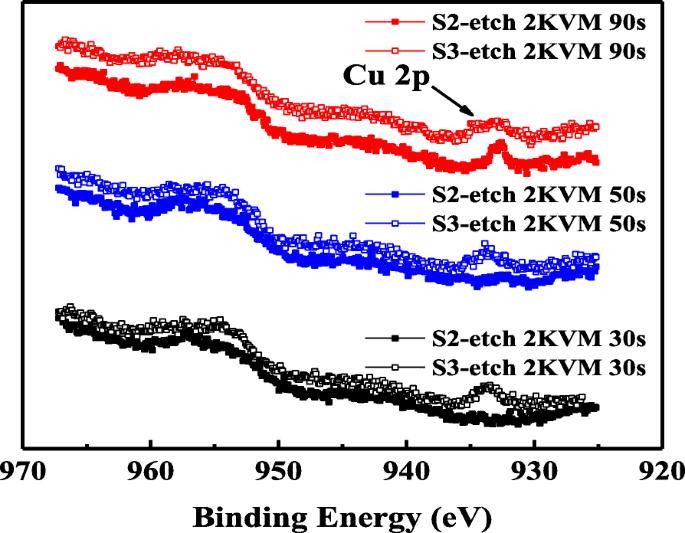
30秒、60秒、および90秒のArイオンエッチング後のS2およびS3のCu2pスペクトルのXPS結果
図3は、2つのCuを埋め込んだLaAlO 3 の典型的な断面透過型電子顕微鏡(TEM)画像を示しています。 RRAM(つまり、S2およびS3)。図3aに示すように、アニールされていないCu / LaAlO 3 の積層構造 / Cu / LaAlO 3 / PtデバイスはS2のTEM画像ではっきりと認識できました。上部LaAlO 3 の堆積後、注目に値します。 ALDプロセスの300°Cの層では、埋め込まれた約2nmのCuナノ層は熱拡散の影響をわずかに受けています。したがって、図3bの高解像度画像から、LaAlO 3 に埋め込まれた2〜6nmのサイズの不規則で分離されたCuナノ粒子 層がはっきりと観察できます。 ALDプロセス後の追加のアニーリング処理により、Cu原子の熱拡散がさらに促進され、図3cに示すようにCuナノ層の存在を区別することが困難になります。図3dに示すように、より高解像度のTEM画像を使用すると、約25nmの厚さのLaAlO 3 いくつかの球状で分離されたCu-NCが埋め込まれた層が観察され、Cuナノ層の一部がすでにLaAlO 3 に拡散していることを示しています。 600°Cのアニーリング処理後にいくつかの小さいサイズのCu-NCが残っている誘電体。
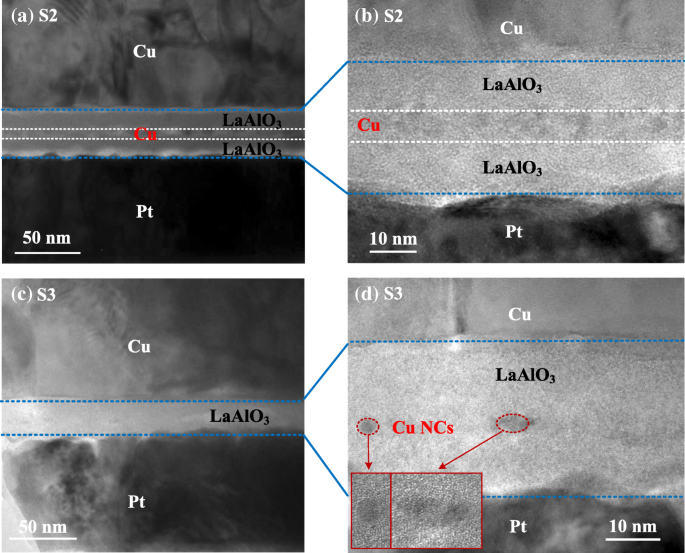
Cuを埋め込んだRRAMデバイスのTEM画像。 a S2の典型的な断面TEM画像。 b S2のHRTEM画像。 c S3の断面TEM画像。 d S3のHRTEM画像
サンプルS1、S2、およびS3の電気成形プロセスを図4に示します。図4に示すように、S1の成形プロセスには約12 Vの高電圧が必要であり、はるかに低い成形電圧が必要です。 (〜7 V)はS2とS3で必要であり、Laベースのデバイスの形成電圧が誘電体膜にCuナノ層を挿入することによって効果的に低減できることを示しています。また、S1の初期抵抗値(2.51×10 12 )との比較 Ω、1 Vで読み取る)、S2の抵抗ははるかに低くなります(2.65×10 6 Ω、1 Vで読み取り)、この値はアニーリングプロセス後に増加します(S3、2.83×10 12 Ω、1 Vで読み取ります)。形成電圧と初期抵抗の上記の変動は、LaAlO 3 の誘電特性の変化に起因する可能性があります。 材料/デバイス構造工学によるフィルム。 ALD法で作製したLa系誘電体膜は高品質であるため、絶縁体(S1)を破壊するには非常に高い電界強度が必要です。 Cuナノ層が誘電体膜に挿入された後、ALDで成長した高品質のスイッチング層は、この金属ナノ層の影響を受けます。これにより、誘電体が破壊されやすくなり、最終的にS2の形成電圧が大幅に低下します。また、CuとLaAlO 3 の構造の違いにより、酸素空孔形成のエネルギー障壁を効果的に低減し、より準安定な欠陥を誘電体膜にもたらすことができます。 材料(格子の一致、熱膨張の一致など)[15]。その結果、より多くの欠陥(電荷トラップ、金属イオン、酸素空孔など)がLaAlO 3 に導入されます。 S2の初期抵抗の低減につながる抵抗スイッチング層[16]。ただし、S2の誘電体薄膜のこれらの多数の欠陥は、追加のアニーリング処理によって効果的に低減(または除去)でき、S3の高い初期抵抗につながります[17]。さらに、追加のアニーリング処理により、いくつかのCu-NCと拡散したCu原子がLaAlO 3 に取り込まれました。 誘電体膜。これにより、局所電界がさらに強化され、S3の形成電圧が低くなります[18]。
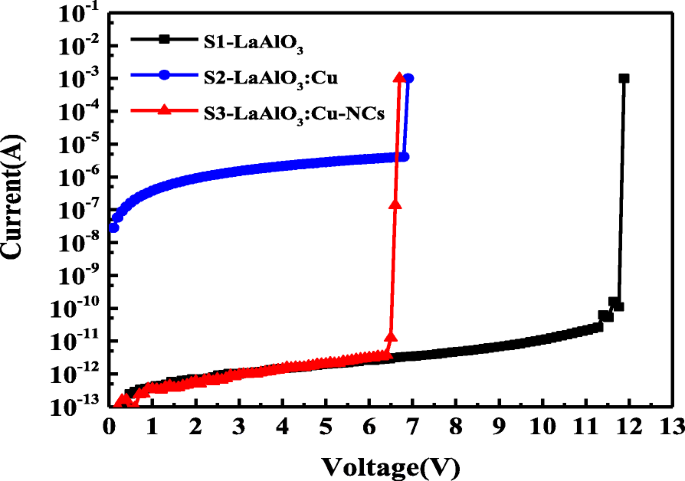
3種類のLaベースのRRAMの成形プロセス
典型的なバイポーラ電流-電圧( I – V )3種類のLaベースのRRAMデバイス(面積サイズ50μm×50μm)の約100の直流(DC)掃引サイクルの曲線が図5a–cで得られます。テスト電圧(リセットプロセスの場合は0〜-1.5 Vおよび-1.5〜0 V、セットプロセスの場合は0〜5 Vおよび5〜0 V)は、BE(Pt)が接地されている間、TE(Cu)にバイアスされます。 。 3つのLaベースのRRAMデバイスは、繰り返し可能なバイポーラRS動作の100連続サイクルを表示しますが、それらの間にはいくつかの大きな違いがあります。まず、S2およびS3と比較して、ドープされていないサンプルS1は、リセット停止電圧( V )を使用した周期的なセット-リセット操作中に損傷を受けやすくなります。 停止 )の− 1.5 V(図5aの挿入に示されている)。これは、最大の V 停止 S1の値はS2およびS3の値よりも低くなっています。これを考慮すると、比較的低い V 停止 サンプルS1の場合、-1.4Vが使用されます。もう1つの違いは、 I – V S1とS2の曲線は、設定プロセス中の異常な変動(上昇と下降)を示しています。これは、滑らかな I とはまったく異なります。 – V S3の曲線。この現象は、ドープされていない(またはドープされているがアニールされていない)LaAlO 3 の一部の導電性フィラメント(CF)の残留物と密接に関連しています。 リセットプロセス後の誘電体膜。また、S1やS2と比較して、S3には I – V セット/リセット電圧のより一貫性とより小さな分布を示す曲線は、RRAMデバイスの安定性がドーピングとアニーリング処理によって効果的に改善できることを意味します。図5d–fは、図5a–cの左側から抽出したS1–S3の耐久性テスト(〜100サイクル、-0.1 Vで読み取ったもの)です。 Cu / LaAlO 3 の最大抵抗比 / Pt RRAMデバイス、つまり、最大高抵抗状態(HRS)から最小低抵抗状態(LRS)までは、6桁にもなる可能性があります。ただし、S1とS2のHRSのランダムな変動が大きいと、非常に低いレベルのオン/オフウィンドウ(〜10)が発生します。 S1およびS2とは異なり、S3のオン/オフウィンドウはS1およびS2の約100倍であり、CuドープLaベースのRRAMデバイスの一貫性特性がアニーリング後に効果的に改善されることを示しています。 S3でのアニーリング処理により、Cu原子がLaAlO 3 全体に拡散するだけではありません。 フィルムだけでなく、誘電体にCu-NCを形成します。したがって、局所電場が強化されました。 CFの形成/破裂のランダム性が制御され、HRS(LRS)の分布が改善されました[19]。上記の結果は、LaベースのRRAMにCuナノ層を埋め込むというアイデアは、デバイスのパフォーマンスを向上させるためにある程度の熱処理が必要であることを示唆しています。

a – c 典型的なバイポーラ I – V 曲線と d – f S1、S2、およびS3の耐久性テスト
図6aは、HRSおよびLRS抵抗の累積確率(-0.1 Vで読み取られる)を示し、図6bは、セット電圧とリセット電圧の累積確率を記録します。図6aでは、平均値(μ )S1、S2、S3のLRSとHRSは、それぞれ50.7Ωと1.59MΩ、100.6Ωと1.51MΩ、80.6Ωと1.95MΩになります。ただし、変動係数(σ / μ )LRSとHRSは、S1、S2、およびS3のほぼ同様の平均値と比較すると大きく異なります。その中で、S3のσ/μ値が最小(LRS − 0.74、HRS − 1.02)、続いてS2(LRS − 1.33、HRS − 1.23)であり、S1のσ/μが最悪(LRS − 1.22、HRS)です。 − 3.00)。図6bに示すように、リセット/セット電圧の平均値は、サンプルS1、S2、およびS3でそれぞれ約-0.79 V / 2.36 V、-0.83 V / 2.49 V、および-1.25 V / 2.59Vです。標準偏差(σ パラメータの分散を評価するために使用されるリセット/セット電圧の)は、それぞれ0.20 / 0.82(S1)、0.23 / 1.16(S2)、および0.13 / 0.45(S3)であることがわかります。 HRS、LRS、 V の幅広いバリエーションがあります。 set 、および V リセット S1とS2のはアニーリング後に改善されます。 S1およびS2と比較して、ドープおよびアニールされたもの(S3)はより優れた均一性を示し、S3が3つの中で最高の動作安定性を持っていることを示しています。前述のように、S2には多数の欠陥が発生する可能性があり、デバイスの信頼性と安定性に問題が発生します。 S3の場合、これらの多数の欠陥は熱プロセスによって除去され、CFの形成/破壊のランダム性はCu-NCの存在により減少します。したがって、S3ではスイッチング電圧と抵抗値の変動が小さい細かい均一性が得られます。
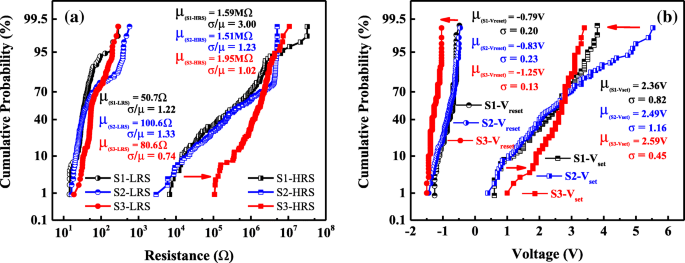
a の累積確率 HRSおよびLRS(-0.1 Vで読み取る)および b 電圧の設定とリセット
室温での読み出し電圧-0.1Vでの3種類のLaベースのRRAMデバイスの保持特性を図7に示します。保持テスト中のCu / LaAlO 3 :Cu-NC / Ptデバイスは、10 4 以上にわたって安定した保持性能を示します s室温でほぼ一定の R HRS / R LRS 最大3桁の比率で、LaベースのRRAMの不揮発性特性に適合します。 DC SET / RESET 10サイクルのバイポーラ歩留まりは、S1、S2、およびS3のスイッチング能力を評価するために測定されます。図8に示すように、S3が最高の歩留まりで、次にS2が続き、S1が最低です。この結果は、埋め込まれたCu層がLaベースのRRAMの歩留まりを向上させるのに役立ち、デバイスの歩留まりを追加の熱処理によってさらに改善できることを示しています。さらに、図8から、デバイスの面積が減少すると、デバイスの歩留まりが向上することがわかります。この現象は、Cu / LaAlO 3 の抵抗スイッチングメカニズムを示しています。 / Pt RRAMデバイスは、ジュール熱効果と密接に関連している可能性があります。つまり、ジュール熱は導電性フィラメントの形成/破壊に関与し、小さいサイズのデバイスでより顕著になるようです。
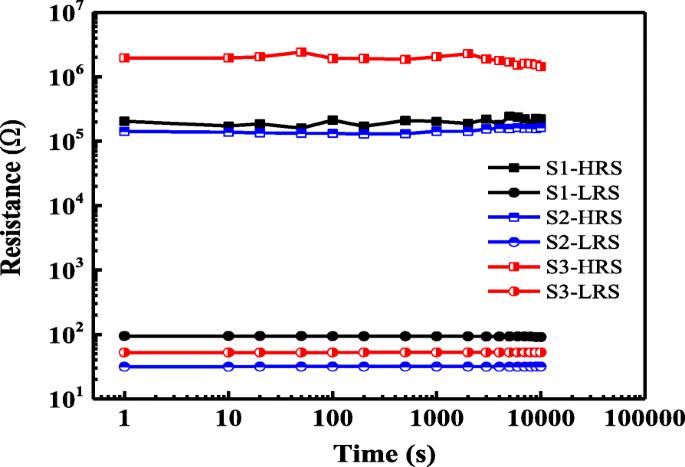
室温でのLaベースのRRAMデバイスの保持動作
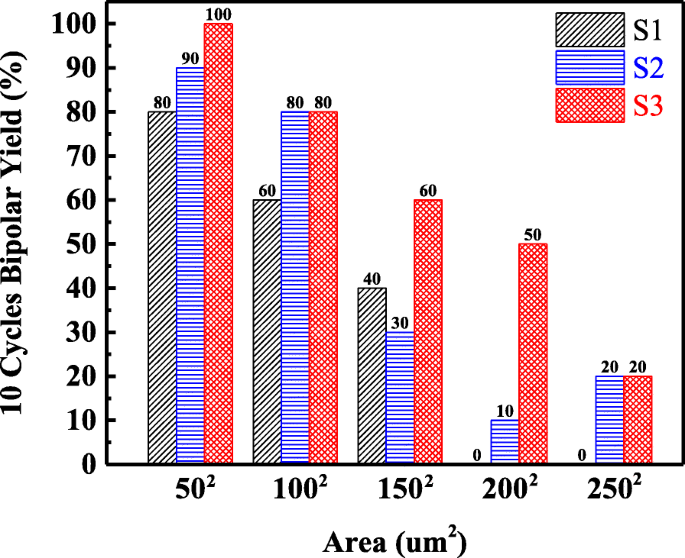
LaベースのRRAMデバイスのDCSET / RESET10サイクルバイポーラ歩留まり
Cu-NCで処理されたLaベースのRRAMについてより多くの洞察を得るために、S3の抵抗スイッチングメカニズムにさらに分析が集中しています。図9aに示すように、 I には、さまざまな方向の電圧の設定とリセットが適用されます。 – V S3の測定。テスト結果は、S3がユニポーラとバイポーラの両方の抵抗スイッチング動作を持っていることを示しており、Cu-NCで処理されたLaベースのRRAMが無極性であることを示しています。研究者は、無極性(単極性)抵抗スイッチング動作は、CFのジュール熱支援形成/破壊と密接に関連していると考えています[7]。 LaベースのRRAMのリセットプロセスでは、大電流のオーバーシュート現象が観察され、ジュール熱効果が誘発されて、CFの溶融、焼結、または熱酸化が発生します。図9bは、 I の二重対数プロットを示しています。 – V S3の曲線と線形フィッティング、および挿入図はln( I / V )– V 1/2 設定されたプロセスの曲線。明らかに、 I – V LRSの関係は、約1の傾きを持つオーム伝導挙動を示します。これは、硬化プロセス後の誘電体にCFが存在することを意味します。ただし、HRSの伝導メカニズムは少し複雑で、 I – V HRSの曲線は、3つの異なる勾配を持つ3つの直線に分割できます。低電圧領域(<0.8 V、オレンジ色の線)では、フィッティング線の傾きは約1.33であり、オーム輸送メカニズムに近いです。電圧の増加(〜0.8〜〜2 V、緑色の線)に伴い、フィッティングラインの傾きは1.93( I )に増加します。 〜 V 1.93 )、これは子供の二乗法( I 〜 V 2 )。 3番目の領域(> 2 V、紫色の線)では、フィッティングラインの傾きが増加し続け(たとえば、この場合は2.86)、 V のときに電流が急激に増加します。 set が達成された。オーム輸送領域と子供の法則領域で構成されるHRSの伝導モードは、古典的な空間電荷制限電流(SCLC)メカニズムとよく一致しています[20、21]。 SCLC伝導メカニズムの出現は、局所伝導経路の形成と破裂を示しており[22]、これはCu / LaAlO 3 の主要なRSメカニズムと見なされています。 :Cu-NC / Ptデバイス。さらに、HRS伝導は、プール-フレンケル伝導メカニズム(インサート)にもよく適合していることがわかります。プール-フレンケル効果は、主に、トラップされた状態をホッピングする電界励起キャリアによって引き起こされます[23]。これは、LaAlO 3 にまだ多数の欠陥があることを示唆しています。 アニーリング処理後もフィルム。
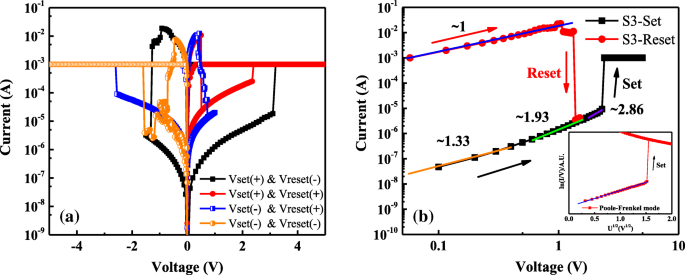
a 私 – V 異なる電圧方向でのS3の測定。 b I の二重対数プロット – V S3の曲線と線形フィッティング、および挿入図はln( I / V )– V 1/2 設定されたプロセスのプロット
RSメカニズムをさらに理解するために、S3の電極面積(図10a)および温度(図10b)への依存性が研究されました。図10aから、LRS抵抗は電極面積に依存しないが、HRS抵抗(および初期抵抗)はデバイス面積の増加とともに減少することがわかります。これは、S3のRSメカニズムが形成と破裂に起因することを示しています。 CFの。図10bでは、HRS抵抗は温度の上昇とともに減少し、S3のオフ状態が半導体動作に関連している可能性があることを示しています。対照的に、LRS抵抗は温度の上昇とともに増加し、オン状態での金属特性を示します[24]。文献によると、金属抵抗と温度の関係は通常、 R の式で調べられます。 ( T )= R 0 [1 + α ( T − T 0 )] [25]。そして、図10bの青い線形フィットは、温度係数(α)を決定します。 )1.03×10 −3 K -1 。この値は、他の文献で報告されているCuナノワイヤの値よりもわずかに小さい(2.5×10 -3 )。 K -1 [26]、2.39×10 -3 K -1 [27])。 Cu-NCをドープしたLaAlO 3 には、多数の欠陥が導入されているためです。 映画、より低いα CuCFの値はこの論文で得られます。
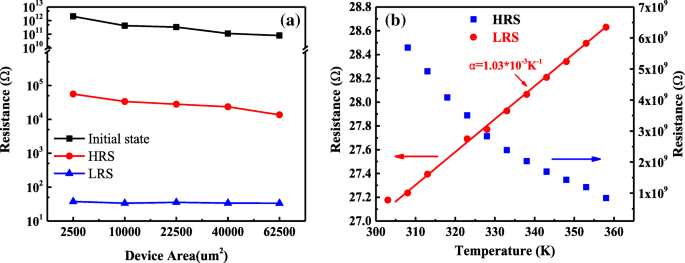
a HRSとLRSの電極面積依存性。 b HRSとLRSの温度依存性
したがって、Cu / LaAlO 3 のRS効果について合理的な説明が提案されています。 :この場合のCu-NC / Ptデバイス。 Cu CFの形成と破裂は、電気化学的金属化(ECM)とジュール熱効果によって媒介される可能性が非常に高いです。図11に、Cu / LaAlO3のRSメカニズムの概略図を示します。(a)初期状態のCu-NC / Ptデバイス。 (b)、(c)プロセスを設定します。 (d)オン状態。 (e)プロセスをリセットします。 TE(Cu)に正の電圧が印加されると、酸化反応が発生します。これは、Cu→Cu 2+ と呼ばれます。 + 2e − 、電気化学的に活性な材料で発生します(図11b)。電場の作用下で、可動性のCu 2+ 陽イオンはLaAlO 3 を介してBE(Pt)に向かって移動します フィルム、およびCu 2+ の還元反応 + 2e − →Cuはカソードで発生します(図11c)。注目に値するのは、S3のLaベースの誘電体にいくつかのCu-NCと拡散したCu原子があり、これがCuCFの形成の自然な経路です。したがって、連続的に沈殿したCu金属原子は、これらの自然な経路に沿って成長し、最終的にTEに到達して導電性チャネルを形成する傾向があります(図11d)。印加電圧の極性を逆にすると、電気化学的効果とジュール熱効果に密接に関係する溶解プロセスがフィラメントのどこかで発生し、CFとデバイスがほぼ完全に破壊されてオフ状態になります(図11e)。 。
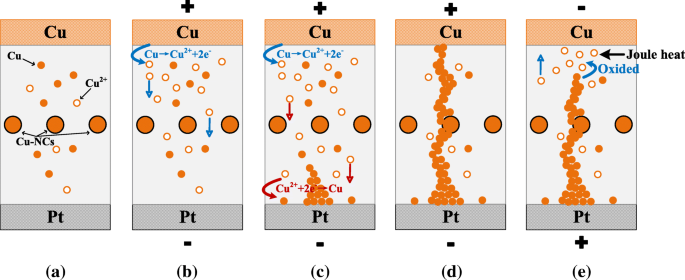
Cu / LaAlO3のRSメカニズムの概略図: a のCu-NC / Ptデバイス 初期状態; b 、 c プロセスを設定します。 d オン状態;および e リセットプロセス
結論
要約すると、LaベースのRRAMデバイスの性能を向上させるために金属ドープ法が導入されています。 I は、低い形成電圧、高いオン/オフ比、優れた電気的均一性、優れたデバイス歩留まりなど、抵抗スイッチング特性の明らかな改善を裏付けています。 – V Cuをドープしてアニールしたサンプルの測定結果。 XPSおよびTEM分析の結果から、スイッチング性能の向上は、アニーリングプロセス後のCu原子の拡散とCuナノ結晶(Cu-NC)の形成に起因する可能性があることが確認されました。さらなる研究により、Cu \ LaAlO 3 の抵抗スイッチングメカニズムが明らかになりました :Cu-NC \ Ptデバイスは、SCLCメカニズムとジュール熱効果に密接に関連するCu導電性フィラメントの形成と破壊に起因する可能性があります。この研究は、Cuナノ結晶を埋め込むことにより、RRAMの抵抗スイッチング動作を制御するための実行可能な方法を示しており、LaベースのRRAMの物理的メカニズムと固有の法則を理解するためにさらに作業を行う必要があります。
データと資料の可用性
この原稿の結論を裏付けるデータセットは、原稿に含まれています。
略語
- ALD:
-
原子層堆積; RRAM
抵抗変化型メモリ; NC
ナノ結晶; M-I-M
金属-絶縁体-金属; RS
抵抗スイッチング;高- k
高誘電率; RS
抵抗スイッチング; BE
下部電極; RTA
ラピッドサーマルアニーリング; TE
上部電極; XPS
X線光電子分光法; DC
直流; CF
導電性フィラメント; HRS
高抵抗状態; LRS
低抵抗状態; SCLC
空間電荷制限電流
ナノマテリアル



