ビアホール長の変調による、通常はオフのGaNHEMTの制限されたマルチメサチャネル幅の突破
要約
電荷中性スクリーン効果を調整するためにビアホール長を変調することにより、マルチメサチャネル(MMC)幅の一般的な制限を克服する新しいノーマルオフGaN高電子移動度トランジスタ(HEMT)を紹介します。強化された表面ピン止め効果に基づいて、最大300 nmの幅を持つ強化モード(Eモード)GaNHEMTを用意しました。 MMCの構造と幅、およびビアホールの長さがそれぞれ100 nm /2μmと300nm /6μmのEモードGaNHEMTは、正のしきい値電圧( V )を示しました。 th )それぞれ0.79Vと0.46Vです。 MMCおよびビアホール長構造のオン抵抗は、一般的なトライゲートナノリボンGaNHEMTのオン抵抗よりも低かった。さらに、デバイスはEモードを実現するだけでなく、GaN HEMTの電力性能を改善し、デバイスの熱効果を効果的に軽減しました。 EモードGaNHEMTを得るために、ビアホール長の側壁表面ピン止め効果を制御しました。私たちの調査結果は、ビアホール長の通常はオフのGaN HEMTが、次世代のパワーエレクトロニクスで使用できる大きな可能性を秘めていることを示唆しています。
背景
ワイドバンドギャップIII–V窒化物は、大きなバンドギャップ、高い臨界電場、高い飽和電子速度、高い導電率などの優れた材料特性により、周波数および電圧動作用の有望な半導体材料です[1、2]。そのため、発光ダイオード(LED)やトランジスタなど、さまざまな用途で広く使用されています[3]。さらに、アルミニウム窒化ガリウム/窒化ガリウム(AlGaN / GaN)ヘテロ構造は、III族窒化物化合物の自発的および圧電分極を利用して、高性能デバイスの開発に適した2次元電子ガス(2DEG)を形成します[4,5 、6]。 2DEGの量は、偏光誘起ドーピングの割合に影響され、デバイスの特性に直接影響します[7、8、9]。それらは多くの魅力的な特性を持っていますが、AlGaN / GaN高電子移動度トランジスタ(HEMT)は、その電子特性がデジタル、電力、RF、およびマイクロ波回路アプリケーションの複雑な回路構成を必要とする可能性があるため、普遍的な有用性を見出していません。したがって、通常はオフの動作が将来のIII-V半導体デバイスに不可欠です[10、11]。いくつかの特別な製造技術がテストされていますが(例えば、埋め込みゲートの使用[12、13、14]、ゲートの下へのp型キャッピング層の挿入[15、16]、トンネル接合構造[17]、フッ化物イオン注入ゲート下のバリア[18]、および特殊なメタルゲートとラピッドサーマルアニーリング(RTA)処理[19])を備えた薄いAlGaNバリア層を含めると、デバイスのパフォーマンスが悪化し、処理によって引き起こされる材料の損傷によって安定性の問題が発生する可能性があります。熱および電界効果の増加。
あるいは、北海道大学のチームは、フィンナノチャネルで製造されたAlGaN / GaN HEMTがしきい値電圧( V )のシフトを示すことを発見しました。 th )正の方向[20、21]。蘇州大学のグループは、 V の値を報告しました th ナノチャネルの幅が90nm未満の場合、系統的な正のシフトが発生しました[22]。慶北大学校の研究者は、挙動を説明するためにチャネル側の部分的なひずみ緩和を検討しました[23]。マサチューセッツ工科大学のチームは、GaNベースのHEMTの表面パッシベーション後のしきい値電圧をシミュレートし、チャネルの幅が100 nm未満のときに正の値が発生することを確認しました[24]。これは、側壁効果と引張応力の増加の結果です。これにより、チャネル内の電子濃度が低下しました。フィン型の構造は、しきい値電圧をシフトするだけでなく、オフ状態の特性を改善しながらオン状態のパフォーマンスを誘導する3D構造により、ゲートの制御性も向上させます。正規化された最大ドレイン電流( I D / mm)フィン型構造のAlGaN / GaN HEMTは、対応する平面構造よりも高くなっています[25]。これらの方法はEモードHEMTの製造に使用されてきましたが、高性能の通常オフGaNパワートランジスタを開発することは依然として非常に困難です。まず第一に、低いオン抵抗( R )の組み合わせ on )、チャネルの幅が100 nm未満に制限されている場合は、デバイスの総電力を低く抑えることができます。 R の値は on ゲート幅は分極クーロンフィールド散乱とゲートリークパスを介して相互コンダクタンスとゲートリークに影響を与えるため、通常はオフのゲートの長さを短くすることでチャネルの長さを減らすことができ、オフ状態のドレインリーク電流を制御することは別の課題になります[26、27 ]。堆積した膜は、これらの問題を改善するためのゲート誘電体として使用できます[28]。
この手紙では、トライゲートチャネルの幅制限のブレークスルーについて説明し、チャネルのビアホール長を変調する方法を提案します。私たちのデバイスは、MMC構造の幅が300 nm、ビアホールの長さが6 µmのEモードを実現し、0.46 Vのしきい値電圧を示しました。このアプローチは、デバイスのオン抵抗を低下させるだけではありません( R on )だけでなく、ジュール熱効果を軽減することもできます。さまざまなチャネル幅とビアホール長を持つ3Dトライゲートを組み合わせることにより、 V の正の値を持つ通常のオフGaNHEMTを実現しました。 th チャネル幅/ビアホール長がそれぞれ100nm /2μmと300nm /6μmの場合は0.79と0.46Vです。
メソッド
AlGaN / GaNエピウェーハは、日本酸素ホールディングスSR-2000有機金属化学蒸着システム(MOCVD)を使用して、(0001)サファイア基板上に成長させました。エピタキシャル構造の成長は、600°Cで堆積されたGaN核形成層から始まりました。次に、厚さ2μmの意図せずにドープされたGaNバッファ層、公称23%のアルミニウム組成を持つ厚さ21.8 nmの意図せずにドープされたAlGaNバリア層、および厚さ2nmのGaNキャップ層が1180°Cで堆積されました。デバイスの処理は、BCl 3 を備えた誘導結合プラズマ(ICP)反応性イオンエッチング(RIE)システムを使用して開始されました。 / Cl 2 130 nmの深さのメサを分離し、周期的なトレンチ構造をエッチングするためのガス混合物。続いて、2つのプロセスを適用して、くぼみ領域とメサ側壁の結晶ファセットを復元し、表面欠陥とイオン衝撃損傷のレベルを低減しました。 1つ目は、結晶学的な湿式化学エッチングに溶融KOHを使用して、ドライエッチングによって引き起こされた表面の損傷を取り除き、同時に滑らかな垂直側壁を生成することです。 2つ目は、ピラニア溶液(H 2 の混合物)の適用です。 SO 4 およびH 2 O 2 )表面の洗浄と有機残留物の除去用。水銀ランプを使用した従来のフォトリソグラフィーを適用して、DC測定用のドレイン、ソース、ゲート、およびコンタクトパッドを定義しました。チタン/アルミニウム/ニッケル/金(Ti / Al / Ni / Au、30/120/20/80 nm)で構成されるAlGaN / GaNヘテロ接合へのオーミック接触は、電子ビーム蒸着によってドレイン/ソース領域に堆積され、 850°Cで30秒間、真空下でアニーリングします。トランジスタチャネルを完成させるために、Ni / Au(20/80 nm)の電子ビーム蒸着によってゲート電極を作製しました。図1は、HEMT構造の断面の概略図、デバイスの上面図、およびデバイスの3D構造図を示しています。ゲートの長さ( L g )、MMC構造の幅( W MMC )、MMC構造のビアホール長( L MMC )、およびMMC構造の高さ( H MMC )は、それぞれ2 µm、100〜500 nm、1〜6 µm、および130nmでした。フィンは並列に接続されていました。表面のピン止め効果を高めるために、GaNHEMTビアホール長構造はパッシベーションを受けませんでした。図2aは、ソースおよびドレイン領域の金属表面の上面走査型電子顕微鏡(SEM)画像を示しています。図2bの光学顕微鏡(OM)画像は、完全なゲートとチャネルを示しています。デバイスに存在するチャネルの数を観察することは、実際の電流を計算するときに役立ちました。アニーリング後、原子が結晶格子内を移動し、転位の数が減少し、抵抗が効果的に減少したため、画像では表面が凹凸に見えました。図2cのSEM画像は、チャネルの寸法を確認しました。
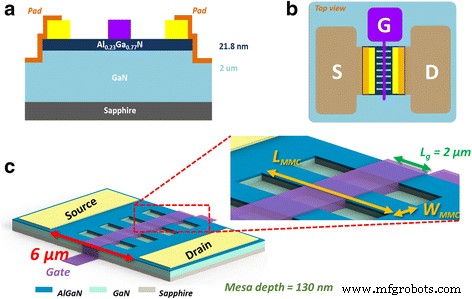
a の概略図 トランジスタチャネルに平行な方向から見たHEMT構造の断面。 b HEMT構造の上面図。および c HEMTの3D構造
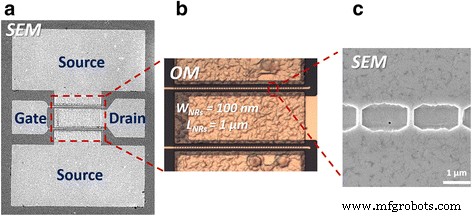
a デバイスの上面SEM画像。 b デバイスの上面OM画像。チャネルの幅と長さがそれぞれ100nmと1μmであることを示しています。および c チャネルの上面SEM画像
結果と考察
これまで、GaN高電圧トランジスタのほとんどの技術開発はAlGaN / GaN HEMTに基づいていました。これは、AlGaN-GaN界面での分極誘起2次元電子ガスのために本質的に空乏モード(Dモード)デバイスです。 [29]。それでも、パワーエレクトロニクス業界がGaN技術を広く採用する場合は、通常はオフのGaNトランジスタが必要になります。
(Al)GaN表面のダングリングボンドの数は約10 15 cm −2 ;これらのダングリングボンドは、表面のピン止め効果の結果として、表面が枯渇したバンドの曲がりを引き起こします。図3aは、トライゲート構造のサイドウォールゲートからの横方向チャネルの表面が枯渇した領域を示しています。慶北大学校の研究者は同様の現象を報告した[21]。図3bは、 I を示しています。 DS – V G L の固定値を持つデバイスの伝達特性 MMC 2μmの値と W の値 MMC 100、300、500nmのドレイン-ソース間電圧が8Vの場合、 V の値 th これらのデバイスのうち、それぞれ+ 0.79、-1.32、および-2.18Vでした。したがって、チャネルが狭くなるにつれて、しきい値電圧の正のシフトが発生しました。この現象は、横方向のチャネルの枯渇とビアホールの長さの表面曲げの影響による、MMCビアホールの長さの構造の側壁からの2μmのビアホールの長さの横方向のチャネルの枯渇と表面のピン止めが原因である可能性があります。

a 広いチャネルと狭いチャネルを持つAlGaN / GaNHEMTの概略図。 b 私 DS – V G L の値を持つデバイスで測定された伝達特性 MMC 2μmおよび W のさまざまな値 MMC
図4は、I DS を示しています。 –v G W の固定値を持つデバイスの転送特性 MMC 300nmの値と L の値 MMC 1、2、および6μmの。ドレイン-ソース間電圧が8Vの場合、 V の値 th それぞれ-2.12、-1.07、+ 0.46Vでした。 MMCの長さと幅がそれぞれ6μmと300nmの場合、デバイスは通常のオフ動作を実現しました。ビアホールの長さとチャネル幅を変調することで、通常はオフの動作を表示するデバイスを提供できます。表1に、さまざまなビアホールの長さとマルチメサチャネルの幅で測定されたしきい値電圧を示します。チャネル幅を500nmに固定し、ビアホールの長さを0.8から6 µmに増やした場合、 V の値は th -2.62から-1.62Vに増加し、飽和ドレイン電流は747から98 mA / mmに減少し、相互コンダクタンスは270から40 mS / mmに減少しました。チャネル幅を300nmに固定し、ビアホールの長さを0.8から6 µmに増やした場合、 V の値は th -2.15から+ 0.46Vに増加し、飽和ドレイン電流は685から6.8 mA / mmに減少し、相互コンダクタンスは290から7.4 mS / mmに減少しました。チャネル幅を100nmに固定し、ビアホールの長さを0.8から2 µmに増やした場合、 V の値は th -0.41から+ 0.79Vに増加し、飽和ドレイン電流は547から53 mA / mmに減少し、相互コンダクタンスは400から67 mS / mmに減少しました。 HEMTの電流処理能力は、キャリア濃度の影響を強く受けます[20、21]。したがって、デバイスの飽和ドレイン電流と相互コンダクタンスは、GaN HEMTの幅とビアホール長を変化させたときの、側壁の全表面状態とトライゲートチャネルの表面枯渇効果の影響を強く受けました。以前に報告されたデバイス[23]と比較して、私たちのデバイスは、低オン抵抗、通常はオフのGaNHEMTの新しいマイルストーンに到達しました。

私 DS – V G W の固定値を持つデバイスの転送特性 MMC 300nmおよび L のさまざまな値 MMC
結論
マルチメサチャネル(MMC)構造のEモードGaNHEMTを用意しました。チャネル幅とビアホール長がそれぞれ300nmと6μmの場合、0.46Vの正のしきい値電圧を示しました。横方向のチャネルの枯渇とビアホールの長さの表面の曲げの両方の影響を推測します。 MMCビアホール長構造のトライゲートを含む場合、MMC構造の幅を300 nm(以前は100 nm未満に制限)に増やした場合でも、新しいノーマルオフGaNHEMTは非常に低いオン抵抗を示しました。さらに、ビアホール長のMMC構造の変調により、通常はGaN HEMTがオフになり、MMC構造のデバイス幅が拡大した結果、優れた電力性能が向上しました。
ナノマテリアル



