GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
要約
成長温度150°CでGe含有量が固定されSn含有量が0〜16%のGeSiSn膜の組成に対する、2次元から3次元への成長(2D-3D)臨界遷移厚さの依存性が得られました。 。 Si上およびGe(100)上でのSnのエピタキシャル成長中の超構造変化の状態図が作成されました。状態図データを使用して、Si表面のSnカバーを識別し、反射高速電子線回折(RHEED)パターンで観察される上部構造のSn偏析を制御することが可能になります。 GeSiSn仮像層と、最大1.8×10 12 の密度のアイランドアレイを備えた多層構造 cm −2 GeSiSnとSiの成長温度の低下によるSn偏析抑制を考慮して成長させた。表面上のSnの存在に関連するダブルドメイン(10×1)超構造は、GeSiSn層でのSi成長中に多層周期構造で最初に観察されました。周期的なGeSiSn / Si構造は、1.45〜2μmの波長範囲に対応する0.6〜0.85eVの範囲のフォトルミネッセンスを示しました。仮像Ge 0.315 を使用した構造のバンド図の計算 Si 0.65 Sn 0.035 レイヤーにより、フォトルミネッセンスのピークが X 間のバンド間遷移に対応すると仮定できます。 Siの谷またはΔ 4 -GeSiSnの谷とGeSiSn層の重い穴のサブバンド。
背景
Siは間接バンドギャップのある半導体であるため、効果的な発光デバイスは提示されませんでしたが、導波路[1]、光検出器[2]、変調器[3]などのシリコンフォトニクスデバイスは正常に作成されました。
Ge、Si、またはGeSi固溶体のマトリックスへのSnの添加は、IV基材料に基づく直接バンドギャップ半導体を得るためのアプローチの1つです。 Ge格子にSnを含めると、Гの最小値の差が小さくなります。 および L 谷、およびGeSnは直接バンドギャップ材料になることができます。示されているように、GeSn立方格子の直接性は約9%のSn含有量で発生します[4、5]。この値は、引張ひずみが存在する場合は6%未満になる可能性がありますが、圧縮ひずみがあるフィルムの場合、Sn含有量が11%を超えると遷移が予想されます[6]。 Snを含めることによるバンドギャップの低減により、動作波長を近赤外から中赤外の範囲に増やすことができます。これは、光相互接続の分野、新世代の光ファイバー通信システム、センサー、信号処理、エネルギー変換、および光ストレージデバイス[7]。したがって、近年、Ge-Si-Sn材料のクラスへの関心が大幅に高まっています。
機器品質のエピタキシャルGeSn膜を取得するために多大な努力が注がれています[8、9]。深刻な問題の1つは、GeSn層の成長中のSn介在物(析出物)の形成です[10、11]。析出に加えて、GeSn、GeSiSn層の成長、GeSn膜の酸化の過程でSnの偏析が観察されます[11、12]。分子線エピタキシー(MBE)や化学蒸着(CVD)などの非平衡成長技術は、沈殿と偏析を抑制する信頼性の高い方法を提供します。 Snの析出と偏析の影響を低減するために、成長温度の低下[13]または変形の包含、あるいはSn原子の周囲の局所応力を低減するSiなどの3番目の元素の添加を実行できます。
単結晶GeSiSn膜の形態と表面構造、または形成メカニズムに関するデータは、グループIV化合物に基づく材料の大きな期待にもかかわらず、実際には文献にはありません。これらのデータは、歪んだリラックスしたGeSiSn層を備えたナノヘテロ構造の作成に必要です。この論文では、多層構造、仮像GeSiSn層だけでなく、GeSiSnナノアイランドを含む超格子の作成に関連するデータが最初に示され、転位を含まず、材料のバンドギャップ幅を広範囲に変化させることができます。以前はGeSiでは利用できなかった赤外線波長範囲をカバーします。
この論文の目的は、弾性応力がかかった仮像GeSiSn膜の成長、3次元ナノアイランド形成を研究し、仮像GeSiSn層とナノアイランドを含む多層周期構造を取得することです。
以前の論文[14、15、16]では、反射高速電子線回折を使用して、0〜8%のSn含有量範囲でGeSiSnとSiの間のさまざまな格子定数の不一致について形態学的GeSiSn膜状態の速度論図を作成しました( RHEED)。この記事には、0〜16%のSn含有量範囲の固定Ge含有量でのGeSiSn膜組成に対する新しい重要な2次元から3次元への遷移厚さの依存性が含まれています。 SiおよびGe(100)上でのSnの成長中の上部構造変化の状態図が得られました。 [17,18,19]で、Si上のSn表面再構成がさまざまなスズ被覆で研究されたという事実にもかかわらず、私たちのデータは新しい上部構造を示しました。さらに、Ge(100)上でのSn成長中の上部構造変化の状態図は、以前はどこにも提示されていませんでした。仮像GeSiSn層を含む多層周期構造の光学特性は、最初に異なるSn含有量のサンプルのフォトルミネッセンス法によって研究されました。 GeSiSn / Siヘテロ構造のバンド図計算は、モデル固体理論アプローチ[20]を使用して実行されました。
実験的
仮像GeSiSn層とGeSiSnナノアイランドを含むすべてのサンプルは、超高真空条件10 -7 で成長しました。 –10 -8 分子線エピタキシー(MBE)装置「KatunC」のPa。エピタキシャル成長チャンバーには、Si用の電子ビーム蒸発器とGeおよびSn用のクヌーセンエフュージョンセルがあります。 GeSiSn層の成長速度は、0.015から0.05 nm / sまで変化しました。エピタキシャル成長は、Sn含有量が0〜20%の150〜450°Cの温度範囲でSi(100)基板上に実行されました。単一のGeSiSn層だけでなく、GeSiSn / Siヘテロ接合を含む多層周期構造も得られました。最初にGeSiSn層が堆積され、次に成長温度400〜500°Cで10nmのSi層で覆われました。形態と表面構造の変化を制御し、成長メカニズムを調査する主な手法は、高エネルギー電子線回折(RHEED)の反射でした。 RHEEDパターンは、成長中にビデオカメラで記録されました。次に、結晶学的方向の1つとともにプロファイルが選択され、時空座標でのこのプロファイルの強度変化が作成されました。 RHEED時空強度分布解析により、2次元成長、超構造変化、3次元島形成のメカニズムを研究することができました。二次元から三次元への成長への遷移(2D-3D遷移)の瞬間は、ボリューム反射が現れる方向のロッドの1つに沿ったRHEEDパターン強度の時間依存性から決定されました。重要な2D-3D遷移厚のGeSiSn含有量への依存性は、2D-3D遷移決定の方法に基づいて作成されました。これらの依存性に基づいて、GeSiSn仮像層の厚さを多層構造に設定し、GeSiSnナノアイランドアレイを備えた層を作成しました。形態と表面構造は、超高真空装置Omicron-Riberで走査型トンネル顕微鏡(STM)によって分析されました。サンプルの光学特性は、ACTON 2300iモノクロメーターと感度帯域1.1〜2.2μmのInGaAsフォトダイオードアレイに基づく冷却OMA-V検出器を使用したフォトルミネッセンス(PL)分光法によって研究されました。フォトルミネッセンスを励起するために、Nd:YAGレーザー放射(532 nm)が使用されました。
結果と考察
0〜16%のSn含有量範囲での150°Cの温度での薄いGeSiSn膜の成長が研究されました。ひずみの蓄積は、GeSiSnとSiの格子定数の不一致によって引き起こされるGeSiSn層の堆積中に発生します。 2D-3D遷移からの遷移は、特定の厚さで観察されます。 Ge 0.6 の例で2D-3D遷移を決定する手順 Si 0.28 Sn 0.12 成長を図1に示します。Ge 0.6 の前のSi表面からの初期RHEEDパターンがあります。 Si 0.28 Sn 0.12 膜堆積(図1a)、Ge 0.6 によって形成された最終的なRHEEDパターン(図1c) Si 0.28 Sn 0.12 アイランドアレイと湿潤層、および図1aの矢印で示されている垂直プロファイルの時空強度分布と水平プロファイル強度の依存性(図1aの時空強度分布に示されている水平プロファイル)。 1b)Ge 0.6 Si 0.28 Sn 0.12 フィルムの厚さ(図1b)。 2D-3D遷移モーメントは、強度が急激に増加する領域の厚さ(図1b)に強度プロットの接線をプロットすることによって決定されました。このようなアプローチは一般的に受け入れられています[21]。
<画像>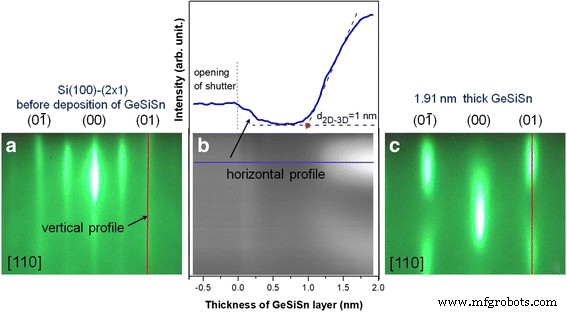
GeSiSn膜成長中の2D-3D遷移モーメントの決定: a Ge 0.6 の前のSi(100)-(2×1)表面からのRHEEDパターン Si 0.28 Sn 0.12 成長が示されています、 b グレースケールでの垂直プロファイルの時空強度分布と、堆積したGe 0.6 に対する水平プロファイルの強度依存性 Si 0.28 Sn 0.12 フィルムの厚さ。プロファイルは( a の矢印で示されます )および( b )、および c 1.91nmの厚さのGe 0.6 の後の最終的なRHEEDパターン Si 0.28 Sn 0.12 沈着
臨界2D-3D遷移厚の、固定Ge含有量および0〜16%のSn含有量のGeSiSn膜の組成への依存性は、上記の2D-3D遷移技術を使用して構築されます(図2)。以前に、GeSiSnとSiの間の異なる格子不整合で、150〜450°Cの温度範囲でのGeSiSn膜の形態学的状態の速度図が公開されました[14]。速度図分析に基づいて、150°Cの最適温度が決定されました。この温度で、臨界2D-3D遷移厚が最大値に達し、Snの偏析が抑制されます。温度と組成の臨界2D-3D遷移厚に対応する曲線の下のGeSiSn膜厚値は、仮像膜の存在領域を決定します。曲線上で、Sn含有量が0から16%に増加するとともに、臨界2D-3D遷移厚の減少が観察されます(図2)。このような挙動は、ひずみ効果によって説明されます。 Sn含有量の0から16%への増加、たとえば、Ge 0.6 Si 0.28 Sn 0.12 成長すると、Ge 0.6 間の格子定数の不一致が増加します。 Si 0.28 Sn 0.12 Siはそれぞれ2.5%から5.6%になり、時間が短縮され、その結果、3次元ナノアイランドへの遷移の厚さが減少します。 Ge含有量が30%の曲線に現れ、Sn含有量が3〜10%で最後まで観察される特徴の性質は完全には明らかではありません。臨界2D-3D遷移厚の大きさを知ることで、仮像GeSiSn膜を取得し、GeSiSn / Siヘテロ接合を備えた多層周期構造で使用することができます。私たちの実験では、臨界2D-3D遷移厚を決定する精度は0.06 nmであり、これは主に、ソース操作の不安定性によるSi流量の維持の不正確さによって決定されます。
<画像>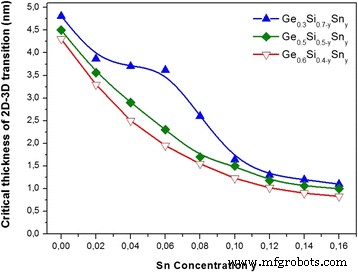
重要な2D-3D遷移厚は、Ge含有量のいくつかの固定値、0〜16%のSn含有量、および150°Cの成長温度でのGeSiSn膜組成に依存します
以前に得られた速度図[16]に基づいて仮像層の厚さを選択し、臨界2D-3D遷移の厚さを組成に依存させることで(図2)、単一のGeSiSn層だけでなく、これらの層を使用して成長させることができます。多層周期構造で。 GeSiSn層がSi層で覆われている周期的なGeSiSn / Si構造では、Si表面へのSnの偏析が原因で問題が発生します。 Snの分離は、Snの表面濃度に応じて、表面の再構成と一連の上部構造全体の出現につながります。どのSnコーティングがRHEED写真で観察された上部構造に対応するかを理解するために、Si(100)およびGe(100)上でのSn成長中の表面再構成の調査が必要でした。上部構造の変化の状態図は、100〜750°Cの温度範囲で作成されました。 Si(100)上でのSn成長の同様の図は、[17]で最初に提示されました。上田ほか室温でSnを堆積させた後、アニーリングしました。彼らは、フィルムをアニーリングした後にのみ上部構造を観察しました。私たちの実験では、Snは100°Cの温度で堆積し、再構成されたSi(100–(2×1)表面で得られました。750°Cまでの温度上昇により、表面(図3)。Sn-Si結合エネルギーに対するSi(100)表面に吸着したSn原子の位置効果は、[18]の光電子分光法によって研究されました。Sn-Si結合エネルギーの減少は、 Sn被覆が増加することにより、Si(100)上でのSn成長中に発生するすべての再構成は、表面系エネルギーの減少によって説明できます。3次元成長への移行は、ひずみの蓄積に関連しています。 [17]では、3.2 ML(単層)Sn厚膜で多結晶膜の外観が観察されました。多結晶膜の形成は、Sn膜の堆積温度が低いことが原因です。同じ理由がSnに関連していますGe(100)表面での成長。現在、Ge(100)のSn上部構造への寄与は文献に報告されていません。
<画像>
成長中の上部構造の変化の状態図: a Si(100)および b 上のSn Ge(100)上のSn
図に示されている上部構造は、温度の上昇と下降の両方で表示されます。これらの状態図は、GeSiSn層上でのSi成長時の表面のSn濃度を決定するのに役立ちます。周期的な構造成長中にSi表面に現れる超構造は、状態図に示されている温度とは異なる温度で観察できます。 Si層は、400〜500°Cの温度でGeSiSn表面に堆積します。ただし、図3に示す全温度範囲に特徴的な上部構造が現れる場合があります。 GeSiSn / Siヘテロ接合で構造を作成するには、2ドメイン(5×1)超構造の形成を防ぐ必要があります。これは、Snの偏析と、仮像層による多層周期構造形成の妨害に関連しています(図4a)。 )。 GeSiSn層上のSi成長でのSn偏析を抑制する最も簡単な方法は、2段階のSi成長です。最初の段階では、室温で1〜2nmの厚さのSi層を堆積します。さらなるSiの成長は、400〜500°Cの温度で継続します。この温度は、GeSiSn層のSn含有量によって決まります。多層周期構造のGeSiSn層でのSi成長中に発生する主な超構造系列は、(2×1)+(2×N)、c(8×4)、(4×1)、(6×1)で構成されます。 、および(5×1)。さらに、2ドメイン(10×1)の超構造がSi表面に観察されます(図4b)。この上部構造は、SiおよびGeでのSn成長の実験では現れませんでしたが、400〜500°Cの温度での短時間のアニーリング中に消失するため、最小のSnコーティングに対応すると言えます。 ×1)Si表面の特徴である超構造が現れる。
<画像>
方位角[110]方向の多層周期構造のGeSiSn層でのSi成長で観察された超構造: a (5×1)および b (10×1)
仮像層またはGeSiSnナノアイランドアレイを含む周期構造が得られました。 GeSiSn膜の形態状態の速度図を使用して、多層周期構造のGeSiSnアイランドアレイを調査しました。 Ge 0.75 のSTM写真 Si 0.2 Sn 0.05 スキャンサイズが400nm×400nmの最初の期間(図5a)と5番目の期間(図5b)のナノアイランドアレイの表面が表示されます。アイランドアレイは、250°Cの成長温度で得られました。サイズの島の数の分布のヒストグラムも図5に示されています。密度が5.18×10 11 の島 cm −2 平均サイズ8.95nmを図5cに示します。堆積したGe 0.75 Si 0.2 Sn 0.05 膜厚は1.78nmでした。第5期の平均島サイズは約4nmで、島密度は1.8×10 12 に達します。 sm −2 Ge 0.75 の有効厚さで Si 0.2 Sn 0.05 フィルム1.89nmであり、図5dのヒストグラムから得られます。密度が3.5倍に増加し、島のサイズが2倍に減少することは、周期数の増加に伴うSi表面のSnの割合の増加に関連している可能性があります。このステートメントは、GeSiSn層上でのSi膜成長中にRHEEDパターンによって観察された、(2×1)および(2×N)からc(8×4)表面構造への超構造の変化によって確認されます。 c(8×4)超構造の形成は、成長温度400°Cで0.4単分子層(ML)の被覆厚から始まり、Si上でのSn成長のプロセス中に発生します。成長温度を100°Cに下げると、島の密度を上げることができますが、表面の品質は低下します。成長温度を250°C以上に上げると、Snの偏析が促進されます。したがって、アイランドアレイを使用したGeSiSn層の最適な成長温度範囲は、150〜250°Cです。ここでは、2D成長メカニズムに対応して、GeSiSn濡れ層の成長で鏡面反射振動が観察されます。
<画像>
Ge 0.75 のSTM画像 Si 0.2 Sn 0.05 スキャンサイズが400nm×400nmの表面: a Ge 0.75 Si 0.2 Sn 0.05 最初の期間の表面、 b Ge 0.75 Si 0.2 Sn 0.05 第5期の表面; Ge 0.75 のベースのサイズにある島の数の分布ヒストグラム Si 0.2 Sn 0.05 映画: c 最初の期間(Ge 0.75 Si 0.2 Sn 0.05 膜厚は1.78nm)および d 第5期(Ge 0.75 Si 0.2 Sn 0.05 膜厚は1.89nmに等しい)
多層構造の結晶の完全性は、透過型電子顕微鏡法(TEM)によって研究されました。 Ge 0.5 を使用した多層構造のTEM画像 Si 0.45 Sn 0.05 / Siヘテロ接合と25nm周期を図6に示します。TEMデータから、サンプルには貫通転位が含まれておらず、鋭い界面を備えた完全な結晶であると結論付けることができます。多層周期構造における仮像GeSiSn膜の状態、結晶格子、およびひずみについては、TEMを使用して得られたデータ分析に基づいて[14]で説明されています。 GeSiSn膜の組成は、Si、Ge、Snの流れを設定して決定されました。 Si、Ge、Snの成長速度を石英厚さ計で測定した。 GeSiSn膜の組成は、X線回折法によって特定されました。分析は、設定された組成と測定された組成の両方の一致を示しました。
<画像>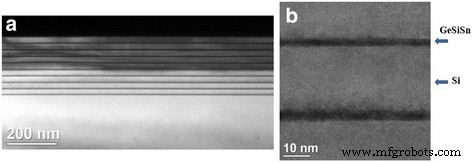
a Ge 0.5 を含む多層構造からのTEM画像 Si 0.45 Sn 0.05 25nm周期のヘテロ遷移。 b 同じ構造からの高解像度TEM画像
GeSiSn層を備えた多層周期構造の光学特性を、異なるSn含有量の構造のフォトルミネッセンスによって調査しました。構造は、0.6〜0.8 eVの範囲でフォトルミネッセンスを示しました。これは、1.45〜2μmの波長範囲に対応します(図7)。強度が最大値が0.78、0.69、0.65eVのフォトルミネッセンススペクトルが得られました。これらは1.59、1.8、および1.9 µmの波長に対応し、それぞれ3.5、4.5、および6%のSnで観測されます。 GeSiSn層のSn含有量の増加は、光学遷移のエネルギーの減少とフォトルミネッセンス強度の増加の両方につながります。強度の増加は、GeSiSn固溶体層のSn含有量が高い場合の量子井戸の深さの増加によって引き起こされる可能性があります。 2μmを超える波長範囲で前進するには、GeSiSn層のSn含有量を増やす必要があります。発光スペクトルで観察される光学遷移を決定するには、GeSiSn / Siヘテロ構造のバンド図を計算する必要がありました。
<画像>
仮像GeSiSn層のSn含有量が3.5、4.5、および6%の多層周期構造からのフォトルミネッセンススペクトル
GeSiSn / Siヘテロ構造バンド図は、モデル固体理論のアプローチを使用して計算されました[20]。このモデル内で、ヘテロ接合を形成する両方の半導体は、ヘテロ接合のバンド位置を決定するために単一の「エネルギー」スケールに置く必要があります。ヘテロ接合のGe / Siヘテロ構造の原子価バンドギャップ値はよく知られており[22]、0.54eVに相当します。さらに、Geの価電子帯はSiの価電子帯よりもエネルギー上にあります。 GeとSnの間のバンドギャップは、[23]に示されているモデルから知られており、0.69 eV [24]です。したがって、Si / Si 1-x-y のヘテロ界面のバンドギャップ値 Ge x Sn y ヘテロ構造は次のように書くことができます:
$$ {E} _ {v、av} =0.54x + 1.23y $$半導体の価電子帯は、重い正孔と軽い正孔のサブバンドによって形成され、スピン軌道相互作用によって分割されたサブバンドによっても形成されるため、次に、価電子帯の位置( E v、av )3つのサブバンドで平均化されたものは、バンドギャップとヘテロ構造バンド図の構成を決定するために使用されます。重い穴と軽い穴のサブバンドの位置、およびスピン軌道相互作用によって分割されたサブバンドを決定するには、次の式を使用します。
$$ {\ displaystyle \ begin {array} {l} {E} _ {\ mathrm {HH} \ left(\ mathrm {LH} \ right)} ={E} _ {v、av} + {\ Delta} _0 / 3 \\ {} {E} _ {\ mathrm {SO}} ={E} _ {v、av} -2/3 {\ Delta} _0 \ end {array}}、$$ここで、HH、LH、およびSOインデックスは、重い穴と軽い穴のサブバンド、およびスピン分割されたサブバンドを示します。 Δ 0 値は、半導体のスピン軌道相互作用エネルギーを示します。ヘテロ接合の価電子帯サブバンドの位置を決定した後、対応する伝導帯の谷の位置は、次の式を使用して決定されます。
$$ {E} ^ n ={E} _ {\ mathrm {Ge}} ^ n \ left(1-xy \ right)+ {E} _ {\ mathrm {Si}} ^ nx + {E} _ {\ mathrm {Sn}} ^ ny- {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ nx \ left(1-xy \ right)-{b} _ {\ mathrm {Sn} \ mathrm {Ge }} ^ ny \ left(1-xy \ right)-{b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ n xy、$$ここで、インデックスは n =Γ 、 L 、および X 対応する谷を示します\({b} _ {\ mathrm {SiGe}} ^ n \)、\({b} _ {\ mathrm {SnGe}} ^ n \)、および\({b} _ {\ mathrm {SiSn}} ^ n \)-「お辞儀」パラメータ。バンドギャップ幅の線形法則からの偏差を考慮に入れて、\({E} _ {\ mathrm {Ge}} ^ n \)、\({ E} _ {\ mathrm {Si}} ^ n \)、および\({E} _ {\ mathrm {Sn}} ^ n \)-対応する谷のGe、Si、およびSnバンドギャップ。ほとんどすべてのパラメータは[24]から取得されます。谷の曲がりパラメータ L およびГ [25]から取得されます。
ヘテロ接合におけるすべての対象バンドの位置を決定した後、変形の影響下でのそれらの変位を考慮に入れました。バンドギャップに対する変形の影響は、変形ポテンシャル定数によって考慮されました[26]。二次元層は仮像であったため、この場合、標準的なアプローチを使用して変形を決定しました。これは、たとえば[26]で説明されています。量子井戸平面のひずみはε> xx(yy) =ε ǀǀ =( a GeSiSn − a Si )/ a Si 、ここで a -対応する材料の格子定数。量子井戸の平面に垂直な方向では、ひずみ値ε zz =−2(С 12 / С 11 )ε xx C で判断できます 12 および C 11 結晶性化合物の弾性モジュール。固溶体の格子定数は二次関係から決定されました:
$$ {a} _ {\ mathrm {Ge} \ mathrm {SiSn}} ={a} _ {\ mathrm {Ge}} \ left(1-xy \ right)+ {a} _ {\ mathrm {Si} } x + {a} _ {\ mathrm {Sn}} y + {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ {\ hbox {'}} x \ left(1-x \ right)+ { b} _ {\ mathrm {Sn} \ mathrm {Ge}} ^ {\ hbox {'}} y \ left(1-y \ right)、$$ここで a Ge 、 a Si 、 a Sn ––ge、Si、およびSn格子パラメーター[24]、\({b} _ {\ mathrm {SiGe}} ^ {\ hbox {'}} \)=−0.026Å、\({b} _ {\ mathrm {SnGe}} ^ {\ hbox {'}} \)=0.166Å––«お辞儀»パラメータ、ベガード則からの逸脱を考慮。
バンド図の計算に基づくと、PLピークは、SiのXバレーまたはΔ 4 間のバンド間遷移に対応します。 -GeSiSnの谷とGeSiSn層のヘビーホールバンド(図8)。
<画像>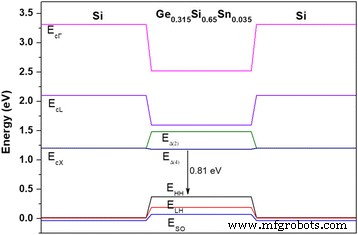
Si / Ge 0.315 Si 0.65 Sn 0.035 / Siヘテロ組成バンド図
結論
150°Cの成長温度で0から16%まで変化する固定Ge含有量とSn含有量のGeSiSn層の組成に対する重要な2D-3D遷移厚さの依存性が決定されました。 Si(100)およびGe(100)上でのSnのエピタキシャル成長の超構造状態図を作成しました。仮像層と最大1.8×10 12 の密度のGeSiSnアイランドアレイを備えた多層周期構造 sm −2 得られました。初めて、GeSiSn層上でのSi成長中の多層周期構造で、わずかなアニーリングで(2×1)超構造に変化する(10×1)2ドメイン超構造が観察されました。 GeSiSn / Si周期構造は、0.6〜0.8 eVの範囲でフォトルミネッセンスを示しました。これは、1.45〜2μmの波長範囲に対応します。仮像Ge 0.315 を使用した構造のバンド図計算に基づく Si 0.65 Sn 0.035 層の場合、PLピークは、SiのXバレーまたはΔ 4 間のバンド間遷移に対応します。 -GeSiSnの谷とGeSiSn層のヘビーホールバンド。長波領域でさらに進歩するには、Sn含有量の多い構造の光学特性を調査する必要があります。
略語
- CVD:
-
化学蒸着
- MBE:
-
分子線エピタキシー
- ML:
-
単層
- PL:
-
フォトルミネッセンス
- RHEED:
-
反射高速電子線回折
- STM:
-
走査型トンネル顕微鏡
- TEM:
-
透過型電子顕微鏡
ナノマテリアル
- 半導体ナノ粒子
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- 小さなセレンナノ結晶とナノロッドの容易な合成と光学的性質
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- 微結晶およびナノセルロースの構造と誘電特性に及ぼす水の影響
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- 界面層の設計によるZnO膜の表面形態と特性の調整
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- 分子線エピタキシー法を用いたGeBi膜の作製と光学的性質
- スパイラル型アンテナによるマイクロブリッジ構造のTHzマイクロボロメータの周波数変調と吸収改善



