p-Si太陽電池の正孔選択的接点としての熱蒸着MoOX薄膜の光学的および電子的性質に対するポストアニーリング効果
要約
その大きな仕事関数により、MoO X 薄膜太陽電池と結晶シリコン太陽電池の両方で、正孔選択的接触に広く使用されています。この作業では、熱蒸発したMoO X p の裏側にはフィルムが採用されています タイプの結晶シリコン( p -Si)太陽電池。MoO X の光学的および電子的特性 フィルムおよび対応するデバイスの性能は、ポストアニーリング処理の関数として調査されます。 MoO X 100°Cでアニールされたフィルムは、最高の仕事関数を示し、エネルギーバンドシミュレーションと接触抵抗率測定の結果に基づいて、最高の正孔選択性を証明します。フルリア p -Si / MoO X / Ag接触太陽電池は、19.19%の効率で最高の性能を発揮します。これは、MoO X の複合的な影響の結果です。 の穴の選択性と不動態化能力。
はじめに
遷移金属酸化物は、欠陥のあるZrO 2 の3.5eVに及ぶ、幅広い仕事関数を持っています。 化学量論的V 2 の場合は7.0eVまで O 5 [1,2,3,4,5,6]。その中で、MoO X は、その高い透明性、非毒性、および適度な蒸発温度[10、11]により、オプトエレクトロニクスデバイス[7、8、9]でのアプリケーション向けに最も広く研究されている材料の1つです。 MoO X は〜6.7 eVの大きな仕事関数を持っていると報告されており、光起電力デバイス[12]、発光デバイス[13]、センサー[14、15]、メモリ[16]の正孔抽出層として広く使用されています。 MoO X を含む光電デバイス用 正孔抽出層の場合、デバイスの性能は、MoO X の光学的特性と電子的特性の両方に強く依存します。 薄膜。太陽光発電分野では、MoO X 薄膜は最初に有機デバイスに適用されました[17、18、19]。近年、MoO X の応用について多くの研究が行われています。 フィルムから結晶シリコン( c -Si)太陽電池[9、20、21、22]。 c のイオン化エネルギー -Siは約5.17eVであり、これは穴選択接触材料の仕事関数の下限です[23]。 MoO X の高い仕事関数 c で大きなバンドベンディングを誘発します -Si / MoO X インターフェースし、 p に穴が蓄積するようになります -タイプシリコン( p -Si)または n の電子の枯渇 -タイプシリコン( n -Si)、したがって、正孔輸送を支持します[24]。 p を置き換えることによって MoO X を備えたタイプのアモルファスシリコン層 古典的なシリコンヘテロ接合太陽電池のフィルム、電力変換効率( PCE )23.5%が達成されました[25]。 MoO X との比較 n への連絡 p 用に作られたタイプのウェーハ タイプのウェーハ(アモルファスSi層なし)は、表面パッシベーションと接触抵抗率の点で優れた性能を示します[24]。 MoO X の実現可能性 p の穴選択接点としてのフィルム -Si太陽電池は以前の研究[26]で実証されており、 p に基づいて20.0%の効率が達成されました。 -Si / SiO X / MoO X / V 2 O X / ITO / Agリアコンタクト[27]。
MoO X (X≤3)は、バルク電子構造の閉じたシェル特性と、その内部層構造によって作成された双極子のために、大きな仕事関数を持っています[28]。酸素空孔欠陥の存在は、MoO X の仕事関数を減少させます [4]結果は n -タイプの材料[29]。数値シミュレーションは、MoO X のより高い仕事関数を示しました 良好なショットキー障壁の高さとMoO X での反転を誘発しました /固有のa-Si:H / n -タイプ c -Si( n -Si)インターフェース、ホールの抵抗が最小のパスを刺激します[30]。したがって、MoO X の電子構造と仕事関数を調整します。 接触を不動態化するために非常に重要です c -Si太陽電池。
MoO X 膜は、原子層堆積[30,31,32,33,34]、反応性スパッタリング[12]、パルスレーザー堆積[35]、熱蒸着[24、36]およびスピンコーティング[37]によって堆積することができます。 Si / MoO X に基づくほとんどの太陽電池研究では 連絡先、MoO X フィルムは室温での熱蒸着によって調製されます[8]。 MoO X のプロパティの可制御性のため 熱蒸着によるフィルムは限られており、熱蒸着されたMoO X の仕事関数を調整するために、後処理のさまざまな方法が研究されました。 。 UV-オゾン曝露は、蒸発したMoO X の仕事関数を増加させる可能性があります 5.7eVから6.6eVの金基板上のフィルム[8]。 Irfan etal。 MoO X の空気アニーリングを実行 金基板上に300°Cで20時間フィルムを貼り付けたところ、基板からMoO X に向かって金が拡散するため、長時間のアニーリングでは酸素空孔の低減に役立たないことがわかりました。 映画[38]。 MoO X の仕事関数 p の映画 -タイプ c -Si( p -Si)は、 in situ 後に減少することがわかりました 300〜900Kの温度範囲での真空アニーリング[39]。
この作品では、 p -MoO X を備えたSi太陽電池 背面の不動態化接点が構成されています。光学的および電子的特性、ならびにポストアニーリングされたMoO X の影響 p の映画 -Si / MoO X 太陽電池は、実験とエネルギーバンドシミュレーションを通じて体系的に調査されます。仕事関数とO / Mo原子比の間に線形関係が見られます。真性サンプルと比較して、仕事関数が高い100°Cでアニールされたサンプルは、SiO X が厚いにもかかわらず、接触抵抗率が低くなっているのは興味深いことです。 中間層。エネルギーバンドシミュレーションによると、MoO X の変動 の仕事関数は、 p のバンドベンディングに少し影響します。 -Si、MoO X のバンドベンディング中 その仕事関数が増加するにつれて大幅に増加します。したがって、 p からの効果的な正孔輸送には、より高い仕事関数が不可欠であることが示唆されています。 -SiからMoO X ここで、界面SiO X 層は適度な厚さの範囲にあります。私たちの結果は、 p のインターフェース特性の貴重な詳細を提供します -Si / MoO X 酸化物ベースのキャリア選択接点を備えた高性能ヘテロ接合太陽電池を考慮して。
メソッド
膜の堆積、アニーリング後のプロセス、太陽電池の製造
太陽電池は p で製造されます -type <100> CZウェーハ。抵抗率は〜2Ω・cm、ウェーハの厚さは170μm。シリコンウェーハは、NaOHとH 2 の混合溶液で前洗浄されています。 O 2 その後、NaOH溶液でテクスチャリングします。次に、ウェーハを脱イオン水(DI水)で洗浄した後、希フッ化水素酸(HF)に1分間浸します。高濃度にドープされたn + 前面( N D ≈4×10 21 cm -3 )は、POCl 3 からリンを拡散させることによって実現されます。 石英炉のソース。二層のSiN X :Hパッシベーションおよび反射防止コーティングは、プラズマ化学気相成長法(PECVD)によって堆積されます。銀ペーストは、選択的エミッターを使用して太陽電池にスクリーン印刷されます[40]。続いて、850°Cで約1分間、ファイアスループロセスが実行されます。その後、オーミック接触により抵抗率が低くなります[41]。各サンプルの背面は、MoO X の前に希薄なHFですすがれます。 沈着。 MoO X フィルムは、8×10 –4 の下で約0.2Å/ sの堆積速度で裏面で熱蒸着されます。 Pa [26]。室温で堆積したMoO X のアニーリング後処理 フィルムは、空気中の高速サーマルプロセッサーで実行されます。 10秒で設定温度に達し、5分間保持されました。 MoO X 異なるアニーリング温度のフィルムが p に適用されます -フルリアMoO X を備えたSi太陽電池 / Agの連絡先。
測定値
MoO X の透過率スペクトル 厚さ1.2mmのシリカガラス上に堆積した膜は、積分球を備えたUV-Vis分光計を使用して測定されます。フィルムの表面形態と粗さは、原子間力顕微鏡(AFM)によって測定されます。 MoO X の光学特性 フィルムは分光エリプソメトリー(J.A. Woollam Co.、Inc.、M2000Uエリプソメーター)を使用して分析され、測定結果は自然酸化物モデルを使用してフィッティングされます。 Mo3dおよびSi2pの高分解能X線光電子分光法(XPS)は、光子エネルギーが1486.7eVの単クロム酸AlKαX線を使用して測定されます。紫外光電子分光法(UPS)スペクトルは、フィルター処理されていないHe I 21.22 eV励起を使用して記録され、サンプルは-10eVにバイアスされています。 XPSおよびUPSが検出する前に、サンプルの表面はアルゴンイオンで事前に洗浄されていました。
p での接触抵抗率 -Si / MoO X インターフェースは、Cox and Stack法[42]によって抽出されます。これには、異なる直径のフロントAg接点を備えたプローブステーションでの一連の抵抗測定が含まれます。 MoO X のパッシベーション品質 さまざまな厚さのフィルムは、準定常状態の光コンダクタンス(QSSPC)法による有効寿命測定から決定されます。 QSSPCテストのサンプルは、前面がテクスチャ化されているため非対称です。 n + 二層SiN X によってドープおよび不動態化 :Hフィルム[43]、背面はMoO X で覆われています 映画[26]。太陽電池の電流密度-電圧特性(3.12×3.12cm 2 )は、標準的な1つの太陽の条件(100mW・cm -2 )で測定されます。 、AM1.5Gスペクトル、25°C)、光度は認定されたフラウンホーファーCalLabリファレンスセルで校正されています。
シミュレーション
p のバンド構造の数値シミュレーション -Si / MoO X 接触は、1次元ポアソン方程式と2つのキャリア連続方程式を解くことに基づくAFORS-HETを使用して行われます[44]。主なパラメータを表1に示します。前面と背面の接触境界は、金属の仕事関数をフラットバンドに固定するように設定されています。 p 間のインターフェース -SiおよびMoO X 「熱電子放出」(数値モデルの1つ)として設定されます。薄いSiO 2 のトンネリング特性 フィルムは通常、金属/半導体ショットキー接触の場合にのみ、「熱電子放出」モデルの下で界面パラメータを変更することによって設定されます。したがって、実際に存在するトンネリングSiO X Si / MoO X で インターフェイスは省略されています。 p の場合 -Si、総トラップ密度を伴う中心エネルギーでの電気的中性欠陥は、1×10 14 に設定されます。 cm -3 。 MoO X の場合 、総濃度のドナー型伝導テール欠陥は1×10 14 に設定されています。 cm -3 。
<図>結果と考察
図1aは、厚さ10nmのMoO X の写真を表しています。 さまざまな温度(100°C、200°C、300°C)で空気中で5分間アニールしたシリカガラス上のフィルム。すべてのサンプルは視覚的に無色透明です。図1bの対応する光透過率スペクトルから、100°CでアニールされたMoO X の透過率スペクトルがわかります。 フィルムは、アニールされていないフィルムのフィルムとほとんど重なっています。アニーリング温度が高くなると、600〜1100 nmの範囲で透過率が低くなります。これは、酸素空孔によって引き起こされる自由キャリアの吸収に起因する可能性があります[46]。より厚いMoO X 屈折率を測定するために、研磨されたSiウェーハ上にフィルム(20 nm)が堆積されます n および吸光係数 k より正確に。図1cの屈折率は1.8〜2.5の範囲にあり、他の研究と一致しています[31、32]。 n 曲線と k 曲線(図1d)は、4つのサンプル間で少し違いがあります。 n 20nmの厚さのフィルムの633nmでわずかに減少します。これは、表2にまとめられています。
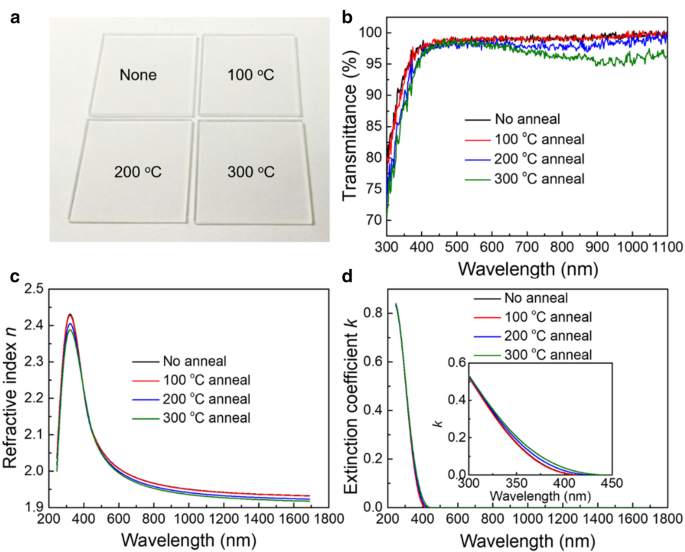
a 写真と b 厚さ10nmのMoO X の透過率スペクトル さまざまな温度で5分間空気中でアニールされたシリカガラス上のフィルム。 c 屈折率 n および d 吸光係数 k 厚さ20nmのMoO X の曲線 研磨されたシリコンウェーハ上のフィルム
次に、追加ファイル1:図S1に示すように、表面形態はAFMによって特徴付けられます。対応する二乗平均平方根(RMS)の粗さを表2に示します。堆積したままの厚さ10nmのMoO X 薄膜(追加ファイル1:図S1a)のRMS粗さは4.116 nmで、これは波状の表面形態と一致しています。アニーリング温度が高くなると(追加ファイル1:図S1b–d)、MoO X の表面のうねりが発生します。 フィルムは大きくなりますが、特徴的な構造は小さくなり、おそらくデウェッティングプロセスのためにはるかに高密度になります[47]。 300°Cでアニーリングした後、RMS粗さは12.913nmに達します。厚さ20nmのフィルムは粗くなく、RMSは約1 nmです(表2)。アニーリング処理の関数としてのRMS測定によって示されるように、デウェッティングプロセスも抑制されます。上記の形態変化は、MoO X であるデバイスレベルでの酸化膜の変化を完全には反映していません。 膜はSi上に堆積され、Ag電極でキャップされますが、形態の進化により、MoO X の固有の特性が得られます。 SiO 2 表面。
MoO X 酸素空孔欠陥を形成する自然な傾向があり[48]、分子構造に影響を与える可能性があります。このような空孔に関連する分子構造の変化を特定するために、MoO X でラマン分光測定が行われます。 (20 nm)/ Si(<100>)。 MoO X の特徴的なピークはありません 緑色光(532 nm)励起下のラマンスペクトル(追加ファイル1:図S2)で、熱処理とは無関係です。励起を325nmの紫外線に変更すると、MoO X の特徴的なバンド 表示されます。通常、600〜1000 cm -1 にあります。 (図2)。 515 cm -1 の鋭いピーク すべてのサンプルで、Si–Si結合に対応しています。固有の100°CでアニールされたMoO X の場合 フィルム、ラマンバンドは695、850、965 cm -1 に存在します 、[Mo 7 からのもの O 24 ] 6- 、[Mo 8 O 26 ] 4- 陰イオン、および(O =) 2 Mo(–O–Si) 2 それぞれジオキソ種[49]。フィルムを200°Cでアニールすると、965 cm -1 バンドが970cm -1 にシフトします 、Mo(= 16 に割り当てられます O) 2 ジオキソ種[50]。 300°CでアニールされたMoO X のラマンスペクトル 映画は695、810、980 cm -1 のバンドを示します 。 810 cm -1 のバンド (O =) 2 がSi–O–Si結合からのものです Mo(–O–Si) 2 980 cm -1 でバンドに貢献します 。結果は、異なる温度でのアニーリングがMoO X の化学組成に影響を与えることを示しています。 フィルム。各サンプルの酸素空孔濃度の違いを示している可能性があります。
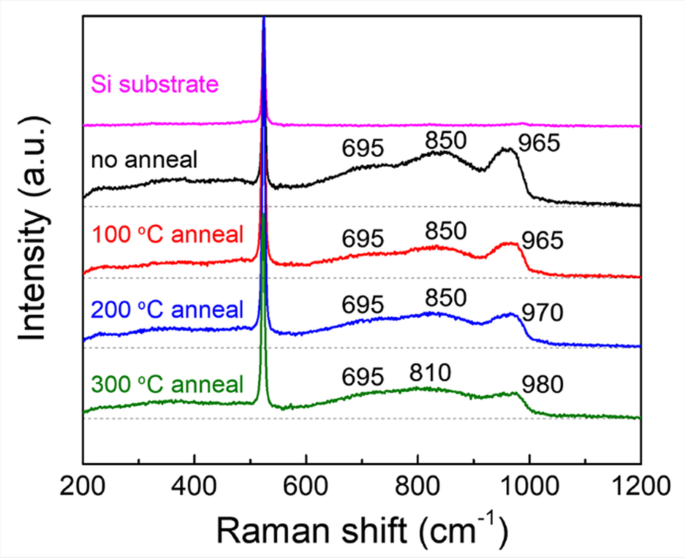
ポストアニーリングされた厚さ20nmのMoO X のUVラマン(325 nm)スペクトル 研磨されたシリコンウェーハ上のフィルム
XPSはMoO X で実施されます フィルム(10 nm)を使用して、各酸化状態の相対的な含有量と、酸素とモリブデン(O / Mo)の原子比を定量化します。シャーリーバックグラウンドの減算とガウス-ローレンツ曲線によるフィッティングの後、XPSスペクトルのマルチピークデコンボリューションが実行されます。 Mo 3dコアレベルは、ダブレットスピン軌道相互作用Δで2つのダブレットピークに分解されます。 BE 3.1 eVおよび3:2のピーク面積比[11]。図3に示すように、Mo 6+ のピーク 3d 5/2 コアレベルは〜233.3eVの結合エネルギーに集中します。すべてのサンプルで、〜232.0eVの2番目のダブレット。これはMo 5+ として示されます。 、は、実験データによく適合するために必要です[8]。 O / Mo比は、次の式[51]で計算されます。
$$ X =\ frac {1} {2} \ cdot \ frac {{\ mathop \ sum \ nolimits_ {n} n \ cdot I({\ text {Mo}} ^ {n +})}} {{\ mathop \ sum \ nolimits_ {n} I({\ text {Mo}} ^ {n +})}} $$ここで私 (Mo n + )は、Mo3dスペクトルからの個々の成分の強度です。 n Moイオンの原子価状態に関連します。つまり、Mo 5+ の場合は5です。 Mo 6+ の場合は6 。係数1/2は、各酸素原子が2つのモリブデン原子によって共有されているためです。
表3にリストされているすべてのサンプルのO / Mo比は3未満です。遷移金属酸化物の堆積中に、酸素損失と酸化状態の遷移が報告されています[1]。 XPS測定は生息域外で行われるため、熱蒸発したMoO 3 への空気暴露 室温のフィルムも酸素空孔を増加させる可能性があります[18、52]。アニールされていないMoO X のO / Mo比 フィルムは2.958ですが、100°Cでのポストアニーリングにより値は2.964に増加します。その後、アニーリング温度を高くすると、O / Mo比が徐々に低下します。 100°Cでアニールされたサンプルの最高のO / Mo比は、空気からMoO X に注入された熱活性化酸素によって説明される可能性があります。 映画[38]。追加ファイル1:図S3は、厚さ10nmのアニールされたMoO X のSi2pXPSスペクトルを比較しています。 映画。アニールされていないサンプルのSi2p XPSスペクトルは、シリコン元素とSi 4+ の二重ピークを示しています。 ピーク。 Si 2+ 100°Cでアニーリングするとピークが現れます。 200および300°Cでアニールすると、Si 4+ のピークが発生します。 、Si 3+ およびSi 2+ 同時に存在します。さらに、SiO X で計算されたX 4つのサンプルの場合、それぞれ2、1.715、1.672、1.815です。 SiO X の酸素原子 MoO X からのものです;したがって、O / Mo比は、酸素を取り込むSiOxと酸素を注入する空気のバランスに依存します。ちなみに、焼鈍温度が高くなると、Si元素の信号が弱くなり、SiO X が厚くなることを示しています。 中間層[26]。
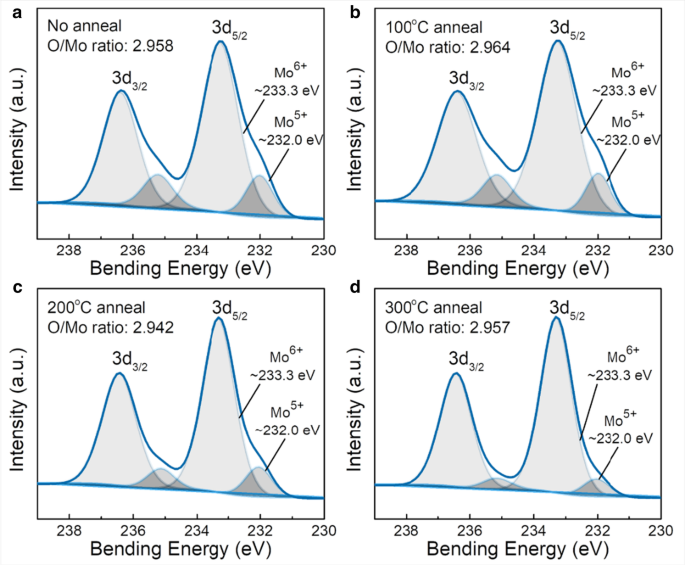
厚さ10nmのMoO X のMo3dコアレベルXPSスペクトル シリコンウェーハ上のフィルム a ポストアニーリングなし、 b でのポストアニーリングあり 100°C、 c 200°Cおよび d 300°C
酸化物の陽イオン酸化状態を低下させると、その仕事関数が低下する傾向があります[1]。 UPSは、MoO X の仕事関数を計算するために使用されます。 熱処理の関数としてのフィルム。図4aは、UPSスペクトルの二次電子カットオフ領域を示しています。この領域から、仕事関数の小さな振動が見られます。図4bから、ポストエアアニーリング後、価電子帯領域[37]の欠陥ピークが弱くなることがわかります。表3に、XPSフィッティングから評価されたO / Mo比と、研磨されたシリコンウェーハ上のサンプルのUPS二次電子カットオフから評価された対応する仕事関数を示します。 MoO X の仕事関数と化学量論の結果 図4cにも示されています。ここでは、強い正の相関関係が示されています。 O / Mo比を2.942から2.964に増やすと、仕事関数が約0.06eV増加します。

a 二次電子カットオフ領域と b ポストアニーリングされたMoO X のUPSスペクトルからの価電子帯 シリコンウェーハ上のフィルム。 c 化学量論(O / Mo比)に対してプロットされた仕事関数
MoO X を適用する前に p の不動態化接触としての映画 -Siウェーハ、AFORS-HET [44]を使用して一次元エネルギーバンドシミュレーションを実行し、 p の鮮明な画像を取得します。 -Si / MoO X ヘテロコンタクト。 p の厚さ -SiおよびMoO X フィルムはそれぞれ1μmと10nmに設定されています。 p のアクセプター濃度 -Siは1×10 16 です cm -3 、結果として4.97eVの仕事関数になります。 MoO X 以降 n です タイプの材料[53]、酸素空孔濃度の変化は、1×10 16 の範囲でドナー濃度を変更することによってシミュレートされます。 cm -3 〜1×10 20 cm -3 。図5aは、MoO X の仕事関数とドナー濃度を示しています。 指数関数的に相関しています。図5c、dは、シミュレートされたバンド構造をドナー濃度( N )として示しています。 D )MoO X の は1×10 16 および1×10 20 cm -3 、 それぞれ。 p の両方のバンド -SiおよびMoO X 仕事関数の違いとフェルミエネルギー平衡のために曲がっています。効率的なキャリア抽出には、 p の価電子帯に光生成された正孔が必要です。 -SiはMoO X に存在する電子と再結合します 隣接する金属電極から注入される伝導帯[7、54]。 p で曲がるバンド -Si、MoO X バンドの全曲がりは図5bに示されています。 MoO X の仕事関数として ( WF MO )変更、 p のバンド機能に明らかな変更はありません -Si。対照的に、MoO X のバンドベンディング 電子注入に適したビルトイン電界を表す、は、仕事関数が増加するにつれて増加します。 MoO X の増加は 仕事関数は p の全バンドベンディングを上げます -Si / MoO X 連絡先、そのほとんどはMoO X にあります 部。したがって、MoO X の高い仕事関数 p での電子注入の観点から望ましい -Si / MoO X インターフェイス。
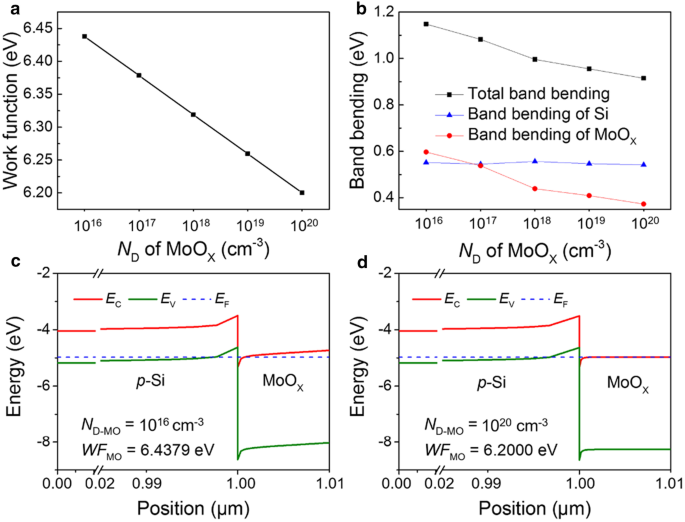
p のシミュレートされたエネルギーバンドの結果 -Si / MoO X コンタクト。 a 仕事関数と N の関係 D MoO X の ( N D-MO )。 b p -Si、MoO X p のバンドの全曲がり -Si / MoO X コンタクト。 p のアクセプター濃度 -Siは1×10 16 です cm -3 。 p のシミュレートされたバンド図 -Si / MoO X N として連絡する D-MO は c 1×10 16 cm -3 および d 1×10 20 cm -3 、それぞれ
図6は、暗い I–V を示しています p の特徴 -Si / MoO X CoxおよびStrack方式を使用した連絡先(概略図については、追加ファイル1:図S4を参照)[42]。 I–V の傾き ドット電極の直径が大きくなると曲線が大きくなります。 I-V アニールされていないサンプルと100°Cでアニールされたサンプルの曲線は線形であり、特定の接触抵抗率(ρ c )0.32および0.24Ω‧cm 2 として取り付け 、 それぞれ。 100°Cでアニーリングすると、SiO X p のレイヤー -Si / MoO X インターフェースが厚くなり、 WF MO アニールされていないMoO X よりも高い フィルムであるため、対応するサンプルは最良の正孔輸送特性を示しています。 I-V 200および300°Cでアニールされたサンプルの曲線は、小さなドット直径で非線形になり、オーミック接触とは見なされませんでした。 100°Cでアニーリングされたサンプルと比較して、より高いアニーリング温度でアニーリングされたサンプルは、より低い電流を持っています。仕事関数のわずかな低下として、主な理由は、より高いアニーリング温度がより厚いSiO X を引き起こすことです。 p のレイヤー -Si / MoO X インターフェースにより、キャリアが酸化物バリアをトンネリングするのがより困難になります。
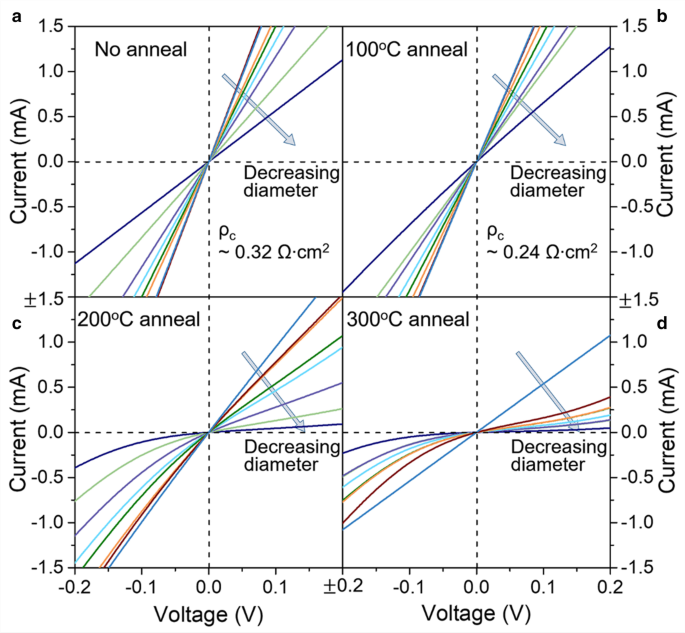
厚さ10nmのMoO X の接触抵抗測定 研磨されたシリコンウェーハ上のフィルム a ポストアニーリングなし、 b でのポストアニーリングあり 100°C、 c 200°Cおよび d 300°C
MoO X のパッシベーション品質 (10 nm)/ p -熱処理の関数としてのSiヘテロ接合は、有効な少数キャリアの寿命(τ)の観点から特徴付けられます。 eff )。注入レベルに依存するτ eff sは、追加ファイル1:図S5に示されています。ここで、τ eff s注入レベル1×10 15 cm -3 表3にリストされています。アニールされていないMoO X 映画は最高の不動態化能力を示しています。処理温度が高いほど、τは低くなります eff 、これは、界面SiO X の化学的不動態化の複合結果です。 およびMoO X の電界効果パッシベーション 、SiO X の大きいXとして シリコンのダングリングボンドが少なく、MoO X のXが大きいことを意味します 内蔵電界強度が大きいことを意味します。
MoO X その後、映画は p に採用されます -Si / MoO X (10 nm)/ Ag構成(図7a)を使用して、MoO X の影響を調査します。 デバイスのパフォーマンスに関するの電子特性。光電流密度対電圧( J–V )曲線を図7bに示します。平均的な J–V 特性を図7c–fに示します。低い V OC アニーリング後のsは、より低いτと一致しています。 eff 。 MoO X のセルを除くすべてのセル 300°Cでアニーリングし、同様の J を共有します SC (〜38.8mA / cm 2 )、これはMoO X の光学屈折率のわずかな違いを意味します 界面SiO X の厚さの変化 長波長範囲でのバルクシリコンの有効光吸収にはほとんど影響しません。最高の PCE アニールされていないMoO X を使用した太陽電池の製造 映画は18.99%で、これは以前のレポート[26]と同様です。 PCE 100°Cのアニーリングを適用すると、19.19%が達成されます。 PCE 改善は主に高いフィルファクター( FF )直列抵抗が減少しました。これは、図6bの低い接触抵抗と一致しています。穴の非効率的な輸送は、 FF の減少につながります 、これは300°Cのアニーリングを備えたデバイスで顕著です。より高いアニーリング温度は PCE につながります 減少した V に起因するドロップ OC (MoO X の劣化した電界効果パッシベーション )および FF (より厚いSiO X 中間層は、キャリアトンネリングの確率を低下させます)。 MoO X として 薄膜はAg電極で覆われているため、性能の低下は主にMoO X での高温による元素拡散に起因する可能性があります。 以前のレポート[26]で示されている/ Agインターフェース。 MoO X へのAg原子の拡散 MoO X が減少します 金属からMoO X への電子の移動により、フェルミ準位が平衡状態で整列するため、の仕事関数 [19、55、56]。
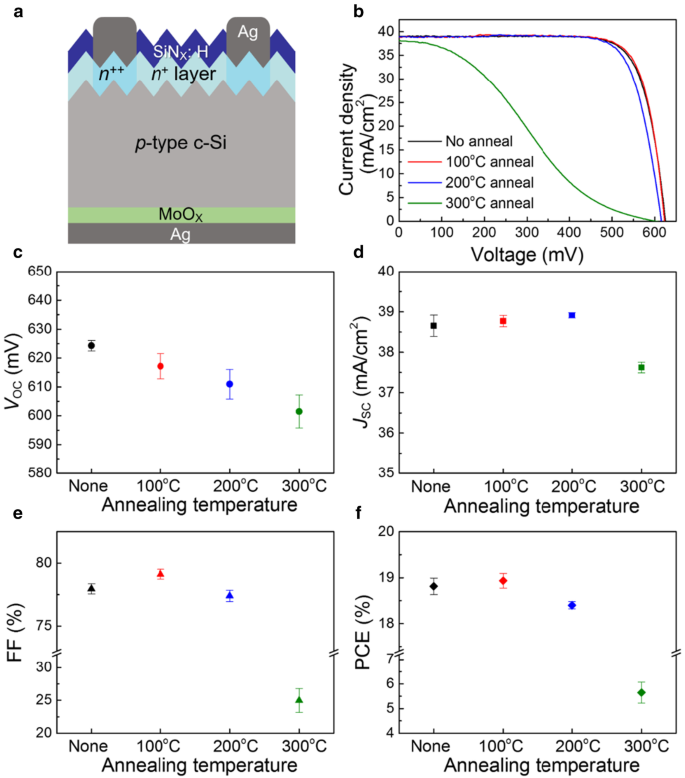
a 断面図、 b J–V 曲線と c–f 平均 J–V p のパラメータ -Si / MoO X / Ag太陽電池とMoO X さまざまな温度でアニールされたフィルム
全体として、 p のパフォーマンス -Si / MoO X ヘテロ接合太陽電池は、正孔選択性MoO X のパッシベーション品質、仕事関数、およびバンド間トンネリング[34]特性の影響を受けます。 映画。現在の構造のパッシベーション性能はまだ低く、 V が比較的低くなっています。 OC 。したがって、効率的な表面パッシベーションは、ドープされていないキャリア選択的接触の研究の焦点となります。
結論
要約すると、MoO X 異なる温度でのポストアニーリングにより、異なる酸素空孔濃度のフィルムが得られた。 MoO X のO / Mo原子比 フィルムは仕事関数と直線的に関連しています。固有のMoO X と比較 100°Cでアニールされたフィルムは、酸素空孔が少なく、仕事関数が高くなっています。エネルギーバンドシミュレーションは、 p のバンドベンディングを示しています - p のSi -Si / MoO X MoO X の仕事関数の場合、接触は基本的に同じです。 6.20eVから6.44eVまで変化します。それにもかかわらず、仕事関数が大きくなると、MoO X のバンドベンディングが増加します。 映画。実験結果は、MoO X の適度に改善された仕事関数を示しています 100°Cでアニールすると、正孔選択性に適しています。最適化されたフルリア p を備えた対応する太陽電池 -Si / MoO X / Agコンタクトは PCE を達成しました 19.19%の。
データと資料の可用性
現在の調査中に使用および分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- c -Si:
-
結晶シリコン
- p -Si:
-
p -結晶シリコンタイプ
- n -Si:
-
n -「 c 」と入力します -Si
- PCE:
-
電力変換効率
- AFM:
-
原子間力顕微鏡
- XPS:
-
X線光電子分光法
- UPS:
-
紫外光電子分光法
- QSSPC:
-
準定常状態の写真コンダクタンス
- RMS:
-
二乗平均平方根
- WF:
-
仕事関数
- FF:
-
フィルファクター
ナノマテリアル
- 色素増感太陽電池用のナノツリー
- 太陽電池用のナノヘテロ接合
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- 色素増感太陽電池の光学的および電気的特性に及ぼすTiO2中の金ナノ粒子分布の影響
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- 着色された低温顔料用のCrドープTiO2の構造的および可視近赤外光学特性
- 分子線エピタキシー法を用いたGeBi膜の作製と光学的性質
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- 赤外領域におけるAlドープZnO膜の光学的性質とそれらの吸収への応用
- ペロブスカイト太陽電池の光起電力特性に及ぼすさまざまなCH3NH3PbI3形態の影響
- InP / ZnS量子ドット膜の光学特性に及ぼすポストサーマルアニーリングの影響



