分子線エピタキシーによりGaAs基板上に成長させた中波および長波InAs / GaSb超格子の電気的性質
要約
本研究では、GaAs(001)上の分子線エピタキシー(MBE)システムによって成長した中波(MWIR)および長波赤外線(LWIR)InAs / GaSbタイプII超格子(T2SL)の面内電気輸送特性について報告します。基板。 T2SLとGaAs基板間の大きな格子不整合は、界面ミスフィットアレイ(IMF)技術に基づくGaSbバッファ層の成長によって低減されます。 InAs / GaSb T2SLの歪みを補償するために、特別なシャッターシーケンスを使用して、InSbのようなインターフェイスとGaAsのようなインターフェイスを取得しました。 MWIR InAs / GaSbT2SLは p を示すことがわかります -および n それぞれ低温と高温でのタイプの伝導。興味深いことに、伝導変化温度は成長温度に依存することが観察されています。一方、LWIRT2SL伝導は電子のみによって支配されます。低温でのLWIRT2SLの主な散乱メカニズムは、界面粗さ散乱メカニズムであることに注意することが重要です。
背景
InAs / GaSb T2SLは、Sai-Halasz etalによって概念化されています。 [1] 1977年、この半導体材料の調査に大きな注目が集まった。このT2SLに基づく光検出器は、テルル化水銀カドミウム(HgCdTe)や、次世代の赤外線(IR)アプリケーション向けの最先端の赤外線材料システムよりも理論的に高い電位を示します[2、3]。興味深いことに、InAs / GaSb T2SLは、InAs伝導帯の最小値がGaSb価電子帯の上部より140 meV低い位置にある、異常なタイプIIの壊れたギャップバンドのラインナップを示しています[1]。したがって、ヘビーホールサブバンドと伝導帯底部の間の基本的な遷移は、InAsまたはGaSb層の厚さに依存します[4]。ただし、このアラインメントの主な利点は、価電子帯のいくつかの非放射経路の抑制のおかげで、オージェ再結合率が低下することです[5]。さらに、有効質量が大きいため(≈0.04 m )、バンド間のトンネリングが大幅に減少します。 0 )電子と正孔の[6]。後者の2つの機能により、暗電流を低減でき、光検出器の動作温度(HOT)が高くなります。
InAs / GaSb T2SLは、伝統的に格子整合したGaSb基板上で成長します。ただし、後者は高価であり、3インチ未満の小さなサイズで入手できるため、大判焦点面アレイ(FPA)の実現が妨げられます。さらに、GaSb基板は「エピ対応」ではなく、その成長表面には多くの巨視的な欠陥が含まれています[7]。さらに、GaSb基板の吸収係数は比較的高い(≈100cm -1 )5μmを超えるIR放射の場合[8]。その多くの利点のために、GaAsはInAs / GaSbT2SLの成長のための実行可能な候補として提案されてきました[9、10、11、12]。実際、これらは「エピ対応」でコスト効率が高く、最大6インチの大型サイズで利用できます。さらに、GaAsの吸収係数はGaSbの吸収係数より2桁低くなっています。残念ながら、GaAsとInAs / GaSb T2SLの間に巨大な格子不整合(〜7.5%)が存在し、高いミスフィット転位密度(10 9 )が発生します。 cm −2 )[13]。したがって、ひずみを緩和し、転位密度を低減するために、新しい成長技術を考案することが義務付けられています。これらの技術の中には、低温核形成[14]とIMF技術[15、16]があります。
InAs / GaSb T2SLに基づく光検出器の性能を向上させるには、基本的なパラメータをよりよく理解する必要があります。これらのパラメータの1つは、少数キャリアの寿命と拡散長に関連するバックグラウンドキャリア濃度です。 InAsとGaSbのバルク材料は、キャリアの濃度とは逆の極性を持っていることに注意してください。実際、分子線エピタキシー(MBE)を使用して成長させたInAsおよびGaSb材料は、残留 n -および p -タイプ、それぞれ[17、18]。したがって、InAs / GaSb T2SLの伝導は、各構成要素の厚さに依存すると予測されます。
この論文では、半絶縁性GaAs(001)上で成長したMWIRおよびLWIR領域での検出専用の10 ML InAs / 10 MLGaSbおよび24ML InAs / 7 ML GaSbT2SLの面内輸送特性を調査します。基板。この研究は、Van derPauw法を使用して温度依存のホール効果測定を実行することによって達成されます。さらに、InAs / GaSbT2SLの伝導に対する成長温度の影響が示されています。
メソッド
InAs / GaSb T2SLサンプルは、RIBER Compact 21-DZソリッドソースMBEシステムの半絶縁性GaAs(001)基板上で成長しました。この後者には、III族元素(インジウム(In)およびガリウム(Ga))用の標準的な浸出セルとV族材料(ヒ素(As)およびアンチモン(Sb))用のバルブ付きクラックセルが装備されています。 As 2 を生成するために、AsとSbの両方でクラッカーの温度を900°Cに維持しました。 およびSb 2 、 それぞれ。マニピュレーター熱電対(TC)とBandiT(BT)は、成長温度を監視するために使用されます。この後者は、GaAs酸化物の脱着温度から較正されています。 610°CでのGaAs基板の脱酸(BTで測定)に続いて、250 nmの厚さのGaAs層が585°C(BT)で堆積され、滑らかな開始面が得られました。続いて、厚さ1μmのGaSbバッファ層が、IMF技術を使用してBT温度440°Cで成長しました[16、19]。この手法は、GaAs / GaSb界面で90°のミスフィット転位の周期的配列を形成することで構成され、転位密度が低くなります(≈10 6 cm −2 )[20]。 GaSbバッファ層の成長後、放射率の変化、表面の粗面化、および余分な放射吸収メカニズムのために、BTは使用できなくなります[21]。したがって、InAs / GaSb T2SLの成長温度は、TCによってのみ制御されます。 MWIR 10 ML InAs / 10 ML GaSb T2SLは、さまざまな基板温度、330、390、および400°C(TC)で成長し、輸送特性に対する成長温度の影響を調査します。一方、LWIR 24 ML InAs / 7 ML GaSb T2SLは、わずか390°Cで堆積されています。 InAsとGaSbの間の歪みを補償するために、構造品質の向上につながると報告されている特別なシャッターシーケンスを使用しました[22、23]。InAsの成長に続いて8秒のSbソークを行ってInSbを形成しました。のような結合であるのに対し、GaSbの成長に続いて2秒間のAsを浸して、GaAsのような界面を成長させました。 V / IIIフラックス比は、InAsとGaSbでそれぞれ8.3と4.6です。さらに、成長率はInAsとGaSbの両方で0.5 ML / sです。成長は、反射高速電子線回折(RHEED)システムによってその場で監視されました。
成長したサンプルは、PANalytical X’Pertの高解像度X線回折(HRXRD)によって評価され、構造特性が調査されています。 CuKα 1 放射線(λ ラインフォーカスと4バウンスGe(004)モノクロメーターに由来する≈1.5406Å)が利用されています。輸送特性は、ECOPIAシステムでVan der Pauw法を使用し、80〜300 Kの温度範囲でホール効果測定によって評価されました。測定は、6×6 mm 2 の正方形のサンプルで実行されました。;接触は各コーナーのインジウムドットによって行われました。 0.4Tの磁場がサンプルに垂直に印加されました。
結果と考察
図1は、測定およびシミュレーションされたHRXRD 2θ-ωを示しています。 MWIRおよびLWIRInAs / GaSb T2SLの対称(004)反射のスキャン曲線。シミュレーションは、PANalytical X’Pertが提供する「Epitaxy」ソフトウェアによって実行されます。ご覧のように、MWIR T2SLの場合は最大4、LWIRの場合は最大7の高解像度の衛星があります。これは、特にLWIR T2SLの場合、成長した層の構造品質が高いことを示しています。一方、ω-2θで測定した0次ピークの半値全幅(FWHM) 方向は、MWIRおよびLWIRT2SLでそれぞれ107および99秒角です。超格子期間( L )は、2つの隣接する衛星間の角距離(Δθ)から決定されます。 )次のように:

HRXRD 004 2θ-ω a のスキャン MWIR b およびLWIRInAs / GaSbT2SL。実験(黒線)およびシミュレーション(赤線)HRXRD 2θ-ω a の(004)反射をスキャンします MWIR T2SL; 4次までの高解像度の衛星があります。これは超格子の質の良さの特徴です。ゼロ次ピークの半値幅は107秒角、 b およびLWIRInAs / GaSb T2SL;最大7次の衛星ピークがあり、結晶品質が高いことが確認できます。ゼロ次ピークの半値幅は99秒角です。各超格子の周期は、隣接する衛星間の距離から計算されます
ここで、λ は前述の入射X線ビームの波長であり、θ SL 超格子の0次ピークのブラッグ角です。図1から、MWIRおよびLWIRT2SLの周期はそれぞれ6.74±0.01および10.24±0.02nmです。測定された曲線をシミュレーションされた曲線に適合させることにより、MWIR T2SLの1周期の組成は、GaSb 3.4 nm(11.2 ML)、GaAs 0.1 nm(0.2 ML)、InAs 3.0 nm(10.1 ML)、およびInSb 0.2 nm(0.5 ML)。さらに、LWIR T2SL構成要素の厚さは、GaSb 2.3 nm(7.5 ML)、GaAs 0.1 nm(0.2 ML)、InAs 7.4 nm(24.7 ML)、およびInSb 0.4 nm(1 ML)です。ゼロ次ピークとGaSbバッファ層の間の角度から決定される格子不整合は8.9×10 -3 です。 および4.5×10 -3 それぞれMWIRおよびLWIRT2SLの場合。図2は、成長したT2SLの非対称(115)逆格子空間マップ(RSM)を示しています。両方のサンプルで、超格子の衛星とGaSbピークは垂直に整列しています(これらは散乱ベクトルQ x の同じ成分を持っています )、これは、両方のT2SLが実質的に完全に歪んでいるという結論につながります。

a の非対称115RSM MWIRと b LWIR InAs / GaSbT2SL。 a の非対称反射(115)の逆格子空間マップ MWIRと b LWIR InAs / GaSbT2SL。両方の超格子のピークは垂直に整列しています(散乱ベクトルQ x の値は同じです)。 )。したがって、MWIRとLWIRの2つの超格子は実質的に完全に歪んでいます
成長したMWIRInAs / GaSb T2SLの面内電気パラメータを図3に示します。ご覧のとおり、意図せずにドープされたInAs / GaSb T2SLは、導電率のタイプに再現性のある変化を示します。 GaSbバッファ層の影響にもかかわらず( p -タイプ)ホール効果測定では、導電率タイプの変化はT2SL層のみによるものであることに注意してください。この変化は、いくつかのグループによっても報告されました[6、24、25、26]。 T2SLは p を示します -変化が発生する温度より下のタイプの伝導( T ch )および n - T より上のタイプの伝導 ch 。前述のように、InAs層とGaSb層は n を示します -タイプと p それぞれタイプの伝導。したがって、2つの構成要素に対して同様の厚さを持つInAs / GaSb T2SLの残留バックグラウンドは、T2SLの2成分構成要素からの多数キャリア補償によって誘導されます[27]。 T の値について ch 、Mohseni etal。 [6]は140Kの値を報告しました、Christoletal。 [24]は190Kの値を取得しましたが、Khoshakhlagh etal。 [25]は、200 Kの値を指摘しました。シートキャリアの濃度と移動度の動作は、よく知られている固有のフォノン散乱(音響、圧電、極性、および非極性光学)メカニズムによって支配されます。例外的に、ホールの移動度は、 T を超える温度の上昇とともに増加します。 ch (図3b);これはおそらく GaSb-on-InAsインターフェースのInSbインターフェースによるイオン化トラップが原因です[6]。 T ch 値は、330、390、および400°Cで成長したT2SLの場合、それぞれ145、195、および225 Kです(図3)。これはおそらくによるものです 成長温度が高くなると正孔濃度が高くなり、 T がシフトします。 ch 温度を下げる。高い正孔濃度は、高い成長温度での欠陥とイオン化された空孔によるものです。 390°Cで成長したInAs / GaSb T2SLは、キャリアの濃度が1.8×10 16 であることを特徴としています。 および2.5×10 16 cm -3 それぞれ80Kと300Kで。この結果は、Mohseniらによって報告された結果よりも優れています。 [6](ホール濃度の範囲は1.5から4×10 17 cm -3 )そして、Christoletalによって報告されたものと実質的に同じです。 [24](1.6×10 16 のホール濃度 および6×10 16 cm -3 それぞれ100Kと300Kで)。一方、ホールの移動度は1300( p -タイプ)および3200 cm 2 / V s( n -タイプ)、それぞれ80Kと300Kで。到達した移動度は、Christoletalによって報告された移動度よりもはるかに高くなっています。 [24]、ホールの機動性が100および1800 cm 2 / Vは、それぞれ100Kと300Kです。

a ホールの集中と b 異なる温度で成長させたMWIRInAs / GaSbT2SLのホール移動度。さまざまな温度で成長したMWIRInAs / GaSbT2SLの電気的パラメータ。 a ホール濃度:3つのT2SLは導電率の変化を示します。彼らは p -低温でタイプし、 n -高温でタイプします。 b ホールの移動性:移動性の傾向には2つの領域があります。低温の場合、散乱メカニズムが異なるため、移動度が低下します。高温の場合、移動度は温度を上げることによって増加します。これは、InSbのような界面のイオン化トラップによって説明できます。成長温度が上昇すると、導電率の変化が発生する温度が上昇します。これは、高温での欠陥レベルが高いためです
。3つの異なるサンプルの抵抗率を図4に示します。抵抗率と温度には、明確に定義された2つの勾配があることがわかります。各サンプルについて、アレニウスの法則から2つの熱活性化エネルギーを抽出できます。 n の場合 -タイプ領域、活性化エネルギー E an 330、390、および400°Cで成長したT2SLの場合、それぞれ58、72、および68meVです。 p の場合 -タイプリージョン、 E ap は、330、390、および400°Cで堆積されたInAs / GaSb T2SLの場合、それぞれ7、12、および14meVに等しくなります。低温用( T 未満 ch )、T2SLは p を示します - p によるタイプ - E に関連付けられたタイプのキャリア ap これは、キャリアの生成と再結合のメカニズムを支配します。 T を超える温度の場合 ch 、T2SLは n を示します 高い活性化エネルギーに関連する深いレベルのキャリアの活性化によるタイプの伝導 E an 。これらの深いレベルの原因は、InAsとInAs / GaSb T2SLの間のバンドラインナップの結果であり、InAs / GaSbT2SLで深いレベルとして機能するバルクInAsの浅いレベルです[28]。
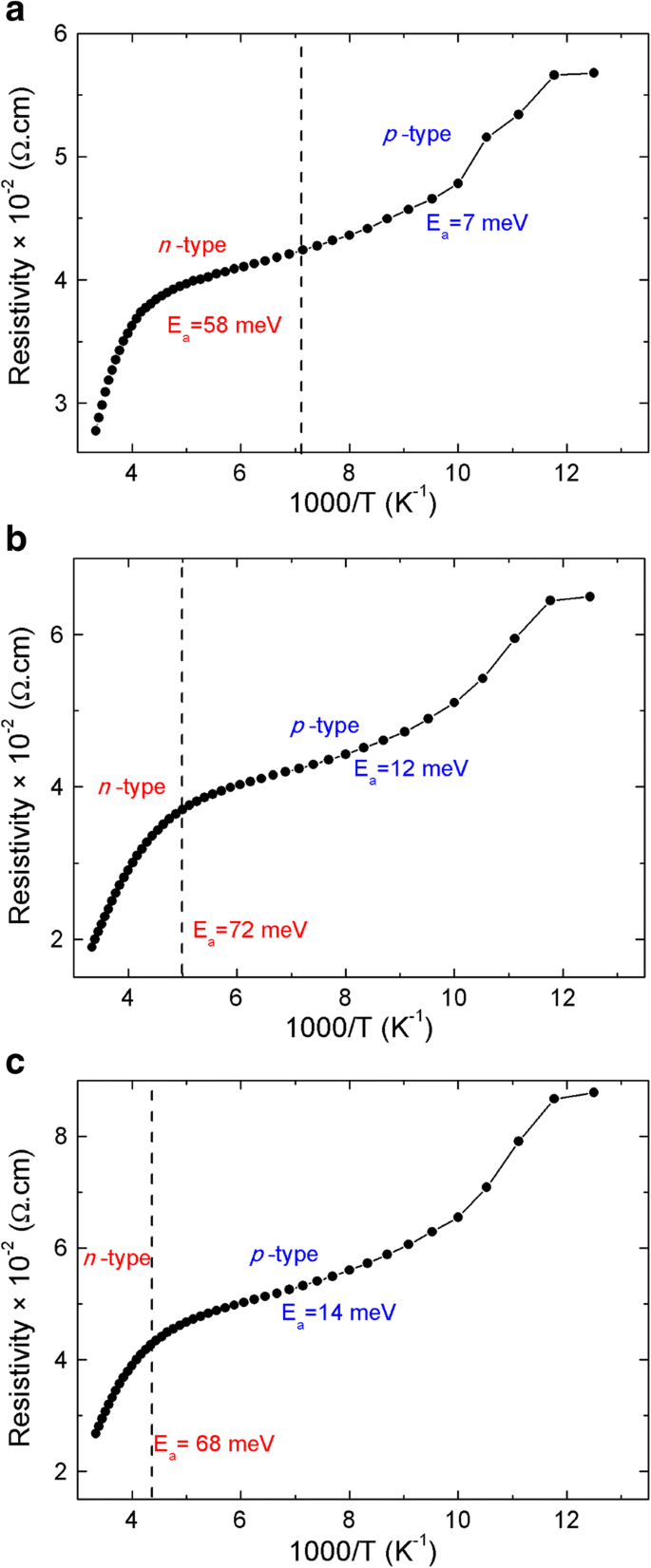
a で成長したMWIRInAs / GaSbT2SLのホール抵抗率 330°C、 b 390°C、および c 400°C。さまざまな成長温度で堆積したMWIRInAs / GaSbT2SLのホール抵抗率 a 330°C、 b 390°C、および c 400°C。グラフごとに、明確に定義された2つの勾配があります。アレニウスの法則から、2つの熱エネルギーを抽出できます。これにより、2つの不純物レベルの存在が確認されます。 1つは n を表します -タイプのキャリアで、2番目のキャリアは p に対応します -タイプのキャリア。 n に関連する深い不純物レベル タイプキャリアは、InAsとInAs / GaSbT2SL間のバンドラインナップの結果です
LWIR InAs / GaSb T2SLのホール濃度、移動度、および抵抗率を図5に示します。MWIRT2SLの反対側では、このサンプルの場合、導電率のタイプに変化はありません。このT2SLは n を示します -タイプの伝導。 p の影響 この n のホール効果測定におけるタイプGaSbバッファ(低移動度キャリア)層 -タイプT2SL(高移動度キャリア)は、ホールの移動度がキャリアの移動度の2乗に比例するため、無視できます。 Khoshakhlagh etal。 [25]は、13 ML InAs / 7 ML GaSbT2SLについて同じ結果を報告しました。さらに、Szmulowicz etal。 [29]は、InAs層がGaSbよりも厚いLWIR T2SLは、 n になる傾向があることを指摘しました。 -タイプ。この n タイプの伝導は、InAs層の厚さが厚いためです(残りは n -ドープ。)GaSbのそれと比較して。これらの n タイプのキャリアは、33 meVの活性化エネルギーに関連付けられています(図5b)。ホールの集中と移動性の動作は、 n で一般的です。 タイプの半導体。ただし、キャリアの濃度と移動度がほとんど温度に依存しない95K未満の温度範囲を除きます。これは、この温度領域に温度に依存しない散乱メカニズムが存在することを示しています。この後者は、界面粗さ散乱(IRS)メカニズムであることが実証されています[30、31、32、33、34]。このメカニズムは、フォノン散乱が凍結する低温で支配的です[35]。 IRSメカニズムは、界面の存在と、層の厚さの変化によるものであり、その結果、電子エネルギーレベルが変化します。したがって、それらはキャリア散乱の発生源として機能します[35]。さらに、IRSメカニズムによって支配されるホールの移動度は、InAsの厚さの6乗に比例します(\(\ mu \ propto {d} _ {\ mathrm {InAs}} ^ {6.2} \))[35]。

a ホールの集中、ホールの移動性、および b 意図せずにドープされたLWIRInAs / GaSbT2SLのホール抵抗率。 LWIR InAs / GaSbT2SLの輸送特性。 a ホールの集中と可動性:この超格子は n のみを示します -全温度範囲のタイプの伝導。イオン化効果による温度上昇により、ホール濃度が上昇します。一方、ホールの移動度の動作は、95 Kを超える温度ではさまざまな散乱メカニズム(フォノンとイオン化不純物)によって制御されます。95K未満の温度では、移動度は一定(およびホール濃度)であることが確認されます。温度に依存しない別の散乱メカニズムの存在。この後者は、界面粗さメカニズムです。 b ホールの抵抗率:アレニウスの法則から、1つの不純物レベルに関連付けられている熱エネルギーは1つだけです
結論
要約すると、InAs / GaSb T2SLは、IMF技術に基づくGaSbバッファ層を使用してGaAs基板上に成長しました。さらに、これらのT2SLは、MWIRおよびLWIR検出領域で実証されています。 MWIR T2SLは、 p の形で伝導タイプの変化を示すことがわかっています。 - n へ -温度が上がるにつれてタイプします。さらに、T2SLの成長温度が上昇するにつれて、変化が発生する温度も上昇します。この伝導タイプの変化は、2つの異なる活性化エネルギーを持つ2つの不純物レベルの存在に起因します。一方、LWIR InAs / GaSbT2SL伝導は n であることが実証されています。 -全温度範囲のタイプ。従来の散乱メカニズムに加えて、IRSメカニズムが低温での主要な散乱メカニズムであることが証明されています。これらの結果により、InAs / GaSb T2SLの物理的特性をよりよく理解できるようになり、この材料に基づくIR光検出器の性能が向上します。
略語
- BT:
-
BandiT
- FPA:
-
フォーカルプレーンアレイ
- FWHM:
-
半値全幅
- HOT:
-
高い作動温度
- HRXRD:
-
高解像度X線回折
- IMF:
-
界面不適合配列
- IR:
-
赤外線
- IRS:
-
界面粗さ散乱
- LWIR:
-
長波赤外線
- MBE:
-
分子線エピタキシー
- MWIR:
-
中波赤外線
- RHEED:
-
反射高速電子線回折
- RSM:
-
逆格子空間マップ
- T2SL:
-
タイプII超格子
- TC:
-
熱電対
ナノマテリアル
- コバルトをドープしたFeMn2O4スピネルナノ粒子の調製と磁気特性
- TiO2ナノ流体に向けて—パート1:準備と特性
- セリウムのダイヤモンドカッティングの分子動力学モデリングとシミュレーション
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- 分子線エピタキシーによって成長したMoSe2のバンドギャップの温度依存性
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- 変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
- 分子線エピタキシー法を用いたGeBi膜の作製と光学的性質
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- ナノ粒子の毒性の物理的および化学的性質への依存性
- <100>引張荷重下のタンタル単結晶の弾性特性の温度および圧力依存性:分子動力学研究



