Geドープ垂直GaNショットキーバリアダイオードの回復性能
要約
垂直GaNショットキーバリアダイオード(SBD)は、Geドープ自立型GaN基板上に製造されました。 SBDの結晶品質はカソードルミネッセンス測定によって特徴づけられ、転位密度は〜1.3×10 6 であると決定されました。 cm − 2 。実施された電気的性能測定により、SBDは低いターンオン電圧 V を示します on (0.70〜0.78 V)および大電流 I on / 私 オフ 比率(9.9×10 7 〜1.3×10 10 )。逆回復特性を調べた。逆回復時間は、直径100、200、300、400、および500μmのSBDでそれぞれ15.8、16.2、18.1、21.22、および24.5nsであることが得られました。一方、逆回復時間と逆回復電荷は両方とも、電極面積と有意な正の相関を示しています。
はじめに
最近、固有の利点を備えたGaNなどのワイドバンドギャップ半導体が、特に高周波、高出力、高性能の分野で、次世代の電子デバイスに多大な研究の注目を集めています[1,2,3 、4、5、6]。一方、水素化物気相エピタキシー(HVPE)の開発により、転位密度が低くなりました(≤10 6 cm − 2 )GaN基板は現在市販されています[7,8,9,10]。横型デバイスと比較して、これらの基板で製造された縦型デバイスは、より大きな電流、より少ない漏れ経路、およびシステムのより良い信頼性を達成するのに役立つより高度な構造であると考えられています[11、12]。その中で、GaNベースのショットキーバリアダイオード(SBD)は、スイッチングデバイスの重要なコンポーネントです。バイポーラダイオードとは異なり、ユニポーラの性質を持つSBDは、少数キャリアのストレージ効果を大幅に低減し、それに応じて、低い逆回復損失で高いスイッチング速度を提供します。ただし、垂直GaN SBDの逆回復特性の体系的な研究を実施したグループはほとんどなく[13、14、15、16、17]、その研究はさまざまな構造のデバイスでのスイッチング時間の比較に重点を置いています。したがって、GaN SBD、特に垂直SBDの回復性能のメカニズムを詳細に調査することが急務です。
一方、オーミック接触技術は、多くの公開された論文[18]でデバイスの性能を改善するために継続的に探求されてきたため、高濃度にドープされたn型GaNは窒化物デバイスを製造するための重要なリンクです。最近、GeはGaNのSiドーパントの代替として提案されています。これは、両方が浅いレベルの不純物の類似した特性を共有し(GeとSiの活性化エネルギーがそれぞれ20と17 meVであると報告されている)、格子歪みが発生するためです。 Gaサイトに置換されるGe原子は、イオン半径が近いために小さくなります[19、20]。 Geドーピングは、欠陥の少ない滑らかな表面を形成すると考えられています[21、22]。さらに、格子歪みと膜応力が低いため、このドーピングは、熱安定性をより重視する高温電子デバイスでも有望です。 GeドープGaNは理論的に研究されてきましたが、関連するデバイスへの実際の影響を調査することが不可欠です。この論文では、Geドープ自立型(FS)GaN基板上に作製された新しい垂直GaNSBDを提案します。垂直GaNSBDは、優れた結晶品質と電子特性を示します。一方、垂直SBDの回復性能は体系的に調査されます。逆回復時間と逆回復電荷は、最終的に電極面積と有意な正の相関を示します。
メソッドと実験
製造されたSBDのデバイス構造の概略図を図1aに示します。これは、主に390μmのFS n + で構成されています。 -GaN基板と9μmn - -GaNドリフト層。この作業では、Ge濃度が1×10 18 の(0001)配向のGaN基板層を使用します。 cm − 3 転位密度は1×10 6 cm − 2 HVPEによって成長しました。そして、この基板上のドープされていないエピタキシャル層は、有機金属化学蒸着によって成長し、成長速度は〜2μm / hでした。 SBD製造では、Ti / Al / Ni / AuオーミックコンタクトがGaN基板の裏面に形成されました。 Ni / Auショットキー電極は、図1bに示すように、5つの異なる直径(100、200、300、400、および500μm)のエピタキシャル層の前面に形成されました。製造プロセスの詳細については、以前のレポート[23、24]を参照してください。
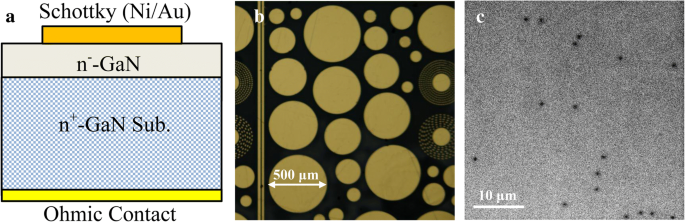
a 製造された垂直SBDの概略断面図。 b さまざまな電極の光学顕微鏡画像。 c エピタキシャル層のパンクロマティックCL画像
カソードルミネッセンス(CL)画像は、Quanta 400 FEG走査型電子顕微鏡(SEM)を10 kVの加速電圧で使用して取得し、エピタキシャル層の転位密度の空間分布を調べました。静電容量-電圧( C-V )および電流-電圧( I-V )SBDの電子特性を評価するために、Keithley4200半導体パラメータアナライザを使用して測定を実行しました。また、温度依存の測定は、カスタマイズされた実験設定を使用して300〜500Kの範囲で実施されました。
結果と考察
エピタキシャル層のCL結果を図1cに示します。転位は非放射再結合中心であると考えられているため、CL画像上にダークスポットの形で現れます。顕著な空間分布の違いは見られないため、転位密度の平均値は〜1.3×10 6 と計算されました。 cm − 2 、CL測定はいくつかの異なる領域で実行されます。この結果は、垂直SBDで高品質のエピタキシャル層が得られたことを示しています。
垂直SBDは並列モードで特徴付けられたため、 C-V および G-V 曲線は1MHzの周波数で得られました。 SBDの結果をそれぞれ図2aとbに示します。ここで、( 1 / C 2 )対印加電圧 V 挿入図にプロットされています。ここで、キャリア濃度 N d 次の式で評価できます:\({N} _d =\ frac {-2} {A ^ 2 q \ varepsilon \ left [d \ left(1 / {C} ^ 2 \ right)/ dV \ right]} \)、ここで A ショットキー電極の面積、 q は電子の電荷です(1.602×10 − 19 C)、およびε はGaNの誘電率です(8.854×10 − 11 F / m)。したがって、 N d エピタキシャル層の長さは〜6.2×10 15 であると決定されました。 cm − 3 。そして位相角θ 次の式で計算することもできます:\(\ theta ={\ tan} ^ {-1} \ left(\ frac {2 \ pi fC} {G} \ right)\)、ここで f 適用される周波数 C は静電容量、 G 測定されたコンダクタンス(ゲートリーク)です。異なる直径の結果は類似しているため、計算された角度θ 対印加電圧 V 例として、直径300μmのSBDの一部を図2bの挿入図に示します。 θに注意してください は90°に非常に近いため、この研究では、リークパスの少ない優れたショットキーゲートが実現されていることが確認されます。 J-V 特性は図2cにも示されています。 I on / 私 オフ 比率は3.8×10 9 です。 、5.9×10 8 、1.3×10 10 、6.5×10 8 、および9.9×10 7 直径100、200、300、400、500μmのSBDの場合、それぞれ I on および私 オフ は、それぞれ1.6および-2Vのゲート電圧での電流として定義されます。線形フィッティング後、ターンオン電圧 V on 垂直SBDの電圧はそれぞれ0.70、0.76、0.72、0.70、0.78 Vと決定され、電極の直径は100から500μmに増加します。これらの結果は、垂直SBDで良好な電子特性が得られたことを示しています。
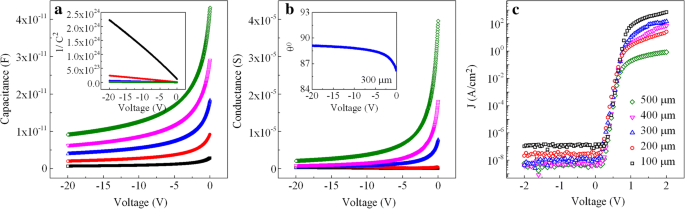
a 室温 C-V 1MHzの周波数での各異なる電極の垂直SBDの曲線。挿入図は( 1 / C のプロットです 2 )対電圧 V 。 b G-V 異なる電極ごとの垂直SBDの曲線。挿入図は、位相角θのプロットです。 対電圧 V 直径300μmのSBD用。 c J-V 異なる電極ごとの垂直SBDの曲線
図3aに示すように、一般的なテスト回路を使用して、垂直SBDの逆回復特性を測定しました。周期的な方形波電圧信号(+ 20〜− 20 V)がテスト対象デバイス(DUT)に順次印加され、寄生インダクタが磁気エネルギーを蓄積して電流に影響を与えます。電圧信号が変化すると、その間に発振電流が発生する場合があります。 Tektronix MDO 4104-3オシロスコープを備えた高速電流プローブを配置して、垂直SBDの過渡電流変動を検出しました。逆回復電流の概略波形を図3bに示すように、この研究では t a t の間の保存時間として定義されます b 逆電流遅延時間として定義されます。そして、逆回復時間 T rr 逆電流が最大逆回復電流の10%に回復する時間として定義されます I RM 、これは t の合計です a および t b 。そして、逆回復料金 Q rr T まで逆電流を積分することによって得られます rr これは、ダイオードに蓄積された電荷に対応します。

a 垂直SBDの逆回復特性を測定するために使用されるテスト回路。 b 垂直SBDの逆回復特性の概略波形
図4は、印加電圧が+20から-20Vに切り替わったときの各電極直径の垂直SBDの逆回復曲線を示しています。ここでは、直径100、200、300、400、および500μmのSBDについて、 T rr 値は15.8、16.2、18.1、21.22、および24.5 nsであることが得られましたが、 Q rr 値は、それぞれ0.0127、0.0536、0.150、0.280、および0.405nCになるように統合されました。これらの垂直デバイスはすべて、高速スイッチング時間(25 ns未満)を示しました。結果にはかなり低い逆電流も観察されますが、これはSBDに蓄積された電荷の量が少ないことが原因である可能性があります[13]。一方、 T の値もはっきりとわかります。 rr および Q rr 両方とも電極の直径の拡大とともに増加し、最小のものは最速の T を示します rr 15.8nsの。
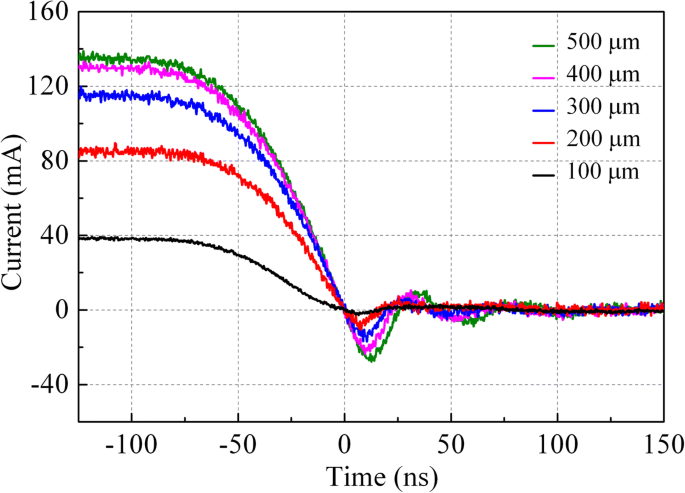
異なる電極ごとの垂直SBDの逆回復電流
これらの変化の根底にあるメカニズムをさらに調査するために、電圧が+10から-10Vに切り替わったときの垂直SBDも測定されました。逆回復時間として T rr 対ダイオード直径 d T の値を図5にプロットします。 rr 各ダイオードについては、目立った変化はありませんでした。逆回復料金 Q rr 対 d は図6に同時に表示され、2つの曲線のデータは同じ傾向を示しています。一方、 Q rr 両方のテストの中で、 d との有意な正の相関が示されています 2 、つまり、電極領域。
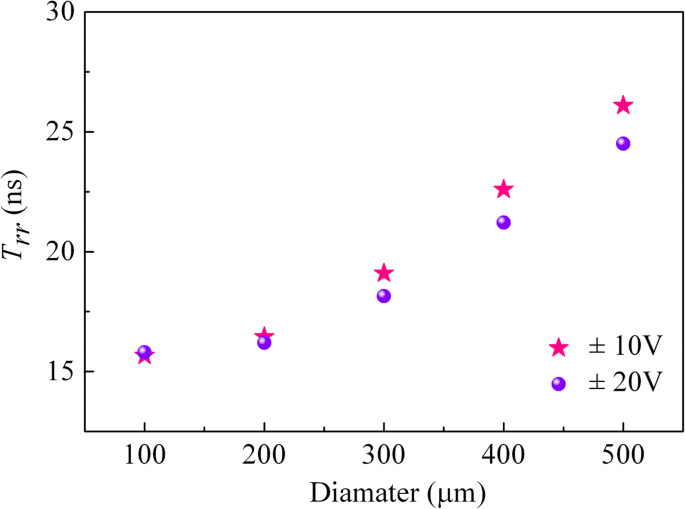
逆回復時間 T rr 対電極径 d
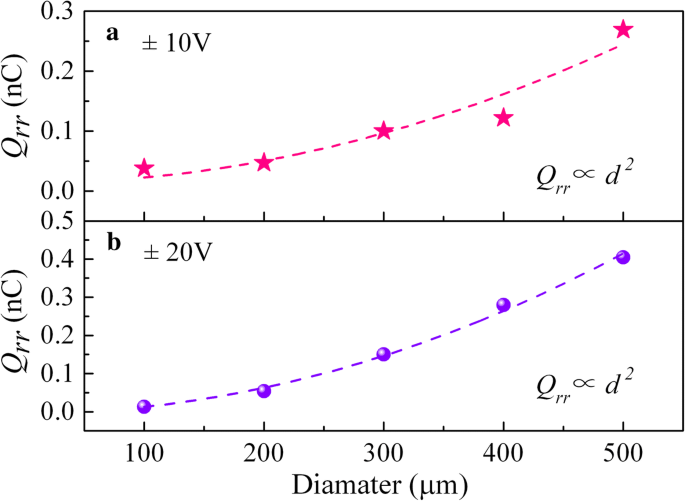
逆回復料金 Q rr 対電極径 d
実際、逆回復効果は主にSBDの寄生インダクタンスと界面トラッピングによるものであると報告されています[25、26]。寄生インダクタンスの寄与は、これらの逆回復曲線では明らかに観察されない発振電流の形で特徴付けられることを考慮すると、逆回復時間と逆回復電荷の変化はトラップに起因するはずです[27、28]。トラップの濃度は垂直SBDで均一であるため、 Q rr はデバイスの接触面積に依存し、最終的には図6に示すように電極面積とともに増加します。したがって、トラップはインターフェースの電界ストッパーとして機能します。 t の間 a 期間中、遅延はショットキー接合でのキャリアトラップの影響を強く受けましたが、 t b 期間中、逆回復速度は、蓄積された電荷を接合部から一掃する時間によっても遅くなります。これらの結果は、 RC を示唆した以前のレポート[29]と一致しています。 時定数はデバイスの直径の増加とともに増加し、逆回復時間との良好な依存性を示します。そして、これらのデバイスのより小さな電極またはより薄いドリフト層から、逆回復特性のさらなる改善が期待できます。
さらに、垂直SBDの回復性能は、より高い温度でさらに調査されます。図7は、それぞれ300、400、500Kで測定された直径500μmのGaNSBDの逆回復電流を示しています。温度が上昇しても、逆回復時間も逆回復電荷も変化しません。トラップの濃度は温度にあまり敏感ではないため、これらの結果は上記の分析と一致しています。逆に、SiベースのSBDの逆回復時間は、温度が300から425 Kに上昇するにつれて191%増加すると報告されています[17]。ここでは、キャリア寿命が短く、バンドギャップが広いGaN SBDは、電流処理能力、逆回復、およびエネルギー損失を大幅に改善することが示されています。 GaNベースのSBDの熱安定性は従来の狭バンドギャップ半導体の熱安定性よりも優れているため[30]、GaNは高温環境に適用されるスイッチングデバイスにも適した材料であると結論付けることができます。
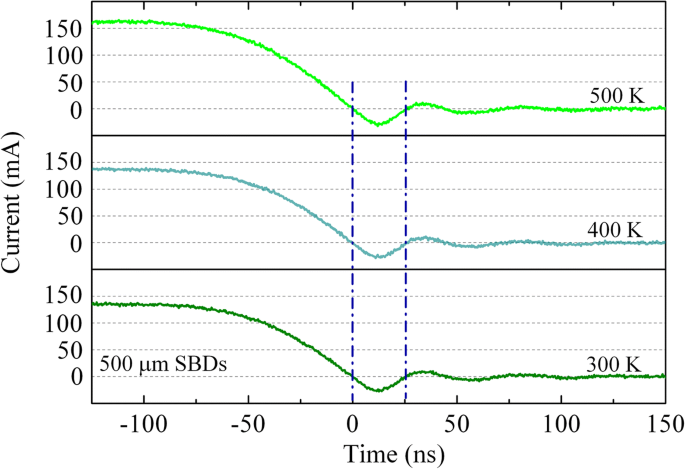
それぞれ300、400、500Kで測定された直径500μmのSBDの逆回復特性
結論
要約すると、HVPEによって成長させたGeドープFSGaN基板上に垂直GaNSBDを製造しました。材料の特性評価と電流-電圧測定を実行すると、垂直SBDで優れた結晶品質と電子特性が得られたことがわかります。逆回復特性を系統的に調査した。逆回復時間は、直径100、200、300、400、および500μmのダイオードでそれぞれ15.8、16.2、18.1、21.22、および24.5nsであることが得られました。一方、逆回復時間と逆回復電荷は両方とも、電極面積と有意な正の相関を示しています。私たちの結果は、GaNベースのSBDの回復性能をさらに改善するための参考になるかもしれません。
略語
- CL:
-
カソードルミネッセンス
- C-V :
-
静電容量-電圧
- DUT:
-
テスト対象デバイス
- FS:
-
自立型
- GaN:
-
窒化ガリウム
- HVPE:
-
水素化物気相エピタキシー
- I-V :
-
電流-電圧
- SBD:
-
ショットキーバリアダイオード
- SEM:
-
走査型電子顕微鏡
ナノマテリアル
- ダイオード
- 量子デバイス
- 専用ダイオード
- Navistar:頑丈なパフォーマンス
- 多層フレキシブル包装用の高水分バリアHDPE技術
- 4H-SiCPiNダイオードの特性に及ぼす紫外線照射の影響
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 多機能GaN / Feナノ粒子による内皮細胞の標的化
- NドープZnO / g-C3N4ナノコンポジットの可視光駆動光触媒性能
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- 垂直ポンプの性能を向上させる3つの方法



