垂直GaNベースのPNダイオードに関する最近の進歩のレビュー
要約
代表的なワイドバンドギャップ半導体材料として、窒化ガリウム(GaN)は、その優れた材料特性(高電子移動度、高電子飽和速度、臨界電場など)により注目を集めています。垂直GaNデバイスが調査されており、パワーエレクトロニクスアプリケーションの最も有望な候補の1つと見なされており、高電圧、高電流、および高ブレークダウン電圧の容量が特徴です。これらのデバイスの中で、垂直GaNベースのPN接合ダイオード(PND)はかなり研究されており、高いエピタキシー品質とデバイス構造設計に基づいて、パフォーマンスが大幅に向上しています。ただし、そのデバイスエピタキシーの品質にはさらなる改善が必要です。デバイスの電気的性能の観点から、デバイスのエッジでの電界混雑効果は緊急の問題であり、早期の破壊をもたらし、GaN材料の放出の優位性を制限しますが、現在はエッジの終端によって緩和されています。このレビューでは、材料のエピタキシャル成長とエッジ端子技術の進歩を強調し、続いて、現在のGaNの開発と、材料とデバイスのシリコンカーボン(SiC)に対する潜在的な利点、GaNショットキーバリアダイオード(SBD)とPNDの違いについて説明します。メカニズムと機能、およびそれらの横方向の対応物に対する垂直デバイスの利点に関して。次に、レビューは見通しを提供し、電力システムに利用される垂直GaN PNDの設計傾向を明らかにします。これには、インチョート垂直GaNPNDも含まれます。
はじめに
産業と経済の急速な成長により、世界のエネルギー消費量は過去数十年よりもはるかに急速に増加しています。したがって、エネルギー消費量の増加という問題を軽減するには、高度な省エネ技術が必要です。
シリコンベースのデバイスは、現在、パワーデバイスの中で主要なタイプです[1]。これらのパワーデバイスの中で、絶縁ゲートバイポーラトランジスタ(IGBT)構造は重要な役割を果たし、パワーバイポーラ接合トランジスタ(BJT)と金属酸化膜半導体電界効果トランジスタ(MOSFET)の発明以来、 1982年のIGBT [2]。現在、IGBTは変換と伝送のためのパワーエレクトロニクス分野の不可欠な要素です[3]。しかし、シリコンベースのパワーデバイスは、これまでの基本的な材料の限界に達しており、電気エネルギーの用途で広く利用されています。
その卓越した特性を考えると、GaNはワイドバンドギャップ半導体材料(SiC、GaN、Ga 2 を含む)の1つです。 O 3 およびダイアモンド)Siベースのデバイスに対して指定されたブレークダウン電圧に対して低い静電容量と抵抗を備えたパワーデバイスを製造することができます。したがって、パワーエレクトロニクスシステム向けの低エネルギー消費、高電力密度、および高変換効率を備えたGaNベースのデバイスが期待されます。
表1に示すように、GaNは、SiC(市販されている)よりもはるかに高いバリガの性能指数(BFOM)を持っています。これは、電子飽和速度が高く、臨界電界が高いためです。ただし、SiCの方が熱伝導率が高くなります。さらに、GaNはより高いキャリア移動度 µ を持っています 熱伝導率が高く、 p の両方を達成しました -および n Ga 2 と比較したタイプのドーピング O 3 。一方、究極のワイドバンドギャップ半導体であるダイヤモンドについては、実用化に向けてかなりの進歩を遂げる必要があります。これまで、3端子デバイス(ヘテロ構造電界効果トランジスタ(HFET)およびMOSFET)や2端子デバイス(SBDおよびPND)などのGaNベースのデバイスが重要な研究トピックになり、それらのデバイスで大きな進歩が達成されました。電力整流および電力変換のアプリケーション。
<図>GaNとSiC
GaNは、その固有の材料特性から、エネルギーバンドギャップが広く、臨界電界が高く、電子飽和速度が高く、パワーデバイスのBFOMが3〜4倍優れているなど、SiCよりもわずかに優れた利点があります[6]。したがって、その優れた機能を考慮すると、GaNベースのデバイスはSiCベースのデバイスよりも優れているはずです。実際のアプリケーションでは、垂直GaNベースのデバイスは、優れた材料特性のため、高電力密度と高動作周波数に不可欠です(図1)。
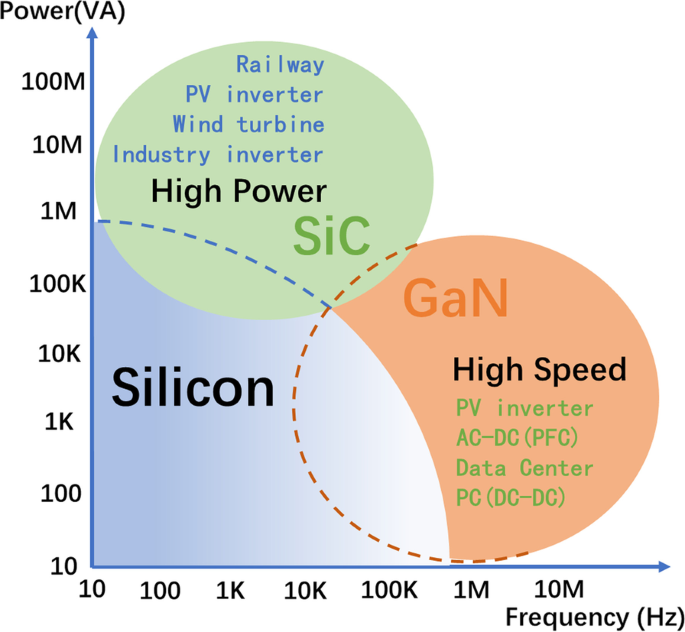
GaNおよびSiCパワースイッチングトランジスタの潜在的なアプリケーション[7]
最も成熟したワイドギャップ半導体として、SiCデバイスは過去10年間で目覚ましい進歩を遂げ、高電圧、低比オン抵抗、高速スイッチング速度の点で有望な性能を示しています[8]。 1980年以来の深い研究基盤と、欠陥の少ない(<10 4 )利用可能なより大きなSiC基板を考えると cm −2 )、SiC SBDおよび接合型電界効果トランジスタ(JFET)は、2001年以来最初に商品化されたSiCベースのデバイスでした。MOSFETやBJTを含む他のSiCベースのパワーデバイスは、高電圧および電力アプリケーションの分野で成功裏に開発され、印象的であることが実証されています。パフォーマンス[9]。
SiCと比較して、GaNデバイスの開発は非常にゆっくりでした。それらの不十分な材料品質は、それらの理論的に優れた特性のいくつかの実現を妨げます。 GaN基板がないことを考えると、GaNデバイスに関するほとんどの研究は、この段階では主に横方向の構造(AlGaN / GaNヘテロ構造など)に基づいています。電子移動度が2000cm 2 と高い / V s(AlGaN / GaNの2次元電子ガス(2DEG))、1000 cm 2 / V s(バルクGaN)および2.5×10 7 のより高い飽和速度 SiCの対応物と比較してcm / sであるため、AlGaN / GaNデバイスは高周波アプリケーションに適しており、SiCデバイスに比べて電力ワットが低くなっています[10]。高周波フィールドでは、AlGaN / GaN SBDは優れた電気輸送性能を達成し、ワットレベルでのマイクロ波およびミリ波アプリケーションにより適しています[11、12]。 AlGaN / GaN SBDは、GaNSBDの代表的なデバイスです。 2DEGの高い移動度は、AlGaN / GaN SBDが、垂直SBDと比較して高周波アプリケーションで大きなパフォーマンス上の利点を示し、低いターンオン電圧も維持することを意味します。最近、AlGaN / GaN SBDは、入力電力が6.4 W、ターンオン電圧が0.38 V、ブレークダウン電圧( BV )の5.8GHz整流回路の基礎となりました。 )3000 Vの[13、14]。最大カットオフ周波数は、0Vで1THzに近く、アノードからカソードまでの距離は70nmです[15]。
GaNベースのパワーデバイスの場合、GaN基板(バルクGaN)はエピタキシー成長に理想的であり、ホモエピタキシー技術を利用してミスマッチを排除することができます。バルクGaNの低い転位密度は、高い転位密度が BV などの性能特性に影響を与える可能性があるため、エピタキシャル基板に不可欠です。 、逆リーク電流、生産量、および信頼性[16]。垂直GaNベースのデバイスの開発は、近年のGaN基板の進歩によって推進されてきました。しかし、垂直三極真空管の技術が比較的未成熟であることを考えると、垂直GaNダイオードはこの初期段階でホットな研究トピックになっています。 AlGaN / GaN SBDと比較して、垂直GaN SBDは、低い逆回復時間と低い伝導損失を伴う高いスイッチング速度などの周波数フィールドで同様の利点があります。それにもかかわらず、後者は前者よりも電流密度が大きく、漏れ経路が少ない[17、18]。
GaN基板にはいくつかの問題が発生しています。まず、現在、転位密度が10 4 のGaN基板が利用可能です。 –10 6 cm −2 、しかし、これらの転位密度は、SiおよびSiC基板のそれよりもはるかに高い[19]。次に、4〜6インチのウェーハサイズと妥当なコスト(10ユーロ/ cm 2 )に関して )SiCの、2〜3インチのサイズで、比較的高コスト(100ユーロ/ cm 2 ) )GaN基板は、GaNの商業化と生産性を大規模に阻害します[20]。供給ベンダーを増やすことは別として、外国の基板(Si、サファイア、またはSiC)でのヘテロエピタキシーは、GaN基板のコストを削減するための代替方法ですが、比較的高いミスマッチと欠陥の課題に対処する必要があります。
バルク材料における前述の問題に加えて、GaNダイオードの課題は、高品質の p を実現することです。 -タイプの材料。 p を形成するための比較的高度な技術に関して -Alイオン注入によるタイプSiC、未成熟 p -タイプのイオン注入技術と p の低アクセプター活性化 タイプのGaNは、GaNベースのデバイスの構造と製造の開発を制限する重大な障害です。したがって、GaNダイオードの性能を改善し、このレビューの重要な部分を構成するために、さまざまな種類のエッジ終端構造が提案されています。
FS基板上の垂直GaNベースのデバイス
10年前まで、SBDやPNDを含むほとんどのGaNダイオードは、バルクGaN基板が利用できないため、横方向または準垂直方向のデバイス構造を形成する外来基板上に製造されていました。横方向または準垂直方向のダイオードは優れた電気的特性を示しますが、それでもデバイス構造に固有の欠点があります[21]。まず、ミスマッチと欠陥は避けられません。次に、異物基板上のGaNデバイスの場合、GaNドリフト層と異物基板の間にバッファが不可欠です。したがって、バッファ層の応力緩和によりウェーハの反りが発生し、GaNエピタキシー層の厚さが薄くなります[22]。さらに、大きな熱境界抵抗(基板を備えたGaN)は、高電力密度で動作するGaNデバイスのデバイス性能に深刻な影響を及ぼします[23]。
エピタキシー技術の開発により、縦型GaNデバイスに採用された低転位密度の自立型GaN(FS-GaN)基板が大きく進歩しました。 FS-GaN基板上のホモエピタキシャルGaNの材料品質は明らかな改善があり、電力アプリケーションの可能性を示しています。垂直GaNデバイスは、横方向GaNデバイスの欠点を軽減する可能性があります。まず、バッファなしでより厚いGaNエピタキシャル層を成長させることができ、 BV (横方向のGaNデバイスのそれを超える)ドリフト層の厚さによって取得および決定できます。一方、最大電界はデバイスの内部にあり、デバイスの表面から遠く離れています(横方向のデバイスで一般的に発生する電子トラップの影響を排除します)。 FS-GaN基板の品質が高いことから、2011年から垂直GaNデバイスが研究されてきました[24]。それ以来、 BV が高い垂直GaNPND 低いオン状態抵抗が製造され、優れた性能を実現しています。
PNDとSBD
実際のアプリケーションでは、ダイオードは電力変換と反転に不可欠なコンポーネントです[25]。 GaNの明確な材料特性により、GaNベースのダイオード(SBDおよびPND)は注目に値する性能を示し、電力アプリケーションの要件を満たすことが期待されます。図2に示すように、PNDは、さまざまな構造のGaNデバイスの中で最大の範囲を持ち、600〜5000 Vの電圧に耐えます。これは、より幅広いアプリケーションシナリオを示す機能です。
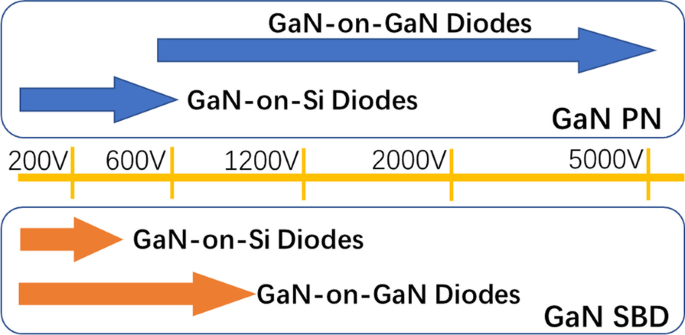
近年報告されている主な垂直GaNパワーデバイスのデバイスタイプ、レポート、および電圧クラスの概要[26]
少数キャリアのストレージの問題がなく、SBDバリアの高さが低いPNDと比較すると、GaN SBDは低い順方向ターンオン電圧( V )を備えています。 on )および高速逆回復。これらの特性は、SBDのメリットが、低い導通/スイッチング損失、高周波動作で明らかになるが、 BV が低いことを示しています。 PNDよりも価値があります。さらに、ターンオン電圧が高いと、導通損失が大きくなり、回路やシステムの効率が低下する可能性があることに注意してください[27、28]。
高倍率視野では、準垂直または垂直SBDはAlGaN / GaNSBDよりも優れた利点があります[29]。さらに、低い仕事関数の金属でバリアの高さを調整することにより、低いターンオン電圧(<0.5 V)が実現されます。ただし、バリアの高さが低いと、逆リーク電流が高くなり、 BV が低くなる可能性があります。 。その結果、性能を改善するために様々なエッジ終端構造が提案されています。さまざまなエッジターミネーションテクノロジー[27、28、30、31]の支援により、KA / cm 2 での高電流密度 BV で成績をつける ■1kVを超えることが確認されています。一方、垂直SBDは、177〜183GHzや0Vで最大902GHzのカットオフ周波数などの高周波に対しても優れた機能を発揮します。これは、テラヘルツ無線通信システムの電源に期待される機能です[12、32]。
n に関して -タイプGaN、 p 有機金属化学蒸着(MOCVD)と分子線エピタキシー(MBE)によって成長したタイプのGaNは、Mgをアクセプターとして使用することによって導入されました[33]。 GaN SBDと比較して、GaN PNDには、低い比オン抵抗( R )などの多くの利点があります。 on A )および適切なデバイスの安定性とサージ電流を抑制する機能。高いターンオン電圧(> 3 V)と比較的低いスイッチング速度にもかかわらず、バリアの高さが高く、 BV が高いため、リーク電流が非常に低くなります。 が得られます。 BV が高いことに注意してください 0.6〜5 kVは、GaNベースのPNDの最も優れたパフォーマンスです。したがって、GaNベースのPNDは、高効率と低エネルギー損失を必要とする高電力アプリケーション向けの次世代電力システムの重要なビルディングブロックとして大きな可能性を秘めています[34]。垂直GaNSBDと同様に、GaN PNDのエッジ終端も、アノード周辺の電界の混雑を緩和するように製造されています。これについては、この記事の後半で詳しく説明します。
パワーデバイスでは、PN接合を新しい接合構造として扱うこともできます。高い BV を利用するため PNDの逆リーク電流が低く、SBDのスイッチング性能が高く、ターンオン電圧が低いと同時に、接合バリアショットキー(JBS)や統合PNショットキー(MPS)などの新しいデバイス構造により、SBDとPNDの組み合わせが生成されます。 p の形成 -Schottky接触領域にグリッド領域を入力します。 JBSまたはMPSデバイスは、SBDの順方向導通とPNDの逆方向ブロッキングの特性を備えており、それぞれ従来のPNDおよびSBDよりも優れたスイッチング性能と高い逆電圧を備えていると期待されています[35]。
高出力アプリケーションに加えて、GaN PNDは、発光ダイオード(LED)、光検出器などのオプトエレクトロニクスデバイス、およびGaNベースのPN接合フォトダイオードの数pAの低い暗電流のために火炎検知にも採用されています[36 、37]。
このレビューの目的
GaNの優れた材料特性に基づいて、GaNベースのデバイスは広く研究されており、最もホットな半導体材料の1つとしてパワーエレクトロニクスアプリケーションで利用されています。 GaNベースのデバイスの中で、垂直GaNベースのPNDはかなり研究されており、優れたBFOMを示しています。エッジ端子技術は、アノードパッドの周りの電界の混雑を緩和するためにも不可欠です。
このレビューでは、主な強調点としての材料エピタキシー成長とエッジ端子技術の進歩に続いて、現在のGaNの開発、メカニズムと機能の観点からのGaN SBDとPNDの違い、および側面デバイスに対する垂直デバイスの利点について説明します。 。このレビューは、見通しを提供し、電力システムに利用される垂直GaN PNDの設計動向を明らかにします。これには、インチョート垂直GaNPNDが含まれます。垂直GaNPNDの異なる層に対応するエピタキシャル成長の開発は、セクションで紹介されています。 2.エッジターミナルテクノロジーはSectで探求されています。 3.宗派で。図4に示されるように、Si基板上の垂直IgG PNDは、代替方法として示されている。最後に、垂直GaNPNDの将来の開発の結論と展望が提供されます。
材料エピタキシーの成長
垂直PNDのGaN基板
主流のエピタキシャルプロセスとして、垂直デバイスエピタキシャル層は現在、主に水素化物気相エピタキシー(HVPE)によって製造された導電性GaN基板上にMOCVDによって成長しています。この構造では、基板の品質が次のエピタキシャル構造に直接影響します。デバイスの多くの故障メカニズムは、基板エピタキシーの品質に起因します[38]。順方向および逆方向の I をさらに改善するには、高品質の導電性GaN基板を入手する必要があります。 – V 性能、特に逆リーク電流と BV 機能。
HVPEで成長させた基板は、コストが比較的低く、再現性が高いため、大量生産に最も便利な方法と考えられています。しかし、初期の段階では、未成熟な成長技術は、HVPEによって成長したGaN基板のバックグラウンドキャリア濃度が高いことを意味していました(> 10 19 cm -3 )そして不十分な結晶品質。したがって、デバイス構造を成長させるためにHVPEは採用されませんでした[39]。エピタキシー成長技術の急速な発展により、HVPEによる高品質のバルクGaN材料が徐々に可能になります[40、41]。基板とは別に、デバイス内の部分的なエピタキシャル層をHVPEで成長させることができ、成長したデバイスと比較して、HVPEとMOCVDエピタキシャルプロセスをカーボンフリー技術と組み合わせることで、より高い電流均一性とGaN表面のマクロステップの排除を実現できます。 MOCVDのみ[42]。
現在、最小転位密度が10 4 未満の市販のGaN基板 cm −2 利用可能です。低欠陥密度のGaN基板上のGaN垂直PNDが処理されました。ただし、ウェーハの曲がりは依然として問題です。有望な解決策として、アンモノサーマル法は、より優れたエピタキシー品質のGaN基板を実現できます。高圧オートクレーブと超臨界アンモニアを使用すると、貫通転位を10 4 まで大幅に減らすことができます。 –10 5 cm −2 [43]。アンモノサーマル法を使用すると、0.001Ωcm 2 の低抵抗 高濃度にドープされた n を使用したGaN基板内 -タイプ(1×10 19 –1×10 20 cm -3 )と同様に BV が報告されました 3kVの[44]。ただし、アンモノサーマル法の欠点は、成長速度が約80〜90μm /日と低いことです。これは、実際の生産には不利な機能です。成長率を改善し、高い材料品質を維持することも、その後の研究にとって有益な方向性です。
市販のGaN基板に加えて、非Ga面( c )を含むいくつかの基板も特徴的な性能について調査されました。 -平面)基板。一般的に、Ga極性(つまり、 c -平面)基板は、GaN垂直デバイスに使用されます。次に、次のエピタキシャル層は劇的な分極効果を示します。ただし、Ga極性の対応物とは反対の方向では、 N に沿ったホモエピタキシャル層 -極性方向は、分解温度が高く、極性に依存する特性があるため、独自のデバイス特性を示します[45、46]。 N で -極性単結晶FS-GaN基板、エッジ終端のない2.2 MV / cmの電界、および BV N 2 で2.4kVの O表面プラズマ処理およびフィールドプレート(FP)[46、47]。別の特別なGaN基板として、 m -平面は、 m でGa:Nが1:1である無極性特性を考えると、広く注目されています。 - c のGaのみに関する平面 -極性があり、 N のみ N で -極性基板。この無極性GaN基板では、2.0 MV / cmの臨界電界と、FPまたはエッジ終端のない高いオン/オフ比でPNDの特性が報告されました[48]。
N-GaNエピタキシャル技術
高品質の導電性GaN基板が存在する前は、GaN PNDは主に、Si、SiC、サファイアなどの異物基板上に製造されていました。したがって、デバイスの構造は常に横方向のものに限定されていました。エピタキシャル品質を改善するために、横方向構造に基づく方法を提案した。横方向デバイスのウィンドウ領域での低い貫通転位(TD)を考えると、マスクを横切って横方向に成長したGaNエピタキシャル層は、はるかに低いTD密度を達成できます。したがって、ラテラルPND用のサファイア基板上にGaNエピタキシャル層を成長させるために、ラテラルエピタキシャルオーバーグロースが実行されました。逆リーク電流は3桁抑制されました[49]。
エピタキシャル技術の開発により、3×10 –6 の低転位密度を備えた高品質の単結晶GaN基板 cm −2 利用可能になり、GaNPNDはGaN基板上に製造されました。成長させたMOCVDによって上部エピタキシャル層と組み合わせると、デバイスは低いリーク電流と高い BV を示します 6〜40μmのドリフト厚に対応する600 V〜4 kV [16、50]。サファイア基板上のデバイスに関しては、逆リーク電流と BV 大幅に改善されました[51]。
ネイティブGaN基板では、通常、外来基板のようなPNDエピタキシャル構造では特別なバッファ層は発生しません。参考として、PNDのバッファ層がGaN基板に与える影響を調べた。バッファ層の存在は、ドリフト層の欠陥密度が低いことを意味します。一方、より高い BV ドリフト層は薄くなりますが、バッファ層は厚くなります。デバイスの逆リーク電流も改善されました。これらのデバイスパラメータは、バッファ層の厚さと強い関係を示し、デバイスの前方特性にわずかな影響を及ぼします[52]。
この部分で説明するように、上部のエピタキシャル層は、MOCVD、有機金属気相成長法(MOVPE)、およびMBEによって堆積されます。 PNDのエピタキシャル構造には、高濃度にドープされた n が含まれます。 + -GaN層と n のドリフト層 − -基板と p の間のGaN -GaN(図3)。高濃度にドープされた n + -GaN層は、一部のレポートでは導電性GaN基板上の遷移層として機能します。
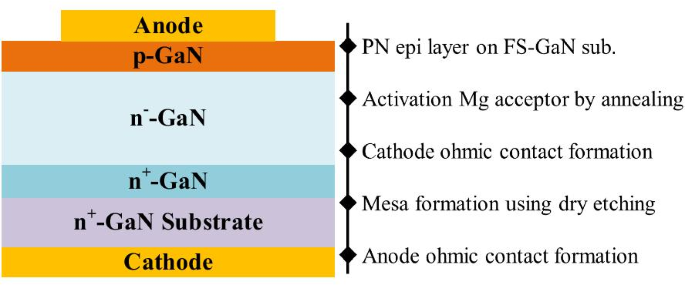
GaN垂直PNDの概略構造と製造プロセス
一般的に、 BV デバイスのアプリケーションシナリオを決定します。たとえば、より高い BV SiCデバイスをGaNと比較すると、電気自動車や新幹線などの高電力および高電圧アプリケーションでSiCデバイスを利用できます(図1)。同様に、PNダイオードは通常、ショットキーダイオードとHEMTに対してより高い電圧で印加されます。 PNDでは、 BV 主にドリフト層(低濃度にドープされた n )によって行われます。 − -空乏領域の広がりを伴うGaN層)(印加電圧 V での式1に示されているように) V デバイスが逆バイアス下にある場合、順方向/逆方向バイアスに対して正/負になります。さらに、逆バイアスがさらに増加すると、ブレークダウンが発生します。
$$ {W _ {\ text {D}}} =\ sqrt {\ frac {{2 {\ varepsilon _ {\ text {s}}} \ left({{V _ {{\ text {bi}}}}-V } \ right)}} {q} \ frac {{{N _ {\ text {A}}} + {N _ {\ text {D}}}}} {{{N _ {\ text {A}}} {N_ {\ text {D}}}}}} $$(1)ここで S 、 q 、 V bi 、 N D 、および N A は、接合部の面積、電荷、ビルトインポテンシャル、ドナー濃度、アクセプター濃度です[53]。
枯渇幅に応じて、デバイスを非パンチスルー[ W D > W Dm ( W Dm :最大空乏層幅)]およびパンチスルー( W D < W Dm )。エピタキシー構造とエッジの問題を考えると、ほとんどのGaN垂直デバイスはパンチスルータイプに分類されます。つまり、それらの空乏領域は n 全体を超えて拡大します。 − -GaN層と n に到達 + -破壊前のGaN基板。
さらに、式(1)で説明されているように。 (2)、 BV 厚みを増やし、 n を減らすことで、強化できます。 ドリフト層のタイプドーピング濃度。
$$ {\ text {BV}} ={E _ {\ text {C}}} t- \ frac {{q {N _ {\ text {D}}} {t ^ 2}}} {{2 {\ varepsilon_0 } {\ varepsilon _ {\ text {r}}}}} $$(2)ここで E C 、 q 、 t 、 N D 、およびε r は臨界電場、電子電荷、 n − -GaN層の厚さ、 n の正味のキャリア濃度 − -GaN層、および半導体誘電率、それぞれ[54]。幸いなことに、経験によれば、厚さが厚く、ドーピングが少ないドリフト層は、順方向伝導のオン状態抵抗のわずかな増加にしか寄与しません。
BV を強化する場合と比較して ドリフト層の厚さを増やし、 n を減らします n のタイプのドーピング濃度 − -GaN層は、Si、Oなどのバックグラウンド濃度が高いため、現在困難です。 n のドーピング濃度をさらに下げるため − -GaN層、意図しないドーピング濃度を調査します。多くの研究グループが、公称i-GaN約10 15 を導入しました。 –10 16 cm − 3 p に連絡する - p を形成するGaN – i – n ダイオードのBVを改善するための構造[55]。
確かに、これらの対策の前提条件は、TDがオフ状態のリークを増加させ、 BV を劣化させる可能性があるため、ドリフト層のエピタキシャル品質が高いことです。 プロパティ[56]。
GaN垂直PNDのドリフト層のエピタキシャル品質をさらに改善するために、MBEによる成長をGaN基板上で調査しました。 3 nA / cm 2 未満の漏れ電流 非常に低い転位密度により、3.1 MV / cmの電界が得られました。ほぼ理想的な破壊性能は、MBEがGaN垂直PNDでエピタキシャル層を成長させるための効果的な方法であることを示しています[56]。ただし、アンモノサーマル成長と同様に、エピタキシャル速度も別の欠点です。
P-GaNエピタキシー
GaN垂直PNDの重要なコンポーネントであるP-GaNは、1969年にHVPEによってGaNが登場して以来、1989年に報告されました[57、58]。それは最初に青色LEDを得るために利用されました。次に、 p -GaNは、ノーマリーオフデバイスやPNDなどの電気デバイス分野で徐々に採用されました。垂直GaNPNDでは、 p -GaNは光を構成します(約10 19 cm -3 )そして重い(≥10 20 cm -3 )ドーピング濃度。これは、ドリフト層とのPN接合層の形成と、アノード電極としてのオーミック接触の促進に対応します。
一般に、 p のエピタキシャル成長 -GaNは約1000°Cの温度でMOCVDによって製造され、Mg 2+ を採用しています。 アクセプターとして。次に、成長した p -GaN層は、N 2 で700〜800°Cの高温で活性化する必要があります 周囲温度またはO 2 で400°C 周囲に存在するため、比較的高い正孔濃度が促進されます[59,60,61]。ただし、Mg-H結合の150〜200 meVの高いイオン化エネルギーは、 p を意味します。 -GaNの活性化率はわずか1〜3%です。低い活性化率は、温度にも関係しています。 Mgドーパントは、NH 3 で600°C以上の高温で再不動態化できます。 または水素アンビエント[62]。正孔濃度を改善するために、 p のドーピング濃度が高いため、ドーピング濃度を上げるだけでは実行できません。 -GaNは、層の結晶品質を低下させ、自己補償効果によって正孔密度を低下させる可能性があります[63]。現在、正孔密度のピークは通常、約3×10 19 のアクセプター濃度で達成できます。 cm -3 [64]。 p にはいくつかの問題がありますが -GaN、関連する調査報告はあまりありません。それは2つの理由に起因する可能性があります。 1つは、材料とエピタキシャル装置の固有の特性の制限です。もう1つは、現在の p -GaNは、デバイスのパフォーマンスを比較することもできます。
ただし、成長条件の最適化と新しいエピタキシャルプロセスはまだ調査中です。たとえば、2017年に、非アクティブ化された再成長した p -MBEによるGaNが提案され、MOCVDよりも優れています。低水素成長環境では、 BV 製造された垂直GaNPNDによって、1.1kVの理想係数と2.5の理想係数が達成されました[65]。もう1つの興味深い p -GaNの製造方法は、超高圧アニーリング(UHPA)プロセスを使用したMgイオン注入です。結果は、70%の高い活性化率と24.1 cm 2 の正孔移動度を示しています。 V -1 s -1 N 2 で1573〜1753Kの温度での注入後アニーリングで達成されました 1GPaの圧力。この結果は、MOCVDによるエピタキシー成長の結果に匹敵します[66]。
結論として、基板については、市販の低欠陥GaN基板が現在入手可能です。一方、エピタキシャル技術はまだ発展途上であり、デバイスの性能に大きな影響を与える状況です。 MOCVDと比較して、MBEは優れたエピタキシャル品質を実現できるため、エッジ終端のない優れたデバイス性能が得られます。ただし、成長率が遅く、コストが高いため、MBEは大規模な生産性には不向きです。 MOCVDによるエピタキシー成長は、実際の主な生産方法です。したがって、MOCVDによって成長させたエピタキシャル層の品質を改善することは緊急の問題であり、かなりの時間がかかるだろう。したがって、この段階で優れたパフォーマンスを発揮するために、高度なデバイス構造の設計または対策が提案されています。
エッジターミネーションテクニック
垂直GaNPNDの場合、 BV 重要なパラメータです。垂直GaNPNDに関するほとんどすべての調査は、逆方向での耐電圧の改善に集中しています(つまり、 BV )。ただし、PN接合のエッジ、空乏層のエッジ、または電極のエッジでの電界の密集により、早期の破壊が頻繁に発生します。したがって、デバイスの電界混雑を低減するために、高度なデバイス構造設計(すなわち、エッジ終端技術)が開発されています。さまざまなエッジ終端技術が採用され、GaN PNDのエッジでの電界の密集を緩和して、より高い BV を実現しています。 。これらの技術には、主にフィールドプレート(FP)、イオン注入とプラズマ処理、さまざまな角度またはステップでのメサエッチング、およびガードリング(GR)が含まれます[49、67、68、69]。これらの機能については、このセクションで説明します。
メタルフィールドプレート
FPは、ゲート、アノード、または接合のエッジから遠く離れたピーク電界を転送するために、GaNベースのデバイスで広く利用されています。この方法には、逆バイアス下でPNエッジの電界強度を緩和する同じ機能があります。さらに、FPターミネーションを使用することで、低リーク電流と逆電圧下での高ブレークダウン電圧を実現できます。FPターミネーションは、製造プロセスも比較的簡単です。
FP構造のメリットには、製造プロセスが単純で、デバイスプロセスとの互換性があります。同時に、FPの誘電体層はデバイスのパッシベーション層でもあります。図4aに示すように、垂直GaN PNDの最も初期で最も広く使用されているエッジ終端として、最初は非拡張FP終端が使用されていました。 FP構造を製造するために、メサ構造は誘導結合プラズマ(ICP)ドライエッチングによって処理されました。次に、プラズマ損傷による寄生リーク電流を抑制するために、不動態化誘電体膜がアノード電極全体とメサ構造全体に堆積されました[70]。
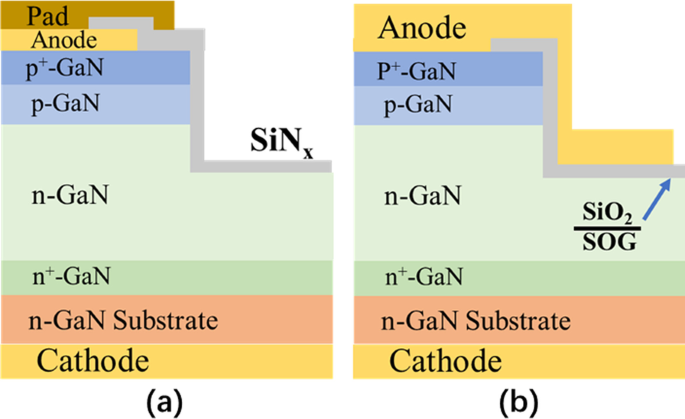
a のPNDの構造 FPと拡張パッシベーション誘電体層および b 拡張FP金属およびパッシベーション誘電体層[70、71]
PN接合エッジ周辺の電界混雑をさらに緩和するために、FPの拡張金属を利用してメサ全体を覆い、逆リーク電流を低減して BV を上昇させました。 [71]。この最適化されたFP構造は、現在、垂直GaNPNDの製造に広く採用されています。図4bに示すように、 BV 拡張FP構造で3kVを超えて上昇しました。一方、逆リーク電流も3kVの逆電圧で非常に低いレベルに抑制されました。
FP構造の必須コンポーネントとして、パッシベーション層はデバイスの特性に大きな影響を与えます。したがって、適切なパッシベーション層が不可欠です。高い k を所有するパッシベーションレイヤー 誘電率はシミュレーションによって提案され、均一な逆電流も得られます[50]。この理論によれば、Ga 2 を使用したFP終端を備えた垂直GaNPND O 3 (誘電率10)不動態皮膜として報告されました。 BV 200Vから550Vに大幅に改善されたため、Ga 2 などの高誘電率膜が O 3 は、デバイスの特性を向上させるための垂直GaNPNDのFP終端のパッシベーション膜として有望です[72]。ただし、FPの終了にはいくつかのデメリットがあります。主な問題は、誘電体層の堆積中の欠陥と、誘電体とGaNの間の界面であり、キャリアトラップが発生します。これらは、長期間の使用中にデバイスのパフォーマンスを不安定にする可能性があります。したがって、誘電体層の最適化された堆積プロセスを調査する必要があります。
メサの終了
メサエッチングは、平面GaNベースのデバイスの製造において隣接するデバイスを分離するために不可欠なステップです。単純なプロセスを考えると、この構造は垂直GaNPNDプロセスで一般的です。 PN接合のエッジでの均一な電界は別として、高い BV 非破壊的でなだれ特性を備えたPNDを実現できます。たとえば、シンプルでありながら深いメサ構造は、優れたパフォーマンスを得ることができます。図5aに示すように、垂直PNDでメサ構造の深さが10 µmを超える場合、非破壊的な BV 雪崩特性が確認されました[73]。
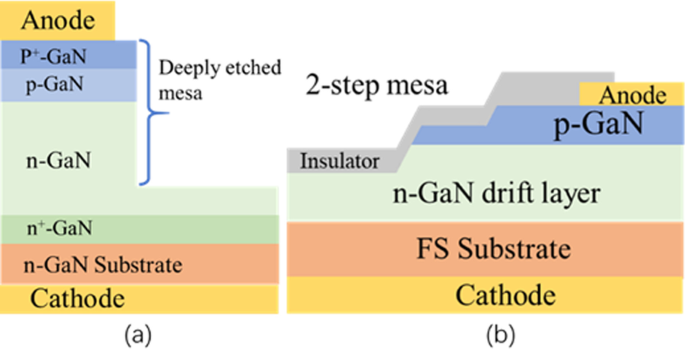
a 深くエッチングされたメサ構造のPND。 b 2段階メサを伴うPND [73、74]
図5bに示すように、新しいメサ構造が調査されます。マルチメサ(2メサ)構造が垂直PNDに採用されました。一般的な単一メサ構造に関して、2メサ構造はピーク電界をPN接合の端から薄くなった p の下にシフトさせることができます。 -薄くなった p の穴が完全に枯渇したため、上部メサのGaN -GaN層。高い BV 非破壊機能を備えた4.7〜4.8 kVは、2メサ構造によって正常に達成されました。前方の I を下げることなく雪崩能力が得られました – V 特性[74]。一方、2メサ構造は準垂直PINDに対して同じ機能を持っています[75]。 BV 同時に低リーク電流で665Vから835Vに拡張されました。
一般的な垂直メサ構造に加えて、負の斜角を持つメサ構造が最近提案され、PN接合のエッジでの電界の混雑を緩和しました。負の斜角メサでは、斜角θのときに、エッジの電界が減少する傾向があります。 90°から下げられます。 ピーク電界はデバイス内部に伝達されます。 [76]では、実験的調査により、斜角のメサ構造(図6a)がより高い BV を誘発する可能性があることが示されました。 3 kVを超え、 BV に対して低リーク電流 同じFP構造を使用した場合、急勾配のメサを持つPNDで3kVになります。技術コンピュータ支援設計(TCAD)を使用したシミュレーションによって、さらなる調査が行われました。斜角メサを備えた垂直GaNPND(図6b)では、最大電界はアクセプター濃度 N によって決定されました。 A p で -GaN、ドナー濃度 N D n で − -GaNドリフト層、およびθ 斜角メサの。理論的な分析とシミュレーションにより、小さいθ E が高くなる可能性があります pp (平行平面降伏場)。同時に、低濃度にドープされた p -GaNは高い BV を達成するのに有益です 固定のθの場合 斜角メサの。 θを取る 例として=10°、実験結果はこれらの発見を裏付けています。 2.86 MV / cmの平行平面降伏場が達成され、この結果はシミュレーションと一致しています[77]。
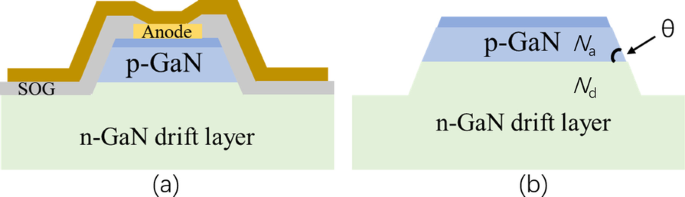
PND構造と a の概略クロス 斜角メサとFP構造、 b PNDエピタキシャル構造は、 N を処理することによってシミュレートされます。 A 、 N D およびθ 変数として[76、77]
FP終端と同様に、エッジ終端のプロセスでは、ドライエッチングおよび/または絶縁体(またはパッシベーションフィルム)が必要です。したがって、ドライエッチングによる損傷を考慮する必要があり、早期の故障であっても、高い逆リーク電流を引き起こす可能性があります。同時に、エッチングの精度を高めるためにエッチング装置への需要が高く、エッチングの深さを制御することは困難です。一方、損傷が存在すると、絶縁体とエッチングされた半導体の間にさらに複雑な界面状態が発生し、デバイスの信頼性に影響を与える状況になります。したがって、被害の軽減または軽減は避けられない問題です。現在、いくつかのレシピ(たとえば、ウェットエッチングによる損傷の除去とドライエッチングによる損傷の修復の機能をそれぞれ備えたテトラメチルアンモニウムヒドロキシド(TMAH)とポストアニーリング)が採用され、エッチングされた表面を処理してパフォーマンスを向上させています。
イオン処理
イオン注入は、エッジ付近の電界集中を緩和するために採用されました。比較的単純な終端構造として、注入ベースの技術がGaNデバイスで調査されました。これには、補償種(O、H、Znなど)または不活性種(Ar、N、He、Krなど)が含まれ、終端領域の深いレベルのトラップ[78,79,80,81,82]。最近、垂直GaN PNDでの早期破壊の発生を緩和するために、イオン注入された終端(たとえば、N、F、Mg、およびH)も利用されています。ただし、これらのイオン注入終端のメカニズムは異なります。
垂直GaNSBD [83]に関して、垂直GaN PNDへのN注入は、ドナーのような欠陥( N )の作成を伴う異なるメカニズムを明らかにします。 空室と N インタースティシャル) p を補正する タイプのドーパント。 N による処理後 図7aおよびbに示すように、 p の導電率 -GaNは、N注入によって還元または除去(絶縁)できます[53]。 BV をさらに改善するため 、完全に補正されていないレイヤー、つまり、 p の部分的に補正された対応するレイヤーと結合された完全に補正されたレイヤーが提案されました。 -GaN。したがって、より高い BV が予想され、そのメカニズムはシミュレーションによって分析された[84]。実験結果は、部分的に補償された p によるN注入を示しています。 + -GaNは BV を誘発する可能性があります 前方特性を損なうことなく1.68kVの[85]。
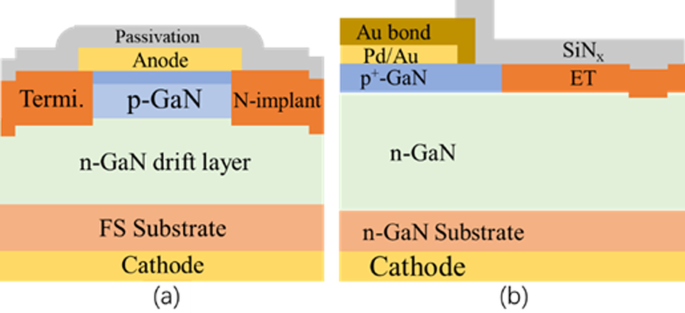
a N を使用したPNDの断面プロット 着床の終了、および b N 完全および部分的に補償された着床終了[53、84]
水素プラズマ(Hプラズマ)エッジ終端も p を減らすことができます -GaNの導電率ですが、別のメカニズムがあります。 Hプラズマ処理は、導電性の p を変換するための効果的な不動態化法です。 - p のMg-Hの強い結合により、GaNを高抵抗膜に変換 -GaN。 N注入とは対照的に、Hプラズマ処理は、損傷が少なく、温度が低く、操作が簡単なため、垂直GaNPNDでの使用に適しています。図8aに示すように、PNDは、Hプラズマ処理だけで3.0 MV / cmの電界を示しました。同時に、デバイスは同等のフォワード I を示しました – V 特性とより低い逆リーク電流[86]。
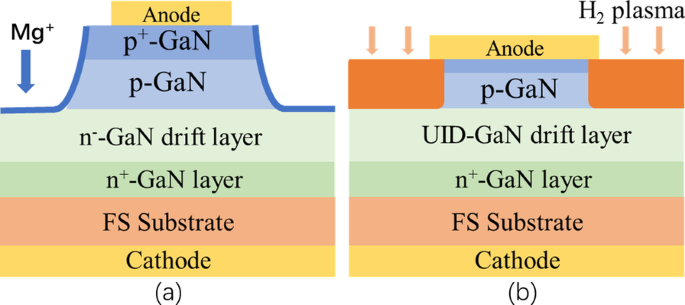
a Mgイオン処理によるPND構造の概略図。 b H 2 のPND プラズマ治療[86、88]
同時に、フッ素(F)イオンには、デバイスが逆バイアス下にあるときに負の固定電荷によるピーク電界を変調する機能もあります。それでも、Fを埋め込んだエッジ終端を垂直GaN PINDで実行する場合は、厳密な設計と構造の最適化が必要です[87]。
エッジ終端としてのN、H、およびFイオン注入に加えて、Mgイオン注入は、ICPドライエッチングの損傷に起因する表面/界面状態を変換するための代替方法でもあります。最近、堀メサと組み合わせた新しいMgイオン注入が採用され、GaN垂直PNDのドナーのような損傷を補償しました(図8b)。次に、 BV 1.5 kVは、特定のオン状態の R で達成されました。 on 0.7mΩcm 2 [88]。
イオン注入の終了は、 BV が高い場合に効果的な方法です。 垂直GaNPNDで。イオン注入プロセスも比較的簡単です。ただし、高エネルギーイオン注入中に結晶損傷が発生します。さらに、結晶の損傷を軽減するために、一部のイオン注入終端では高温でのポストアニーリングが必要です。長方形のイオン注入プロファイルを追求するため、注入深さを正確に制御する必要があります。最後に、イオン注入プロセスは単純ですが、高エネルギーイオンを使用するため、必要な機器は高価です。
ガードリング
BV を改善するためのエッジターミネーションとしてのフローティングガードリング(GR)の使用 は、垂直GaN PNDの効果的な方法であり、逆電圧ではGRを介して電圧降下が発生し、電界の混雑を緩和します。同時に、GR製造プロセスは、アノード金属の堆積と同期する特別なステップを必要としません。より高い BV の場合 、FP構造のGRはPNDで製造され(図9a)、さらに電圧降下するための抵抗デバイスとして、GRとアノード部分の間にポリイミドがセットされました。抵抗部分のため、 BV の0.2〜0.4kVの増分 最大5.0kVが得られました。 GR構造のない通常のPNDと比較して、抵抗性GRを備えたデバイスは同様の順方向 I を示しました。 – V R の特徴 on 1.25mΩcm 2 、ただし、BFOMが20 GW / cm 2 の場合、逆リーク電流は低くなります。 [69]。
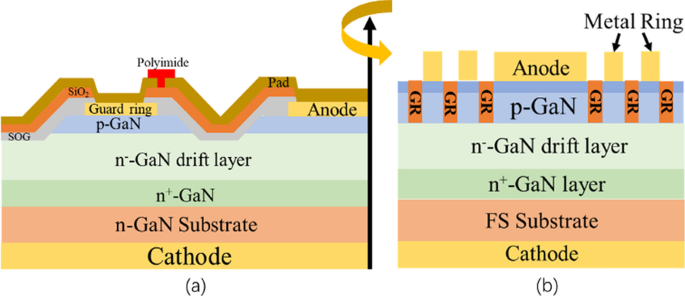
a フローティングGR終端を備えた垂直GaNPND構造。 b Hが埋め込まれたGRを使用したPND構造[69、90]
フローティングGRに加えて、HプラズマベースのGR構造もエッジ終端を形成するために適用されました。損傷が少ないことに加えて、Hプラズマの拡散係数が低いと、GaNで比較的理想的なプロファイルが得られる可能性があります[89]。 p に対するHプラズマの不動態化効果による -GaN、導電性 p -GaNは高抵抗になり、GR構造はその後高抵抗 p によって形成されました。 -GaNリング(図9b)。 BV を改善するために、1〜2 µmの狭いGR幅と減少する間隔が使用されました。 さまざまなリングを持つGR構造が測定されました。リングが変化するPNDは、約0.65mΩcm 2 の同様の前方特性を持っています。 GRなしのものと比較して1.65の理想係数。より多くのGRは、デバイスエッジでの電界をさらに緩和する可能性があります。したがって、デバイスはより高い BV を示しました 測定後にリングの数を増やすことによって。その結果、PNDは BV を示しました 1.7 kVで、最高電界は3.43 MV / cm 10 GR [90]です。
GRの欠点は、面積利用率が低いことであり、GR構造は一般に、アノードよりもさらに大きな面積を必要とします。次に、GRの量は、GRの幅や間隔などの設計の難しさを高めます。現在、より高い BV のために、2種類以上のエッジ終端が単一の垂直GaNPNDに採用されています。 。これらのエッジ終端には、製造が比較的単純なため、通常、FP、斜角メサ、およびガードリングが含まれます。一方、これらのエッジ終端は、イオン処理に関してGaN結晶に外来元素を導入することを意図したものではありません。これは、デバイスの性能に有益な機能です。ただし、エピタキシャル層の品質は依然としてかなりの割合を占めています。
Si基板上の垂直GaNPND
今日まで、垂直GaN-on-GaNデバイスは優れた性能を示しますが、GaN基板の高コストと小径は、依然として大規模な市場アプリケーションを妨げています。 Si基板の大規模かつ低コストのメリットを考えると、この段階でGaN-on-Siデバイスはかなり多くの注目を集めています。
Si基板上の準垂直PNDには、高品質のバッファが不可欠です。 [91]では、図10aに示すように、AlN核形成層とそれに続く成長プロセスを最適化して、2.95×10 8 の低い貫通転位密度を持つGaNドリフト層を示しています。 cm −2 720 cm 2 の高い電子移動度 / Vsが得られました。 FP構造では、デバイスに BV があります R で820Vの on 0.33mΩcm 2 。
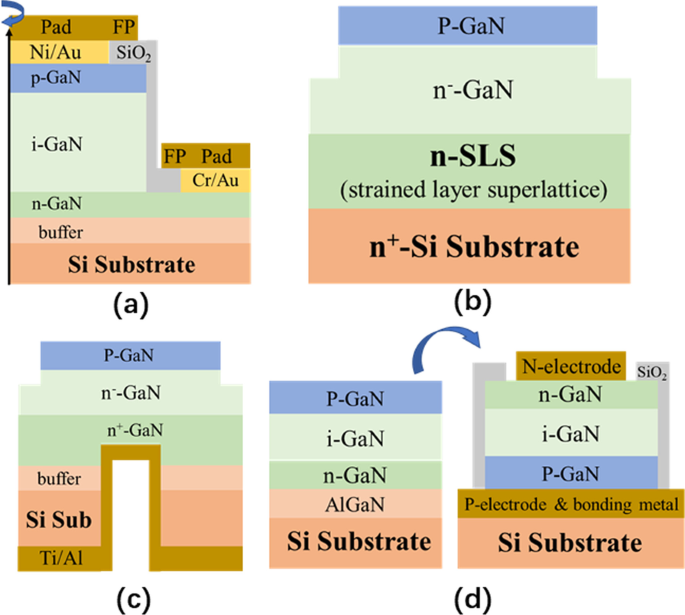
a FPを使用した準垂直PIND。 b 導電性Si基板上に薄いAlNおよびSLS超格子構造を使用することによる完全に垂直なPND。 c 背面にトレンチオーミック接触があるPND。 d 層転写技術によって製造されたPND [91,92,93,94]
材料の不一致の課題に加えて、導電性バッファ層とSi基板は、Si基板上の完全に垂直なPNDの基本です。図10bでは、 n + タイプSi基板は、垂直PNDのカソードとして最初に利用されました。続いて、デバイスの性能を向上させるために、Siをドープした薄いAlN層とGaN / AlNが歪んだ超格子層が採用されました[92]。 Si基板上の垂直PNDは、FPおよび BV で提案されます。 288 Vは、1.5 µmのドリフト層で確認されています。さらに、より高い BV 5.7 µmのドリフト層を持つSi上のPNDの720 Vの値は、図10cに報告されています[93]。導電性Si基板法とは異なり、カソードオーミックオンバックアプローチは、 n に到達するトレンチによって作成されました。 + -通常のSi基板とバッファ層を選択的に除去したGaN層。
導電性Si基板と背面のトレンチオーミックコンタクトに加えて、基板除去技術は、Si基板上に垂直GaNPNDを生成するための代替方法です。図10dでは、層転写技術を使用して、Si基板上の垂直PINDを処理しています。 Si基板を除去した後、転送、 n -電極、および側壁のパッシベーション、デバイスは低い R を示します on 3.3mΩcm 2 および BV 350Vの[94]。 37.0 MV / cm 2 の高いBFOM値 PINDの例は、基板除去技術がSi基板上でのGaNベースのPIND製造に効果的な方法であることを示しています。ただし、他の技術と比較して、より複雑な製造プロセスとより高い製造コストは、基板除去部品の間に対処しなければならない問題です。
代替の技術ルートとして、Si基板上のPNDは、準垂直または垂直のデバイス構造で製造されます。 Si基板とGaNエピタキシャルスタック間の実質的な材料の不一致を軽減するには、より効果的なエピタキシャル技術を調査する必要があります。より高い BV の場合 、より高い BV には、より厚いドリフト層も不可欠です。 。 Si基板のドリフト層の厚さは約5µmであるため、この事実は調査すべきもう1つの重要な問題です。
将来の課題と結論
垂直PNDは、高電流(> 100 A)と高電圧(> 600 V)を同時に取得するために不可欠です。これは、電気自動車やリサイクルエネルギー処理などのいくつかのアプリケーションの要件を満たすことができます。大きな進歩が達成されたにもかかわらず、垂直GaN PNDのアプリケーションは、コストや技術的限界などのいくつかの障壁のままです。
FS-GaN基板の場合、一般的なMOCVDにより、低い貫通転位を伴う高いエピタキシャル品質が達成されています。 FS-GaN基板のサイズが小さく、コストが高いため、垂直GaN PNDのアプリケーションは狭い範囲に限定され、サイズが小さいとGaNの価格も高くなります。市販のGaN基板はわずか2インチで、4〜6インチのSiCおよび8〜12インチのSi基板よりもはるかに小さいです。垂直GaNPNDの主な課題は、高いエピタキシャル品質、特に p の高品質を実現することです。 -正孔濃度の高いGaN層。最近、 p を置き換えることで新しいPNDが提案されています -NiOを含むGaN x 熱酸化またはスパッタリングによって合成された; p の代わりとして、優れたパフォーマンスも実証されています -垂直PNDのGaNとGaNSBDのガードリング[95,96,97,98]。
この研究では、最も有望なパワーデバイスの1つである垂直GaN PNDをレビューし、要約します。さまざまな材料(SiC対GaN)およびさまざまなデバイス構造(SBD対PND)、材料エピタキシー成長およびエッジ終端技術(FP、MESA、イオン注入およびGRエッジ終端)の比較を含む、垂直GaN PNDの最近の進歩は次のとおりです。議論された。 R の値 on 対 BV さまざまな技術によるプロットが図11に示されています。エピタキシャル技術とは別に、エッジ終端技術は、この段階で高いデバイス性能を達成するために垂直GaNPNDにとって重要な役割を果たします。デバイス性能の面で大きな進歩にもかかわらず、垂直GaNPNDの利点は十分に活用されていません。垂直GaNPNDの特性は、後続の研究でデバイス構造とエピタキシャル品質を最適化することによって促進できます。その後、成熟したエッジ終端とエピタキシャル技術を備えた商用化された垂直GaNPNDが間もなく利用可能になります。
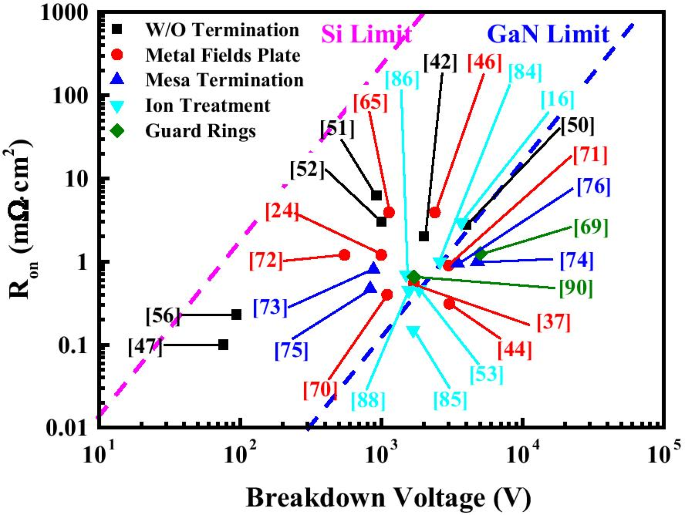
R のベンチマーク on 対 BV 準垂直または完全垂直GaNPNDの数
データと資料の可用性
現在の調査中に使用または分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- GaN:
-
窒化ガリウム
- SiC:
-
シリコンカーボン
- PND:
-
PN接合ダイオード
- PIND:
-
P-i-N接合ダイオード
- SBD:
-
ショットキーバリアダイオード
- IGBT:
-
絶縁ゲートバイポーラトランジスタ
- BJT:
-
バイポーラ接合トランジスタ
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- BFOM:
-
バリガの性能指数
- HFET:
-
ヘテロ構造電界効果トランジスタ
- JFET:
-
接合型電界効果トランジスタ
- 2DEG:
-
二次元電子ガス
- BV:
-
絶縁破壊電圧
- FS:
-
自立型
- MOCVD:
-
有機金属化学蒸着
- MBE:
-
分子線エピタキシー
- JBS:
-
ジャンクションバリアショットキー
- MPS:
-
統合されたPNショットキー
- LED:
-
発光ダイオード
- HVPE:
-
水素化物気相エピタキシー
- FP:
-
フィールドプレート
- TD:
-
貫通転位
- MOVPE:
-
有機金属気相エピタキシー
- HEMT:
-
高電子移動度トランジスタ
- UHPA:
-
超高圧焼鈍
- GR:
-
ガードリング
- ICP:
-
誘導結合プラズマ
- TCAD:
-
テクノロジーコンピュータ支援設計
- TMAH:
-
テトラメチルアンモニウムヒドロキシド
ナノマテリアル



