ハイブリッドトレンチカソードを備えた高精度AlGaN / GaN逆ブロッキングCRD(RB-CRD)
要約
トレンチショットキーアノードとハイブリッドトレンチカソードを備えたAlGaN / GaN横方向逆ブロッキング電流調整ダイオード(RB-CRD)が提案され、シリコン基板上で実験的に実証されています。アノードに統合されたショットキーバリアダイオード(SBD)は、0.7Vのターンオン電圧と260Vの逆ブレークダウン電圧を示します。ハイブリッドトレンチカソードは、アノードSBDと直列に接続されたCRDとして機能します。 RB-CRDでは、1.3Vのニー電圧と200Vを超える前進動作電圧を実現できます。 RB-CRDは、25〜300℃の広い温度範囲で優れた定常電流を出力することができます。さらに、順方向調整電流は、− 0.152%/ o 未満の小さな負の温度係数を示します。 C。
背景
ワイドバンドギャップ半導体は、次世代の高出力、高周波、高温デバイスで大きな注目を集めています。 GaNは、大きなバンドギャップ、高い電子移動度、高い臨界電場などの優れた特性により、最も有望なワイドバンドギャップ半導体の1つです[1,2,3,4,5]。さらに、自発分極と圧電分極の組み合わせにより、AlGaN / GaNヘテロ界面で高密度の二次元電子ガス(2DEG)を実現できます。このような優れた特性により、AlGaN / GaNベースのパワーデバイスは、高いブレークダウン電圧を維持しながら、低いオン抵抗で動作することができます。 GaN-onシリコン(GaN-on-Si)プラットフォーム[6,7,8]は、大口径シリコンウェーハの入手可能性と既存の成熟したCMOS製造プロセスとの互換性。現在までに、さまざまなパワーデバイス[9、10、11、12、13、14、15、16]がAlGaN / GaN-on-Siで実証されており、そのうちのいくつかは市販されています。同時に、新しい機能を備えたAlGaN / GaNデバイスの開発は、AlGaN / GaN-on-Siの応用可能性を拡大する可能性があり、AlGaN / GaN技術の広範な商業化を後押しするのに有益です。
図1aに示すように、この作業では、逆ブロッキング電流調整ダイオード(RB-CRD)と呼ばれる新しいタイプのデバイスがAlGaN / GaN-on-Siで実験的に実証されました。 RB-CRDは、トレンチショットキーアノードとハイブリッドトレンチカソードを備えています。トレンチショットキーバリアダイオード(SBD)がアノードに形成され、CRDがハイブリッドトレンチカソードで実現されます。 RB-CRDは、CRDと直列に接続されたSBDと見なすことができます。 RB-CRDの一般的な用途は、図1bに示すようにバッテリー充電です。前述のバッテリ充電回路では、CRDは定電流源として機能し、入力とバッテリ間の順方向電圧変動に関係なく、定電流を出力してバッテリを充電します[17、18、19]。入力電圧がバッテリー電圧を下回ると、回路内の逆バイアスされたSBDによってバッテリーの放電が防止されます。
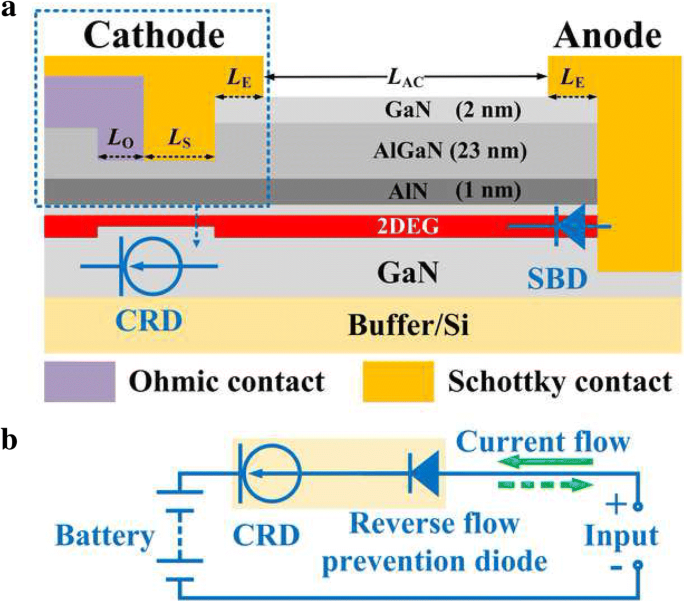
a RB-CRDの概略断面図。 b RB-CRDを使用したバッテリー充電の回路図
メソッド
RB-CRDの製造に使用されるエピタキシャルAlGaN / GaNヘテロ構造は、有機金属化学蒸着(MOCVD)によって6インチ(111)シリコン基板上に成長しました。エピタキシャル層は、2 nm GaNキャップ、23 nm AlGaNバリア、1 nm AlN中間層、300 nm GaNチャネル、および3.5μmバッファで構成されています。 2DEGのホール効果測定密度と移動度は9.5×10 12 でした。 cm −2 および1500cm 2 それぞれ/ V・s。デバイスの製造プロセスを図2に示します。最初に、浅いトレンチ(図3を参照)が低電力Cl 2 によってRB-CRDのカソードにエッチングされました。 / BCl 3 ベースの誘導結合プラズマ(ICP)エッチング技術。開発されたエッチングレシピを使用して、RFパワー20 W、ICPパワー60 W、Cl 2 を使用して、7 nm / minのエッチング速度が観察されました。 5 sccmのフロー、およびBCl 3 10sccmのフロー。次に、同じICPエッチング技術を使用してデバイスを切断し、深さ300nmのメサ分離を形成しました。アノードトレンチは、このプロセスによって同時に達成されました。その後、Ti / Al / Ni / Au(20/150/55/60 nm nm)金属スタックが電子ビーム蒸着によって堆積され、続いて880°Cで35秒間N で急速熱アニーリングが行われました。 2 アンビエント。 1.1Ωmmのオーミック接触抵抗と400Ω/ squareのシート抵抗を伝送線路法で抽出しました。最後に、デバイス製造プロセスは、Ni / Au(50/300 nm)ショットキー金属スタック堆積で終わりました。アノードとカソードの間の距離( L AC )は4μmです。オーミック接触の長さ( L O )およびSchottky連絡先( L S )カソードトレンチ内はそれぞれ0.5μmと1μmです。拡張オーバーハング( L E )ショットキー接点のは0.5μmです。
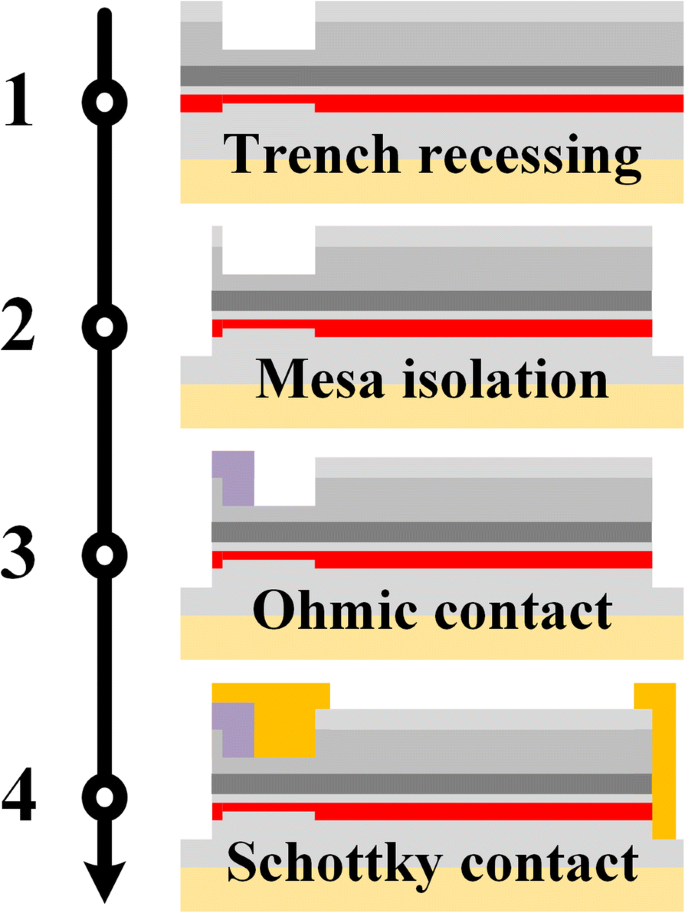
RB-CRDの製造プロセスフロー
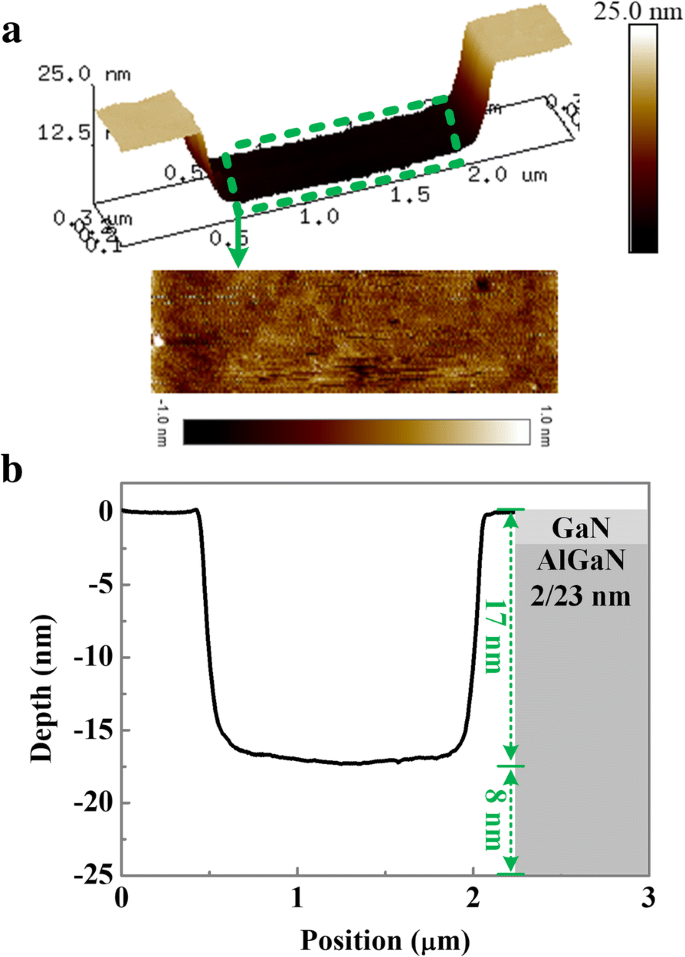
a カソードトレンチのAFM画像。 b カソードトレンチから取得した高さプロファイル
結果と考察
図3aは、製造されたカソードトレンチの3D原子間力顕微鏡(AFM)画像を示しています。カソードトレンチの底の表面粗さは0.3nmです。このような小さな表面粗さは、次の金属-半導体接触に有益です。図3bに示すように、深さ17 nmのカソードトレンチが凹んでいるため、8nmのAlGaNバリア層はカソードトレンチ領域に残ります。このような残りのAlGaNバリア層により、カソードトレンチ領域の2DEGチャネルが常にゼロバイアスで存在することが可能になります。
図4に、RB-CRDの動作メカニズムを示します。アノードにゼロバイアスが印加されている場合( V AC =0 V)(図4aを参照)、RB-CRDは、ゲート-ソース電極が接続されたショットキードレイン空乏モードHEMTに類似しています。アノードに負のバイアスが印加された場合( V AC <0 V)(図4bを参照)、電子はカソードトレンチ領域に蓄積し、2DEGチャネルは逆バイアスされたショットキー接合によりアノード領域で空乏化されます。アノードとカソードの間に続く所望の電流はなく、RB-CRDは逆バイアスされたSBDとして機能します。図4cに示すように、ターンオン電圧( V )を超える正のバイアスの場合 T 、アノードの1 mA / mmでSBDがアノード( V )に適用されます AC > V T )、電子は陰極のオーミック接触と陽極のショットキー接触の間を流れます。一方、カソードのショットキー接合は逆バイアスされ、ショットキー接点の下の2DEGチャネルは、順バイアスの増加に伴って徐々に減少します。したがって、出力電流は、最初に印加されたアノード電圧とともに増加し、その後徐々に飽和に達します。このような場合、安定した出力電流を得ることができます。
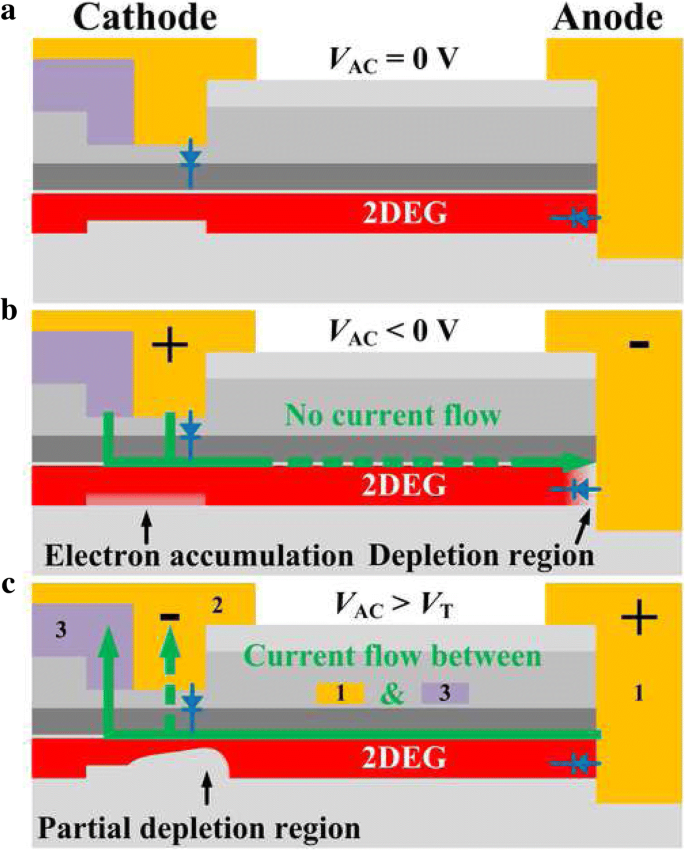
a でのRB-CRDの概略動作メカニズム ゼロバイアス、 b 逆バイアス、および c 順バイアス条件
温度依存の順方向 I-V ウェーハ上のRB-CRDの特性を図5に示します。図5aに示すように、RB-CRDの場合、ニー電圧( V K 、安定した調整電流の80%で)1.3 Vが得られます。これは、以前に報告されたCRDの値(たとえば、標準値0.6 V)よりも高くなっています[20、21]。これは、RB-CRDのアノードSBDでの追加の電圧降下(たとえば、標準値0.7 V)によるものです。温度が25°Cから300°Cに上昇すると(図5aを参照)、 V が負にシフトします。 T が観察されます。これは、熱電子放出モデルによって説明できます(つまり、電子が高温でショットキー障壁を克服するために必要なエネルギーは少なくなります)。 RB-CRDは、最大200 Vの安定した調整電流を出力できます(図5bを参照)。これは、Siベースの商用CRDの報告されている最大動作電圧よりも高くなっています[22、23、24]。 25°Cでは、調整電流比( I 200 V / 私 25 V )提案されたRB-CRDのは0.998であり、出力電流が非常に安定していることを示しています。 AlGaN / GaNプラットフォームに固有の高温動作能力のおかげで、RB-CRDは I の安定性の低下を無視できる程度に示します。 A 300°Cの高温で最大200V。一方、気温が25°Cから300°Cに上昇すると、前方の I A 図5bに示すように、高温での電子移動度の低下により、31.1から23.1 mA / mmに減少します。温度係数(α )さまざまな温度範囲での調整電流は、次の式で計算できます
$$ \ alpha =\ frac {I_1- {I} _0} {I_0 \ left({T} _1- {T} _0 \ right)} \ times 100 \%$$ここで私 0 は温度 T での出力電流です 0 および私 1 は温度 T での出力電流です 1 。 − 0.152%/ o 未満の小さな温度係数 Cが観察され、製造されたRB-CRDが優れた熱安定性を備えていることを示しています。

温度依存の順方向バイアス I - V RB-CRDの特性。アノード電圧範囲: a 0–2 V、 b 0〜200 V
図6の挿入図に示すように、RB-CRDの逆方向降伏電圧は25°Cで260Vです。対応する平均臨界電界は0.65MV / cmと計算されます。温度依存の逆 I-V RB-CRDの特性を図6に示します。周囲温度が25°Cから300°Cに上昇すると、リーク電流が2桁増加します。

温度依存の逆バイアス I - V RB-CRDの特徴
結論
結論として、トレンチショットキーアノードとハイブリッドトレンチカソードを特徴とする新しいAlGaN / GaN-on-SiRB-CRDが初めて成功裏に実証されました。製造されたRB-CRDは V を示します K 1.3 V、200 Vを超える順方向動作電圧、および260 Vの逆方向降伏電圧。優れた精度と、-0.152%/ o 未満の小さな負の温度係数 RB-CRDのCを取得しています。高精度の多機能RB-CRDは、新しいGaNパワーエレクトロニクスシステムに組み込む可能性が非常に高いです。
略語
- 2DEG:
-
二次元電子ガス
- AFM:
-
原子間力顕微鏡
- ICP:
-
誘導結合プラズマ
- MOCVD:
-
有機金属化学蒸着
- RB-CRD:
-
逆遮断電流調整ダイオード
- SBD:
-
ショットキーバリアダイオード
ナノマテリアル
- イーサリアムとグーグルでハイブリッドブロックチェーン/クラウドアプリケーションを構築する
- リバースエンジニアリングによる積層造形の強化
- インフィニオン:保護機能を備えた逆導通IGBT
- Python 配列:Python 配列の例による作成、反転、ポップ
- AlGaN / GaNHEMTの表面電位と2DEGに及ぼす表面状態とアルミニウムモル分率の影響
- 半極性InxGa1-xN / GaN多重量子井戸を備えた紫外線GaNベースのフォトニック準結晶ナノピラミッド構造からの多色発光
- グラファイトナノプレートレットを備えた多層カーボンナノチューブに基づくハイブリッド複合材料の電気的性質
- リチウムイオン電池用のCr3 +およびF-複合ドーピングを用いたLiNi0.5Mn1.5O4カソード材料の合成と電気化学的性質
- 高性能シリコン/有機ハイブリッド太陽電池用の溶媒処理を備えた高導電性PEDOT:PSS透明正孔輸送層
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 多機能GaN / Feナノ粒子による内皮細胞の標的化



