遷移元素V、Cr、およびMnによってエッジ修飾されたアームチェアブラックフォスフォレンナノリボンの電子特性
要約
遷移金属(TM)元素V、Cr、およびMnによってエッジ官能化されたアームチェアブラックフォスフォレンナノリボン(APNR)の構造的、電気的、および磁気的特性は、非平衡グリーン関数と組み合わせた密度汎関数理論によって研究されました。スピン偏極したエッジ状態は、TM-APNRの電子構造にさまざまな種類をもたらします。 Mnステッチエッジを持つAPNRの場合、それらのバンド構造は、強磁性状態で半半導体の電気的特性を示します。次に、横電界は、シュタルク効果を介してエッジ状態の伝導帯をシフトすることにより、Mn-APNRを金属にすることができます。 Mn / Cr-APNRヘテロ接合を使用して、スピン p-n を製造できます。 強力な整流が1つのスピンにのみ作用するダイオード。
はじめに
グラフェンの発見[1、2]は、2次元(2D)結晶材料の研究の急増を引き起こしました[3,4,5,6]。過去10年間で、六方晶窒化ホウ素、遷移金属ジカルコゲニド、黒色フォスフォレン、およびその他の多くが準備または予測されてきました[7、8、9]。これらの2D材料は、2D制限の下での新しい物理現象と性能を探索するためだけでなく、電子、スピントロニクス、およびオプトエレクトロニクスデバイスの多くの新しいアプリケーションにとっても重要な幅広い分野で実装できます[10、11、12、13 、14、15、16、17、18、19、20、21]。さらに、二次元材料のいくつかの特性は、一次元(1D)ナノリボンに調整された後、または/および機能化された後に改善することができます[22、23]。ボトムアップで合成されたグラフェンナノリボンの電界効果トランジスタで優れた性能が観察されています[24]。 OまたはOH基で官能化された金属炭化物または窒化物を介した2D半導体とのショットキーバリアフリーの接触が予測されています[25]。エッジ修飾フォスフォレンナノフレークは、高効率の太陽電池用に提案されています[26]。原子の欠陥と不純物を使用して、磁性と触媒作用の潜在的な用途のために電子特性を局所的に変調することができます[27、28、29]。外部電場とヘテロ構造を適用すると、電子特性をさらに大幅に操作できます[30、31、32]。
これらの既知の2D材料の中で、黒色フォスフォレンは、デバイスアプリケーション向けの優れた機械的、電気的、および光学的特性を備えた数少ないものの1つです。これに基づく電界効果トランジスタの製造[9]以来、黒色フォスフォレンはますます関心を集めています。これは、適度なバンドギャップ(≈2eV)と高い正孔移動度(≈1000cm 2 )を備えた直接半導体です。 /(Vs))[33,34,35]、エレクトロニクス、オプトエレクトロニクス、センサー、触媒作用、およびバッテリーの分野での巨大なアプリケーションの可能性を示しています[36,37,38,39]。グラフェンと同様に、黒色フォスフォレンは2つの典型的な方向に沿って、ジグザグフォスフォレンナノリボン(ZPNR)またはアームチェアフォスフォレンナノリボン(APNR)に切断できます[40、41、42]。第一原理シミュレーションは、遷移金属の置換ドーピングがスピントロニクスアプリケーションのためにフォスフォレンに磁性を容易に導入できることを示しました[43]。欠陥によって固定された遷移金属の吸収は、ハーフメタリックおよびメタリック複合フォスフォレンシステムを引き起こす可能性があります[44]。遷移金属のエッジ修飾は、ジグザグフォスフォレンナノリボンの電子特性も大幅に調整できると予測されています[45]。ただし、私たちが知る限り、APNRに対するTMパッシベーションの影響はまだ十分に研究されていません。
この論文では、典型的な遷移金属元素V、Cr、およびMnによって機能化されたAPNRの電子特性の変調に焦点を当てます。これは、APNRが他の元素よりも大きな磁気モーメントを導入するためです。密度汎関数理論に基づくシミュレーションは、半半導体の振る舞いが現れる可能性があり、横電界によって制御できることを示しています。さらに、高性能スピン p-n ジャンクションはスピントロニクスアプリケーション向けに設計されている可能性があります[46]。
システムと計算方法
黒リンは、原子層が弱い層間ファンデルワールス力によって積み重ねられ、各層の原子が強い共有結合によって結合されている層状材料です。簡単に剥がして単層フォスフォレンにすることができます。フォスフォレンの上面図を図1aに示します。右側にズームイン部分があり、ジオメトリパラメータが表示されています。加えて、アームチェアとジグザグ方向にそれぞれ沿った2つの側面図が示されています。各リン原子は、3つの隣接するリン原子(格子定数3.31および4.38Å、結合長2.2Å、結合角96.34°、および二面角102.1°)に結合して、プリーツハニカム構造を形成します[47]。グラフェンや二硫化モリブデンなどの六角形のハニカム格子の他の2次元材料と同様に、フォスフォレンは、アームチェアとジグザグブラックフォスフォレンナノリボンの2つの典型的なエッジ形態を持つナノリボンに合わせて調整できます[40、41、48、49]。
>
a 右側にズームインビューがある2Dフォスフォレンの上面図と側面図。アームチェアとジグザグエッジからの断面図をそれぞれ下と左側に示します。 b エッジの中空サイト(A)と上部サイト(B)にTM吸着原子があるAPNR。破線のフレームは、プリミティブセルのサイズと、 n の数を示しています。 ナノリボンの幅を示します。 c APNRの4つの磁気構成。 d 横電界が存在する場合の概略図
ここでは、半導体 n について考察します。 -奇数幅の番号 n のAPNR 鏡面対称断面。 n でも、同様の結果が続くはずです。 以下で説明するように、ナノリボンの2つのエッジはほとんど独立しているためです。 3つの典型的な遷移金属(TM)元素V、Cr、およびMnによるエッジ修飾の影響を体系的に分析します。図1bに示すように、TM原子は、中空位置(ケースA)または上部位置(ケースB)のAPNRエッジに吸着される場合があります。ケースAは結合エネルギーがはるかに大きいため、TM原子が各中空位置の中心近くに吸着され、さらに2つのリンエッジ原子に結合する場合に採用します。図1bに示すように、APNRエッジ上のTM原子の結合形状の説明を容易にするために、サイト1、2、3、および4のリン原子をP 1 と表記します。 、P 2 、P 3 、およびP 4 、 それぞれ。いくつかのジオメトリパラメータも定義します:結合長\({d} _1 ^ {P-P} \)(P 2 の間 およびP 3 )、\({d} _2 ^ {P-P} \)(P 1 の間 、P 2 またはP 3 、P 4 )、および d P − TM と結合角θ 1 (\({d} _1 ^ {P-P} \)と\({d} _2 ^ {P-P} \))とθ 2 (\({d} _2 ^ {P-P} \)と d の間 P − TM )。 TM吸着原子の磁性により、図1cに示すように、FM、AFM1、AFM2、およびAFM3の4つの可能な磁気構成があります。磁場がない場合、シミュレーションでは、図1cのAFM2ユニットセルのエネルギーがFMユニットセルのエネルギーよりも約0.2eV低いことが示されています。 2つのエッジはほぼ独立しており、AFM1およびAFM3構成でのそれらの間の反対のスピン偏極により、エネルギーを0.002eV未満削減できます。この論文では、印加された磁場がナノリボンを維持する可能性があるため、FM構成でのナノリボンの電子特性を研究します。また、図1dに示すように、FMAPNRの電子構造と特性に対する印加横電界の影響についても研究します。最後に、材料の可能なデバイスアプリケーションを提案します。
ナノリボン接合の輸送特性は、2プローブデバイス構造を確立することによって計算されます。接合部は3つの部分に分割されます。接合部の境界面が配置されている散乱領域は、左(L)電極と右(R)電極の間に挟まれています。電圧バイアス V の場合 b を2つの電極の間に適用し、電極LとRのフェルミエネルギーをμに設定します。 L =− e | V b | / 2およびμ R = e | V b | / 2。スピンの電子電流σ 量子デバイスを介して、Landauer-Büttikerの式[50]によって評価されます:
$$ {I} _ {\ sigma} =\ frac {e} {h} \ underset {-\ infty} {\ overset {\ infty} {\ int}} {T} _ {\ sigma}(E)\ left [f \ left(E-{\ mu} _ {\ mathrm {R}} \ right)-f \ left(E-{\ mu} _ {\ mathrm {L}} \ right)\ right] dE $ $(1)ここで、 T σ ( E )はスピンσの伝達です および f フェルミディラック分布関数。
シミュレーションは、非平衡グリーン関数(NEGF)法と組み合わせたab initio密度汎関数理論(DFT)に基づくAtomistixツールキット(ATK)パッケージによって実行されます[51、52]。電子構造と輸送シミュレーションの前に、各原子に作用する力が0.02 eV /Å未満になるまで構造が最適化されます。交換相関汎関数には、Perdew-Burke-Emzerhofパラメーター化(SGGA-PBE)を使用したスピン依存の一般化勾配近似を使用します。 SGGA + Uシミュレーションにより、以下の[43]と同じ結果が得られることを確認しました。二重ゼータ分極( dzp )の基底関数系 )正確な結果を得るために、原子軌道が計算に使用されます。リボン間の結合を避けるために、隣接するナノリボンの間に20Åの厚さの真空層が挿入されます。波動関数の基本ベクトル展開の切り捨てエネルギーは、 k で150ハートリーまたは4082eVに設定されます。 -1×1×101の空間メッシュグリッド。シミュレーションを容易にするために、NEGFスキームの実軸積分の手法で300Kの電子温度が採用されています。 4つの磁気構成は、最適化の前にTM吸着原子の対応するスピン分極を最初に設定することによって得られます。横電界ε 距離 l で分離された2枚の平行な仮想金属プレートによって生成されます 、電位差 V t したがって、ε=V t / l 。
結果と考察
ジオメトリと結合エネルギー
自然のままのAPNRでは、図2a、bに示すように、エッジP原子が中空の位置に移動するため、各エッジの「アームチェア」は2Dの対応するものと比較して狭くなります。 APNRが、参考文献に記載されているように、1つのH原子で飽和した各エッジP原子の懸垂結合で水素化された場合。 [48、53]、図2cに示すように、エッジP原子は2D位置に回復します。 TM原子が各中空位置に吸着されると、そのほかに2つのエッジP原子が不動態化されます。その後、アームチェアは部分的に回復し、TM吸着原子のスピン偏極によりエッジが磁化されます。 FM構成では、図2d–fに示すように、エッジで再構成は観察されず、プリミティブセルの長さは変更されません。

FM9-APNRの形状 a 2Dフォスフォレンから切り取っただけです b 幾何学的に最適化された(元の)、 c 水素化され、 d を吸着した後 V、 e Cr、および f エッジ上のMn原子。原子のスピン偏極の密度は、0.004 e /Å 3 の値で緑色の等値面で示されます。
表1に、形状パラメーターと結合エネルギー E を示します。 b 該当する場合、FM構成の元の、水素化された、TMを吸着する9-および17-APNRの場合。ここで、 E b =( mE X + E APNR − E X − APNR )/ m E で X 、 E APNR 、および E X − APNR 外部原子、元のAPNRの原始細胞、および m によって不動態化されたAPNRの原始細胞の総エネルギー それぞれ m の外部原子 =Hおよび m の場合は4 =TM要素の場合は2。 2Dフォスフォレンを切断してAPNRを作成すると、エッジの懸垂結合が大幅に減少します。θ 1 102から87°まで。外部原子による懸垂結合の不動態化により、θが回復します。 1 そして、\({d} _ {P-P} ^ 1 \)と\({d} _ {P-P} ^ 2 \)のストレッチによって特徴づけられる反発反応を導入します。 TMの場合、V原子の吸着は、最大のθで最も強い反発反応を示します。 1 。 Hと同様に、TM元素の吸着は4eV程度の結合エネルギーでエネルギー的に安定しています。 APNRの2つのエッジは互いにほとんど独立しているため、ジオメトリパラメータと E b APNRの幅に影響されません。結合形状とエネルギーは、TM- n のさまざまな磁気構成でも保持されます。 -APNR。
<図>電子構造と磁気特性
図3に、エッジ修正がある場合とない場合の9-APNRの電子のバンド構造と典型的な波動関数を示します。元のAPNRは、バンドギャップが E の非磁性間接半導体です。 g ≈0.5eV、ここで価電子帯(伝導)バンドの上部(下部)の電子状態はバルク(エッジ)状態です。エッジP原子がH原子によって不動態化されると、元のAPNRのエッジ懸垂結合による伝導帯がバンドギャップからシフトし、水素化されたANPRは E のより広いバンドギャップを持つ直接半導体になります。 g ≈1.0eV。伝導帯の下部と価電子帯の上部の状態はすべてバルク状態です。幅が n から増加するにつれて =9から17、バンドギャップはHanらによって予測されたものと一致して1.01から0.89eVにわずかに減少します。 [49]。

a によってエッジ修正された元の9-APNRのフェルミエネルギー付近のバンド構造と典型的な波動関数 H、 b V、 c Cr、および d Mn原子
TM原子がAPNRのエッジに吸着されると、スピン偏極したままになります。 FM構成では、V- n -APNRは、スピンに依存するバンドギャップを持つ磁性半導体です。図3bに示すように、 n の場合 =9、スピンアップ電子の間接ギャップは\({E} _g ^ {\ mathrm {up}} \ approx 0.03 \)eVですが、スピンダウン電子の直接ギャップは\({E} _g)です。 ^ {\ mathrm {down}} \ approx 0.5 \)eV。フェルミエネルギー周辺のスピンアップバンドの電子状態は、 d で構成されています。 V原子の軌道であり、エッジに限定されています。これらのスピンアップエッジバンドは同様の分散を持ち、部分的に占有されています。 k では、対応する価電子帯の上部と伝導帯の下部が分離しています。 スペースですが、エネルギーは互いに近接しています。スピンアップ電子には狭い間接バンドギャップが現れます。対照的に、すべてのスピンダウンエッジバンドはフェルミエネルギーをはるかに上回っています。スピンダウン価電子帯はバルク状態からのものであり、エッジ状態からのものであるスピンダウン伝導帯の反対の分散を持っています。これにより、スピンダウン電子の直接バンドギャップが生じます。左端と右端のV原子間の結合が弱いため、V端のバンドはペアで表示されます。 5つのペアのうち3つが占有されているため、各プリミティブセルの磁気モーメントは6 μです。 B 。
1ペアのスピンアップとすべてのスピンダウン d 図3cに示すように、軌道エッジバンドはCr-9-APNRのフェルミ準位より上にあります。これは4つの d があるためです。 各Cr原子の軌道電子。スピンダウン価電子帯の上部近くにあるスピンアップエッジバンドの2つの最も高いペアがわずかに重なっているため、スピンダウン価電子帯の上部のすぐ上にフェルミ準位を持つハーフメタルになります。 Mn-9-APNRでは、5組のスピンアップ d スピンダウン d の間、軌道バンドは占有されます 図3dに示すように、軌道バンドは空です。反対のスピンのバンドギャップが大きく異なるハーフ半導体になり、スピンアップの場合は\({E} _g ^ {\ mathrm {up}} \ approx 1 \)eV、スピンアップの場合は\({E} _g ^ {\スピンダウンの場合はmathrm {down}} \ approx 0.3 \)eV。両方のスピンは、バルク状態である同じ価電子帯の上部を持っています。ただし、スピンダウンの伝導帯の底は、スピンダウンのエッジ状態が占有されていないため、スピンアップの伝導帯よりもはるかに低くなっています。
TMの電子構造- n -APNRは同じパターンのままであり、 n ほど変化しません。 図4に示すように、増加します。それでも、エネルギーギャップが n として開く可能性があるため、Crで不動態化されたサンプルでは物理的特性が大幅に異なる可能性があります。 増加します。狭いCr- n -APNRはハーフメタルですが、Crが広い- n - n の図4の挿入図に示すように、APNRは半導体になる可能性があります。 =11および n =17、それぞれ。

手付かずの n のバンド構造 -APNRと、さまざまな n のV、Cr、およびMn原子によってエッジが変更されたAPNR 。 Crの拡大図- n -フェルミ準位に近いAPNRは、 n の挿入図に示されています。 =11と17
FM TM-9-APNRの磁気モーメント分布プロファイルを図2に示します。ここで、スピン密度の等値面Δρ =ρ アップ − ρ ダウン =0.004 e /Å 3 プロットされます。ここで、ρ アップ およびρ ダウン はそれぞれスピンアップ電子とスピンダウン電子の密度です。磁気モーメントは主にTM原子の周りに集中しており、P原子からの寄与は小さすぎて明確に示すことができません。表2に、総磁気モーメント M を示します。 T プリミティブセルでは、10個のエッジ原子のモーメントの合計 M E =2 M (TM)+ 4 M (P 1 )+ 4 M (P 2 )、および単一エッジ原子のモーメントTM、P 1 / P 4 、またはP 2 / P 3 。
<図>総磁気モーメントは主にエッジ原子( M )から発生します T ≈ M E )およびμの単位 B 原始セルあたりは、遷移金属原子の価電子数から4を引いた値に近いです。V- n -APNR、エッジPアトム(P 1 およびP 4 )はわずかに逆平行に分極しますが、2番目のエッジのP原子(P 2 およびP 3 )は平行偏波です。そのため、P原子の磁気モーメントはほぼ打ち消し合っています。各V原子の磁気モーメントは約3 μです。 B 3つの3 d から 軌道。 4 s 軌道は、単一のV原子と同様に完全に占有されています。対照的に、Cr- n のエッジP原子 -APNRには、 M のはるかに大きな磁気モーメントがあります。 (P1)≈− 0.27 μ B 。偶然にも、彼らは最長の d P − TM 3つのTM-APNRの中で、2DフォスフォレンのP原子からのP原子の最大の形状偏差も示しています。さらに、各Cr原子の磁気モーメントは約5 μです。 B 、4 μの代わりに B 。これは、その4 s 軌道は完全には占有されておらず、価電子配置が3 d の孤立したCr原子の場合と同様に、スピン偏極に寄与します。 5 4 s 1 。スピン偏極した s Cr-APNRのCr原子の軌道は、 p に逆平行スピン偏極を引き起こした可能性があります。 速度論的交換機構を介した隣接するP原子の軌道。 Mn- n -APNR、 d Mn原子の軌道は、約5 μの磁気モーメントで半分占有されています。 B そして隣接するP原子はすべて平行に非常に弱く分極しています。図5に、 d の部分状態密度(PDOS)(青)をプロットします。 9-APNRの総状態密度(DOS)(黒)とともにTM原子の軌道。ここでは、 d のスピンスプリットとエネルギー拡散 軌道がはっきりと表示されます。自然のままのAPNRと水素化されたAPNRでは、スピンアップとスピンダウンのDOSスペクトルが互いに重なり合っており、スピン偏極がないことを示しています。 TM-APNRでは、スピンアップとスピンダウン d 軌道PDOSスペクトルは、主に2〜4eVのエネルギー範囲で分布します。それらは、V-、Cr-、およびMn-APNRでそれぞれ約3、9、および4 eVの分離で、エネルギーが十分に分離されています。 d を除く 軌道、 p P原子の軌道は、価電子帯のDOSへの寄与を支配します。 s に注意してください Cr原子の軌道もCr-APNRに大きく寄与します。 CoおよびNi原子のエッジパッシベーションもAPNRに磁性を導入する可能性がありますが、Sc、Ti、Fe、Cu、およびZnなどの他のTM元素によって導入される磁性はかなり制限される可能性があります。

FM状態の元の状態および変更された9-APNRのDOS(黒い曲線)が、アップスピン(右)とダウンスピン(左)に対してプロットされます。 d 比較のために、TM原子の軌道PDOS(青い曲線)も示しています。フェルミエネルギーに近いV-9-APNRのDOSは、バンドギャップを示すために挿入図で拡大されています
横電界の影響
横電界は、半導体のキャリア濃度とバンド構造を制御するために電子デバイスで広く使用されています[54、55]。図1dに示すように、TM- n の電子構造をシミュレートします。 -ナノリボンを2本の平行棒で挟むことにより、ナノリボン平面に平行な横電界\(\ mathcal {E} ={V} _t / l \)下でのFM構成のAPNR。ここでは、 V t 2本のバーと l の間の電圧差です それらの間の分離です。シュタルク効果により、電場に沿って距離Δだけ実空間で分離された2つの縮退状態は、\(\ delta E =e {\ mathcal {E}} ^ {\ ast} \ Delta \)の量で分割されます。 、ここで、有効電界\({\ mathcal {E}} ^ {\ ast} \)は通常、スクリーニング効果の結果として外部電界\(\ mathcal {E} \)よりも小さくなります。 TMの場合- n -APNR、エッジバンドペアの状態中心間の距離Δは、各状態が1つのエッジのみに限定されている場合はナノリボン幅と同じくらいになる可能性がありますが、混合エッジ状態の場合はΔを短くするか、消失させる必要があります。図3の波動関数で示されているように、通常、エッジ状態は混合されています。
図6に、さまざまな\(\ mathcal {E} \)のV-、Cr-、およびMn-13-APNRのバンド構造を示します。ナノリボンの幅は約\(w =0.5 \ left(n-1 \ right)\ times 3.31 \ {\ AA} + {d} ^ {P- \ mathrm {TM}} \ cos \ left({135} ^ {{} ^ {\ circ}}-{\ theta} _2 \ right)\ approx 21 \ kern0.20em {\ AA}。\)シュタルク分割は\(e \ mathcal {E} w \)よりもはるかに小さい強力なスクリーニング効果またはエッジ状態の強力な混合を示します。 V-13-APNRのスピンアップバンドギャップは非常に狭いため、約\(\ mathcal {E} =3 \)V / nmで半分金属になります。伝導エッジバンドのシュタルク分割は、\(\ mathcal {E} =5 \)V / nmで0.1eVに達する可能性があります。 Cr-13-APNRは、シュタルク分裂と同様の強度を示し、横方向の場の下で半分の金属のままです。

a のスピンアップ(実線)およびスピンダウン(点線)バンド構造 V-、 b Cr-、および c Mn-13-強度\(\ mathcal {E} =0,1、\ dots、5 \)V / nmの横電界下のAPNR。 d Mnのバンドギャップ- n -アップスピン(\({E} _g ^ {\ mathrm {up}} \)、実線)およびダウンスピン(\({E} _g ^ {\ mathrm)のAPNRと\(\ mathcal {E} \) {down}} \)、点線)with n =9、11、および13。 e ギャップの差\(\ Delta E ={E} _g ^ {\ mathrm {up}}-{E} _g ^ {\ mathrm {down}} \)と\(\ mathcal {E} \)
図6cに示すように、半半導体Mn-13-APNRでははるかに強いシュタルク効果が観察されます。エッジ状態のスピンダウン伝導帯ペアは、 k のΓ点で約0.55eVのスプリットを取得します。 \(\ mathcal {E} =5 \)V / nmの下のスペース。スピンダウン伝導帯はスピンアップ価電子帯と重なり、Mn-13-APNRは、拡大された挿入図に示されているように、半導体の半分から金属に移行します。図6dでは、スピンアップとスピンダウンのエネルギーギャップと電界強度の関係をプロットしています。電子の波動関数は場によって変化し、エネルギーギャップは場によって直線的に変化しません。 Mn-13-APNRのバンドギャップは、スピンダウン電子の場合は\(\ mathcal {E} =5 \)V / nmでほぼ消失しますが、スピンアップ電子の場合は0.75eVを超えたままです。エネルギーギャップの差ΔE n の図6eでは、反対のスピン間の距離が\(\ mathcal {E} \)に対してプロットされています。 =9、11、および13。 ∆E n の場合、はるかに遅いステップで増加します = n よりも9 =低磁場では11と13ですが、高磁場では方法が逆になります。
スピン p-n ジャンクション
TM原子は、さまざまな方法でAPNRのバンド構造を変調できることを確認しました。これは、新しいデバイス設計の機会を提供します。たとえば、Cr-APNRとMn-APNRを組み合わせて、スピン依存の p-n を形成できます。 ジャンクション。実験的に、フォスフォレンへの金属イオンドーピング[56]が利用可能です。 2D材料の滑らかなステッチング[57]およびナノリボンの原子エッジ修飾も実現できます[58]。これらの手法は、 p-n を作成するために使用される可能性があります ジャンクション。図7aに、その電流-電圧( I-V )をプロットします。 )上の挿入図に示されている2プローブシステムのシミュレーションから得られた特性。スピン p-n 接合部は、スピンアップ電子に対しては非常に強い整流効果を示しますが、スピンダウン電子に対しては弱い効果しか示しません。このスピン依存性は、下の挿入図に示されているように、左右の電極の識別されたバンド構造に由来します。負のバイアス下では、左側のMn-APNR電極はフェルミエネルギーμを持ちます。 L = e | V b | / 2および右側のCr-APNR μ R =− e | V b | / 2。エネルギー範囲[μの輸送ウィンドウ内 L 、μ R ]、Cr-APNR電極にはスピンダウンエネルギーバンドのごく一部しかないため、スピンダウン電流は低いままです。対照的に、スピンアップエネルギーバンドの広いオーバーラップは、Mn-およびCr-APNR電極の両方に存在し、スピンアップ電流はバイアスとともに急速に増加します。トランスポートウィンドウ内[μ R 、μ L ]ただし、正のバイアスでは、左側の電極にスピンアップエネルギーバンドがなく、Mn-APNRが p であるため、対応する電流はほぼゼロのままです。 アップスピン用のタイプのワイドギャップ半導体。スピンダウン電流は V で増加し始めます b =0.2 V(右のフェルミエネルギーが左のスピンダウン伝導帯に整列するとき)。図7bに、整流比αをプロットします。 σ =[私 σ (− | V b |)− 私 σ (| V b |)] / 私 σ (| V b |)スピンのσ バイアスの大きさの関数として| V b |。 | V で b | =0.5 V、APNRスピン p-n ジャンクションの整流は、アップスピンの場合は2400、ダウンスピンの場合は2のみです。
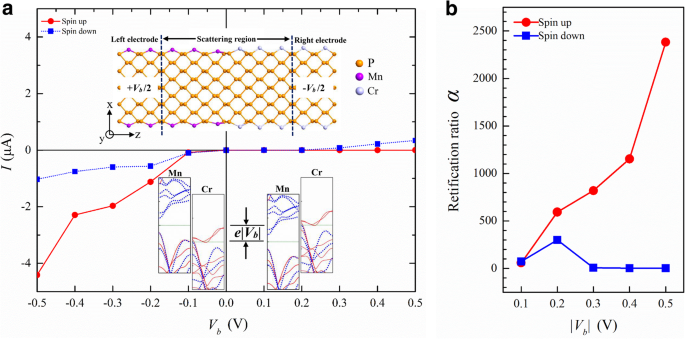
a スピン依存の I-V Mn / Cr-9-APNRヘテロ接合の特性。 2プローブシステムの形状は上の挿入図に示されています。下の挿入図は、負および正のバイアスの電極エネルギーバンドの整列を示しています。 b 対応する整流比α バイアスの大きさに対してプロットされます
結論
DFT-NEGFシミュレーションは、TM原子のエッジ機能化により、非磁性半導体APNRの電気的および磁気的特性を大幅に操作し、それらを金属または半半導体にすることができることを示唆しています。 TM-APNRのTM原子は、VおよびMn原子の磁性が主に d に由来する、孤立した状態で電子配置を保持します。 軌道ですが、両方の d からのCrの軌道 および s 軌道。 Mn-APNRでは、 d 軌道は半分満たされています。すべてのスピンアップ d Mn原子の軌道が占有され、スピンダウン d 軌道はフェルミ準位より上にあります。 d のバンドギャップが狭いため 軌道上で、Mn-APNRは半導体の半分になり、スピンダウンエネルギーバンドは、スピンアップエネルギーバンドよりもフェルミ準位ではるかに狭いギャップを持ちます。この特異な特性は、適切な条件下で材料が一方のスピンに対して半導体であり、もう一方のスピンに対して絶縁体である可能性があるため、スピントロニクスデバイスの設計に使用される可能性があります。エッジ状態に対するシュタルク効果の助けを借りて、エネルギーギャップは、印加された横電界によってさらに変調することができます。たとえば、5 V / nmの磁場は、スピンアップ電子のギャップを0.75 eVに維持しながら、スピンダウン電子のバンドギャップを閉じることができます。 Mn-APNRとCr-APNRのエネルギーバンドの大幅な違いを利用して、スピン p-n を設計できます。 Mn / Cr-APNR接合のダイオード。1回のスピンでのみ強い整流が発生します。
略語
- 1D:
-
一次元
- 2D:
-
二次元
- AFM:
-
反強磁性
- APNR:
-
アームチェアブラックフォスフォレンナノリボン
- ATK:
-
Atomistixツールキット
- DFT:
-
密度汎関数理論
- DOS:
-
状態密度
- FM:
-
強磁性
- NEGF:
-
非平衡グリーン関数
- TM:
-
遷移金属
ナノマテリアル
- タングステンフラックスの特性と用途
- タンタルの特性と用途
- コバルトをドープしたFeMn2O4スピネルナノ粒子の調製と磁気特性
- TiO2ナノ流体に向けて—パート1:準備と特性
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- ns-Laserによって調製されたブラックシリコン上に酸素をドープしたナノ結晶の電子状態と可視発光
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- クロム金属:元素、特性、および用途
- 自動車 PCB の特性と設計上の考慮事項



