Samsung I-Cube4は、4つのHBMとロジックダイを紙のように薄いシリコンインターポーザーに配置します
サムスン電子は、最新の統合2.5DパッケージソリューションであるInterposer-Cube4(I-Cube4)の発売を発表しました。これは、100㎛の厚さのシリコンインターポーザーに4つの高帯域幅メモリ(HBM)ダイと1つのロジックダイを組み込んだものです。
同社のI-Cubeは、1つ以上のロジックダイ(CPU、GPU、およびその他のブロック)と複数のHBMダイをシリコンインターポーザーの上に水平に配置し、複数のダイを1つのパッケージの単一チップとして動作させる異種統合テクノロジーです。
4つのHBMと1つのロジックダイを組み込んだ新しいI-Cube4は、I-Cube2の後継として3月に開発されました。 I-Cube4は、ハイパフォーマンスコンピューティング(HPC)からAI、5G、クラウド、大規模なデータセンターアプリケーションまで、異種統合を通じてロジックとメモリ間で別のレベルの高速通信と電力効率をもたらすことが期待されています。
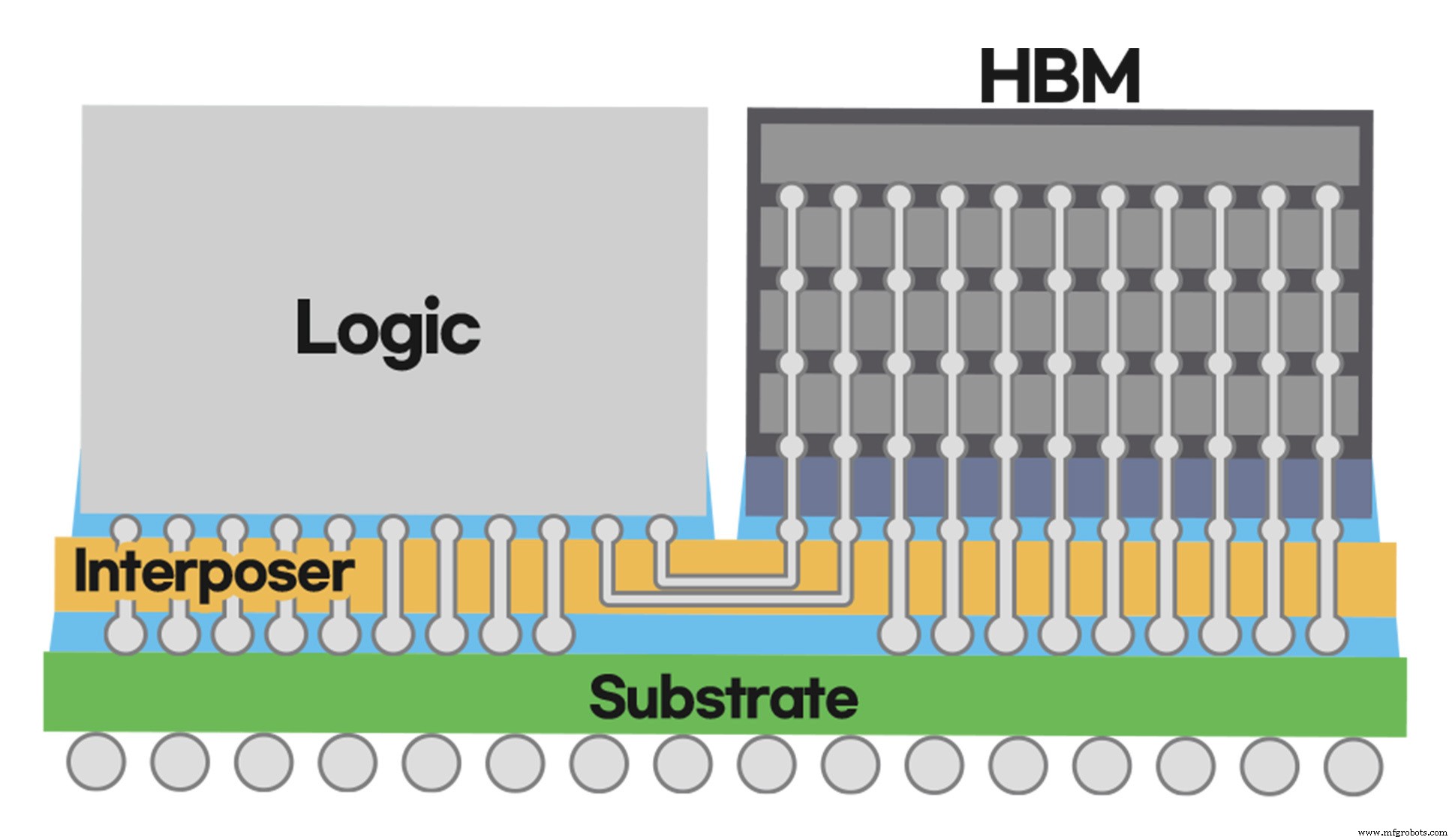
一般に、シリコンインターポーザーの面積は比例して増加し、より多くのロジックダイとHBMに対応します。 I-Cubeのシリコンインターポーザーは紙よりも薄い(厚さ約100㎛)ため、大きなインターポーザーを曲げたり反らせたりする可能性が高くなり、製品の品質に悪影響を及ぼします。サムスンは、半導体に関する専門知識と知識により、材料と厚さの変更を通じてインターポーザーの反りと熱膨張を制御する方法を研究し、I-Cube4ソリューションの商品化に成功したと述べました。
さらに、Samsungは、I-Cube4の独自のカビのない構造を開発し、製造プロセス中に欠陥製品をろ過できる事前スクリーニングテストを実施することで、熱を効率的に除去し、歩留まりを向上させました。このアプローチは、プロセスステップの数の削減などの追加の利点を提供し、その結果、コストの節約と所要時間の短縮につながります。
サムスンエレクトロニクスのファウンドリ市場戦略担当シニアバイスプレジデントであるMoonsooKangは、次のように述べています。 「I-Cube2を通じて蓄積された大量生産の経験とI-Cube4の商業的ブレークスルーにより、Samsungは顧客の製品実装を完全にサポートします。」
2018年にI-Cube2を、2020年にeXtended-Cube(X-Cube)を発売して以来、Samsungは、その異種統合テクノロジーがハイパフォーマンスコンピューティング(HPC)市場の新時代を示唆していると述べました。同社は現在、高度なプロセスノード、高速インターフェースIP、および高度な2.5 / 3Dパッケージング技術を組み合わせて使用することにより、I-Cube6以降のより高度なパッケージング技術を開発しており、顧客が最も効果的な方法で製品を設計するのに役立ちます。
関連コンテンツ :
- 機械学習アルゴリズムはReRAMの変動性を利用します
- Siemensは、シームレスなハードウェア支援検証のためにVeloceに追加します
- エッジAIはメモリテクノロジーに挑戦します
- Synopsysは、集積回路シミュレーションフローを使用して超収束ICに取り組みます
- 新しいEDA設計ツールが異種システム統合に対応
埋め込み
- ジャイロスコープ
- ケイ素
- AIチップアーキテクチャはグラフ処理を対象としています
- 60 GHzレーダーオンチップは、自動車業界の要件をサポートします
- ロボットのグローバルプレーヤーは、北米により多くのチップを投入しています
- 金型メーカーはIIoTを採用して、より短期間の生産に移行します
- サムスンは2020年までに20%の市場シェアを達成するために5GネットワーキングとAIに220億ドルを投資する予定です
- サムスンは5G機能を加速するためにZhilabsの購入を確認します
- TE Connectivityは、デジタルトランスフォーメーションの過程で製造の自動化を実践します
- EDM 型彫り加工の基本的な概要とそれに伴う利点
- ダイカストプロセスの動作原理とその応用



