低温での急速熱アニーリングプロセスによる成長の制御高均一性セレン化インジウム(In2Se3)ナノワイヤ
要約
均一性の高いAu触媒によるセレン化インジウム(In 2 Se 3) ナノワイヤは、気液固(VLS)メカニズムを介した急速熱アニーリング(RTA)処理で成長します。金触媒によるIn 2 の直径 Se 3 ナノワイヤは、さまざまな厚さのAu膜で制御でき、ナノワイヤの均一性は、100°C / sの高速プレアニーリング速度によって改善されます。遅い加熱速度0.1°C / sと比較すると、In 2 の平均直径と分布(標準偏差、SD) Se 3 RTAプロセスがある場合とない場合のナノワイヤは、それぞれ97.14±22.95 nm(23.63%)と119.06±48.75 nm(40.95%)です。インサイチュアニーリングTEMは、堆積したままのAu膜からのAuナノ粒子の形成に対する加熱速度の影響を研究するために使用されます。結果は、RTAプロセスがある場合とない場合のAuナノ粒子の平均直径と分布がそれぞれ19.84±5.96 nm(30.00%)と約22.06±9.00 nm(40.80%)であることを示しています。これは、Au触媒によるIn 2 の直径サイズ、分布、および均一性を証明しています。 Se 3 ナノワイヤは、前処理されたRTAによって削減および改善されます。体系的な研究は、他のナノ材料のサイズ分布を制御するために、アニーリング速度、前駆体の温度、および成長基板を調整することにより、他のナノ材料のサイズ分布を制御するのに役立つ可能性があります。

ラピッドサーマルアニーリング(RTA)プロセスは、Auナノ粒子のサイズ分布を均一化できることを証明し、その後、高均一性のAu触媒In 2 を成長させるために使用できます。 Se 3 蒸気-液体-固体(VLS)メカニズムを介したナノワイヤ。一般的な成長条件と比較すると、加熱速度は遅く、0.1°C / sであり、成長温度は比較的高い成長温度であり、> 650°Cです。 RTAで前処理された成長基板は、In 2 と反応するために、より小さく均一なAuナノ粒子を形成できます。 Se 3 蒸気を発生させ、高い均一性を生成しますIn 2 Se 3 ナノワイヤー。インサイチュアニーリングTEMは、堆積したままのAu膜からのAuナノ粒子形成に対する加熱速度の影響を実現するために使用されます。自己触媒作用によるIn 2 の副産物 Se 3 ナノプレートは、前駆体と成長温度を下げることで抑制できます。
背景
過去10年間で、1次元(1D)ナノ構造のチューブ、ワイヤー、ロッド、およびベルトは、本質的に低次元性に関連する高性能と表面積対体積比により、ナノテクノロジーの世界的な研究の焦点となっています。これは、さまざまなナノスケールデバイスでの独自のアプリケーションにつながる可能性があります[1、2]。特に、バルクまたは薄膜と比較して異なる特性を示す1D半導体ナノワイヤー(NW)は、データストレージ、コンピューティング、およびセンシングデバイスで大きな潜在的アプリケーションを示しています[2、3、4]。
セレン化インジウム(In 2 Se 3 )は、A III の黒色結晶で非常に興味深い化合物半導体です。 B VI α(2層六角形、2H)、β(3層菱面体晶、3R)、γ(六角形の欠陥ウルツ鉱、H)、δ、およびκの少なくとも5つの結晶修飾を有する層状構造のグループ[5、 6]。その多形性と関連する金属イオン欠陥構造により、In 2 Se 3 太陽電池[7、8]、オプトエレクトロニクス[9]、イオン電池[10]などのいくつかの異なる用途向けの有望な半導体材料として大きな注目を集めています。
In 2 の層状構造 Se 3 通常、 c に沿ってSe原子が積み重ねられた[Se-In-Se-In-Se]シートで構成されます。 -軸[11、12、13、14、15]。強い層内結合と弱い層間ファンデルワールス相互作用は、異方性の高い構造的、電気的、光学的、および機械的特性をもたらします[16、17]。レイヤー構造In 2 Se 3 ナノワイヤーとナノリボンは、蒸気-液体-固体(VLS)プロセスを介して触媒として金属ナノ粒子を使用することによって合成されています[2、18、19、20]。 NWの特性は、形状の異方性だけでなく、結晶学的な異方性にも依存します[21]。気液固成長メカニズムは、ナノワイヤの直径と成長方向を制御することが実証されています[20、21、22、23、24]。いくつかの研究結果は、触媒がナノワイヤの形態を制御するための重要な部分の1つであることを示しました。また、NWの結晶学的配向は、初期核形成中に、特定のサイズと形状の共晶液滴内の液固(LS)界面で熱力学的に決定されます[25、26]。また、以前の研究では、VLS成長プロセスの触媒として明確に定義されたナノクラスターを使用することで、非常に均一な半導体NWの合成を実現できることが示されています[25]。 Au-In合金液滴触媒の成長温度を制御することで、Au-In合金液滴中のInおよびSe原子の偏析濃度を決定できます。これは、ナノワイヤの直径に影響を与えます。ただし、Au触媒によるIn 2 Se 3 ナノワイヤは通常、650°Cを超える比較的高温で成長します。 Au-In状態図によると、共晶温度は約530°Cであり、Inおよび/またはSeはAu-In液体合金から析出し、Seと反応してIn 2 Se 3 NW [27]。この作業では、ラピッドサーマルアニーリング(RTA)を使用して、Au膜を均一なAuナノ粒子に転写します。さらに、ナノワイヤの直径を小さくし、VSで成長したIn 2 を防ぐために、より低い前駆体と成長温度が選択されます。 Se 3 副産物。興味深いことに、より薄いIn 2 Se 3 NWは、成長温度を550°Cまで低く制御することで直径を取得できます。インサイチュアニーリング透過型電子顕微鏡法(TEM)を使用して、堆積したままのAu膜からのAuナノ粒子形成に対する加熱速度の影響を研究します。
実験的
In 2 Se 3 NWは、2つの温度ゾーンを持つ石英管状炉システムで合成されました。従来、In 2 Se 3 粉末(99.9%、CERAC)を前駆体として使用し、800°C(加熱速度は0.01°C / s)でチューブの中央の上流に配置しました。 SiO 2 / Si(100)基板は、下流に配置された2.0nmの厚さの金膜でコーティングされています。 SiO 2 厚さ2.0nmの金膜でコーティングされた/ Si(100)は、RTAによって550°C(加熱速度は100°C / s)でアニールされ、基板が成長炉のチューブにロードされてIn 2 Se 3 25 sccm、圧力1Torrのアルゴンガスの流量のナノワイヤ。 In 2 の温度 Se 3 上流の前駆体粉末と下流(成長ゾーン)のAuコーティングされた基板は、それぞれ800°C(1.2°C / s)と550°C(0.1°C / s)まで上昇し、30分間保持されました。分。 In 2 の形態と微細構造 Se 3 NWは、走査型電子顕微鏡(SEM、JEOL JSM-6500F)および透過型電子顕微鏡(TEM、FEITecnai™G 2 )によって特徴づけられました。 F20フィールドエミッションガン)200kVで動作します。エネルギー分散型X線分析装置(EDS)で確認された化学組成はTEMに搭載されています。 In 2 のフェーズ Se 3 NWは、X線回折計(XRD、D8 DISCOVER SSS多機能高出力)で確認されます。その場アニーリングTEMを使用して、Auナノ粒子形成に対する加熱の影響を研究しました。その場加熱TEMサンプルを準備するために、2.0nmのAu膜をSiO 2 の正方形の開口部に堆積します。 / Si 3 N 4 薄膜。 SiO 2 の厚さ およびSi 3 N 4 フィルムはそれぞれ30nmと60nmです。 2.0nmのAu膜がSiO 2 に堆積します 次に、TEMにロードして、TEM内の加熱ホルダー(Gatan 652ダブルチルト加熱ホルダー)で加熱します。
結果と考察
図1aは、In 2 の成長に使用された石英管炉システムの概略図です。 Se 3 NW。通常、Au触媒によるIn 2 の成長ウィンドウ Se 3 NWは650〜750°Cで、前駆体In 2 Se 3 は900〜950°Cで加熱され、VLSメカニズムを介してInとSeのソースを提供します[19]。ただし、Au-In状態図は、AuIn x の組成によっては、Au-Inの共晶温度が450〜550°Cまで低下する可能性があることを示しています。 合金[28、29]。 NWの直径は、Auの厚さ、成長温度、および炉の周囲温度によって制御できると予想されます。この作業では、成長温度とIn 2 の温度 Se 3 前駆体粉末は、それぞれ550℃と800℃に設定されています。図1b、cは、In 2 のSEM画像です。 Se 3 200nmのSiO 2 上に堆積された2.0nmのAu膜上に成長したNW /シリコンウェーハ、それぞれラピッドサーマルアニーリング(RTA)プロセスありとなし。 NWの上部にある明るいナノ粒子は、図1b、cの挿入図から観察できます。これは、In 2 Se 3 NWはAuIn x を介して成長します VLSメカニズムを介したナノ粒子。 In 2 の平均直径 Se 3 RTAプロセスがある場合とない場合のNW(50ナノワイヤ)は、それぞれ97.14±22.95 nm(23.63%)と119.06±48.75 nm(40.95%)です。 In 2 の平均と分布 Se 3 RTAプロセスがある場合とない場合の北西の直径は著しく異なります。これは、RTAプロセスが均一性を改善し、In 2 の直径を小さくする可能性があることを明確に示しています。 Se 3 NW [30,31,32]。図1dは、In 2 のXRD結果です。 Se 3 NW、およびすべてのピークは、α-In 2 の六角形の結晶構造にインデックスを付けることができます Se 3 格子定数が a であるNW =4.025Åおよび c =19.235Å(JCPDSカード、番号34–1279)。

a 2ゾーン石英管炉の図。 In 2 Se 3 粉末を前駆体として使用し、800°Cでチューブの中央の上流に配置し、SiO 2 厚さ2.0nmのAu膜でコーティングされた/ Si(100)を下流に配置し、キャリアガスとしてアルゴンガスを配置しました。 b および c In 2 のSEM画像です Se 3 それぞれRTAプロセスの有無にかかわらず基板上に成長したナノワイヤ。 d Au触媒によるα-In 2 の典型的なXRDスペクトル Se 3 NW。格子定数は a =4.025Åおよび c =19.235Å(JCPDSカード、No。34–1279)
一般に、Auフィルムでコーティングされた基板は炉にロードされ、加熱速度は通常1〜2°C / sで、前駆体と反応して低融点のAuIn x を形成します。 共晶合金が過飽和してSeと反応し、In 2 を成長させるため、Inは分離されます。 Se 3 北西。加熱速度が遅いと、Auナノ粒子の均一性が低下します。基板上のAu膜の厚さと加熱速度だけでなく、成長温度もナノワイヤの形態を制御するための重要な要素です。図2a〜cは、In 2 のSEM画像です。 Se 3 RTA処理された後のNWは、それぞれ550、600、および650°Cで成長しました。図2a〜cの対応する挿入画像は、In 2 Se 3 NWの直径は、それぞれ80〜100、100〜200、300〜500nmでした。結果は、In 2 の直径が Se 3 NWは、成長温度を制御することで調整できます。成長温度が上昇したため、Au触媒への溶解度が増加します。つまり、In原子は、過飽和濃度に達するためにより多くの量を必要とします。同時に、より厚いIn 2 Se 3 NWは、より大きなAuIn x を通じて成長します。 飛沫。図2dは、In 2 を示しています。 Se 3 850°C(1.3°C / s)の前駆体温度で成長したナノワイヤ。 2 では、Au触媒による気液固成長と自己触媒による気固(VS)成長の両方 Se 3 ナノワイヤー、ナノプレート、フィルムなどのナノ材料が同時に得られます。より高い前駆体温度はより高い前駆体蒸気につながり、過剰な前駆体はIn 2 につながります Se 3 自己核形成して成長する傾向がある製品。他の研究と比較して、550°Cの成長温度は、一般的に報告されている650〜750°Cよりもはるかに低い可能性があります。さらに、自己触媒による成長を防ぐために、前駆体の温度を800°Cに下げることができます。表1に、成長するIn 2 の比較を示します。 Se 3 成長基板温度(加熱速度)、成長基板アニーリング処理、前駆体温度、およびナノワイヤの直径を含むナノワイヤパラメータ。成長温度が低いため、副産物は均一なIn 2 になるように抑制されます。 Se 3 NWは比較的低温で得ることができます。 In 2 であることを明確に示しています Se 3 この作業では、NWを最低の成長温度と前駆体温度で成長させることができます。さらに、RTAプロセスの結果は、In 2 の直径の均一性が優れていることを示しています。 Se 3 金粒子の直径が制限されていたため、従来のシステムよりも北西。
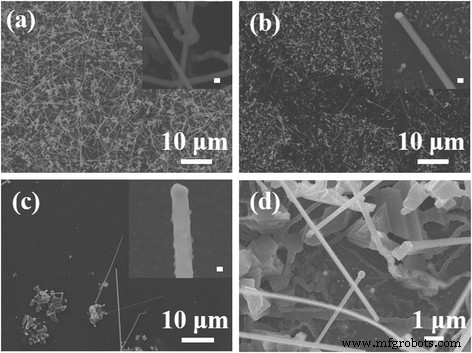
In 2 のSEM画像 Se 3 a で成長したナノワイヤ 550°C、 b 600°C、および c それぞれ650°C。挿入画像のスケールバー( a – c )は100nmです。 d 2 Se 3 ナノワイヤは、前駆体と成長温度がそれぞれ850°Cと600°Cで成長します
インサイチュアニーリングTEMは、Auナノ粒子の形成とナノワイヤの成長に対する加熱速度の影響を研究するために使用されます。図3aは、SiO 2 上に堆積したままの2nmAu膜のTEM画像です。 / Si 3 N 4 ウィンドウ、0.1°C / sおよび100°C / sで550°Cまでアニーリングし、30分間保持します。図3b、cは、それぞれ100°C / sと0.1°C / sの加熱速度でのAuナノ粒子形成の結果です。インサイチュアニーリングTEMの結果に従って、Auナノ粒子の平均サイズと分布を分析し、表2に示します。簡単に説明すると、より速い加熱速度により、Auナノ粒子の平均サイズを小さくして均一性を高めることができます。図3dは、代表的なIn 2 のTEM画像です。 Se 3 RTA処理後、550°Cで成長させた後のナノワイヤ。結果は、ナノワイヤの一般的な直径が約100 nmであり、挿入図が対応する選択領域電子回折(SAED)パターンであることを示しています。図3eは、対応するIn 2 の高分解能透過型電子顕微鏡(HRTEM)画像を示しています。 Se 3 0.35および0.48nmの格子間隔を持つ[010]ゾーン軸から取得され、(100)および(004)平面のd間隔にインデックスを付けることができるNW。これは、In 2 <を示しています。 / sub> Se 3 NWは[001]方向に沿って成長しています。 EDS分析は、トップとステムから取得されます。結果を図3f、gに示します。 CuおよびC信号は、カーボンコーティングされた銅TEMグリッドから提供されます。ステムから取得した図3fは、InとSeのみで構成されており、In / Seの原子比は約2/3です。図3gは、InとAuを含む上位のナノ粒子組成のEDS結果です。追加のAu信号は、In 2 Se 3 ナノワイヤは、気液固(VLS)メカニズムを介して成長します。 TEM分析、SEAD、およびHRTEMによると、VLSで成長させたナノワイヤはIn 2 のα相として識別できます。 Se 3 。

a 室温で2.0nmのAu膜。 b 100°C /秒で550°CのRTAによる金膜。 c 金の膜は0.1°C /秒で550°Cまで上昇しました。 d 合成されたままの個々のα-In 2 のTEM画像 Se 3 ナノワイヤー、Auナノ粒子チップ付き。 α-In 2 のSAEDパターン Se 3 ナノワイヤー(挿入図)。 e d の対応するHRTEM画像 は、ナノワイヤの成長方向が[001]に沿っていることを示しています。 f および g 選択したα-In 2 のEDSスペクトルです。 Se 3 体の部分と先端の部分からそれぞれ取られたナノワイヤー
結論
Au触媒In 2 を成長させるために、それぞれ800°Cと550°Cの低い前駆体温度と成長温度が提供されます。 Se 3 VLSメカニズムによるナノワイヤー。さらに、In 2 の均一性 Se 3 ナノワイヤは、RTA処理によって改善され、Auナノ粒子のサイズと分布を減らすことができます。インサイチュアニーリングTEMは、Auナノ粒子へのAu膜の転写に対する加熱速度の影響を研究するために使用されます。前駆体と成長温度が低いと、自己触媒作用のあるIn 2 の形成が減少する可能性があります。 Se 3 ナノプレート。温度が低いと、前駆体濃度が低くなり、エネルギーが低くなり、自己触媒作用のあるIn 2 が核形成されます。 Se 3 ナノプレートはIn 2 を阻害する可能性があります Se 3 ナノプレート副産物。
ナノマテリアル
- デジタル温度センサーは高精度、低電力を特長としています
- 温度センサーは、高精度、低消費電力を特長としています
- IBMの科学者がナノスケール用の温度計を発明
- 材料科学者はナノワイヤーに「踊る」方法を教えます
- 引抜成形プロセス:繊維強化ポリマーの製造
- アニーリングによって酸化ケイ素膜上に成長したアモルファスシリコンナノワイヤ
- 自己組織化と急速熱アニーリングによるAgナノヘアによる「厚く生い茂った」活性炭繊維
- ポリオール媒介プロセスによるZnOナノクリップの製造と特性評価
- InP / ZnS量子ドット膜の光学特性に及ぼすポストサーマルアニーリングの影響
- エレクトロスピニングされたPUナノファイバーの機械的性質に及ぼす温度の影響
- 高摩擦材料と低摩擦材料の違いを理解する



