GaTe / C2Nヘテロ構造におけるひずみ調整可能な電子特性とバンドアラインメント:第一原理計算
要約
最近、GaTeとC 2 N単分子層は正常に合成されており、魅力的な電子的および光学的特性を示しています。 GaTeとC 2 のこのようなハイブリッド Nは新しい新しい物理的特性を誘発する可能性があります。この作業では、GaTe / C 2 の構造的、電子的、および光学的特性についてabinitioシミュレーションを実行します。 Nファンデルワールス(vdW)ヘテロ構造。私たちの計算によると、GaTe / C 2 N vdWヘテロ構造は、タイプIIバンドアラインメントを備えた間接ギャップ半導体であり、光生成キャリアの効果的な分離を促進します。興味深いことに、それはまた、その成分と比較して強化された可視紫外線吸収を示し、垂直ひずみを適用することにより、特定のpHでの水分解のための優れた光触媒になるように調整することができます。さらに、C 2 の表面での水分子の吸着と分解を具体的に調べます。 ヘテロ構造のN層とそれに続く水素の形成。これにより、2D GaTe / C 2 での光触媒水素生成のメカニズムが明らかになります。 Nヘテロ構造。さらに、面内二軸ひずみは、間接-直接-間接、半導体-金属、およびタイプIIからタイプIまたはタイプIIIへの遷移を誘発する可能性があることがわかっています。これらの興味深い結果により、GaTe / C 2 N vdWヘテロ構造は、次世代の多機能オプトエレクトロニクスデバイスでのアプリケーションの有望な候補です。
背景
グラフェンの発見[1、2]以来、2次元(2D)層状材料への関心は着実に高まっています。遷移金属ジカルコゲニド[3]、V族元素とIII-V二元化合物の単層ハニカム構造[4–8]、遷移金属カルコゲニド(PTMC)[9]など、多くのグラフェンのような2D材料が多くを獲得しています。それらの並外れた物理的特性と有望な用途のために興味深い。これらの多様な2D材料の中で、PTMCのメンバーとしてのGaTe単分子層[9]は、分子線エピタキシー法[10]によって首尾よく製造されています。理論計算では、GaTe単分子層は間接バンドギャップ半導体であり、そのバンドギャップはひずみを加えることで変調できることが示されました[11]。その上、単層C 2 細孔と窒素原子の分布が均一な新しい2D層状材料であるNも、ボトムアップの湿式化学反応によって合成に成功し、ダイレクトギャップ半導体であることがわかりました[12]。多くの研究は、そのバンドギャップ、バンドエッジ位置、および光学特性は、それらの積層順序、層数、外部電界またはひずみを変化させ、他の元素と合金化/置換することによって設計できることを示しました[13–16]。 C 2 の調整可能な直接バンドギャップと多孔性に注意する必要があります。 Nは、エレクトロニクス、オプトエレクトロニクス、エネルギー変換、および光触媒による水分解などに望ましい特性を示すことが期待されています[15]。ただし、C 2 の使用には、依然として重要な課題が残っています。 光触媒および太陽電池のN:光生成された電子正孔対は空間的に同じ領域にとどまり、光生成されたキャリアの再結合率が高くなり、太陽エネルギー変換が低下する可能性があります
単一の2D材料への取り組みと並行して、異なる2D半導体材料を積み重ねることによって製造されたファンデルワールス(vdW)ヘテロ構造は、新しい材料を作成し、新しいデバイスを設計するための新しい道を切り開きました[17–23]。この種のヘテロ構造は、価電子帯の最大値(VBM)と伝導帯の相対位置に応じて、一般にタイプI(ストラドリングギャップ)、タイプII(スタッガードギャップ)、タイプIII(ブロークンギャップ)の3つのタイプに分類できます。それぞれの半導体の最小値(CBM)[18、24、25]。タイプIヘテロ構造の場合、一方の材料のVBMとCBMのエネルギーが他方の材料のエネルギーにまたがり、すべての光生成された電子と正孔が同じ層に蓄積されます。これにより、励起されたキャリアの超高速再結合が誘発され、利用できます。発光ダイオードなどのオプトエレクトロニクスデバイスで。タイプIIヘテロ構造の場合、一方の材料のCBMとVBMはどちらも、もう一方の材料よりもエネルギーが低いか高いです。その結果、光生成された電子と正孔はそれぞれ2つの材料に別々に閉じ込められ、それによって再結合の速度が抑制されます。したがって、それらは光起電力デバイスのビルディングブロックとして使用できます[18、24]。タイプIIIヘテロ構造に関しては、一方の材料のVBMレベルが他方のCBMレベルよりも高く、これはトンネル電界効果トランジスタに望ましい[25、26]。ごく最近、多くのGaTeベースのヘテロ構造が理論的および実験的に広く研究されています。 GaTe / InSeヘテロ構造は実験的に製造されており、タイプIIのバンドアラインメントを示します[27、28]。準2DGaTe / GaSeヘテロ構造は、剥離した数層のGaSeをバルクGaTeシートに転写することによって作成され、界面でタイプIのバンド配列を形成することがわかりました[29]。 GaTe / SnIヘテロ構造は、大きなギャップの量子スピンホール絶縁体であることが確認され、ヘテロシートの層間距離を変更することで変調できる顕著なラシュバ分裂を示します[30]。さらに、半導体/ C 2 の構築 g-C 3 などのN個のヘテロ構造 N 4 / C 2 N [31]、MoS 2 / C 2 N [32]、およびCdS / C 2 N [33]は、C 2 の光触媒性能を促進する大きな可能性を示しました 電子正孔対の効率的な分離によるN。これにより、光生成キャリアの再結合が抑制されます。
この作業では、GaTe / C 2 を構築します N vdWヘテロ構造を作成し、第一原理密度汎関数理論(DFT)計算を実行して、その構造パラメーターと電子的、光学的特性を調査します。結果は、ヘテロ構造が、構成層よりも固有のタイプIIバンドアラインメントと優れた可視UV光吸収を持っていることを示しています。さらに、GaTe / C 2 のバンドギャップ、バンドアライメント、およびバンドエッジ位置のひずみ依存性を予測します。 新しい多機能ナノデバイスの設計に不可欠なNヘテロ構造。
メソッド
私たちの研究では、Vienna ab initioシミュレーションパッケージ(VASP)[34]を使用して第一原理計算を実行します。運動エネルギーカットオフが500eVの平面波基底関数系とPerdew-Burke-Ernzerhofer(PBE)投影増強波擬ポテンシャル[35]を採用して、波動関数を拡張し、電子イオンポテンシャルを記述します。 DFT / PBE計算によって得られた過小評価されたバンドギャップを修正するために、計算量の多いハイブリッドHeyd-Scuseria-Ernzerhof(HSE06)関数法[36]が採用されています。 2つの単分子層間の弱いvdW相互作用は、GrimmeのDFT-D2補正によって説明されます[37]。 z の真空スペース -隣接するヘテロ二層間の相互作用を回避するために、25Åを超える方向が使用されます。 21×21×1(11×11×1) k -PBE(HSE06)計算のメッシュは、ブリルアンゾーンのサンプリングに使用されます。エネルギーと力が10 -5 に収束するまで、原子位置は完全に緩和されます。 それぞれeVおよび0.01eV /Å。
結果と考察
手付かずのGaTeとC 2 の調査から始めましょう。 N単分子層。 2つの単分子層の最適化された構成をそれぞれ図1a、bに示します。それらの構造パラメータを表1に示します。GaTe単分子層の場合、最適化された格子定数とGa-Te結合長はそれぞれ4.14Åと2.41Åです。 C 2 の場合 N単分子層、最適化された格子定数、C-N、およびC-C(1)/ C-C(2)の距離は、それぞれ8.26、1.34、および1.47 /1.43Åです。さらに、それらのバンド構造もPBE / HSE06計算によって調査され、それぞれ追加ファイル1:図S1aおよびbに示されています。どうやら、GaTe単分子層は1.43 / 2.13 eVの間接バンドギャップを持つ半導体であり、C 2 N単分子層は、1.65 / 2.44eVの値を持つ直接バンドギャップ半導体です。一方、リジッドシフトは別として、C 2 のバンド構造がわかります。 PBEとHSE06で計算されたN単分子層は、特に価電子帯で大きく異なります。ただし、PBEとHSE06を使用して計算されたCBMとVBMは、すべてΓにあります。 ポイントは、精度に多少の違いはありますが、2つの汎関数によって与えられるバンド分散が比較的一貫していることを示しています。すべての結果は以前の報告[11、38]の結果とよく一致しており、私たちの計算方法の信頼性を示唆しています。よく知られているように、半導体のバンドギャップは、エネルギー汎関数の微分不連続性がないため、一般にPBE汎関数によって過小評価されています。その後の電子的および光学的特性に関するプレゼンテーションは、HSE06の結果に基づいて行われます。

( a の上面図と側面図 )GaTeおよび( b )C 2 N単分子層。 ( c の上面図 – e )α -、β -、およびγ -GaTe / C 2 をスタックします N個のヘテロ構造。ヘテロ構造の対応するベースベクトルにラベルが付けられています
GaTe / C 2 Nヘテロ二層は、GaTeシートの2×2スーパーセルとC 2 の1×1ユニットセルを組み合わせて構築されます。 N層、わずか0.48%の格子不整合。ヘテロ構造の安定した構成を見つけるために、GaTe単分子層をさまざまな方向にシフトします。その結果、αと名付けられた対称性の高い3つのエネルギー的に有利なスタッキングタイプ -、β -、およびγ -図1c–eに示すように、スタッキングが得られます。 αで -スタッキング、六角形のC 4 N 2 リングは六角形のGaTeリングの真上にあります。 βは -およびγ -スタッキング、α内のGaTe層を移動することで取得できます - a に沿って約1.21Åと2.42Åを積み重ねる + b それぞれ方向。 3つのスタッキング構成の相対的な安定性を比較するために、インターフェイスの結合エネルギーを計算します。\(\ phantom {\ dot {i} \!} E _ {\ mathrm {b}} =(E _ {\ mathrm {GaTe / C_ { 2} N}}-E _ {\ text {GaTe}}-E _ {\ mathrm {C_ {2} N}})/ S \)、ここで\(\ phantom {\ dot {i} \!} E _ {\ mathrm {GaTe / C_ {2} N}} \)、 E GaTe 、および\(E _ {\ mathrm {C_ {2} N}} \)は、GaTe / C 2 の総エネルギーを表します。 Nヘテロ構造、自立型GaTeおよびC 2 それぞれN単分子層、および S 2Dスーパーセルの表面積です。表1に示すように、GaTe / C 2 の結合エネルギー αのN個のヘテロ構造 -、β -、およびγ -スタッキング構成は、-15.06 meV、-14.97 meV、および-15.80meV /Å 2 です。 、 それぞれ。 γを介して、3つの結合エネルギーは互いに非常に接近しています。 -スタッキングはエネルギー的に有利であり、これは最小の層間距離と一致しています。さらに、フォノンスペクトルを計算し、ab initio分子動力学(MD)シミュレーションを実行することにより、さまざまなスタッキング形式のこれらのヘテロ構造の動的および熱的安定性を確認し、その結果を追加ファイル1:図S2に示します。 Γ付近の横音響モードを除いて、すべてのフォノンモードは正の周波数を持っています フォノンの軟化による点、動的安定性の確認[5]。 MDシミュレーションでは、システムの全エネルギーが特定のエネルギー範囲で振動し、ヘテロ構造で幾何学的再構成や結合の切断が発生することはなく、これらのシステムが室温で熱的に安定していることを示しています[39]。 MDシミュレーション中にγに注意してください -スタッキング構成は、エネルギーのうねりが最小(7 meV /原子未満)であり、より顕著な熱安定性を示しています。 3つのスタッキング構成の非常に緊密な結合エネルギーは、それらの電子構造も非常に類似している可能性があることを意味します。これを確認するために、3つの構成のバンド構造を計算します(追加ファイル1:図S3を参照)。 3つのバンド構造が実際にほとんど同じであることがわかります。 γ -スタッキング構成は最も安定した構成であり、3つの構成は、それらの類似した形成エネルギーのために、室温でまだいくつかの確率で占められている可能性があります。ただし、それらの電子構造も互いに非常に近いため、作業を提示するために選択できる構成は1つだけです。ここでは、最も安定したγを選択します -以下の分析と議論におけるスタッキング構成。
次に、GaTe / C 2 の電子特性について説明します。 NvdWヘテロ構造。図2aに示すように、GaTe / C 2 のバンドギャップ Nヘテロ構造は約1.38eVと計算されます。そのコンポーネントのそれと比較して、そのバンドギャップはGaTe-C 2 のために減少します N相互作用と結果として生じるバンドアラインメント。また、C 2 の電子構造 N単層はよく保存されています。それにもかかわらず、ヘテロ構造におけるGaTeの投影されたバンド構造は、単分子層と比較してかなりの変化があります。これは、層間vdWと静電相互作用がヘテロ構造のバンドの電子状態のオーバーラップをもたらす可能性があるという事実に起因する可能性があります。同様の動作は、MoS 2 でも見られます。 / PbI 2 vdWヘテロ構造[40]。さらに、そのVBMとCBMは主にGaTeとC 2 にローカライズされていることがわかります それぞれN個のサブレイヤー。図2a(右パネル)の計算された全体および部分状態密度(PDOS)から、CBMは主に p に由来することがわかります。 VBMは主に p によって支配されているのに対し、NおよびC原子の状態 TeおよびGa原子の状態。図2c、dのCBMとVBMのバンド分解電荷密度は、最低エネルギーの電子と正孔がC 2 に分布していることを示しています。 N層とGaTe層は、それぞれ、上記の詳細なPDOSの結果と一致しています。 GaTe / C 2 のバンドアラインメント VBオフセット(VBO)とCBオフセット(CBO)の両方を含むNヘテロ構造を図2bに示します。これは、図2aの分析によるものです。明らかに、GaTe層のVBとCBは、C 2 の対応するバンドよりもエネルギーが高くなっています。 N層、およびGaTeとC 2 の間のVBOとCBO N層はそれぞれ約1.03と0.72eVです。ヘテロ構造に光が当たると、太陽光から得られたエネルギーを持つ電子がVBからCBに飛び込みます。そして、GaTeシートのCB上のこれらの光生成電子は、C 2 の電子に簡単にシフトできます。 観測されたCBOによるN層。逆に、C 2 のVBに光生成された穴 VBOにより、NシートがGaTe層に転写されます。上記の結果は、タイプIIバンドアラインメントがGaTeとC 2 の間の界面で形成されることを示唆しています。 電子と正孔を効率的に分離するための前提条件であるN層。さらに、追加ファイル1:図S4に示されている、ヘテロ構造の計算された平面平均電荷密度差は、一部の電子がC 2 から移動することを示しています。 N層からGaTe層へ。これは、固有のビルトイン電界( E in )は、C 2 からの方向を指すように誘導されます N層からGaTe層へ。 E にも注意してください in 光生成された電子(正孔)の移動と反対の(同じ)方向に作用し、したがって光生成された電子-正孔対の再結合を阻害します。その結果、固有の E の複合効果の下で in バンドオフセットにより、光生成されたキャリーをさまざまな表面で効果的に分離できるため、エネルギー変換効率が向上し、最終的にオプトエレクトロニクスデバイスのパフォーマンスが向上します。
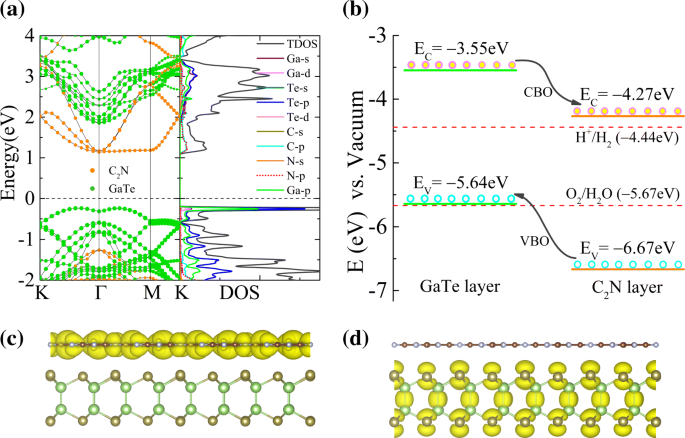
a GaTe / C 2 の投影されたバンド構造 γのNヘテロ構造 -スタッキング構成および対応する状態の全体および部分密度。 b GaTe / C 2 でのキャリア移動と分離のためのタイプIIバンドアライメントの概略図 Nヘテロ構造、真空レベルを参照。比較のために、pH =0での水分解の酸化還元電位(赤い破線)を示します。 c のバンド分解電荷密度 VBMと d ヘテロ構造のCBM
さらに、ヘテロ構造のCBMは、水素発生の還元電位(-4.44 eV vs真空準位)よりも正の位置にありますが、そのVBMは、酸素発生の酸化電位(-5.67 eV vs真空準位)とほぼ重複しています。したがって、pH =0で水素を生成することによって水を分解する光触媒能力は限られています。それでも、層間の間隔とpH値を変更すると、可視光光触媒としてのヘテロ構造の潜在的な用途に火がつく可能性があります(詳細については後の説明を参照してください)。
実際、有望な光電ナノデバイスは、可能な限り多くの可視紫外線を吸収する必要があります。したがって、GaTe / C 2 の光吸収をさらに調査します。 Nヘテロ構造とそのコンポーネント。計算の詳細は、以前の研究[22、23]で完全に説明されています。図3に示すように、GaTe / C 2 Nヘテロ構造は、特に2.20〜4.71 eVのエネルギー範囲で、そのコンポーネントと比較して、より強い可視UV光吸収とより広い吸収範囲を示します。これは、ヘテロ構造における電荷移動と層間結合によって引き起こされる新しい光学遷移に起因します[41]。

計算された光吸収スペクトル A (ω )GaTe / C 2 の ハイブリッドHSE06汎関数を使用したNヘテロ構造とそのコンポーネント。 A (ω )0.5Åと1.5Åの垂直ひずみと+ 6%と-6%の面内ひずみを持つヘテロ構造の。また、比較のために太陽スペクトルも示されています
層間(法線)および面内ひずみを含むひずみが、電子特性を調整し、材料の性能を向上させる効果的な方法を提供することは広く知られています[42]。ここでは、最初にGaTe / C 2 の通常のひずみ効果を調べます。 NvdWヘテロ構造。正常ひずみはΔで評価されます d = d − d 0 、ここで d および d 0 GaTeとC 2 の間の実際の距離と平衡距離です。 N個のサブレイヤー。したがって、Δの場合 d > 0の場合、システムは通常の引張ひずみ下にあり、その逆も同様です。 GaTeとC 2 間の相互作用の変化 N層は、それらの間の電荷移動の強度によって反映される必要があります。 GaTe / C 2 の計算された平面平均電荷密度差 異なる層間距離を持つN個のヘテロ構造は、追加ファイル1:図S5に示されています。結果は、GaTeとC 2 の間の距離として Nシートが減少し、強化された層間相互作用の結果として電荷移動が明らかに強化されます。したがって、GaTe / C 2 の電子的振る舞い Nヘテロ構造は、通常のひずみによって適切に調整されることが期待されます。
加えられたひずみの関数として計算されたヘテロ構造のバンドギャップと結合エネルギーを図4aに示し、通常のひずみの下でのヘテロ構造のCBMとVBMの変化を図4bに示します。通常の圧縮ひずみが増加すると、層間相互作用が強化されるため、バンドギャップが減少することが明確に示されています。対照的に、通常の引張ひずみの増加は、最初にバンドギャップをゆっくりと増加させ、次にΔでほぼ収束に達します。 d ≃0.8Å。これは、層間相互作用の大幅な減少から生じる可能性があります[32]。 Δで平衡構造を見つけます d =0の結合エネルギーは最も低く、表1に示す結果と一致しています。一方、タイプIIのバンド配列と強化された可視紫外線吸収が維持され、層間距離にほとんど関係がないことがわかります(を参照)。図3および追加ファイル1:図S6)。さらに興味深いことに、大きな引張垂直ひずみ(Δ d ≃0.3Å)VBMをO 2 より下にシフトします / H 2 O酸化電位により、システムはpH =0での水分解に適しています。光触媒水分解中、水素と酸素の生成プロセスはC 2 で別々に発生します。 それぞれN層とGaTe層。このような状況では、VBMの過電圧が非常に小さいため、O 2 には不十分である可能性があることに注意してください。 生産[43]、しかしそのようなバイアスポテンシャルは媒体のpH値を変えることによって調整することができます[44]。言い換えれば、水の酸化還元電位に一致するようにpHを制御することにより、水分解の光触媒特性をさらに調整することができます。図4bに示すように、pH =2の酸性環境では、ヘテロ構造のバンドエッジが水の酸化還元電位に完全にまたがっており、ヘテロ構造がH 2 に適していることを示しています。 / O 2 水からの生産、特に大きな垂直ひずみが適用された場合。

a に対する通常のひずみの影響 バンドギャップと入札エネルギー、および b GaTe / C 2 のバンドエッジ位置 NvdWヘテロ構造。比較のために、pH 0(赤い破線)とpH 2(青い破線)での水分解の酸化還元電位を示します
。GaTe / C 2 での光触媒水素生成のメカニズムをさらに明らかにする Nヘテロ構造、C 2 の表面での水の吸着と分解をシミュレートします 光触媒水分解中に水素が生成されるN層。水素分子の形成は吸収された水の分解から始まるため、まずH、OH、H 2 の吸収エネルギーを調べます。 C 2 のO DFT / PBEレベルでのN面。対応する吸着エネルギーは、図5aに示すように、それぞれ-1.03、-0.51、および-0.56eVです。負の値は、吸収がエネルギー的に良好であることを示します[45]。続いて、水の分解の計算された反応エネルギーは約1.48 eV(-0.56から0.92 eV)です。これは、水の分解がこの表面での吸熱反応であることを意味します。さらに、生成された水素原子はC 2 に吸着されます。 N表面では、遠隔分離された水素吸着原子は、近くに移動して水素分子を形成するのにエネルギー的に有利です[46]。図5bに示すように、1つのH 2 を除去するために必要な反応エネルギー C 2 から Nは比較的小さい(0.04 eV)。これは、吸着されたH 2 放出が容易で、光触媒水素ガスの製造に役立ちます。

a H、OH、H 2 の吸着構成 OとH 2 の分解機構 C 2 のO GaTe / C 2 のN面 NvdWヘテロ構造。 b 2つの水素吸着原子間の相互作用、C 2 での水素分子の形成と放出 GaTe / C 2 のN面 NvdWヘテロ構造
最後に、面内二軸ひずみの影響の調査に移ります。これは、結晶格子パラメーターを変更することによってシミュレートされ、εによって計算されます。 =( a − a 0 )/ a 0 、ここで a および a 0 は、それぞれひずみのある構造と元の構造の格子定数です。考慮される層内二軸ひずみが弾性応答の範囲内にあることを保証するために、最初に原子あたりのひずみエネルギー E を調べます。 s =( E 緊張 − E 制約なし )/ n 、 n を使用 ユニットセル内の原子の数です。計算されたひずみエネルギー曲線(図6a(右 y を参照) -axis))は、2次関数の特性を示します。これは、考慮されるすべてのひずみが弾性限界内にあり、したがって完全に可逆的であることを示しています。さまざまな二軸ひずみ下でのバンドギャップの進展を図6aに示します。約-2%のひずみでバンドギャップが最大値(〜1.45 eV)に達することがわかります。 εで =− 12%システムは半導体から金属への遷移を経て、このヘテロ構造の調整可能な導電性と輸送特性を意味します。一方、興味深い間接-直接-間接(Ind-D-Ind)バンドギャップ遷移がεに見られます。 ≃− 3%と− 8%、それぞれ。これらの遷移は、さまざまなk点でのひずみ誘起バンドエネルギーシフトに由来します(詳細については、追加ファイル1を参照してください:図S7)。 Ind-D遷移とひずみによる電子構造の変化は、光吸収を高める可能性があります[47]。図3では、GaTe / C 2 の吸光度を比較しています。 バンドギャップがほぼ同じである、±6%のひずみ下のN個のヘテロ構造。結果は、二軸ひずみが可視光の範囲で光学スペクトルを赤方偏移させ、上記のバンドギャップの減少と一致していることを示しています。興味深いことに、-6%のひずみは、[1.60–2.65eV]の領域で大幅に強化された光吸収につながります。さらに、ひずみがバンドの整列を変化させる可能性があることもわかっています。図6bおよび追加ファイル1:図S7に示すように、εの場合 ≥+ 6%の場合、GaTeサブレイヤーのCBMは下にシフトし、ヘテロ構造のCBMになります。その結果、GaTeサブレイヤーのCBMとVBMのエネルギーは、C 2 のエネルギーにまたがっています。 タイプIIからタイプIへの移行につながるNサブレイヤー。ここで、GaTeサブレイヤーのCBMとVBMは、大きな引張ひずみの下で互いに接近し、非常に小さなバンドギャップを形成しますが、C 2 Nサブレイヤーにはわずかな変更しかありません。この振る舞いは、最初に2つの孤立した単分子層の電子構造に対するひずみの影響を考慮することで理解できます。以前の計算では、GaTe単分子層のバンドギャップは、C 2 のバンドギャップよりも大きな引張ひずみに対してはるかに敏感であることが示されていました。 N単分子層:大きな引張ひずみの下では、前者は非常に小さくなり、後者は残ります[11、16]。これは、面内ひずみの影響をより大きく受けるGaTeの座屈構造が原因である可能性があります。ヘテロ構造の全体的な層間相互作用は弱く、主にバンドギャップにわずかな影響しか及ぼさないvdWと静電相互作用であるため、大きな引張ひずみ下での2つの単分子層の挙動はGaTe / C 2 Nヘテロ構造。さらに、εの場合 ≥-12%、GaTeサブレイヤーのCBMとVBMの両方がC 2 のものより高くなります N副層、したがってタイプIIIバンドアラインメントが形成されます。ただし、圧縮ひずみがさらに増加して-13%を超えると、このタイプIIIのバンドアライメントが壊れ、C 2 Nサブレイヤーは金属になります。一言で言えば、ひずみは、GaTe / C 2 のバンドギャップとバンドアラインメントのタイプと値を効果的に設計することができます。 Nヘテロ構造。これは、多機能で高性能な電子および光電子デバイスの設計に役立ちます。
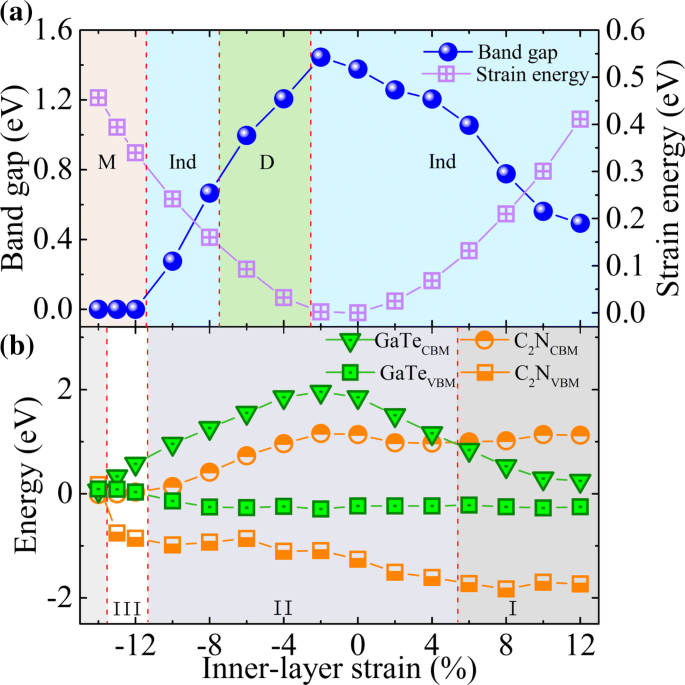
a GaTe / C 2 のバンドギャップとひずみエネルギーに対する面内二軸ひずみ効果 Nヘテロ構造。ミスティローズ、青、および緑の領域は、それぞれ金属(M)、Ind、およびDのバンドギャップ範囲を表します。 b 面内二軸ひずみの関数としてのヘテロ構造におけるサブレイヤーのバンドエッジ位置の変化。 I、II、およびIII領域は、それぞれタイプI、-II、および-IIIのバンドアラインメントに対応します
結論
要約すると、第一原理ハイブリッドDFT計算を実行することにより、GaTe / C 2 のひずみ依存の構造的、電子的、および光学的特性を体系的に調査しました。 Nヘテロ構造。それは、その成分と比較して可視-UV範囲で改善された光吸収を示す間接ギャップ半導体であると予測されています。タイプIIバンドアラインメントと固有のビルトイン電界は、光生成キャリアのエネルギー浪費された再結合を抑制し、したがってオプトエレクトロニクスデバイスの性能を向上させます。特に、大きな通常の引張ひずみは、システムを特定のpHでの水分解に適したものにすることができます。 C 2 での水分子の吸収および分解挙動を研究することによって ヘテロ構造のN副層では、H 2 の吸収が見られます。 OとH 2 の形成 C 2 で N表面はすべてエネルギー的に有利であり、これは光触媒的に水素ガスを生成するのに有益です。面内圧縮ひずみはInd-D-Indおよび半導体-金属転移を誘発しますが、面内引張ひずみはタイプIIからタイプIまたはタイプIIIへの転移を誘発します。これらの結果は、GaTe / C 2 Nヘテロ構造は、多機能オプトエレクトロニクスデバイスのアプリケーションに大きな可能性を秘めています。
略語
- 2D:
-
二次元
- CBM:
-
伝導帯の最小値
- CBO:
-
伝導バンドオフセット
- DFT:
-
密度汎関数理論
- HSE06:
-
ハイブリッドHeyd-Scuseria-Ernzerhof
- PBE:
-
Perdew-Burke-Ernzerhofer
- PDOS:
-
部分状態密度
- PTMC:
-
遷移後の金属カルコゲニド
- VBM:
-
価電子帯の最大値
- VBO:
-
ヴァランスバンドオフセット
- vdW:
-
ファンデルワールス
ナノマテリアル
- コバルトをドープしたFeMn2O4スピネルナノ粒子の調製と磁気特性
- TiO2ナノ流体に向けて—パート1:準備と特性
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- ナノ粒子の毒性の物理的および化学的性質への依存性
- InSeナノリボンの電子構造とI-V特性
- 酸化亜鉛ナノ粒子の特性と微生物に対するそれらの活性
- アルカリ金属吸着g-GaN単分子層:超低仕事関数と光学特性
- 自動車 PCB の特性と設計上の考慮事項



