パワーエレクトロニクスアプリケーション用の超広帯域Ga2O3半導体ベースのショットキーバリアダイオードの概要
要約
酸化ガリウム(Ga 2 O 3 )は、超広帯域ギャップ、高破壊電界、バリガ性能指数(BFOM)が大きいという利点を備えた新しい半導体材料であるため、ショットキーバリアダイオード(SBD)などの次世代ハイパワーデバイスの有望な候補です。 )。この論文では、Ga 2 の基本的な物理的性質 O 3 半導体が分析されました。そして、Ga 2 に関する最近の調査 O 3 ベースのSBDがレビューされました。一方、絶縁破壊電圧やオン抵抗など、性能を向上させるためのさまざまな方法をまとめて比較しました。最後に、Ga 2 の見通し O 3 パワーエレクトロニクスアプリケーション向けのベースのSBDが分析されました。
背景
電力、産業用制御、自動車用電子機器、および家庭用電化製品産業の急速な発展に伴い、高性能パワー半導体デバイスに対する大きな需要があります。ワイドおよび超ワイドバンドギャップ半導体材料は、この需要を満たすことができます[1、2]。 Ga 2 の5つの構造の中で O 3 単結晶、単斜晶系β -Ga 2 O 3 は最も安定しており、超広いバンドギャップ( E g 〜4.8 eV)および非常に高い破壊電界( E br 〜8 MV cm -1 )、従来のSiおよび後に開発されたSiCおよびGaN材料と比較。結果として、β -Ga 2 O 3 非常に大きなバリガの性能指数を示しています(BFOM =\(\ varepsilon \ mu {E} _ {\ mathrm {b}} ^ 3 \); ε は比誘電率であり、μ 電子移動度です)。 BFOMは、パワーデバイス用途の材料の適切性を評価するための重要な基準です[3,4,5,6,7,8,9,10,11]。表1は、Si、ワイドバンドギャップ(GaN、SiC)、および超ワイドバンドギャップ(β)の基本的な物理的特性を比較しています。 -Ga 2 O 3 )半導体材料。さらに、単結晶の成長のためにβ -Ga 2 O 3 基板には、フローティングゾーン(FZ)[12、13]やエッジ定義のフィルムフィード成長(EFG)[14,15]など、大気圧での簡単で低コストの大量生産可能な溶融成長方法があります。 、16、17]。これは、Ga 2 のもう1つの利点です。 O 3 SiCやGaNと比較して、高品質の単結晶成長の面で。したがって、β -Ga 2 O 3 は、ショットキーバリアダイオード(SBD)[18,19,20,21,22,23,24]や金属酸化膜半導体電界効果トランジスタ(MOSFET)[MOSFETなどの次世代ハイパワー半導体デバイスの有望な候補です。 25、26、27、28、29]。 Ga 2 に関する多くの研究が注目に値します O 3 材料の成長とパワーデバイスの製造および特性評価は過去数年間に行われているため、この論文では、超広帯域ギャップGa 2 の材料特性を確認しました。 O 3 半導体とGa 2 の調査 O 3 パワーエレクトロニクスアプリケーション用のベースのSBD。 SBDでは、最も重要な性能パラメータは絶縁破壊電圧( V )です。 br )およびオン抵抗( R on )、 V を改善するためのさまざまな方法を要約して比較することで br および R on パフォーマンス、私たちのレビュー作業がGa 2 の開発に役立つことを願っています O 3 ベースのパワーデバイス。
<図>酸化ガリウム半導体の物理的特性
酸化ガリウム(Ga 2 O 3 )は新しい酸化物半導体材料ですが、長い研究の歴史があります。 Al 2 の相平衡に関する調査 O 3 -Ga 2 O 3 -H 2 Oシステムは1952年までさかのぼることができ、R。Royetal。 Ga 2 の多形の存在を決定しました O 3 およびそれらの安定性の関係[30]。 1965年、H。H。Tippins etal。 βのバンド端の吸光度と光伝導度を調べた -Ga 2 O 3 4.7eVの値でバンドギャップを確認しました[6]。 1990年代には、Ga 2 の融解成長に関するいくつかの方法がありました。 O 3 Ga 2 のバルク単結晶およびエピタキシャル成長 O 3 フィルムが開発されていました。この5年間で、その特殊な特性と、高品質で大型の単結晶基板Ga 2 の成長に成功したためです。 O 3 材料は多くの研究関心を集めています。
今まで、人々はGa 2 の5つの結晶相を発見しました O 3 、つまりα 、β 、γ 、δ 、およびε フェーズ。これら5つのフェーズ間の変換関係を図1に示します[30]。単斜晶相β- Ga 2 O 3 他の4つの相は準安定であり、β-に変換する傾向がありますが、最高の熱安定性を備えています。 Ga 2 O 3 高温で。したがって、現在、ほとんどの研究はβ-に焦点を合わせています Ga 2 O 3 。最近のいくつかの調査では、他の相がβであるいくつかの特別な材料特性を示していることもわかりました。 フェーズはありませんでした。たとえば、α- Ga 2 O 3 サファイア(Al 2 )と同様のコランダム結晶構造を持っています O 3 )、したがって、高品質のα-をエピタキシャル成長させるのは比較的簡単です。 Ga 2 O 3 現在存在するAl 2 上の単結晶膜 O 3 単結晶基板。円筒相ε- Ga 2 O 3 は2番目の安定相であり、AlGaN / GaN接合の状態と同様に、ヘテロ接合界面で高密度の2D電子ガスを形成するのに有益な強力な自発分極効果を示します[31]。近年、大型のβ-の成長に成功したため Ga 2 O 3 単結晶基板とその最高の安定性、これまでのβ-の研究 Ga 2 O 3 他の4つのフェーズのものよりはるかに多いです。したがって、この論文では、主にβ-に関する研究成果をレビューします。 Ga 2 O 3 。
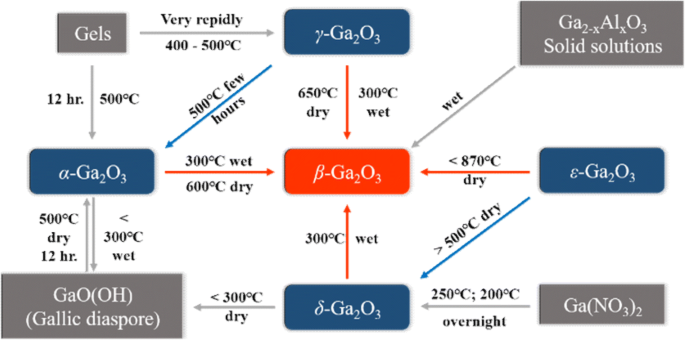
Ga2O3の結晶相とその水和物の間の変態関係[30]
β- Ga 2 O 3 単斜晶系に属し、熱的に安定しています。その格子定数は a =1.22 nm、 b =0.30 nm、および c =0.58 nm、図2に示すように。β-の結晶構造 Ga 2 O 3 一定の導電率があると判断しますが、これは、既知のすべての透明半導体材料の中で最も広いバンドギャップ(4.7〜4.9 eV)によって制限されます。バンドギャップにいくつかの欠陥エネルギーレベルが存在し、自由電子が生成される場合にのみ、材料は比較的強い導電率を持ちます。ほとんどのワイドバンドギャップ半導体では、ZnO半導体などのバンドギャップに欠陥レベルが存在するという理由だけで導電性が形成されます[32]。 β-の固有の電気伝導 Ga 2 O 3 結晶の大部分に形成された点欠陥によって導かれる自由電子に由来します。ほとんどの研究は、酸素空孔が電気伝導の重要な欠陥であることを示しています[33,34,35]。

β-Ga 2 の格子構造 O 3 結晶。参考文献から転載。 [5]
多結晶β-にはたくさんの酸素空孔が存在するため、興味深いことです。 Ga 2 O 3 、ある種のガスを吸収して抵抗率を変化させるのは簡単なので、β-の使用について多くの報告があります。 Ga 2 O 3 H 2 を検出するためのガスセンサーを製造する 、CH 4 、CO、およびO 2 [36,37,38,39]。また、β-の格子定数のため Ga 2 O 3 [100]方向は[001]、[010]方向よりもはるかに大きいため、デバイス製造の[100]方向に沿って超薄膜を簡単に剥がすことができます[27、40、41、42、43]。同時に、この結晶構造の特徴により、β-の製造において Ga 2 O 3 [100]方向に沿ってバルクを切断するウェーハは、非常に低い粗さの平坦な表面を得ることができます。
SiCやGaNと比較して、β- Ga 2 O 3 は特定の電気的特性を備えており、その中で超広帯域ギャップ(4.7〜4.9 eV)が最も顕著です。これにより、非常に高い臨界破壊電界( E br 約8MV / cm)、SiCおよびGaNの約2倍。材料の破壊電界は、ユニポーラパワーデバイスにとって非常に重要なパラメータです。材料の E が高い場合 br 、単位厚さの材料では、より高い電界を維持することができ、これは、デバイスサイズの縮小およびパワーモジュールの統合レベルの向上に有利である。図3は、オン抵抗( R )の基本的な制限を示しています。 on )ブレークダウン電圧( V )の関数として br )Si、GaAs、SiC、GaN、Ga 2 を含むいくつかの重要な半導体用 O 3 、およびダイヤモンド[5]。この図から、Ga 2 の導通損失がわかります。 O 3 デバイスは、同じ V でのSiCおよびGaNデバイスよりも1桁低くなります。 br 。したがって、Ga 2 O 3 ユニポーラデバイスでその大きな可能性を示しています。 β-の飽和電子移動度として Ga 2 O 3 比較的低い(〜200 cm 2 V − 1 s − 1 )、β- Ga 2 O 3 GaNと比較して高周波デバイスには適していません。ただし、ドリフト層が薄いほど空乏幅が小さくなるため、バンドギャップが広いため、この欠点を補うことができます。したがって、寄生容量を減らして、高周波アプリケーションの要件を満たすことができます。さらに、約4.8eVのバンドギャップによりGa 2 O 3 太陽のブラインド紫外線(UV)光線の範囲にちょうど位置する特別な吸収波帯(250〜280 nm)を持っているため、Ga 2 O 3 は、UV検出器を製造するための天然の優れた材料です[44、45、46、47]。
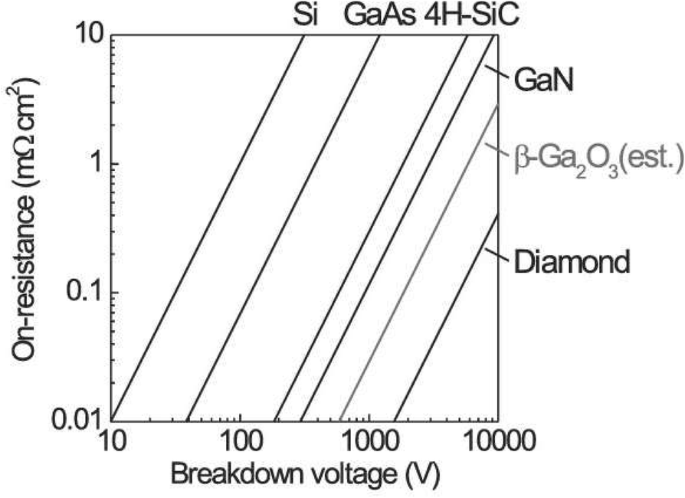
オン抵抗の理論上の限界( R on )ブレークダウン電圧( V )の関数として br )β-Ga 2 の場合 O 3 および代表的な半導体。参考文献から転載。 [26]
近年、β-のn型ドーピング Ga 2 O 3 基本的に実現されています。 SiおよびSn元素は、エネルギー準位が浅いドナー不純物として、活性化エネルギーが低くなっています。ドーピング濃度は、10 15 の範囲になるように適切に調整できます。 –10 19 cm -3 [47]、最高値は10 20 cm -3 に達した。同時に、ドーピング濃度の変化に伴い、光学的および電気的特性も変化します。たとえば、n型β-の抵抗率 Ga 2 O 3 10 -3 の範囲で変化します − 10 12 ドーピング濃度を変化させた場合のΩcm[48、49]。バンドギャップもドーピング濃度が異なると変化するため、Ga 2 の光吸収特性 O 3 影響を受ける[50]。
Ga 2 の開発から O 3 、この材料にはまだ次のようないくつかの欠点があります。 (1)P型ドーピングはGa 2 の大きな課題です O 3 材料。アクセプターレベルがβ-の価電子帯から遠く離れているため Ga 2 O 3 、アクセプター不純物の活性化エネルギーは非常に高いです。一方、Ga 2 のn型バックグラウンド不純物 O 3 結晶はまた、アクセプター不純物に対して自己補償効果を生み出し、材料の自己絶縁をもたらします。したがって、効果的なp型の実行はまだありません。 (2)Ga 2 の熱伝導率 O 3 低すぎます。実験的および理論的調査により、β-の熱伝導率が証明されました Ga 2 O 3 わずか0.1〜0.3 W cm -1 K -1 [51,52,53]。これは、高電圧および大電流の状況で使用されるパワーデバイスに悪影響を及ぼします。過度の熱の蓄積は、デバイスのパフォーマンスと信頼性に深刻な影響を及ぼします。 (3)キャリアの移動度が低い。 Ga 2 の理論上の移動度 O 3 約200cmに制限されています 2 散乱の影響による/ V [54]。移動度が低いと、周波数と電流の特性に悪影響を及ぼします。
ショットキーバリアダイオードの基本概念
ショットキー接触、オーミック接触、および電界分布は、オン抵抗( R )を含む高性能を達成するためのSBDの重要な要素です。 on )および絶縁破壊電圧( V br )、それらを改善するためのさまざまな方法が特に重要です。
ショットキーバリアの概念によれば、バリアの高さはショットキー金属の仕事関数と半導体の電子親和力に関係しています。異なる金属の仕事関数は周期的に変化し、ショットキー障壁を形成するためには、金属は半導体よりも大きな仕事関数を持つ必要があります。ニッケル(Ni)と白金(Pt)は、β-の一般的なショットキー金属です。 Ga 2 O 3 、およびそれらのバリアの高さは、さまざまな方法で導出されます[55、56、57、58、59、60、61、62、63、64、65、66、67、68、69、70、71、72、73、74 、75、76、77]。半導体表面下の空乏領域は、キャリアトンネリングを防ぐために必要な厚さが必要であり、これには、半導体の限られたドーピング濃度が必要です。ドーピング濃度の一般的な値は10 16 です。 –10 17 cm -3 β-で Ga 2 O 3 基板またはエピタキシー層[56,57,58,59,60,61,62]。バリアの高さは、実際にはインターフェースの状態の影響を受け、仕事関数との単純な関係から逸脱します。表面前処理は、表面近くの酸素空孔やダングリングボンドなどの界面状態を減らすことを目的としています[78]。
オーミック接触は、金属と半導体の間の基本的なリンクです。オーミック接触の低い比抵抗は、デバイスが接触抵抗( R )を減らすのに役立ちます s )およびオン抵抗( R on )。低接触抵抗を実現するための従来の方法は、低仕事関数の金属と高濃度のドーピングを選択することです。実際、接触金属の仕事関数は、界面状態のピン止めにより、オーミック接触の形成に常に影響を与えません。半導体の高濃度ドーピングは、オーミック接触の主要な技術になります。主な目標は、キャリアの濃度を改善し、界面障壁を下げることです。 RTA(ラピッドサーマルアニーリング)は、界面特性を改善し、接触抵抗を低減します。 Y. Yao etal。 β-へのオーミック接触金属として9つの金属をテストしました Ga 2 O 3 そして、チタン(Ti)とインジウム(In)が特定の条件下で良好なオーム挙動を示すことを発見しました[79]。高温でのアニーリング後、チタンのみが連続形態を維持できます。これと同様に、ほとんどの研究では、β-とのオーミック接触金属としてチタンを適用しました。 Ga 2 O 3 良好なデバイス性能が得られました[60,61,62,63,64,65,66,67,68,69,70]。
破壊挙動はデバイス内部の電界分布に関係しており、同じ条件で円筒接合と球面接合の方が平行平面接合よりも電界が大きくなります[1]。したがって、絶縁破壊電圧を高めるためのフィールドプレートなど、いくつかのエッジ終端保護方法が必要です[19、23、68]。界面電荷と呼ばれる界面状態は、通常、半導体表面に近い電界に影響を与え、早期の破壊を引き起こします。漏れ電流は破壊挙動の指標であり、一般に転位を含む半導体の内部欠陥の影響を受けます。どちらの状況もデバイスの不安定性を引き起こし、回避すべきブレークダウン電圧を低下させる可能性があります。界面状態の影響を低減するための一般的な方法は表面の不動態化であり、絶縁破壊電圧を上げるには高品質の基板も必要です。
β-に基づくショットキーバリアダイオード Ga 2 O 3
高品質で低コストの単結晶基板の成長の難しさは、SiCおよびGaNデバイスの商品化に影響を与えています。 Ga 2 O 3 単結晶基板は、Ga 2 をベースにしたパワーデバイスである低コストの溶融法で成長させることができます。 O 3 近年、単結晶が注目されています。現在、Ga 2 のn型ドーピング技術 O 3 はかなり成熟していますが、p型ドーピングがないためGa 2 O 3 バイポーラデバイスには適用できません。超大きなバンドギャップは、ユニポーラデバイスのアプリケーションで大きな利点になります。したがって、Ga 2 の開発 O 3 パワーデバイスは、ショットキーバリアダイオード(SBD)と金属酸化膜半導体電界効果トランジスタ(MOSFET)の2種類のユニポーラデバイスによって支配されています[23、55、56]。
ワイドバンドギャップ(WBG)半導体材料技術の開発により、WBG半導体に基づくSBDデバイスは、パワーエレクトロニクスシステムに適用するためにp-n接合ダイオードに取って代わり始めます。これは、SBDに少数キャリアストレージ効果がなく、スイッチング損失が非常に低いためです。理論的には、SiCおよびGaN SBDと比較して、Ga 2 O 3 SBDは、はるかに薄いドリフト層で同じブレークダウン電圧を達成できます。同時に、ドリフト層が薄いほど寄生容量が小さくなり、デバイスの逆回復時間が短縮されます。 Ga 2 の主な開発進捗 O 3 SBDを図4に示します。エピタキシー技術の開発に伴い、SBD構造は、初期の基板ベースの単純な構造から、基板およびエピタキシャル膜ベースの複雑な構造に発展しました。その後、デバイス製造プロセスの段階的な調査を通じて、フィールドプレートやトレンチなどの高度な端子構造が登場し、デバイスのパフォーマンスがさらに向上しました。 Ga 2 O 3 SBDは、パワーエレクトロニクスアプリケーションでその可能性を示し始めています。
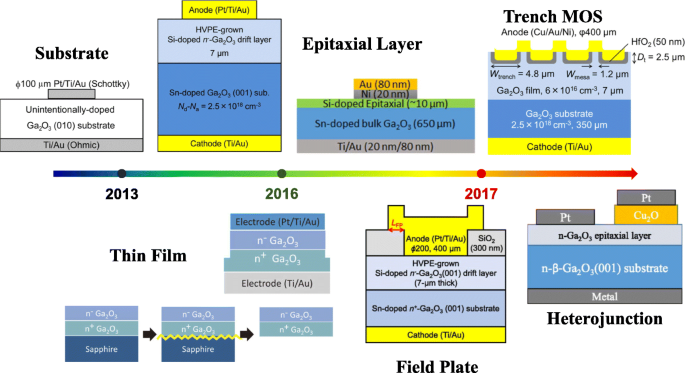
Ga 2 の開発 O 3 近年のSBD [16、18、62、68–71]
新しいワイドバンドギャップ半導体材料として、人々はGa 2 の初期開発段階で多くの基本的な問題に直面しました。 O 3 、したがって、Ga 2 の開発の進捗状況 O 3 SBDはパワーSBDの進化を非常によく反射します。 SBDで最も重要な部分はショットキー接合であるため、初期の研究ではGa 2 に取り組んでいます。 O 3 SBD、主にGa 2 間の接触を含む、ショットキー接合の研究に焦点を当てたものがかなりの数あります。 O 3 異なるショットキー電極(Ni、Cu、Au、Pt、TiN)[57,58,59]、ショットキー接合の電子輸送メカニズム、界面状態の問題、バリアの不均一性、ショットキー接触に存在するイメージ力、およびカソード界面で完全なオーミック接触を獲得する方法[60、61]。
物性が徐々に目立つようになり、製造工程がますます改善されることで、デバイスの性能が徐々に向上します。以下は、Ga 2 の開発におけるいくつかの典型的な作品です。 O 3 SBD。
2013年、佐々木健一ほかタムラ製作所では、高品質(010)βをベースにSBDを製造しました。 –ga 2 O 3 フローティングゾーン法で成長させた単結晶基板[62]。彼らは、基板内の異なるドーピング濃度がデバイスの性能に与える影響を調査し、ドーピング濃度が高いほど、オン抵抗は低くなりますが、逆方向降伏電圧が低くなり、逆方向リーク電流が大きくなることを発見しました。図5は、(010)βで製造された2つのSBDの逆破壊特性を示しています。 –ga 2 O 3 異なるドーピング濃度の基板。絶縁破壊電圧は150Vに達します。両方のデバイスの理想係数は1に近いです。また、Pt /βのショットキー障壁の高さ –ga 2 O 3 インターフェースは1.3〜1.5eVと推定されました。
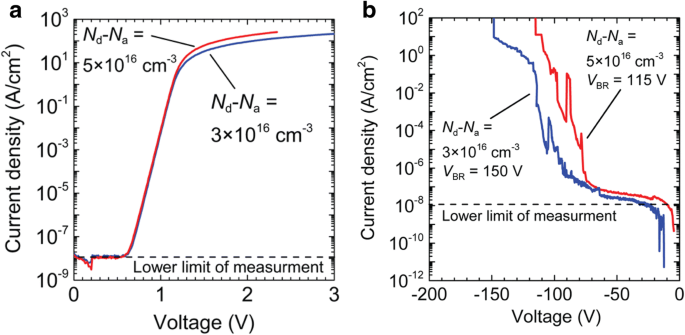
a 、 b (010)βに基づくSBDの順方向および逆方向の電気的特性 -Ga 2 O 3 異なるドーピング濃度の基板。電流密度測定の下限は10 -8 です。 A / cm 2 。参考文献から転載。 [62]
中国科学院マイクロエレクトロニクス研究所(IMECAS)と山東大学の研究者が協力して、(100)指向のβに基づいてSBDを調査しました。 –ga 2 O 3 バルク基板。 2017年に、彼らはPt / βを報告しました –ga 2 O 3 SBDとその温度依存の電気的特性。 X線回折(XRD)および高分解能透過型電子顕微鏡(HRTEM)分析により、β –ga 2 O 3 エッジ定義フィルムフィード成長(EFG)技術によって成長したバルク単結晶は、良好な(100)配向と良好な結晶品質を示しました(図6a、b)。 I–V測定と熱電子放出モデリングにより、製造されたPt / β –ga 2 O 3 SBDデバイスは10 10 の整流比を含む良好な性能を示しました 、理想係数( n )1.1、ショットキー障壁の高さ(Φ B )1.39 eV、しきい値電圧( V bi )1.07 V、オン抵抗( R on )12.5mΩcm 2 、2 Vでの順方向電流密度( J @ 2V )56 A / cm 2 、および有効ドナー濃度( N d − N a )2.3×10 14 cm -3 (図6c、d)。良好な温度依存性能もデバイスで見られました(図6e、f)。温度の上昇に伴い、 R on および J @ 2V デバイスが高温でうまく機能することを示して、より良くなりました。次の研究で、彼らは理想係数とショットキー障壁高さの温度依存性をさらに深く調査し、この種の温度特性は障壁高さの不均一性のガウス分布によって説明できることを発見しました[61]。 2018年には、結晶成長パラメータをさらに最適化し、Snドーピング濃度( N )を改善しました。 d − N a =2.3×10 14 cm -3 )。新しいPt / β –ga 2 O 3 SBDデバイスは、順方向電流密度( J )を含む著しく改善されたパフォーマンスを示します @ 2V =421A / cm 2 )、オン状態の抵抗( R on =2.9mΩcm 2 )、短い逆回復時間(20 ns)、および200Vを超える逆降伏電圧[63]。彼らの研究は、EFGがβ成長したことを示しています –ga 2 O 3 単結晶はパワーデバイスの用途に有望です。

a (100)βのX線回折(XRD)曲線 -Ga 2 O 3 (400)、(600)、および(800)面のピークを明確に示す単結晶基板。 b Pt / βの断面高分解能透過型電子顕微鏡(HRTEM)画像 -Ga 2 O 3 βのショットキー接触と高速フーリエ変換(FFT)顕微鏡写真 -Ga 2 O 3 結晶。 c Pt / βの順方向および逆方向のJ–V曲線 -Ga 2 O 3 SBDとSBDの概略図(挿入図)。 d 線形および片対数プロットの順方向J–V曲線。 e 温度依存のJ–V曲線とリチャードソンのプロット(挿入図)。 f オン抵抗と順方向電流密度の温度依存性。参考文献から転載。 [60]
Q. Feng etal。西安電子科技大学の研究者は、パルスレーザー堆積(PLD)の準備プロセスと、Alをドープしたβの基本的な物理的特性を研究しました。 –ga 2 O 3 映画[64,65,66]。 Alをドーピングすると、βのバンドギャップを調整できます。 –ga 2 O 3 異なるAl原子比を組み込むことによって。この種のAlドープ膜に基づいて、Ni / β -(藻類) 2 O 3 SBDデバイスが製造され、特性評価されました。ショットキーバリアの高さは1.33eVです。現在のオンオフ比とオン抵抗は10 11 に達します および2.1mΩcm 2 、それぞれ[65]。彼らはまた、理想係数とショットキー障壁の高さに対する温度の影響を研究し、 n のこれらの温度依存特性についても結論を出しました。 およびΦ B バリア高さのガウス分布の存在を仮定することにより、ショットキーバリアの不均一性に起因する[66]。
フィルムエピタキシー技術の開発に伴い、ハロゲン化物気相エピタキシー(HVPE)を利用してGa 2 を成長させました。 O 3 映画。エピタキシーの高速性とフィルムの高品質の利点により、HVPEで成長させたGa 2 O 3 高電圧SBDのドリフト層の製造に非常に適しています。 2015年、M。Higashiwakietal。情報通信研究機構(NICT)で、厚さ7μmの低濃度ドープ(〜1×10 16 )に成長しました。 cm -3 )高濃度にドープされた( N d − N a =2.5×10 18 cm -3 )(001)β- Ga 2 O 3 HVPE法による基板とさらに製造されたSBDデバイス。さまざまな温度でのデバイスのC–VおよびI–V特性を調査しました。ショットキー障壁の高さ、しきい値電圧、C–VおよびI–V曲線の温度による変化傾向が指摘されました。図7は、デバイス構造と順方向および逆方向のJ–V–T曲線を示しています[16]。 21〜200°Cでは、バリアの高さがほぼ一定に保たれていることがわかりました。順方向電流と逆方向電流は、それぞれ熱電子放出(TE)モデルと熱電子電界放出(TFE)モデルとよく一致しました。彼らの結果は、Ga 2 のアプリケーションの可能性を示しました O 3 次世代パワーデバイスのSBD。
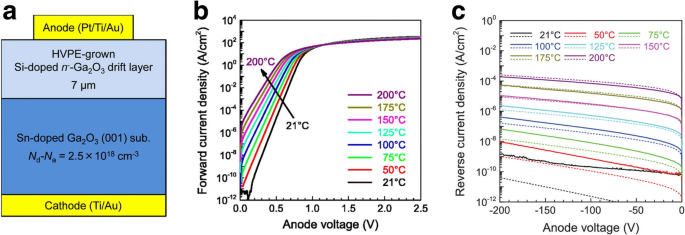
a HVPEで成長させた厚さ7μmのn - に基づくSBDデバイスの構造 - Ga 2 O 3 n + 上のホモエピタキシャルドリフト層 - Ga 2 O 3 単結晶基板。 b 21〜200°Cで測定されたデバイスの順方向J–V特性。 c 21〜200°CでJ–Vを逆にします(実線と点線はそれぞれ実験結果とシミュレーション結果を表します)。参考文献から転載。 [16]
2016年、M。Odaetal。 FLOSFIAInc。でαに関する作品を発表しました -Ga 2 O 3 SBD [18]。ミスト化学蒸着(CVD)技術、つまりMISTEPITAXY®により、それらは連続的に大きく成長し(3〜4μmの厚さ)、軽くドープされたα -Ga 2 O 3 サファイアの映画(Al 2 O 3 )基板。 αを持ち上げた後 -Ga 2 O 3 基板、カソード、アノードの層は、n - の底面と上面に堆積されました。 - Ga 2 O 3 / n + - Ga 2 O 3 それぞれレイヤー(図8)。厚さ2580nmのデバイスn - - Ga 2 O 3 層は、855 Vの高い絶縁破壊電圧と、0.4mΩcm 2 のオン抵抗を示しました。 。より薄い(430 nm)n - のデバイス - Ga 2 O 3 レイヤーSBDは、0.1mΩcm 2 という非常に低いオン抵抗を示しました。 そして、531 Vの絶縁破壊電圧。2018年に、彼らはさらに、TO220パッケージで実施されたこの種のデバイスを報告しました[67]。 130 pFの接合容量が得られたため、デバイスはSiCSBDおよびSiSBDと比較して優れた逆回復特性を示しました。同時に、パッケージ後、デバイスは13.9°C / Wの熱抵抗を示しました。これは、同じパッケージのSiC SBD(12.5°C / W)に匹敵し、薄いドリフト層を採用することで効果的に補償できることを示しています。 Ga 2 の熱伝導率が悪いという欠点 O 3 材料。このレポートでは、著者はαも指摘しています。 -(Rh、Ga) 2 O 3 αの効果的なp型チャネル層として機能することができます -Ga 2 O 3 デバイス。

αの製造プロセス -Ga 2 O 3 FLOSFIAInc。によって提案されたSBD。参考文献から転載。 [18、67]
2017年、K。Konishietal。 NICTでPt / HVPE-n - を報告しました - Ga 2 O 3 /(001)n + - Ga 2 O 3 ブレークダウン電圧が1076V、オン抵抗が5.1mΩcm 2 のSBDデバイス (図9)[68]。エッジターミネーションテクノロジーの一種であるフィールドプレート(FP)エンジニアリングは、Ga 2 に最初に使用されました。 O 3 SBD。アノード接続されたSiO 2 を追加することによって FP、デバイス構造全体の最大電界は臨界電界未満に保たれ、特にアノード周辺の電界は明らかに減少する可能性があります。この方法を採用することで、高い絶縁破壊電圧と低いオン抵抗の両方を実現できます。同じ年に、より高い絶縁破壊電圧(1600 V)がJ.Yangらによって報告されました。 Ni / MOCVDを使用したSBDデバイスでフロリダ大学から-n - - Ga 2 O 3 /(− 201)n + - Ga 2 O 3 構造[69]ですが、オン抵抗が非常に大きい(25mΩcm 2 )。エッジ終端は使用されませんでした。彼らの調査によると、ショットキー電極のサイズは絶縁破壊電圧とオン抵抗に影響を及ぼしました。これは、電極が大きいほど欠陥が多くなり、絶縁破壊が容易になるためです。
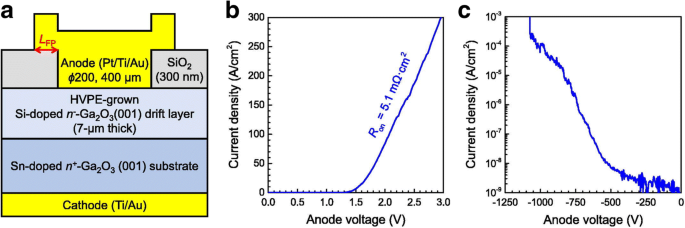
a フィールドプレートを備えたSBDの構造。 b 、 c 順方向および逆方向の電気的特性( V br =1076 V)。参考文献から転載。 [68]
2017年、佐々木健一ほかノベルクリスタルテクノロジー社から最初に製造されたβ -Ga 2 O 3 トレンチ終端構造を備えたSBD(図10)[70]。 By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O 3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O 3 SBD exhibited superiority in switching loss.
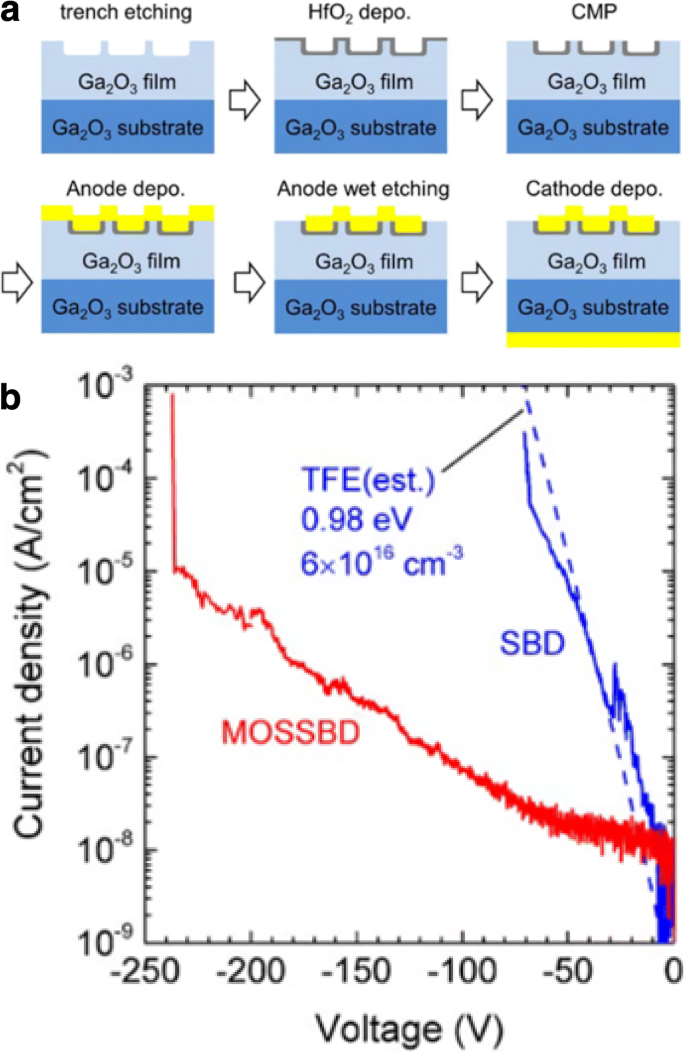
a Fabrication processes of the MOS-type Ga2 O 3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2 O 3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O 3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O 3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O 3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O 3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O 3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O 3 device before the successful preparation of p-type Ga2 O 3 。
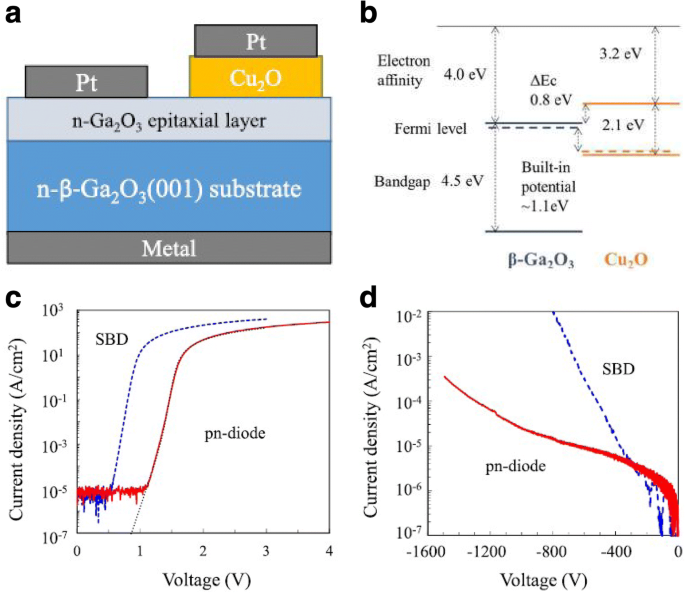
a Schematic of the cross-sectional Pt/Ga2 O 3 SBD and p-Cu2 O/n-Ga2 O 3 diode. b Band diagram of the p-Cu2 O/n-Ga2 O 3 インターフェース。 c 、 d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O 3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O 3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O 3 SBD single device.

a Rectification circuit. b – e Rectifying effect of Pt/Ga2 O 3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O 3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
<図>結論
Currently, Ga2 O 3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O 3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O 3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O 3 will better display its unique application value, which requires the joint efforts of the researchers.
略語
- AC:
-
交流
- BFOM:
-
Baliga’s figure of merit
- CVD:
-
化学蒸着
- EFG:
-
Edge-defined film-fed growth
- FFT:
-
高速フーリエ変換
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
高分解能透過型電子顕微鏡
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
有機金属化学蒸着
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
パルスレーザー堆積
- SBD:
-
Schottky barrier diode
- TE:
-
熱電子放出
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
X線回折
ナノマテリアル



