AlGaNベースの深紫外線発光ダイオード用のp-AlGaN / n-AlGaN / p-AlGaN電流拡散層について
要約
このレポートでは、さまざまなp-AlGaN / n-AlGaN / p-AlGaN(PNP-AlGaN)構造の電流拡散層を備えたAlGaNベースの深紫外線発光ダイオード(DUV LED)について説明し、調査しました。私たちの結果によると、採用されたPNP-AlGaN構造は、横方向の電流分布を変調できる正孔注入層にエネルギー障壁を誘導することができます。また、電流拡散効果は、厚さ、ドーピング濃度、PNPループ、および挿入されたn-AlGaN層のAlN組成によって強く影響を受ける可能性があることもわかりました。したがって、PNP-AlGaN構造が適切に設計されていれば、提案されたDUV LEDの順方向電圧、外部量子効率、光パワー、およびウォールプラグ効率は、PNPなしの従来のDUVLEDと比較して大幅に改善できます。 -AlGaN構造。
はじめに
2003年の最初の登場以来、AlGaNベースの深紫外線発光ダイオード(DUV LED)は、水殺菌や空気浄化などの幅広い用途で大きな関心を集めています[1,2,3,4,5、 6,7]。ただし、発光波長が300 nmより短い場合、DUV LEDの外部量子効率(EQE)は10%未満であり[8]、それ以降のアプリケーションは大幅に制限されます。 EQEが低いのは、内部量子効率(IQE)が低いことが部分的に原因です。 IQEは、キャリア注入と転位の拡大によって著しく影響を受けることがかなりの注目を集めています[8]。絶縁サファイア基板上に成長するAlGaNベースのDUVLEDは、光抽出効率を高めるためにフリップチップ構造を採用しています。それにもかかわらず、フリップチップDUV LED構造では、n電極とp電極が同じ側にある必要があります。したがって、不均一な横方向の電流分布、すなわち電流混雑効果が容易に発生します[9]。現在の混雑効果は、局所的なジュール熱効果と不均一な発光を簡単に引き起こす可能性があります[10、11、12]。局所的な過熱は、DUVLEDの寿命を著しく低下させることは言及する価値があります。さらに、Alリッチp-AlGaNベースの正孔注入層のMgドーピング効率が非常に低いと、導電率が低下し[13]、DUVLEDの電流拡散を改善することの重要性がさらに明らかになります。カーンらが。総説[14]で現在の混雑に注意を払う必要があることを指摘しており、現在の混雑とその解決策に関する詳細な分析は、これまでDUVLEDについてあまり議論されていません。
電流拡散を促進するための広範な技術がGaNベースの青色LEDについて報告されており、電流拡散は、たとえば、p-GaN層を選択的にイオン注入し[15、16]、電流遮断層(CBL)を挿入することによって改善できます。 [17,18,19]、p-GaN層の正孔を補償するために窒素空孔を選択的に生成し[20]、オーミック接触のアニーリングプロセスを最適化します[21]。製造後のアプローチを使用することに加えて、電流拡散層は、有機金属化学蒸着(MOCVD)システムでのその場でのエピタキシャル成長によっても得ることができます。重要な例は次のとおりです。複数の量子井戸(MQW)構造とp-GaN層の間の短周期p-GaN / i-InGaN超格子構造[22、23]、トンネル接合[24、25]、およびバリアジャンクション[10]。それにもかかわらず、DUVLEDの電流拡散を改善するためのエピ構造に関するレポートはめったに見つかりません。この手紙では、p-AlGaN / n-AlGaN / p-AlGaN(PNP-AlGaN)層を使用して、DUVLEDの横方向電流をよりよく分散させることを提案します。 PNP-AlGaN構造は、p型正孔注入層の価電子帯にエネルギー障壁を生成することができます。エネルギー障壁は、p型正孔注入層の電気抵抗率を変調できるため、電流流路を調整できます。 PNP-AlGaN電流拡散層を適切に設計することにより、EQE、ウォールプラグ効率(WPE)、および順方向電圧を改善できます。さらに、この作業では、電流拡散の感度、EQE、WPE、およびPNP-AlGaNループへの順方向電圧、Siドーピング濃度、厚さ、および挿入されたn-AlGaN層のAlN組成も包括的に調査します。 PNP-AlGaNアーキテクチャの概要。
調査方法と物理モデル
AlGaNベースのDUVLEDの電流拡散メカニズムをより明確にするために、さまざまなDUV LEDデバイスが設計されています(図1aを参照)。すべてのDUVLEDは、厚さ4μmのn型Al 0.60 で構成されています。 Ga 0.40 Siドーピング濃度が5×10 18 のN層 cm -3 。次に、3 nm Al 0.45 の5つの周期 Ga 0.55 N / 12 nm Al 0.56 Ga 0.44 N個のMQWが続きます。次に、厚さ18nmのp型Al 0.60 でMQWをキャップします。 Ga 0.40 N電子ブロッキング層(p-EBL)、その上に198nmの厚さのp型Al 0.40 Ga 0.60 正孔注入層には、N層と厚さ50nmのp型GaNキャップ層を採用しています。 p型層の正孔濃度は3×10 17 に設定されています。 cm -3 。提案されたPNP-AlGaN構造のDUVLEDの場合、従来のp型バルクAl 0.40 Ga 0.60 N層はp-Al 0.40 に置き換えられます Ga 0.60 N / n-Al x Ga 1- x N / p-Al 0.40 Ga 0.60 N層。図1bは、PNP-AlGaN層の概略構造図を示しています。図1cは、PNP-AlGaN構造の原子価バンド図を示しています。この図から、正孔の障壁を確認できます。バリアは、薄いn-Al x のSiドーパントが枯渇したために発生します。 Ga 1- x N層[26]。この障壁は、DUVLEDの電流経路とデバイス性能を決定する上で非常に重要です。詳細な分析は後で行われます。
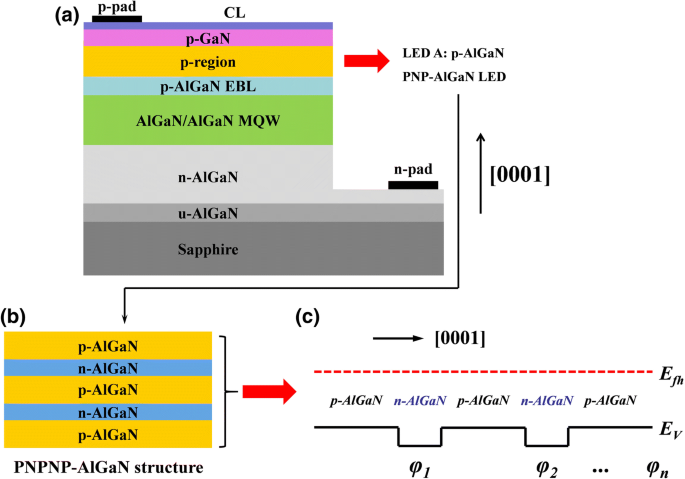
a 調査対象のデバイス(参照LEDAおよびPNPNP-AlGaNLED)の概略図、 b 2つのPNP-AlGaN接合を備えたPNP-AlGaN構造の概略図 c 複数のPNP-AlGaN接合を備えたPNP-AlGaN構造の概略原子価バンド図。φ 1 、φ 2 、およびφ n [0001]方向および n に沿った各PNP-AlGaN接合のバリア高さを示します PNP-AlGaN接合数を表します
電流を拡散する際のPNP-AlGaN構造のメカニズムをさらに説明するために、図2aに、サファイア基板上に成長したDUVLEDの簡略化された等価回路と電流流路を示します。電流は、p-AlGaN領域からn-AlGaN領域に垂直方向と横方向の両方に流れます。通常、電流拡散層(CL)の厚さ(つまり、デバイスの場合は200 nm)は、n-AlGaN層の厚さ(つまり、デバイスの場合は4μm)よりもはるかに薄くなります。したがって、CLの電気抵抗はn-AlGaN電子注入層の電気抵抗よりもはるかに大きくなります。次に、電流はp電極の下、つまり J に集まる傾向があります。 1 > J 2 > J 3 > J 4 > .....> J n 、これは現在の混雑効果として知られています[27]。幸い、p型正孔注入層にPNP-AlGaN接合を組み込むことで、電流の密集効果を抑えることができます。また、図2bを使用して、全電流を垂直部分に分割することで、根本的なメカニズムを解釈できます( J 1 )と水平部分( J 2 )。参考文献によると。 [27]、 J 間の関係 1 および J 2 式によってリンクすることができます。 (1)次のように
$$ \ frac {J_1} {J_2} \ cong \ frac {l} {\ frac {\ rho_p} {\ rho _ {\ mathrm {CL}}} {t} _p + \ frac {N \ cdot {\ rho} _ {\ mathrm {PNP}}} {\ rho _ {\ mathrm {CL}}}}、$$(1)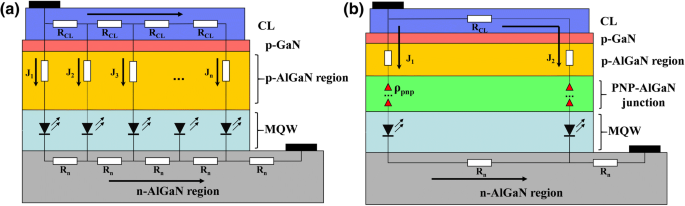
a 横方向電流注入方式のDUVLEDの等価回路( J 1 > J 2 > J 3 > J 4 >……> J n )および b PNP-AlGaN構造のLEDの簡略化された等価回路、電流経路( J 1 および J 2 )も表示されます
ここで l は水平方向の電流経路の長さ、 t p は厚さ、ρ p p型正孔注入層の垂直抵抗率ρを表します CL exsitu堆積電流拡散層の抵抗率ρを示します PNP は、各PNP-AlGaN接合部で誘導される特定の界面抵抗率を意味し、 N PNP-AlGaN接合の数を表します。式に基づく。 (1)、 J を増やすことができると推測します 2 ρを減らすことによって CL 。式(1)は、垂直抵抗の適切な増加(つまり、ρ)も示しています。 p× t p ) J の強化にも役立ちます 2 。または、 N・ρを含めることにより、垂直抵抗を大きくすることもできます。 PNP 。ただし、 N・ρの値 PNP PNP-AlGaN接合の数の影響を受ける可能性があります。さらに、ρの値 PNP n-Al x のドーピング濃度、厚さ、およびAlN組成の影響を受けます。 Ga 1- x N層。したがって、さまざまなPNP-AlGaN接合に関する詳細については、後で説明します。
デバイスの物理的性質の調査は、APSYS [28]を使用して行われます。 AlGaN / AlGaNヘテロ接合の伝導バンドオフセットと原子価バンドオフセットの間のエネルギーバンドオフセット比は50:50に設定されています[29]。分極レベルは、格子不整合界面での分極誘導電荷を計算するために40%に設定されています[30、31]。 Auger再結合係数とShockley-Read-Hall(SRH)再結合寿命は1.0×10 -30 に設定されています。 cm 6 / s [27]と10ns [32]。 DUV LEDの光抽出効率は約8%に設定されています[33]。窒素含有III-V半導体に関するその他のパラメータは、他の場所で見つけることができます[34]。
結果と考察
DUVLEDの電流拡散におけるPNP-AlGaN接合の有効性の証明
DUV LEDの電流を拡散する際のPNP-AlGaN構造の有効性を示すために、PNP-AlGaN構造のない参照DUV LED(つまり、LED A)とPNP-AlGaN構造のあるDUV LED(つまり、LED B)は次のとおりです。勉強した。 DUV LEDのアーキテクチャ情報は、LED BのPNP-AlGaN構成を除いて、研究方法と物理モデルのセクションに記載されていることに注意してください。LEDBには2つのPNP-AlGaNループ、つまりPNPNP-AlGaN構造があります。各PNP-AlGaN接合部は、p-Al 0.40 で構成されます。 Ga 0.60 N / n-Al 0.40 Ga 0.60 N / p-Al 0.40 Ga 0.60 N構造。厚さ20nmのn-Al 0.40 のSiドーピング濃度 Ga 0.60 N挿入層は5.3×10 17 cm -3 。電流密度170A / cm 2 でのLEDBのエネルギーバンド図を計算して表示します 図3a。 LED A(エネルギーバンドはここには示されていません)と比較すると、MQWに注入される前に穴が2つの障壁に遭遇することがわかります。ここでの価電子帯の障壁は、電流を効果的に拡散し、正孔を横方向によりよく均質化することができます。私たちのポイントにさらに取り組むために、そしてデモンストレーションの目的のために、p-EBLに最も近い量子井戸[すなわち、最後の量子井戸(LQW)]の横方向の正孔濃度プロファイルを図3bに示します。 LED Bの正孔分布は、実際にLQWでより均一なプロファイルを示しています。図2bの観察結果は、図3aのエネルギーバンド図および以前の分析とよく一致しており、PNP-AlGaN構造が電流拡散効果の改善に役立つことが証明されています。
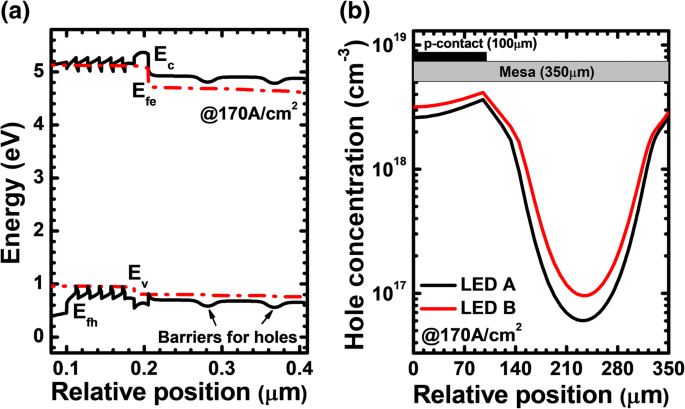
a 電流密度170A / cm 2 でのLEDBのエネルギーバンド図 。 E c 、 E v 、 E fe 、および E fh 電子と正孔の伝導帯、価電子帯、擬フェルミ準位をそれぞれ示します。 b 170 A / cm 2 の電流密度でのLEDAおよびBの最後の量子井戸における横方向の正孔分布 、それぞれ
次に、図4a、bに、それぞれLEDAとBのMQW領域での正孔濃度と放射再結合率のプロファイルを示します。現在の拡散効果を監視するために、図4a、bのデータは、メサの左端から230μm離れた位置で収集されていることに注意してください。 LED Bの電流拡散の改善により、MQWへの正孔注入の促進も可能になることがわかります。 MQWの正孔濃度の改善により、図4bに従って、LEDBの放射再結合率が向上します。

a 正孔濃度プロファイルと b 170 A / cm 2 の電流密度でのLEDAおよびBのMQW領域での放射再結合率 、それぞれ
次に、図5aは、LED AとBの注入電流密度レベルに関するEQEと光パワー密度を示しています。LEDAとBのEQEレベルはそれぞれ3.38%と4.13%であり、 170 A / cm 2 の電流密度 。これらの観察された改善は、より良い電流拡散効果とLED BのMQW領域への正孔注入の強化に起因します。前述のように、PNP-AlGaN構造の採用は、価電子帯のエネルギー障壁につながる可能性があります。順方向電圧に影響を与える可能性があります。 LED Bの順方向電圧がわずかに増加していることを示す図5bを参照すると、推測が証明されます。LEDBの順方向電圧が高いにもかかわらず、図5cによると、LEDのウォールプラグ効率はLEDAの場合よりも大きくなります。 、170 A / cm 2 の電流密度レベルでLEDAとBの数値が3.56%と4.27%になるように 、 それぞれ。図5a、cをさらに比較すると、WPEのLED Bの垂下がより顕著であることがわかります。これは、PNP-AlGaN接合での追加の電圧降下によるものです。したがって、さまざまなPNP-AlGaN設計に対するEQE、順方向電圧、およびWPEの感度を明らかにするより包括的な調査を実施することが本質的に重要です。
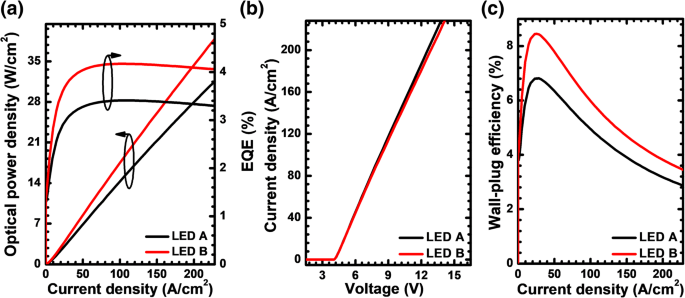
a 注入電流の関数としての光出力パワー密度とEQE、 b 電流-電圧特性、 c LEDAとBのそれぞれの注入電流に関するWPE
デバイスのパフォーマンスに対するn-AlGaN層の厚さの影響
式によると。 (1)、 N・ρの値を大きくすることで、水平方向の電流の流れを向上させることができると結論付けることができます。 PNP 。 n-Al 0.40 の場合、PNP-AlGaN接合のバリア高さは増加します。 Ga 0.60 N層が厚くなるため、ρが大きくなります。 PNP を得ることができ、これは電流拡散効果の改善に有益です。ただし、n-Al 0.40 Ga 0.60 N層が厚すぎるため、p-Al 0.40 に穴が多くなります Ga 0.60 N層が枯渇する可能性があり、これにより導電性が犠牲になる可能性があります。したがって、n-Al 0.40 の厚さの関係をよりよく説明するために Ga 0.60 DUV LEDのN層と性能については、n-Al 0.40 の影響を調査する必要があります。 Ga 0.60 電流拡散、正孔注入、EQE、順方向電圧、およびWPEでのPNP-AlGaN接合のN層の厚さ。そのために、n-Al 0.40 の値を変更します Ga 0.60 6、13、20、27、34 nmのN層の厚さで、デバイスはそれぞれLED T1、T2、T3、T4、T5と呼ばれます。表1は、各PNP-AlGaN接合の価電子帯バリア高さをまとめたもので、n-Al 0.40 とともにバリア高さが増加することを示しています。 Ga 0.60 N層の厚さが増加し、n-Al 0.40 の増加が証明されます。 Ga 0.60 N層の厚さにより、大きな N・ρが可能になります PNP 、したがって、水平電流 J が増加します 2 。次に、図6aは、PNP-AlGaN構造の電流拡散層のないLEDAとさまざまなn-Al 0.40 のあるLEDの最後の量子井戸の正孔濃度プロファイルを示しています。 Ga 0.60 170 A / cm 2 の電流密度でのN層の厚さ 。 n-Al 0.40 の厚さだけでなく、最後の量子井戸でも正孔がより均一に分布するようになることが明らかにわかります。 Ga 0.60 N挿入層が増加します。
<図>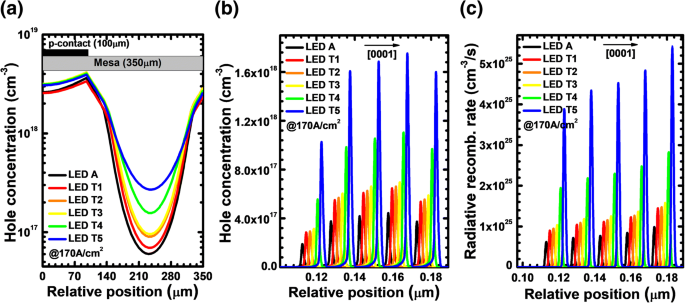
a 最後の量子井戸 b の横方向の正孔分布 正孔濃度プロファイルと c 170 A / cm 2 の電流密度でのLEDA、T1、T2、T3、T4、およびT5のMQW領域での放射再結合率プロファイル 。パネル b のプロットされた曲線 および c 解像度を上げるために意図的に2nmシフトしています
次に、電流密度170 A / cm 2 で調査したすべてのデバイスについて、MQW領域の正孔濃度プロファイルと放射再結合率プロファイルを示します。 それぞれ図6b、cにあります。穴の濃度と放射率のプロファイルは、左側のメサエッジから230μm離れた位置で収集されます。視覚的な解像度を高めるために、LED A、T1、T2、T3、T4、およびT5の正孔濃度と放射再結合率のプロファイルは、それぞれ図6b、cで2nmだけ空間的にシフトされています。 LED Aの正孔濃度が最も低く、したがってMQW領域での放射再結合率が最も低いことが明確に示されています。 MQW領域の正孔濃度と放射再結合率は、n-Al 0.40 の厚さが増すにつれて増加します。 Ga 0.60 N層。
図6cに示されている観測結果は、EQE、および図7aに示されている光パワー密度とよく一致しており、n-Al 0.40 の厚さが増加しています。 Ga 0.60 PNP-AlGaN接合のN層は、EQEと光パワー密度を向上させることができます。ただし、各PNP-AlGaN接合部の正孔の価電子帯障壁の高さは、n-Al 0.40 になると大きくなります。 Ga 0.60 N層は、表1に従って厚くなります。これにより、図7bに示すように、提案されたDUVLEDの順方向電圧がそれに応じて増加します。したがって、n-Al 0.40 の影響 Ga 0.60 LED性能に広がるPNP-AlGaN電流のN層の厚さは、WPEと注入電流密度の関係を示すことによって評価する必要があります(図8を参照)。 n-Al 0.40 の増加に伴い、WPEが単調に増加しないことがわかります。 Ga 0.60 N層の厚さ。 n-Al 0.40 に関するEQEとWPE Ga 0.60 N層の厚さは、図8の挿入図に示されています。この作業で提案されたデバイスアーキテクチャでは、n-Al 0.40 のときにWPEが最大値に達します。 Ga 0.60 N挿入層の厚さは20nmで、n-Al 0.40 になると減少します。 Ga 0.60 N挿入層が厚くなります。この現象は、n-Al 0.40 のときに垂直抵抗が増加したためと考えられます。 Ga 0.60 N層の厚みが厚くなり、消費電力が大きくなります。したがって、PNP-AlGaN接合部のn-AlGaN挿入層の厚さは慎重に最適化する必要があります。このセクションでは、AlN組成を40%、つまりn-Al 0.40 に設定します。 Ga 0.60 Nはデモンストレーションの目的であり、AlNの組成を増やすと、n-AlGaN挿入層の最適化された厚さが薄くなると考えられます。
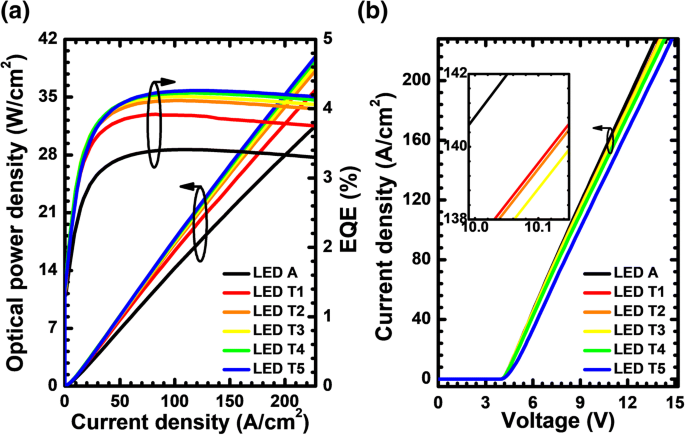
a 光出力電力密度、 b LED A、T1、T2、T3、T4、およびT5の電流-電圧特性。挿入図は、ズームイン電流-電圧曲線を示しています
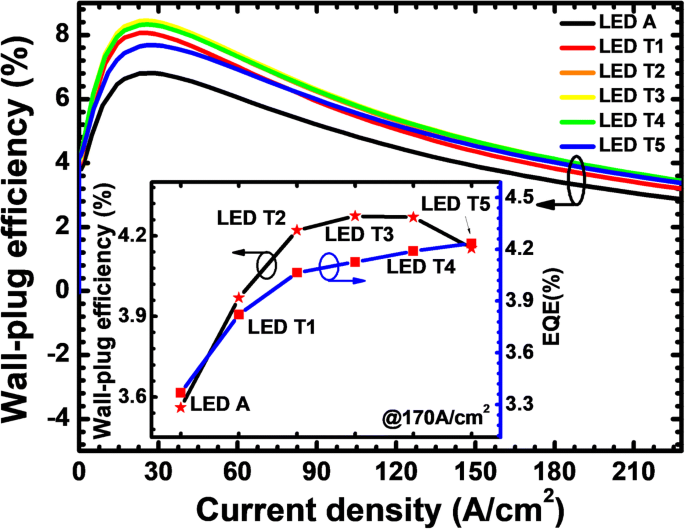
LED A、T1、T2、T3、T4、およびT5の注入電流の関数としてのWPE。挿入図は、n-Al 0.40 のさまざまな厚さの調査対象LEDのWPEとEQEを示しています。 Ga 0.60 170 A / cm 2 の電流密度でのPNP-AlGaN接合のN層
デバイスの性能に対するn-AlGaN層のドーピング濃度の影響
n-AlGaN層の厚さに加えて、n-AlGaN層のドーピング濃度は、正孔の価電子帯障壁の高さを変更する可能性があるため、 N・ρに影響を与えます。 PNP 。 n-AlGaN層のドーピング濃度が電流拡散効果とPNP-AlGaN接合を備えたDUVLEDの光学性能に与える影響をより正確に調べるために、ドーピング濃度を1.3×10 17 、5.3×10 17 、9.3×10 17 、1.33×10 18 、および1.73×10 18 cm -3 LED D1、D2、D3、D4、およびD5のn-AlGaN層のそれぞれ。 n-AlGaN層の厚さは20nmに設定され、2つのPNP-AlGaN接合が採用されています。 AlNの組成は40%、つまりn-Al 0.40 Ga 0.60 N。
表2は、n-Al 0.40 のSiドーピング濃度が高くなると、正孔の価電子帯障壁の高さが増加することを示しています。 Ga 0.60 PNP-AlGaN接合部のN層が高くなります。価電子帯の障壁の高さが増加していることは、 N・ρが大きいことを示しています。 PNP 、同時に J の高い水平電流を生成します 2 。式によると。 (1)、電流拡散の増加は、より均一な横方向の正孔濃度プロファイルを伴うため、図9aに、PNP-AlGaNが完了すると、最後の量子井戸の横方向の正孔分布がより均質化されることを示します。 LED Aと比較した場合、接合部はDUV LEDにドープされます。さらに、n-Al 0.40 のSiドーピング濃度が高くなると、横方向の正孔はより均一に分布します。 Ga 0.60 PNP-AlGaN接合部のN層が増加します。
<図>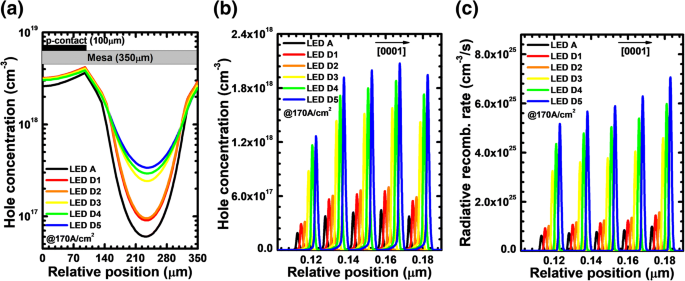
a 最後の量子井戸 b の横方向の正孔分布 正孔濃度プロファイル、および c 電流密度170A / cm 2 でのMQW領域またはLEDA、D1、D2、D3、D4、およびD5の放射再結合率プロファイル 。パネル b のプロットされた曲線 および c 解像度を上げるために意図的に2nmシフトしています
次に、電流密度170 A / cm 2 で調査したすべてのデバイスについて、MQW領域の正孔濃度プロファイルと放射再結合率プロファイルを示します。 それぞれ図9b、cで、左メサエッジから230μm離れた位置に集められています。 LED Aは、MQW領域で正孔濃度が最も低く、放射再結合率が最も低いことが明確に示されています。 MQW領域の正孔濃度と放射再結合率は、n-Al 0.40 のドーピング濃度の増加とともに増加します。 Ga 0.60 PNP-AlGaN接合を備えたLED用のN層。 LED D1、D2、D2、D3、D4、およびD5のMQWでの正孔濃度レベルの向上は、PNP-AlGaN接合のおかげで、より優れた電流拡散効果によるものです。
次に、図10aで、調査対象のデバイスの注入電流密度の観点から、EQEと光パワー密度をさらに計算して提示します。観察されたEQEは、図9b、cの結果と一致しており、PNP-AlGaN接合を使用するとEQEを改善できます。それ以上に、n-Al 0.40 のSiドーピング濃度として Ga 0.60 PNP-AlGaN接合部のN層が増加すると、電流拡散が改善されるため、EQEをさらに促進できます。図10bは、調査対象のデバイスの順方向動作電圧を比較しています。 n-Al 0.40 のドーピング濃度の増加に伴い、順方向動作電圧が増加することが示されています。 Ga 0.60 N層。 Siのドーピング濃度は1.33×10 18 であることに注意してください。 および1.73×10 18 cm -3 、ターンオン電圧は大幅な増加を示しています。これは、n-Al 0.40 にSiをドープすると、PNP-AlGaN内蔵接合が寄生ダイオードとして動作することを示しています。 Ga 0.60 N層は非常に高いレベルに増加します。さまざまなPNP-AlGaN接合を備えたDUVLEDの性能をより正確に評価するために、図11は、LED A、D1、D2、D3、D4、およびD5の注入電流密度の関数としてのWPEを示しています。明らかに、WPEはLED D5で最も低く、これは順方向電圧の消費量が最も多いためです。図11の挿入図は、WPEがn-Al 0.40 のSiドーピング濃度に対してより敏感であることも示しています。 Ga 0.60 EQEよりN層。 n-Al 0.40 のSiドーピング濃度が高いと結論付ける価値があります。 Ga 0.60 N層は確かに電流拡散層を改善し、光子生成率を高めることができます。それにもかかわらず、PNP-AlGaN接合部での追加の順方向電圧降下は、より多くの電力を消費するため、WPEが制限されます。このセクションの調査結果は、n-Al x のSiドーピング濃度も示しています。 Ga 1- x AlNの組成および/またはn-Al x の厚さを増やす場合は、N層を適切に減らす必要があります。 Ga 1- x PNP-AlGaN接合のN層。そうすることで、改善されたEQEと適切なWPEの両方を得ることができます。
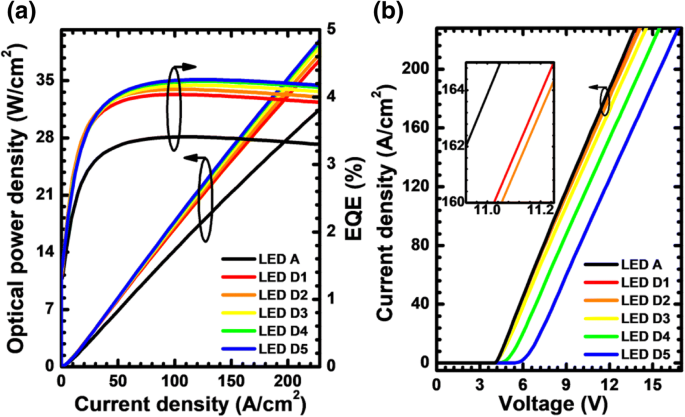
a 注入電流の関数としての光出力パワー密度とEQE、 b LED A、D1、D2、D3、D4、およびD5の電流-電圧特性。挿入図は、ズームイン電流-電圧曲線を示しています
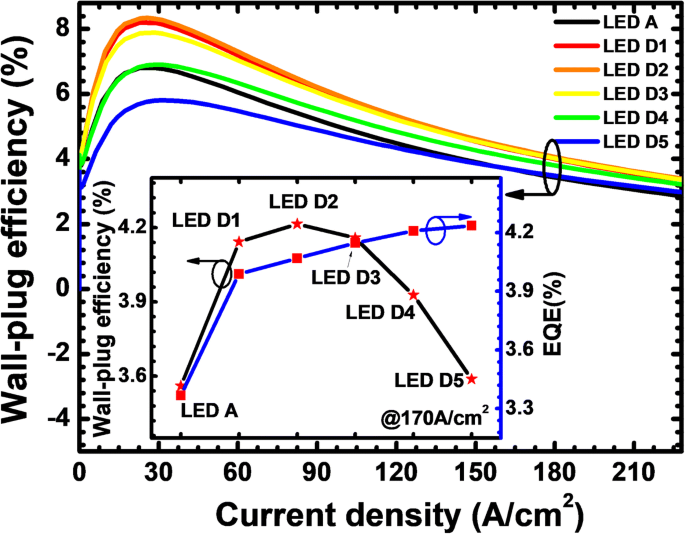
LED A、D1、D2、D3、D4、およびD5の注入電流の関数としてのWPE。挿入図は、n-Al 0.40 のさまざまなドーピング濃度で調査したLEDのWPEとEQEを示しています。 Ga 0.60 電流密度170A / cm 2 のN層
デバイスのパフォーマンスに対するPNP-AlGaNジャンクション番号の影響
このセクションでは、DUVLEDの電気的および光学的性能に対するPNP-AlGaN接合の数の影響を調べます。デモンストレーションの目的で、ドーピング濃度とn-AlGaN層の厚さを5.3×10 17 に固定します。 cm -3 それぞれ20nmと20nmです。 AlN組成は、n-Al 0.40 などの0.40に選択されます。 Ga 0.60 N. PNP-AlGaN接合には異なるループを採用しています。つまり、LED N1、N2、N3、およびN4のループ番号はそれぞれ1、2、3、および4に設定されています。まず、表3に、各PNP-AlGaN接合の価電子帯障壁の高さを計算して示します。PNP-AlGaN接合数の増加により、全体的な N・ρが明らかになることがわかります。 PNP 高い。次に、電流密度170 A / cm 2 でのLEDA、N1、N2、N3、およびN4の最後の量子井戸の正孔の横方向分布を計算して示します。 (図12aを参照)。これは、より多くのPNP-AlGaN接合が組み込まれるにつれて、最後の量子井戸の正孔分布がより均一になることを示しています。図12aの結果は、式(1)によって行われた予測をさらに裏付けています。 (1)。
<図>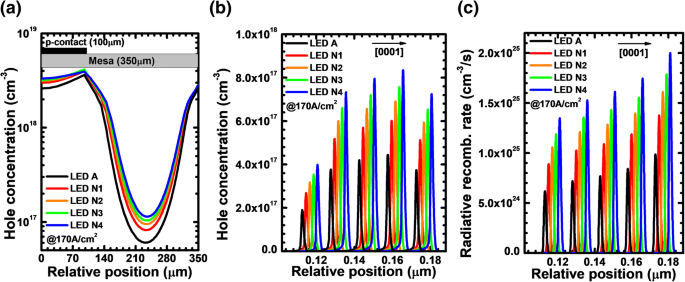
a 最後の量子井戸 b の横方向の正孔分布 正孔濃度プロファイル、および c 170 A / cm 2 の電流密度でのLEDA、N1、N2、N3、およびN4のMQW領域での放射再結合率プロファイル 。パネル b のプロットされた曲線 および c 解像度を上げるために意図的に2nmシフトしています
次に、電流密度170 A / cm 2 でのLEDA、N1、N2、N3、およびN4のMQW領域における正孔濃度と放射再結合率のプロファイルを示します。 それぞれ図12b、cにあります。穴と放射再結合率のプロファイルは、左メサエッジから230μm離れた位置でプローブされます。 PNP-AlGaN接合の数が多いほど、正孔濃度と放射再結合率が高くなることが示されています。ここで言及する価値があるのは、 N の値を増加させないことです。 N のときから、4を超える がさらに増加すると、残りのp-Al 0.40 の厚さが増加します。 Ga 0.60 N層が非常に薄くなるため、イオン化されたSiドーパントによって正孔が枯渇し、正孔の供給が不十分になる可能性があります。
改善された電流拡散効果のおかげで、MQW領域の正孔濃度が向上し、LED N1、N2、N3、およびN4は、LED Aと比較してEQEと光パワー密度を向上させます(図13aを参照)。図13bは、より多くのPNP-AlGaN接合が組み込まれると、推奨されるDUVLEDの順方向動作電圧も増加することを示しています。幸い、LED N1、N2、N3、およびN4の順方向電圧を上げても、図14によるとWPEは低下しません。図14の挿入図をさらに調査すると、EQEとWPEの両方がPNP-AlGaN接合の数が増えるにつれて飽和レベル。したがって、先にも指摘したように、PNP-AlGaN接合の数をさらに増やすと、正孔が枯渇し、それに応じて正孔供給能力が低下する可能性があり、EQEとWPEの向上にはほとんど寄与しないと考えられます。この作業で提案されたデバイスアーキテクチャ。
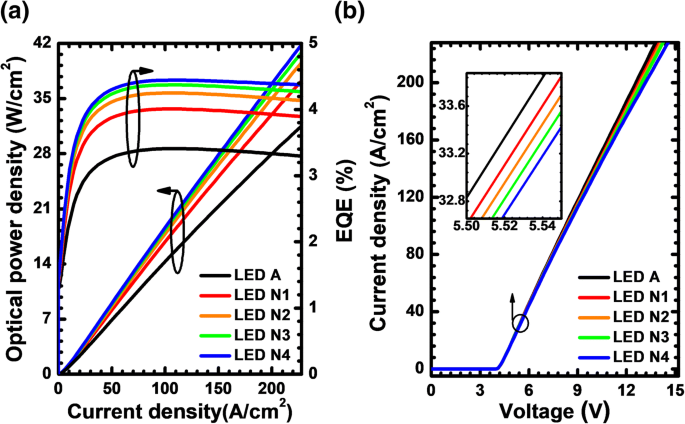
a 注入電流の関数としての光出力パワー密度とEQE、 b LED A、N1、N2、N3、およびN4の電流-電圧特性。挿入図は、ズームイン電流-電圧曲線を示しています
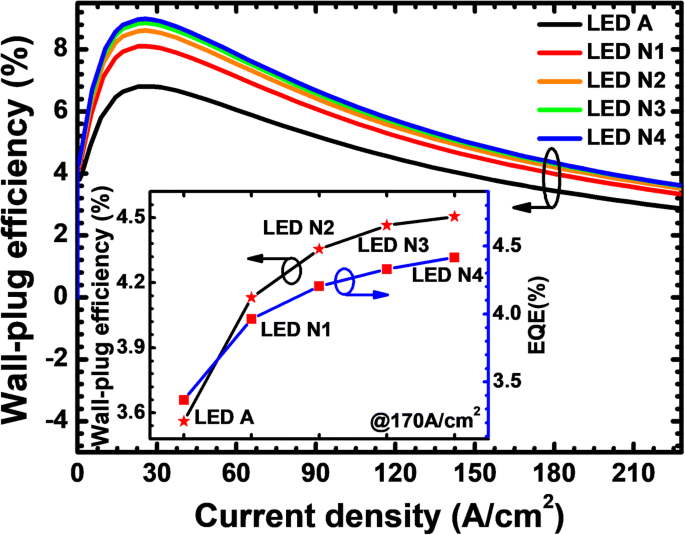
LED A、N1、N2、N3、およびN4の注入電流の関数としてのWPE。挿入図は、電流密度170 A / cm 2 でさまざまな数のPNP-AlGaN接合を備えたLEDのWPEとEQEを示しています。
n-AlGaN層のAlN組成がデバイスのパフォーマンスに与える影響
最後に、ρを変更します PNP PNP-AlGaN接合部のn-AlGaN層のAlN組成を変えることによって。 n-AlGaN層のAlN組成の値は、LED C1、C2、C3、C4、およびC5に対してそれぞれ0.40、0.43、0.46、0.49、および0.51に設定されています。 n-AlGaN層の厚さとSiドーピング濃度は20nmと5.3×10 17 に設定されています。 cm -3 、 それぞれ。 LED C1、C2、C3、C4、およびC5には2つのPNP-AlGaN接合を採用しています。残りのp-AlGaN層のAlN組成は0.40に固定されています。表4は、n-AlGaN挿入層にさまざまなAlN組成を持つPNP-AlGaN接合の価電子帯障壁の高さを示しています。 n-AlGaN層のAlN組成が増加すると、正孔の価電子帯障壁の高さが高くなることは容易に理解できます。図15aは、電流密度170 A / cm 2 でのLEDA、C1、C2、C3、C4、およびC5の最後の量子井戸の正孔の横方向分布を示しています。 。 n-AlGaN層のAlN組成が0.43まで増加すると、電流拡散効果が大幅に向上します。 n-AlGaN層のAlN組成が0.43を超えると、n-AlGaNのAlN組成が高すぎると正孔注入がブロックされる可能性があるため、正孔をさらに健全に広げることはできないようです。
<図>
a 最後の量子井戸 b の横方向の正孔分布 正孔濃度プロファイル、および c 170 A / cm 2 の電流密度でのLEDA、C1、C2、C3、C4、およびC5のMQW領域での放射再結合率プロファイル 。パネル b のプロットされた曲線 および c 解像度を上げるために意図的に2nmシフトしています
電流密度170A / cm 2 でのLEDA、C1、C2、C3、C4、およびC5のMQW領域における正孔濃度と放射再結合率のプロファイル それぞれ図15b、cに示されています。データは、メサの左端から230μm離れた位置でも収集されます。ここでの結論は、図6b、図9b、および図12bの結論と同様です。つまり、PNP-AlGaN電流拡散層を採用すると、正孔注入が増加し、MQW領域の正孔濃度がさらに向上します。 n-AlGaN層のAlN組成が増加します。次に、調査対象のデバイスの注入電流の観点から、EQEと光パワー密度をさらに計算して提示します(図16a)。明らかに、PNP-AlGaN接合を使用すると、EQEを改善できることがわかります。さらに、PNP-AlGaN接合のn-AlGaN層のAlN組成が増加すると、以前に示したように各量子井戸面の正孔濃度を均一化するより良い電流拡散のおかげで、EQEをさらに促進できます。 。
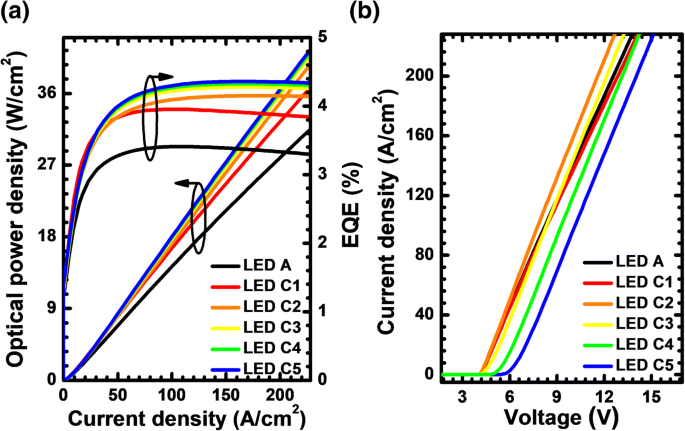
a 注入電流と b の関数としての光出力パワー密度とEQE LED A、C1、C2、C3、C4、およびC5の電流-電圧特性
図16bは、LED A、C1、C2、C3、C4、およびC5の電流-電圧特性を調査しています。このデバイスは、PNP-Al 0.40 を使用してLEDC1の順方向動作電圧がわずかに上昇します。 Ga 0.60 LED Aと比較した場合のN接合。一方、デバイスはLEDC4およびC5に対してより多くの順方向電圧を消費します。ここでの観察は、図7b、図10b、および図13bの観察と一致しており、PNP-AlGaN接合の採用により、正孔の価電子帯バリアの高さが追加され、その結果、順方向電圧が増加します。さらに、ターンオン電圧(LED C4およびC5など)もあります。ただし、LED C2およびC3の順方向動作電圧は、LED Aと比較すると低下していることに注意してください。現時点では、根本的なメカニズムは明確ではありません。ただし、暫定的に、LED C2およびC3の順方向電圧の低下は、穴の加速効果によるものと考えられます[35]。
図17は、テストしたLEDのWPEと注入電流密度の関係を示しています。特に注入電流密度が89A / cm 2 を超える場合、提案されたすべてのLEDのWPEを強化できることがわかります。 。 LED C5に関する洞察に満ちた調査によると、電流密度が89 A / cm 2 未満の場合、LEDC5のWPEはLEDAのWPEよりも低くなります。 。それにもかかわらず、LED C5のWPEは、注入電流密度が高くなると(つまり、> 89 A / cm 2 )、LEDAのWPEを圧倒します。 )。よく知られているように、LEDデバイスが高電流レベルでバイアスされると、電流が混雑しやすくなります。 LED C5のWPEは、PNP-Al 0.51 Ga 0.49 N接合は確かに電流拡散効果を改善するのに効果的です。ただし、PNP-AlGaN接合での追加の電圧消費を考慮すると、図17の挿入図に従ってWPEを最大化できるように、n-AlGaN層のAlN組成を設定する際には十分に注意する必要があります。
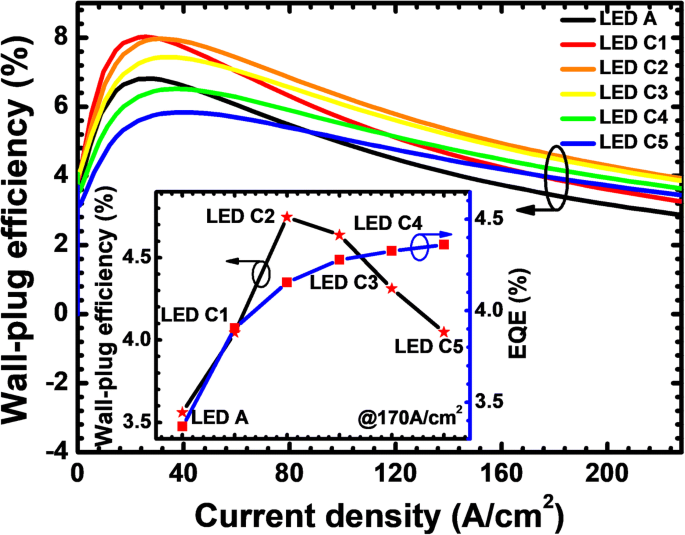
LED A、C1、C2、C3、C4、およびC5の注入電流の関数としてのWPE。挿入図は、電流密度170 A / cm 2 でのn-AlGaN層のさまざまなAlN組成を持つ調査対象のLEDのWPEとEQEを示しています。
結論
要約すると、DUV LED用のPNP-AlGaN接合が調査され、実証されています。提案されたPNP-AlGaN接合によって支援され、電流拡散効果を改善することができます。改善された電流拡散効果は、垂直方向の抵抗の増加と水平方向の電流の流れの強化によく起因しています。さらに、パラメトリックスタディを実施して、現在の拡散効果、EQE、およびWPEに対するさまざまなPNPジャンクションを明らかにしました。厚さ、ドーピング濃度、n-AlGaN挿入層のAlN組成、およびPNP-AlGaN接合の数を適切に増やすことにより、電流拡散効果を改善できることがわかります。一方、現在の拡散効果が実際にEQEを強化できることもわかりました。ただし、PNP-AlGaN接合が完全に最適化されていない場合、順方向電圧が上昇する可能性があり、そのコストはWPEの削減になります。電流拡散の特徴は、厚さ、ドーピング濃度、n-AlGaN挿入層のAlN組成、およびPNP-AlGaN接合の数の協調関数であることも指摘する価値があります。結果として、DUVLED用のPNP-AlGaN電流拡散層の最良の設計に対する独自の答えはありません。ただし、この作業の結果は、PNP-AlGaN電流拡散層とDUVLEDの電流拡散効果に追加の物理的理解をもたらすと強く信じています。したがって、この作業は光半導体デバイスのコミュニティにとって非常に役立ちます。
略語
- APSYS:
-
半導体デバイスの高度な物理モデル
- CBL:
-
現在のブロッキング層
- CL:
-
現在の拡散層
- DUV LED:
-
深紫外線発光ダイオード
- EQE:
-
外部量子効率
- IQE:
-
内部量子効率
- LQW:
-
最後の量子井戸
- MOCVD:
-
有機金属化学蒸着
- MQW:
-
複数の量子井戸
- PNP-AlGaN:
-
p-AlGaN / n-AlGaN / p-AlGaN
- SRH:
-
Shockley-Read-Hall
- WPE:
-
ウォールプラグの効率
ナノマテリアル
- AIコンピューティングのためのニューロモルフィックチップの主張
- IBMの科学者がナノスケール用の温度計を発明
- 電子増倍管の発光層の設計
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- ペロブスカイト太陽電池用のTiO2コンパクト層を製造するための最適なチタン前駆体
- 高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
- PEDOT:PSSを正孔輸送層として処理する高極性アルコール溶媒を使用した高輝度ペロブスカイト発光ダイオード
- 異なる温度でのAlGaN深紫外線発光ダイオードのエレクトロルミネッセンス特性に及ぼす量子井戸幅の影響
- 高効率白色発光ダイオードのための環境に優しいペロブスカイトの統合
- 深紫外線フリップチップ発光ダイオードの光抽出効果に及ぼすメッシュp型接触構造の影響
- AC 電流の最も一般的な用途は?



