異なる温度でのAlGaN深紫外線発光ダイオードのエレクトロルミネッセンス特性に及ぼす量子井戸幅の影響
要約
AlGaN深紫外線発光ダイオード(DUV LED)のエレクトロルミネッセンス特性に対する量子井戸(QW)幅の影響をさまざまな温度で研究しました。 3.5 nmQWのLEDと2nmのLEDの最大外部量子効率(EQE)比は、室温(RT)の6.8から5 Kの8.2に増加しました。ただし、3.5 nmQWのLEDと5nmのLEDの比はQWはRTでの4.8から5Kで1.6に減少しました。EQE比のさまざまな変化は、非放射再結合の減少とアクティブ領域のボリュームの増加に起因していました。理論的分析から、2 nmウェルのLEDは、量子閉じ込め効果により電子オーバーフローに対するバリアが最も浅いのに対し、5 nmウェルのLEDは、内部電界が大きいため、電子と正孔のオーバーラップが最小でした。したがって、3.5 nm QWのLEDは、同じ温度で最大のEQEが最も高くなりました。温度が下がると、すべてのLEDで最大EQEの電流が減少しました。これは、QWからオーバーフローした電子の増加と正孔濃度の減少によるものと考えられます。この結果は、DUVLEDの偏光効果と電子オーバーフローの組み合わせを理解するのに役立ちました。
背景
AlGaNベースの深紫外線発光ダイオード(DUV LED)は、固体照明、医療、生化学などの分野で広く使用できます。したがって、材料の結晶品質の改善[1,2,3,4]、p型ドーピング技術、およびデバイス構造の最適化[5,6,7,8、 9]。三宅ほかAlN結晶の品質は、高温アニーリングによって大幅に改善できることが実証されました[3]。成長温度を上げることによって、Sun等。サファイア上に高品質のAlN厚膜が得られました[2]。最近、江ら。 AlNホモエピタキシャル成長における欠陥の進展を研究しました[1]。彼らの結果は、AlNホモエピタキシーメカニズムの理解に貢献し、結晶品質を改善するための重要な技術を提供しました。さらに、フォトニック結晶やナノ構造、表面プラズモンなど、光抽出を改善するための多くの方法が提案されました[10、11、12]。過去数十年で、この種のLEDについて大きな進歩が得られ、Liらによって全体的にレビューされました。 [13]。それにもかかわらず、デバイスの性能は、外部量子効率が低いため、まだ実用化にはほど遠い。 III族窒化物がウルツ鉱構造を持っていることはよく知られています。ウルツ鉱構造では、大きな自発的および圧電性の場が傾斜したバンド図をもたらします。これらの傾斜したバンドは、LED、LD [14、15]、UV検出器[16、17]などのIII族窒化物ベースのデバイスに大きな影響を及ぼしました。平山ほかAlGaNベースのシングルQWDV LEDのフォトルミネッセンス(PL)特性に対する量子井戸(QW)幅の影響を報告しました[18]。彼らは、QW幅が1.5〜1.7 nmのLEDはより高い発光を示し、QW幅が1.5 nm未満になると、PL強度が低下することを発見しました。これは、ヘテロ界面での非放射再結合の増加に起因します。この作業では、異なる量子井戸(QW)幅のDUV LEDを製造し、エレクトロルミネッセンス(EL)特性に対するQW幅と温度の影響を調べました。 QW幅が3.5nmのLEDが、最高の最大外部量子効率(EQE)を示すことがわかりました。温度が下がると、すべてのLEDで最大EQEの電流が減少しました。これは、正孔濃度の低下とオーバーフローした電子電流の増加によるものと考えられます。
メソッド
LEDは、1.0μmのAlNバッファ層とそれに続く0.5μmの厚さのドープされていないAl 0.6 を使用して、(0001)サファイア基板上に有機金属化学蒸着によって成長させました。 Ga 0.4 Nおよび1.0μm厚のn-Al 0.6 Ga 0.4 Nテンプレート。テンプレートの転位密度は約6×10 9 です。 cm − 2 透過型電子顕微鏡で測定。次にAl 0.49 Ga 0.51 N / Al 0.58 Ga 0.42 N個の複数のQW(MQW)がアクティブ領域として成長しました。バリアの厚さは5.0nmでした。 p-Al 0.3 Ga 0.7 N(25 nm)/ Al 0.6 Ga 0.4 N(25 nm)をp型層として使用しました。最後に、200nmのp-GaNコンタクト層が堆積されました。上記の構造に基づいて、LED A、B、Cという名前の3つのサンプルが、それぞれ2.0、3.5、5.0nmのQW幅で成長しました。
500μm×500μmの正方形のジオメトリ p - n 接合デバイスは、特徴を定義するための標準的なリソグラフィー技術と、 n を露光するための反応性イオンエッチングを使用して製造されました。 -Al 0.6 Ga 0.4 Nオーミック接触層。 Ti / Al / Ni / Au(15/80/12/60 nm)のn型オーミックコンタクトは、電子ビーム蒸着によって堆積され、窒素雰囲気下で900°Cで30秒間ラピッドサーマルアニーリングシステムでアニーリングされました。透明な p の場合 -接点、Ni / Au(6/12 nm)層を電子ビーム蒸着し、600°Cで3分間空気環境でアニールしました。デバイスは、Ni / Au(5/60 nm) p の堆積で完成しました。 コンタクト。 ELスペクトルは、JoninYvonのSymphonyUV強化液体窒素冷却電荷結合デバイス検出器を使用して5Kから室温(RT)まで測定されました。熱加熱効果の影響を回避するために[19]、EL測定では0.5%の1μs電流パルスによるパルス注入を使用しました。
結果と考察
図1aは、100 mAの直流下でLED A、B、およびCの室温(RT)で測定されたELスペクトルを示しています。ここでは、すべてのスペクトルが帯域間放射に対して正規化されています。 LED A、B、CのELピークは、それぞれ約261、265、268nmでした。明らかに、QW幅が増加すると、ELピークは赤方偏移を示しました。さらに、LED AのELスペクトルには、304 nm付近に弱い寄生ピークが存在することに注意してください。これは、電子オーバーフローに関連していることが明らかになっています[20]。図1bは、すべてのLEDのパルス電流の関数としての相対EQEを示しています。すべての値は、LED Bの最大EQEに正規化されました。LEDBの最大EQEは、LEDAおよびCの最大EQEのそれぞれ約6.8倍および4.8倍でした。
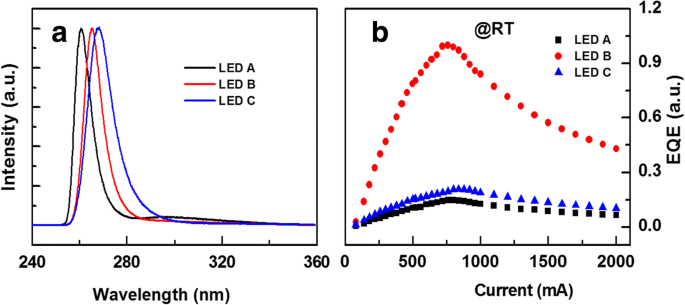
a 100mAの直流下でのLEDA、B、およびCのRTELスペクトル。すべてのスペクトルは、バンド間放射に対して正規化されました。 b パルス電流の関数としての相対EQE
その理由を理解するために、APSYSを使用してキャリアのエネルギーレベルと波動関数をシミュレートしました。図2a–cは、LED A、B、Cのそれぞれについて、100mAの電流で1QWのバンド構造、基底状態レベル、およびキャリア波動関数を示しています。分極効果と加えられた順方向バイアスによって引き起こされる大きな内部場のために、QWのバンド構造は傾斜した形状を示し、量子閉じ込めによりQW幅が増加するにつれて、電子と正孔の波動関数の空間的重なりが少なくなりました。シュタルク効果(QCSE)。 LED A、B、およびCの基底状態のエネルギーギャップは、それぞれ4.733、4.669、および4.637 eVであり、図1aに示すように発光波長とよく一致しました。さらに、QW幅が減少するにつれて、QWによるキャリアの閉じ込め能力が減少することに注意する必要があります。量子閉じ込め効果により、QW幅が減少するにつれて基底状態レベルが増加しました。バリアの高さの値は、LED A、B、Cでそれぞれ0.030、0.057、0.069eVでした。したがって、LED AのEQEは、電子電流のオーバーフローのためにLED BのEQEよりも小さくなりました。これは、図1aに示す明らかな寄生ピークによって確認できます。 LED Cは、すべてのデバイスで電子オーバーフローに対する障壁が最も高かったものの、QCSEにより、そのEQEはLEDBよりも低くなりました。

バンド構造、基底状態レベル、およびキャリア波は、( a の場合、100mAの電流の下で1つのQWで機能します。 )LED A、( b )LED B、および( c )LED C
デバイスの性能を評価するために、低温でのEQEを測定しました。図3aは、5 Kで測定された相対EQEを示しています。すべての値は、LED Bの最大EQEに正規化されています。明らかに、最大EQEの注入電流は、すべてのデバイスのRTでの注入電流と比較して大幅に減少しました。 LED Bの最大EQEは、LEDAとCのそれぞれの約8.2倍と1.6倍でした。電流に依存するEQEはさまざまな温度で測定されました。図3bは、LED Bのさまざまな温度での電流依存の相対EQEを示しています。すべての値は、10 Kでの最大EQEに正規化されています。最大EQEの電流は、温度が下がるにつれて減少したことがわかります。 3つのLEDすべてで同じ現象が見られました。バルク材料では、p-AlGaN中のMgのイオン化エネルギーが高いため、温度が下がると正孔濃度が急速に低下することはよく知られています。私たちの構造では、温度が下がると正孔濃度も下がることが実証されました[21]。また、さまざまな温度での穴の分布をシミュレートしました。図4は、100mAの注入下でのLEDBの100および300Kでのアクティブ領域の正孔濃度を示しています。明らかに、温度が下がるにつれて穴の濃度は減少しました。また、QWからオーバーフローした電子電流は[22]と表すことができます。
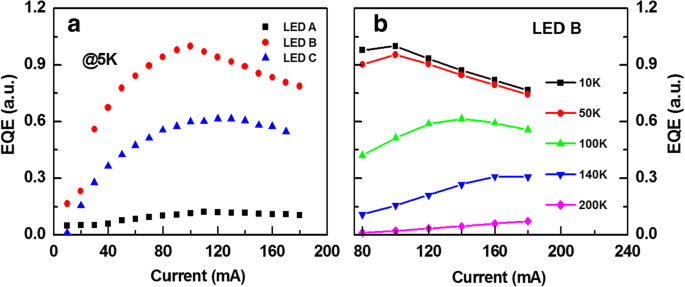
a 5 Kおよび( b での相対EQE )LEDBのさまざまな温度での電流依存の相対EQE

100mAの注入下でのLEDBの100および300Kでのアクティブ領域の正孔濃度
\({J} _ {\ mathrm {overflow}} =D {\ left(\ frac {\ Delta E} {kT} \ right)} ^ 3 qBl \)
ここで D は定数、Δ E 量子井戸のフェルミ準位とバンドエッジの差、 K はボルツマン定数、 T は温度、 q は電子の電荷、 B は二分子放射再結合係数であり、 l MQWの厚さです。特定のLEDの場合、Δ E の変動の寄与 J へ オーバーフロー T と比較して無視できます 温度が下がるにつれて。したがって、 J オーバーフロー 最大EQEに達した注入電流が減少した主な理由は、RTと比較して5Kで大幅に増加したことです。 J オーバーフロー 図3bに示すように、温度が上昇すると減少し、最大EQEの注入電流が増加します。低温では、転位などの非放射中心が凍結するため、内部効率が向上します。これは、アクティブ領域の体積が最大のLEDCにとって有益でした。これが、LEDBとLEDCのEQE比がRTの場合と比較して5Kで減少した最も可能性の高い理由でした。同様に、LEDBとLEDAのEQE比は、RTの場合と比較して5Kで増加しました。
結論
さまざまな温度でのAlGaNDUVLEDのEL特性に対するQW幅の影響を調べました。 ELスペクトルは、QW幅が増加するにつれて赤方偏移を示しました。 QW幅が3.5nmのLEDの最大EQEは、RTで2nmと5nmのそれぞれの約6.8倍と4.8倍でした。ただし、これらの値は5Kでそれぞれ8.2と1.6に変更されました。最大EQE比のさまざまな変化は、非放射再結合の減少とアクティブ領域のボリュームの増加に起因していました。理論的分析から、2 nmウェルのLEDは、量子閉じ込め効果により電子オーバーフローのバリアが最も浅いのに対し、5 nmウェルのLEDは、内部電界が大きいため、電子と正孔のオーバーラップが最小でした。したがって、3.5 nm QWのLEDは、最大のEQEが最も高くなりました。温度が下がると、すべてのLEDで最大EQEの電流が減少しました。これは、QWからオーバーフローした電子の増加と正孔濃度の減少によるものと考えられます。 QW幅が3.5nmのLEDの最大EQEは、5Kで2nmと5nmのそれぞれの約8.2倍と1.6倍でした。これは、非放射再結合中心の減少と体積の増加によるものと考えられています。活性領域の。
略語
- DUV LED:
-
深紫外線発光ダイオード
- EL:
-
エレクトロルミネッセンス
- EQE:
-
外部量子効率
- MQW:
-
多重量子井戸
- PL:
-
フォトルミネッセンス
- QCSE:
-
量子閉じ込めシュタルク効果
- QW:
-
量子井戸
- RT:
-
室温
ナノマテリアル
- 銀の抗菌特性
- 2020年のディープテック:パラダイムはどのように異なりますか?
- 4H-SiCPiNダイオードの特性に及ぼす紫外線照射の影響
- 水素センサーの特性に及ぼすPd / SnO2ナノ材料形成の条件の影響
- 微結晶およびナノセルロースの構造と誘電特性に及ぼす水の影響
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- 高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
- ペロブスカイト太陽電池の光起電力特性に及ぼすさまざまなCH3NH3PbI3形態の影響
- ペロブスカイト太陽電池の変換効率に及ぼすTiO2コンパクト層に埋め込まれた異なるサイズと濃度のAgナノ粒子の影響
- LSPカップリングの波長と強度に対する基板の影響
- 銅の抗菌特性



