インメモリアプリケーションを計算するための低動作電圧の原子層堆積HfAlOxベースのRRAM
要約
ムーアの法則が物理的な限界に近づいているため、従来のフォンノイマンアーキテクチャは課題に直面しています。コンピューティングインメモリアーキテクチャベースの抵抗変化型メモリ(RRAM)は、従来のコンピュータのフォンノイマンボトルネック問題を克服するための潜在的な候補になると予想されます[Backus、J、プログラミングをフォンノイマンスタイルから解放できますか?、 1977]。この作業では、CMOS技術と互換性のあるHfAlOxベースのRRAMを、原子層堆積(ALD)プロセスによって製造しました。金属AgとTaNが上部電極(TE)として選択されています。実験によると、Ag / HfAlOx / Ptデバイスは、低い設定電圧(0.33〜0.6 V)により、低消費電力と良好な均一性を意味するため、メモリ計算デバイスとしての利点が実証されています。 Ag / HfAlOx / Pt構造に基づいて、IMPロジックは100 nsの高周波低電圧パルス(0.3Vおよび0.6V)を適用することにより高速で実装されました。 IMP実装の2つのステップの後、NANDも取得できます。
背景
ストレージとコンピューティングの境界について、研究者は一連の研究プログラムを提案しました:高帯域幅メモリ、ニアメモリコンピューティング、およびニューラル圧縮ネットワーク。これらの方法では、メモリにアクセスする時間を短縮できますが、この問題を根本的に解決することはできませんでした。この問題を根本的に解決するために、インメモリコンピューティングの概念が世界中で注目を集めています。抵抗変化型メモリ(RRAM)デバイスは、メモリ内コンピューティングの機能により、非フォンノイマンコンピューティングデバイスの競争力のある候補として広く注目されていることは注目に値します[1,2,3,4,5、 6]。コンピューティングインメモリデバイスは、同じ回路内でコンピューティングユニットとストレージユニットの両方として機能します[7]。それは1971年にチュアによって最初に提案されました[8]。ほぼ40年後、RRAMベースの論理演算が2010年に最初に提案されました[9]。それ以来、RRAMベースのコンピューティングインメモリデバイスが広く研究され、多くの実装方法が提案されてきました[10、11、12、13、14]。しかし、コンピューティングインメモリデバイスとして、最も重要な機能は安定性と低エネルギー消費です。この分野には、調査する必要のある多くの問題がまだあります。この手紙では、2種類のRRAMデバイスが構築され、電気的特性がテストされました。論理演算を実装するプロセスでは、安定したセット電圧とリセット電圧、およびデバイス間の良好な均一性が非常に重要な指標です。
これまでのところ、さまざまな材料がRRAMの動作を示していますが、CMOSプロセスと互換性のあるものはほとんどありません。二元high-k酸化物HfAlOx膜は、原子層堆積(ALD)を使用して堆積されました。 ALDは、表面飽和飽水状態に基づいており、正確な前駆体のドーズ量が必要ないため、さまざまなデバイスやアプリケーションの酸化膜や上層の堆積に最適です[15]。 HfAlOxは、従来のCMOSプロセスとの互換性が高く、インメモリコンピューティングデバイスの誘電体層として使用できます。 Ag / HfAlOx / Pt RRAMデバイスは、ステートフルロジック操作を実装するために使用されました。 IMPロジックは、1910年にWhiteheadとRussellによって4つの基本的なロジック操作(OR、AND、NOT、およびIMP)の1つと見なされていました[16]。さらに、NANDロジックはIMPロジックの2つのステップで取得できます。 NANDロジックはユニバーサルロジックとして知られています。これは、NANDロジックを介して任意のブールロジックを構築できることを意味します。このCMOS互換、高速、低動作電圧のインメモリコンピューティングデバイスは、将来の従来のフォンノイマン構造の問題を解決する効果的な方法を示しています。
メソッド
この作業では、Ag / HfAlOx / PtおよびTaN / HfAlOx / Ptデバイスがそれぞれ製造されました。回路図を図1aに示します。最初に、70 nmの薄膜Pt下部電極が、物理蒸着(PVD)によって洗浄されたSiO 2 に蒸着されました。 / Si基板。次に、テトラキスエチルメチルアミノハフニウム(TEMAH)、トリメチルアルミニウム(TMA)、およびH 2 に由来するALDを使用して、厚さ16nmのバイナリHigh-k酸化物HfAlOx膜を堆積しました。 240°CでのO前駆体。最後に、50 nmのAgまたはTaN上部電極膜をフォトリソグラフィーで作製し、PVDで作製しました。上部電極にバイアスをかけ、下部電極にアースを付けて、デバイスの直流測定を、AgilentB1500A半導体によって室温で実行しました。さらに、Agilent B1500A半導体デバイスパラメータアナライザと2つの半導体パルスジェネレータユニット(SPGU)を使用してロジック測定を実行しました。

a Ag / HfAlOx / PtおよびTaN / HfAlOx / Ptデバイスの概略図。 b 16 nm HfAlO
のXPSスペクトル結果と考察
メモリとプロセッサは、従来のフォンノイマンコンピュータアーキテクチャで分離されています[17]。メモリに保存され、コンピューティングユニットで計算されたデータの転送時間は、コンピュータのパフォーマンスを大幅に制限します。データをメモリ上で直接操作することにより、制限を打破することが可能です。インメモリコンピューティングの研究は、この限界を打ち破る可能性があります。
論理機能を実証するために、RRAMはAg / HfAlOx / PtおよびTaN / HfAlOx / Ptで準備されました。回路図を図1aに示します。 2つの小さなデバイスと1つの大きなデバイスが、最小のRRAMロジックIMPロジックユニットを形成します。複数のIMPセルを使用して、さまざまなロジックを実装できます。 ALDによって成長した16nm HfAlOx膜は、X線光電子分光法(XPS)によって特徴づけられました。図1bに示すように、完全なXPSスペクトルと、Hf4f、Al2p、C1s、およびO1sが表示されます。 XPSの結果から、ALDHfAlO膜が正常に得られたと結論付けることができます。図2aとbは、 I を示しています – V AgilentB1500A半導体デバイスパラメータアナライザで測定されたAg / HfAlOx / PtおよびTaN / HfAlOx / Ptのバイポーラスイッチング特性。掃引電圧は、-1.5〜1.5 V(Agの場合)および-3〜3 V(TaNの場合)に印加され、室温で読み取り電圧は0.1Vでした。 Ag / HfAlOx / Pt構造とTaN / HfAlOx / Pt構造の両方の抵抗比を図3aとbに示します。上部電極としてAgを使用するデバイスは、抵抗比が103になり、上部電極が60に達する可能性があるためTaNになります。AgとTaNの両方の上部電極は、優れたバイポーラスイッチング特性を示します。セットおよびリセット動作電圧の分布は、それぞれ図3cおよびdにヒストグラムとして示されています。 Ag / HfAlOx / Ptデバイスは、はるかに低いSET電圧を示します。 2つの構造のパフォーマンスが比較されます。 Ag / HfAlOx / PtデバイスのSETおよびRESET電圧範囲は0.33〜0.62 Vおよび-1.3〜-1.5 Vであり、TaN / HfAlOx / Ptデバイスは0.8〜1.8 Vおよび-1.3〜-2Vでした。比較の結果、上部電極としてAgを使用するデバイスは、安定性が高く、動作電圧が低いため、ロジックを実装するためのデバイスとしてより適していることがわかりました。
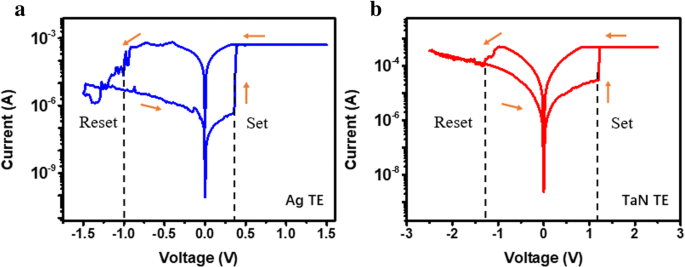
Ag / HfAlOx / Ptの典型的な電流-電圧特性( a )およびTaN / HfAlOx / Ptデバイス( b )

Ag / HfAlOx / Ptの耐久特性とセット/リセット分布( a 、 c )およびTaN / HfAlOx / Ptデバイス( b 、 d )100回の連続DCスイープサイクル未満
さらに、2種類の構造のスイッチングメカニズムについてさらに詳しく説明します。 I–V 曲線は図4a〜dで分析されています。曲線は対数座標で取得され、それぞれ低抵抗状態(LRS)状態と高抵抗状態(HRS)状態の現在の状態を分析します。図4aおよびbに示すように、Ag / HfAlOx / Ptデバイスの電流輸送は、電圧掃引中にオーム電流を示します。図4cおよびdに示すTaN / HfAlOx / Ptデバイスに順方向電圧を印加するか負電圧を印加するかにかかわらず、準オーム電流(勾配はほぼ1に等しい)がLRSに表示されますが、オーム、準オーム、空間電荷制限電流は、正の電界でHRSに表示されます。

a でのAg / HfAlOx / Ptデバイスの現在のフィッティング ポジティブで b c での負の電界とTaN / HfAlOx / Ptデバイスの電流フィッティング ポジティブで d 負の電界
この現象の理由は、TaN / HfAlOx / Ptデバイスの抵抗変化メカニズムが、酸素イオンと酸素空孔誘電体層のなだれ発生と再結合によるものであるためです。 Ag / HfAlOx / Ptデバイスでは、金属Agの酸化還元反応のおかげで、導電性フィラメントの形成と破壊をはるかに低い電界で駆動できます。
この実験では、低抵抗状態(LRS)をロジック1として定義し、高抵抗状態(HRS)をロジック0として定義しました。IMPロジックのテスト図を図5aに示します。これは、2つのRRAMデバイスPとQ、および1つの固定負荷抵抗によって実装されます。 PとQの状態は、それぞれpとqで表されます。 IMPは、VaとVbの2つの同時電圧パルスによって実行されます(Vaがロジック0から1をプログラムでき、Va − Vbがロジックをプログラムできないように、Va> Vset> VbとVa– Vb
IMPのテスト図( a )およびNAND( d )ロジック。 b 演算q←pIMPq( c )の真理値表 )およびq←pNANDq( e )。パルス( c )によるPとQの状態変化 )
s ′←pIMPs(1)。
s ′′←qIMPs ′(2)。
一連の操作がNANDと同等であることを示す真理値表を図5eに示します。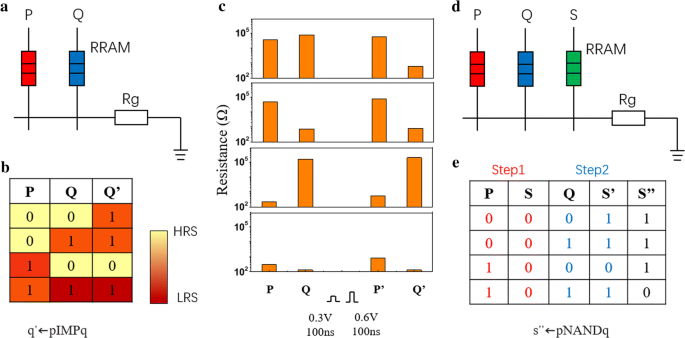
結論
要約すると、この研究では2種類のデバイス(Ag / HfAlOx / PtとTaN / HfAlOx / Pt)が製造されました。どちらのデバイスも優れたスイッチング特性を示します。 Ag / HfAlOx / Ptデバイスは、CMOS互換性、優れた均一性、低動作電圧、低消費電力など、コンピューティングインメモリデバイスとしての利点を実証しています。ロジックは、Ag / HfAlOx / PtRRAMデバイスを介して実装されました。低動作電圧コンピューティングのメモリ内デバイスの実現は、将来の従来のフォンノイマン構造の問題を解決するための効果的な方法を提供します。
略語
- ALD:
-
原子層堆積
- HRS:
-
高抵抗状態
- LRS:
-
低抵抗状態
ナノマテリアル
- Google CloudPlatformを使用したCIO向けのアプリケーションモダナイゼーションの再考
- フォグコンピューティングのベストセキュリティプラクティス
- ST:ITおよびIoTアプリケーション向けのすぐに使用できるソフトウェアを備えたセキュアエレメント評価キット
- インフィニオン:産業用アプリケーション向けの新しい電流センサーは、±25 A〜±120Aの範囲をカバーします
- ルネサス:産業用アプリケーション向けのEtherCATをサポートするRX72M MCU
- American Control Electronics:スナップオンプログラマブルボードオプション付きの低電圧DCドライブ
- 癌用途のための細胞ベースのドラッグデリバリー
- 純粋なCMOSロジックプロセスによる自己抑制抵抗スイッチング負荷を備えたRRAM統合4TSRAM
- 粗い表面の通常の荷重による接触面積の変化:原子スケールから巨視的スケールまで
- GEは、Hornetシリーズの新しい産業用アプリケーションのニーズに貢献しています
- AC 電流の最も一般的な用途は?



