温度依存性HfO2 / Si界面の構造進化とそのメカニズム
要約
この作業では、酸化ハフニウム(HfO 2 )薄膜は、250°Cでp型Si上にリモートプラズマ原子層堆積を行い、続いて窒素中で急速熱アニーリングすることにより、p型Si基板上に堆積されます。 HfO 2 の結晶化に及ぼすアニーリング後の温度の影響 映画とHfO 2 / Siインターフェースが調査されます。 HfO 2 の結晶化 映画とHfO 2 / Si界面は、電界放出透過型電子顕微鏡、X線光電子分光法、X線回折、および原子間力顕微鏡によって研究されています。実験結果は、アニーリング中に、酸素がHfO 2 から拡散することを示しています。 Siインターフェースへ。 400°C未満のアニーリング温度の場合、HfO 2 フィルムと界面層はアモルファスであり、後者はHfO 2 で構成されています および二酸化ケイ素(SiO 2 )。 450〜550°Cのアニーリング温度で、HfO 2 フィルムは多相多結晶になり、結晶性のSiO 2 インターフェイスにあります。最後に、550°Cを超えるアニーリング温度では、HfO 2 膜は単相多結晶によって支配され、界面層は完全に結晶性SiO 2 に変換されます 。
はじめに
酸化ハフニウム(HfO 2 )薄膜は、さまざまな用途にとって興味深い材料です。高密度、高屈折率などの優れた特性により、多層光学コーティング[1]、保護コーティング[2]、ゲート誘電体[3]、不動態化層[4,5,6]などに使用できます。屈折率、ワイドバンドギャップ、および比較的高い熱安定性。 HfO 2 の作成には、多くの方法が使用されています。 電子ビーム蒸着[7]、化学溶液蒸着[8]、反応性スパッタリング[9]、有機金属化学蒸着[10]、分子線エピタキシー[11]、原子層堆積(ALD)などの薄膜。 ALDは、高精度の厚さ制御と高精度の均一性の両方を備えた薄膜を得るための有望な方法です。ポストアニーリングは、ALD HfO 2 に大きな影響を与えることがわかっています。 映画[12、13、14、15]。調査によると、HfO 2 薄膜は、500°Cを超えるアニーリング温度で結晶化する可能性があります[16、17、18]。 HfO 2 の結晶構造 光学的および電気的特性に強く影響します。たとえば、HfO 2 の構造変化 アモルファスから単斜晶相への変化は、屈折率を1.7から2.09に、光学ギャップを5.75から6.13 eVに、誘電率を24.5から14.49に変化させる可能性があります[19、20]。 ALD HfO 2 の場合 シリコン基板上に堆積された酸化物層は、通常、HfO 2 で観察されます。 / Siインターフェース[21、22]。この界面層の存在は、誘電率を低下させると報告されています[22]。さらに、Kopani etal。 [23]は、5 nm HfO 2 の構造特性を示しました。 nドープSi基板の硝酸酸化後の膜。彼らは、高いアニーリング温度が結晶核の成長速度を増加させることを発見しました。ただし、それらの結晶化特性、特にHfO 2 /基板インターフェースはほとんど研究されていません。したがって、HfO 2 の結晶化特性に影響を与えるアニーリング温度 ALDによって作成された薄膜は、さらに調査する価値がありました。
この作品では、HfO 2 薄膜は、p型シリコン基板上にリモートプラズマ原子層堆積(RP-ALD)によって製造されました。ポストアニーリングは、さまざまな温度でのラピッドサーマルアニーリング(RTA)システムによって実行されました。 HfO 2 の構造変化と結晶化特性 RTAによる薄膜は、原子間力顕微鏡(AFM)、かすめ入射X線回折(GIXRD)、X線光電子分光法(XPS)、および高分解能透過型電子顕微鏡(HR-TEM)によって特徴づけられました。温度依存のHfO 2 / Si界面の構造進化とそのメカニズムも調べられます。
メソッド
抵抗率30Ωcmの両面研磨(100)配向p型2インチ250μmチョクラルスキーSiウェーハを使用しました。堆積の前に、Siウェーハを標準のRadio Corporation of Americaの方法で洗浄した後、希釈したフッ化水素酸溶液(5%)に2分間浸して、最後の水でリンスせずに浮遊酸化物を除去しました。洗浄後、すべてのウェーハを純窒素(N 2 )で乾燥させました。 )ガスと基板ホルダーに取り付けられています。約15nmHfO 2 (168 ALDサイクル)テトラキス(エチルメチルアミノ)ハフニウム(TEMAH)と酸素(O 2 )を使用して、RP-ALD(Picosun R-200、フィンランド)によってSiウェーハ上に薄膜を堆積させました。 )N 2 と交互パルスで パルス間の反応チャンバーのパージ。 TEMAHとO 2 プラズマは、次の順序でリアクターにパルスされました。TEMAHパルス1.6秒。 N 2 10秒パージします。 O 2 プラズマパルス10s、およびN 2 12秒パージします。 HfO 2 をデポジットした後 薄膜の場合、ラピッドサーマルアニーリングはN 2 で実行されました。 周囲温度10分。 HfO 2 の結晶化への影響を調べるために、アニーリング温度を400〜600°Cに変更しました。 薄膜とHfO 2 / Siインターフェース。表1に、RPALDとポストアニーリングの一般的な条件を示します。
<図>HfO 2 の表面形態を調査するために、タッピングモードでAFM測定を実行しました。 薄膜。この作品で示されているAFM画像は、256ポイント×256ラインの解像度で2μm×2μmスキャンです。 HfO 2 の構造 フィルムは、Cu長細焦点X線管を用いた斜入射X線回折(GIXRD、Rigaku TTRAXIII、日本)測定によって特徴づけられました。波長0.154nmのX線は、50kVの動作電圧と300mAの電流で生成されました。 2 θにわたる回折パターンを得るために、0.5°の入射角が選択されました。 20〜60°の範囲。 X線光電子分光法(XPS、Thermo Fisher K-alpha)も、単色AlKαX線放射(hν=1486.6 eV)を使用して実行されました。 XPS分析では、直径100μmのスポットを使用し、45°の離陸角度で光電子を収集しました。 HfO 2 の断面 薄膜は、日立NX2OOOシステムの集束イオンビームリフトアウト技術によって準備されました。 HfO 2 の断面画像 薄膜は、電界放出型高分解能透過型電子顕微鏡(HR-TEM、JEM-2100F、米国)によって検査されました。
結果と考察
図1は、HfO 2 のAFM画像を示しています。 異なる温度でアニールされたフィルム。表面粗さを示すために、二乗平均平方根(RMS)と平均表面粗さ(Ra)の値が示されています。堆積したままの膜のRMS値は0.44nmです。アニーリング温度が500°Cに上昇すると、わずかに0.47nmに増加します。アニーリング温度をさらに600°Cに上げると、表面粗さが大幅に向上し、RMSが0.69nmに増加します。 Ra値でも同じ傾向が見られます。アニーリングされたフィルムの表面粗さの増加は、構造変化を推測する可能性があります。
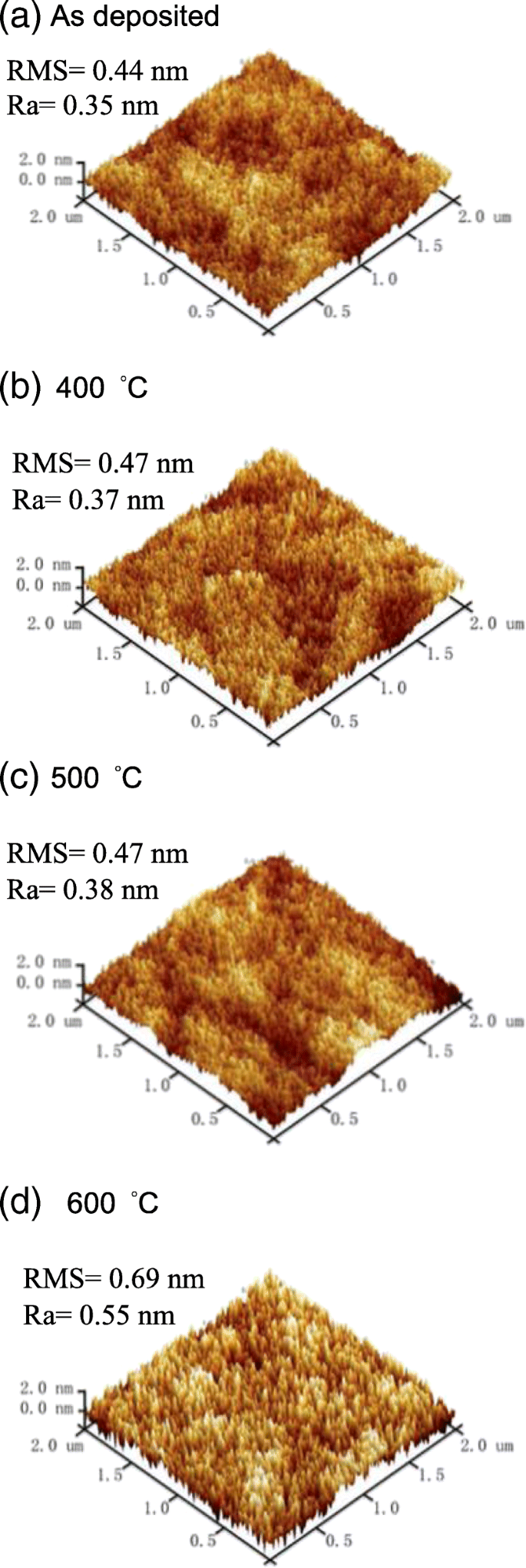
a のAFM画像 預け入れたまま、 b 400°C-アニーリング、 c 500°C-アニーリング、および d 600°CでアニーリングされたHfO 2 映画
図2は、さまざまなHfO 2 の温度依存GIXRDスペクトルを示しています。 薄膜。デポジットされたままのHfO 2 フィルムはアモルファスであり、400および450°Cでアニーリングした後もアモルファスのままです。 500°Cを超えるアニーリング温度では、回折ピークが現れ、結晶性HfO 2 の形成を示します。 。 1 / d =0.319および0.354Å -1 のピーク 単斜晶相(ICDD PDF#34-0104、空間群P21 / c)の-111面と111面にそれぞれ対応します。 1 / d =0.340Å -1 のピーク 斜方晶相の(111)面に対応します(ICDD PDF#21-0904、空間群Pbcm)。 1 / d =0.380〜0.395付近の他のピークは、単斜晶系の200、020、および002面と、斜方晶相の020面です。結果はまた、単斜晶相が減少し、斜方晶相がアニーリング温度とともに増加することを明らかにしている。斜方晶系HfO 2 より高いアニーリング温度で結晶構造を支配します。ただし、斜方晶系HfO 2 の回折ピーク ICDD PDF#21-0904と比較して、より低い1 / d(より小さなd間隔)で観察されました。さらに、1 / d =0.340Å -1 のシフト より高い値に向かっていることは、d間隔がアニーリング温度とともに減少することを示します。
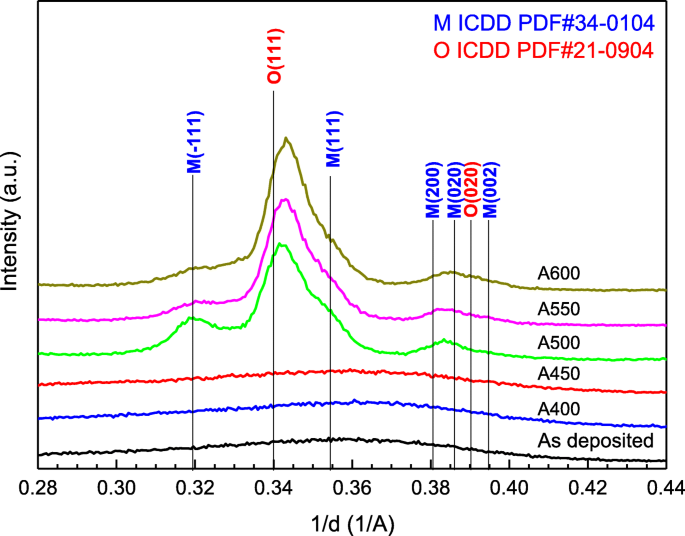
HfO 2 のGIXRDスペクトル さまざまな温度でアニールされた薄膜
HfO 2 内のHfとOの濃度 フィルムは、深度プロファイルされたXPSを使用して測定されました。図3は、堆積されたままの状態とアニールされた後のHfO 2 のO / Hf組成比を示しています。 映画。 O / Hf比は、アニーリング温度とともに1.60から1.29に減少します。 N 2 を使用しているため アニーリング中、HfO 2 温度とともに酸素不足になります。酸素欠乏HfO 2 前述のように、フィルムのd間隔も小さくなります。

HfO 2 の酸素とハフニウムの原子比 さまざまな温度でアニールされた薄膜
図4a、b、c、d、e、およびfは、堆積したままの400°C-、450°C-、500°C-、550°C-、および550°C-の高解像度断面HR-TEM画像を示しています。 600°CでアニールされたHfO 2 それぞれSi基板上の薄膜。 HfO 2 これらの画像では、層とSi基板がはっきりと示されています。さらに、HfO 2 の間に1〜2nmの厚さの薄層があります Si基板はSiO 2 である可能性があります 映画。図4aに示すように、堆積したままのHfO 2 には明らかな格子配列はありません。 フィルム、このフィルムがアモルファスであることを示します。 400°Cでアニーリングした後、HfO 2 のほとんどの領域が フィルムはまだアモルファスであり、このフィルムでは、d間隔の値が2.82および3.12Åの格子配列の一部が形成されていることがわかります。これらの2つのd間隔値は、単斜晶系HfO 2 にインデックス付けされます。 (111)および単斜晶HfO 2 それぞれ(− 111)面、および400°Cでアニールされた膜はナノ結晶構造を示しています。アニーリング温度を400°Cから600°Cに上げると、HfO 2 の結晶品質が向上します。 フィルムは徐々に強化されます。 HfO 2 の場合 フィルムは500〜550°Cでアニールされ、主な格子配列は単斜晶系HfO 2 で構成されます。 (− 111)、単斜晶系HfO 2 (200)、および斜方晶HfO 2 (111)を識別できます。ただし、アニーリング温度をさらに600°Cに上げると、斜方晶系HfO 2 の格子構造になります。 (111)はまだフィルムに存在し、他の2つの格子配列は徐々に消えます。一方、斜方晶系HfO 2 のd間隔値 (111)500°C-、550°C-および600°CでアニールされたHfO 2 の平面 フィルムは、それぞれ2.93、2.90、および2.88Åであると決定されます。これは、斜方晶系HfO 2 というXRDの結果とよく一致しています。 (111)回折ピークは、アニーリング温度を500から600°Cに上げると、高角度方向にシフトします。結果は、HfO 2 の酸素含有量が アニーリング温度が上昇するにつれて、フィルムは徐々に減少します。他の興味深い現象は、SiO 2 の結晶構造と厚さの変化に見られます。 層。堆積したままの状態では、SiO 2 層はアモルファスです。サンプルを400°Cでアニールしたとしても、熱エネルギーはSiO 2 の構造を変換するのに十分なほど高くありません。 アモルファスから結晶への層。それにもかかわらず、アニーリング温度を450℃から600℃に上げることにより、結晶性SiO 2 層(立方晶SiO 2 (220)構造)が形成され、その厚さは1.0から1.6nmに増加します。アモルファスSiO 2 層は完全に立方体のSiO 2 に変換されます 600°Cでサンプルをアニーリングした後の構造。アニーリング温度を550から600°Cに上げると、立方晶SiO 2 のd間隔値 (220)は2.48から2.56Åに増加します。これは、SiO 2 の酸素含有量を意味します 層はアニーリング温度を上げることによって増加します。 SiO 2 に酸素含有量が追加されていると合理的に推測できます。 層は、HfO 2 から供給される酸素原子の拡散に起因します 映画。さらに、全体の厚さは、550および600°Cのアニーリング温度で減少し、結晶化および水素除去によって引き起こされる膜密度の増加に関連している可能性があります。
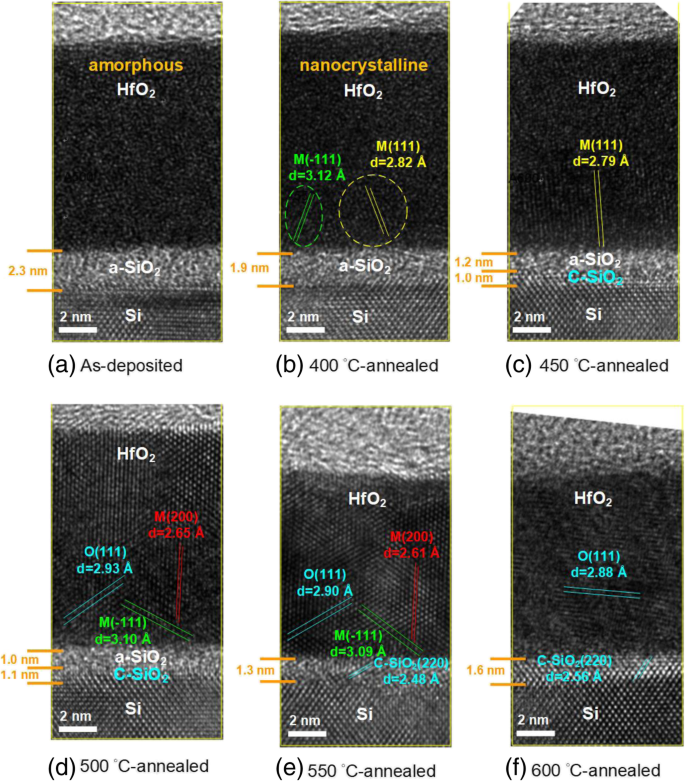
a の断面TEM画像 預け入れたまま、 b 400°C-アニーリング、 c 450°C-焼きなまし、 d 500°C-焼きなまし、 e 550°C-アニーリング、および f 600°CでアニーリングされたHfO 2 / Si
上記の結果に基づいて、図5はHfO 2 のメカニズムを示しています。 異なるアニーリング温度のフィルム。アニーリング温度が400°C未満であることを考慮すると(図5a)、膜はアモルファスであり、Hf原子とO原子がランダムに配置されています。 HfO 2 間の界面層 c-Siウェーハは、a-SiO 2 からなる混合酸化物です。 およびa-HfO 2 。 450〜550°Cのアニーリング温度(図5b)で、HfO 2 フィルムは熱エネルギーを受け取り、単斜晶相と斜方晶相を伴うアモルファスから多結晶への構造変化をもたらします。結晶配向とd間隔は、HR-TEMとGIXRDの結果に従って示されます。結晶性SiO 2 層が形成されます。いくつかの研究では、a-SiO 2 の界面に秩序だった酸化ケイ素層が報告されています。 (100)c-Siですが、メカニズムと原子スケールの構造については議論の余地があります。シリコンの熱酸化は、酸素原子のSi-Si結合への連続的な挿入操作と見なすことができ、これにより、酸化領域に圧縮ひずみが大量に蓄積され、SiO 2 <で秩序酸化物への構造変換が引き起こされる可能性があります。 / sub> / c-Siインターフェース[24]。結晶性酸素含有相は、Siの高酸素過飽和[25]または低界面欠陥密度[26]の条件下で形成される可能性があることも報告されています。この作品のXPSおよびTEM画像から、HfO 2 層は酸素が不足しています。かなりの量の酸素がHfO 2 から拡散します シリコン基板に向かって、これはc-Si界面での酸素の過飽和と結晶性SiO 2 の形成につながる可能性があります 。この温度範囲では、結晶性SiO 2 層の厚さは増加しますが、a-HfO 2 + a-SiO 2 混合層の厚さは、アニーリング温度の上昇とともに減少します。 550°Cを超えるアニーリング温度(図5c)では、HfO 2 構造は多結晶斜方晶(111)単相によって支配されます。界面層は完全に結晶性SiO 2 によって支配されています 。斜方晶系HfO 2 の場合、d間隔は減少します。 層とc-SiO 2 の増加 。 HfO 2 のアニーリングが 高温で高Siウェーハの不動態化と誘電率を達成するには、HfO 2 の結晶化が必要です。 および界面SiO 2 フィルムの特性を低下させる可能性があります。 500°Cのアニーリング温度は、17.2の最高の誘電率を得ることがわかります。アニーリング温度をさらに上げると、おそらく結晶相の変化が原因で、誘電率が低下します。富田ほかHfO 2 の誘電率が 構造が多結晶から単斜晶の単相に変化すると減少します[27]。 HfO 2 の最高のパッシベーション / Siは、500°Cのアニーリング温度でも取得できます。これは、温度が高くなると完全なc-SiO 2 が得られる可能性があるためです。 界面層と界面での脱水素化。
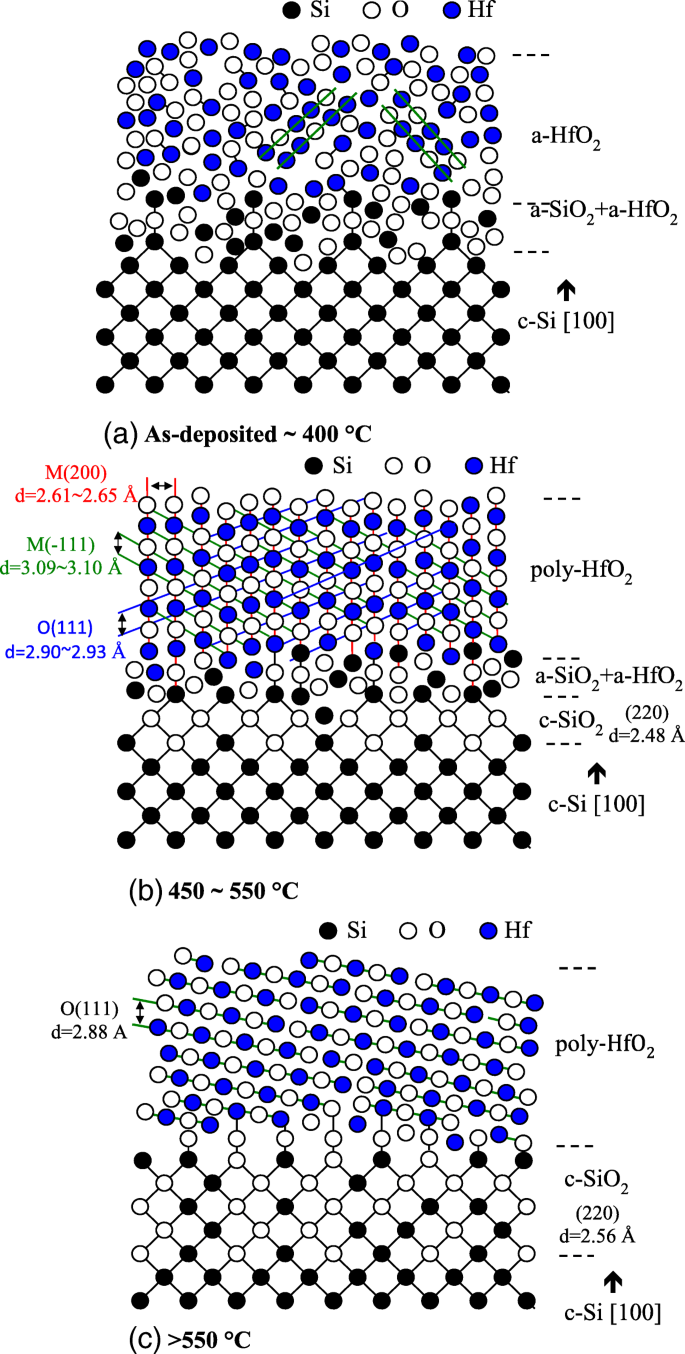
HfO 2 の結晶化のメカニズムの図 温度範囲 a のフィルムと界面層 400°Cまで堆積したまま、 b 450〜550°C、および c 550°Cを超える。 d間隔の値と結晶配向も示されています
結論
HfO 2 フィルムはRP-ALDを使用して作成され、アニーリング温度がHfO 2 の結晶構造に及ぼす影響 調査されました。デポジットされたままのHfO 2 そしてそれは400°C以下でアニールされ、HfO 2 界面層はアモルファスです。アニーリング温度を上げると、斜方晶のd間隔は減少しますが、c-SiO 2 のd間隔は減少します。 界面層が増加し、HfO 2 からの酸素拡散を示します Siインターフェースへ。 550°Cを超えるアニーリング温度は、HfO 2 を示します 多結晶斜方晶単相の層であり、界面層は完全にc-SiO 2 に変化します。 。 HfO 2 にはアニーリングが必要ですが Siウェーハの高い不動態化や高い誘電率の達成などの多くのアプリケーションでは、結晶化は膜の特性に悪影響を与える可能性があります。 500°Cのアニーリング温度は、最高のSiウェーハパッシベーション品質と誘電率を実現できます。
略語
- AFM:
-
原子間力顕微鏡
- a-HfO 2 :
-
アモルファス酸化ハフニウム
- ALD:
-
原子層堆積
- a-SiO 2 :
-
アモルファス二酸化ケイ素
- c-SiO 2 :
-
結晶性二酸化ケイ素
- GIXRD:
-
かすめ入射X線回折
- HfO 2 :
-
酸化ハフニウム
- HR-TEM:
-
高分解能透過型電子顕微鏡
- N 2 :
-
窒素
- O 2 :
-
酸素
- RMS:
-
二乗平均平方根
- RP-ALD:
-
リモートプラズマ原子層堆積
- RTA:
-
ラピッドサーマルアニーリング
- TEMAH:
-
テトラキス(エチルメチルアミノ)ハフニウム
- XPS:
-
X線光電子分光法
ナノマテリアル
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- 界面層の設計によるZnO膜の表面形態と特性の調整
- パラジウム(II)イオンインプリント高分子ナノスフェアの調製と水溶液からのパラジウム(II)の除去
- 窒化処理を施したHfO2ベースのRRAMの伝導メカニズムと耐久性の向上
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- CA / TPUヘリカルナノファイバーの製造とそのメカニズム分析
- 組み合わせたストライプパターン化FeCoBSi膜の厚さに依存する磁気およびマイクロ波共鳴特性評価
- 低エネルギー照射に対するSi、Ge、およびSi / Ge超格子の放射応答の理論的シミュレーション
- Pr2CuO4ナノシートの制御された合成と選択的吸着特性:メカニズムの議論
- PEG-PCCLナノ粒子の毒性評価とパクリタキセル負荷の抗腫瘍効果に関する予備調査



