GaNテラヘルツ量子カスケードレーザーの性能に対する界面粗さ散乱の主な影響
要約
量子井戸の界面粗さ、意図的でないドーピング、および合金の無秩序が、GaNベースのテラヘルツ量子カスケードレーザー(QCL)の性能に及ぼす影響を、非平衡グリーン関数の形式化によって調査しました。光学的利得に対する合金の乱れの影響はごくわずかであり、意図的でないドーピングは、10 17 の妥当な濃度未満にとどまる必要があることがわかりました。 cm -3 電子不純物の散乱劣化と自由キャリア吸収を防ぐため。さらに重要なことに、界面粗さ散乱が光学利得劣化の支配的な要因であることがわかります。したがって、製造中の正確な制御が重要です。最後に、60 cm -1 のゲイン 300 Kで得ることができ、室温のGaNテラヘルツQCLを製造する可能性を示しています。
はじめに
テラヘルツ(THz)スペクトル領域は、品質とセキュリティの制御、医療診断、および電気通信での潜在的なアプリケーションのため、集中的な研究の対象となっています。しかし、その開発は、利用可能なコンパクトなデバイスの不足によって妨げられてきました。量子カスケードレーザー(QCL)は、強力なTHz固体光源を開発するための有望な候補です[1、2]。これまでのところ、最良のTHz QCLはGaAsに基づいており、GaAsのLOフォノンエネルギー(36 meV)が低いため、最大動作温度は約200 Kです[3、4]。磁場の助けを借りて、この温度を225 Kまで上げることができます。しかし、この方法は広範囲の用途には適していません[5、6]。温度が上昇すると、上位レベルの状態の電子は、下位レベルの状態に向かうLOフォノン放出を介して非放射緩和を活性化するのに十分な熱エネルギーを獲得できるため、反転分布が破壊されます。 GaAsと比較して、GaNははるかに高いLOフォノンエネルギー(92 meV)を持っているため、室温で動作するTHzQCLを生成する可能性があります[7,8,9]。さらに、GaAsベースのQCLは、光フォノンによる吸収のために材料が完全に不透明になるスペクトル領域であるReststrahlen帯域のため、4.6〜12THzの周波数範囲では動作できません。 GaNの光フォノンのエネルギーが大きいほど、1〜15THzのはるかに広いスペクトル範囲で動作できるTHz量子カスケードデバイスの可能性が広がります。
GaN THz QCLの最初のステップの研究は、遠赤外線ドメインへのサブバンド間(ISB)遷移の調整でした。 THz周波数でのISB吸収は、極性[10、11]および非極性窒化物ベースの量子井戸(QW)[12、13、14、15、16、17]で観察されています。 THzで動作するISBGaNベースの検出器は、それぞれ13 THz [18]および10THz [19]で実証されました。 QCL構造からの自発的エレクトロルミネッセンスに関する平山グループからのいくつかの物議を醸す報告を除いて、この範囲のエレクトロルミネッセンスの実証はこれまで達成されていません[20、21]。いくつかの理論的研究が発表されており[7、9、22、23、24、25、26]、その中には、電子とLOフォノン間の非常に強い相互作用によるゲインスペクトルの広がりなど、GaN THzQCL性能の制限要因を調査するものもあります。 GaN [23]。
この記事では、量子井戸の界面粗さ、意図的でないドーピング、合金の無秩序など、THz GaNQCLの光学的利得を損なう可能性のある他の要因を分析することによってこれらの研究を完了することを提案します。光学的利得に対する合金の乱れの影響はごくわずかであり、意図的でないドーピングは、10 17 の妥当な濃度未満にとどまる必要があることがわかりました。 cm -3 電子不純物の散乱劣化と自由キャリア吸収を防ぐために[27]。最後に、界面粗さ散乱が光学利得劣化の支配的な要因であることを発見しました。そして、60 cm -1 のゲイン 300 Kで得られます。これは、二重金属導波路の理論上の損失をはるかに上回り、室温のGaN THzQCLを製造する可能性を示しています。
メソッド
GaN THz QCLデバイスの製造には、転位密度の低い厚い活性領域を成長させる必要があることが知られています。 GaNとAlGaNの間の格子不整合のため、このタスクは困難です[28]。エピタキシーに起因する他の望ましくない要因も現れる可能性があります:成長条件に応じた界面粗さ(IFR)、成長中の不純物(主に酸素)の取り込みに起因するn型非意図的ドーピング(nid)、Ga表面に起因する合金障害(AD)偏析とAl吸着原子の移動度が低い。これらの現象がTHzGaN QCL性能にどのように影響するかを調査するために、非平衡グリーン関数(NEGF)の形式を使用します。計算は、NextnanoQCLソフトウェア[29,30,31]を使用して実行されます。このモデルには、界面粗さ、イオン化不純物、合金無秩序、LOフォノン、音響フォノン、または電子-電子相互作用によって引き起こされる緩和が含まれます。 THz QCL設計がこれまでで最高の動作温度を提供するため、共鳴フォノン過疎化スキームを備えた3量子井戸QCLを採用しました[3、32]。図1aは、設計されたアクティブ領域の構造を示しています。 1つのAlGaN量子構造/ AlGaN量子構造の層シーケンスは 1.6 です。 /6.2/ 1.6 /3.4/ 1.0 /3.4 nm、斜体はバリアの厚さを示します。図1bは、− 84.5 kV / cmのバイアスで設計されたQCL構造の伝導バンド図を示しています。右側の前の期間から、電子は、1でラベル付けされた上部レイジング状態の共鳴トンネリングによって注入されます。次に、電子は、下部レイジング状態2への放射遷移を受けます。この下部レイジング状態は、トンネリングによって状態3に過疎化されます。最後に、電子はLOフォノン放出によって状態4に緩和されます。このプロセスは期間ごとに繰り返されます。
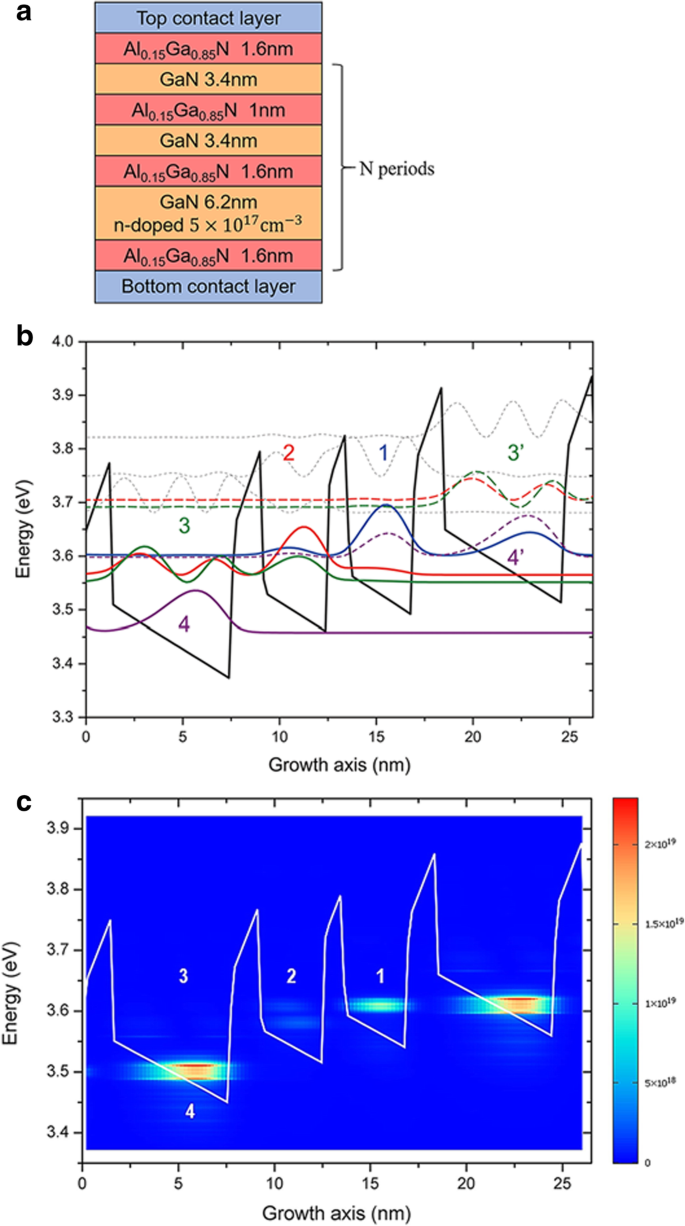
設計された活性領域構造、伝導帯プロファイル、二乗包絡関数、およびキャリア密度。 a 1期間のレイヤーシーケンスは 1.6 です。 /6.2/ 1.6 /3.4/ 1.0 /3.4nm。バリアはイタリック体で示されています。 6.2 nmの厚さのウェルには、 n がnドープされています。 =5×10 17 cm -3 。 b GaN / Al 0.15 の伝導帯プロファイルと二乗包絡線関数 Ga 0.85 NQCLはこの研究で検討されました。 − 84.5 kV / cmの電界が印加されます。 c NEGFモデルで計算されたQCLのキャリア密度と伝導帯。印加される電界は− 84.5 kV / cmです。温度は10Kに設定されています。
計算では、プラズマ支援分子線エピタキシー(PAMBE)を使用したGaN / AlGaN成長構造に通常見られるパラメーターを使用します。界面粗さは0.25nm [33]、相関長は1 nm、意図せずにn-キャリア濃度10 17 でのドーピング cm -3 。合金の無秩序散乱もシミュレーションに含まれています。
結果と考察
図1cは、− 84.5 kV / cmの動作バイアスで計算されたこの構造のキャリア密度を示しています。前の期間と上部レイジング状態1の間の交差防止を観察しました。また、下部レイジング状態2は、状態3と4の共鳴フォノンによって過疎化されていることがわかります。IFRの影響を分析および比較するために、nid、 ADについては、いくつかの構成(IFR、nid、およびADを考慮した参照構成、IFRなしの構成、nidなしの構成、およびADなしの最後の構成)のGaN THzQCL光ゲインおよび電流特性を計算しました。図2は、10 Kの温度で計算された各構成の最大光ゲイン対周波数(a)および電流密度対印加電界(b)を示しています。参照構造は、142 cm -1 8.7 THzでは、ヒ化物材料では到達できない周波数。 n.i.dがQCLのパフォーマンスにどのように影響するかを見てみましょう。 n.i.dがない場合、ピークゲインは127 cm -1 です。 8.46THzで。ゲインの低下は、n.i.d。から来る電子を取り除いた後、上部レイジング状態でキャリア濃度が低下するためです。実際、参照構成では、上部および下部のレイジング状態の電子濃度は ∆N です。 = N 1 – n 2 =5.43×10 12 cm −2 、n.i.dがない場合は、 ∆N になります = N 1 – n 2 =5.06×10 12 cm −2 。印加電界は-84.5から-81.6kV / cmにシフトします。現在のしきい値は25.11kA / cm 2 から低下し、シフトします。 − 84.49 kV / cmから17.11kA / cm 2 − 93.24 kV / cmで。電流密度の低下は、n.i.dなしの計算で電子輸送を増加させる電子不純物散乱の減少に起因する可能性があります。この仮説のもう1つのヒントは、n.i.d電流密度特性がない場合に見られる− 64 kV / cmのピークです。これは、4 ’と3の間の周期間共鳴トンネルです(ここには示されていません)。この現象は、n.i.d。を考慮した電流特性での電子不純物散乱によって隠されています。電流しきい値と印加電界シフトは、n.i.dの有無にかかわらず構成間の伝導帯の不整合に起因します。興味深いことに、n.i.dの場合はゲインのピークが大きくなりますが、ゲインスペクトルの広がりが観察され、荷電不純物の影響があります[31]意図しないドーピングは10 17 の妥当な濃度にとどまる必要があります。 cm -3 電子不純物の散乱劣化と自由キャリア吸収を防ぐため。 AD散乱のない構成では、ピークゲインは147 cm -1 です。 8.7THzで。ピークゲインは、AD散乱の有無にかかわらず同じ周波数であることがわかります。 AD散乱が計算に含まれていない場合、光学ゲインは3%のわずかな増加しか得られません。電流特性もほぼ同じです。私たちの設計では15%の低いアルミニウム含有量とかなり薄いバリア(1〜1.5 nm)を使用しているため、このQCLでのAD散乱の影響は無視できます。

さまざまな散乱プロセスのシミュレーションされた最大光ゲイン対周波数および電流-電界シミュレーション。 a 異なる散乱過程を考慮したシミュレートされた光利得対周波数。 b さまざまな散乱パラメータを考慮したGaNTHzQCLの電流-電界シミュレーション。温度は10Kに設定されています
それどころか、デバイスのパフォーマンスにおけるIFR散乱の影響は重要です。 IFR散乱がない場合、191 cm -1 のピークゲインが観測されます。 8.7THzで。電流密度のしきい値は24.08kA / cm 2 。このゲインの34%の増加と電流密度のしきい値の低下は、多くの電子がIFR散乱を介して輸送されるという事実を反映しています。 IFR散乱が多いほど、レイジングの放射散乱は少なくなります。上部と下部のレイジング状態の参照構成の電子集団を比較する場合ΔN = N 1 – n 2 =6.6×10 12 –1.27×10 12 =5.43×10 12 cm −2 IFRのないものに ∆N = N 1 – n 2 =7.4×10 12 –1.17×10 12 =6.23×10 12 cm −2 、上位状態の電子集団がより高いことがわかります。これは、IFR散乱がないために増加する上部レイジング状態の寿命によるものです。 nidがない場合と比較して、IFR散乱がないデバイスの電流密度特性では、4 'と3の間の周期間共鳴トンネルの特徴である-67kV / cmにピークが見られます。この現象はより顕著です。 IFR散乱プロセスを考慮しない場合。これは、共鳴トンネルに対する優位性の証拠です。これらの観察結果を基に、THz GaNQCLの性能におけるIFR散乱の影響の優位性を強調します。
THz性能におけるIFR散乱の重要性に気づいた後。 IFRサイズを変えてさらに調査しました。 IFR =0.5nmと0.75nmのケースを調査に追加しました。相関長は1nmに保たれます。図3に、最大ゲインと周波数(a)、および電流密度と印加電界特性(b)を示しました。まず、IFR =0.5 nmの場合、最大光学ゲインが47.9 cm -1 に減少することを確認しました。 そして劇的に-8.8cm -1 に低下します IFR =0.75nmの光ゲインを失います。 IFRの長さの関数としてのゲインの広がりも明らかです。 I-V特性からわかるように、IFRサイズが大きくなると、電子散乱におけるその役割が大きくなり、電流密度が高くなり、デバイスの共鳴トンネルと放射散乱プロセスが減少します。この効果は、IFR =0.25nmの参照構成をIFR =0.75 nmの極端な場合と比較すると明らかになり、上下のレイジング状態の電子集団は ∆N から低下します。 =5.43×10 12 cm −2 ∆N へ = N 1 – n 2 =3.71×10 12 cm −2 。
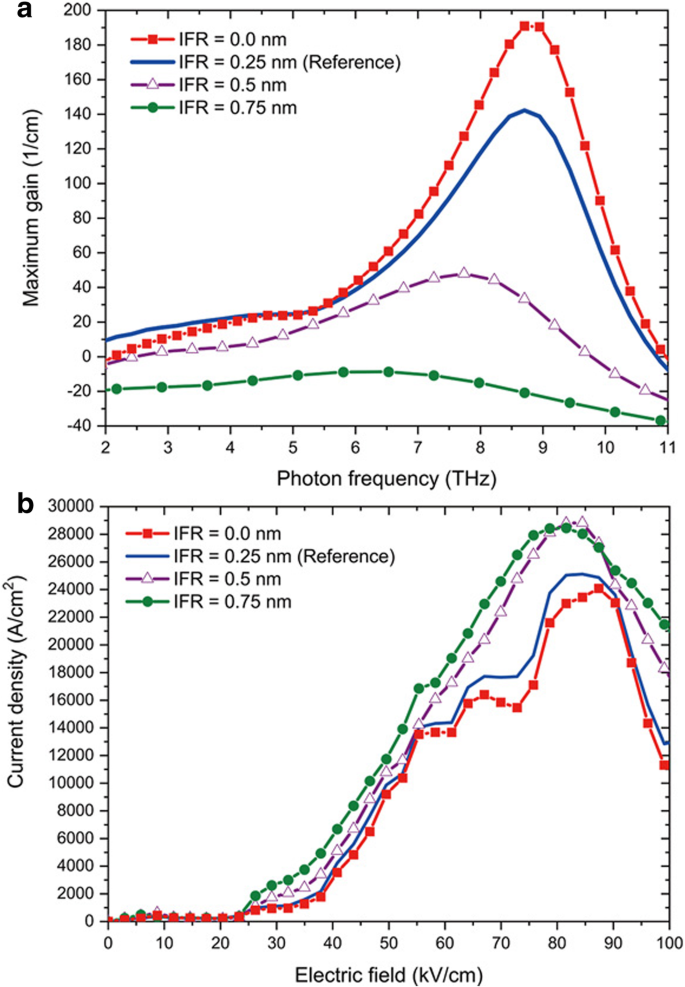
さまざまなIFRのシミュレーションされた最大光利得対周波数および電流-電界シミュレーション。 a さまざまなIFRのシミュレートされた最大光ゲインと周波数。 b さまざまなIFRを考慮したGaNTHzQCLの電流-電界シミュレーション。温度は10Kに設定されています
後者は、デバイスでのレーザー発振が見られなくなるまで減少します。 GaAsベースのTHzQCLを使用した以前の研究ですでに指摘されているように[25、34、35、36]、エピタキシー中にIFRサイズを考慮し、GaN THzQCLを製造するために0.5nm未満に保つことの重要性を強調します。正の光利得を提供します。
GaN THz QCLの利点は、GaAsベースのTHzQCLよりも高い温度で動作する可能性があることです。このパートでは、動作温度の関数としてデバイスのパフォーマンスを分析しました。 IFR =0.25 nm、n.i.d、およびADが計算に含まれているリファレンスデバイスを引き続き使用しました。図4は、さまざまな格子温度での最大光学ゲインを示しています。ゲイン値は、約142 cm -1 で10〜150Kで安定しています。 、それは150から250 Kの間で減少し始め、61 cm -1 に低下します。 実際、温度が上昇すると、熱による埋め戻しにより反転分布が減少し、LO-フォノン散乱の増加によりゲインが広がります。この61cm -1 の光学ゲイン値 GaN THz QCLダブルメタル導波路の損失よりもまだ高い(30 cm -1 )、このGaN THzQCL設計は室温で動作できるはずであることを示しています。また、室温で動作できることに加えて、GaNベースのTHz QCLには別の利点があります。ドーピング濃度が高く、屈折率が低く、周期長が短いため、よりもはるかに高い光学利得を提供できる可能性があります。それらのGaAs対応物。私たちの設計は、142 cm -1 というかなり高い光学ゲイン値を提供します。 10Kで。これは良い例です。
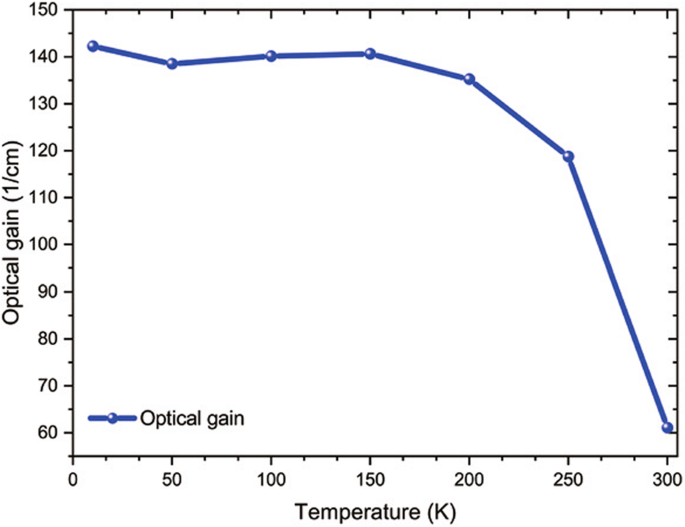
計算された最大ゲインと格子温度の特性
結論
結論として、8.7THzで動作するGaNTHzQCL設計を報告します。シミュレーションでは、142 cm -1 の光学ゲインが示されています。 10Kおよび60cm -1 で 室温で。エピタキシーに起因する望ましくない現象の中で、GaN THz QCLゲインの性能における界面粗さ、意図的でないドーピング、および合金の乱れの影響を計算しました。合金の乱れの影響は無視できます。光学利得は147から142cm -1 にしか低下しません。 シミュレーションで合金無秩序散乱を追加する場合。伝導帯のミスアライメントを防ぐために、設計では意図的でないドーピングを考慮に入れる必要があります。私たちの研究では、n.i.dによって誘発された-84.5から-81.6 kV / cmへの印加電界シフトを観察しました。最後に、さまざまな界面粗さ値(191、142、47.9、および− 8.8 cm -1 )で光学ゲインに大きな差異が見られました。 界面粗さがそれぞれ0、0.25、0.5、0.75nmの場合。そのため、光学利得の低下における界面粗さ散乱の支配的な影響を特定します。この作業は、最終的に将来のGaN THzQCL製造のパフォーマンスを最適化するためのルートを提供します。
データと資料の可用性
現在の研究中に生成および/または分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- AD:
-
合金障害
- IFR:
-
界面粗さ
- ISB:
-
サブバンド間
- n.i.d:
-
意図的でないドーピング
- NEGF:
-
非平衡グリーン関数
- QCL:
-
量子カスケードレーザー
ナノマテリアル
- ステンレス鋼の性能に及ぼすモリブデンの影響
- テラヘルツバンド入門
- ガラス繊維の性能
- 微結晶およびナノセルロースの構造と誘電特性に及ぼす水の影響
- 低消費電力基板発光DFB量子カスケードレーザー
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- ナノワイヤ/量子ドットハイブリッドナノ構造アレイ太陽電池の光起電力性能
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解
- タルボットキャビティと統合されたテーパー量子カスケードレーザーアレイ
- LSPカップリングの波長と強度に対する基板の影響



