グラフェン/ TiO2 / Si三層ヘテロ接合に基づく高性能全光テラヘルツ変調器
要約
この論文では、p型シリコン(p-Si)基板であるTiO 2 を組み合わせて作られた3層ハイブリッドテラヘルツ(THz)変調器を示します。 中間層、および単層グラフェン。 SiとTiO 2 間のインターフェース ビルトイン電場を導入し、光電子をSiからTiO 2 に駆動しました。 、次に電子がグラフェン層に注入され、グラフェンのフェルミ準位がより高い伝導帯にシフトします。グラフェンの導電率が増加し、透過テラヘルツ波が減少します。そしてテラヘルツ伝送変調を実現しました。適切な光励起により、0.3〜1.7 THzの周波数範囲と88%の大きな変調深度でテラヘルツ伝送の広帯域変調が観測されました。結果は、グラフェン/ TiO 2 / p-Siハイブリッドナノ構造は、テラヘルツイメージングや通信などのテラヘルツブロードバンドアプリケーションに大きな可能性を示します。
はじめに
テラヘルツ(THz)イメージング技術[1]とテラヘルツ通信技術[2、3]は、THzの分野における2つの主要な研究の方向性です。また、THz変調器は技術の基本コンポーネントであり、信号(光、電気、熱など)を変調することでTHz波の透過率と反射率を変調できます[4]。テラヘルツ変調器については、主に材料に焦点を当てて多くの研究が行われています[5、6]。テラヘルツ変調器には、SiやGeなどの半導体材料が使用されています。しかし、変調性能は理想的ではなく、変調深度は高くないため、多くの新しい材料が提案されています[7、8、9]。代表的な新素材はメタマテリアルです。メタマテリアルと半導体を組み合わせることで、高速テラヘルツ変調器を実現できます。ただし、メタマテリアルに基づく変調器の帯域幅は、構造が固定されているため依然として非常に狭く、製造プロセスは複雑です[10、11]。別の典型的な材料は、VO 2 などの相変化材料です。 。特定の温度または電圧で、VO 2 絶縁状態と金属状態の間で可逆的な相変化を起こす可能性があり、それに応じて電磁特性が変化します。金属状態はテラヘルツ波の減衰を引き起こす可能性があります。しかし、テラヘルツ波はVO 2 の絶縁状態に容易に浸透する可能性があります。 。したがって、外部励起を適用してVO 2 の位相変化を行うことにより、THz伝送を変調できます。 。しかし、そのような変調器[12、13、14、15]は温度の変化に基づいており、温度降下が遅いため、変調速度は遅くなります。
近年、グラフェンは、その優れた電子的、光学的、および機械的特性により、THz技術に徐々に適用されています[16、17、18、19]。 Lee etal。グラフェンをメタマテリアルと統合することにより、電気的に制御されたTHz変調器を製造しました[20]。グラフェンの電気的および光学的特性が金属原子の強い共鳴によって強化されると、光と物質の相互作用が強化され、透過テラヘルツ波の振幅変調が47%、位相変調が32.2%になります。 2012年、Sensale etal。ゲート電圧がグラフェンのキャリア濃度を調整しながら、グラフェンベースの電界効果トランジスタ(GFET)THz波変調器を準備しました[21]。ただし、この種の変調器[22、23、24]の変調深度は、キャリア注入が制限されているため浅いものでした。グラフェン/ n-SiTHz変調器はWeisらによって作成されました。 808 nmのフェムト秒パルスレーザーの励起下で最大99%の変調深度を持ちます[25]。その後、Liらによって製造されたグラフェン/ n-SiTHz変調器。電気的および光学的励起を同時に行うことで、83%の変調深度を達成しました。しかし、電界をかけない場合は、光だけを加えるため、変調効果はあまり良くありませんでした[26]。低コストで毒性がなく、化学的に安定した半導体材料として、二酸化チタン(TiO 2 )エネルギーや環境の分野で大きな注目を集めています。環境汚染物質の光触媒分解に使用されるだけでなく、太陽電池にも広く使用されています。最近、タオ等。準備されたMoS 2 TiO 2 上のフィルム 表面[27]。界面は強力なビルトイン電場を導入し、電子正孔対の分離を強化し、その光触媒特性の向上につながりました。 2017年、Cao etal。高性能ペロブスカイト/ TiO 2 を作りました / Si光検出器[28]。彼らは、性能の向上は、TiO 2 の挿入による、Siとペロブスカイト間の界面での光励起キャリアの分離の増加と再結合の減少に起因すると考えました。 映画。ここでは、グラフェン/ TiO 2 / p-Siナノ構造の全光THz変調器が製造されました。私たちが設計したデバイスは、0.3〜1.7 THzの周波数範囲で最大88%の大きな変調深度を備えています。
メソッド
厚さ500μmのSi(p型、抵抗率ρ 〜1–10Ωcm)基板をアセトン、エタノール、脱イオン水で超音波浴中で20分間順次洗浄した後、4.6 M HF溶液に10分間浸漬して、表面の自然酸化物層を除去しました。次に、洗浄したSiを0.1 MTiCl 4 に浸しました。 343 Kで1時間水溶液を使用して、厚さ10nmのTiO 2 映画。単層グラフェンは、化学蒸着によって銅上に成長しました[29]。次に、グラフェンをTiO 2 に転写しました。 グラフェン/ TiO 2 を形成するためのウェットエッチング法[30]を使用したフィルム / p-Siヘテロ構造。サンプル領域全体は1cm 2 です。 。グラフェンの品質は、ラマン分光法によって特徴づけられました。吸収スペクトルは、UV-可視分光光度計(島津製作所、UV-3600)によって測定された。紫外光電子分光法(UPS)(Thermo Scientific、Escalab 250Xi)測定を実行して、エネルギーバンド構造を取得しました。静的変調は、Fico THz時間領域システム(Zomega Terahertz Corporation)によって評価されました。
結果と考察
全光学グラフェン/ TiO 2 の構造 / p-Si THz変調器は、図1aに概略的に示されています。テラヘルツ波とレーザーはグラフェン側から同時に入射しました。変調信号として、波長808 nm、スポット径〜5 mm、出力0〜1400mWの半導体レーザーを照射しました。 THzビーム(〜3 mm)はレーザービームと重なる可能性があります。また、送信されたTHz波は、さまざまなレーザー出力でTHz-TDSシステムによって測定されました。グラフェン変調器の性能はグラフェンの品質に関連しているため、SiおよびTiO 2 上に転写されたグラフェンの品質を評価しました。 図1bに示すように、514nmの波長のレーザーを使用したラマン分光法による/ p-Si基板。 p-Si上のグラフェンのGピークと2Dピークが〜1580 cm -1 にあることは明らかです。 および2681cm -1 、 それぞれ。 TiO 2 上のグラフェンの場合 / p-Si、Gピークは〜1575 cm -1 に位置します 2Dピークは〜2667 cm -1 に配置されます 。シリコン上のグラフェンのラマンスペクトルと比較して、TiO 2 上のグラフェンのGおよび2Dピーク / p-TiO 2 の挿入によってグラフェンに応力がかかるため、Siが左にシフトします。 。さらに、DピークはSi上のグラフェンとTiO 2 の両方で弱いです。 / p-Si。 2Dピークは単一のローレンツに適合し、両方のGピークの高さの2倍以上です。ラマン結果は、SiおよびTiO 2 上に移動したグラフェンを示しています。 / p-Siは高品質の単層グラフェンです[31]。
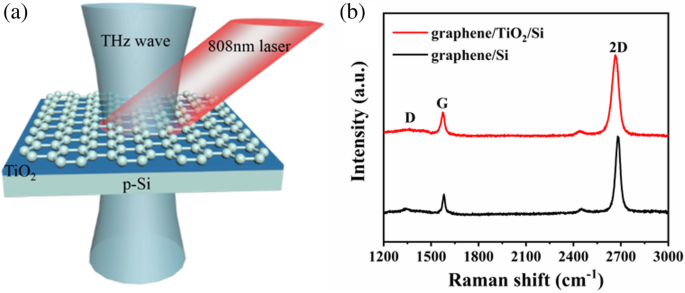
グラフェンの実験計画とラマンスペクトル。 a 全光THz変調器の概略図。変調器は、TiO 2 を備えたp-Si基板上の単層グラフェンで構成されています。 映画。 b SiおよびTiO 2 上のグラフェンのラマンスペクトル / p-Si基板
図2a–cは、Si、グラフェン/ Si、およびグラフェン/ TiO 2 のテラヘルツ波透過率を示しています。 それぞれ異なるレーザー出力での/ Si。これはFicoTHz時間領域システムによって測定されます。光励起なし、Si、グラフェン/ Si、およびグラフェン/ TiO 2 / p-Siは、Siがpドープされているため、キャリアからの部分的な吸収と反射により、THz波の約55%の中程度の透過率を示します。そして、光励起なしの透過率は、それらすべてに顕著な違いはなく、TiO 2 を示しています。 グラフェンは、光励起がない場合、THz波を減衰させません。したがって、TiO 2 によって追加の挿入損失が発生することはありません。 とグラフェン。 808nmレーザーの出力が0から1400mWに増加すると、透過率はSi、グラフェン/ p-Si、およびグラフェン/ TiO 2 で0.3THzから1.7THzの範囲で減少します。 / p-Si。 Siのバンドギャップより大きいエネルギーでレーザーを照射すると、電子は価電子帯から伝導帯に励起されます。励起された電子正孔対が表面に形成され、導電率が増加します。また、半導体のTHz吸光度と反射率は、導電率の変化に依存します。したがって、THz波がレーザーを照射したSiを透過すると、透過するTHz波の強度が低下します。さらに、808 nmのレーザー照射下でSiによって生成される電子正孔対の数は、レーザー出力が増加するにつれて増加します。そして、Siの導電率の増加は、送信されたTHz波の減衰をもたらします。図2bでは、グラフェン/ Siの透過率は、シリコンよりもレーザー出力の増加に伴って大幅に減少しています。レーザーをグラフェン/ Siに照射すると、Siの光吸収はグラフェンよりもはるかに高くなるため、Siで生成されるキャリアの数はグラフェンよりもはるかに多くなります。遊離キャリアは、濃度勾配の作用下でシリコンからグラフェンに拡散します。グラフェンはキャリア移動度が高いため、Siよりも導電率の変化が大きくなります。 THzの吸光度と反射率は導電率の変化に依存しますが、グラフェン/ p-Siの変調性能はSiに比べて向上しています。図2cに示すように、グラフェン/ TiO 2 の透過率の低下 / p-Siは、200mWおよび400mWのレーザー出力で急激に変化します。レーザー出力が増加し続けると、透過率の低下は穏やかになります。適用されるレーザー出力は1400mWですが、THz透過率は0.3THzから1.7THzの範囲で約10%に低下します。変調度は( T )で計算できます。 励起なし − t 興奮 )/ T 励起なし 、ここで T 励起なし および T 興奮 それぞれ、光励起なしと光励起ありのTHz透過の強度を表します。その静的変調性能をより直感的に明らかにするために、Si、グラフェン/ Si、およびグラフェン/ TiO 2 のレーザー出力の関数として変調深度をプロットしました。 / p-Si、図2dに示すように。グラフェン/ Siの変調度はSiの変調度よりも高く、グラフェン/ TiO 2 の変調度は / p-Siはグラフェン/ p-Siよりも高いです。それらすべての変調度は、レーザー出力の増加とともに増加します。 200 mWを照射した場合、グラフェン/ TiO 2 の変調度 / p-Siは〜33%で、Siの約6倍、グラフェン/ Siの2.5倍、グラフェン電界効果トランジスタに基づくTHz変調器よりも高くなっています[21]。グラフェン/ TiO 2 の変調度 / p-Siは、1400mWの出力の808nmレーザーでポンピングすると、88%に達する可能性があります。これは、電気的および光学的励起を同時に行うグラフェンベースの変調器よりも高くなります[26]。したがって、静的テストから、変調器は広帯域で大きな変調深度で高性能であるという結論を得ることができます。

変調テスト。 a の透過率スペクトル Si、 b グラフェン/ p-Si、および c グラフェン/ TiO 2 / p-異なるレーザー出力でのSi。 d Si、グラフェン/ Si、およびグラフェン/ TiO 2 のレーザー出力の関数としての変調深度 / p-Si変調器
グラフェン/ TiO 2 のエネルギーバンド図を取得するには / Si変調器では、図3に示すように、UV-可視分光光度計とUPS測定を行いました。図3aによると、SiとTiO 2 のバンドギャップを計算できます。 それぞれ1.19と2.98eVです。図3bは、Si、TiO 2 でのUPS測定を示しています。 、グラフェン、およびAu。メーターのフェルミ準位の位置を確認するために、AuでUPS測定を実行しました[32]。また、図3cとdは、図3bの拡大部分です。図3cから、スペクトルの二次電子の開始は、Si、TiO 2 の場合16.33、16.97、16.43、および17.11eVです。 、グラフェン、およびAu。したがって、メーターのフェルミ準位の位置は0.98 eVであり、Si、TiO 2、の仕事関数です。 グラフェンは、それぞれ5.85、5.21、5.75eVと計算されます。図3(d)によると、SiとTiO 2 の価電子帯の最大値 1.48および2.86eVにあります。 SiとTiO 2 の価電子帯レベル は-6.35および-7.09eVと計算されます。 SiとTiOのバンドギャップとの組み合わせ 2 、SiとTiO 2 の伝導帯レベルを取得できます 、これは-5.16および-4.11eVです。

吸収スペクトルとUPSスペクトル。 a SiおよびTiO 2 の吸収スペクトル / Si。 b Si、TiO 2 のUPSスペクトル 、グラフェン、およびAu。 c b の拡大部分 二次電子の開始を示しています。 d b の拡大部分 価電子帯の最大値を示す
上記の結果に基づいて、グラフェン/ TiO 2 のエネルギーバンド図 / Siヘテロ接合を図4に示します。E c 、E v 、およびE F は、伝導帯エネルギー、価電子帯エネルギー、およびフェルミ準位エネルギーをそれぞれ示します。 TiO 2 はp-Siと直接接触しており、TiO 2 の電子は p-Siの正孔と再結合すると、界面に空乏層が生じます。 TiO 2 以降 は「弱い」n型であり、TiO 2 の空乏幅です。 Siよりも大きいです。 TiO 2 を検討する フィルムは非常に薄く(〜10 nm)、完全に枯渇した状態がTiO 2 に現れます。 層。グラフェンがTiO 2 に転写されたとき / Si、TiO 2 には過剰な電子はありませんでした グラフェンに移行します。したがって、暗状態ではキャリア蓄積層はなく、THzは高い透過率を示しました。これは、図2bの結果と一致しています。グラフェン/ TiO 2 の場合 / p-Siヘテロ接合は808nmレーザーによって光励起され、Siで生成された電子正孔対の量はグラフェンやTiO 2 よりもはるかに多かった。 。光励起すると、Siのフェルミ準位はTiO 2 で上昇しました。 / p-Siインターフェース。さらに、電子はTiO 2 に向かって移動しました ビルトイン電界の影響によりSiに向かう穴。 TiO 2 の存在 Si中の光励起キャリアの分離を強化し、薄いTiO 2 にn型導電層を形成します。 層、テラヘルツ波の送信を妨げます。 TiO 2 として 層が比較的薄いため、THz透過への影響はわずかに少なくなります。グラフェンをTiO 2 に転写した後 / p-Si、TiO 2 内の多数の電子 グラフェンに注入され、フェルミ準位がより高い伝導帯にシフトします。その間、グラフェンの導電率が増加し、テラヘルツ波の減衰が大きくなりました。このようにして、高い変調深度が実現されました。
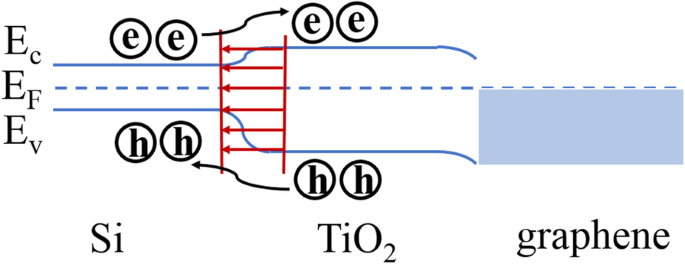
グラフェン/ TiO 2 のバンドスキーム / Siヘテロ接合
結論
要約すると、高性能の全光学グラフェン/ TiO 2 の製造に成功しました。 / p-Siテラヘルツ変調器。変調器は、0.3〜1.7 THzの範囲の広帯域を示し、変調度は88%です。 TiO 2 の挿入 フィルムはp-SiとのPN接合を導入し、内蔵電界はSi内の光励起キャリアの分離を強化しました。光電子はSiからTiO 2 に移動しました 、次にグラフェン層に注入され、グラフェンのフェルミ準位がより高い伝導帯にシフトします。したがって、グラフェンの導電率が増加するため、THz透過変調を実現できます。この装置はまた、製造が非常に簡単で低コストです。電極を堆積する必要はなく、TiO 2 フィルムは薬液法で作製できます。さらに、私たちが使用したレーザーは半導体レーザーであり、変調信号として必ずしも高価なフェムト秒パルスレーザーではありません。
略語
- p-Si:
-
P型シリコン
- THz:
-
テラヘルツ
- UPS:
-
紫外光電子分光法
ナノマテリアル
- テラヘルツバンド入門
- 効率的な光触媒水素生成のためのS、N共ドープグラフェン量子ドット/ TiO2複合材料
- ポリアニリンアレイでコーティングされたグラフェンエアロゲル電極に基づく柔軟なスーパーキャパシタ
- 2種類のグラフェン修飾TiO2複合光触媒の高い光触媒性能
- グラフェン/ MnZnフェライト/ p-Siヘテロ接合の赤外線特性とテラヘルツ波変調
- Pdナノ粒子の表面装飾による数層MoS2 / SiO2 / Siヘテロ接合の高度に強化されたH2センシング性能
- スーパーキャパシター用途の電極としてのグラフェン/ WO3およびグラフェン/ CeOx構造の評価
- リチウムイオン電池のアノード材料としてのマグネシウム-熱還元によって製造された埋め込みSi /グラフェン複合材料
- スパイラル型アンテナによるマイクロブリッジ構造のTHzマイクロボロメータの周波数変調と吸収改善
- イプシロンに近いゼロに近いインジウムスズ酸化物に基づく偏光非感受性表面プラズモン偏光電気吸収変調器
- SnO2-TiO2ナノメイスアレイに基づく高性能セルフパワーUV検出器



