鉛筆型GaN /(In、Ga)Nコアシェルナノワイヤの電子トモグラフィー
要約
多面的な鉛筆型の頂点を持つGaN /(In、Ga)Nコアシェルナノワイヤの三次元構造を、走査型透過電子顕微鏡で高角度環状暗視野モードを使用した電子トモグラフィーによって分析します。パターン化されたマスクを使用したGaN-on-sapphireテンプレートでの選択的領域成長は、分子線エピタキシーによって実行され、均一なナノワイヤの規則正しいアレイが得られます。トモグラフィック再構成の結果により、内部(In、Ga)N多面シェル構造の複雑な形態と完全な六方対称からの逸脱を詳細に決定できます。断層像は、正確な形状とサイズ、およびその化学組成の空間分布を含む、ナノワイヤの頂点でのドットインワイヤ構成を明確に識別します。
はじめに
光電子デバイスの小型化の進行中のプロセスは、複雑な三次元(3D)ナノ構造の開発を引き起こしました。この点で、ナノワイヤ(NW)は、軸方向または半径方向のNWヘテロ構造における効率的なひずみ緩和に関連する大きな表面積対体積比により、高品質の量子井戸または量子ドット(QD)構造を実現する有望な候補です[1 2,3]。 GaN-on-sapphireテンプレートでの分子線エピタキシー(MBE)による選択領域成長(SAG)の最近の改善により、フラットまたはペンシル型のトップを備えた規則正しい均一なGaN NWアレイが製造されました[4、5]。後者は、QDの成長のための代替ソリューションを提供するGaNコアの多面的な先端上に成長した(In、Ga)N / GaNシェル構造を製造するために使用されてきました。減少したNW直径と、それに対応してGaNバリアに挿入された低バンドギャップ(In、Ga)N材料の短いセクションでヘテロ構造を成長させる可能性を利用すると、いわゆるドットインアワイヤ(DIW)が形成されます。 )構造。実際の寸法に応じて、このDIW構成では、NWアンサンブルの代わりに単一のNWのみを簡単にプローブできるという大きな利点を利用して直線偏光の単一光子を放出できました[6、7、8]。それでも、これらのDIWヘテロ構造の詳細な微細構造分析は、単一光子放射特性に対するNW形態、シェルの厚さ、および局所的な化学組成の影響を理解するために必要です。
透過型電子顕微鏡(TEM)は、原子スケールでそのようなナノ構造の構造と化学組成に関する情報を取得するために頻繁に使用される強力なツールです[9]。ただし、たとえば平面システムと比較して、これらの3Dナノ構造の対称性が低いため、TEM顕微鏡写真の解釈がはるかに困難になります。主な特徴は、電子ビームによるサンプルの透過であり、構造情報が2次元画像に投影されます。電子ビームの方向およびサンプルの厚さ以下のオーダーでのサンプル構造の変化は、直接検出することが非常に困難であるか、不可能でさえあります。電子断層撮影法はこの問題を回避することができます。サンプルの単一の投影を使用する代わりに、オブジェクトに対して異なる傾斜角度を持つ一連の投影が記録され、サンプルの3D情報が再構築されます。これにより、コアシェルNWのような複雑な構造の形態と化学組成を記述および分析するための新しい高度な可能性が可能になります。これまでのところ、NW構造[9,10,11,12,13,14,15]または埋め込まれたQD構造[16]の電子トモグラフィーに関して公開されている出版物はごくわずかです。
この作業では、埋め込まれた(In、Ga)Nシェルを含む秩序化されたGaNNWの構造特性評価のための電子トモグラフィーの適用について説明します。損傷を導入することなく分離することにより、単一のNWを電子断層撮影にアクセスできるようにするという課題のために、サンプルの準備についてここで詳細に説明します。 NWの表面形態と結晶ファセットは、外側のGaNシェルの3D表面表現の分析を通じて研究されます。 NWの内部構造、つまり(In、Ga)Nシェルの形態、および化学組成の空間分布について、再構成されたボリュームの2次元スライスと補完的なエネルギー分散型の助けを借りて説明します。 X線(EDX)分光測定。
メソッド
資料
GaN /(In、Ga)N NWは、プラズマ支援分子線エピタキシー(PAMBE)により、GaNバッファー層の厚さが3.3μmの市販のGaN-on-sapphire(0001)テンプレート(LUMILOG)上で成長しました。最初のステップでは、コロイドリソグラフィーを使用して、六角形のパターンを構築するTiナノホールマスクを作成しました。その後のSAGは、鉛筆のような頂点を持つGaNNWの周期的な配列を生成しました。 GaN NWコアは、より低い成長温度で薄い(In、Ga)N層によって成長し、温度を変えずに薄いGaNキャッピング層によって完成しました。成長プロセスの概略図を図1aに示します。基板のパターニング手順とSAGMBEプロセスの詳細は、他の場所で見つけることができます[6、7、17]。図1は、サンプルの2つの走査型電子顕微鏡(SEM)画像を示しており、上面図(b)と45°傾斜した図(c)からのNWの六角形配列を高倍率で示しています。 SEM顕微鏡写真は、形状と長さがわずかに変化するだけの比較的均質な配置を示しています。 NWの平均直径は約180nm、平均高さは約500nmです。
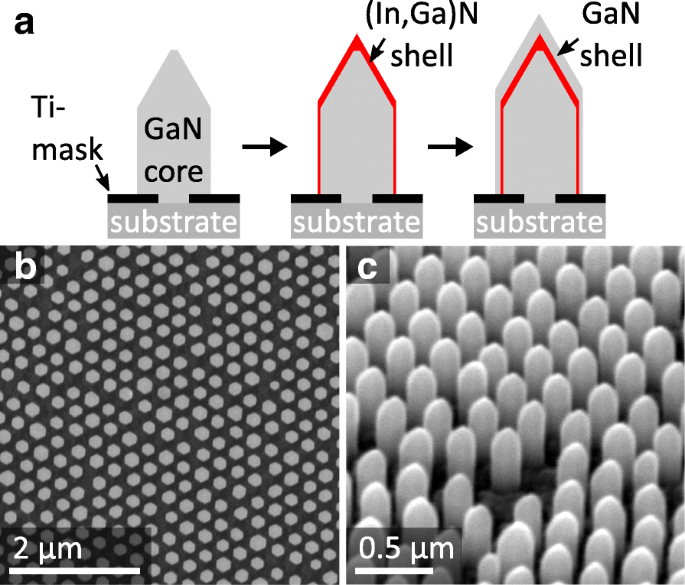
a NW成長プロセスの概略図。 b のSEM顕微鏡写真 上面図と c からのGaN /(In、Ga)NNWのアレイ 高倍率の45°傾斜ビュー
断層撮影針の準備
単一のNWのみを含む針状の断層撮影標本を取得するには、高度な準備技術が必要です。丸い形の針は180°の最大傾斜範囲を可能にし、それによってサンプルの厚さはすべての傾斜角度でほぼ一定です。集束ガリウムイオンビーム(FIB)顕微鏡により、この部位特異的なサンプル調製が可能になります。この作業には、デュアルビーム顕微鏡システム(JEOL JIB-4501)を使用しました。次の準備手順は、標準のFIBリフトアウト技術に基づいており、その後、針状の標本を取得するために細くします[18、19、20]。
さまざまな準備手順を図2に要約します。最初に、関心のある領域が選択されます。これは、いくつかの北西の乱されていないほぼ完全な六角形の配置によって識別されます(図2aの白いボックスでマークされています)。この選択されたプローブボリュームは、FIBミリングプロセス中にNWを保護するためにカーボンで満たす必要があります[21]。炭素堆積は、Ga汚染を減らすために、2つのステップで実行されました。(i)最初に、電子ビームによって誘発された炭素堆積によってNW間のボリュームを埋め(図2b)、(ii)続いて炭素堆積を行います。ガリウムビームによって誘導され、約選択した領域の上に1μmの厚さの保護層があります(図2c)。次の準備ステップでの配向を単純化するために、追加のカーボンマーカーが作成されました。
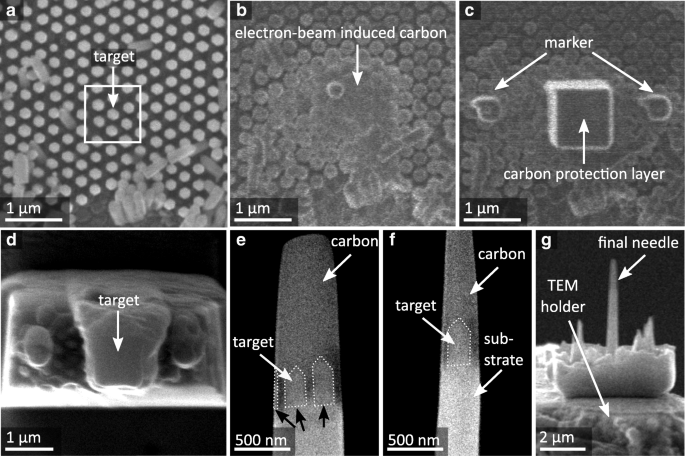
a を示すSEM顕微鏡写真 NWの配列と、FIB針の準備のために選択された領域(白いボックス)、 b 電子ビーム誘起炭素に埋め込まれたNW、 c 選択した領域の上部にある厚い堆積層としてのガリウムビーム誘起炭素と、2つの追加マーカー d 分離された針はリフトアウトの準備ができています、 e 、 f 細くした断層撮影針(黒い矢印は北西の位置を示します)、および g 最終的な断層撮影針の概要
炭素堆積後、FIBフライス盤を導入して、保護領域を分離し(図2d)、いくつかのNWを含む長方形の針を製造しました。マイクロマニピュレーター(Kleindiek Nanotechnik GmbH)を使用して、針を断層撮影ホルダーに移しました。そのため、針の軸はゴニオメーターの回転軸と平行に注意深く調整する必要があります。これにより、同じ焦点が広いサンプル領域に適用されます。さらに、北西[0001] c -軸は基板に垂直であるため、針の軸に平行です。この関係は、断層撮影軸に対する結晶の方向を決定するために使用されました。後方測定された制限視野回折(SAD)パターンは、北西[0001] c の傾斜を示しました。 -わずか2.2°の断層像の回転軸への軸。
さらに細くするステップを実行して、単一のNWを分離し、針を丸め、最終的に電子の透明度を取得しました(図2e、fを参照)。図2gは、最終的な断層撮影針を示しています。
電子断層撮影
断層撮影の取得と微細構造分析は、200 kVで動作するTEM(JEOL JEM-2100F)を使用して実行されました。顕微鏡には、明視野(BF)および高角度環状暗視野(HAADF)検出器を含むスキャンユニットと、50 mm 2 が装備されています。 EDX分光法用のX線検出器(JEOLEX-24065)。 HAADF走査透過電子顕微鏡(STEM)モードは、主に化学的コントラストのために選択されています[22]。強度と物体の質量密度および厚さの単調な関係は、電子断層撮影の前提条件であり、「投影要件」として知られています[23]。
一連の89のHAADF顕微鏡写真が、各測定の間に2°のステップで記録されました。 180°の全範囲をカバーするこの傾斜シリーズは、サンプル針の準備された形状をサポートする特別な断層撮影ホルダー(E.A. Fischione Instruments Inc.のモデル2050)によって可能になります。各STEM顕微鏡写真は、2048×2048ピクセルの解像度でキャプチャされます。 30μsのピクセル滞留時間、つまり、画像あたり127秒のフルスキャン時間。 0.5nmのスポットサイズ。製造元のマニュアルによると、電子の受け入れ角度は70〜180mradです。顕微鏡写真はビニングされ(4×4ビニング=512×512最終解像度)、信号対雑音比と3D再構成の計算速度が向上しました。針の軸がラドン変換の回転軸として選択されるように、すべての顕微鏡写真は手動で相互に位置合わせされます。断層像は、断層撮影ソフトウェアパッケージ(IMOD)によって計算および視覚化されます[24]。 3D構造の高度なレンダリングは、無料のオープンソースコンピュータグラフィックスソフトウェアBlender(Blender Foundation)を使用して実行されます。
この作業では、2つの異なる方法が視覚化に適用されます。 2次元スライスは、3D再構成されたボリュームから抽出されます。そのようなスライスは、信号対雑音比を改善するためにボクセル(3Dピクセル)強度が統合される最終的な厚さを持っています。理想的なスライス幅は、スライスに垂直なサンプル変動の平均化によるノイズリダクションとコントラストブラーの間の妥協点です。もう1つの視覚化方法は、等値面表現です。これは、2つの隣接する材料間の十分なコントラストの場合に使用されます。一般に、等値面は、一定の強度を持つボクセルの3D表面表現です。隣接する材料の界面を再現する等値面を構築するために、2つの材料間の中間強度が選択されます。
HAADF顕微鏡写真は断層像計算の基礎として使用されますが、再構成された強度分布は、サンプルの化学組成だけに由来するものではありません。サンプルの結晶欠陥[25]、または一方で、サンプルのドリフトまたは磁場の乱れによる顕微鏡写真の不整合および顕微鏡写真の歪みは、再構成された強度に影響を与え、したがって最終的な解像度に影響を与えます。同じことが、カッピングアーチファクト[26]やCrowther基準[27](制限されたサンプリング)による断層像の空間分解能の限界などの固有の再構成エラーにも当てはまります。後者は、特に数百ナノメートルの太い断層撮影針に対して考慮されるべきです。再構成する対象物のサイズを大きくすると、顕微鏡写真の数を固定すると断層像の解像度が低下します。
結果と考察
表面形態と結晶ファセット
図3aおよびbは、透視図(中央)および低屈折率方向に沿ったさまざまなビューでの30°刻みの完全な北西および北西頂点の等値面表現を示しています。この図は、それぞれ外側の結晶形状と表面ファセットを示しています。再構成の下部には、北西の予想される六角柱が表示され、通常の無極性\(\ left \ {1 \ overline {1} 00 \ right \} \) m -平面ファセット。結晶ファセットと平面は、HAADF画像と同時に撮影された対応する電子回折パターンに基づいて決定されます。このようなSADパターンの例は、− 90°の方向、つまり[\(1 \ overline {1} 00 \ Big] \)ゾーン軸に沿ったものです(図3bを参照)。北西の上部は、\(\ left \ {1 \ overline {1} 01 \ right \} \) s で構成されるピラミッド型の形状を反映しています。 -平面と\(\ left \ {1 \ overline {1} 02 \ right \} \) r -平面ファセット。ただし、互いに完全に対称的に配置されているわけではありません。非常に小さな三角形の表面ファセット(図3bで緑色の矢印でマークされている)は、北西の先端の近くにあり、\(\ left \ {2 \ overline {2} 01 \ right \} \)を表している可能性があります。 -タイプファセット。ピラミッド型の先端形状のこのようなわずかな非対称性は、サンプルで頻繁に見られます(図1を参照)。この逸脱の理由は、次の段落で説明するように、欠陥の相互作用に関連しています。

a の等値面表現 単一の北西と b 中央に透視図があり、GaNの低屈折率方向(ZA、ゾーン軸)に沿ってさまざまな視野角を持つ北西頂点。さらに、いくつかの模範的な m -、 s -、および r -平面ファセットにはラベルが付けられています(緑色の矢印は\(\ left \ {2 \ overline {2} 01 \ right \} \)-typeのファセットを示します)
ラベルの付いた r の上 -平面ファセットと\(\ left \ {2 \ overline {2} 01 \ right \} \)ファセットでは、不規則な北西の「帽子」が最上部に形成されます。同じウェーハの複数のNWを含むラメラTEMサンプルの高分解能(HR)TEM測定は、スタッキング障害の存在と、北西上部領域での結晶格子の六角形から立方晶への変化を示しています(ここには示されていません)。これらの構造変化は、GaNコア(ca. 625°C)と比較して、GaN外殻の成長に使用される成長温度が大幅に低いために結晶相が不安定になることによって説明される以前の観察結果と一致しています。 .850°C)[5、7]。
内部(In、Ga)Nシェル構造
NWの断層像は、(In、Ga)Nシェルの内部構造、その化学組成、および空間分布に関する情報を抽出するために使用されています。 (In、Ga)NシェルとGaNマトリックス材料の間のボクセルコントラストが低いため、シェル構造の3D等値面表現に簡単にアクセスすることはできません。したがって、別の方法として、再構成された3D断層像から切り取った薄いスライスを抽出することによって内部シェル構造を視覚化します。
図4は、北西の先端を通り、[0001]ワイヤ軸に沿った5つの断面スライスの例を示しています。各スライスの厚さは約7nmです。スライスの向きは、六角形の6回対称性が考慮されるように選択されています。したがって、スライスは、図3bで導入されたラベルに対応して、互いに30°回転します。この点をさらに説明するために、NWの3Dレンダリング画像と、-60°傾斜したスライスの空間位置(つまり、\(\ left(\ overline {2} 110 \ right)\に平行なスライス) )格子面)が図に追加で示されています。
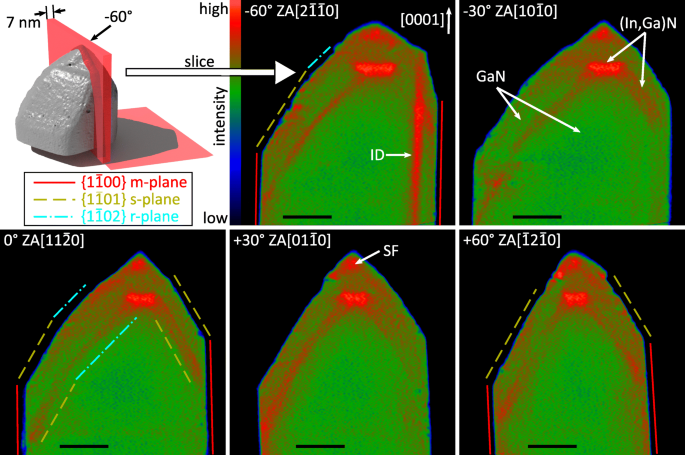
断層像の断面スライス。 NWとスライス(左上隅)の3Dレンダリング表現は、-60°傾斜したスライスの空間位置を指定します。すべてのスライスは、北西先端を貫通し、[0001]北西成長軸に平行な軸を中心に回転します。反転ドメイン(ID)とスタッキング障害の場所(SF)にラベルが付けられています。スライスの向きは図3のラベルに対応しています。黒いスケールバーの長さは50nmに対応しています
(In、Ga)Nの再構成されたボクセルは、GaNのボクセルと比較してわずかに高い強度を持っています。したがって、図4のカラーコードを参照すると、GaNは緑色で表示されていますが、Inを含む層は明確にするために赤みがかっています。断面スライスは、北西部のコアシェル構造を示しています。 (In、Ga)Nの過成長による成長温度の低下により、GaNコアの形態は変化せず、(In、Ga)Nの成長はコンフォーマルに進行すると考えるのが妥当です。したがって、(In、Ga)N内部シェルとGaN外部シェルは、GaNNWコアの形態を大まかに複製します。具体的には、(In、Ga)N層は完全な m-を形成します ワイヤーの周りの平面シェルが s に変わります -および r -北西の先端にある平面ファセットピラミッドシェル。内側のシェルの先端が拡張され、 c で構成される六角形の底面を持つ逆に切り詰められたピラミッドの形をした、いわゆる(In、Ga)NDIW構成が形成されます。 -上下の境界としての平面ファセット(次の段落を参照)。
さらに、図4は、さまざまな(In、Ga)N層の厚さの概要を示しています。 m -平面シェルの厚さはわずか1nmです(\(\ left \ langle 11 \ overline {2} 0 \ right \ rangle \)方向に沿ったHAADF STEM顕微鏡写真によると、追加ファイル1:図S1を参照)。 i> s -および r -平面ファセットの厚さは8〜14nmの範囲です。この厚さの違いは、さまざまなファセットの不均一な成長速度[28、29]と、MBE成長中の低インジウム拡散によって引き起こされるシャドウイング効果[30]の結果です。さらに、インジウムの取り込み率は c で最も高い値を持つファセットの向きに依存するため、インジウム原子はシェル構造に沿って均一に分布していません。 -平面レイヤー[31]。さらに、シェルの一部の領域では、界面近くで濃度が高くなっているようです。 m -平面シェルは、再構築では十分に解決されません。ラドン変換の回転軸は、Crowther基準に従って、北西の中心で最高の断層撮影解像度を達成するために北西の先端を貫通するように選択されました。
− 60°方向のスライスは、幅10nmの高強度のストリップを示しています。このストリップは、チルトシリーズのHAADF画像でも明るいコントラストとして表示されました。暗視野g 0002 測定値は、Kong etal。による同様の構造の観察と一致する反転ドメイン境界の存在を示しています。 [32]。反転ドメインは、基板と北西の間に位置するチタンの意図しない原子層(マスク残基)によって誘導されることがわかっています。この反転領域の電子トモグラフィーは、以下に示すように、楕円形の円柱の形状を明らかにします。
シェル構造の完全な3D想像力を得るために、断面に加えて、NW軸に垂直な断層像を通る一連の平面図スライスが作成されました。さまざまな高さの9つのスライスが、最初のスライスの空間位置の描写とともに、さまざまな高さの位置を表す断面とともに図5に示されています。すべての平面図スライスの幅は3.6nmです。
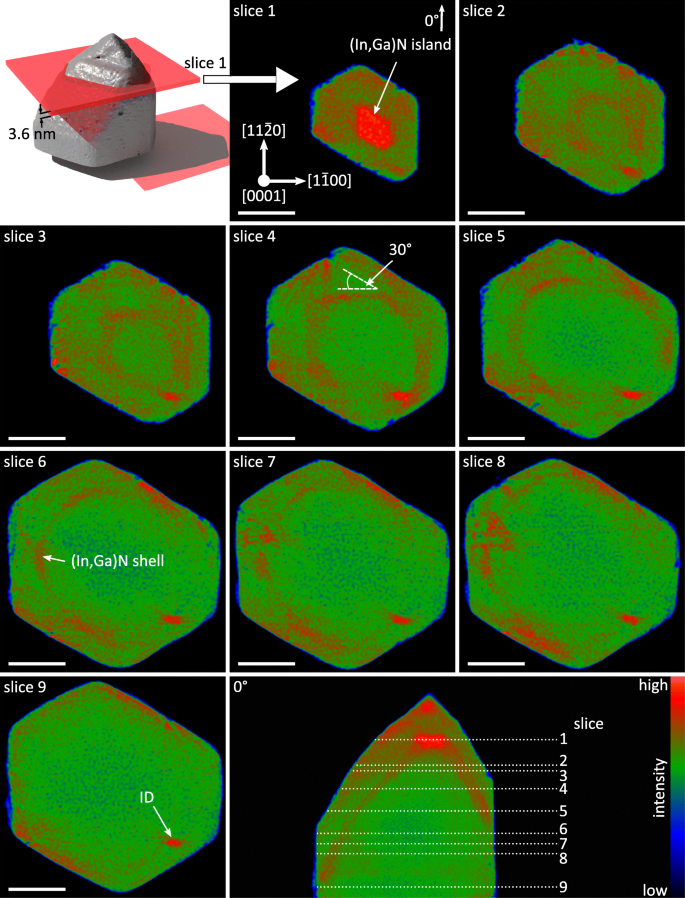
断層像のスライスを平面図で表示します。 NWとスライス(左上隅)の3Dレンダリング表現は、スライス1の空間位置を指定します。すべてのスライスは[0001]方向に垂直であり、さまざまなスライス位置が断面スライス(右下)にラベル付けされています。 )。スライスの幅は3.6nmです。白いスケールバーの長さは50nmに対応します
図5を検討すると、電子断層撮影法なしでは実験的にアクセスできなかった内部NW構造に対する2つの新しい洞察が得られます。まず、北西の直径、つまり平面図のスライス領域が下から上に向かって減少していることは直接明らかです。これは、北西の鉛筆のような形状の結果です。ただし、楕円形の円柱状の反転ドメインに近い側壁がその位置に留まり、他の側壁よりもゆっくりと寸法が変化することは注目に値します。等値面表現(図3を参照)と比較すると、この側壁は非常に細長い m の外側のGaNシェルに対応していることがわかります。 -三角形の\(\ left \ {2 \ overline {2} 01 \ right \} \)のようなファセットに変わる平面ファセット(図3の緑色の矢印)。したがって、反転ドメインの存在は全体的な成長速度に影響を及ぼし、最も近い位置にある側壁のピン止めをもたらすと結論付けることができます。その結果、北西先端の中心は反転領域に向かってシフトし、反対側のファセットは m から低い高さで回転する必要があります。 - s への飛行機 -および r -変位したNWチップを形成するための平面ファセット。
次に、(In、Ga)Nシェルは常に m と平行であるとは限りません。 -、 r -、または s -平面ファセットGaN側壁。 NWの下部では、(In、Ga)Nシェルが m のGaNコアの形状を1対1で再現します。 -GaN外殻と同じように平面ファセット。一方、北西のピラミッド型の先端では、内側の(In、Ga)NシェルがGaNの外側のシェルの六角形の形状から外れています。たとえば、図5のスライス4は、GaNの外側ファセットと(In、Ga)Nシェルに、対称性の理由に基づいて予想される方向に30°回転したファセットがあることを示しています。これらのファセットは、半極性の\(\ left \ {11 \ overline {2} l \ right \} \)ファセットに対応します。スライス1と2に関しては、(In、Ga)Nシェルは、6つのファセットのうち2つがわずかに目立つだけで、先端に向かって六角形に戻ります。六角形からのこの逸脱は予想外であり、電子断層撮影法によってのみ明らかにすることができます。 GaNの外側のシェルが内側の(In、Ga)Nシェルの形状を完全に複製しておらず、代わりにNWの形状がGaNNWの予想される六角形の対称性に変化することは注目に値します。
Dot-in-a-Wire構造
前に図1および2に示したように。図4および5に示されるように、増加したインジウム含有量の挿入は、(In、Ga)Nシェルの先端に位置する。このDIW構造の詳細を図6に示します。この図は、トモグラフィック再構成の平面図と断面スライスの両方を拡大したものです。さらに、ドットの3D形状の等値面表現と、EDXによって測定されたインジウム分布を示します。 EDX分析は、同じウェーハの同様のNWの頂点から実行されます。
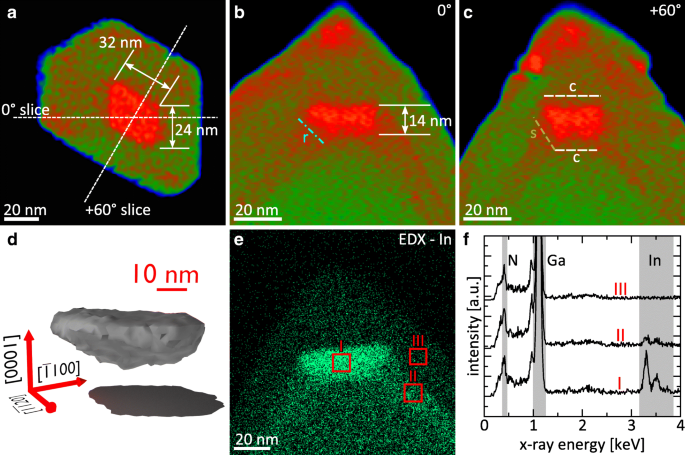
拡大された a プランビューと b 、 c 図1および2の断面断層撮影スライス。図4および5は、ドット・イン・ア・ワイヤ構造の形態を明らかにしている。 d (In、Ga)Nドットの3D等値面表現。同様の北西先端でのEDX測定値は、 e の形式で表示されます。 空間インジウム分布と f を示すEDXマップ 3つの異なる領域でマップから抽出されたEDXスペクトル:(I)(In、Ga)Nドット、(II)(In、Ga)Nシェル、(III)GaN外殻
>図6a〜cの3つのスライスは、ドットの形状と寸法を示しています。 (a)の平面図のスライスに基づくと、ドットは、2つのあまり目立たない側壁を持つ六角形ではなく、平行四辺形のジオメトリをほぼ表示します。側壁の2つの大きなペアの長さは、それぞれ32nmと24nmです。ドットの高さ((b)と(c)の2つの断面スライスで示される)は約14nmです。さらに、断面スライスは、 r の形成を伴う、上部に向かってドットが横方向に広がっていることを示しています。 -および s -底面と上面が c を形成する平面サイドファセット -平面ファセット。これにより、ドット構造は、歪んだ六角形の底面を持つ逆に切り詰められたピラミッドに似ています。ナノドットのこの3D形式は、図6dの等値面表現によってさらに示されます。これは、ドットのファセット形状を確認し、さらに下部の c -平面ファセットはより高い粗さを示します。
図6eとfは、(In、Ga)Nドット(I)とシェル(II)の内側、およびGaNの外殻の位置から取得したスペクトルと組み合わせたインジウムマップによるEDX測定の結果を示しています。 (III)。 In- Lαの強度はありません 1 線はGaN領域(III)で検出されます。一方、シェルとドットの間には線の強度に大きな違いがあり、インジウム濃度の大きな違いが確認されています[7]。ドットのインジウム含有量は、おおよそ(24±6)%と推定されます(詳細については、追加ファイル1:図S2を参照してください)。したがって、EDXマップは、(In、Ga)Nシェルとドットの間の明確な空間的分離を可能にし、同時にそのファセット形状を証明します。さらに、EDXマップは、北西先端に非常に近い断層像の高強度のボクセルがインジウムの取り込みから生じていないことを示しています。この強度の増加は、乱れた「ハット」領域での積層欠陥から生じるHAADFコントラストに起因する可能性があります[25]。さらに、先端は北西の他の部分と比較してはるかに薄い厚さであり、先端領域の質量密度の過大評価につながります[26]。
(In、Ga)Nドットの3D等値面表現は、滑らかな c と比較して、下部界面の化学的粗さがかなり大きいことを示しています。 -上部の平面インターフェース(図6dを参照)。この粗さの原因は、GaN NWコアの多面的な頂点での(In、Ga)Nの核形成メカニズムに関連している可能性があります。 m での(In、Ga)Nの成長中 -、 r -、および s -平面は、インジウム濃度が低く、 c のインジウム含有量(In、Ga)Nがはるかに高いため、2Dモードで発生します。 -平面は、歪んだ3D核の成長をもたらします。これらの核は周囲に応力を発生させ、界面を変形させ、最終的に測定された粗さにつながります。
結論
(In、Ga)N / GaNコアシェルNWは、電子トモグラフィーによって調査されました。等値面表現と断層撮影スライスにより、GaN外殻と(In、Ga)N内殻のファセットの決定が可能になりました。 NWの対称性は、円筒形の反転ドメインの存在によって乱されることが示されています。特に、内側の(In、Ga)Nシェルの予想される六方対称性の偏差が明らかになりました。これは、電子トモグラフィーによってのみ解決できました。さらに、(In、Ga)Nシェルの厚さとさまざまなファセットのインジウム取り込みの違いを分析しました。さらに、(In、Ga)NDIW構造の形態が詳細に特徴づけられました。ドットはファセット化されており、シェルと比較してかなり高いインジウム含有量を含んでいることがわかっています。補足的なEDXマップを使用して、断層像のボクセル強度を確認しました。これは、たとえば、GaN外殻の低温成長が原因である可能性がある北西端に形成される積層欠陥の影響を受けました。
トモグラフィー分析は、調査された北西部の複雑なコアシェル構造の完全な図を提供します。 GaNコアは、反転ドメインの影響によりわずかにずれたピラミッド型の先端を含む六角形であり、(In、Ga)Nシェルはコアの形状を1対1で複製します。予期せぬことに、GaNの外側のシェルは内側の(In、Ga)NシェルとGaNコアの形状を再現しません。代わりに、六角形の対称性に基づいて予想される形状に変換されます。結果は、電子トモグラフィーが成長中のコアシェル構造形成の進化への洞察を可能にすることを示しています。
この分野での将来の調査は、合金の安定性とナノメートルスケールでの潜在的な合金の変動、およびそれらが発光特性と光学特性に強く影響するため、それらの空間分布の問題を指摘しています。したがって、私たちの試みは、インジウム合金の不均一性とナノクラスターを検出できるように、(In、Ga)NDIW構造の3D再構成の空間分解能と化学物質過敏症を改善することである可能性があります。
データと資料の可用性
現在の調査中に使用および分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- (S)TEM:
-
(走査型)透過型電子顕微鏡
- BF:
-
明視野
- DIW:
-
ドットインアワイヤー
- EDX:
-
エネルギー分散型X線
- FIB:
-
集束イオンビーム
- HAADF:
-
高角度環状暗視野
- ID:
-
反転ドメイン
- MBE:
-
分子線エピタキシー
- NW:
-
ナノワイヤー
- PAMBE:
-
プラズマ支援MBE
- QD:
-
量子ドット
- SAD:
-
制限視野回折
- SAG:
-
選択的領域の成長
- SEM:
-
走査型電子顕微鏡
- SF:
-
スタッキング障害
- ZA:
-
Zone axis
ナノマテリアル
- 電子管
- 電子管の紹介
- 材料科学者はナノワイヤーに「踊る」方法を教えます
- ナノ構造の電子マント
- 電子増倍管の発光層の設計
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- アニーリングによって酸化ケイ素膜上に成長したアモルファスシリコンナノワイヤ
- 多機能GaN / Feナノ粒子による内皮細胞の標的化
- 二軸引張ひずみゲルマニウムナノワイヤの理論的研究
- 横方向電子集束におけるスピンスプリットピークの温度依存性
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層



