個々のSiナノワイヤのサイズ依存導電特性の調査
要約
垂直に整列したSiナノワイヤー(Si NW)の周期的に配列されたアレイは、金属支援化学エッチングと組み合わせたナノスフェアリソグラフィーによって首尾よく製造されます。エッチング時間を調整することで、ナノワイヤの直径と長さの両方を適切に制御できます。このようなSiNWの導電特性、特にそれらのサイズ依存性は、個々のナノワイヤの導電性原子間力顕微鏡(CAFM)によって調査されます。結果は、SiNWのコンダクタンスがそれらの直径と長さに大きく関係していることを示しています。直径が小さく長さが短いSiNWは、より優れた導電特性を示します。 I–V曲線の特性評価とともに、サイズに依存するショットキー障壁の高さの観点から考えられるメカニズムが想定されます。これは、静電力顕微鏡(EFM)測定によってさらに検証されます。この研究はまた、CAFMが個々のナノ構造に対する導電性のサイズ(または他のパラメーター)依存性を調査する効果的な手段として機能できることを示唆しています。これは、ナノ構造の製造最適化と潜在的なアプリケーションの両方に不可欠です。
はじめに
シリコンナノワイヤー(Si NW)は、その高いアスペクト比と独自の電気、熱電、光電特性、および従来のシリコン技術との互換性により、電子、フォトニック、オプトエレクトロニクス、およびその他の多くの分野で有望なアプリケーションを獲得しています[1,2,3 、4,5]。過去数十年間、Si NWの研究は、主に成長の改善と特性測定に焦点を合わせてきました。 Si NWを調製するために、気液固法、化学蒸着法、分子線エピタキシー法[6,7,8,9,10]などのボトムアップ法や、電子を使用したトップダウン法など、多くの方法が開発されています。 -ビームリソグラフィー、反応性イオンエッチングまたは金属支援化学エッチング[11、12、13、14、15、16]。これらの方法の中で、金属支援化学エッチング(MACE)と組み合わせたナノスフェアリソグラフィー(NSL)は、その単純さ、低コスト、および汎用性のために、垂直に整列したSiNWの大面積秩序アレイを製造するために集中的に採用されています[15,16,17 、18、19、20、21、22、23]。 MACEによって達成されるSiNWは通常、非常に粗く、多孔質の表面を持っています[18、19、20、21]。これにより、比表面積が大きく、優れた特性が得られ、バイオセンサー、熱電デバイス、リチウムに大きな応用の可能性が生まれます。 -イオン電池、太陽電池など[22、23、24]。これらのアプリケーションを実現するには、それらの電気的特性をよく理解することが不可欠です。今日、ナノワイヤの電気的特性を調査するために、2種類の方法がしばしば適用されてきました。 1つは通常の巨視的方法で実行されます。これは比較的簡単ですが、ナノワイヤの大規模なアセンブリ全体で平均化された結果しか提供できません[24、25]。もう1つは、特別に製造された単一ナノワイヤデバイスを使用して個々のナノワイヤで実行されます[21、26、27、28]。これは、サイズの不均一性の影響を排除できますが、特に特性依存性を測定する場合は簡単に実現できません。したがって、複雑なナノファブリケーションなしで個々のNWの電気的特性を研究するためのより便利な方法が強く求められています。
ここ数十年で、走査型プローブ顕微鏡(SPM)ベースの電気的測定は、ナノスケールでの電気的特性評価のための強力な技術としての地位を明らかにしています[29、30]。これらのSPM技術の中で、導電性原子間力顕微鏡(CAFM)は、単一または個々のナノ構造の導電性を研究するためにうまく適用されています[30、31、32]。 ZnO、InAs、CdS、CdSe、GaAs、InAsSb、Si NWなどのさまざまなナノワイヤに関するCAFMの調査は、すでに報告されています[33、34、35、36、37、38]。ほとんどの研究は固定パラメータを持つナノワイヤの導電性に焦点を合わせていましたが、導電性のドーピング依存性を調査するためにいくつかの調査が行われました[37,38,39]。ナノワイヤの導電特性のサイズ依存性は、まだほとんど調査されていません。 CAFMに限定されない場合でも、ナノワイヤの直径に依存する導電特性について報告されている研究はわずかであり、それらのかなりの部分がナノワイヤの抵抗率の直径依存性を扱っています[25、40、41、42]。たとえば、GaNナノワイヤに関するいくつかの研究では、抵抗率が臨界直径(20〜80 nm、製造方法によって異なります)で高く、それを超えても変化しないことがわかりました[41、43]が、Siナノワイヤに関する他の研究では次のように報告されています。ナノワイヤの抵抗率は、直径が数十から数百ナノメートルの範囲で増加するにつれて減少しました[40、44]。金属接点を備えた半導体ナノワイヤの場合、ショットキーバリアが導電特性に重要な役割を果たす可能性があります。したがって、抵抗率を除いて、半導体ナノワイヤが存在する場合はショットキー障壁を考慮する必要があります。ショットキーバリア高さ(SBH)の直径依存性に焦点を当てた論文がいくつかありますが、結果は一貫していません。たとえば、Calahorra etal。ナノワイヤでポアソン方程式を解くことによってSBHを計算し、サイズの縮小に伴ってバリアの高さが増加するという明確な傾向を発見しました[45]。同様の直径依存性は、Soudiらによって実験的に報告されました。 ZnOシングルナノワイヤデバイスの直径に依存する表面光起電力と表面状態密度を調査する場合。彼らは、表面バリアの高さが直径の減少(20–60 nm)とともに増加することを発見しました。これは、ポアソン方程式[46]を使用してシミュレートされた表面状態密度によって解釈されました。対照的に、Yoonらによる単一Siナノワイヤ電界効果トランジスタの走査型光電流顕微鏡測定。反対の依存性を明らかにしました。つまり、界面状態の寄与により、直径が減少するにつれてバリアの高さが減少しました[47]。真央らによる別の実験的研究。単一のPt / ZnOナノニードルショットキーダイオードでは、直径の減少に伴ってバリアの高さが減少することも報告されています。これは、ジュール熱効果および/または界面の電子的不均一性によって説明されます[48]。したがって、これまでのところ、ナノワイヤの導電特性の直径依存性はまだコンセンサスに達しておらず、完全には理解されていません。特に、サイズに依存する導電特性とサイズに依存するSBHの研究は、MACE法で製造された個々のSi NWについては報告されていません。これは、有望なアプリケーションにとって非常に粗い表面です。
この論文では、異なる直径と長さの垂直に整列したSi NWの周期的配列を、MACEと組み合わせたNSLの方法によって準備します。 SiNWの直径と長さは、エッチング時間を調整することで適切に制御できます。アレイ内の個々のSiNWの導電特性は、サンプルを交換するだけで、個々のSiNWのサイズに依存する導電特性を簡単に調べることができるナノファブリケーションなしでCAFMによって調査されます。結果は、個々のSi NWで測定された電流が、NWの直径と長さに強く依存していることを示しています。直径が小さく長さが短いSiNWは、より優れた導電特性を示します。 I–Vカーブフィッティングから、サイズに依存するショットキーバリアの高さを取得できます。これは、ナノワイヤのサイズに依存する導電特性を決定するための重要な要素として機能することがわかります。さらに、同様のサイズ依存のSBHは、静電力顕微鏡(EFM)測定によって得られました。したがって、私たちの研究は、Si NWのサイズ依存特性を明らかにするだけでなく、CAFMが個々のナノ構造に対する導電特性のサイズ(または他のパラメーター)依存性を調査する効果的な手段として機能できることも示唆しています。
材料と方法
資料
SiウェーハはMTI(中国)から購入しました。ポリスチレン球(PS、直径490 nm)の懸濁液(水中2.5 wt%)は、Duke Scientific(USA)から購入しました。 Si NWを製造するためのアセトン、メタノール、硫酸、過酸化水素、およびフッ化水素酸は、Sinopharm Chemical Reagent(中国)から購入しました。脱イオン水(DI、18.2MΩ・cm)は限外ろ過システム(Milli-Q、Millipore、マサチューセッツ州マールボロ)から入手しました。
SiNWの作成
垂直に配列されたシリコンナノワイヤアレイは、NSLとMACEを組み合わせて製造されます。これは、以前の文献[49、50]で詳細に説明されています。主要な製造プロセスは図1aにスケジュールされています。まず、直径490 nmのポリスチレン球(PS)の単分子層を、化学的に洗浄した平面Siウェーハ(n型、0.01Ωcm)上に自己組織化して、六角形の最密単分子層を形成しました。続いて、PSで覆われたサンプルをO 2 を使用した反応性イオンエッチング(RIE、Trion Technology)(50 W、70 mTorr)によってエッチングしました。 ガス(20 sccm)でPSの直径を小さくします。これは、次の手順でマスク層として機能します。その後、イオンスパッタリングにより、PS層でマスクされたサンプル上に20nmのAu膜を堆積させ、次のMACE処理の触媒として機能させました。サンプルは、HF(40%)およびH 2 でMACEによって処理されました。 O 2 (30%)室温での混合溶液(体積比4:1)。 MACEプロセスでは、Auで覆われたSi表面が効果的にエッチングされ、PSで覆われたSi表面(Auなし)が保護され、SiNWが形成されました。最後に、サンプルをKI / I 2 に浸すことにより、残ったAu層とPS球を除去しました。 それぞれテトラヒドロフラン溶液。この製造方法により、垂直に整列したSiNWアレイの大面積周期アレイを得ることができます。

a 垂直に整列したSiナノワイヤアレイを製造する手順の概略図。 b 個々のSiナノワイヤでのCAFMおよびEFM測定の実験装置の概略図
SiNWの特性評価
作製したSiNWの形態を走査型電子顕微鏡(SEM、SIGMA300)で確認し、励起波長532 nm、低出力約1 mWのラマン分光法(Jobin Yvon HR-Evolution 2システム)で構造特性を調べました。 。
図1bに示すように、Si NWの電気的特性は、市販のSPM機器(マルチモードV、Bruker Nano Surfaces)を使用してCAFMおよびEFMによって調査されました。 Cr / Ptコーティングされたチップ(Multi75E-G、バジェットセンサー、半径約25 nm)は、CAFMとEFMの両方の測定に使用されました。 CAFMでは、導電性チップを接触モードでサンプル表面上をスキャンし、チップを接地した状態で基板にDCバイアス電圧を印加し、チップとサンプル間の電流を測定しました。表面の陽極酸化は正のサンプルバイアスの下で深刻であるため、現在のすべての画像は負のサンプルバイアスで測定されました。 CAFM実験では、-0.5〜-3.0Vの範囲のさまざまな負電圧がテストされました。バイアス電圧を-1.5V未満に設定すると、電流が小さすぎてコンダクタンスの低いサンプルを検出できないことがわかりました。バイアス電圧を− 2.0 V以上に設定しましたが、大きな静電界下でのチップやサンプルの損傷などにより、測定が不安定になりました。したがって、現在の画像測定には− 1.5Vのバイアス電圧が選択されました。 EFM測定は、2パスモードのSiNWで実行されました。最初のパスでは、タッピングモードで地形画像を取得し、2番目のパスでは、ファンデルワールス力を無視するのに十分な高さまで先端を持ち上げました。リフトパスでは、サンプルと接地チップの間にDC電圧を印加し、静電力による位相シフト信号を検出しました。すべての実験は、流れるN 2 で実施されました。 安定した電気的測定のために周囲温度を測定し、サンプルをHF溶液(5%)に30秒間事前に浸して、導電性の特性評価に対する酸化物層の影響を効果的に低減しました。測定はHF浸漬直後に行われたため、改質酸素層は導電性チップが貫通するのに十分な薄さであり、コンダクタンスへの影響は最小限である必要があります。
結果と考察
SiNWの作成
大面積の垂直に整列した秩序化されたSiナノワイヤアレイの製造を図1aに示します。 RIE時間を変更することにより、PS球の直径を所望の値に減少させることができ、したがって、制御可能な直径を有するSi NWを達成することができる。 90、120、および150秒のRIEエッチング後に得られたSi NWのSEM画像を、それぞれ図2 a、b、およびcに示します。 Si NWは、広い領域で周期的に六角形に垂直に並んでいることがわかります。これらの垂直に整列したSiNWは、同じ周期490 nm、同じ長さ約350 nm(同じMACE時間40 s)です。 (a)、(b)、および(c)のSi NWの直径は、それぞれ約350、260、および190nmです。 NWの直径のRIEエッチング時間への依存性が図2dにプロットされており、良好な線形相関を示しています。一方、ナノワイヤの長さは、HFとH 2 でMACEの時間を変えることで調整できます。 O 2 混合溶液。 40、60、80、および100秒のMACE後のSiNWの断面SEM画像を図2eに示します。 MACE時間を長くすると、NWの長さが350nmから960nmに増加することがわかります。同様に、図2fに示すように、SiNWの長さはMACE時間に対して良好な線形依存性を示します。これらの結果は、直径と長さが制御可能な順序付けられたSi NWが、MACEと組み合わせたNSLの方法によって正常に製造されたことを示しています。
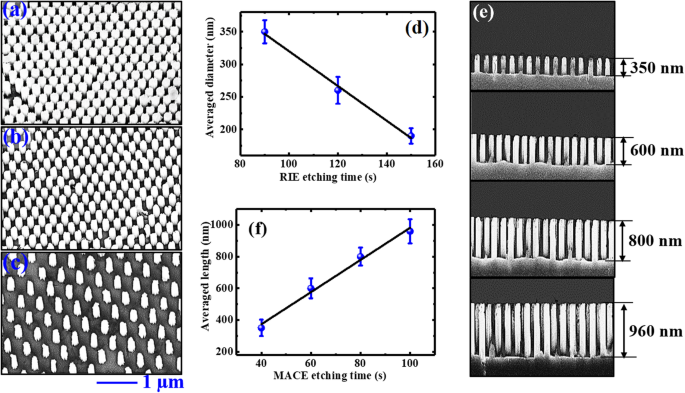
長さが350nmで、直径が異なる a のSiNWの上面SEM画像 350 nm; b 260 nm;および c 190nm。 NWの直径のRIEエッチング時間への依存性は、 d にプロットされています。 。 e 同じ直径260nmで、長さが350、600、800、960nmの異なるSiNWの断面SEM画像。 f NWの長さのMACE時間への依存性を示します
SEM画像から、Si NWは化学エッチング後の表面が非常に粗く、側壁表面が特に粗いことがわかります。直径と長さの関数として表面層の微細構造をチェックするために、異なる直径と異なる長さのバルクSiとSiNWの両方でラマンスペクトルを測定しました。各スペクトルは、520 cm − 1 での最大ピーク強度を使用して正規化されました。 、およびさまざまな直径とさまざまな長さの結果を、それぞれ図3aとbに示しました。バルクシリコンのスペクトルは、〜520.1 cm − 1 にある鋭いピークを示しています。 。図3cおよびdにそれぞれプロットされているように、ピーク位置の赤方偏移とピーク幅の広がり(半値全幅、FWHMと呼ばれる)の両方がSiNWで観察できます。ピークの赤方偏移と広がりは、350および600 nmの短い長さのナノワイヤではかなり小さく、ナノワイヤの長さが800nm以上に増加するにつれて比較的明白になります。このようなラマンピークの赤方偏移と広がりは、ドーパントレベルまたは結晶含有量の変化に起因する場合があります。以前の文献[5、51]によると、同じMACE法で製造されたSi NWの場合、ドーピング濃度は出発ウェーハと同じドーピングレベルを持つ可能性があります。設備の制約により、この結果を確認することができませんでした。一方、これらのSi NWは表面が粗いものの、以前の文献では、MACE法で製造されたSi NWは、主にnドーピングとpドーピングの両方、および軽いドーピングと重いドーピングの両方で結晶構造を維持できることがわかっています[5、51 、52]。 NWの壁面には薄いアモルファス層のみが観察された。同様の結果が、異なるグループによって異なる直径と長さのSiNWで得られました。そのため、MACE法で製造されたSi NWは、薄い表面層を除いて、バルクの対応物と同様に、ドーパントレベルと結晶含有量をほとんど変化させないことができると考えられます。

a を使用したバルクSiおよびSiナノワイヤの典型的なラマンスペクトル 350 nmの長さは同じですが、直径と b が異なります。 直径は190nmですが、長さが異なります。 c および d ナノワイヤの長さの関数としてのピーク位置の赤方偏移とFWHMの広がりを表す
したがって、ラマンのピークシフトと広がりは、おそらくナノワイヤの損傷した粗い表面によって引き起こされます[53]。同じMACE法で製造されたSiNWのラマン結果を報告した論文がいくつかあります。たとえば、Feser etal。 520 cm − 1 で有意なピークの広がりが見られました MACE時間とともに増加し、このピークの広がりは、エッチングプロセスによって引き起こされた結晶の乱れ(たとえば、点欠陥のクラスター)に起因すると考えられます[23]。 Lajvardi etal。ラマン赤方偏移がMACE時間とともに増加することを発見しました。 e。 TOラマンピークは521.1cm − 1 にありました バルクSiの場合、518.7 cm − 1 にシフト それぞれ80分のエッチングされたサンプルの場合[54]。彼らは、ラマンシフトの起源は、ナノワイヤの壁でのSiナノ結晶の形成に起因する可能性があると述べた。リンら。 TOラマンピークが520から516cm − 1 にシフトすることを観察しました NWの長さが0(バルクSi)から2.73μmに増加し、ピーク幅が3から9cmに拡大した場合 − 1 NWの長さが0.19から2.73μmに増加します[55]。彼らは、ラマンピークの広がりはフォノンとひずみの相互作用によって支配され、ラマンピークシフトはひずみによって引き起こされる表面格子歪みに比例することが証明されたと考えました。 HFエッチングによって誘発されるひずみはNWの長さとともに増加するため(エッチング時間の増加)、ラマンピークの赤方偏移と広がりの両方がNWの長さの増加とともに増加しました。私たちの場合、図3 aおよびbに示すラマンスペクトルから、TOラマンピークが520から519.4 cm − 1 にシフトしていることがわかります。 NWの長さが0(バルクSi)から960 nmに増加し、FWHMが4.41から4.47 cm − 1 に拡大した場合 NWの長さが350から960nmに増加するにつれて。この長さに依存するラマンピークシフトと広がりは、損傷した表面(ひずみまたは無秩序)に起因することをお勧めします。ただし、直径と長さが異なるナノワイヤでは、赤方偏移とピークの広がりの両方の変動が非常に小さいため(<1.0 cm − 1 )、サイズによるひずみ/障害の変化は最小限であると見なすことができます。したがって、ひずみ/障害はNWのコンダクタンスを変更する可能性がありますが、コンダクタンスのサイズ依存性への影響は次のセクションでは関係ありません。
単一SiNWの導電性測定
Si NWの導電特性は、直径と長さが異なる個々のNWでCAFMによって測定されます。長さが同じ350nmで直径が350、260、190nmの異なる垂直に整列したSiNWの典型的な地形画像を、それぞれ図4 a、b、cに示します。また、対応する現在の画像はサンプルで取得されています。 − 1.5 Vのバイアスは(d)、(e)、および(f)に示されています。 Cr / PtコーティングされたAFMチップは大きな角度のくさびであるため、SiNWは実際のものよりも大きな直径を示すことに注意してください。さらに、チップが基板と接触できない可能性があるため、ナノワイヤからの電流を十分に検出できなかったため、ナノワイヤで測定された電流のみが考慮されます。現在の画像から、Siナノワイヤのほとんどのエッジが中心よりもわずかに優れたコンダクタンスを示していることがわかります。これは、AFMチップとSiNWの間の接触面積が大きい側方接触が原因である可能性があります。さらに、上面の明らかな粗さのために、中央領域の一部の領域もエッジと同様に大きな電流を示し、明確なリング状の電流分布が得られない場合があります。一方、Si NWのコンダクタンスは、明らかにナノワイヤの直径に関係しています。直径が350から190nmに減少するにつれて、ナノワイヤの導電面積比と絶対電流値の両方が大幅に増加することがわかります。この結果は、直径が小さいSiNWの方が大きいSiNWよりも導電性が高いことを示しています。直径依存性をより直感的に取得するために、図4dからfのマークされた線に沿った電流プロファイルが図4gに表示されます。これは、直径190nmのSiNWが、直径260nmおよび350nmのSiNWよりもはるかに導電性が高いことを明確に示しています。このような直径依存性は、追加ファイル1:図S1(a)に示すように、さまざまな直径のSi NWの電流分布の統計ヒストグラムからも取得できます。これは、直径が減少すると電流分布が高い値にシフトすることを示しています。平均電流( I av )のSi NWは、電流画像内のすべてのナノワイヤの電流を平均することによって計算されます。これは、NWの直径の関数として図4hにプロットされています。 Si NWの平均電流は、NWの直径が350から190 nmに減少すると、劇的に9倍に増加します。直径に対する同様の電流依存性は、単一のInAsナノワイヤおよび単一のSiナノワイヤデバイスで達成されています[35、47]。

長さが350nmで、直径が異なる a のSiNWのトポグラフィー画像 350 nm、 b 260 nm、 c 190nm。 − 1.5Vのサンプルバイアスの下で得られたそれらの対応する電流画像は d で与えられます。 、 e および f 、 それぞれ。 d のマークされた線に沿った現在のプロファイル – f g でプロットされます 、および h 平均電流を示します( I av )NWの直径の関数としてのナノワイヤ上。 a の地形画像に対応する線が追加されています – c g のプロファイル曲線 ガイダンスのために垂直方向にシフトされます
図5に、サンプルバイアス-1.5Vで測定された長さが異なり同じ直径が190nmのSiNWの典型的な電流画像を示します。図5aからdは、長さが350のSiNWの電流画像を示しています。それぞれ600、800、960nm。これらの電流画像では、導電領域は長さが長くなるにつれて明らかに減少しますが、絶対電流の減少はそれほど明白ではありません。特に、長さが350nmと600nmのNWの場合はそうです。局所的な不規則な表面粗さの存在が原因である可能性があり、図5bのいくつかのスポットでさらに大きな電流が観察されました。それにもかかわらず、図5bの平均電流は図5aの平均電流よりはるかに小さかった。上記と同じ分析を使用して、マークされた線に沿った現在のプロファイルを図5eに示し、統計ヒストグラムを追加ファイル1:図S1(b)に示します。どちらも、NWの長さが長くなると、明らかに電流が大幅に減少します。 NWの長さの関数としてのナノワイヤの平均電流が図5fにプロットされており、それらは数十から数百pAのオーダーであり、図5aからeに示されているnAのオーダーよりもはるかに小さい。 。これは、ほとんどの領域が非導電性である場合、ナノワイヤが少数の導電性スポットでのみ比較的大きな電流を示すためです。図5fから、長さが300から960 nmに増加すると、平均電流は3分の1以上減少します。これは、長さが増加するとナノワイヤのコンダクタンスが減少することを示しています。ナノワイヤの抵抗の長さへの依存性は、半導体ナノワイヤの4点抵抗測定によって以前に調査されており、オーミック接触下では、ナノワイヤの抵抗は抵抗の傾きに比例して長さとともに増加することが示唆されました[56、57]。私たちの場合、追加ファイル1:図S2に示されているI〜1 / Lのプロットから、依存性は著しく非線形です。したがって、抵抗率は曲線の傾きから正しく取得できませんでした。 CAFM測定では注目に値します。測定された総抵抗には、Cr / PtコーティングされたチップとSiNW( R )間の接触抵抗が含まれます。 tip / NW )、Si NWの抵抗( R NW )およびSiウェーハの抵抗( R バルク )。 CAFMによって測定される抵抗は、主に先端の下の局所的な表面積に由来し、電流経路に沿った面積の増加に伴って急速に減少するため、 R バルク R と比較してはるかに小さい NW および R tip / NW 。一方、チップとナノワイヤ間の金属-半導体接触面積が非常に小さいため、接触抵抗 R tip / NW ナノワイヤの抵抗よりもはるかに大きい R NW 。 1 / Lへの電流依存性の非線形性は、大きな接触抵抗の存在を示しています。したがって、CAFMで実行される測定では、ショットキー障壁が重要な役割を果たす金属-半導体接触抵抗を強調して考慮する必要があります。

同じ直径190nmで長さが異なる a のサンプルバイアス-1.5VでのSiNWの現在の画像 350 nm、 b 600 nm、 c 800 nm、および d それぞれ960nm。 a のマークされた線に沿った現在のプロファイル – d e にプロットされます 、および f ナノワイヤの平均電流を示します( I av )NWの長さの関数として。 e のプロファイル曲線 ガイダンスのために垂直方向にシフトされます
上記の推論を検証するために、電流-電圧(I-V)曲線を個々のSi NWで記録し、金属チップ/ Siナノワイヤ接点のショットキー障壁を調査しました。同じ長さ350nmで直径が異なるSiNWの典型的なI-V曲線を図6aに示し、同じ直径190nmで長さが異なるSiNWの典型的なI-V曲線をそれぞれ図6bに示します。すべてのI–V曲線は、金属チップとn型半導体の間にショットキー接触がある典型的なI–V曲線に従って、負のサンプル電圧領域でより大きな電流を示します。 I–V曲線は良好な金属半導体特性を示すため、コンダクタンスに対する酸素層の影響は深刻ではなく、以下の説明では最小限であると想定されていることを示しています。一方、結果は、小さくて短いナノワイヤは、大きくて長いナノワイヤよりも大きなコンダクタンスを示し、現在の画像から得られた結果とよく一致していることを示しています。定量分析には、金属-半導体接触のよく知られた熱電子放出モデルが採用されています[58、59]。このモデルでは、直列抵抗が存在する場合のn型半導体へのショットキー接触のI–V特性は、[59]:
として近似できます。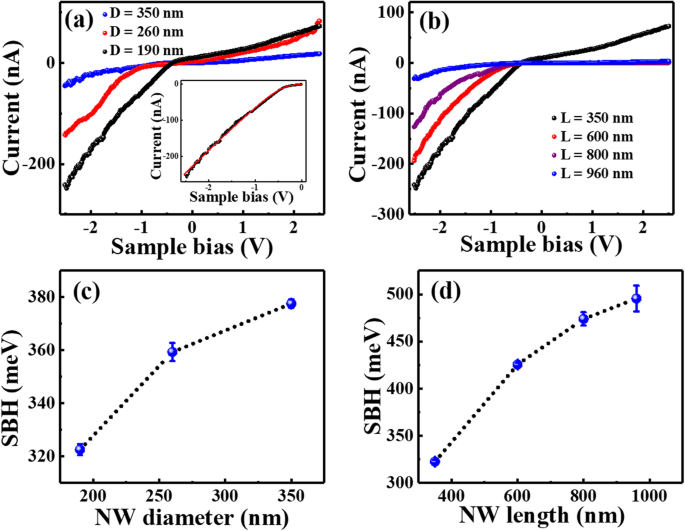
同じ長さ350nmで直径が異なるSiNWの典型的なI-V曲線( a )で、直径は190 nmですが、長さが異なります( b )。 a の挿入図 は、直径190 nm、長さ350nmのSiNWの典型的なフィッティング結果を示しています。 c および d それぞれNWの直径と長さの関数としてフィッティング結果から得られたショットキーバリアの高さを表します
ここで n は理想的な要素であり、 R S は直列抵抗です。 私 S は飽和電流であり、次の式で表すことができます。
$$ {I} _S =\ mathrm {AA} \ ast {T} ^ 2 \ exp \ left(-\ frac {\ varphi_B} {kT} \ right)、$$(2)ここで、Aは接触面積、A *はリチャードソンの定数、 φ B は、金属チップとSiナノワイヤ間のショットキーバリア高さ(SBH)です。したがって、SBHは次の式で取得できます。
$$ {\ varphi} _B =kT \ ln \ left(\ frac {\ mathrm {AA} \ ast {T} ^ 2} {I _ {\ mathrm {S}}} \ right)、$$(3)図6aおよびbのI–V曲線は、式(1)でうまく適合させることができます。 (1)であり、前方領域での典型的なフィッティングラインが図6aの挿入図に示されています。飽和電流からSBH値を取得するために、実効リチャードソン定数A *は、バルクシリコンの定数とほぼ等しい、つまり112 A cm − 2 であると想定されます。 K − 2 n型シリコン用[59]。接触面積は2×10 − 11 と想定されています。 cm 2 Cr / Ptでコーティングされたチップ半径を25nmとします。 SBH値は、同じ長さ350 nm、異なる直径190、260、350nmのSiNWでそれぞれ約322、359、377meVになるように得られます。同じ直径が190nmで長さが350、600、800、960nmの異なるSiNWの場合、SBH値はそれぞれ322、425、473、495meVです。比較のために、追加ファイル1:図S3(a)に示すように、同じタイプのSiウェーハで典型的なI-V曲線を測定しました。これは、Siウェーハのコンダクタンスが生成されたNWよりもはるかに小さいことを明確に示しています。検出可能な電流は、高バイアス電圧(− 4〜− 10 V)でのみ測定できました。 I–V曲線を上記の熱電子放出モデル(追加ファイル1:図S3(b))に適合させた後、バルクSiに対して0.60eVのSBH値が得られました。明らかに、直径と長さが異なるSi NWの測定されたSBH値はすべて、バルクSiの値よりも小さくなっています。ナノワイヤでの同様のショットキーバリア低下は、空乏領域でのキャリア再結合[46、60]、バリアの不均一性とジュール熱効果[48]、または画像電位低下[47]に起因する、さまざまなタイプのナノワイヤのさまざまなグループによって報告されています。 ]。私たちの場合、バリアの低下は、表面状態の高密度によって引き起こされる画像電位の低下と空乏領域でのキャリア帯電にも起因する可能性があります。
SBH値のナノワイヤの直径と長さへの依存性をそれぞれ図6cとdにプロットし、ナノワイヤの直径と長さの両方が増加すると、SBHが明らかに増加することがわかります。さらに、すべての長さで直径が260および350nmの異なるSiNWで同じ測定が行われ、I–V曲線がそれぞれ追加ファイル1:図S4aおよびbに示されています。すべての長さのカーブフィッティングから得られた直径依存のSBH値を表1に示し、追加ファイル1:図S5にプロットします。結果は、SBH値がすべての長さで直径が大きくなると増加し、すべての直径で長さが長くなると増加することを示しています。したがって、I–V曲線分析から得られた結果は、ショットキー障壁の低下が、直径が小さく長さが短いナノワイヤの方が重要であることを示しています。一方、理想的な要素は n および直列抵抗 R 表1に示すように、フィッティングの結果から、直径と長さが異なるSiNWのsを取得することもできます。結果は n であることを示しています。 はすべてのナノワイヤで1よりはるかに大きく(2.8〜9.4)、おそらく酸化物層の存在のために、チップとナノワイヤ間の接触が理想的な金属-半導体接触ではないことを示しています。一方、 R sは、直径が大きくなり、長さが長くなると大きくなります。たとえば、 R S 350nmの同じ長さで直径が190から350nmに増加すると、6.1から21.6MΩに増加し、190nmの同じ長さで350から960nmの長さで6.1から32.3MΩに増加します。 R の増加 長さが長くなると合理的ですが、直径が大きくなるとその増加は予想外です。現在のところ、これについての適切な説明はありません。これは、直列抵抗が単にナノワイヤの抵抗ではなく、有効なチップとナノワイヤの接触面積がナノワイヤの断面積と正確に等しくないためである可能性があります。それにもかかわらず、Si NWの直列抵抗は接触抵抗よりもはるかに小さかったため、SiNWのコンダクタンスはSBHで決定された接触抵抗によって支配されるはずです。
<図>サイズに依存するSBHの起源はまだはっきりしていません。 SBHの同様の直径依存性のメカニズムの説明は、いくつかの文献で想定されています[45、46、47、48、60]。たとえば、Leonard etal。この効果を空乏領域での電子正孔再結合の点で解釈した[60]。ナノワイヤの直径が減少するにつれて再結合時間が減少するにつれて、電流密度はナノワイヤの直径が減少するにつれて増加した。ユンら界面状態の存在を使用して直径に依存するSBHを説明しました[47]。真央他その起源は、バリアの不均一性とジュール熱効果に起因すると考えられています[48]。私たちの場合、Si NWはMACE法で作られているため、必然的に表面に大量の欠陥が存在し、再形成された薄い酸素層が存在し、表面状態の密度が高くなります。実際、拡大したSEM画像とAFM観察から、Si NWの上面は非常に粗く、表面状態の密度がさらに高くなっています。 SBHの直径依存性の主な原因は、表面(または界面)状態の存在であると考えられます。以前の文献[47、61、62]によると、SBHの低下は帯電した界面状態によって解釈されました。参考文献[47]で使用されている円筒形同軸コンデンサモデルを採用することにより、界面状態に起因するキャリア移動は、2つの反対の帯電層(金属と半導体の接触面)を形成し、ビルトイン電界と反対の電界を生成して障壁を下げます。潜在的な。ナノワイヤの直径が小さくなると表面状態密度が増加するため、直径の小さいナノワイヤではより小さなSBHが得られます。ナノワイヤの長さに関連するSBHの値がまだ明確でない理由。 MACE時間が増加すると、それに応じて表面の乱れまたは粗さが増加します。表面の微細構造の変化が異なると、SBH値の変化が異なる可能性があり、それを解決するにはさらに調査が必要です。とにかく、導電性のサイズ依存性の原因が何であれ、サイズに依存するSBHの低下は、より高いコンダクタンスをもたらす可能性があり、これは実際のアプリケーションに有益であるはずです。
単一SiNWでのEFM測定
CAFMによって得られたSiNWのサイズ依存のSBH結果をさらに検証するために、同じサンプルでEFM測定を実行し、適用されたDCバイアスの関数としてEFM位相シフトを測定しました。以前の文献[63、64]では、位相シフトと静電力の関係はすでに確立されており、チップサンプルシステムは大まかに平面コンデンサとして扱われます。チップとサンプルの間にバイアスがかかると、容量性静電力勾配によって位相シフトが発生します。ファンデルワールス力を無視できる持ち上げられた高さでは、先端に作用する静電力は[63]:
として表すことができます。 $$ F =\ frac {1} {2} \ frac {\ partial C} {\ partial z} {\ left({V} _ {EFM}-{V} _ {CPD} \ right)} ^ 2、 $$(4)ここで C 、 V EFM 、および V CPD は、それぞれサンプルとチップ間の静電容量、印加DC電圧、および接触電位差(CPD)です。 V CPD ( φと書くことができます サンプル − φ ヒント )/ eバイアス電圧 V の場合 EFM 私たちの実験ではサンプルに適用されました。 EFMによって検出される位相シフトは、静電力の勾配に比例します。これは、次のように記述できます。
$$ \ varDelta \ varPhi =-\ frac {Q} {k} \ frac {\ partial F} {\ partial z} =-\ frac {Q} {k} \ left [\ frac {1} {2} \ frac {\ partial ^ 2C} {\ partial {z} ^ 2} {\ left({V} _ {EFM}-{V} _ {CPD} \ right)} ^ 2 \ right]、$$(5)ここで Q は品質係数、 k はプローブのばね定数であり、 z SiNWの先端と上部の間の距離です。
式から(5)、EFM位相シフトは V でゼロに等しくなければならないことがわかります。 EFM = V CPD 。したがって、 V CPD EFM測定から達成することができます。 ΔΦ 〜 V EFM 直径と長さが異なる個々のSiNWでリフト高さ100nmで測定された曲線が、それぞれ散乱ドットとして図7aとbに示されています。式を使用することによって。 (5)、ΔΦ 〜 V EFM 図7aおよびbに実線で示されているように、曲線はうまく適合させることができます。フィッティングパラメータから、 V の値 CPD 図7cとdにそれぞれ直径と長さの関数として示されているように、を得ることができます。結果は、CPD値が直径と長さの増加とともに増加することを示しています。同様のCPDの結果は、ZnO NWでケルビンプローブフォース顕微鏡法によって実行された以前の研究で報告されており、ZnOナノワイヤとPt / Irチップ間のCPDの絶対値も直径の増加とともに増加しました[65]。追加ファイル1:図S6に示されているように、SBHの値は qV にほぼ等しくなります。 CPD プラス E n (= E C − E F )。 E として n は、同じ材料で作られたすべてのSi NWの定数であり、 V のサイズ依存性です。 CPD SBHのサイズ依存性をよく表しています。したがって、EFMの結果から、SBH値は、NWの直径と長さの増加とともに増加し、CAFM測定によって達成された結果とよく一致していることが示唆されます。同様に、EFM測定は、すべてのシリーズのSi NW、および直径に依存する V で実行されます。 CPD さまざまな長さの値を追加ファイル1に示します。それぞれ図S7(a)および(b)で、CAFMで得られたものと同じ直径依存性を示します。

∆ Φ 〜 V a を使用して個々のSiNWでEFMによって測定された曲線 190、260、350 nm(長さ=350 nm)と b の異なる直径 350、600、800、および960 nmのさまざまな長さ(直径=190 nm)。 c および d V を提示する CPD NWの直径と長さの関数としてカーブフィッティングによって得られた値。 a の曲線 および b ガイダンスのために垂直方向にシフトされます
結論
要約すると、複雑な手順を必要としないシンプルで低コストの方法により、制御可能な直径と長さのSiNWアレイが準備されます。 SiNWの直径と長さは、エッチング時間を調整することで適切に制御できます。導電特性には電流マップが含まれ、I–V曲線は、CAFMを使用した複雑なナノファブリケーション手順なしで、個々のSiNWで直接測定されます。 Si NWのサイズに依存するコンダクタンスは、現在の画像とI–V曲線の両方から取得できます。我々の結果は、より小さな直径とより短い長さのSiNWがより良いコンダクタンスを示すことを示しています。これは、SBHのサイズ依存性に起因する可能性があります。SBHは322から377 meVに増加し、同じ長さ350nmで直径が190から350nmに増加しました。これに対応して、同じ直径190nmで長さが350から960nmに変化すると、SBH値は322から495meVに増加しました。同じサイズ依存のSBHは、EFM測定からも取得できます。このようなSBHの低下は、帯電したインターフェース状態によって解釈されます。したがって、私たちの研究は、Si NWのサイズ依存特性を明らかにするだけでなく、CAFMが個々のナノ構造に対する導電特性のサイズ(または他のパラメーター)依存性を調査する効果的な手段として機能できることも示唆しています。
データと資料の可用性
結論を裏付けるために使用されたデータセットは、記事と裏付けファイルに含まれています。
略語
- CAFM:
-
導電性原子間力顕微鏡
- CPD:
-
接触電位差
- EFM:
-
静電力顕微鏡
- MACE:
-
金属支援化学エッチング
- NSL:
-
ナノスフェアリソグラフィー
- PS:
-
ポリスチレン球
- RIE:
-
反応性イオンエッチング
- SBH:
-
ショットキーバリアの高さ
- SEM:
-
走査型電子顕微鏡
- Si NW:
-
Siナノワイヤー
- SPM:
-
走査型プローブ顕微鏡
ナノマテリアル



