二重ヘテロ接合を有するSi基板上のAlGaN / GaNショットキーバリアダイオードに関する理論的および実験的研究
要約
二重ヘテロ接合を備えたAlGaN / GaNショットキーバリアダイオード(SBD)は、理論的および実験的にGaN / AlGaN / GaN / Si-subで調査されます。二次元正孔ガス(2DHG)と電子ガス(2DEG)は、それぞれGaN-top / AlGaNとAlGaN / GaNの界面で形成されます。オフ状態では、2DEHと2DHGは部分的に使い果たされ、その後完全に消えます。固定された正および負の分極電荷が残り、分極接合を形成します。したがって、ドリフト領域での平坦な電界と高い絶縁破壊電圧(BV)が得られます。さらに、ターンオン電圧( V )を下げるために、アノードは凹んでいます。 オン )。低損傷のICPエッチングプロセスにより、ショットキー接点が改善され、リークゲー電流が低くなり、 V が低くなります。 オン が得られます。製造されたSBDは、アノードからカソードまでの距離( L )で1109VのBVを示します。 AC )11μmの。製造されたSBDは低い V を達成します オン 0.68 Vで均一性が高く、オン/オフ電流比が高い〜10 10 室温では、比オン抵抗が低くなります( R ON、SP )1.17mΩcm 2 、および1051 MW / cm 2 の高いバリガの性能指数(FOM) 。
はじめに
AlGaN / GaNヘテロ構造ベースのラテラルダイオードは、2次元電子ガス(2DEG)の高い電子移動度、高い電子飽和速度、および高い破壊電界のために魅力的なデバイスです[1,2,3]。低いターンオン電圧( V )を実現するために多大な努力が払われてきました。 オン )、電源および力率補正用のコンバーターおよびインバーターで使用されるGaNダイオードの低い逆リーク電流および高いブレークダウン電圧(BV)[4,5,6,7,8,9,10,11,12] 。電界の不均一な分布を解決するために、様々なアプローチが提案されてきた。それらの1つは、フィールドプレート(FP)テクノロジーです[5、13]。デュアルフィールドプレートを備えた完全に凹んだアノードSBDは、25μm L で1.9kVの高い絶縁破壊電圧を実現します。 AC [5] 。 また、高いブレークダウン電圧を維持しながら、ターンオン電圧を大幅に下げることができます。さらに、シリコン技術で一般的に採用されている従来の縮小表面フィールド(RESURF)の概念は、GaNHEMTで実証されています[14]。さらに、特定のオン抵抗( R )間の関係を改善するために、2DEGの上の2次元ホールガス(2DHG)で構成される分極接合(PJ)が提案されています。 ON、SP )およびBV [15,16,17,18]。 PJコンセプトに基づくGaNベースのデバイスは、サファイアとSiC基板で実証されていますが、SiC基板上のGaNの高コストと小径は、大規模な商用アプリケーションに反しています。直径の大きいGaN-on-Siは、低コストであるため、有望な選択肢と見なされています[19、20、21、22]。したがって、シリコン基板上のPJダイオードの性能は研究する価値があります。
この作業では、ダブルヘテロ接合(DJ)を備えたGaN / AlGaN / GaN-on-Siショットキーバリアダイオードを提案し、実験的に実証しました。分極接合効果は、シミュレーションと実験によって確認されています。アノード電極とカソード電極の間のフラットな電界(電界)が実現されます。ショットキートレンチをエッチングするICPプロセスは、低い逆リーク電流と低い V を実現するように最適化されています。 オン 優れたエッチング均一性を備えています。オーミック接触プロセスは、カスタマイズされたエピタキシャル層(45 nm GaNトップ)に基づいて、低い接触抵抗(2DEGの場合)を実現するようにも最適化されています。したがって、11μm L のSBDでは1109Vの絶縁破壊電圧が達成されます。 AC バリガの性能指数(FOM)は1051 MW / cm 2 。温度依存性と動的 R ON、SP パフォーマンスも調査されます。
メソッドと実験
エピタキシャル層は、3.5μmのGaNバッファ層、150 nmのGaNチャネル層、1 nmのAlN中間層、45nmのAlからなる6インチのp型シリコン上に有機金属化学蒸着によって成長させました。 0.25 Ga 0.75 Nバリア層、および下から上への45 nmGaNトップ層。 GaNトップ層には、35nmのp-GaN層と10nmのドープされていないGaN層が含まれます。与えられたAlGaNの厚さが45nmの場合、2DHG密度はGaNトップの厚さの増加とともに増加します[22]。厚いGaNトップ層は高密度2DHGに不可欠ですが、オーミック接触抵抗が低くなります(2DEGの場合)。提案されたダブルヘテロ接合ショットキーバリアダイオード(DJ SBD)の概略図を図1aに示します。 SBDの製造は、Cl 2 によるメサの分離から始まりました。 / BCl 3 300 nmの深さまでのベースの誘導結合プラズマ(ICP)エッチング。次に、低損傷ICPエッチングプロセスでオーミックトレンチとショットキーアノードトレンチを形成しました。オーミックトレンチとショットキーアノードトレンチの深さはそれぞれ50nmと90nmであり、これは原子間力顕微鏡(AFM)を使用して確認されました。 85°Cで15分間のテトラメチルアンモニウムヒドロキシド(TMAH)溶液を導入して、エッチング後の残留物を除去し、エッチングプロセスの終了後にトレンチの側壁を変更しました[23]。次に、N 2 で400°Cで10分間のアニーリング アンビエントを実施しました。続いて、オーミックカソードは、電子ビーム蒸着されたTi / Al / Ni / Au(20/140/55/45 nm)によって形成され、N 2 中で870°Cで35秒間アニールされました。 周囲、接触抵抗( R C )0.49Ω・mm。最後に、アノード金属と相互接続がNi / Auによって堆積され、製造フローが完了しました。デバイスはさまざまな L を備えていました AC 7から11μmまで。図1bは、ICPと金属蒸着後のアノードの高解像度断面TEM画像を示しており、層構造がはっきりと観察されました。
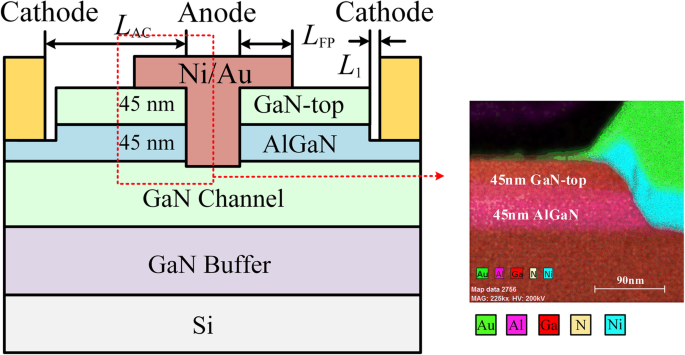
a 提案されたダブルヘテロ接合AlGaN / GaNSBDの断面と主な製造プロセス。 L AC はアノードからカソードまでの長さです。 L FP および L 1 それぞれ1μmと2μmです。 b ICPおよび金属堆積後のアノードのHR-TEM画像
2DEGは、AlGaN / GaN界面に沿った正の分極電荷によって誘導されます。上部のGaN / AlGaN界面は負の分極電荷を持っているため、上部の界面で2DHGを生成します[15]。ドリフト領域とカソードの間のギャップ( L 1 )は、図2に示すように、穴の電流経路を削減するために使用されます。 L の影響のみを調査しました。 1 元のレイアウト設計の制限により、順方向および逆方向のブロッキング特性が2〜3μmになります。 V オン および R ON、SP L であるため、変化はありません 1 ショットキー接触と電子電流経路には影響しません。さらに、BVは L の増加とともにわずかに減少します 1 ドリフト領域が短くなっているためです。順バイアス下でのDJSBDの動作メカニズムは、従来のSBDとほぼ同じであり、2DHGがカソードからアノードへの電子電流経路にほとんど影響を与えないことを意味します。逆バイアス電圧が増加すると、2DEGと2DHGは完全に消耗します。分極接合を形成する固定された正および負の分極電荷が残っています。その結果、カソードとアノードの間に平坦な電界分布が得られます(図3)。
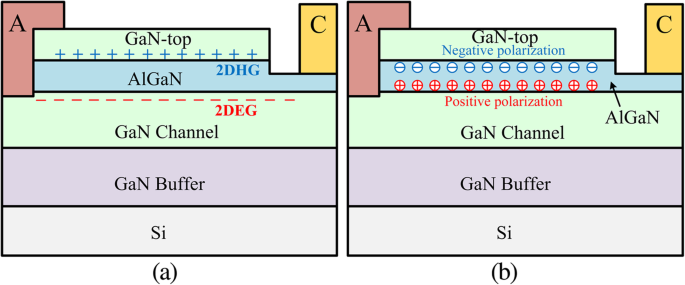
DJSBDの動作メカニズム分析 a ゼロバイアスと b 逆バイアス

TCADシミュレーションによるAlGaN / GaNチャネルヘテロ界面に沿った電界分布。 Alの割合は0.25と定義されています。バッファ層の正味アクセプター(ディープレベル)密度は、1.5×10 16 に設定されています。 cm -3 エネルギー準位は、伝導帯の最小値より0.45eV低くなっています。 AlGaN / GaN界面のアクセプター密度は6×10 12 に設定されています。 cm -3 エネルギー準位は伝導帯の最小値より0.23eV低い
図3に示すように、破壊特性と分極接合メカニズムは、Synopsysの2-D SentaurusTCADによって確認されました。シミュレーションでは、バンドギャップの狭まり、分極、電子/正孔の移動度、衝突電離、SRHの再結合など、いくつかの重要な物理現象を説明しました。
2DHGまたは2DEGの密度と移動度の値を決定するためにホール効果測定が採用されました[22]。測定は、室温でヴァンデルパウ法によって実施された。参考文献に従って2DHGを測定するには。 [17]、ホール測定サンプルはNi / Auオーミックコンタクトで製造されました。 2DHGの密度と移動度は9×10 12 でした。 cm −2 と15cm 2 それぞれ/ Vs。 2DEGは、凹型GaNトップとTi / Al / Ni / Auオーミックコンタクト(2DEG用)で製造された部分的にAlGaNを備えたサンプルによって測定されました。 2DEGの密度と移動度は8.5×10 12 でした。 cm −2 と970cm 2 それぞれ/ Vs。ホール測定では、100 cm 2 を超えると、ホール移動度はバルク移動度よりもはるかに低いことが示されました。 /Vs。移動度の低下は、MOCVD成長中のp-GaNからドープされていないGaNへのMgの拡散に起因していました。
結果と考察
測定された I-V さまざまな L を持つSBDの前方特性 AC 図4aおよびbにプロットされています。ターンオン電圧( V オン )は0.68 Vで、わずかな変動は0.02 Vです。SBDの理想係数とバリア高さは、それぞれ1.44±0.15と0.76±0.04eVと計算されます。図4aは、183 mA / mmおよび144mA / mmの高い順方向電流密度(@順方向バイアス2.5 V)および0.642および1.17mΩcm 2 のオン抵抗を示しています。 L で達成されます AC =それぞれ7および11μm。さらに、優れたオン/オフ電流比〜10 10 図4bに示すように得られます。サブスレッショルドスロープ(SS)は63.0 mV / decで、理想的なSS(59.6 mV / dec)に近いです。
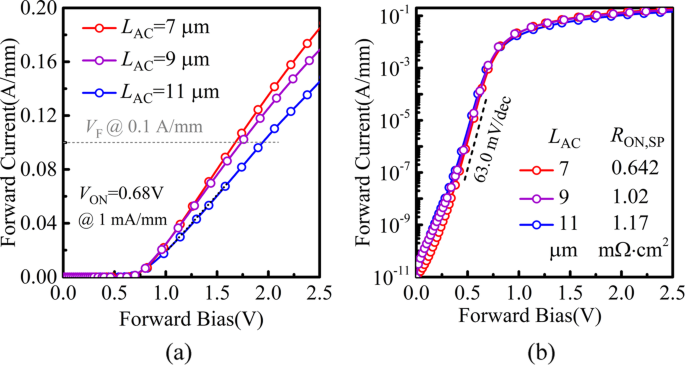
測定された順方向バイアス I-V a のDJSBDの特徴 線形および b 異なる L の片対数スケール AC
図5aは、測定された逆ブロッキング I-V を示しています。 さまざまな L を備えたSBDの特性 AC 300Kで。異なる L のデバイスの絶縁破壊電圧 AC は、1 mA / mmのリーク電流で、それぞれ803 V、940 V、および1109Vです。シミュレーション中、2DEGと2DHGの密度は同じであると想定されています。ただし、実験結果は、2DHGの密度(9×10 12 )を示しています。 cm −2 )は2DEGよりもわずかに高い(8.5×10 12 cm −2 )。オフ状態での固定された正と負の分極電荷の違いは、電荷バランスに影響を与え、したがって絶縁破壊電圧を低下させます。 L の影響 AC BVと R ON、SP 図5bに示します。 BVと L の間のほぼ線形の関係 AC が得られ、ドリフト領域の比較的平坦な横方向電界を意味します。分極接合効果により、デバイスは高いバリガの性能指数を示します(FOM =BV 2 / R ON、SP )1051 MW / cm 2 (@ L AC =11μm)。
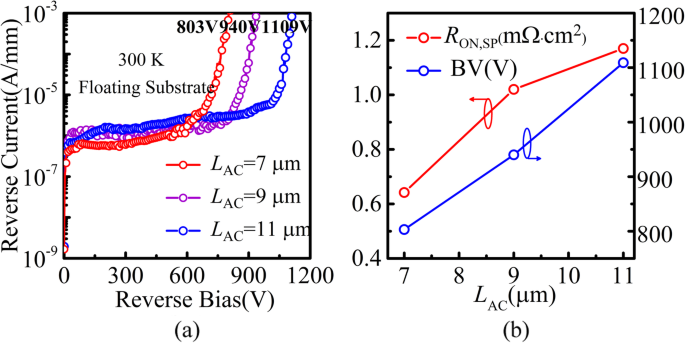
a 測定された逆ブロッキング I-V L が異なるDJSBDの特性 AC ( b ) R ON、SP L の関数としてのBV AC
エッチングプロセスは、高品質のショットキーインターフェースとオーミック接触に不可欠です。図6aは、ICPエッチング(@ 5°C)およびTMAH溶液後の凹型トレンチの表面形態を示しています。エッチング速度は約4.9nm / minで、最終的に選択されるレシピはCl 2 です。 4 sccm、ICPパワー50 W、RFパワー15W。二乗平均平方根(RMS)粗さは0.244 nm、スキャン領域は2×2μm 2 。
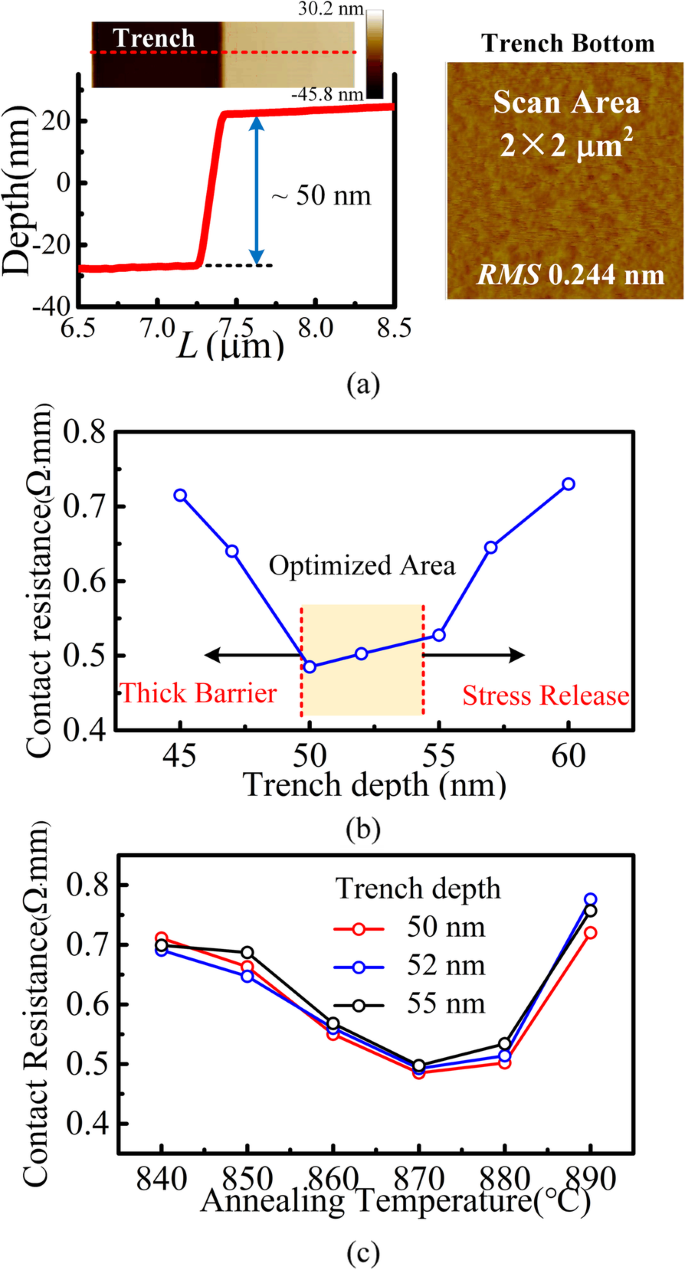
a ICPエッチング後のトレンチのAFM形態。 b TLMテストによるオーミック接触抵抗に対するエッチング深さの影響。 c トレンチ深さが50〜55nmのアニーリング温度の関数としての接触抵抗。アニーリング時間は35秒でした
カスタマイズされたエピタキシャル層には45nmのGaNトップ層と45nmのAlGaN層が含まれているため、オーミック接触(2DEGの場合)プロセスは従来のSBDとは異なります。 GaNトップ層とAlGaNバリア層の両方を凹ませないと、オーミック金属と2DEGの間にポテンシャル障壁があるため、アニーリングによって低い接触抵抗を実現することは困難です。ただし、バリアが過度に凹んでいる場合、応力の解放により2DEG濃度が低下します。オーミック接触抵抗を低減するために、追加のプロセスが採用されています。サンプルの表面は、堆積前にネイティブ酸化物層を除去するためにHCl溶液で処理されます。また、プラズマ表面処理を採用しています(ICPパワー50 W BCl 3 10 sccm 3 min)表面ドナー状態を導入します[24]。図6bは、接触抵抗のトレンチ深さへの依存性を示しています。最適化された深さは50〜55nmで得られます。 Ti / Al / Ni / Au接点の高温ラピッドサーマルアニーリング(RTA)を図6cで調べます。アニーリング温度は840〜890°Cで、870°Cの接触抵抗が最も低くなります。高温、すなわち870℃でのアニーリングは、Ti /窒化物界面でのTiNの形成を助長します。ただし、温度が高くなると(たとえば、890°C)、AuとAlの相互拡散が増加し、良好なオーミック接触の形成に不利になります。
図7a–cは、 V を含む静的特性の統計プロットを示しています。 オン 、 V F 、およびBV。データは、 L を使用して72のSBDから抽出されます。 AC 3つの別々のプロセス実行で製造された7、9、および11μmの。デバイスは、安定した順方向ターンオン特性と V を示します オン L とは独立しています AC 、 V オン 主にSchottkyの連絡先によって決定されます。低損傷のICPエッチングプロセス、正確に制御されたトレンチ深さ、および高品質のショットキーインターフェースは、 V の優れた均一性に貢献します。 オン および V F 。さらに、 L の増加に伴い AC (7から11μm)、提案された構造で観察されたBVの単調な増加(〜100 V /μm)があります。図7dは、 V のヒストグラム統計を示しています。 オン 72台のデバイスの場合、平均値は0.68 Vで、標準値は0.02Vと小さくなっています。

a の統計プロット ターンオン電圧、b順方向電圧、および c L を使用して72個のSBDから抽出された絶縁破壊電圧 AC 3つの別々のプロセス実行で製造された7、9、および11μmの。 d V の分布 オン 72台のデバイス用
逆特性と順特性の温度依存性を図8で評価します。図8aに示すように、周囲温度が300から475 Kに上昇すると、 R が上昇します。 ON、SP 1.94倍。
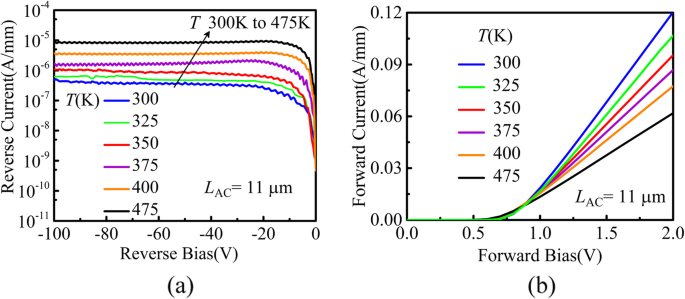
a 逆リーク電流と b さまざまな温度でのDJSBDの前方特性
DJ SBDの動的特性は、AgilentB1505Aパワーデバイスアナライザによって測定されます。アノードパルス静止バイアスポイントは、-10 V、-20 V、-30 V、-40 V、-70 V、および-100 Vに設定され、アノードパルスの幅と周期は0.5 ms / 500msです。図9bは、動的な R を示しています。 ON、SP 応力電圧の関数として。動的な R ON、SP 100 Vの予備応力電圧でも、逆応力がない場合の1.18倍であり、参考文献に匹敵します。 [8]。動的 R の限定的な増加 ON、SP インターフェイス状態の削減に貢献します。動的 R の劣化 ON、SP さらに作業が必要です。
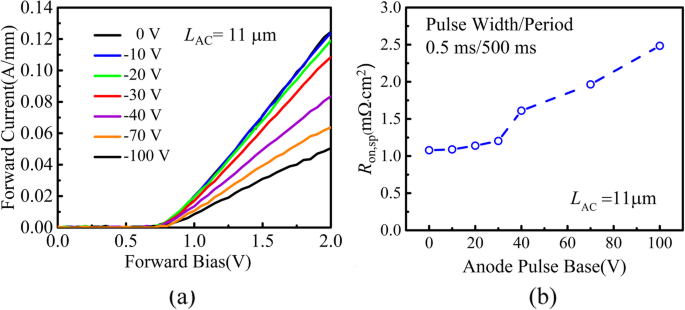
a I-V パルス測定時の特性。 b 抽出された R ON、SP 対パルス幅/周期=0.5 ms / 500 ms
のアノードパルスベース図10は、BVと R のベンチマークプロットを示しています。 ON、SP Si / SiC /サファイア基板上のGaNパワーダイオードの場合[8、10、22、25、26、27、28、29、30、31]。 L で提案されたデバイス AC 11μmのBVは、対応する R で1109VのBVを示します。 ON、SP 1.17mΩcm 2 、1051 MW / cm 2 の高いバリガのFOMにつながります 。この値は、Si基板上のラテラルGaNパワーダイオードの中で最良の結果です。
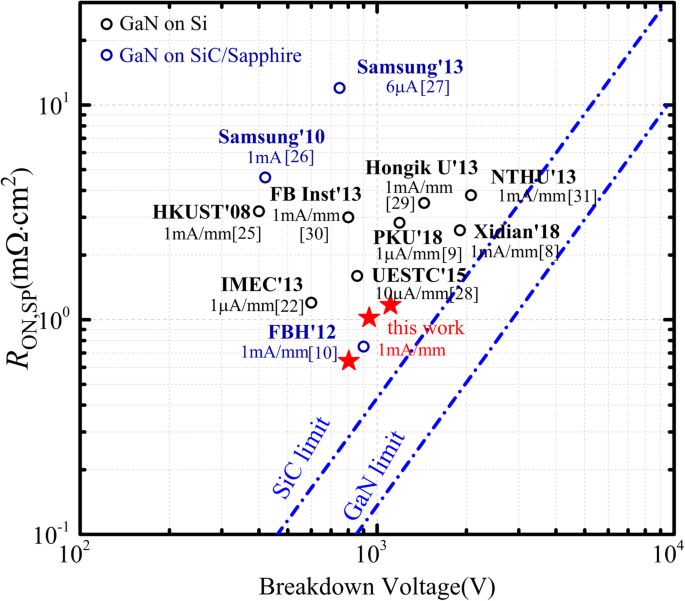
BV対 R のベンチマークプロット ON、SP SiC /サファイア/ Si基板上のGaNパワーダイオードの特性。故障を定義するために使用される逆リークも示されています
結論
性能指数の高いダブルヘテロ接合GaN / AlGaN / GaN-on-SiSBDが製造されます。低損傷のICPエッチングプロセスにより、提案されたデバイスのオーミック接触とショットキー接触が最適化されます。したがって、低い V オン 0.68 Vで、均一性が高く、 R が低い ON、SP 1.17mΩcm 2 L のデバイスで取得されます AC 11μmの。 1051 MW / cm 2 の高いバリガのFOM 分極接合効果により達成されます。高性能と低コストのGaN-on-Siテクノロジーは、将来の電力アプリケーションに大きな可能性を示します。
データと資料の可用性
この調査中に生成または分析されたすべてのデータは、この記事に含まれています。
略語
- SBD:
-
ショットキーバリアダイオード
- 2DEG / 2DHG:
-
二次元電子/正孔ガス
- MOCVD:
-
有機金属化学蒸着
- ICP:
-
誘導結合プラズマ
- TEM:
-
透過型電子顕微鏡
- AFM:
-
原子間力顕微鏡
- BV:
-
絶縁破壊電圧
- R ON、SP :
-
特定のオン抵抗
- V オン :
-
ターンオン電圧
- FOM:
-
性能指数
ナノマテリアル
- AlGaN / GaNHEMTの表面電位と2DEGに及ぼす表面状態とアルミニウムモル分率の影響
- 異なる回転角のエンクロージャー内のTiO2-水ナノ流体の安定性と自然対流に関する実験的研究
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- RGOと3次元グラフェンネットワークが高性能でTIMを共同修正
- らせん状溝管内のTiO2-水ナノ流体の流れと熱伝達特性に関する実験的研究
- 高度に圧縮耐性のあるスーパーキャパシタ電極としての超弾性と高静電容量を備えたグラフェン/ポリアニリンエアロゲル
- 肥厚性瘢痕を治療するためのCO2フラクショナルレーザーと組み合わせた5-フルオロウラシルカプセル化エトソームの実験的研究
- パワーエレクトロニクスアプリケーション用の超広帯域Ga2O3半導体ベースのショットキーバリアダイオードの概要
- 機械的に剥離したβ-Ga2O3薄膜上のMo / AuSchottky接触の実験的および理論的研究
- Geドープ垂直GaNショットキーバリアダイオードの回復性能
- 高ねじれ角と低ねじれ角の利点と欠点



