空孔を有する欠陥のある単分子層WSe2の電子的および磁気的性質
要約
密度汎関数理論に基づく第一原理法を採用することにより、欠陥のある単分子層WSe 2 の構造的、電子的、および磁気的特性を研究しました。 空室があり、欠陥のある構成に対する外部ひずみの影響があります。私たちの計算では、2つのW原子の空孔(V W2 )および1つのW原子とその近くの3対のSe原子空孔(V WSe6 )両方とも単分子層WSe 2 に磁性を誘導します 磁気モーメントが2および6μ B 、 それぞれ。磁気モーメントは、主に空孔の周りの原子によってもたらされます。特に、単層WSe 2 V W2 を使用 ハーフメタリックです。さらに、1つのSeと1つのW原子の空孔(V Se 、V W )、2つのSe原子空孔(V Se-Se )、および同じ層の空孔(V WSe3 )上の1つのW原子と近くの3つのSe原子 )ドープされた単分子層WSe 2 非磁性半導体のままです。しかし、空孔の周りのWdおよびSep軌道に起因する不純な電子状態は、フェルミ準位の周りに位置し、エネルギーギャップを狭めます。一方、私たちの計算によると、0〜7%の引張ひずみは、欠陥のある単分子層WSe 2 の電子特性を操作するだけではありません。 エネルギーギャップを狭めることで空孔を確保しますが、V W の磁気モーメントも制御します。 -、V W2 -、およびV WSe6 ドープされた単分子層WSe 2 。
はじめに
ギャップレスグラフェン[1、2]とは異なり、バンドギャップが1〜2 eVの半導体遷移金属ジカルコゲナイド(TMD)単層[3,4,5,6]は、触媒、エレクトロニクス、オプトエレクトロニクスの分野で優れた利点があります。それらのユニークな化学的、光学的、および電子的特性[3,4,5,6,7,8,9]。特に、単層WSe 2 は半導体であり、直接バンドギャップは〜1.6 eVです[4、10、11、12]。さらに、そのキャリア移動度は約250 cm 2 です。 / Vであり、オン/オフ比が10 6 より高い 室温で[13]。さらに重要なのは、単層WSe 2 は、高仕事関数の金属(Pd)が接点であるp型伝導挙動を示す最初のTMDです[13]。これらの新しい特性のため、単層WSe 2 将来のエレクトロニクスおよびオプトエレクトロニクスの有望な候補として広く研究されてきました[4、6、13、14、15、16]。ただし、単層WSe 2 非磁性であるため、磁性に関連する他の多くの分野での用途が制限されます。
以前の研究[17、18、19、20、21、22、23、24、25]に基づくと、構造上の欠陥は、機械的、電子的、および磁気的特性に大きく影響します。たとえば、点欠陥と空孔欠陥は、グラフェン[19、20]、MoS 2 に磁性を導入します。 単分子層、およびBaTiO 3 (001)薄膜[21,22,23]、それぞれ。ウーら単層WSe 2 のデバイス伝送性能に対する欠陥の影響を研究しました ab initio計算を実行することにより、電界効果トランジスタ(TFST)をトンネリングします。これは、高性能TFETを取得するために欠陥を適切に設計できることを示しています[25]。一方、成長過程の不完全性により、成長したままの2D材料に構造欠陥が見つかりました[19、20、26、27、28]。たとえば、点欠陥などの固有の構造欠陥は、成長したままの単分子層WSe 2 で顕著になります。 [26]。
実際、電子ビーム[29]、イオンビーム[30]、高エネルギーレーザーの高エネルギー粒子による照射、および化学エッチング[31、32]を含む構造工学手法は、2D材料に欠陥を誘発する効果的な手法であり、原子構造を変更するために使用されます。したがって、単分子層WSe 2 の特性に対する空孔などの構造欠陥の影響を研究することは、重要であるだけでなく現実的でもあります。 、新しい機能を提供する可能性があります。さらに、2D材料は、単層MoS 2 で実証されているように、強力な塑性変形能力により、破壊前に大きなひずみに耐えることができ、固有の限界である10%を超えて伸ばすことさえできます。 [33、34]。したがって、ひずみ工学は、2D材料の特性を調整し、関連するアプリケーションで関連するパフォーマンスを向上させるために広く使用されています[11、17、33、34、35、36、37、38、39]。ヤンらの研究によると、ナノスケールの局所ひずみは、光学バンドギャップを変更し、単分子層ReSe 2 の電子的および磁気的特性を変化させます。 [38]。特に、非磁性WS 2 単分子層は、二軸ひずみが加えられると強磁性になり、最大磁気モーメントは4.85μ B に達します。 [39]。
この作業では、単分子層WSe 2 の電子特性に対する空孔欠陥と引張ひずみの影響を体系的に調査しました。 。単一原子空孔、二重原子空孔、および4原子と7原子の大きな空孔のいくつかの空孔欠陥を計算しました。すべての空孔欠陥が単分子層WSe 2 の電子特性を変化させることがわかりました。 、V W2 のみ およびV WSe6 空孔は2および6μ B の磁性を導入します 、 それぞれ。さらに、単層WSe 2 V W を使用 空孔は、外部引張ひずみの下で非磁性から磁性に変換されます。さらに重要なことに、外部の2軸ひずみは、エネルギーギャップだけでなく、V W の磁気モーメントも効果的に変調します。 -、V W2 -、およびV WSe6 ドープされた単分子層WSe 2 。私たちの計算は、欠陥のある単分子層WSe 2 潜在的な単層磁性半導体として空孔がある。
計算方法
本研究のすべての計算は、密度汎関数理論(DFT)に基づくVienna Ab initio Simulation Package(VASP)を採用することによって実行されました[40、41]。 Perdew–Burke–Ernzerhof(PBE)法を使用して、電子交換相互作用を計算しました[42]。イオン-電子および電子-電子の相互作用は、プロジェクター拡張波(PAW)法と平面波基底関数系によって計算されました[43、44]。平面波基底関数系のカットオフエネルギーは300eVに設定され、最初のブリルアンゾーンはMonkhorst-Pack法[45]に基づいて3×3×1kメッシュでサンプリングされました。周期表モデルの隣接する画像間の相互作用を取り除くために、単分子層の上の垂直方向に沿って15Åの真空空間が追加されました。各イオンにかかるすべての力が0.02eV /Å未満になるまで構造緩和が実行され、総エネルギーの収束基準は10 -4 に設定されました。 eV。空孔欠陥をドープした単分子層WSe 2 に二軸引張ひずみを加えた 、εによって計算されました =( c − c 0 )/ c 0 ×100%、ここで c および c 0 歪んだ自由単分子層WSe 2 の格子定数です。 それぞれ。
結果と考察
単分子層WSeの原子構造と電子特性 2
単分子層WSe 2 の最も安定した結晶構造 、1H-WSe 2 として示されます 、を図1aに示します。これは、Se-WSeのサンドイッチ層を示しています。 1H-WSe 2 で 、W原子とSe原子は六角形のシートの副格子を占め、下層のSe原子は上層のSe原子の真下にあります。計算されたW-W結合長は3.31Å、W-Se結合長は2.54Åであり、以前の結果とよく一致しています[10、11]。図1bに示すように、1H-WSe 2 の計算された電子バンド構造と状態密度(DOS) 1H-WSe 2 は、1.54eVの直接バンドギャップを持つ非磁性半導体です。私たちの計算結果は、以前の1.55eVの結果とよく一致しています[12]。より正確なバンドギャップを得るために、Heyd–Scuseria–Ernzerh(HSE06)[46]法を採用して電子バンド構造を計算しました。 1H-WSe 2 のエネルギーギャップ HSE06法で計算すると2.0eVです。

a 単分子層WSe 2 の原子構造の上面図と側面図 。 b 単分子層WSe 2 の電子バンド構造と状態密度(DOS) 。青、赤、タンジェリンのボールは、それぞれ最上層と最下層のワンドSe原子を表しています。フェルミ準位は0eV
に設定されています欠陥のある単分子層WSe 2 の磁気的および電子的特性 空室あり
単分子層WSe 2 の7つの空孔欠陥構成を検討しました。 本研究では。これらは、1つのSe原子空孔(V Se )を含む単一原子空孔です。 )、1つのW原子空孔(V W )、およびV Se-Se の2つの原子空孔 、V Se2 、およびV W2 。 2つのSe原子の空孔V Se-Se V Se2 が削除されている間、互いに真下または真上にある2つのSe原子が削除されることを意味します / V W2 空孔とは、隣接する2つのSe / W原子が除去されることを意味します。また、V WSe3 の大きな欠員についても検討しました。 およびV WSe6 。 V WSe3 同じ層上の1つのW原子と近くの3つのSe原子の空孔を示します。V WSe6 1つのW原子と近くの3対のSe原子の空孔を示します。単層WSe 2 の最適化された構造 V Se の欠員あり 、V Se-Se 、V Se2 、V W 、V W2 、V WSe3 、およびV WSe6 図2の挿入図に示されています。ご覧のとおり、欠陥のある単層WSe 2 の現在の研究では、5×5×1のスーパーセルが使用されました。 。

単分子層WSe 2 の最適化された原子構造 V Se を使用 、V Se-Se 、V Se2 、V W 、V W2 、V WSe3 、およびV WSe6 欠員。青、赤、タンジェリンのボールは、それぞれ最上層と最下層のW原子とSe原子を表しています。
表1は、欠陥のある単分子層WSe 2 の結果をまとめたものです。 V Se の欠員あり 、V Se-Se 、V Se2 、V W 、V W2 、V WSe3 、およびV WSe6 。 V Se の空孔の周りのW-W距離がわかります 、V Se-Se 、およびV Se2 単層WSe 2 の元のW-W距離と比較して、それぞれ0.23、0.52、および0.24Å減少します。 、これは、Se原子の空孔の周りのW原子が互いに近づくことを意味します。さらに、V W の空孔の周りのW-W距離 、V W2 、およびV WSe3 0.02、0.01、および0.06Åだけわずかに増加します。そして、それらの単一原子空孔の周りのW-W距離(V Se / V W )は、2つの原子の空孔(V Se2 )の周りの対応物とほぼ同じです。 / V W2 )。より大きな空室の場合V WSe6 ドープされた単分子層WSe 2 、空孔の角にある隣接するW原子間のW-W距離は0.58Å減少しますが、空孔の端にあるW-W距離は0.44Å増加します。 7つの空孔形状の形成エネルギーは、次の方法で計算されます。
$$ {E} _ {\ mathrm {form}} ={E} _ {\ mathrm {van} \ hbox {-} {\ mathrm {WSe}} _ 2} \ hbox {-} {E} _ {{\ mathrm {WSe}} _ 2} + \ Sigma {n} _ {\ mathrm {i}} {u} _ {\ mathrm {i}} $$\({E} _ {\ mathrm {van} \ hbox {-} {\ mathrm {WSe}} _ 2} \)と\({E} _ {{\ mathrm {WSe}} _ 2} \)は合計です単層WSe 2 の5×5×1スーパーセルのエネルギー 空室欠陥がある場合とない場合、および u i および n i (i =Se、W)は、除去された i の化学ポテンシャルと数です。 原子。表1にリストされているように、7つの空孔について計算された形成エネルギーは、V Se 、単一のSe原子の空孔は、WSe 2 で頻繁に観察される必要があります。 単層、単層MoS 2 の以前の結果と一致 [17、21]。 V Se-Se の2つのSe原子空孔について およびV Se2 、V Se2 の形成エネルギー V Se-Se より少し高いです 、V Se-Se V Se2 よりもエネルギー的に好ましい 。したがって、次の調査では、V Se-Se のみ 2つのSe原子空孔として研究されています。さらに、大きなサイズの空孔の形成エネルギーはより高く、これは特定の種類の構造工学技術によって生成される可能性があります[29、30、31]。
次に、欠陥のある単分子層WSe 2 の電子特性を調べました。 V Se の欠員あり 、V Se-Se 、V W 、V W2 、V WSe3 、およびV WSe6 。図3は、6つの空孔がドープされた単分子層WSe 2 の電子バンド構造を示しています。 。図3aに示すように、V Se ドープされた単分子層WSe 2 半導体のままですが、ギャップ領域にある空孔欠陥から生成された余分な電子状態が明らかにあります。したがって、V Se のエネルギーギャップ ドープされた単分子層WSe 2 単層WSe 2 と比較して1.18eVに減少 。 V Se-Se の電子バンド構造 ドープされた単分子層WSe 2 V Se と同様です ドープされた単分子層WSe 2 、そしてそれらのエネルギーギャップは近いです。 V W -およびV WSe3 ドープされた単分子層WSe 2 図3cとeに示すように、半導体機能も維持されていますが、エネルギーギャップはそれぞれ0.18と0.76eVとはるかに小さくなっています。上記の空孔欠陥とは異なり、多数派と少数派のスピンチャネルはV W2 に対して非対称に分布しています。 -およびV WSe6 ドープされた単分子層WSe 2 図3dおよびfに示すように。 V W2 の場合 ドープされた単分子層WSe 2 、多数のスピンチャネルはフェルミ準位を横切りますが、少数のスピンチャネルは0.19 eVのエネルギーギャップで半導体を維持し、その磁気モーメントは2.0μ B です。 、V WSe6 ドープされた単分子層WSe 2 は、6.0μ B の磁気モーメントを持つ磁気半導体です。 。

単分子層WSe 2 の電子バンド構造 a で V Se 、 b V Se-Se 、 c V W 、 d V W2 、 e V WSe3 、および f V WSe6 欠員。青と赤の線は、それぞれ多数派と少数派のスピンチャネルを表しています。フェルミ準位は0eV
に設定されていますまた、6つの空孔をドープした単分子層WSe 2 の部分状態密度(PDOS)も計算しました。 それらの電子的性質をさらに研究する。図4は、V Se の不純な電子状態を示しています。 -およびV Se-Se ドープされた単分子層WSe 2 は主に伝導帯領域に位置し、主に空孔付近のW原子のd軌道に由来し、空孔周辺のSe原子のp軌道にはほとんど由来しません。逆に、V W の不純な電子バンド -およびV WSe3 ドープされた単分子層WSe 2 伝導帯領域にあるだけでなく、価電子帯領域にも分割されています。 V W の場合 空孔、フェルミ準位近くの伝導帯は主にd(d xy 、d x2 およびd z2 )空孔周辺のW原子の軌道、およびフェルミ準位付近の価電子帯は、主に空孔周辺のSe原子のp軌道に由来します。 V W との比較 ドープされた単分子層WSe 2 、V WSe3 の不純な電子状態 ドープされた単分子層WSe 2 フェルミ準位からさらに離れています。フェルミ準位付近の伝導帯は、Se p z の両方に由来します。 フェルミ準位付近の価電子帯は主に空孔周辺のWd軌道からのものであるのに対し、空孔周辺の軌道とWd軌道。さらに、Wd軌道と隣接するSep軌道は強く相互作用し、フェルミ準位付近で混成状態になります。ハーフメタリックV W2 の場合 ドープされた単分子層WSe 2 、フェルミ準位の伝導帯交差は主にSe p x に由来します 軌道、およびフェルミ準位付近の価電子帯は主にW d(d x2 およびd z2 )軌道。磁性半導体V WSe6 ドープされた単分子層WSe 2 、フェルミ準位付近の伝導帯と価電子帯は、どちらも空孔付近のWd軌道に由来します。

単分子層WSe 2 の部分状態密度(PDOS) a で V Se 、 b V Se-Se 、 c V W 、 d V W2 、 e V WSe3 、および f V WSe6 欠員。 NN_WとNN_Seは、それぞれ空孔の周りに最も近い隣接するW原子とSe原子を表します。フェルミ準位は0eV
に設定されています単層WSeの電子的および磁気的特性 2 引張ひずみ下で空孔欠陥がある
さらに、空孔をドープした単分子層WSe 2 の電子的および磁気的特性を研究しました。 ひずみは2D材料の電子構造と磁気モーメントを調整する効果的な方法であるため、2軸ひずみの下で。最初に1H-WSe 2 を調査しました 二軸ひずみ下の単分子層。私たちの計算結果は、0〜7%の範囲の二軸ひずみが単分子層WSe 2 に磁性を誘発しないことを示しています。 、単層MoS 2 と同様 [34、36]。さらに、単層WSe 2 半導体の性質を維持し、7%のひずみでエネルギーギャップが0.5 eVに減少し、加えられた引張ひずみが増加するにつれてW-W結合長が増加します。
次に、空孔をドープした単分子層WSe 2 を調べました。 0〜7%の引張ひずみの下で。図5は、V Se の電子バンド構造を示しています。 -、V Se-Se -、V W -、V W2 -、V WSe3 -、およびV WSe6 ドープされた単分子層WSe 2 1%、4%、および7%の2軸ひずみの下で。手付かずのWSe 2 と同様 単層、V Se -、V Se-Se -、およびV WSe3 ドープされた単分子層WSe 2 すべてが0〜7%の二軸ひずみの下で半導体機能を維持し、伝導帯の最小値は、加えられた引張ひずみが増加するにつれてフェルミ準位に近づいています。 V W の場合 ドープされた単分子層WSe 2 1%を超える二軸ひずみの下では、多数派と少数派のスピンチャネルが非対称に分布します。さらに、V W2 -およびV WSe6 ドープされた単分子層WSe 2 どちらも1〜7%のひずみで磁気半導体の特徴を示します。 V Se -、V Se-Se -、およびV WSe3 ドープされた単分子層WSe 2 図6aに示すように、半導体機能を0〜7%の2軸ひずみの下で維持し、2軸ひずみがエネルギーギャップを効果的に制御します。 V Se のエネルギーギャップ -およびV Se-Se ドープされた単分子層WSe 2 両方とも1.1から0.5eVに減少しますが、V WSe3 のエネルギーギャップは ドープされた単分子層WSe 2 は比較的小さく、0.76から0.3eVに減少しました。一方、V W のエネルギーギャップ -、V W2 -、およびV WSe6 ドープされた単分子層WSe 2 0〜7%の二軸ひずみ下で0.2eV未満です。

単分子層WSe 2 の電子バンド構造 V Se を使用 、V Se-Se 、V W 、V W2 、V WSe3 、およびV WSe6 1%、4%、および7%の引張ひずみ未満の空孔。青と赤の線は、それぞれ多数派と少数派のスピンチャネルを表しています。フェルミ準位は0eV
に設定されています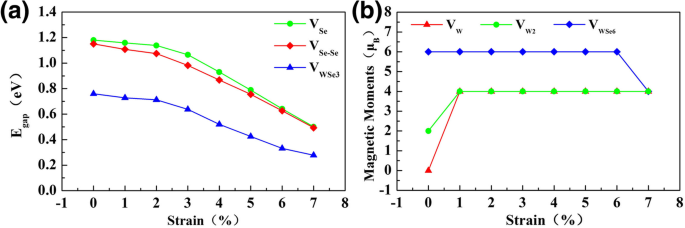
a 単分子層WSe 2 のエネルギーギャップ V Se を使用 、V Se-Se 、およびV WSe3 欠員。 b 単分子層WSe 2 の磁気モーメント V W を使用 、V W2 、およびV WSe6 0〜7%の引張ひずみ下での空孔。
0〜7%の二軸ひずみの下で、V Se -、V Se-Se -、およびV WSe3 ドープされた単分子層WSe 2 図5に示すように、非磁性のままです。対照的に、非磁性V W ドープされた単分子層WSe 2 4μ B の磁気モーメントで磁気を帯びる 1%を超える二軸ひずみ下。図7aに示すスピン分解電荷密度は、磁気モーメントが主に空孔周辺のW原子とSe原子から発生することを示しています。図7bに示すように、V W2 の磁気モーメント ドープされた単分子層WSe 2 主に空孔付近のSe原子に由来し、空孔周辺のW原子にはほとんど由来しません。加えられたひずみが1%より大きい場合、より多くのSe原子がスピン偏極し、4μ B の磁気モーメントが大きくなります。 。 V WSe6 の場合 空孔欠陥、その磁気モーメントは6μ B のままであることがわかります 0〜6%のひずみの下で、その後4μ B に減少します 図6bに示すように7%のひずみで。図7cは、その磁気モーメントが主にV WSe6 の周りの6つのW原子から発生することを示しています。 。加えられたひずみが7%に増加すると、空孔の周りの近くのSe原子はよりスピン偏極しますが、W原子の局所磁気モーメントは減少します。同様に、V WSe6 の総磁気モーメント ドープされたWSe 2 4μ B に減少します 7%のひずみの下で。

単分子層WSe 2 のスピン分解電荷密度 a で V W 、 b V W2 、および c V WSe6 0〜7%の引張ひずみ下での空孔。黄色とシアンの等値面は、それぞれ正と負のスピン密度を表します
結論
要約すると、単分子層WSe 2 のいくつかの空孔欠陥を研究しました。 、単一のSeおよびW原子の空孔を含む(V Se およびV W )、二重のSeおよびW原子の空孔(V Se-Se およびV W2 )、同じ層上の1つのW原子と近くの3つのSe原子の大きな空孔(V WSe3 )、および1つのW原子と近くの3対のSe原子の空孔(V WSe6 )。 V Se -、V Se-Se -、V W -、およびV WSe3 ドープされた単分子層WSe 2 すべてが非磁性半導体機能を完璧なWSe 2 として維持します 単分子層ですが、エネルギーギャップ領域にある不純な電子状態のためにエネルギーギャップが小さくなります。これは、空孔の周りのWdおよびSep軌道に起因し、V W2 およびV WSe6 空孔は単分子層WSe 2 に磁性を誘発しました 磁気モーメントが2および6μ B 、 それぞれ。特に、単層WSe 2 V W2 を使用 空孔は半導体からハーフメタルに変換されます。さらに重要なことに、私たちの計算結果は、外部の二軸ひずみが単分子層WSe 2 の磁性と電子特性を効果的に調整することを示しています。 。
略語
- 2D:
-
二次元
- CVD:
-
化学蒸着法
- DFT:
-
密度汎関数理論
- DOS:
-
状態密度
- HSE06:
-
Heyd–Scuseria–Ernzerhメソッド
- PAW:
-
プロジェクター拡張波法
- PBE:
-
Perdew–Burke–Ernzerhofメソッド
- PDOS:
-
状態の部分密度
- TMD:
-
遷移金属ジカルコゲナイド
- VASP:
-
ウィーンabinitioシミュレーションパッケージ
ナノマテリアル
- セレン化タングステン(WSe2)の特性と用途
- コバルトをドープしたFeMn2O4スピネルナノ粒子の調製と磁気特性
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- ns-Laserによって調製されたブラックシリコン上に酸素をドープしたナノ結晶の電子状態と可視発光
- MnХFe3−XО4スピネルの構造的および磁気的特性に及ぼす接触非平衡プラズマの影響
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- アルカリ金属吸着g-GaN単分子層:超低仕事関数と光学特性
- 自動車 PCB の特性と設計上の考慮事項



