AlGaN / GaNHEMTの表面電位と2DEGに及ぼす表面状態とアルミニウムモル分率の影響
要約
表面トラップの存在は、AlGaN / GaNHEMTの重要な現象です。これらの表面トラップの電気的および物理的特性は、HEMTのバリア層におけるアルミニウムの割合の変化とともに2DEG電子濃度の研究を通じて分析されています。この分析は、深いドナーから浅いドナーまで、2DEGの電子密度の変化率がアルミニウム濃度の変化で飽和する(8%近く)ことを示しています。フェルミ準位よりかなり下の量子ポテンシャルの深さも分析され、表面ドナーがエネルギーが浅いところから深いところに変化すると、アルミニウムのパーセンテージで飽和する(2%近く)ことがわかります。この集合的な効果の背後にある物理学も、バンド図によって分析されます。表面電位に対する表面ドナートラップの影響についても詳細に説明しました。これらの表面状態は、ドナー状態としてモデル化されます。ディープドナー( E C − E D =1.4 eV)から浅いドナー( E C − E D =0.2 eV)10 11 のドナー濃度について、表面トラップが徹底的に研究されています。 〜10 16 cm −2 。この研究では、アルミニウム濃度を5〜50%変動させます。この論文では、表面ドナーの包括的なTCAD研究と、チャネル内の電子濃度およびAlGaN-GaN界面での2DEG形成の分析を初めて紹介します。
<セクションデータ-タイトル=" はじめに ">はじめに
高周波および高出力アプリケーションは、過去30年間に研究されてきたGaN材料の2つの主な特徴です[1、2]。 AlGaN / GaN構造の主な利点の1つは、バリア層に意図的にドーピングしなくても、AlGaN-GaN界面の三角ポテンシャル井戸に2DEGが形成されることです[3、4]。 AlGaN / GaN構造のAlGaN層に自発分極と圧電分極が存在することは十分に証明されています[3]。この分極により、AlGaNバリア層の下部と上部に2枚の反対側の電荷シートが生じます。これらの分極シート電荷だけでは、AlGaN-GaN界面で三角ポテンシャルを形成するのに十分ではありません。これに対処するために、Ibbetson et al 。 [5]は、AlGaN層の表面に存在しなければならない正の電荷シートが存在する必要があることを示唆しました。これらの正電荷は、表面ドナー状態のイオン化によりポップアップします(1.35×10 13 の伝導帯から1.42eV cm −2 )表面で[6]。
Vetury et al 。 [7]は、フローティングゲートとしてポテンシャルプローブを使用して、これらの表面状態の影響を調査しました。 AlGaN / GaN HEMTのDCおよびRF性能に対する表面状態の影響が研究されています[8、9]。ナノメートルスケールのショットキーゲートの振る舞いは、表面ドナー状態によるゲートなし領域での仮想ゲート形成について説明しています[10]。固定表面ドナー状態は、HEMTの自己発熱効果を分析するために使用されます[11]。 Longobardi et al 。 [12]は、AlGaN / GaNMISFETのDC特性に対する表面ドナー状態の影響を研究するために最初のTCADシミュレーションを実行しました。 TCADシミュレーションでこれらの表面ドナー状態をアクティブにするために、Bakerootらは別のモデルを導入しました[13、14]。ドレイン/ソース抵抗は、AlGaN表面のゲートなし領域に仮想ゲートが形成されるため、ゲートバイアスにも依存します。 Pradeep et al 。 [15]は、AlGaN / GaNHEMTの線形領域DC特性に基づいた移動度と抵抗の抽出手順を開発しました。 Meneghesso et al 。 [16]は、表面状態を、AlGaNの表面にある高密度の正孔層を捕捉して2DEGの電子を補償するトラップとして説明しました。 AlGaN層の上部で利用可能な表面ドナートラップは、これらのトラップが負のゲートバイアスを持つ電子によって占有されている場合、デバイスの電気的動作を変更します[17]。表面ドナートラップと2DEG電子の関係も、時間依存の輸送現象を採用することにより、TCADシミュレーションを通じて議論されてきました[18]。さまざまな特性評価手法が検討されてきましたが、Tapajna etal。 [19]は、しきい値過渡法を使用して界面アクセプタートラップを調査しましたが、表面ドナートラップの特性評価はまだ調査されていません。ドナーとしての表面トラップの広範な計算モデリングアプローチも議論されています[20]。 Gucmann et al 。 [21]は、表面ドナーの密度が分極電荷濃度よりも大きい場合、電子がAlGaN-GaN界面に移動して、2DEGをチャネルに発生させると説明しました。
上記の文献は、AlGaN / GaNヘテロ構造の非常に多くの関連する側面を報告していますが、表面ドナーの複合効果(濃度+エネルギー)と2次元電子濃度におけるアルミニウム濃度の寄与を説明していません。アルミニウムの割合が、AlGaNバリア層の分極電荷の主な原因であることは明らかです[3]。
このような効果の適切な物理的理解を提供するために、本研究では以下の調査をカバーしました(i)AlGaNバリア層のアルミニウムのパーセンテージ変化に伴う表面ドナートラップの深部から浅部への変化による2次元電子濃度への影響(ii)表面ポテンシャルに対する表面トラップとアルミニウムの割合の影響、および(iii)AlGaN-GaN界面の三角ポテンシャル井戸に対する表面ドナートラップとアルミニウムの割合の影響。
メソッドセクションとシミュレーションの設定
2次元デバイスシミュレーションは、SynopsysのSentaurusTCADバージョンL-2016.12 [22]を使用して実行されました。図1bに示すように、AlGaN / GaN HEMTヘテロ構造の実験結果[15]を再現することにより、TCADシミュレーションのセットアップを調整しました。

a Alモル分率が28%の2Dシミュレーション構造の概略図。 b 報告された実験結果を再現することによるシミュレーション設定のキャリブレーション[15]
キャリブレーションされたデバイスには、2μmのGaNバッファ層の上部に30nmのAlGaNバリア層があります。ショットキーゲート長( L G )1μmをAlGaNバリア層の上部に対称的に配置します。ゲートからドレイン/ソースまでのゲートなし領域( L GD / L GS )の寸法はそれぞれ2.5 µmで、デバイスの幅は150 µmです。
シミュレーションプラットフォームは、半導体の動作を監視する3つの条件(電子と正孔の連続性条件に加えてポアソン条件)に取り組みます。
自己無撞着なドリフトと拡散(DD)輸送モデルも含まれています。電界とドーピングによる移動度の低下を促進するために、ロンバルディ移動度とフィリップ統一移動度モデルが呼び出されました。さらに、AugerとSRH(Shockley–Read–Hall)の再結合モデルが、Fermi–Dirac統計とともに使用されました。スロットブームモデルがアクティブになり、高濃度にドープされたドレインとソースの拡張領域のバンドギャップが狭くなります。この構造には2つの層があり、AlGaNバリア層のアルミニウムの割合を変更しているため、分極電荷は[3]の式に従って導入されます。
$$ \ left | {\ sigma(x)} \ right | =\ left | {2 \ frac {a(0)-a(x)} {{a(x)}} \ left \ {{e_ {31}(x)-e_ {33} \ frac {{C_ {13}(x )}} {{C_ {33}(x)}}} \ right \} + P _ {{{\ text {SP}}}}(x)-P _ {{{\ text {SP}}}}(0 )} \ right | $$(1)ここで P SP 自発分極、 e 33 および e 31 は圧電係数、 C 33 および C 31 は弾性定数、aは格子定数、 x はアルミニウムのモルパーセントです。
分極電荷の変化±σ AlGaN ( x )アルミニウムの割合を図2aに示します[3]。分極電荷が計算されると、ポアソン方程式を解くことができます。 AlGaN-GaN界面では、伝導帯が急激に変化し、電子が蓄積する狭い(1〜4 nm)三角形のポテンシャル量子井戸を形成します。この量子ポテンシャルは非常に狭いため、状態の密度の低下が支配的になります。シュレディンガー量子方程式は量子ポテンシャルを十分に説明しますが、より大きなHEMTデバイスを解くのは困難です。量子ポテンシャル井戸の振る舞いをキャプチャするために、Sentaurus TCADでeQuantumpotentialモデルを呼び出しました。これは、密度勾配量子補正モデル[23]をアクティブにし、より大きなHEMTデバイス(パワーHEMTデバイス)のシュレディンガー量子方程式と厳密に一致する結果をもたらします。密度勾配量子モデルは、2DEGの電子密度のピーク値を減少させ、ピーク値もAlGaN-GaN界面からシフトします。したがって、これにより界面散乱メカニズムが減少し、チャネル内の移動度が向上します(図2b [20]を参照)。密度勾配量子モデルは、次のような正規密度式に追加の項Λを導入します。
$$ n =N _ {{\ text {C}}} F_ {1/2} \ left({(E _ {{\ text {F}}} --E _ {{\ text {C}}}-\ Lambda) / kT} \ right)$$(2)ここで N C は有効状態密度 F 1 / 2は1次のフェルミ積分です / 2、 E F 電子の擬フェルミエネルギー E C は伝導帯の端であり、 kT 電子の熱エネルギーを表します。 Λは次のように計算されます:
$$ \ Lambda =-\ left({\ left({{{\ gamma \ hbar ^ {2}} \ mathord {\ left / {\ vphantom {{\ gamma \ hbar ^ {2}} {6m_ {n} }}} \ right。\ kern- \ nulldelimiterspace} {6m_ {n}}}} \ right)\ cdot \ left({\ nabla ^ {2} \ sqrt n} \ right)/ \ sqrt n} \ right) $$(3)ここでħ = h / 2 π 、 h プランク定数、 m n は電子の有効質量γです。 (γ =1.28)はフィッティングパラメータであり、 n は電子密度です。

a AlGaNバリア層のアルミニウム濃度に対する分極シート電荷の変化[3]。 b 2DEG電子密度に対する量子捕獲の影響
表面トラップはドナー状態として導入されました(+ σ D )AlGaNバリア層の表面図1aで、シミュレーションは300 Kの温度で実行されました。キャリブレーションは初期アルミニウム濃度28%で行われました。
シミュレーション結果とディスカッション
2DEG密度に対するアルミニウムの割合と表面トラップの影響
2DEG電子密度を調査するために、バイアスをかけずにデバイスをシミュレートしました。 2DEG電子密度に集中している間、ドナー状態のすべてのエネルギーについて、ドナートラップ濃度の特定の値(比較的低い値)まで、電子密度(つまり、Region1)に大きな変化はありません。 2DEG電子密度は、表面ドナー濃度に比例して変化します(Region1からRegion2の間)。表面ドナートラップの特定のしきい値の後も、電子密度(つまり、Region2)に変化は見られません。図3a〜dを参照してください。このメカニズムは次のように説明できます。
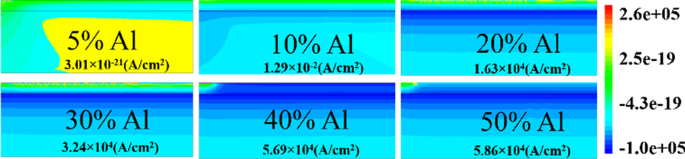
a – d さまざまなアルミニウムの割合に対する2DEGw.r.t表面ドナー濃度とエネルギー(浅い0.2eVから深い1.4eVまで)の電子シート密度の変化。 e デバイス内の異なる電荷分布と電界方向
(i)領域1のAlGaNバリア層の伝導帯は、表面のフェルミ準位とのギャップが大きくなっています。ドナートラップ濃度が低い値から高い値に増加し始めると、遷移期間(Region1からRegion2の間)で、伝導帯は比例してフェルミ準位に向かって移動し始めます。したがって、2DEG濃度は低い値から高い値に増加し始めます。遷移期間(Region1からRegion2の間)では、伝導帯が比例してフェルミ準位に向かって移動し始めるため、ドナーの表面エネルギーもフェルミ準位に向かって移動します。領域2の場合、ドナー濃度がしきい値を超えると、ドナートラップのエネルギーがフェルミ準位を固定するように伝導帯の屈曲が始まります。フェルミ準位のピン止めにより、すべてのドナー状態がイオン化され、2DEG三角量子ポテンシャルに電子が寄与します。ドナー状態のエネルギーがフェルミ準位に固定されると、電子密度に大きな変化は反映されません。 (ii)デバイス内の電荷の中性を見つけるには、2DEGの電子に対抗するために表面ドナー状態が不可欠です。表面ドナー状態が増加すると、電場は表面から2DEG量子井戸に増加し始めます。この電界は、分極シート電荷(±σ)によって生成されるビルトイン電界に対抗します。 AlGaN )。外部電界が内部電界を超え始めたとき(±σによる) AlGaN )、それは表面の伝導帯を下げ、したがって2DEGポテンシャル井戸により多くの電子を提供します。図3eを参照してください。アルミニウムの割合が5%から50%に増加すると、分極シートの電荷密度も比例して増加し、(分極のために)内部電界が高くなります。この内部電界を克服するには、より高濃度の表面ドナートラップが必要です。したがって、遷移領域はシフトされます(10 11 で10から130倍) cm −2 )ドナートラップ濃度の値が高い場合、2DEG電子密度はドナートラップ濃度に比例して変化します(図3a〜d)。表面ドナー(濃度+エネルギー)に対する各アルミニウムの割合の2DEG濃度を図4にプロットします。2DEG電子濃度のパターンは、ドナートラップが浅い(0.2 eV)から離れるとき、アルミニウムのすべての割合で同じです。深部(1.4 eV)まで(図5)、深部から浅部への2DEG電子密度の変化は依然として非常に重要です。アルミニウム濃度が5%の場合、ドナートラップは深い(1.4 eV)から浅い(0.2 eV)になり、ポテンシャル井戸にはあまり寄与しません。分極電荷濃度として(±σ )は10 11 のオーダーです cm −2 5%アルミニウムの場合、図2aを参照してください。これらの分極電荷による電界は、伝導バンドのオフセットをフェルミ準位より低くするのに十分ではないため、AlGaN-GaN界面構造のGaN側に2DEG三角ポテンシャル井戸は形成されません。また、表面ドナートラップの濃度が高くても、図1および2に示すように電子密度の飽和が発生しないことも明らかです。図4aおよび6。これは、図4bに示すように、アルミニウムの割合が10%の場合にも当てはまります。 20%以上の場合、分極電荷(±σ)濃度は10 12 を超えます。 cm −2 。したがって、内部電場は、伝導バンドオフセットをフェルミ準位より下に引っ張るのに十分な大きさであるため、2DEG三角量子ポテンシャルを形成します。図6b、cを参照してください。したがって、アルミニウムの割合が20%以上の場合、2DEG電子密度は〜10 13 に近づきます。 cm −2 図4cに示すように、浅いドナートラップの場合。アルミニウム濃度が20%、30%以上の場合、三角井戸内の電子の寄与は1×10 13 の密度になります。 〜3×10 13 cm −2 。図5a、bは、ドナートラップエネルギーが1.4eから0.2eVに変化したときの三角ウェルの電子密度の変化率を示しています。アルミニウムの割合が5%から50%になると、2DEG濃度の変化は10.89倍から1.08倍に大幅に減少し、30%を超えると飽和状態になります。
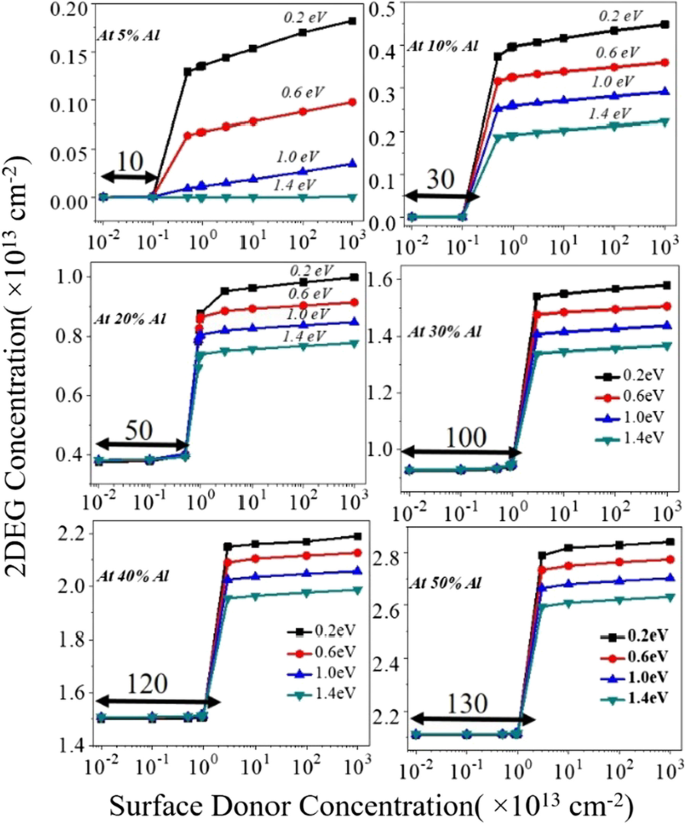
伝導帯に関して深いところから浅いところへのドナー表面トラップに対する個々のアルミニウムの割合の変化
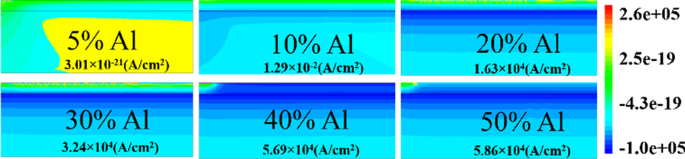
a 表面ドナーが伝導帯に対して深いレベルから浅くなるときのAl濃度の2DEG電子密度の対数スケールの変化率。 b 線形スケール

a 、 c 5%アルミニウムおよび b の場合のAlGaN-GaN界面の両側の伝導帯の変動 、 d 30%アルミニウム用。深いレベルの表面トラップは、ポテンシャル井戸と表面に電子と正のシート電荷を与えないため、伝導帯の傾きが大きくなります。深いドナー表面状態(1.4 eV)の場合でも、30%のアルミニウムに対して2DEGポテンシャル井戸が形成されています。これは5%アルミニウムには当てはまりません
表面電位に対するアルミニウムの割合と表面トラップの影響
いくつかの文献は、アルミニウムのパーセンテージの変化による表面電位の変動について論じています[29]。しかし、それらは表面電位に対する表面ドナートラップの効果を組み込んでいません。ここでは、エネルギーと濃度の両方の次元で、表面ドナートラップによる表面電位の変動を報告しています。図7aを参照してください。この研究では、表面ドナー濃度を1×10 12 から変更しました。 〜1×10 16 表面ドナーエネルギーは0.2〜1.4eVです。表面電位は図6bから計算されています。表面電位は3.7eV近くに落ち着きます(表面ドナー濃度1×10 12 の場合) )および3.6 eV(表面ドナー濃度1×10 13 の場合 )。この表面電位は、表面ドナートラップのエネルギーに依存せず、値が低くなります。表面ドナーが浅い(0.2 eV)から深くなる(1.4 eV)と、表面電位は直線的に増加します。表面電位が低下すると、表面電位は表面ドナートラップエネルギーに比例して変化するため、2DEG電子濃度は増加します。アルミニウムの割合も表面電位に大きな影響を与えます。アルミニウムの割合を5%から50%に増やすと、電子濃度は7.79×10 11 から増加します。 〜2.75×10 13 。アルミニウムの割合が5%から50%に変化すると、表面電位も0.49から0.576 eVに増加します(図7bを参照)。したがって、表面ドナートラップ濃度とエネルギー、およびアルミニウム濃度は、表面電位に大きな影響を及ぼします。
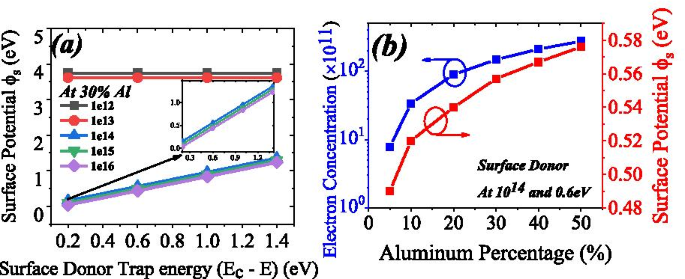
a 表面ドナートラップのエネルギーに関する表面電位の変動。低濃度(1e14未満)では、表面電位に大きな変化はありません。 1e13を超える表面ドナー濃度、表面電位は表面ドナーのエネルギーに比例して変化します。 b 2DEGの電子濃度が7.79×10 11 から変化 〜2.75×10 13 アルミニウムのパーセンテージは5%から50%に変化します(青い線)。表面電位は、アルミニウムの割合の5%から50%に約0.1eV変化します
伝導帯と2DEGポテンシャル井戸に対するアルミニウムの割合と表面トラップの影響
イオン化された表面トラップは、AlGaN表面のポテンシャル井戸と正のシート電荷に電子を寄与します[6]。アルミニウム濃度が5%の場合、トラップが浅いエネルギーレベルから深くなるにつれて、イオン化された表面トラップの量はますます少なくなります。したがって、イオン化された表面トラップは、三角形のポテンシャル井戸と表面の正のシート電荷に寄与する電子が少なくなります。 2DEGの正のシート電荷と電子濃度が少ないと、外部電界が十分に寄与しないため、図6に示すように、AlGaN層の伝導帯の傾きが大きくなります。これは10%のアルミニウムにも当てはまります。 AlGaNバリア層で。表面ドナー状態からの自由電子は2DEGポテンシャル井戸に存在し、AlGaNの表面に現れる正のシート電荷を中和します。この電子シートの電荷は[24]によって計算されます:
$$ n _ {{\ text {s}}}(x)=\ frac {+ \ sigma(x)} {e}-\ left({\ frac {{\ varepsilon_ {o} \ varepsilon(x)}} {{de ^ {2}}}} \ right)\ left [{e \ phi _ {{\ text {b}}}(x)+ E _ {{\ text {F}}}-\ Delta E _ {{\ text {C}}}(x)} \ right] $$(4)ここで d Al x の厚さです Ga (1- x ) N バリア層、 ϕ b ショットキーバリア、 E F はフェルミ準位であり、Δ E C は、AlGaN-GaN界面での伝導バンドオフセットです。それは式から明らかです。 (4)電子シートの電荷密度は、アルミニウムのパーセンテージの関数である伝導帯のオフセットと分極電荷に正比例します。アルミニウムの割合を10%から50%に増やすと、伝導バンドオフセットが増加し[25]、したがって、エネルギー準位の数の増加により2DEGの電子密度が増加します(図8を参照)。デバイスの内部電界、アルミニウム濃度が20%以上の場合、図6b、dに示すように、伝導バンドの勾配が十分に高く、深いレベル(1.4 eV)の表面トラップエネルギーと低い表面ドナートラップ濃度でも三角ポテンシャルを十分に構築できます。 。
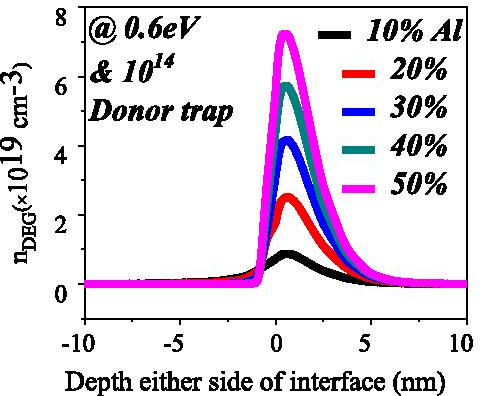
固定ドナー濃度とエネルギーでのさまざまなアルミニウム濃度に対する三角量子ポテンシャル井戸の電子密度
フェルミ準位(( E )の下で整形式の三角量子ポテンシャルのノッチを調べることが重要です。 F − e)eV)、ここで E フェルミ準位より下のエネルギーです。三角量子ポテンシャル井戸の2つの重要なパラメータは、フェルミ準位よりもはるかに低いポテンシャルの深さと、フェルミ準位でのポテンシャル井戸の幅です。二次元領域への電子の閉じ込めは、2DEG量子シートと呼ばれます。状態密度 N ( E )は、2DEG量子ポテンシャル井戸の重要な機能の1つです。二次元量子井戸の状態密度は[26]:
として定義されます。 $$ N(E)=\ left({{{m ^ {*} L _ {{\ text {X}}} ^ {2} E} \ mathord {\ left / {\ vphantom {{m ^ {*} L _ {{\ text {X}}} ^ {2} E} {\ pi \ hbar ^ {2}}}} \ right。\ kern- \ nulldelimiterspace} {\ pi \ hbar ^ {2}}}} \右)$$(5)ここで、 m * は電子の有効質量であり、 L X 井戸の幅です。この2次元の状態密度は、階段関数のように見えます。
占有状態の数はフェルミ準位によって異なります。たとえば、フェルミ準位が E よりも高い場合 1 ただし、 E 未満 2 ;次に、 E のみ 1 サブバンドがいっぱいです。フェルミ準位が E を超える場合 2 、ただし E 未満 3 、次に2つの下位サブバンド E 2 および E 1 図9bに示すように、電子で満たされています。これは、界面のエネルギーがフェルミ準位とともに深くなると、電子だけが多数期待されることを意味します。 AlGaN / GaNヘテロ構造では、エネルギー間隔が減少します(( E 2 − E 1 )>( E 3 − E 2 ))上位サブバンドの場合[27]。サブバンドエネルギーが増加すると、それらの間の差は無視できるようになり、連続的に見えます。波動関数の厳密に正しい解には、ポアソン方程式とシュレディンガー方程式が同時に含まれています。しかし、密度勾配モデルは、シュレディンガー方程式とほぼ等しい結果を生成します。量子ポテンシャル井戸では、エネルギーレベルが定量化されます。これは、この井戸がAlGaN-GaN界面のGaN側で最大数nmの長さを形成するためです。フェルミ準位より下のより深いノッチは確かにより多くの定量化されたエネルギー準位を持ちます。フェルミ準位より下の定量化されたエネルギー準位が占有されています。したがって、フェルミ準位より下のエネルギーが深くなるほど、2DEGの電子濃度は高くなります。図9aから、分極電荷が増加し、内部電界によってノッチが深くなるため、アルミニウムの割合が増加すると、フェルミ準位より下のエネルギー準位が高くなることが明らかです。表面ドナーのエネルギーに関する限り、前の説明から、表面トラップが深くなると(1.4 eV)、これらの表面ドナーのイオン化が減少することが明らかです。したがって、電場は表面の正のシート電荷によって生成され、これらの表面ドナーによって2DEGに寄与する電子は、内部電場を克服するのに十分ではありません。したがって、電界に関する分極電荷の影響が減少し、フェルミ準位よりも低いエネルギー準位につながります。例外は5%のアルミニウム濃度で、図10aから E の値が明らかです。 F − E 深いドナートラップ(> 0.9eVから1.4eV)の場合、フェルミ準位はゼロレベルであると想定されるため、は負になります。これは、エネルギー E を意味します。 フェルミ準位よりも高い(2DEGは形成されていない)。浅い表面ドナートラップ(<0.9eVから0.2eV)の場合、 E の値 F − E は正です。これは、 E の値が フェルミ準位よりも低いです。残りのアルミニウム濃度(10%から50%)の場合、 E の値 F − E は正であり、 E の値を意味します はフェルミ準位よりも低く、すべてのタイプの表面ドナーエネルギー(0.2eVから1.4eV)に対して2DEGノッチが形成されています。図11aから、エネルギーの変化率 E アルミニウムは20%のアルミニウム濃度を超えて飽和しますが、これも図5と一致しています。表面ドナーがエネルギーを深い場所から浅い場所にトラップする場合、20%のアルミニウム濃度の後、フェルミ準位より下のノッチの深さは大きく変化しません。図11bは、アルミニウムのモル分率が10%までは大きな電流が流れないことも示しています。 10%を超えると、表面ドナーのエネルギーが E から変化すると、電流に大きな変化が生じます。 C −0.2から E C − 1.4 eVで、再び20%を超えて飽和します。この結果は、図1および2とも一致しています。 11aおよび5。絶対電流密度の輪郭プロットは、20%Alモル分率を超えると飽和し、Alモル分率の10%までは有意な電流密度がないことも示しています。図12.これは、10%Alまでの2DEGの非形成も検証します。モル分率。モル分率の20%を超えると、かなりの量の電子密度が観察されます(図13a)。チャネルに沿った電界分布が図13bにプロットされています。図13bは、Alモル分率の10%まではゲート下の電界が著しく改善されておらず、Alモル分率の20%を超えると電界に大きな違いがないことを示しています。これにより、Alの割合が高くなると電流が制限されます。

a Fang–Howard Airy を使用して、サブバンドのエネルギーをよく表す三角形のポテンシャル 波動関数。 b 低エネルギーサブバンドのみ( E 1 および E 2 、フェルミ準位より低い)が占有されている[28]

a – f ( E F − E )すべてのアルミニウム濃度に対する表面ドナーエネルギーの変動
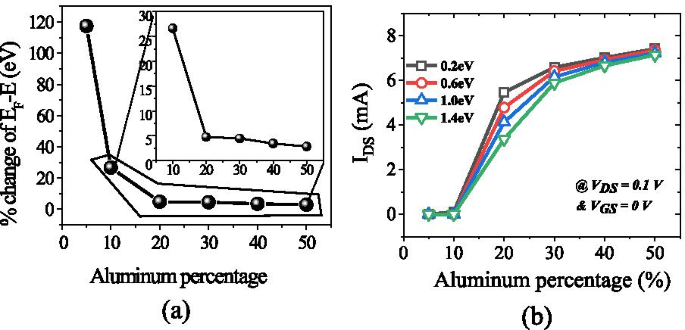
a エネルギーの変化率 E 表面ドナーのエネルギーが深くから浅く変化するときのアルミニウム濃度。 b ドレイン電流と V DS =0.1Vおよび V GS 異なる表面ドナーで=0Vはエネルギーをトラップします。デバイスで最大10%の有意な電流は観察されません
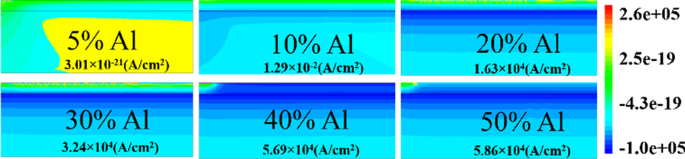
V での0.6eV表面ドナーエネルギーの絶対総電流密度の等高線図 DS =0.1Vおよび V GS =0 V
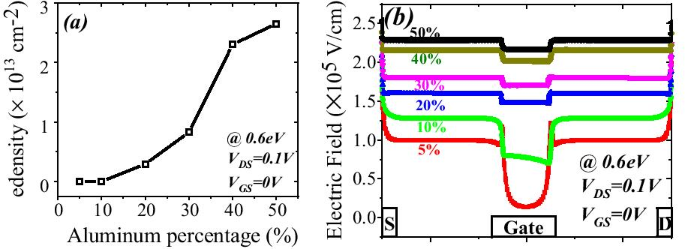
a Electron density variation with aluminum percentage and b electric field variation below gate and either side of gate for different aluminum percentage
Conclusion
In this paper, we comprehensively present the effect of surface donor traps along with aluminum percentage on electron density and quantum potential well. This manuscript demonstrated that the percentage change happens in 2DEG and notch below the Fermi level gets saturated above 20% of aluminum concentration when surface donor trap energy goes deep to shallow. The electron density in the two-dimensional quantum potential well is saturated approximately at 8%, whereas the energy below the Fermi level saturates somewhere around 2%. These two results are also in tune with each other, except 5% aluminum, having a condition for not forming two-dimensional well for relatively deep (> 0.9 eV) surface donors. Aluminum percentage above 10% forms two-dimensional quantum potential well even for deeper surface donor traps. The effect of surface donor traps on the surface potential also has been discussed in this work. The results of this paper may provide the impetus to the experimental result validation.
データと資料の可用性
All data are available on request.
略語
- GaN:
-
Gallium nitride
- HEMT:
-
High-electron-mobility transistor
- 2DEG:
-
Two-dimensional electron gas
- DD:
-
Drift and diffusion transport model
- SRH:
-
Shockley–Read–Hall recombination model
ナノマテリアル
- IoTと5Gの影響の評価
- 5GおよびGaN:将来のイノベーション
- 金コーティングとプラズマ処理によるポリエーテルエーテルケトンの表面化学の調整
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 表面の湿潤性と湿度を制御することによる絶縁基板へのエレクトロスピニング
- メタマテリアルにおける表面プラズモンポラリトンと磁気双極子共鳴の結合効果
- ナノ粒子の跳ね返りに及ぼす弾性剛性と表面接着の影響
- クリーンでグラフェンで覆われたCu(111)表面へのバナジウム原子の吸着の電子的性質
- 特性と目的:アルミニウム ブロンズ
- さまざまな PCB 表面仕上げと PCB への影響について学ぶ



