シリコン基板上のInGaN / GaN多重量子井戸におけるひずみ制御再結合
要約
この論文は、n型GaN層への周期的Siδドーピングのような異なる引張応力制御アーキテクチャで設計されたシリコン基板上に成長したInGaN / GaN多重量子井戸(MQW)発光ダイオードのフォトルミネッセンス(PL)特性を報告します。システム内の歪み制御再結合メカニズムを調査するためにInGaN / AlGaN層を挿入します。 PLの結果から、引張応力が解放されたサンプルは、外部量子効率が通常のサンプルの7倍の17%に増加したため、PLのパフォーマンスが向上することがわかりました。詳細分析により、非放射再結合率が小さいことが確認されました((2.5〜2.8)×10 -2 s -1 (3.6〜4.7)×10 −2 と比較して s -1 )、これは、より良い結晶品質と転位または亀裂の欠如に関連していました。さらに、それらの放射再結合率はより安定しており、はるかに高かった((5.7〜5.8)×10 -3 s -1 [9〜7]×10 -4 と比較して s -1 ) 室温で。これは、MQW界面の浅い局在状態の抑制に起因し、放射再結合を支配するInGaN層内の深い放射局在中心を残しました。
背景
従来のサファイアではなくシリコン基板上に成長したInGaN / GaN多重量子井戸(MQW)構造は、低コストのソリッドステート照明、パネルディスプレイ、およびシリコンフォトニクスでの潜在的なアプリケーションで注目を集めています[1,2,3,4、 5]。 Si上に高品質のGaN膜を製造する際の重大な障害は、GaNとSiの間の熱膨張の不一致(56%)であり、これにより、成長したGaN膜に大きな引張応力と亀裂が生じます[6、7、8、9]。さらに、発光ダイオード(LED)またはレーザーダイオード(LD)には、MQW層の下にSiをドープしたn型GaN層が必要です。これらの場合、Siドーピングによる追加の引張応力がもたらされます。近年、引張応力を相殺するために適切な圧縮応力を持つ中間層を使用することにより、これらの困難を克服するための努力がなされてきました[10、11、12、13、14、 15,16]、ひずみ緩和のためのデルタドーピング[17、18]、または格子整合バッファ層堆積[19、20]。以前の研究[17]によると、n型GaN層の周期的なSiδドーピングアーキテクチャは、Si均一にドープされたGaNよりも高い結晶品質と低い亀裂密度を備えたより滑らかなGaN層を実現できます。これは、引張応力の減少に起因していました。サファイア[21、22]またはシリコン基板[23]のいずれか上の結晶性GaN /SiδドーピングGaN層の表面形態、転位密度、および電気的特性を調べるために、いくつかの研究が行われてきました。残念ながら、SiδドーピングGaN層上のInGaN / GaN MQW構造の発光特性を直接調査し、デバイスにとって重要な膜構造の改善によって引き起こされる発光効率の向上とひずみ解放の関係を明らかにしたものはほとんどありませんでした。製造。また、LEDサンプルを分解せずにひずみを直接測定したり、格子歪みを観察したりすることは困難です。内部ひずみを評価するために、常に間接的な方法が適用されます。たとえば、機械的圧力を加えて内部ひずみを変調し、MQW内の圧電場の変化とLEDデバイスの光電子性能をもたらしました[24、25、26、27]。これらのいずれの場合でも、ひずみに関連するデバイスの性能を調べるには、発光スペクトルの測定が不可欠であることがわかりました。
したがって、この作業では、InGaN / GaN MQWLED構造を結晶シリコン基板上に堆積させました。比較のために、Siを均一にドープしたGaNまたはn型GaN層として機能する周期的なSiδをドープしたGaNのいずれかを成長させました。さらに、AlGaNまたはInGaNの薄層によってそれぞれ挿入された、Si均一にドープされたn型GaN層に基づくさらに2つの制御サンプルも、AlGaNとして、デバイス性能に対する圧縮応力または引張応力の影響の分析をサポートするために準備されました。は、表面の引張応力を部分的に解放するGaNよりも格子定数が小さく、InGaN挿入層は逆に引張応力を悪化させます。各サンプルの相対フォトルミネッセンス(PL)効率と再結合寿命(レート)は、温度変化した定常状態(SS)PLスペクトルと時間分解(TR)PLスペクトルから抽出され、体系的に分析されました。結果は、構造欠陥に関連する非放射再結合が抑制され、放射再結合がInGaNウェル層内の深い再結合状態により関連しているため、引張応力解放サンプルのPL性能が優れていることが判明しました。これにより、温度に対してより安定した放射再結合が実現しました。 。
メソッド
図1の概略図に示すように、InGaN / GaN MQWのエピタキシャル成長は、前の研究[17]で報告された有機金属化学蒸着によって実行されました:100 nm AlN層、660 nm線形傾斜AlGaN層、および200 nmの名目上ドープされていないGaN層は、それぞれ1060、1060、および1020°CでバッファとしてSi(111)基板上に成長しました。サンプルS1、S3、およびS4の場合、1μmのSi均一にドープされたGaN層が、推定Si原子濃度が約10 18 でバッファ上に堆積されました。 cm -3 。サンプルS3およびS4の場合、In%〜10at%の20 nm InGaN挿入層またはAl%〜20%の20 nm AlGaN挿入層が、n型Si均一にドープされたGaN層の後に堆積されました。サンプルS2の場合、20周期のSiδドープ面に続いて、Si均一にドープされたGaN層の代わりに、合計厚さが1μmの名目上ドープされていない50nmのGaNがバッファ上に成長しました。その後、S1〜S4の各サンプルで、インジウム組成が約22.0at%である800°Cで6周期のInGaN / GaNQWを成長させました。井戸/バリアの平均厚さは2.4nm / 10nmと推定されました。その後、220 nmMgをドープしたp型GaN層を1020°Cで成長させました。 PLスペクトルテストでは、10 mW、377nmのパルスレーザーを備えたZolix-750PLシステムを励起光源として使用し、0.09nmの分解能を備えたANDORNewtonCCDを光検出器として使用しました。 TRPL測定では、PLの減衰は、10〜300Kの時間相関単一光子計数システムによって記録されました。
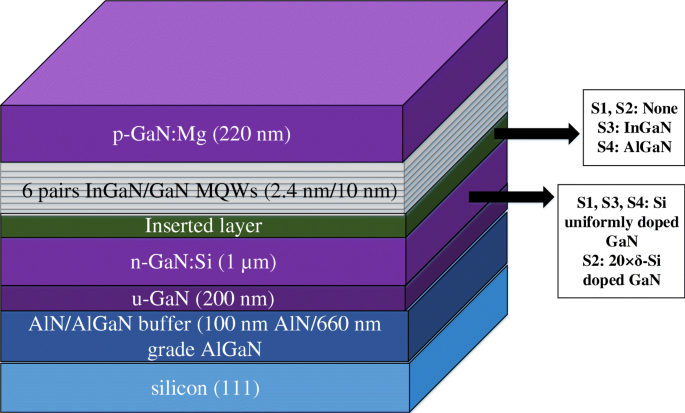
Si基板上に成長させたMQWLEDサンプルの構造。 S1、S3、およびS4には、1μmのSiが均一にドープされたn型GaN層が含まれています。 S3には、20nmのInGaN挿入層が含まれています。 S4には、20nmのAlGaN挿入層が含まれています。 S2には、20周期のSi-δドープ面が含まれ、その後に、Si均一にドープされたn型GaN層の代わりに、合計厚さが1μmの名目上ドープされていない50nmのGaNが続きます
結果と考察
10 Kでテストされた各MQWサンプルのSSPLプロパティの概要を図2に示します。挿入図に示されているように、Si構造のS1上の元のMQWは、ファブリペロー振動で500〜650nm付近に発光ピークを示します。 4つのサンプルすべてのPLスペクトルは同じ特性を持っています。この現象は、Si基板上に成長したGaNベースのLEDで一般的に観察されます[28、29、30]。バッファ/ Si界面の反射率が大きいため、MQWからのPL強度の顕著な下向きの部分が反射され、真上に干渉します。分数。これらの振動ピークは、ガウスPL信号に振動項目(1 + Acos(4 πnd)を掛けたものとして簡単に説明できます。 / λ ))(図1の挿入図に赤い曲線として示されています)、ここで A 振動子強度 n を表します MQWフィルムの平均屈折率 d はMQWフィルムの全体の厚さであり、λ PL波長です。上記のモデルによれば、元のガウスPLピークを適合させ、複雑な振動ピークから抽出することができます(図1の挿入図に青い曲線として示されています)。 SSPLの結果は、In%〜22at%のInGaN結晶のバンドギャップエネルギーによると、S1は531nmに鋭い緑色のPLピークを持っていることがわかりました。比較として、Siδをドープしたn型GaN層を備えたS2は579 nmで著しく赤方偏移したPLピークを持ち、InGaNを挿入した層を備えたS3は517 nmでわずかに赤方偏移したPLピークを持ち、AlGaNを挿入した層を備えたS4はわずかに赤方偏移したPLを持ちます545nmでピークになります。 AlGaN挿入層がSiδドーピングの機能に精通した引張応力を解放する役割を果たしているのに対し、InGaN挿入層は引張応力を悪化させることを考慮すると、これらの結果は、基板上の引張応力がMQWPL位置のブルーシフトにつながることを示していますまたはInGaNウェルの平均バンドギャップの拡大。 SiδをドープしたGaN層のひずみ解放効果は、挿入層の導入よりもはるかに強力です。
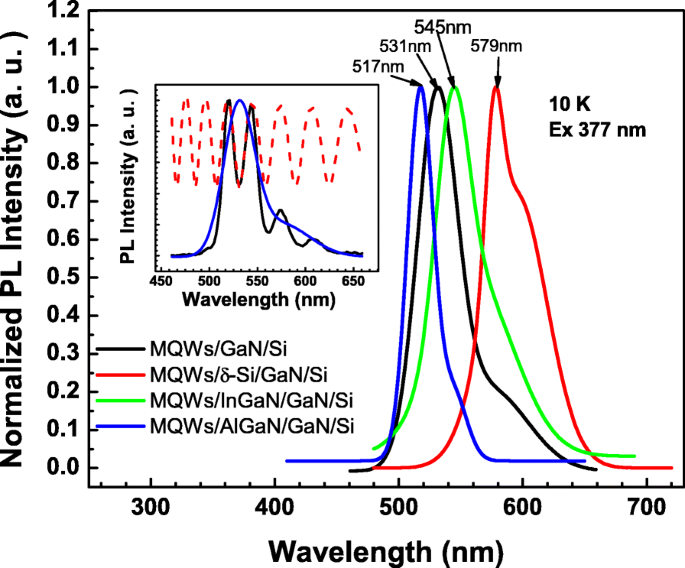
10Kで377nmレーザーによって励起されたS1〜S4のSSPLの概要。元のPL信号には、インサートに黒い曲線として示されているファブリペロー振動が含まれています(例としてS1)。振動項目(赤い破線の曲線)とガウスPLピーク(青い曲線)は、元の信号をフィッティングすることによって分割されます。 S1〜S4のすべてのPLデータは同じ方法で処理され、分割されたガウスPLが図に示されています
MQWの再結合の性質を理解するには、放射/非放射再結合率に関連するPLの寿命を減衰曲線から直接抽出できるため、PLの減衰特性をテストすることが重要です。ここで、PL減衰は、検出された波長をS1〜S4のピーク値に固定して測定され、測定は10〜300 Kの範囲のさまざまな温度で行われました。図3は、10、100でテストされたS1の3つの典型的なPL減衰曲線を示しています。 、および300K。すべてのS1〜S4のPL減衰は、温度によって変化する傾向があることがわかります。この現象は、サンプル内の放射再結合率と非放射再結合率の両方の温度依存性を反映しています。次の単一の指数関数的減衰関数を使用して、すべての減衰曲線を適合させました。
$$ I(t)={I} _0 {e} ^ {-t / \ tau} $$(1)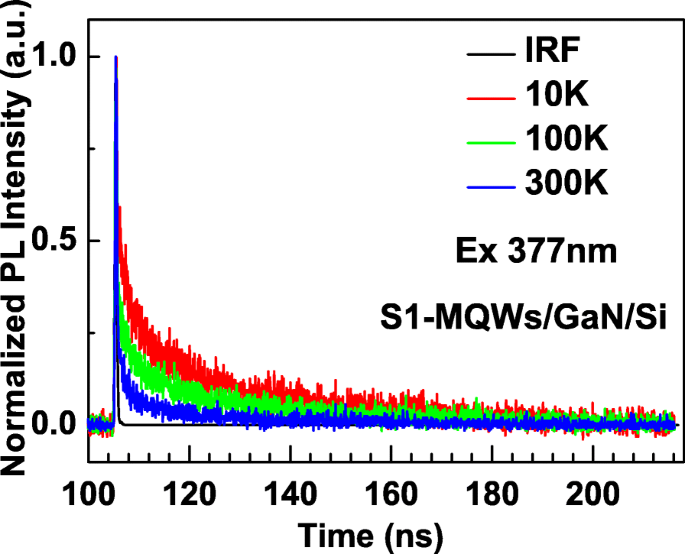
10 K、100 K、および300Kで377nmパルスレーザーによって励起されたS1のPL減衰曲線
ここで私 0 t でのPL強度を表します =0およびτ PLの寿命を表します。すべての減衰曲線が上記の単一の指数関数的減衰関数によって完全に適合できるわけではないことに注意してください。これはいくつかのグループによって広く議論されてきました[31、32、33、34]。合理的な仮定は、システム内に複数の再結合センターが存在するというものでした。曲線を適合させるために、多指数関数的減衰関数が使用されることがありました。ここでは、最終的に検証するのが難しい多くの仮定を導入したり、分析をPLプロパティ全体のごく一部にのみ誤って反映させたりすることを避けるために、最も単純なモデルを使用して、各サンプルの平均PL寿命を抽出しました。全体的なPL動的プロパティを反映している可能性があります。得られたS1〜S4の寿命を図4aにまとめました。 PLの動的結果を組換え確率に関連付けるには、組換え率 k k として定義されました =1 / τ 。 k のスポット S1〜S4の対温度も図4bに示されています。結果は、 k の2種類の進化を明確に示しています。 引張応力解放サンプルS2およびS4の再結合率が元のサンプルS1または引張応力悪化サンプルS3の再結合率よりも全温度範囲で小さく、温度の上昇とともにさらに急激に増加する温度で。 k に注意してください = k r + k nr 、ここで k r 放射再結合率と k を表します nr 非放射再結合率を表します。 k nr 温度が上がると上昇し、 k を支配します 室温では、常に熱によるエネルギー交換プロセスに関係しているためです[35]。つまり、 k 図4bの高温側の結果は、SiδドーピングやAlGaN挿入などのひずみ解放プロセスが、 kに大きな影響を与える転位欠陥や亀裂の低減全体を通じてMQWの非放射再結合の抑制にプラスの影響を与えるという確かな証拠を示しています。 nr 。しかし、 k r 低温状態では無視できなくなります。したがって、 k の動作を説明するには、追加情報とさらなる分析が必要です。 低温側で。

a S1〜S4のPL寿命と温度の関係。検出された波長は、図2のSSPLの結果に従って、各ピーク位置に保持されます。 b k によって得られるS1〜S4の対応する組換え率 =1 / τ
したがって、 k を分割する場合 r および k nr 各 k から 値、各サンプルのさまざまな温度条件でのSSPLスペクトルを測定しました。次に、以前のTRPLテストで検出された波長に対応する各PLピークの強度を、 I として記録しました。 ( T )。その後、相対的なPL効率はηとして定義されました。 =私 ( T )/ 私 0 、 I 0 は0KでのPL強度を表します。S1〜S4で得られたPL効率を図5aにまとめました。 S2とS4のPL効率は両方とも約17%であり、S1のPL効率の7倍であることがわかります。放射再結合のみがPL強度に寄与することが知られています。したがって、この相対的なPL効率は、総再結合率における放射再結合率の比率を反映しています。
$$ \ eta ={k} _r / \ left({k} _r + {k} _ {nr} \ right)={k} _r / k $$(2)<図> <画像> <ソースタイプ=" image / webp "srcset =" // media.springernature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-018-2663-6/MediaObjects/11671_2018_2663_Fig5_HTML.png?as=webp ">
a S1〜S4の相対的なPL効率と温度の関係。検出された波長は、図2のSSPLの結果に従って、各ピーク位置に保持されます。 b S1の総再結合率、放射再結合率、および非放射再結合率と温度の関係
したがって、 k を解決することができます r =kη および k nr = k (1 − η )ηと組み合わせたTRPLの結果から 。 k のそれぞれの計算 r および k nr 例としてS2のを図5bに示しました。その結果、Siδドーピング修飾を施したS2でも、50 Kの非常に低い温度に達するまで、非放射再結合率は放射再結合率よりも大きいことがわかりました。これが、 k の理由を説明しています。 k では温度が支配的であるため、温度が上昇しても上昇し続けます nr 。また、Si構造上のMQWの結晶品質をさらに改善する必要性が高いことも示しています。放射再結合率 k r は、温度の上昇とともに単調に低下することがわかりました。これは、 k という自由電子正孔対の再結合に起因する典型的なPL特性とは一致しません。 r 温度がありません。ただし、励起子の局在化においてPLプロセスが支配的である場合は合理的です。励起子は、より高い温度範囲で非局在化する傾向があります。その結果、温度の上昇は局在化率の低下につながります[32]。 k nr および k r S1〜S4の対温度は、それぞれ図6a、bにまとめられています。示されているように、 k の結果 nr S2とS4の300Kでの値は2.5×10 -2 s -1 および2.8×10 −2 s -1 、それぞれ、S1の場合よりも低くなっています(3.6×10 -2 s -1 )およびS4(4.7×10 −2 s -1 )。これらはさらに、ひずみ解放プロセスがMQWの転位と亀裂の形成を抑制し、その結果、非放射再結合中心の密度を低下させることを確認します。この抑制効果は、温度が下がるとより敏感になります。得られた k r 結果はより複雑です。示されているように、 k r S1とS3の場合、温度上昇後のS2とS4の場合よりもはるかに深刻に低下します。その結果、 k が得られました r S2の場合は300Kで(5.7×10 -3 s -1 )およびS4(5.8×10 -3 s -1 )はS1の場合よりもはるかに高い(9×10 -4 s -1 )およびS3(7×10 -4 s -1 )。この現象をひずみ解放プロセスに帰することは合理的です。上記の議論によれば、これらのMQWサンプルの放射プロセスは、主に局在状態での励起子再結合に関連しています。ここでは、 k r 主に励起子局在化率 k によって決定されます loc 。 k の劇的な減少 loc 温度が上昇すると、局在化状態の平均深さがシステム内で比較的浅くなり、励起子が高温で非局在化しやすくなることを示します。言い換えると、S1およびS3としてひずみが解放されたサンプルの局所状態の平均深度は、ひずみが解放されていないサンプルよりも小さくなります。以前の研究[36]に基づくと、InGaN / GaN MQWの局所的な放射再結合中心は、ウェルの厚さの変化やインジウムに富むクラスターなど、InGaNウェル層の構造欠陥によって提供されることが多く、ウェルの厚さの変化は浅い状態を提供します。インジウムに富むクラスターは、はるかに深い深さの状態を提供します[33]。ここで、 k の結果 r は、Si基板とSiドープGaNによって導かれるMQW界面の強い引張応力が、放射性の浅い構造欠陥の形成を改善する可能性があることを示しています。 。 S2とS4の場合、ウェルの厚さの変動が抑制されるため、励起子局在化プロセスはInGaNウェル内の深い状態で支配的であり、局在化状態の平均深さがはるかに大きく、より安定した k r 対温度。その結果、サンプルS1とS3はより高い k を示します r 励起子の非局在化効果が弱い低温側のS2やS4よりもはるかに小さい k r 室温で。

a S1〜S4の非放射再結合率と温度の関係。 b S1〜S4の放射再結合率と温度の関係
結論
要約すると、温度変化したSSPLおよびTRPLスペクトルは、引張応力解放処理の有無にかかわらず、Si構造上のさまざまなInGaN / GaNMQWについて研究されました。 SiδドーピングGaN層またはAlGaN挿入層を備えたサンプルは、通常のサンプル(2.5%)またはInGaN挿入層を備えたサンプル(1.6%)よりも再結合率が低く、PL効率が高い(最大17%)ことがわかりました。さらなる分析により、より小さな再結合率は主に、より小さな優勢な非放射再結合率(2.5×10 -2 )によって導かれることが明らかになりました。 s -1 δドーピングサンプルの場合、3.6×10 -2 s -1 3.6×10 -2 と比較したAlGaN挿入サンプルの場合 s -1 通常のサンプルおよび4.7×10 -2 の場合 s -1 InGaN挿入サンプルの場合)、これは転位または亀裂の形成の抑制に起因していました。非放射再結合率が小さいことに加えて、室温でより安定して高い放射再結合率(5.7×10 -3 )によって、PLのパフォーマンスが向上しました。 s -1 δドーピングサンプルの場合、5.8×10 -3 s -1 9×10 -4 と比較したAlGaN挿入サンプルの場合 s -1 通常のサンプルおよび7×10 -4 の場合 s -1 InGaN挿入サンプルの場合)。それらはまた、MQW界面でのウェルの厚さの変動の抑制に起因し、InGaN層内の深い放射局在中心が放射再結合プロセスを支配するままになっています。上記の結果は、シリコン基板上でのInGaN / GaN MQW LEDデバイスの再結合プロセスを明確に示しており、将来のデバイス製造の指針となる可能性があります。
略語
- IQE:
-
内部量子効率
- LD:
-
レーザーダイオード
- LED:
-
発光ダイオード
- MQW:
-
多重量子井戸
- PL:
-
フォトルミネッセンス
- SSPL:
-
定常状態のフォトルミネッセンス
- TRPL:
-
時間分解フォトルミネッセンス
ナノマテリアル
- 量子輸送は弾道的になります
- 顕微鏡下での単一原子キュービットの構築
- 水素を生成するナノシリコン
- 複数色のナノコーティング
- Nano書記素、シリコンベースの柔軟な透明メモリ
- 構造的および光学的性質を改善するためのH2 / NH3混合ガス中のGaNベースの多重量子井戸の原子転位
- 半極性InxGa1-xN / GaN多重量子井戸を備えた紫外線GaNベースのフォトニック準結晶ナノピラミッド構造からの多色発光
- 酸化物を含まないシリコンの滑り速度に依存する摩擦化学摩耗
- アニーリングされたGaAsBi / AlAs量子井戸のビスマス量子ドット
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層



