GaAs / AlAs超格子の点欠陥の第一原理研究:相安定性とバンド構造およびキャリア移動度への影響
要約
高度な半導体超格子は、航空宇宙、高エネルギー物理学、重力波検出、天文学、原子力関連分野など、将来の重要なハイテクアプリケーションで重要な役割を果たします。高照射環境のような極端な条件下では、これらの半導体超格子はさまざまな欠陥を生成する傾向があり、最終的にはデバイスの故障につながる可能性があります。ただし、GaAs / AlAsのような超格子では、相安定性と点欠陥のデバイス性能への影響はまだ明確ではありません。現在の計算は、GaAs / AlAs超格子では、アンチサイト欠陥が空孔や格子間欠陥よりもエネルギー的に有利であることを示しています。 As X (X =AlまたはGa)およびX As 欠陥は常にGaAs / AlAs超格子とGa Al の金属量を誘発します およびAl Ga アンチサイト欠陥は、電子構造にわずかな影響を及ぼします。格子間欠陥または空孔欠陥のあるGaAs / AlAs超格子の場合、バンドギャップまたは誘導金属量の大幅な減少が見られます。さらなる計算は、格子間欠陥と空孔欠陥が電子移動度を大幅に低下させる一方で、アンチサイト欠陥の影響は比較的小さいことを示しています。この結果により、GaAs / AlAs超格子の放射線損傷の影響についての理解が深まり、極限環境アプリケーション向けの非常に安定した耐久性のある半導体超格子ベースの電子およびオプトエレクトロニクスを設計するためのガイダンスが提供されます。
背景
超格子(SL)は、2つ以上の異なるコンポーネントの薄い層が交互に並んだ人工材料です。 (GaAs) n /(AlAs) m は、数十年前に高電子移動度トランジスタ(HEMT)と量子カスケードレーザー(QCL)が開発されて以来、最も重要なSLの1つです[1,2,3,4,5,6]。最近、フィルムエピタキシーおよびナノファブリケーション技術の進歩に伴い、(GaAs) n /(AlAs) m (n + m)が2から10の範囲のベースのSLおよびナノデバイスは、発光および光吸収、2光子吸収、ラマン、および赤外線スペクトルに関連する刺激的な物理的特性を示しており、オプトエレクトロニクス、センシング、 LED、エネルギー、レーザー関連の民間および工業地域[7,8,9,10,11,12]。一方、航空宇宙、高エネルギー物理学、重力波検出、天文学、宇宙旅行、核および国家安全保障関連分野などの他の重要なハイテクアプリケーションに向けて、半導体SLおよびデバイスはさまざまな放射線環境にさらされています。光線、中性子、電子、イオンなど。これにより、不純物、空孔、格子間原子、アンチサイト、およびこれらの複合体を含む欠陥が生成される可能性があります。半導体材料および関連する物理的特性は、これらの電子デバイスおよび集積回路の動作および機能に重要な役割を果たすため、特に多層システムでは、少量の欠陥によって光学特性および輸送特性が大幅に変化する可能性があります[13]。
半導体SLとその構成材料に対する異物不純物または固有欠陥の影響は、過去数十年にわたって広く調査されてきました。 Zollo etal。密度汎関数理論(DFT)法を使用して、GaAsの点欠陥の安定性を調査し、アンチサイト欠陥の方が有利であることを発見しました[14]。 Kahaly etal。 GaAs / AlAs SL構造をDFT法で研究し、ヒ素空孔(V As )界面およびその近くの欠陥は、絶縁性誘電体ヒ化物間の導電性準2-DEGにつながりました[7]。 Spasov etal。 GaAs / AlAsSLダイオードのキャリア輸送と電子正孔再結合に対する窒素不純物の影響を研究しました[9]。彼らは、N不純物が電子ミニバンドのエネルギーを変更し、SLミニバンドを介した電子拡散を妨げ、電子正孔対の強力な放射再結合につながる可能性があることを報告しました[9]。王ら。 ab initio を使用して、GaAs / AlAsSL構造のZn不純物によって引き起こされる相互拡散を研究しました。 分子動力学(AIMD)法[15]。彼らの結果は、Znの拡散がIII族元素によって促進され、それらが格子間チャネルに放出されて急速に拡散し、それによって超格子を無秩序化することを示唆しました[15]。 MitraとStarkは、空孔の存在がGaAs / AlAsSLでのGa / Al混合を促進することを発見しました。これは、提案された拡散の2原子リングメカニズムに起因します[16]。最近、GaAs / AlAs SLの放射応答のAIMDシミュレーションが実行され[17]、格子サイトから恒久的に変位する各原子の最小エネルギーが決定され、欠陥生成の経路が提供されました。作成された欠陥の種類が特定されました。作成されたGa(またはAlまたはAs)フレンケルペアとAs Ga -Ga As アンチサイトペアは、GaAs / AlAsSLの状態分布密度とバンド構造に大きな影響を及ぼします[17]。
これまでのところ、SL構造の点欠陥の安定性やキャリア移動度などの輸送特性はまだ不明です。したがって、空孔、格子間原子、およびアンチサイト欠陥の存在が、GaAs / AlAsSLの構造安定性と電気的特性にどのように影響するかを調査することが非常に重要です。この研究では、単一のGa(またはAlまたはAs)の空孔、単一のGa(またはAlまたはAs)の格子間原子、および単一のGa As の相安定性 (またはAl As またはAs Ga またはAs Al )アンチサイトの欠陥が研究されています。アンチサイト欠陥は、空孔および間質欠陥よりもエネルギー的に有利であることが示されています。これらの欠陥状態のバンド構造は、ハートリーフォック理論からの正確な交換の一部と他のソースからの交換相関エネルギーの残りを組み込んだハイブリッドDFT法によって調査されました( ab initio または経験的)[18]であり、標準のDFTよりも半導体材料の電子構造のより正確な記述を提供することが期待されます。特に、電子移動度が予測されています。格子間欠陥と空孔欠陥は電子移動度を大幅に低下させますが、アンチサイト欠陥の影響は比較的小さいことがわかります。この作業は、半導体超格子の放射線損傷効果の理解を深め、極限環境アプリケーション向けの非常に安定した耐久性のある半導体超格子ベースの電子およびオプトエレクトロニクスを設計するためのガイダンスを提供します。
メソッド
この研究では、構造緩和は標準のDFTフレームワーク内で実行され、バンド構造は緩和された構造に基づいてHeyd-Scuseria-Emzefhof(HSE)[19]のフレームワークのハイブリッドDFTによって計算されます。すべての計算は、Vienna Ab Initio を使用して実行されます。 シミュレーションパッケージ(VASP)[20]。プロジェクター増強波擬ポテンシャルは、イオンと電子間の相互作用を説明するために使用され、交換相関効果は、Ceperley-Alderパラメーター化の局所密度近似を使用して処理されます[21]。総エネルギーと力の収束基準は10 -4 です。 eVおよび10 -3 それぞれeV /Å。 AlAsとGaAs結晶の原点グループは T です。 d 図1aに示すように、閃亜鉛鉱のグループ。考慮される点欠陥の図を図1bに示します。この研究では、GaAsの2つの単分子層とAlAsの2つの単分子層を交互に含むGaAs / AlAs SLを検討し、幾何学的構成を、検討した点欠陥とともに図2に示します。

a の幾何学的構造の概略図 XA(X =GaまたはAl); b XAの欠陥。 V X :(X =Ga、Al、またはAs)X空室; X int :Xインタースティシャル; X As :As格子サイトを占めるX; As X :X格子サイトを占めるように。黄色と紫色の球は、それぞれ空孔と間質の欠陥を表しています

a の幾何学的構造の概略図 理想的なGaAs / AlAs超格子; b および c 異なる点欠陥を持つGaAs / AlAs超格子。 X Y :(X、Y =Ga、Al、またはAs)XはY格子サイトを占有します。 V X :X欠員; X int :Xインタースティシャル。黄色の球とカーマインの球は、それぞれ空孔と間質の欠陥を表しています
結果と考察
GaAsとAlAsの基底状態の特性
表1に示すように、バルクGaAsとAlAsの格子定数はそれぞれ5.61Åと5.63Åと決定されており、実験値やその他の理論値とよく一致しています[22、23、24]。 GaAsとAlAsの格子定数は小さく、GaAs / AlAsSLの格子定数は5.62Åの中間値に設定されているようです。体積弾性率は\(B =\ frac {1} {3} \ left({C} _ {11} +2 {C} _ {12} \ right)\)[25]で計算されます。ここで、C 11 およびC 12 弾性定数を表します。 GaAsの体積弾性率は76.3GPaと計算され、AlAsの76.5GPaの結果に近い値です。これらの結果は、理論的および実験的データと合理的に一致しています[22、26、27]。
<図>GaAs / AlAs超格子の欠陥形成エネルギー
GaAs / AlAs SLおよびバルク状態の場合、欠陥形成エネルギーは\({E} _f ={E} _ {def}-{E} _ {undef} + \ sum \ Limits_i \ Delta {n} _i {によって計算されます。 \ mu} _i \)[28]。ここで、 E def 緩和後の欠陥のあるシミュレーションセルの総エネルギー E undef リラックスした理想的なスーパーセルの総エネルギーΔ n i 種の数の変化です i ( i =Ga、Al、またはAs)、およびμ i 種の化学ポテンシャル i [28]。
バルクXA(X =AlまたはGa)の場合、AsおよびXの化学ポテンシャルは次の制約に従います:\({\ mu} _X \ le {\ mu} _X ^ {bulk} \)、\({\ mu} _ {As} \ le {\ mu} _ {As} ^ {bulk} \)、および\({\ mu} _ {As} + {\ mu} _X ={\ mu} _ {XAs} ^ {bulk } \)、ここで\({\ mu} _X ^ {bulk} \)、\({\ mu} _ {As} ^ {bulk} \)、および\({\ mu} _ {XAs} ^ {bulk } \)は、それぞれバルクX、バルクAs、バルクXAの総エネルギーに対応します。 Xリッチ条件下での欠陥形成エネルギー、すなわち\({\ mu} _X ={\ mu} _X ^ {bulk} \)および\({\ mu} _ {As} ={\ mu} _ {XAs } ^ {bulk}-{\ mu} _X ^ {bulk} \)、およびAsが豊富な条件、つまり\({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \ )と\({\ mu} _X ={\ mu} _ {XAs} ^ {bulk}-{\ mu} _ {As} ^ {bulk} \)を表2にまとめます。GaAsの場合、As- As Ga の豊富な条件 (Ga格子サイトを占めるように)1.57 eVの最小の形成エネルギーによって示されるように、アンチサイト欠陥が最もエネルギー的に有利であることがわかります。次の好ましい欠陥はGa As です (As格子サイトを占めるGa)アンチサイト欠陥、2.31eVの形成エネルギー。 Asインタースティシャル(As int )は5.20 eVの最大の形成エネルギーを持っており、他の考えられる点欠陥よりも形成が難しいことを示唆しています。 Gaが豊富な条件下では、V Ga 、As int およびAs Ga 欠陥はより大きな形成エネルギーを持ち、V As 、Ga int およびGa As Asリッチ状態と比較して、欠陥の形成エネルギーは小さくなります。明らかに、欠陥の安定性は化学的環境に依存します。 GaAsと比較すると、As int の場合を除いて、AlAsの欠陥形成エネルギーは一般に大きくなります。 およびAs X (X =AlまたはGa)Asリッチ条件下。 As Al およびAl As アンチサイト欠陥は、それぞれAsリッチおよびAlリッチ条件下で最も好ましい欠陥であると判断されます。 GaAsの場合と同様に、As int AlAsでも不利です。バルクXAのAsリッチおよびXリッチ(X =GaまたはAl)条件下での欠陥形成エネルギーを図3にプロットします。図3aは、As Ga およびGa As アンチサイト欠陥は、それぞれAsリッチおよびGaリッチ条件下でより有利です。 As Al ほとんどの場合、アンチサイト欠陥が望ましいです(図3bを参照)。 Alが豊富な条件下では、Al As の相安定性 、V As およびAs Al それぞれ3.0、3.16、3.24 eVの形成エネルギーで示されるように、欠陥は互いに近接しています。また、GaAsとAlAsの両方で、As int の不利性がわかります。 化学環境に依存しません。 Zollo etal。 GaAsの第一原理計算を実行し、それらのDFTの結果は、As Ga の形成エネルギーを示しました。 およびGa As 空孔や格子間欠陥の場合よりも小さく[14]、これは私たちの結果と一致しています。
<図>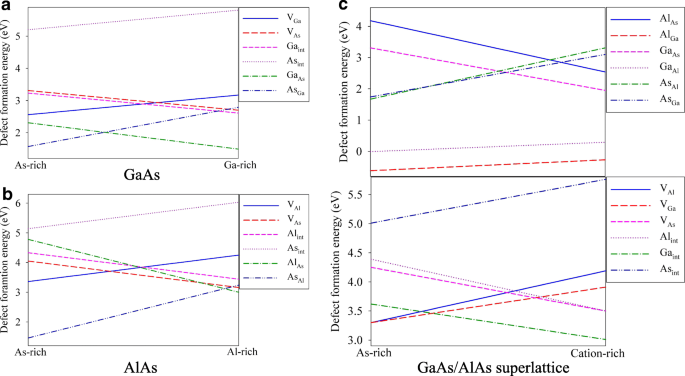
a のAsリッチおよびカチオンリッチ条件下での欠陥形成エネルギー GaAs、 b AlAsと c GaAs / AlAs超格子。 X Y :(X、Y =Ga、Al、またはAs)XはY格子サイトを占有します。 V X :X欠員; X int :Xインタースティシャル
E f GaAs / AlAsでは、SL構造もAsリッチ条件下で計算されます。つまり、\({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \)、\({\ mu} _ {Al} ={\ mu} _ {Al As} ^ {bulk}-{\ mu} _ {As} ^ {bulk} \)、および\({\ mu} _ {Ga} ={\ mu} _ {Ga As} ^ {bulk}-{\ mu} _ {As} ^ {bulk} \)、および陽イオンが豊富な条件、つまり\({\ mu} _ {Al} ={\ mu} _ {Al } ^ {bulk} \)、\({\ mu} _ {Ga} ={\ mu} _ {Ga} ^ {bulk} \)および\({\ mu} _ {As} =\ left({\ mu} _ {SL} ^ {bulk}-{n} _ {Al} \ times {\ mu} _ {Al} ^ {bulk}-{n} _ {Ga} \ times {\ mu} _ {Ga} ^ {bulk} \ right)/ {n} _ {As} \)、ここで n Al 、 n Ga 、および n As シミュレーションセル内のAl、Ga、As原子の数をそれぞれ表します。表3に示すように、Al Ga 欠陥の形成エネルギーは負であり、Asリッチおよびカチオンリッチ条件下でそれぞれ-0.62および-0.27 eVであり、Al Ga の形成を示しています。 アンチサイト欠陥は発熱過程です。 Ga Al について 欠陥の場合、形成エネルギーは、Asリッチ条件下で-0.01 eV、カチオンリッチ条件下で0.29eVと小さくなります。明らかに、Al Ga の形成 およびGa Al GaAs / AlAs SL構造のアンチサイト欠陥は、他の点欠陥よりもはるかに簡単です。 Asが豊富な条件下では、As Ga の2番目に有利な欠陥の形成エネルギー およびAs Al それぞれ1.67および1.74eVであると決定されます。インタースティシャルの場合、相安定性は両方ともGa int の傾向に従います。> Al int > As int Asリッチおよびカチオンリッチ条件下で。 GaAs / AlAsSL構造の欠陥形成エネルギーも図3cにプロットされています。バルクGaAsと比較して、GaAs / AlAs SLの点欠陥は、As int の場合を除いて、一般に形成が困難です。 (図3a、cを参照)。 As int の形成エネルギー バルクのGaAsは、AsリッチおよびGaリッチ条件下で5.20および5.81 eVであり、GaAs / AlAsSLの5.01および5.76eVの対応する値よりもわずかに大きくなっています。図3bとcに示すように、バルクAlAsとSL構造の点欠陥の安定性は異なる特性を示しています。 Al As およびAs int GaAs / AlAs SLの欠陥は、バルクAlAsよりもエネルギー的に有利ですが、V As SL構造よりもバルクAlAsの方が欠陥の方が好ましい。 AsリッチおよびAlリッチ条件下で、Al int の形成エネルギーが注目に値します。 バルクのAlAsは、GaAs / AlAsSLのそれに匹敵します。 Al int の場合と同様です 、V Al バルクAlAsおよびSL構造の欠陥は、同等の形成エネルギーによって示されるように、同様の好感度を示します。 As Al の場合 欠陥の場合、SL構造ではAsリッチ条件下での形成エネルギーが小さく(1.46 eV)、バルクAlAsでは陽イオンリッチ条件下で値が小さく(3.10 eV)、As Al <の安定性が示唆されます。 / sub> 化学的環境によって異なります。
<図>バルクAlAs、GaAs、およびGaAs / AlAs SLの欠陥安定性を比較すると、特にGa Al の場合、空孔や格子間原子よりもアンチサイト欠陥の方が常に好ましいことがわかります。 およびAl Ga GaAs / AlAsSLで。 Asリッチおよびカチオンリッチ条件下では、As int 欠陥は、バルク状態とGaAs / AlAsSL構造の両方で形成するのが最も困難です。
GaAs / AlAs超格子のバンド構造に対する点欠陥の影響
GaAs / AlAs超格子の元の状態
バルクGaAs、AlAs、およびGaAs / AlAs SLのバンドギャップを表4にまとめ、それらのバンド構造を図4に示します。ハイブリッドDFT計算により、GaAsの直接バンドギャップは1.44 eVと決定されます(図4aを参照)。 )、これは1.52 eV [29]および他の計算[24]の実験値とよく一致します。対照的に、標準のDFTは0.5 eVのバンドギャップ値を予測しますが、これはGaAsのバンドギャップを大幅に過小評価しています。 AlAsの場合、バンド構造は間接特性であり、ハイブリッドDFTバンドギャップは2.16 eV(図4bを参照)であり、DFT結果より0.85 eV大きく、実験値2.22eVとよく一致しています[23]。図4cに示すように、GaAs / AlAs SLのバンドギャップは直接であると判断され、(GaAs) m のバンドギャップを発見したBottiらの研究と一致しています。 /(AlAs) m SL(m≥2)はΓ点に直接なります[3]。私たちの計算では、GaAs / AlAsSLの直接バンドギャップはハイブリッドDFT法によって2.06eVであると決定されており、これは実験値の2.10eVと一致しています[30]。
<図>
a のバンド構造 GaAs、 b AlAsと c GaAs / AlAs超格子。ハイブリッドDFT値は左側のパネルにプロットされ、DFTの結果は右側のパネルにプロットされます
GaAs / AlAs超格子のバンド構造に対するアンチサイト欠陥の影響
GaAs / AlAs SL構造では、Ga Al およびAl Ga アンチサイト欠陥は、他のポイント欠陥よりもエネルギー的に有利です。図5aおよびbに示すように、Ga Al のバンド構造 およびAl Ga 欠陥状態は元の状態と非常によく似ており、バンドギャップはそれぞれ1.98および2.01eVと決定されます。これは、AlとGaの化学元素が同様の原子価電子配置、つまり3s 2 を持っているという事実によるものと思われます。 3p 1 Alおよび4s 2 の場合 4p 1 Gaの場合、Ga Al の形成時に余分な電子や正孔は導入されません。 およびAl Ga アンチサイトの欠陥。 As Ga のバンド構造 およびAs Al 欠陥のある状態を図5cおよびdに示します。これらの2つの欠陥がGaAs / AlAsSLのバンド構造を大幅に変更していることがわかります。 As Ga の両方 およびAs Al アンチサイト欠陥は余分な電子を導入し、n型ドーパントとして機能します。図5cおよびdに示すように、不純物レベルは価電子帯から遠く、フェルミ準位と交差していることがわかります。これらの深い欠陥レベルは、キャリアの再結合中心として機能する可能性があります。

異なるアンチサイト欠陥を持つ欠陥のあるGaAs / AlAs超格子のバンド構造。 a :Al格子サイトを占めるGa; b :Ga格子サイトを占めるAl。 c :Ga格子サイトを占めるように; d :Al格子サイトを占めるように
図6は、Ga As を使用した欠陥SLのバンド構造と部分状態密度(PDOS)を示しています。 およびAl As 欠陥。図6aに示すように、Ga As のバンド構造 欠陥のあるSLはスピン分裂特性です。スピンダウンサブバンドでは、フェルミ準位はGa As によって導入された欠陥準位を通過します。 欠陥、欠陥のあるSLのハーフメタリック特性を示します。ハーフメタリックギャップの定義[31]によると、Ga As のバンドギャップ 不良状態は約0.10eVです。 Ga As を使用した欠陥のあるSLのPDOSに示されているように 、フェルミ準位近くのスピンダウンサブバンドは主に p によってもたらされます 部分波。 Ga原子とAl原子の間で価電子配置が類似しているため、計算されたAl As のスピンアップおよびスピンダウンバンド構造 欠陥状態が特定され(図6bを参照)、バンドギャップは0.15eVと計算されます。全体として、Al Ga およびGa Al アンチサイト欠陥は、GaAs / AlAsSLの電子構造にほとんど影響を与えません。 As Al を使用したSLの欠陥にも注意してください。 およびAs Ga 欠陥は金属性を示しますが、Ga As を含む欠陥のあるSLは およびAl As ハーフメタリックです。

a の欠陥のあるGaAs / AlAs超格子のバンド構造と部分状態密度 Ga As および b Al As アンチサイトの欠陥。 X As (X =GaまたはAl)As格子サイトを占めるX
GaAs / AlAs超格子のバンド構造に対する空孔欠陥の影響
異なる空孔を持つSL構造のバンド構造を図7にプロットし、対応するPDOSを図8に示します。バンド構造のスピン分裂特性は、V Gaを伴う欠陥のあるSLの場合にも見られます。 およびV Al 図7aおよびbに示すように、欠陥。実際、元の位置から原子を削除すると、 sp に関連する4つのダングリングボンドが残ります。 3 軌道。構造緩和中に、空孔の周りの最も近い原子が空格子サイトに向かって均等に変位し、正方晶の D によって定義されるサイト対称性が生じます。 2 d ポイントグループ。誘発された欠陥レベルは価電子帯の近くに現れ、GaAs / AlAsSLの禁止領域に位置します。バンドギャップは、V Ga のSLでは0.47および0.44eVと決定されます。 およびV Al それぞれ欠陥。 V Ga を使用した欠陥のあるSLのPDOSに示されているように およびV Al (図8aおよびbを参照)、グループIIIの空孔の主な影響は p にあります。 州。図7cに示すように、V As を持つ欠陥のあるSLのバンド構造 欠陥はスピンアップ部分とスピンダウン部分に分かれ、欠陥レベルは伝導帯の近くに現れます。 V As 以降 欠陥はn型ドーパントとして機能し、フェルミ準位はより高いエネルギーにシフトし、欠陥レベルのエッジを横切ります。 Kahaly etal。 GaAs-AlAsヘテロ界面の電気的特性を調査し、V As 界面の欠陥は準2-DEG [7]につながり、これは我々の結果と一致しています。私たちの計算によると、空孔はGaAs / AlAs SLのバンド構造、つまりV As にさまざまな影響を及ぼします。 欠陥はGaAs / AlAs SLの金属量を誘発し、V Ga およびV Al 欠陥はSL構造のバンドギャップを大幅に減少させます。

a の欠陥のあるGaAs / AlAs超格子のバンド構造 V Ga 、 b V Al および c V As 空室の欠陥。 V X (X =Ga、Al、またはAs)X空孔

a の欠陥のあるGaAs / AlAs超格子の部分状態密度 V Ga 、 b V Al および c V As 空室の欠陥。 V X (X =Ga、Al、またはAs)X空孔
GaAs / AlAs超格子のバンド構造に対する格子間欠陥の影響
図9は、格子間欠陥のあるSL構造のバンド構造を示しています。 III族の格子間原子がドナーのような欠陥であるという事実のために、フェルミ準位が高エネルギーにシフトし、伝導帯の端を横切ることに注意してください(図9aおよびbを参照)。その結果、Ga int の欠陥のあるSL およびAl int メタリックなキャラクターを見せてください。図9cに示すように、バンド構造のスピンアップ部分とスピンダウン部分では、不純物レベルが伝導帯の近くに現れ、フェルミレベルが不純物レベルの端を横切っており、欠陥のあるGaAs / AlAsSLの誘導金属量を示しています。 As int 。明らかに、格子間欠陥はGaAs / AlAs SLの電子構造を大幅に変化させ、一般に欠陥のあるSL構造の金属性を誘発します。

a の欠陥のあるGaAs / AlAs超格子のバンド構造 Ga int 欠陥、 b Al int 欠陥と c As int 欠陥。 X int (X =Ga、Al、またはAs)Xインタースティシャル
GaAs / AlAs SLのバンド構造と代表的なPDOSをアンチサイト、空孔、格子間原子と比較すると、Ga Al の場合を除いて、欠陥が電子構造を大幅に変更していることがわかります。 およびAl Ga アンチサイトの欠陥。さらに、バンドギャップの狭まりや金属性さえも誘発され、GaAs / AlAsSLの性能に大きく影響します。
GaAs / AlAs超格子の電子移動度に対する点欠陥の影響
0 Kでの電子移動度は、式μから計算できます。 =eτ / m ∗ 、ここで e は電子の電荷、τ は緩和時間であり、 m ∗ はキャリアの有効質量です[32]。電子の有効質量は、バンド構造の曲率から\({m} ^ {\ ast} ={\ mathrm {\ hslash}} ^ 2 {\ left(\ frac {d ^ 2 \ varepsilon } {dk ^ 2} \ right)} ^ {-1} \)[32]、ここでℏは縮小されたプランク定数 k は波数ベクトルであり、ε は伝導帯の最小エネルギーです。図4aおよびbに示すように、 m が得られます。 * =0.057 m e GaAsおよび m の場合 * =0.19 m e AlAsの場合、0.057 m の実験値とよく一致します。 e GaAs [33]および0.124 m の場合 e AlAs [34]の場合、 m e は静的電子質量です。 AlAsとGaAsの緩和時間はそれぞれ0.17と0.48psと想定されています[35]。 0KでのGaAsとAlAsの電子移動度は1.48×10 4 と計算されます。 cm 2 / Vsおよび1.57×10 3 cm 2 / Vsはそれぞれ、0.94×10 4 の実験値に相当します。 cm 2 GaAsの/ Vs [36]および0.28×10 3 cm 2 / Vs for AlAs [37]。
表5に示すように、Г点(\({m} _ {\ Gamma} ^ {\ ast} \))での電子の有効質量は0.113 m と決定されます。 e 手付かずのGaAs / AlAsSLと緩和時間τの場合 0.4psと想定されています[38]。ブリュアンゾーンのz方向、つまりΓ-X方向に沿った電子移動度(μ Γ− X )は0.623×10 4 と計算されます cm 2 理想的なGaAs / AlAsSLの/ Vs。これは実験値1.0×10 4 に相当します。 cm 2 / Vs [38]。アンチサイト欠陥のある欠陥SLについては、μの値 Γ− X Ga As の場合を除いて、理想的なSLの場合と同等です。 およびAl As 欠陥。 Γ-X方向に沿った電子移動度は、0.263×10 4 であると決定されます。 cm 2 / Vsおよび0.311×10 4 cm 2 / Vs for Ga As およびAl As それぞれ、理想的な状態よりもはるかに小さい欠陥状態。 Ga int 、Al int およびAs int 0.225×10 4 の値で示されるように、欠陥も電子移動度を大幅に低下させます。 cm 2 / Vs for Ga int 、0.243×10 4 cm 2 / Vs for Al int および0.315×10 4 cm 2 / Vs for As int 。アンチサイトおよびインタースティシャルの欠陥と比較して、欠員は最も深刻な影響を及ぼします。 V Ga の場合 およびV Al 欠陥、μの値 Γ− X 手付かずの状態の約6分の1です。 V As 0.127×10 4 で示されるように、欠陥も電子移動度を大幅に低下させます。 cm 2 /対。田中ほかGaAs / AlGaAsヘテロ構造の電気的特性に対する電子照射の影響を調査し、5×10 20 を超える線量で電子移動度が低下することを発見しました。 cm −2 [10]。特に、n-AlGaAs層ではなくGaAsチャネル領域での欠陥の発生が、移動度の低下の主な原因であると考えられています[10]。最近、電子が欠陥や不純物にトラップされ、格子緩和を伴う準安定状態を生成する可能性があることが示唆されています[39]。その結果、GaAs / AlAsSLの電子構造とキャリア移動度は点欠陥の影響を大きく受けます。したがって、GaAs / AlAs SLの放射線耐性を高めて、放射線環境下での電子性能を向上させる必要があります。
<図>結論
この作業では、GaAs / AlAs超格子(SL)の電気的特性に対する点欠陥の影響を調査するために、ハイブリッド密度汎関数理論研究が実行されます。計算された欠陥形成エネルギーは、アンチサイト欠陥がバルクGaAsおよびAlAsで最も有利であることを示しています。 GaAs / AlAs SL構造では、陽イオンに富む条件とAsに富む条件下では常にアンチサイト欠陥が支配的であり、化学ポテンシャルの全範囲で格子間欠陥を形成することは非常に困難です。異なる点欠陥がGaAs / AlAsSLの電子構造にさまざまな影響を与えることが示されています。 As X (X =AlまたはGa)およびX As X As の欠陥のあるSLはありますが、アンチサイトの欠陥は常に金属量を誘発します アンチサイトはスピン分裂を示します。空室については、V As の欠陥のあるSL は金属量特性を示し、グループIIIの空孔欠陥は超格子のバンドギャップを大幅に減少させます。金属量は、格子間欠陥のある欠陥のあるGaAs / AlAsSLにも見られます。さらなるキャリア移動度の計算は、格子間欠陥と空孔欠陥が電子移動度を大幅に低下させる一方で、アンチサイト欠陥の影響は比較的小さいことを示しています。
略語
- 2-DEG:
-
二次元電子ガス
- AIMD:
-
Ab initio 分子動力学
- Al:
-
アルミニウム
- AlAs:
-
ヒ化アルミニウム
- As:
-
ヒ素
- As X :
-
X格子サイトを占めるように
- DFT:
-
密度汎関数理論
- Ga:
-
ガリウム
- GaAs:
-
ガリウムヒ素
- HEMT:
-
高電子移動度トランジスタ
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
発光ダイオード
- N:
-
窒素
- PDOS:
-
部分状態密度
- QCL:
-
量子カスケードレーザー
- SL:
-
超格子
- VASP:
-
ウィーン Ab Initio シミュレーションパッケージ
- V X (X =Ga、Al、またはAs):
-
X欠員
- X As :
-
As格子サイトを占めるX
- X int :
-
Xインタースティシャル
- Zn:
-
亜鉛
ナノマテリアル
- スタックカップカーボンナノファイバーの原子および電子構造を明らかにする
- 超狭帯域完全吸収体と可視領域のプラズモニックセンサーとしてのその応用
- ボロフェンの安定性とSTM画像に関する第一原理研究
- TIPS-ペンタセンベースの有機電界効果トランジスタの移動度と形態に及ぼすその場アニーリング処理の影響
- Li-Nb-O化合物の調製と光触媒性能に及ぼすLi / Nb比の影響
- 微結晶およびナノセルロースの構造と誘電特性に及ぼす水の影響
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- らせん状溝管内のTiO2-水ナノ流体の流れと熱伝達特性に関する実験的研究
- メタマテリアルにおける表面プラズモンポラリトンと磁気双極子共鳴の結合効果
- Pt / Nd:SrTiO3接合におけるマルチレベル抵抗スイッチングメモリとメモリ状態依存光起電力に関する研究
- サイズ、修正、欠陥、およびドーピングによるグラフェン仕事関数の設計と調整:第一原理理論研究



