異なる層間距離と外部電場を持つ二分子膜α-GeTeの調整可能な電気的性質
要約
第一原理計算に基づいて、安定性、電子構造、光吸収、および異なる層間距離または二層α-GeTeの外部電場による変調された電子特性が体系的に調査されます。結果は、ファンデルワールス(vdW)二重層α-GeTeが0.610 eVのギャップ値を持つ間接バンド構造を持ち、α-GeTeが魅力的に効率的な光収穫を持っていることを示しています。興味深いことに、層間距離の減少に伴い、層間vdW相互作用の強化により、二重層α-GeTeのバンドギャップは直線的に減少します。さらに、バンドギャップ遷移は、正の電界の印加下での電界誘起近自由電子ガス(NFEG)に起因します。ただし、負の電界が印加された場合、NFEGはありません。二分子膜α-GeTeのこれらの特性のために、可能なデータストレージデバイスが設計されました。これらの結果は、二分子膜α-GeTeが新しい電子および光電子デバイスで機能する可能性があることを示しています。
はじめに
グラフェンの成功[1、2]は、六方晶窒化ホウ素(h-BN)[3]、遷移金属ジカルコゲナイド(TMD)[4]、遷移金属などの新しい2次元(2D)材料の研究を刺激しました。炭化物(MXenes)と窒化物[5]、およびvan der Waals(vdW)ヘテロ構造[6]。これらの2D材料は、調整可能な電子特性[9]と引張ひずみ下での優れた柔軟性[10]により、電子または光電子アプリケーション[7、8]で機能します。ただし、2D材料には、空気中のフォスフォレンの容易な分解[11]、正孔移動度の低さ、セレン化インジウム(InSe)の可視光の弱い吸収[12]など、多かれ少なかれ課題があります。グラフェン[7]、シリセン[13]、およびゲルマネン[14]のゼロバンドギャップ。したがって、優れた安定性、高いキャリア移動度、および望ましいバンドギャップを備えた新しい2D材料を調査する必要があります。
過去数年間、バルクα-GeTeは、不揮発性相変化メモリ技術[15、16]、ニューロミメティックコンピューティングアプリケーション、熱電[17、18]などのさまざまな分野で適用されてきました。最近、ナノ構造のα-GeTeは、原子層堆積(ALD)[17]、蒸気-固-液体(VLS)法[18]、および表面安定化ポリマーを使用した化学的方法[19]によって広く製造されています。ナノ構造のα-GeTe[20]相は、バルクのα-GeTe[19]よりも結晶化温度が高く、融点が低くなっています。最も重要なことは、α-GeTeは、Ge原子とTe原子が結合した座屈した原子層を持つIV-VI半導体です。 α-GeTeの層間には弱いvdW力があります。
ごく最近、Zhangらによってエタノールに分散されたα-GeTe粉末に超音波処理支援液相剥離を適用することにより、2〜4層の数層α-GeTeナノシート、さらには単層α-GeTeが得られました。 [21]。しかし、外部電場と垂直ひずみを使用した2Dα-GeTeの電子特性の変調に焦点を当てた理論的研究はほとんどありません。これらは両方ともバンドギャップ工学で効果的な方法です[22]。事実を考慮すると、潜在的なアプリケーションでは、単層よりも多層構造の方が利用可能です。したがって、最も典型的な多層構造である二層α-GeTeの研究は、2Dα-GeTeナノシートの潜在的な開発に不可欠です。この論文では、第一原理計算に基づいて、安定性、バンド構造、光吸収、および異なる層間距離と二層α-GeTeの外部電場による変調電子特性を体系的に調査します。私たちの研究は、vdW二重層α-GeTeが新しい電子およびオプトエレクトロニクスデバイスの可能性があることを証明しています。
計算方法
すべての計算は、Vienna Ab initio Simulation Package(VASP)[23、24]に実装されている投影増強波(PAW)法を使用して、スピン偏極密度汎関数理論(DFT)に基づいて実行されます。 Perdew-Burke-Ernzerhof(GGA-PBE)[25]の一般化された勾配近似は、電子交換と相関を説明するために選択されています。 vdWの相互作用は、半経験的DFT-D3法を使用して考慮されます[26]。平面波のカットオフエネルギーは、総エネルギーの収束を確実にするために500 eVに設定され、15×15×1kポイントメッシュがブリルアンゾーン積分用に選択されています。周期スラブ間の相互作用を分離するために、 z の真空空間 方向は30Åに設定されています。力とエネルギーが0.01eV /Åと10 -5 に収束するまで、格子ベクトルと原子位置は完全に緩和されます。 それぞれeV。 GGA-PBE法は通常、半導体のバンドギャップを過小評価するため、Heyd–Scuseria–Ernzerhof(HSE06)[27]法を使用して、半導体のギャップ値とバンドエッジを正しく計算します。したがって、電子構造と光学特性は、HSE06を使用して計算されます。フォノンバンド構造は、Phonopy [28]で実装されている密度汎関数摂動理論(DFPT)を使用して実行されます。これは、準調和近似法を採用して、最小エネルギー構造の近傍の位置エネルギー超表面を分析します。
結果と考察
幾何学的構造
単分子層α-GeTeは、Ge原子が一方の層にあり、Te原子がもう一方の層にある座屈した原子層を持つ六角形の構造を持っています。最適化された格子定数、結合長、および単分子層α-GeTeの角度は、a =b =3.95Å、 L です。 Ge-Te =2.776Å、およびθ =91.497°、それぞれ。格子定数単分子層α-GeTeも以前の報告[21]と一致しています。二分子膜α-GeTevdWヘテロ構造の場合、図1に示すように、2種類の対称性の高いスタッキング構造、つまりAAスタッキングとABスタッキングが考慮されます。AAスタッキングは六角形のスタッキング配置を示します。 ABスタッキングはバルクα-GeTeの構造としてベルナルスタッキング機能を備えています。相対的な安定性を評価するために、2つのスタッキング構造の合計エネルギーがそれぞれ計算されます。結果は、AAスタッキングの総エネルギーがABスタッキングの総エネルギーより147meV少ないことを示しています。二分子膜α-GeTeのより安定した構造はAAスタッキングであり、そのバルクの構造とは異なります。また、AAスタッキング二重層α-GeTeの場合、計算された平衡距離は2.920Åです。図2に示すAAスタッキング二重層α-GeTeの計算されたフォノン分散は、フォノンスペクトルに仮想周波数がないため、AAスタッキング二重層α-GeTeが安定していることを示しています。また、実験では安定した2層α-GeTeが得られています[21]。したがって、AAスタッキング二重層α-GeTeについては、主に次のセクションで説明します。

上面図( a )および側面図( c )AAスタッキング二重層α-GeTeの。上面図( b )および側面図( d )ABスタッキング二重層α-GeTe

AAスタッキング二重層α-GeTeのフォノンバンド分散
電子構造
二重層α-GeTeの電子特性を明確に理解するために、図3aに示すように、単分子層α-GeTeのバンド構造と投影状態密度(PDOS)が計算されます。伝導帯の最小値(CBM)はM点とΓ点の間にあり、価電子帯の最大値(VBM)はΓ点にあります。これは、単分子層α-GeTeがエネルギーギャップ値1.796eVの間接バンドギャップ半導体であることを示しています。 、以前の結果とよく一致している[21]。 PDOSによると、CBMは主にGe-s、Ge-p、およびTe-pの状態で構成されていますが、VBMの状態はGe-pおよびTe-pの状態に起因しています。二分子膜α-GeTeの場合、投影されたバンド構造が図3bにプロットされており、ギャップ値が0.610eVの間接バンドを示しています。二分子膜α-GeTeのCBMは、M点とΓ点の間にある下層によって支配されますが、VBMは、主に、Γ点とK点の間にある上層からの状態によって寄与されます。二分子膜α-GeTeの投影されたバンド構造が単分子層成分の合計であるように見えるという興味深いことがあります。これは、典型的な弱いvdW相互作用が二重層α-GeTeに存在することを示しています。二重層α-GeTeについてさらに洞察を得るために、図3cに示すように、VBMとCBMのバンド分解電荷密度が計算されます。 CBMとVBMのバンド分解電荷密度は明らかに異なります。最低エネルギーの電子と最高エネルギーの正孔の状態は、それぞれ下層と上層に局在し、タイプIIのバンドエッジ配列を持つ電子と正孔の効果的な分離を引き起こします。したがって、空間的に間接的な励起子の再結合は、光電子工学のアプリケーションにとって重要な、二重層の千鳥状のギャップを介して発生します[12]。

a 単分子層α-GeTeのバンド構造と部分状態密度。投影されたバンド構造( b )二重層α-GeTeの青い線(下層)と赤い線(上層)で示されます。バンド分解電荷密度( c )二分子膜α-GeTeのVBMとCBMの比較
光学特性
オプトエレクトロニクスデバイスの光吸収を研究することは非常に重要です。周波数依存の誘電関数に基づくε (ω )、吸光係数 a (ω )単分子層および二重層のα-GeTeは、式[12、22]に従って計算できます。
$$ \ alpha \ left(\ omega \ right)=\ sqrt {2} \ omega {\ left [\ sqrt {\ omega_1 ^ 2 \ left(\ omega \ right)+ {\ omega} _2 ^ 2 \ left( \ omega \ right)}-{\ omega} _1 \ left(\ omega \ right)\ right]} ^ {\ raisebox {1ex} {$ 1 $} \!\ left / \!\ raisebox {-1ex} {$ 2 $} \ right。} $$ここで、ε 1 (ω )およびε 2 (ω )は、それぞれ複素誘電関数の実数部と虚数部です。図4に、得られた単分子層、二重層、バルクα-GeTeの吸光係数を示します。単分子層α-GeTeには、単分子層α-GeTeの伝導帯と価電子帯の間の遷移に応じて、3つの吸収ピークがあります。そして、紫外線と深紫外線領域で明らかな光吸収があります。ただし、二重層α-GeTeは、可視領域と赤外領域でも明確な光吸収を示します。二分子膜α-GeTeと同様に、バルクα-GeTeは深紫外線から赤外線までの幅広い光吸収を示し、光吸収強度は10 5 のオーダーに達する可能性があります。 cm -1 。この増強された光吸収強度は、単層および二層α-GeTeと比較して、バルクα-GeTeの層数の増加によって引き起こされます。したがって、α-GeTeは、太陽エネルギーの利用効率が高いため、オプトエレクトロニクス用途の有望な材料となる可能性があります。
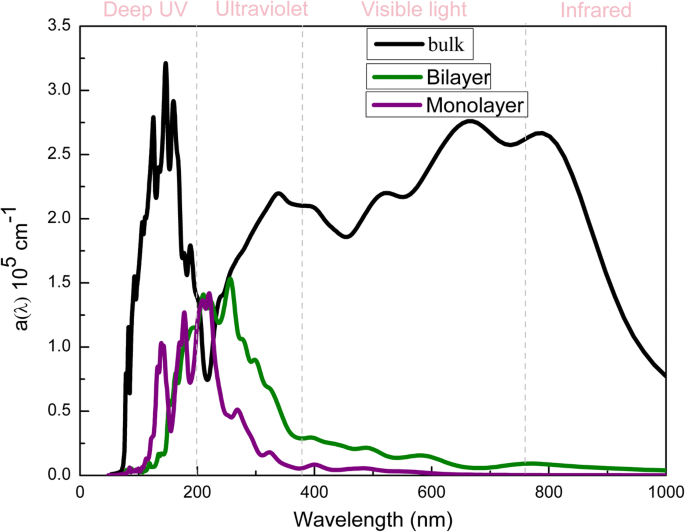
単層および二層α-GeTeの吸収係数
垂直ひずみの影響
垂直ひずみを適用することは、二重層材料の電子特性を調整するための効果的な方法です。図5aは、層間距離の関数としてのバンドギャップを示しています。結合エネルギー( E b )は次の式で計算されます[22]:
$$ {E} _ {\ mathrm {b}} ={E} _ {\ mathrm {b} \ mathrm {ilayer}}-2 {E} _ {\ mathrm {monolayer}} $$ここで E 二重層 および E 単層 それぞれ、二分子層と単分子層のα-GeTeの総エネルギーです。 2.420から3.520Åまでの層間距離の変化により、結合エネルギーはすべて負になります。さらに重要なのは、 d との距離です =2.920Åは E の最小値に対応します b 、最も安定した構造を示します。さらに、二重層α-GeTeのバンドギャップは、異なる層間結合によって連続的に調整することができます。バンドギャップは単調に増加しますが、すべてのバンド構造の形状は、距離が2.420から3.520Åまで変化しても変化しません。図5bでは、2.420Åと3.520Åの層間距離を持つ二重層α-GeTeのバンド構造がプロットされています。 CBM1とVBM1は層間距離3.520Åに対応し、CBM2とVBM2は層間距離2.420Åに関連しています。層間距離の減少に伴ってVBMが上昇する一方で、CBMは低下します。バンドギャップは、vdW層間相互作用と軌道の重なりの強化により、二重層α-GeTeの層間距離の増加とともに増加します。同様の振る舞いは、二重層InSe [22]にも見られます。
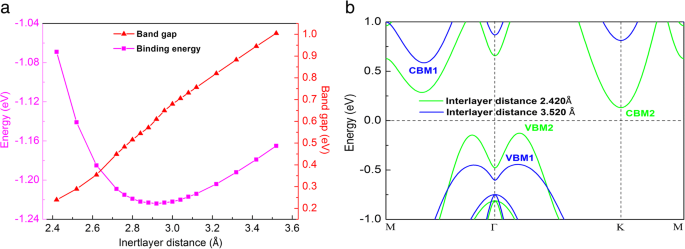
結合エネルギーとバンドギャップの変化( a )層間距離の関数としての二重層α-GeTeの。バンド構造( b )2.420Åおよび3.520Åの層間距離を持つ二重層α-GeTeの
外部電界の影響
2D vdW二重層の電子特性を調整する別の効果的な方法は、垂直外部電界を適用することです。有効な結果を得るために、平面双極子層が真空領域の中央で実行され、電界を適用したすべての計算で対称性が失われます[29]。さらに、正の方向は、下層から上層を指すものとして定義されます。図6では、電界を印加した場合の値( E )により、二重層α-GeTeのバンドギャップが微妙に変化します。 app )は0.01から0.64 V /Åまで変化します。 E の場合 app 臨界値( E )よりも小さい(または大きい) c )、二重層α-GeTeのバンドギャップは非常に迅速かつ直線的に低下します。次に、 E まで、二重層α-GeTeの半導体から金属への転移が起こります。 app 通常の値( E )よりも小さい(または大きい) t )。これらの結果は、印加電界強度が大きいほど、2つの層間の混成が強くなることを示しています。
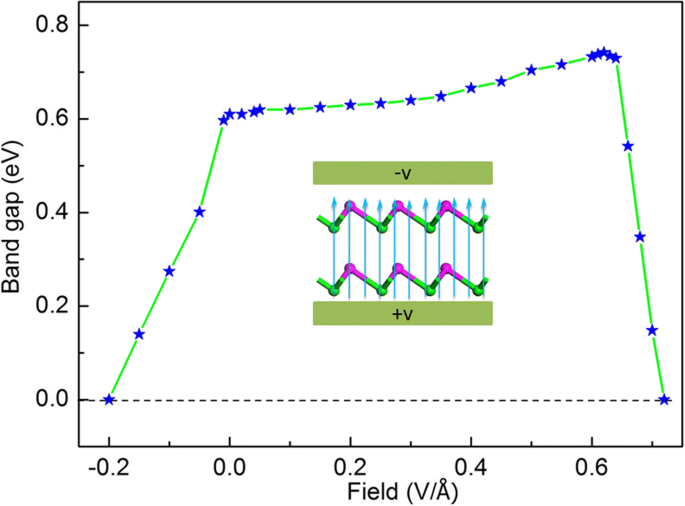
印加する垂直電界の関数としての二重層α-GeTeのバンドギャップの変化。色付きの水平の破線はゼロギャップにシフトされます
特に、 E の範囲 c – E t は0.01–0.20 V /Åであり、負の電界を印加すると、 E の範囲よりも明らかに大きくなります。 c – E t (0.64–0.72 V /Å)正の印加電界で。印加された垂直電場の下でのバンドギャップ遷移を理解するために、図7に示すように、選択された外部垂直電場の下での二重層α-GeTeの投影バンド構造が計算されました。 E app =−0.20および E app =− 0.10 V /Å、二重層α-GeTeのCBMとVBMも、それぞれ下層と上層の影響を受けます。垂直電界の印加により、CBMとVBMの両方がフェルミ準位に近づき、最終的に E で半導体-金属転移が達成されます。 app =− 0.20V /Å。他方、正の印加電界の増加に伴い、下層のバンド構造のエネルギー準位は徐々に増加し、逆もまた同様である。その結果、 E の場合、上層と下層はそれぞれ二重層α-GeTeのCBMとVBMに起因します。 app ≥0.64V/Å。さらに、シアンの線で示されている正の電界が印加されると、追加の伝導帯が現れます。これらのバンドは、下層または上層の影響を受けません。これは、ほぼ自由電子ガス(NFEG)の特徴を示しています[30]。 NFEGバンドのエネルギーレベルは、印加電界の増加に伴って非常に急速に低下します。 E の場合 app ≥ E c 〜0.64 V /Å、CBMはNFEGバンドで構成されていました。 E の場合 app ≥ E t 〜0.72 V /Å、NFEGバンドはフェルミ準位に近く、下層のVBMはNFEGバンドと接触しており、金属バンド構造の特徴を示しています。そして、電界の正の印加下での二分子膜α-GeTeのバンドギャップ変動傾向をさらに分析します。 E の場合 app < E c 、バンドギャップは、CBMとVBMの間のエネルギー準位の差に依存します。これは、電界の印加に敏感ではありません。したがって、バンドギャップは比較的安定しています。 E の場合 c < E app < E t 、NFEGバンドがCBMを引き継ぎ、バンドギャップの変化を支配します。 NFEGバンドのエネルギーレベルが急激に低下すると、バンドギャップは急激かつ直線的に減少します。 E の場合 app < E t 、NFEGバンドのエネルギーレベルはVBMのエネルギーレベルよりも低くなります。したがって、二重層α-GeTeの半導体-金属転移は、電場によって誘発されたNFEGに由来します。さらに、二重層α-GeTeは2倍以上の E を持っています t 二分子膜InSeの[29]は、二分子膜α-GeTeの半導体-金属転移がより多くの電圧を必要とすることを示しています。

異なる外部垂直電界下での青い線(下層)と赤い線(上層)で示される二重層α-GeTeの投影されたバンド構造
上記の結果に基づいて、図8に示すように、2層α-GeTeを使用した可能なデータストレージデバイスが設計され、その概略構造が構築されています。2層α-GeTeは薄いSi / SiO 2 基板。同じSi / SiO 2 2Dα-GeTeを空気から保護するために、層は二重層α-GeTeで覆われています。大面積のグラフェン膜は、その高い光透過率と導電率により、ソース電極とドレイン電極に転写されて使用されます[31]。ネイティブ二重層α-GeTeは、ソース電極とドレイン電極の間の電気抵抗が高いオフ状態の半導体です。電界誘起NFEGは、 E によって二重層α-GeTeをゼロギャップに変調することができます。 app ≥ E t 下から上へSi。これは、ソース電極とドレイン電極の間の電気抵抗がゼロのオン状態を意味します。印加電界が引き抜かれるとき、NFEGとON状態をこの電界効果トランジスタ(FET)デバイス内に保つことができます。負の電界が印加されると、二重層α-GeTeのNFEGが消去されます。したがって、半導体および金属バンド構造の機能を備えたオフ状態とオン状態は、2層のα-GeTeベースのデータストレージデバイスに保存できます。
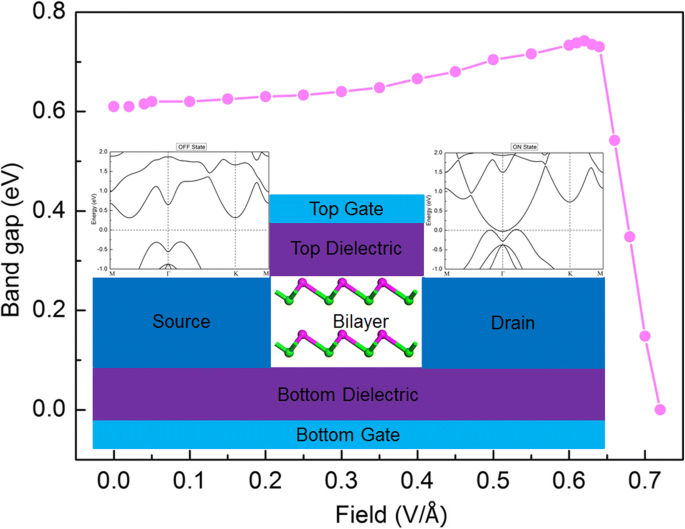
印加電界の関数としての二重層α-GeTeのバンドギャップ。挿入図は概略モデルです
結論
要約すると、二重層α-GeTeの安定性は、vdW補正された第一原理に基づいて結合エネルギーとフォノンバンド分散を計算することによって調査されます。 vdW二重層α-GeTeには、典型的なタイプIIのバンドアラインメントを持つ間接バンドギャップがあります。特に、α-GeTeは光吸収範囲と強度が向上しています。さらに、二重層α-GeTeのバンドギャップは、垂直ひずみを加えることと外部垂直磁場を加えることによって調整することができます。正の電界が印加された場合にのみ、NFEGが存在します。また、電界によって誘発されるNFEGにより、バンドギャップが非常に急速に変化する可能性があります。これらの優れた特性に基づいて、二層α-GeTeに基づく可能なデータ記憶装置が提案されている。これらの結果は、二重層α-GeTeのバンドギャップ遷移の根本的なメカニズムを説明しています。全体として、効果的な電荷分離、広い光吸収スペクトル、高い光吸収強度、およびNFEG機能により、2層のα-GeTeポテンシャル材料が2D材料ベースの電子および光電子デバイスで機能します。
略語
- 2D:
-
二次元
- ALD:
-
原子層堆積
- CBM:
-
伝導帯の最小値
- DFT:
-
密度汎関数理論
- E app :
-
印加電界の値
- FET:
-
電界効果トランジスタ
- GGA-PBE:
-
Perdew-Burke-Ernzerhofの一般化された勾配近似
- h-BN:
-
六方晶窒化ホウ素
- HSE06:
-
Heyd–Scuseria–Ernzerhof
- InSe:
-
セレン化インジウム
- MXenes:
-
遷移金属炭化物
- NFEG:
-
ほぼ自由電子ガス
- PAW:
-
投影-拡張波
- PDOS:
-
予測される状態密度
- TMD:
-
遷移金属ジカルコゲニド
- VASP:
-
ウィーンabinitioシミュレーションパッケージ
- VBM:
-
価電子帯の最大値
- vdW:
-
ファンデルワールス
- VLS:
-
蒸気-固体-液体
ナノマテリアル
- 電界と静電容量
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- ナノカーボンフィラーの電界支援配向による複合材料の電気的性質
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- 異なる粒子サイズのアベルメクチンナノデリバリーシステムの製造、特性評価、および生物活性
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- 自動車 PCB の特性と設計上の考慮事項
- 電子と電気の違いは?
- さまざまな工具鋼の特性とグレード



