深紫外線フリップチップ発光ダイオードの光抽出効果に及ぼすメッシュp型接触構造の影響
要約
この作業では、さまざまなメッシュ接触構造を備えたフリップチップAlGaNベースの深紫外線発光ダイオード(DUV LED)を、3次元有限差分時間領域(3D FDTD)法によって体系的に調査します。横方向電気(TE)および横方向磁気(TM)偏光抽出効率(LEE)の両方が、メッシュ構造の間隔と傾斜角に敏感であることが観察されます。また、メッシュ構造に大きな充填率を採用した場合、p-GaN層吸収、Al金属プラズモン共鳴吸収、メッシュ構造による散乱効果の競合により、LEEが増加しないことがわかります。 。ハイブリッドp-GaNナノロッド/ p-AlGaNトランケートナノコーンコンタクトで発生する非常に強い散乱効果は、TE偏光とTM偏光の両方のLEEを大幅に向上させることができます。たとえば、傾斜角が30°の場合、TEのLEEは-およびTM偏光は、280 nmの発光波長でそれぞれ〜5倍および〜24倍に増加する可能性があります。
はじめに
AlGaNベースの深紫外線発光ダイオード(DUV LED)は、浄水、医療光線療法、検出、光触媒などの分野で大きな応用の可能性を秘めています[1,2,3]。ただし、外部量子効率(EQE)の高いDUV LEDは、特に発光波長が短くなると、依然として入手が困難です。 LEDのEQEは、ηで表される内部量子効率(IQE)の積で計算できます。 IQE ηで表される光抽出効率(LEE) LEE 、つまりη EQE =η IQE ・η LEE 。現在、従来のフリップチップ構造のDUV LEDのEQEは10%未満であり、7〜9%の低いLEEによって強く制限されています[4]。これまでのところ、DUV LEDの世界記録最高のEQEは275nmの波長で20%であり、このような高いEQEは、パターン化されたサファイア基板などのさまざまな高度なLEE技術を統合することによって可能になる著しく強化されたLEEのおかげで達成されます。透明なp電極、および高度なパッケージ技術[5]。したがって、高効率DUVLEDを実現するためにLEEを改善することが本質的に重要になります。 LEEは、全反射(TIR)と、AlGaNと空気( n )間の大きな屈折率コントラストによって引き起こされるフレネル損失の影響を大きく受けることはよく知られています。 空気 =1および n AlGaN =2.6)[6]。さらに、AlGaNベースの量子井戸のAl含有量の増加は、横磁気(TM)偏光の優位性をもたらします。これは、DUVLEDから抽出される前にエスケープコーンに伝播するのが困難です[7]。 LEEを増加させるために、一方では、粗面[8]、パターン化されたサファイア基板[9]、傾斜した側壁[10]、表面プラズマポラリトン[11]などのさまざまな技術が広く適用されており、そうすることで散乱が発生します。光子のサファイア基板からの脱出確率を高めるのに役立つ中心を生成できます。 LEEを制限するもう1つの障害は、正孔濃度の高いAlリッチp-AlGaN層の成長が困難なため、吸収性p-GaN接触層から生じます[5]。したがって、DUV LEDのp-GaN層によって引き起こされる光吸収を低減することが重要であり、提案された方法には、メッシュp型接触電極[12、13]、分布ブラッグ反射鏡(DBR)/全方向反射鏡が含まれます。 (ODR)[14、15]、およびフォトニック結晶[16]。提案されたアプローチの中で、メッシュ化されたp型接触電極は効果的であり、より安価である。 Lobo etal。マイクロメートルスケールのp型接触パターンを報告し、光抽出の改善に効果的であることが証明されました[13]。ただし、ナノメートルスケールのメッシュp型接触電極の調査はほとんど行われていません。その上、LEEに対するマイクロメートルスケールのメッシュp型接触電極の散乱効果は以前の報告では無視されています。ナノメートルスケールのp型接触電極での散乱効果により、LEEがさらに増加すると考えられます。
この論文では、DUVLEDのLEEに及ぼすナノスケールメッシュ接触構造とAlリフレクタの影響を数値的に調査します。 p-GaNナノロッドコンタクト、ハイブリッドp-GaNナノロッド/ p-AlGaNナノロッドコンタクト、ハイブリッドp-GaNナノロッド/ p-AlGaNトランケートナノコーンコンタクトなど、さまざまなメッシュコンタクト構造が研究されています。この作業では、3次元有限差分時間領域(3D FDTD)シミュレーションを使用して、提案された構造の可変パラメーターに対するLEEの依存性を調査します。最適化されたハイブリッドp-GaNナノロッド/ p-AlGaNトランケートナノコーンメッシュコンタクトを備えたLEDにより、横方向の電気(TE)およびTM偏光に対してそれぞれ5倍以上および24倍以上のLEE増強が可能になることがわかりました。
モデルとシミュレーションの方法
私たちの研究で使用されているシミュレーターは、時間依存のマクスウェル方程式を解いて有限構造の電磁界分布を計算できるLumerical FDTDソリューションによって開発されています[17、18]。図1aは、従来のフリップチップDUVLEDのシミュレーションモデルを示しています。シミュレートされた構造の上部にAl反射体の層が固定され、光子を反射して透明なサファイアに戻し、ほとんどの光を抽出できるようにします[19]。 AlリフレクターはUVスペクトル範囲で92%もの反射率を持っていることに注意してください[20]。金属散逸メカニズムは、シミュレーション中に修正されたドルーデモデルによって記述されます[21]。 p-GaN層、n-AlGaN層、サファイアの厚さは、それぞれ100 nm、1.5 µm、1 µmに設定されています[12]。 n-AlGaN層とp-AlGaN層の間に複数の量子井戸(MQW)が埋め込まれており、全体の厚さは100nmです。さらに、MQW領域の中央に単一の双極子を設定し、電子正孔再結合を表す双極子を設定しました[22]。ダイポールソースのスペクトルのピーク発光波長は280nmに設定されています。ダイポールソースは、 X に平行または垂直な方向に偏光されます。 -それぞれTEまたはTMモードを励起するための軸[23]。 Z -軸は、DUVLEDのC平面に垂直です。したがって、TE偏光とTM偏光は、それぞれ主にYZ平面とXY平面を伝搬します。 AlGaN層、MQW、およびGaN層の発光波長280 nmでの吸収係数は、10 cm -1 であると想定されています。 、1000 cm -1 、および170,000 cm -1 、 それぞれ。 AlGaN層、GaN層、およびサファイアの材料の屈折率は、それぞれ2.6、2.9、および1.8であると想定されています[23、24]。計算された構造の横方向の寸法は8×8μm 2 に設定されています 。 4つの横方向の境界の境界条件は、有限の横方向の寸法が無限であると推測できるように、100%の反射率を持つと想定されています[25]。上部と下部の境界の条件は、電磁エネルギーを完全に吸収できる完全一致層(PML)を持つように設定されています。私たちのモデルでは、シミュレーションを実行するときに不均一なメッシュが適用され、最小メッシュサイズは5 nmに設定されています。これにより、LEEの計算に優れた精度が提供されます。パワーモニターは、サファイアから300 nm離れた場所に配置され、モニターを介して電力伝送を収集し、近接場電界放射を記録します。近接場電場は、フーリエ変換を実行することによって遠方場電場に変換されます。 LEEは、パワーモニターから収集された総抽出電力とダイポールからの総放出電力の比率をとることによって計算されます[26]。パワーモニターから収集されたパワーは、パワーモニター表面全体の遠方界パワー分布を統合することによって得られます。
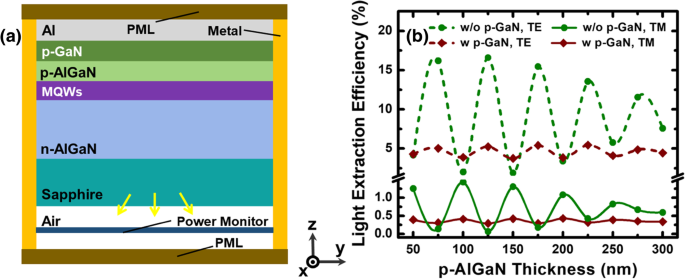
a 従来のフリップチップDUVLED構造の3DFDTD計算モデルの概略側面図。 b p-AlGaNの厚さの関数としてのp-GaNを含むDUVLEDとp-GaNを含まないDUVLEDのTEおよびTM偏光LEE
結果と考察
LEEに対する光共振器の厚さの影響
よく知られているように、光共振器効果は、p型層の厚さに敏感なフリップチップLEDのMQWの放射モードを調整できますが、p型層の厚さはLEEに大きな影響を与えます[27]。 。したがって、最初に、従来のLED構造のTE偏光およびTM偏光LEEに対するp-AlGaN層の厚さの影響を調べます。 p-AlGaN層の厚さは、MQWとAlリフレクター間の距離も表します。図1bに示すように、すべてのLEE曲線は、p-AlGaN層の厚さで周期的な振動を示し、周期は約50nmです。振動挙動は、光源からの光とAlミラーによって反射された光との間の建設的な干渉によって導入される光共振器効果によるものです。干渉理論によれば、周期はΔ d で計算できます。 =λ / 2 n AlGaN =53 nm [21]、これは図1bのシミュレーション結果とよく一致しています。さらに、TM偏光のピークLEEは、TE偏光のピークLEEと反対です。フレネルの式とミュラー行列[28]によると、2つの線形等方性媒体間の界面からのTE偏光とTM偏光の反射には、異なる反射振幅と位相シフトがあります。さらに、強いp-GaN層の吸収は光共振器効果を弱めますが、100nmの厚さのp-GaN層を備えたLEDのLEEは依然として小さな振幅変動を示すことがわかります。 p-GaN層を備えたLEDの光共振器効果が弱いため、TE偏光とTM偏光の両方で、p-GaN層を備えたLEDの最小LEEは、p-GaNを備えていないLEDの最小LEEよりも大きくなります。図1bに示すような層。一方、TM偏光の平均LEEはTE偏光の平均LEEの10分の1であり、ここでの結果は[23]の結果と一致していることも観察できます。さらに、p-GaN層のないLEDは、TE偏光とTM偏光の最大LEEがそれぞれ16%と1.5%であるのに対し、これらの数値は5%と0.5%にすぎないことに注意してください。それぞれp-GaN層を備えたLED。したがって、LEEの3倍の向上は、p-GaN層のないLEDで得られます。これは、TE偏光とTM偏光の両方がp-GaN層によって大幅に吸収されることを示しています。これは、一部の光が逃げるために複数の反射を経験する必要があり、p-AlGaNの最適化された厚さも最良の光共振器効果を引き起こすためです。したがって、p-GaNからの吸収を減らすことは、DUV LEDのLEEにとって非常に重要であり、LEEを2倍以上増やすことができます。
LEEに対するメッシュp-GaNコンタクトの影響
p-GaN層の吸収を減らすために、p-GaNはサブマイクロコンタクトにメッシュ化されてLEEを増加させます。図1aの従来のフリップチップDUVLEDに基づいて、p-GaN層は、Alリフレクターに埋め込まれたナノロッド用に設計され、正方形のアレイを備えたp型サブマイクロコンタクト電極(図2aを参照)を形成します。 (図2bを参照)。 p-GaNナノロッドの高さは100nmに設定されています。 p-GaNナノロッドの直径は250nmに固定されており、その数は発光波長に近いものです。最適化されたp-AlGaN層の厚さは、図1bに従って125nmに設定されています。メッシュ状のp-GaN接点を備えたDUVLEDの場合、間隔が最も重要です。一方では、間隔を狭くすると、電流がアクティブ領域全体により効率的に拡散します。一方、間隔を狭くすると、メッシュ化されたp-GaN接点の充填率が高くなり、吸光度が高くなります。したがって、優れた電流拡散と優れたLEEの両方を可能にする最適化された間隔は、提案されたDUVLEDにとって非常に重要です。次に、図2cで、LEEに対する間隔の影響を調査して示します。予想通り、従来のDUV LEDと比較して、メッシュp-GaN接点を備えたDUVLEDのTE偏光およびTM偏光LEEは大幅に改善されています。 TE偏光のLEEは、間隔が125 nmに達するまで間隔が長くなるにつれて増加します。これは、p-GaNの充填率が低下した結果、p-GaNの吸収が低下するためです。また、間隔が約125 nmの場合、LEEは3倍以上に向上します。ただし、125 nm以降、TE偏光のLEEは充填率とともに減少します。間隔が125nmを超える場合の観察結果は、LEEに重要な影響を与える別の要因があることを示唆しています。 [29]の報告によると、光子の消光長は1 / L で表すことができます。 消滅 =1 / L 散乱 + 1 / L 吸収 、ここで L 散乱 および L 吸収 それぞれ散乱長と吸収長に対応します。 LEEは主に材料の吸収と構造散乱に依存するため、間隔が125 nmより大きい場合、メッシュのp-GaN接触によって引き起こされる散乱効果がLEEに主に影響を与えると推測できます。

a メッシュ化されたp-GaN接点を備えたフリップチップDUVLEDの概略側面図。 b メッシュ化されたp-GaN接触分布の概略上面図。 c p-AlGaNの厚さが125nmの場合のナノロッドの間隔の関数としてのメッシュp-GaN接点を備えたDUVLEDのLEE
メッシュ化されたp-GaN接点による散乱効果を確認するために、吸収性材料を含まないモデルを設定し、GaN材料の吸収係数を0に設定し、Al反射体をほぼ100の完全電気導体(PEC)に置き換えます。 %反射率。シミュレーション結果は図3aの黒い四角線でプロットされています。間隔が大きくなると、LEEが増加してから減少することがわかります。すなわち、p-GaNサブマイクロコンタクトの散乱効果は増加し、その後、スペースの増加とともに減少します。したがって、メッシュ化されたp型GaN接点の間隔を大きくすると、散乱効果が抑制されます。これは、間隔が50 nmより大きい場合、間隔が大きくなるとLEEが減少するという図3aの観察結果を解釈します。
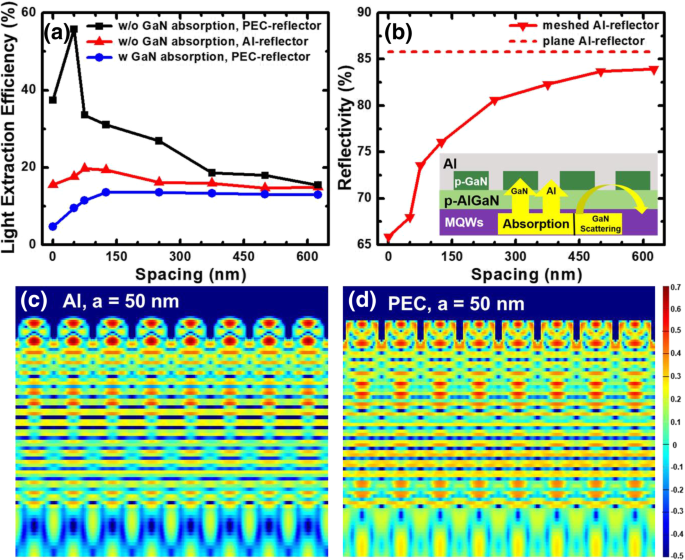
a 高さ100nmの非吸収性/吸収性p-GaNナノロッドを備えたDUVLEDのナノロッド間隔の関数としてのLEE、および反射体はそれぞれAlとPECです。 b ナノロッド間隔の関数としてのメッシュAlリフレクターと平面Alリフレクターによる垂直入射の反射率。挿入図は、メッシュ化されたp-GaN接点を備えたDUV LEDにおける、p-GaN層の吸収、Al金属の吸収、および構造散乱の影響を示しています。 c を使用した50nmのナノロッド間隔での電界の断面分布 Alと d PECリフレクター
さらに、GaNの吸収を0に設定し、Al反射体を適用すると、LEEも最初に増加し、次に図3aに示す赤い三角形の線のように減少します。ただし、Alリフレクタを備えた構造の最大LEE 20%は、PECリフレクタを備えた構造の最大LEE 56%よりもはるかに小さくなっています。図3bは、メッシュAlリフレクターの間隔に対する反射率の依存性を示しています。メッシュAlリフレクターの反射率は、間隔が狭くなるにつれて低下します。言い換えれば、間隔が狭くなると、Al金属の表面が粗くなります。したがって、粗い金属表面の反射率の低下は、表面プラズモンの励起と表面効果に起因する可能性があります[30、31、32]。粗い金属表面は、吸収された光と表面波励起(表面プラズモン)につながる入射光の位相を変調するものとします。表面効果により、表面のピットに光が閉じ込められ、最終的に吸収されます。また、Al反射器とPEC反射器の入射源として平面波を用いた断面電界分布を図1、2に示します。それぞれ3cとd。 Alリフレクターを備えたLEDの場合、p-GaNナノロッドが最も強い局所電界強度を持っていることがわかりますが、PECリフレクターを備えたLEDのp-GaNナノロッドでは、そのような観察はあまり明白ではありません。メッシュAl反射体の表面プラズモン共鳴吸収。さらに、図3aの青い円の線が示すように、同様のLEE傾向が観察されます。これは、モデルがp-GaN層の吸収とPECリフレクターを考慮した場合です。 LEEは、GaN吸収がなくPECリフレクター(赤い三角形の線)があるLEDの場合に大きくなります。これは、p-GaN層の吸収が金属の吸収よりも深刻であることを示しています。したがって、メッシュ化されたp-GaN接点を備えたDUV LEDの場合、図3bの挿入図に示すように、p-GaN層の吸収、Al金属の吸収、および構造散乱の間で競合が発生します。間隔が小さすぎると、LEEはp-GaN層と金属の吸収の影響を強く受けますが、間隔が大きくなると、構造の散乱がLEEに主な影響を及ぼします。
さらに、DUVLEDのLEEに対するp-GaNナノロッドの高さの影響をさらに調査します。 10 nm、25 nm、50 nm、および100nmのさまざまなp-GaNナノロッドの高さでのLEEの間隔依存性を図4aに示します。ナノロッドの高さが100から25nmに減少すると、LEEは増加します。 LEEの増加は、より薄いp-GaN層の吸収が弱いことに起因することは明らかです。ただし、図4aは、ナノロッドの高さが25nmと10nmの場合にLEEが類似していることも示しています。図4bに示すように、p-GaNナノロッドを含むAl金属の反射率は、ナノロッドの高さが低くなるほど速く増加します。したがって、25nmの高さでの散乱効果は10nmの高さでの散乱効果よりも強く、同様のLEEが生成されると推測できます。それにもかかわらず、p-GaNナノロッドが100 nmの高さにある場合の最大LEEは15%であり、p-GaNナノロッドが25 nmの高さにある場合の最大LEEはわずか18%です。したがって、わずかな違いが得られます。これは主に、図4aの挿入図に示すように、強い吸収性のp-GaN層に起因します。厚さ10nmのp-GaN層の場合、反射できる光は40%のみであるため、反射光は主にp-GaNナノロッドの中でAl反射体からのものです。その結果、反射率は、p-GaNナノロッドの高さよりも間隔の影響を強く受けます。したがって、ナノロッドの間隔と比較して、p-GaNナノロッドの高さはLEEにあまり影響を与えません。
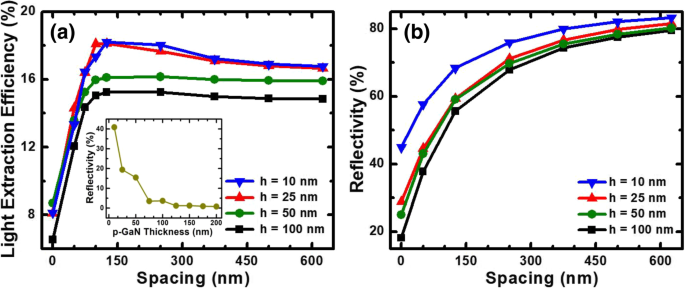
( a) Alリフレクターを備え、p-GaNナノロッドの高さが10、25、50、および100nmのDUVLEDのナノロッド間隔の関数としてのLEEが設定されています。挿入図:p-GaN層の厚さと b の関数としての従来のDUVLEDの垂直入射の反射率 p-GaNナノロッドの高さが10、25、50、および100nmの場合のナノロッド間隔の関数としての垂直入射の反射率
LEEに対するハイブリッドp-GaN / p-AlGaNメッシュコンタクトの影響
さらに、図5aに示すように、ハイブリッドp-GaN / p-AlGaNメッシュコンタクト層をさらに提案します。 p-GaNナノロッドの高さと直径はそれぞれ100nmと250nmに設定されています。 p-AlGaNナノロッドの高さ( H )はこの場合の変数です。ナノロッド間隔に関するさまざまなDUVLEDのLEEを図5bに示します。ここで、 H の値を設定します。 0 nm、25 nm、75 nm、および100nmまで。さまざまな高p-AlGaNナノロッドを備えたDUVLEDのLEEは、p-AlGaNナノロッドを備えていない場合( H )よりも大きいことがわかります。 =0 nm)。また、DUV LEDのLEEは、 H の場合、p-AlGaNナノロッドの高さによる影響が少なくなります。 0nmではありません。図5bの挿入図は、ハイブリッド構造のナノロッド間隔に関する通常の反射率を示しており、p-AlGaNナノロッドの高さが反射率に与える影響はごくわずかであることがわかります。したがって、散乱効果はp-AlGaNナノロッドによってのみ強化され、LEEの改善につながります。ナノロッドの間隔が125nmの場合の高さ75nmおよび0nmのp-AlGaNナノロッドを備えたDUVLEDの遠方界放射パターンを図1および2に示します。それぞれ5cとd。高さ75nmのp-AlGaNナノロッドを使用したDUVLEDの電界強度(図5cを参照)は、高さ0 nmのp-AlGaNナノロッドを使用した場合(図5dを参照)よりも強いことがわかります。高さ75nmのp-AlGaNナノロッドを使用したDUVLEDの電界分布は、高さ0nmのp-AlGaNナノロッドを使用した場合よりも大きく、p-AlGaNナノロッドが光の散乱効果を向上させることが確認されました。図5eは、TM分極LEEがp-AlGaNナノロッドの高さによってさらにわずかに影響を受けることを示しています。

a ハイブリッドp-GaN / p-AlGaNナノロッドベースのメッシュ接点を備えたフリップチップDUVLEDの概略側面図。 b ナノロッド間隔とp-AlGaNナノロッドの高さの関数としてのTE偏光のLEEは、0、25、75、および100nmに設定されます。挿入図:高さ100 nmのp-GaNと、ナノロッド間隔の関数としてのp-AlGaNの高さが0、25、75、および100nmのDUVLEDの垂直入射の反射率。 p-AlGaNの高さが c の125nmの間隔での遠方界放射パターン 75nmおよび d 0nm。 e ナノロッド間隔とp-AlGaNナノロッドの高さの関数としてのTM偏光のLEEは、0、25、75、および100nmに設定されます
以前の分析では、TM偏光は依然として非常に低いLEEに悩まされていることが示されています。結果として、TM偏光を散乱させる方法を提案しなければならない。そのために、側壁が傾斜したp-AlGaNナノロッドを提案し、図6aに示すようにp-AlGaNトランケートナノコーン構造を形成します。 p-AlGaNトランケートナノコーンの高さは75nmに設定され、傾斜角はαに定義されます。 。 αが減少したTE偏光とTM偏光の両方で注目すべきLEEの向上 図1と図2で見ることができます。それぞれ6bとc。傾斜角αの場合 =30°、p-GaNナノロッドの間隔が260 nmの場合、p-AlGaNのトランケートされたナノコーンは密に詰まっているため、より短い周期を設定することは不可能です。最大のTE偏光LEEは、間隔が375 nmのときに26%に達し、α 30°に設定されています。この数は、図5aの設計の1.44倍です。図5aの構造と比較して、図6aの設計で最大のTM偏光LEEは、間隔が260nmでαの場合に12%であることはさらに注目に値します。 は30°に設定され、この数は10倍に増加します。メッシュ構造のない従来のDUVLEDと比較すると、図6aの設計を利用することで、TE偏光とTM偏光の両方のLEEをそれぞれ5倍以上と24倍以上増やすことができます。これらのシミュレーション結果は、傾斜角が30°のp-AlGaNトランケートナノコーンが、特にTM偏光の場合に光散乱効果を大幅に改善できることを示しています。
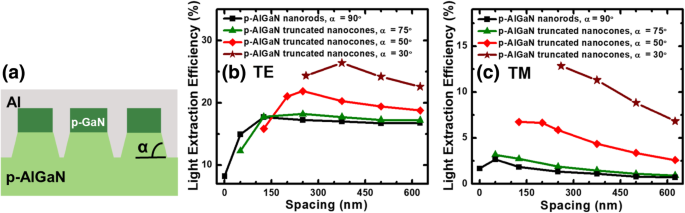
a ハイブリッドp-GaNナノロッド/ p-AlGaNトランケートナノコーンコンタクトを備えたフリップチップDUVLEDの概略側面図。 TE偏光のLEE( b )およびTM偏光( c )DUV LEDのナノロッド間隔の関数として、構造は高さ100nmのp-GaNと高さ75nmのp-AlGaNです(傾斜角は30°、50°、75°に設定されています)。 、および90°)
結論
要約すると、p-GaNナノロッド、ハイブリッドp-GaN / p-AlGaNナノロッド、p-GaNナノロッド/ p-AlGaNトランケートナノコーンを含むさまざまなメッシュ接触構造がDUVLEDのLEEに与える影響を詳細に調査します。ナノロッド間隔が小さい構造では、p-GaN層吸収とAl金属吸収がLEEで主要な役割を果たし、ナノロッド間隔が大きい構造では、メッシュ構造の散乱能力がLEEに大きく寄与することが証明されています。 TE偏光のLEEが非常に顕著に向上しているにもかかわらず、p-GaNナノロッドもハイブリッドp-GaN / p-AlGaNナノロッドも、TM偏光のLEEを大幅に促進できないことは注目に値します。面内光に対する散乱効果は非常に貧弱です。したがって、p-GaNナノロッドとp-AlGaNトランケートナノコーンを組み合わせることにより、TM偏光のLEEを大幅に改善できることをさらに提案し、証明します。最適化された傾斜角は30°であることがわかります。したがって、メッシュ構造のない従来のDUV LEDと比較して、TM偏光LEEの24倍の向上を実現できます。
略語
- 3D FDTD:
-
3次元有限差分時間領域法
- DBR:
-
分布ブラッグ反射鏡
- DUV LED:
-
深紫外線発光ダイオード
- EQE:
-
外部量子効率
- IQE:
-
内部量子効率
- LEE:
-
光抽出効率
- MQW:
-
複数の量子井戸
- ODR:
-
全方向性リフレクター
- PEC:
-
完全電気導体
- PML:
-
完全一致レイヤー
- TE:
-
横電気
- TIR:
-
全反射
- TM:
-
横磁気
ナノマテリアル
- AIコンピューティングのためのニューロモルフィックチップの主張
- 4H-SiCPiNダイオードの特性に及ぼす紫外線照射の影響
- MnХFe3−XО4スピネルの構造的および磁気的特性に及ぼす接触非平衡プラズマの影響
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- 粗い表面の通常の荷重による接触面積の変化:原子スケールから巨視的スケールまで
- リチウムイオン電池用の金属酸化物アノードの電気化学的性能に及ぼす異なるバインダーの影響
- 高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
- チタニアナノチューブの熱伝導率に及ぼす形態と結晶構造の影響
- 薄膜シリコン太陽電池用の両面ピラミッド格子を使用した効果的な光吸収
- GaAs / AlAs超格子の点欠陥の第一原理研究:相安定性とバンド構造およびキャリア移動度への影響
- 光の流れを設計する



