ヘテロ構造ReS2 / GaAs飽和吸収体パッシブQスイッチNd:YVO4レーザー
要約
ヘテロ構造ReS 2 / GaAsは、化学蒸着法により110μm(111)GaAsウェーハ上に作製されました。パッシブQスイッチNd:YVO 4 レーザーは、ヘテロ構造ReS 2 を使用して実証されました 可飽和吸収体(SA)としての/ GaAs。 452kHzの繰り返し率で51.3nsの最短パルス幅が得られました。これは、465nJのパルスエネルギーと9.1Wのピークパワーに対応します。ReS 2 と比較して QスイッチレーザーとGaAsQスイッチレーザー、ヘテロ構造体ReS 2 / GaAs Qスイッチレーザーは、より短いパルス持続時間とより高いパルスエネルギーを生成できます。
はじめに
パッシブQスイッチング技術は、単純な構造とかなりの効率という点で顕著な利点があるため、産業、医学、科学研究に広く適用されています[1,2,3,4]。可飽和吸収体としてはさまざまな材料が使用されてきましたが、最も一般的なものは半導体可飽和吸収体です[5、6、7]。 SESAMと比較して、2次元(2D)材料は、広い帯域幅、低コスト、および容易な製造により、大きな可能性を示します。近年、黒リン、グラフェン、トランジションメンタルジカルコゲナイド(TMD)などの2D材料が、パッシブQスイッチングレーザーのSAとして広く採用されています[8、9、10、11、12]。これらの報告されたTMDの中には、MoS 2 などがあります。 、MoSe 2 、およびWS 2 、1つの特徴は、バルクから単分子層に移行するときに、その間接から直接へのバンドギャップの変化が発生することです[13、14]。
上記のTMDとは異なり、ReS 2 直接バンドギャップがあり、その値はバルクと単分子層の両方の形態で〜1.5eVのままです[15]。さらに、ReS 2 の光電特性 バルクから単層まで類似しています[16]。半導体として、ReS 2 強い非線形吸収を示すため、ReS 2 SAは、1.5μm、2.8μm、および3μmの波長の固体レーザーで実験的に使用されているためです[17、18、19]。最近、ReS 2 サファイア基板をベースにしたものは、1μmレーザーの可飽和吸収体として報告されています[20]。ただし、ReS 2 可飽和吸収体は、弱いファンデルワールス力でサファイア基板に接着されました。これは、基板から簡単に切断されます[20]。現在まで、GaAsは一般的に1μmでのQスイッチング用のNdドープ固体レーザーに適用されてきました[21]。ただし、GaAsは他の半導体と組み合わせてMoS 2 などのヘテロ構造にすることもできます。 / GaAs、MoSe 2 / GaAs、およびPtSe 2 / GaAs [22]。これまでのところ、ヘテロ構造半導体MoS 2 / GaAs SAは、より短いパルスを取得するために使用されており[23]、同様のヘテロ構造がパルス動作に魅力的である可能性があることを確信しています。化学蒸着(CVD)技術は、堆積の厚さを正確に制御し、きれいに格子整合した表面を生成することができます。 ReS 2 との比較 サファイア基板上、半導体ReS 2 量子井戸としての/ GaAsヘテロ構造は、キャリアを閉じ込め、反転分布を大幅に改善することができます。ヘテロ構造ReS 2 の性能 / GaAs可飽和吸収体が期待できます。
この論文では、ヘテロ構造半導体ReS 2 / GaAsが最初に製造されます。可飽和吸収体として、受動的にQスイッチされたNd:YVO 4 固体レーザーは、ヘテロ構造ReS 2 で実証されました / GaAs。 ReS 2 との比較 可飽和吸収体またはGaAs半導体可飽和吸収体であるヘテロ構造ReS 2 により、レーザー性能が大幅に向上しました。 / GaAs可飽和吸収体。実験結果は、ReS 2 / GaAs可飽和吸収体は、パッシブQスイッチング動作に非常に役立つ可能性があります。
メソッド/実験
最近、ReS 2 可飽和吸収体は、低コストのため液相剥離(LPE)によって調製されます。ただし、ReS 2 ReS 2 の厚さを正確に制御できるため、実験の単分子層はCVDによって合成されました。 。ここでは、硫黄粉末と過レニウム酸アンモニウム(NH 4 ReO 4 )成長の前駆体として使用されました。 ReS 2 単分子層は、きれいなサファイアウェーハ上で成長しました。堆積プロセス中、硫黄のキャリアガスとしてアルゴンが使用されました。次に、CVDで成長させたReS 2 を転送しました 10×10mm 2 の寸法を持つ110μmの深さのGaAsウェーハへの単分子層 ヘテロ構造を構成します。全体の手順を図1に示しました。
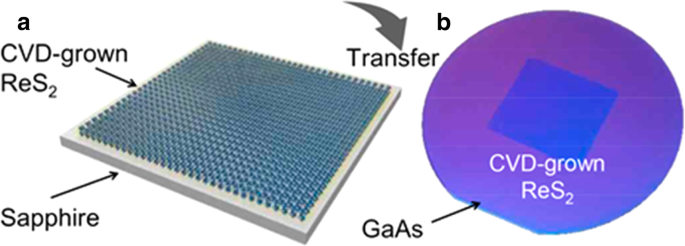
a 、 b ReS 2 の製造手順 / GaAsヘテロ構造
準備したReS 2 のレイヤー番号を確認する / GaAsヘテロ構造では、準備したサンプルのラマンシフトを調べました(図2)。 A g 134および141cm -1 にあるモード 、 E g 150.7、160.6、210.7、および233 cm -1 にあるモード 。 III-Iピークの差は16.7cm -1 でした 、これは単層と見なされていました[24]。

ヘテロ構造ReS 2 のラマン分光法 / GaAs
図3は、ReS 2 を備えたパッシブQスイッチレーザーの概略図を示しています。 / GaAsヘテロ構造可飽和吸収体。 0.1%-Ndをドープしたc-cut Nd:YVO 4 レーザー結晶として採用され、寸法は3×3×10 mm 3 。パッシブQスイッチレーザーは、808nmのファイバー結合ダイオードレーザーによってエンドポンプされました。次に、ポンプビームは、直径400μmの利得媒体上にスポットを備えたリフォーカスモジュールを使用して結晶に集束されました。入力ミラーとして凹面ミラーM1を使用しました。これは、共振器の両側に808 nmの反射防止(AR)コーティングがあり、1064 nmに高反射(HR)コーティングが施されています。 M1の曲率半径は200mmでした。フラットミラーM2は、1064 nmでの透過率が10%の出力カプラー(OC)として機能しました。長さ約30mmの短く直線的な空洞が形成されました。 ReS 2 次に、/ GaAs(またはGaAs)をキャビティに挿入し、可飽和吸収体として機能させ、出力カプラーの近くに配置しました。
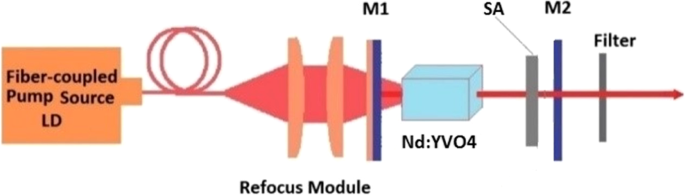
Qスイッチングレーザーキャビティの概略図
結果と考察
パルス幅と繰り返し率は、高速InGaAsフォトダイオードを介してデジタルリン光オシロスコープ(DPO 7104C)で記録されました。図4と図5に示すように、入力電力を0.5から2.26 Wに増やすと、ReS 2 からのパルス幅が増加します。 / GaAsパッシブQスイッチレーザーは322から51.3nsに減少し、繰り返し率は139から452kHzに増加しました。それに比べて、GaAsQスイッチレーザーも設置しました。図1と図2からわかります。 ReS 2 の4と5 / GaAsヘテロ構造は、パルス幅の短縮とパルス繰り返し率の低下に貢献しています。

Qスイッチレーザーのパルス幅と入射ポンプパワーの関係

パッシブQスイッチレーザーの繰り返し率と入射ポンプパワーの関係
図6は、さまざまな半導体可飽和吸収体を使用した、2.26WのポンプパワーでのQスイッチングパルスのプロファイルを示しています。 ReS 2 を使用すると、パルス幅51.3nsおよびパルスエネルギー465nJの出力パルスを実現できます。 / GaAsヘテロ構造可飽和吸収体。対照的に、GaAs Qスイッチレーザーからの出力パルス幅は63.2nsで、パルスエネルギーは435 nJでした。これは、挿入図に示されています。図6は、ReS 2 の対称性も示しています。 / GaAsQスイッチパルスは比較的優れています。

ReS 2 に基づくQスイッチレーザーのプロファイル / GaAsまたはGaAsの入射ポンプパワー2.26W
パルスエネルギーとピークパワー対入射ポンプパワーを図7に示します。ポンプパワーの増加に伴い、ピークパワーが急速に増加しました。さらに、ReS 2 のピークパワーとパルスエネルギー / GaAs Qスイッチレーザーは、同じ条件でGaAsベースのQスイッチレーザーよりも高くなっています。そしてReS 2 の場合 / GaAs Qスイッチレーザー、最大ピークパワー9.1 W、最大パルスエネルギー465 nJは、2.26Wのポンプパワーで達成できます。

パルスエネルギー( a )およびピーク電力( b )Qスイッチレーザーの
また、実験結果を以前の研究[20]とReS 2 で比較しました。 サファイア基板上の可飽和吸収体。 ReS 2 からの最短パルス幅 Qスイッチ1μmレーザーは139nsで、繰り返し率は644 kHzで、ピークパワーは1.3 Wに相当します。その結果、ヘテロ構造ReS 2 / GaAs可飽和吸収体は、ReS 2 と比較した場合、特にパルス幅、パルスエネルギー、ピークパワーの点でレーザー性能を明らかに向上させることができます。 QスイッチレーザーまたはGaAsQスイッチレーザー。
結論
要約すると、ヘテロ構造ReS 2 / GaAs可飽和吸収体が最初に製造されました。 ReS 2 に基づく / GaAsヘテロ構造可飽和吸収体、パッシブQスイッチNd:YVO 4 レーザーが実証されました。 2.26 Wのポンプパワーで、452kHzの繰り返し率で51.3nsの最小パルス持続時間が達成されました。これは、465nJの最高パルスエネルギーと9.1Wのピークパワーに対応します。我々の結果は、ヘテロ構造ReS <を確認します。 sub> 2 / GaAsは、半導体ReS 2 と比較してQスイッチング性能を向上させるのに有益です。 またはGaAs可飽和吸収体。
略語
- 2D:
-
二次元
- AR:
-
反射防止
- CVD:
-
化学蒸着
- HR:
-
高反射
- LPE:
-
液相剥離
- OC:
-
出力カプラー
- SESAM:
-
半導体可飽和吸収体ミラー
- TMD:
-
精神的ジカルコゲニドの移行
ナノマテリアル
- (p-i-n)接合GaAsナノワイヤ太陽電池におけるプラズモン増強光吸収:FDTDシミュレーション法の研究
- 金属支援化学エッチングによって製造されたAuキャップGaAsナノピラーアレイ
- MoS2 / GaAsヘテロ接合における大きな横方向光起電力効果
- 変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- AlGaAs / GaAsヘテロ接合を使用したGaAsナノワイヤピン接合アレイ太陽電池の最適化
- 分子線エピタキシーによりGaAs基板上に成長させた中波および長波InAs / GaSb超格子の電気的性質
- 広いチューニング範囲の連続波テラヘルツアプリケーションに向けたInAs / GaAs量子ドットデュアルモード分散フィードバックレーザー
- GaAs / AlGaAs二次元電子ガスにおける外因性光誘起逆スピンホール効果の観測
- GaAs / AlAs超格子の点欠陥の第一原理研究:相安定性とバンド構造およびキャリア移動度への影響
- リモートセンシング用のグラフェンベースのフォトニクスデバイス



