四級InGaNBiの構造的および電子的性質の組成依存性
要約
実現可能なバンド構造エンジニアリングを実現し、それによって発光効率を向上させるために、InGaNBiは、可視光および中赤外のフォトニックデバイスで利用できる魅力的な合金です。本研究では、バンドギャップ、スピン軌道相互作用エネルギー、InGaNBi対InおよびBi組成の基板ひずみなどの構造的、電子的特性を、第一原理計算を使用して研究します。格子定数は、InおよびBiの組成が増加するにつれてほぼ直線的に増加します。ビスマスドーピングにより、4次InGaNBiバンドギャップは、0.38〜1.9 µmの波長範囲に対応する最大9.375%および最大50%のBiに対して3.273〜0.651eVの広いエネルギー範囲をカバーできます。計算されたスピン軌道相互作用エネルギーは、3.125%で約0.220 eV、6.25%で0.360 eV、9.375%Biで0.600eVです。また、GaN上のInGaNBiのひずみも示しました。これは、InとBiの組成を調整することにより、許容可能なひずみでGaN上にInGaNBiを設計できることを示しています。
はじめに
近年、ウルツ鉱(WZ) In x Ga 1− x N合金とInGaN / GaN量子井戸(QW)は、太陽電池、高効率発光ダイオード(LED)、およびレーザーダイオード(LD)を開発する可能性が高いため、幅広い注目を集めています[1–10]。一般的に使用される[0001]指向の In x Ga 1− x N / GaN QWは、 In の2軸圧縮応力によって引き起こされる強いビルトイン電界に苦しんでいます。 x Ga 1− x N層[11]は、電子正孔対のQW放出エネルギーと振動子強度の低下を引き起こします。その上、 In には高密度の幾何学的欠陥が存在します x Ga 1− x 積層欠陥および貫通転位(TD)を含むN合金[12];これらのTDは、非放射再結合中心と大きな相関関係があります。 In の効率低下の原因は、欠陥、電子漏れ、オージェ再結合の3つです。 x Ga 1− x N個のLED、そのうちオージェの再結合が主な原因です[13]。
同様に、GaAsベースの赤外線ダイオードの場合、ビスマス合金がバンドギャップ( E )を減少させる効果的な方法であることがすでに提案されています。 g )また、スピン軌道相互作用(SO)分割を強化して、オージェ再結合プロセスの抑制を実現します[14]。ビスマスの最大の第5族元素は、ビスマス合金の物理的特性に対する魅力的な効果を示しています。 AlNBi [15]、GaNBi [16、17]、GaSbBi [18、19]、InPBi [20、21]、およびInSbBi [19、22–24]。バンドギャップは、主にInPBiの高濃度での大きなBi原子誘起ひずみによって変更されます。 Biの取り込みは、Bi不純物状態と重い/軽い正孔バンドおよびスピン軌道相互作用バンドとの相互作用のために価電子帯(VB)を混乱させます[21]。最近では、四元ビスマイド合金(たとえば、GaAsNBi [25–27]、InGaAsBi [28、29]、GaAsPBi [30])も大きな注目を集めています。 P原子とBi原子の周りの局所的な歪みは、GaAsPBiのバンドギャップの変化に大きく影響します。 Ga As の構成要件 1− x − y P y Bi x GaAsよりも低いオージェ再結合比を達成することが得られた[30]。ビスマスと他のIIIまたはV原子を組み合わせると、バンドギャップ、スピン軌道相互作用、伝導帯(CB)と価電子帯のオフセット、ひずみの制御など、バンド構造工学の範囲が広がります[25]。したがって、[0001] In に対するBi置換の効果を説明することは非常に興味深いことです。 x Ga 1− x N / GaN、構造的および電子的特性を調整し、したがって発光効率を調整します。本研究では、第一原理計算[31]を使用して、バンドギャップ、スピン軌道相互作用エネルギー(Δなどの構造的、電子的特性 SO )、およびInGaNBi対InおよびBi組成の基板ひずみが研究されています。 InGaNサンプルの55〜60%を超えるIn含有量の大きな格子不整合と低品質[32]、および希釈ビスマス合金へのビスマスの溶解度の低さを考慮して、InとBiの濃度は最大50%に制御されます。それぞれ9.375%。この論文は次のように構成されています。 「方法」のセクションでは、詳細な計算方法を示します。構造的、電子的特性、および基板のひずみは、「結果と考察」のセクションに記載されています。最後に、簡単な要約を要約します。
メソッド
私たちの理論計算は、VASPコード[33、34]に実装されている密度汎関数理論(DFT)[31]に基づいています。構造特性の計算では、電子イオンと交換相関の相互作用は、プロジェクター拡張波法(PAW)[35、36]およびPerdew-Burke-Ernzerhof(PBE)の一般化勾配近似(GGA)で処理されます。それぞれ[37]。 In、Ga、N、およびBi原子の価電子配置は、4 d として使用されます。 10 5 s 2 5 p 1 、3 d 10 4 s 2 4 p 1 、2 s 2 2 p 3 、および5 d 10 6 s 2 6 p 3 、 それぞれ。電子特性のバンドギャップにおけるPBEポテンシャルの過小評価を克服するために、局所密度近似相関(MBJLDA)と組み合わせて修正Becke-Johnson交換ポテンシャルを使用します[38]。ビスマスはスピン軌道相互作用(SOC)効果が大きいため、電子計算にはSOCが含まれます。すべての計算で、各原子にかかる力が0.02 eV /Å未満になり、最大エネルギー変化が10 -4 になるまで、構造が緩和されます。 eV。計算の精度を確保するために、450eVの平面波カットオフが設定されています。モンホルスト-4×4×4 k のパック -最初のブリルアンゾーンではポイントメッシュが採用されています。
結果と考察
構造プロパティ
スーパーセルは、64個の原子を含む4×2×2のWZ-GaNプリミティブセルで構成されています。 I の36の構成を調査します n y Ga 1− y N 1− x Bi x 0≤ x の場合 ≤0.09375,0≤ y ≤0.5は、InGaNサンプルが55〜60%を超えるIn含有量に対して大きな格子不整合と低品質を示し[32]、希釈ビスマス合金へのビスマスの溶解度が低いという最近の実験に基づいています。 In原子とBi原子が均等に分散している代表的な構成の1つを検討します。三元 In の計算された格子定数を要約しました y Ga 1− y Nおよび4次 In y Ga 1− y N 1− x Bi x 合金と他の理論的および実験的データを図1に示します。元のGaNの場合、格子定数 a =3.211、 c =5.235Å。これは他の理論計算とよく一致しています a =3.155,3.22Å、 c =5.144,5.24Å[39–41]および a の実験データ3.19Å 、 c の場合は5.19Å [42]。格子定数( a 、 c )の In y Ga 1− y 図1aに示すように、In組成が増加すると、Nが上昇し、ほぼ線形の変化を示します。現在の計算では、 a を予測しています =3.304Å、 c =5.365Å( In の場合) 0.25 GaNと a =3.397Å、 c =5.509Å( In の場合) 0.5 GaN、これらはすべて a の以前の結果とよく一致しています =3.33Å、 c = In の場合は5.39Å 0.25 GaNと a =3.43,3.485Å、 c =5.55,5.488Å( I の場合) n 0.5 GaN [39、40、43、44]。四元合金の場合 In y Ga 1− y N 1− x Bi x 、私たちに関する限り、構造特性の実験的および理論的値はありません。図1bでは、得られた格子定数もInとBiの組成の増加に伴ってほぼ直線的に増加しています。 InおよびBiのイオン半径はGaおよびN原子よりも大きいため、Ga上のInおよびN上のBiの置換により、InGaNBiの格子定数が向上します。

a の格子定数 三元合金 In y Ga 1− y N 、0≤ y ≤0.5および b 四元合金 In y Ga 1− y N 1− x Bi x 、0≤ x ≤0.09375、0≤ y ≤0.5。比較のために、参考文献から他のいくつかの計算と実験データを追加します。図1aの[39–44]。実線は a を表します 破線は c です
InとBiの取り込みは、結晶の周期性を破壊し、高度に合金化された構造に幾何学的変形をもたらします。 In を選択します 0.25 GaN Bi 0.0625 図2に示すように、4つの化学結合統計の例として。 Ga-N、In-N、Ga-Bi、およびIn-Bi結合の平均長は、それぞれ2.009、2.195、2.592、および2.704Åです。自然のままのバルクGaNのGa-N結合長は1.970Åであることに注意してください。 In-N結合長はGa-Nの結合長よりも長く、これはIn原子がN原子を著しく押しのけることを示しています。同様に、Ga-NよりもGa-Biの結合長が長いということは、Bi原子がGa原子を押しのけることを意味し、Gaの共有結合半径(1.22Å)、In(1.42Å)、N(0.71Å)、およびBi(1.48Å)[45]。他の構成でも同様の動作が見られます。格子変形とホストとドーパント間の電気陰性度の不一致は、電子的および光学的特性にかなりの影響を及ぼします。

In の結合長のヒストグラム 0.25 GaNBi 0.0625 。パネルの値は、4種類の結合の平均の長さを示しています
電子プロパティ
機能ポテンシャルまたは補正ポテンシャルとSOC効果は、III-V合金のバンドギャップエネルギー、価電子帯、およびスピン軌道相互作用エネルギーの予測精度に大きく影響することが示されています。したがって、MBJLDAポテンシャルを使用して結果を検証し、他の理論計算や実験と比較します。図3は、 In のバンドギャップエネルギーとIn組成のプロットです。 y Ga 1− y Nおよびデータへの適合。実験、理論上のHSE06、mBJ、およびLMTO-CPA-MBJ汎関数によって得られたいくつかのバンドギャップ値もプロットされています。 GaNの予測バンドギャップは3.273eVであり、現在の計算と実験とよく一致しています。mBJによる3.33 eV [40]、HSE06による3.261、3.23 eV [39、46]、実験による3.40–3.50 eV [47– 49]。 I で観察されたように n y G a 1− y N、DFTの結果は E g I の値 n y G a 1− y Nは y として継続的に減少します 0から50%に増加します。 E g 3.273から1.546eVにスムーズに減少します。これは、理論上の結果(HSE06、mBJポテンシャル)[39、40、46]および実験結果[50、51]とよく比較されます。
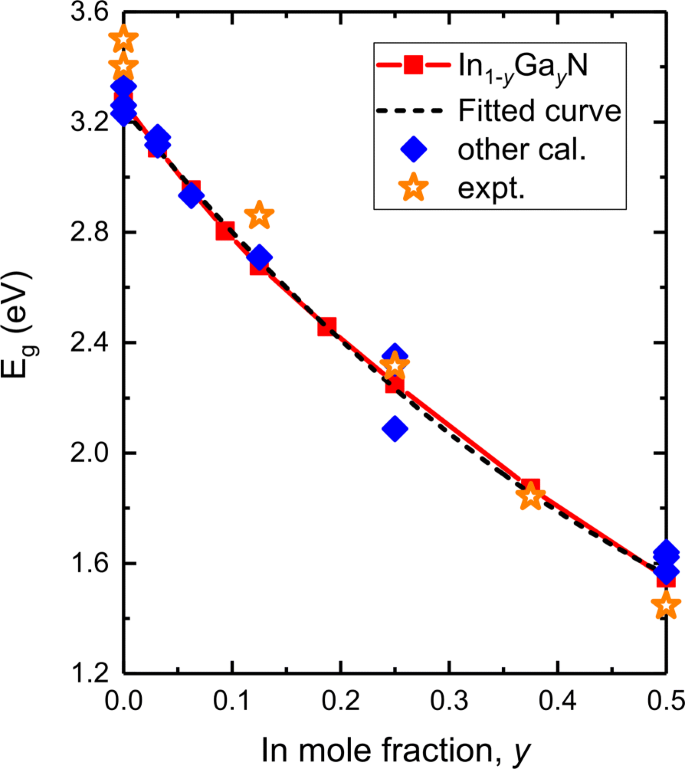
予測されるバンドギャップエネルギー( E g 、赤い実線) I のIn組成の関数として n y G a 1− y N データへの適合と同様に(黒い破線)。他の理論的[39、40、46]および実験的[47–51]の結果もプロットされています
第四紀の I のバンドギャップの等高線図 n y G a 1− y N 1− x B i x 合金を図4に示します。第4合金のバンドギャップは、組成の関数として非線形の傾向を示し、InおよびBiの含有量が増えると減少します。結果から、InGaNBiバンドギャップは、Biが最大9.375%、Inが最大50%の場合、3.273〜0.651 eVの広いエネルギー範囲をカバーできることがわかります。これは、0.38〜1.9 µmの波長範囲に対応し、可視光と中赤外線スコープ。

I のバンドギャップ値の等高線図 n y G a 1− y N 1− x B i x Bi( x の関数としての合金 )およびIn( y )構成
InGaNと比較して、Biを組み込むと、バンドギャップが大幅に減少します。しかし、それを超えると、Δが大幅に増加します。 SO 電子スピンと軌道角運動量の間の高度な相互作用がSOバンドエネルギーを減少させるビスマスの強いSOC効果のために得られます。さらに、ビスマイド合金の価電子帯の交差防止効果から生じた価電子帯のエッジの改善も、Δを大幅に向上させます。 SO [28]。計算されたΔ SO 値は、3.125%で約0.220 eV、6.25%で0.360 eV、9.375%Biで0.600 eVであり、インジウムの割合による変化はわずかです。以前の調査では、さまざまなBi配列が、スピン軌道相互作用エネルギーなど、ビスマイド合金のバンド構造に大きな影響を与えることが示されています[21、52]。現在の結果は、 I n 0.5 G a N B i 0.09375 バンドギャップ値(0.651 eV)はΔのバンドギャップ値に非常に近い SO (0.577eV)。 InGaNサンプルは、55〜60%を超えるIn含有量に対して大きな格子不整合と低品質を示し[32]、希釈ビスマス合金へのビスマスの溶解度が低いため、Inの含有量を最大50%、Biの含有量を最大9.375%。インジウムまたはビスマスの含有量が多いほど、Δが達成されると考えています。 SO > E g InGaNBiベースのLEDおよびLDの効率を高めるための4次InGaNBiサンプル。
元のGaN、 I の投影されたバンド構造と総状態密度(TDOS) n 0.25 GaN、および I n 0.25 G a N B i 0.03125 合金を図5に示します。InとBiの寄与は、色で強調表示されています。青(赤)は、In(Bi)に由来する状態に対応しています。 I のIn置換 n 0.25 GaNは、伝導帯と価電子帯の両方に大きな影響を及ぼします。伝導帯の最小値(CBM)は、フェルミ準位に関してより低いエネルギーに押し上げられ、より狭いエネルギーギャップを反映します。フェルミ準位近くの禁制ギャップに欠陥バンドを導入するビスマスとは異なり、In原子はVBの深い準位との混成軌道を示します。四元合金の場合 I n 0.25 G a N B i 0.03125 、バンドギャップの減少は、上向きの価電子帯最大値(VBM)と下向きのCBMの両方に起因し、CBMは I と比較してより大きく変化することがはっきりとわかります。 n 0.25 ビスマスの添加によるInGaNBiのより大きな圧縮ひずみに起因するGaN。赤い色で強調表示された欠陥レベルは、主にBiと近くのGa原子間の混成に由来するVBエッジとの強い相互作用を持っています。図5eのTDOSは、-1.0〜-0.5eVの局所的な欠陥レベルも反映しています。
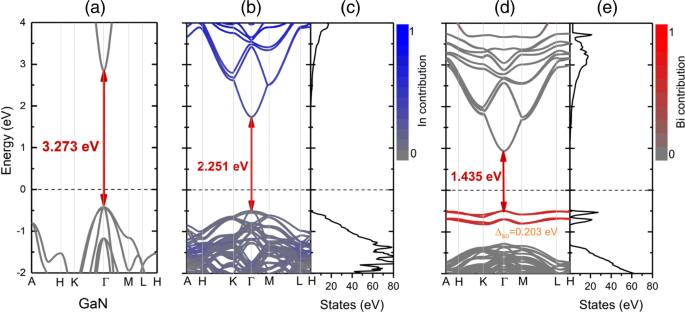
投影されたバンド構造とそれに対応する a の全状態密度(TDOS) GaN、 b 、 c 私 n 0.25 G a N 、および d 、 e 私 n 0.25 G a N B i 0.03125 。黒い破線はフェルミ準位を表しており、ゼロに設定されています。 InとBiの相対的な寄与は、色で強調表示されています。青(赤)は、In(Bi)に由来する状態に対応しています
GaN上のInGaNBiのひずみ
[0001]指向の I n y G a 1− y N / GaN歪み量子井戸は、現在のLEDおよびLDデバイスで広く採用されており、 I n y G a 1− y N層は二軸圧縮応力を受けます。 In原子とGa原子の局所的な組成変動と異なる共有結合半径により、 I にひずみが生じます。 n y G a 1− y N層[53]。図6は、GaN基板上のInGaNBiのひずみを示しています。インジウム原子はガリウム原子よりも大きいため、ビスマス原子は窒素原子よりも大きくなります。したがって、InおよびBi原子をInGaNBiに組み込むと、GaN上に圧縮ひずみInGaNBiが発生します。 In含有量が50%、Bi含有量が9.375%の場合、InGaNBiは8.5%の高い圧縮ひずみ下にあることが示されています。 Inフラクションが6.25%以内、Biフラクションが2.8%以内の場合、GaN上のInGaNBiのひずみは1%以内です。つまり、InとBiの組成を調整することで、許容可能なひずみでGaN上にInGaNBiを設計できます。

Bi分率の関数としてのさまざまなIn(0–0.5)でのGaN基板上のInGaNBi合金のひずみ。ひずみの正の値は、InGaNBiが圧縮ひずみを受けていることを示します
結論
密度汎関数理論に基づいて、GaN上のInGaNBiの構造的、電子的特性、およびInとBiの組成を調べます。 InGaNBiの格子定数は、InおよびBiの組成が増加するにつれてほぼ直線的に増加します。 InおよびBi原子はGaおよびN原子よりも原子半径が大きいため、In-NおよびGa-Bi結合長はGa-Nよりも長くなります。電子特性については、4次 I のバンドギャップの等高線図を示しました。 n y G a 1− y N 1− x B i x 合金。四元合金のバンドギャップは、Biが最大9.375%、Inが最大50%の場合、3.273〜0.651 eVの広いエネルギー範囲をカバーでき、0.38〜1.9 µmの波長範囲に対応します。計算されたΔ SO 値は、3.125%で約0.220 eV、6.25%で0.360 eV、9.375%Biで0.600 eVであり、インジウムの割合による変化はわずかです。インジウムまたはビスマスの組成が高いほど、Δが達成されると考えています。 SO > E g InGaNBiベースのLEDおよびLDの効率を高めるための4次InGaNBiサンプル。バンド構造分析は、インジウムがCBとVBの両方に大きな影響を及ぼし、ビスマスがVBエッジと強い相互作用を持っていることを示しています。最後に、GaN上のInGaNBiのひずみを調査します。 InとBiの組成を調整することにより、InGaNBiは許容可能なひずみでGaN上に設計できます。
ナノマテリアル
- 構造用自動車および電子部品用の炭素繊維強化PPA
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- MnХFe3−XО4スピネルの構造的および磁気的特性に及ぼす接触非平衡プラズマの影響
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- 着色された低温顔料用のCrドープTiO2の構造的および可視近赤外光学特性
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- ナノ粒子の毒性の物理的および化学的性質への依存性
- InSeナノリボンの電子構造とI-V特性
- 自動車 PCB の特性と設計上の考慮事項
- 銑鉄の性質と組成



