HfO2 / TiOx二層抵抗変化型メモリの低電力抵抗変化特性
要約
原子層堆積HfO 2 を備えた抵抗変化型メモリデバイス および高周波スパッタリングTiO x 抵抗性スイッチング層がうまく製造されたので。 HfO 2 では、1.52μWの設定電力(1μA@ 1.52 V)と1.12μWのリセット電力(1μA@ 1.12 V)の低電力特性が得られました。 / TiO x TiO x の酸素含有量を制御することによる抵抗変化型メモリ(RRAM)デバイス 層。その上、TiO x の間の酸素含有量の影響 抵抗スイッチング特性に関するスパッタリングプロセスについて詳細に説明する。調査の結果、HfO 2 の電気成形/硬化プロセス中に「ソフトブレークダウン」が発生しやすいことがわかりました。 / TiO x TiO x の酸素含有量が高いRRAMデバイス 層、高抵抗スイッチング電力をもたらします。低電力特性はHfO 2 で得られました / TiO x TiO x の酸素空孔密度が適切に高いRRAMデバイス 層、TiO x の適切な酸素空孔密度を示唆している 層は、成形/硬化プロセス中に誘電体層全体を通る「ソフトブレークダウン」を回避できるため、RRAMデバイスを流れる電流が制限され、動作電力消費が減少します。
はじめに
抵抗変化型メモリ(RRAM)は、シンプルなセル構造、不揮発性ストレージ、高速動作、および高いオン/オフ比により、従来の充電ベースのメモリを超えてスケールダウンするための有望なソリューションを提供します[1,2,3、 4,5,6,7,8,9,10]。最近、1トランジスタ1抵抗(1T1R)は、1Rアレイのスニークパス電流によって引き起こされる不正確な抵抗測定を防ぐために広く受け入れられている構造です[11、12]。さらに、新しいメモリ、特に酸化物ベースのRRAMは、シナプス前およびシナプス後ニューロンから信号を受信する生物学的シナプスの動作を模倣できるパルス数による漸進的なコンダクタンス変調により、プラスチックシナプスデバイスに提案されています[13、14、15 、16、17]。ただし、高抵抗スイッチング電流は、低電力および高密度アプリケーションの主な制限です[18、19、20]。 1T1Rアレイは、RRAMの動作電流がそれに応じてスケーリングできない場合にも、スケーリングの課題に直面します。たとえば、CMOSテクノロジが27 nmにスケールダウンすると、駆動電流は40μAに減少します[21]。したがって、1T1Rスケーリングを継続するには、構造と材料を最適化してRRAMデバイスの動作電流を10μAに減らす必要があります[22]。さらに、生物学的シナプスは、複雑な人間の脳でイベントごとに約1〜10 fJを消費するため、神経形態の人工ニューラルネットワーク(ANN)の開発には、生物学的シナプスと同じくらい電気シナプスデバイスのエネルギー消費を削減することが重要です[23、 24,25]。したがって、デバイスの電流を制限し、消費電力を削減することは、データストレージとニューロモルフィックコンピューティングアプリケーションの実用的なプロセスに役立ちます。
この作品では、Pt / HfO 2 / TiO x TiO x の酸素含有量が異なる/ Ptデバイス フィルムを作製し、低酸素含有量での低出力特性を実証しました。メモリデバイスは、TiO x の酸素含有量を減らすことにより、1.52μWのセット電力と1.12μWのリセット電力を達成しました。 スパッタリングプロセス中のフィルム。低電力特性の導電メカニズムをさらに分析して、酸化物RRAM設計への洞察を提供しました。
メソッド
Pt / HfO 2 / TiO x / Ptデバイスの構造と製造プロセスを図1aとbに示します。最初は、Si / SiO 2 / Ti基板、100 nm Pt下部電極(BE)は、室温での直流(DC)スパッタリングによって準備されました。次に、3 nmHfO 2 TEMAHとH 2 を使用して、300°Cで原子層堆積(ALD)(Picosun R200)技術によって堆積されました。 前駆体としてのO。続いて、30 nm TiO x 高周波スパッタリングにより、異なる酸素含有量で堆積された。 TiO x 中 フィルムスパッタリングプロセス、アルゴン(Ar)と酸素(O 2 )20 sccmとして、酸素分圧を9%、11%、および13%に変更して、3つのサンプルデバイス(S1、S2、およびS3)を取得し、TiO x > 抵抗スイッチング性能に関するフィルム。その後、70 nmのPt上部電極(TE)がDCスパッタリングによって堆積され、リソグラフィーでパターン化されました。最後に、100μm×100μmの正方形のデバイスが反応性イオンエッチング(RIE)によって形成されました。 TEにバイアス電圧を印加し、BEをグランドに接続しました。 Pt / HfO 2 の断面の高分解能透過型電子顕微鏡(HRTEM)画像 / TiO x / Ptを図2に示します。デバイスの電気的特性は、AgilentB1500A半導体パラメータアナライザを使用して測定しました。 TiO x 内の原子の化学状態 フィルムはX線光電子分光法(XPS、Axis Ultra)によって調査されました。
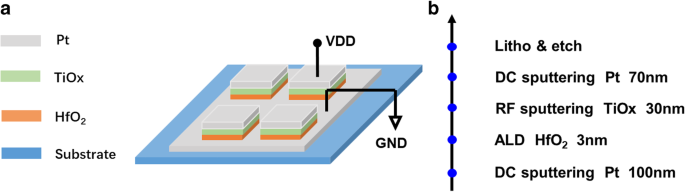
a Pt / HfO2 / TiO x の構造 / Ptデバイス。 b 製造プロセスフロー
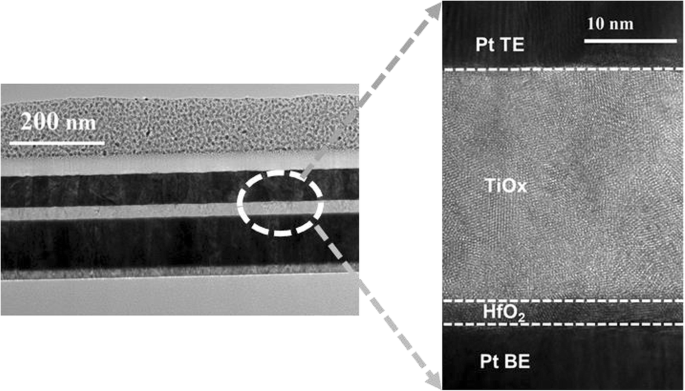
Pt / HfO 2 のTEM断面 / TiO x / Ptデバイス
結果と考察
図3a、b、およびcは、TiO x のXPSO1sコアレベルスペクトルを示しています。 映画。膜中の酸素の化学結合を明らかにするために、非対称のO 1sピークを2つのピークに分割します。これらのピークは、一般にO 2- に起因します。 金属イオンとO 2- で結合 酸素欠乏領域で[26]。 TiO x 中の酸素分圧 フィルムスパッタリングプロセスはそれぞれ9%、11%、13%に設定され、3つのサンプルの対応する酸素欠乏含有量は約28.23%、24.06%、23.63%であり、非格子酸素イオンの含有量を示しています。酸素分圧の増加に伴い、酸素空孔は減少します。

TiO x のO1sXPSスキャンスペクトル S1、S2、およびS3のフィルム。酸素分圧は a に設定しました 9%、 b 11%、および c TiO x 中は13% フィルムスパッタリングプロセス
新しいデバイスの場合、元の状態は高抵抗状態(HRS)です。図4に示すように、電流形成(CF)を適用して導電性フィラメントの形成を開始し、デバイスの状態を低抵抗状態(LRS)に変更します[27]。 1μAの電流コンプライアンスを適用すると、S1に導電パスが形成され、後続の操作で安定したセット/リセットプロセスを実現できます。 S2およびS3の場合、CFプロセス中のデバイスの中間状態から、電流コンプライアンスが最大20mAになるまでリセット操作は成功しません。
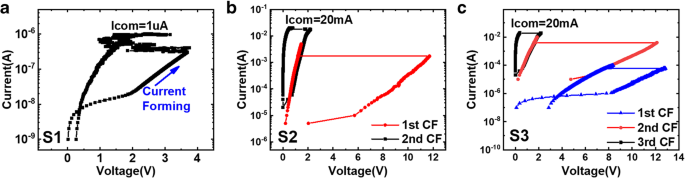
Pt / HfO2 / TiO x の現在の成形プロセス a の/ PtRRAMデバイス S1、 b S2、および c S3
RRAMデバイスの電気的性能をテストするために、電圧掃引下でのDC測定が実行されます。成形および硬化プロセスでの正のバイアス電圧がTEに印加されて導電性フィラメントが完成し、リセットプロセスでの負のバイアス電圧がフィラメントを切断します。バイアスを前後にスイープした場合、3つのサンプルの100サイクルのバイポーラスイッチング電流-電圧(IV)曲線を図5に示します。S1デバイスは、10μAの電流コンプライアンスの下で安定した抵抗スイッチング性能を実現しますが、動作電流は他の2つのサンプルでは最大10mA。 S1の低電力特性は、TiO x にすでに存在する高酸素空孔含有量に起因する可能性があります。 フィルム。成形/硬化プロセス中に電流を効果的に制限します。
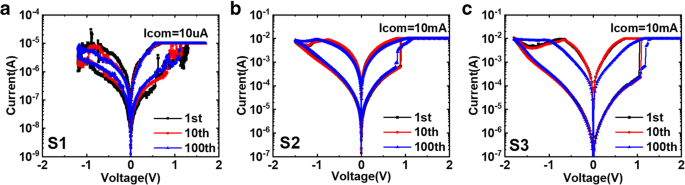
a で100サイクルの安定した双方向I-V曲線 S1、 b S2、および c S3
図6と7は、サイクルごとおよびデバイスごとの変動(相対標準偏差、(σ)を示しています。 / μ ))3つのサンプルのうち、統計は表1と2にまとめられています。S1の場合、弱いホッピング電流によって適度な抵抗分布が生じ、S2とS3に形成された強い導電性フィラメントにより、比較的安定した抵抗分布が保証されます。数十サイクル後のS3の劣化はわずかですが、オン/オフ比は100を超えています。

R LRS のサイクルごとの変動 およびR HRS a で100サイクル S1、 b S2、および c S3

R LRS のデバイスごとのバリエーション およびR HRS a の20台のデバイスの場合 S1、 b S2、および c S3
図8に示すように、1μAの低いコンプライアンス電流の下で、設定電力(Pset)1.52μWとリセット電力(Preset)1.12μWに達します。他の2つのサンプルの消費電力は、10mAの動作電流のために数十ミリワットです。さらに、S1の抵抗状態は、保持特性を10 4 以上に保つことができます。 s85°C未満で約100のオン/オフ比。データストレージアプリケーションで安定しています。
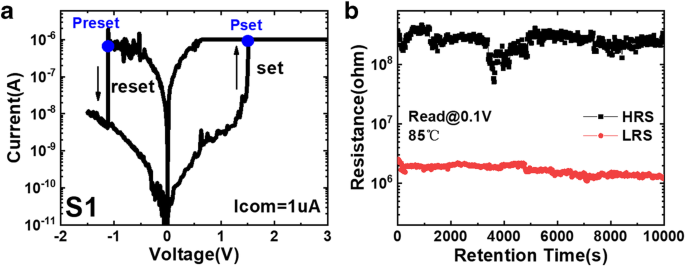
a 1μAの電流制限の下での抵抗スイッチング性能。 b S1の保持特性は10 4 を超えています s85°C未満
低電力特性の導通メカニズムを解明するために、動作電流を変えてS1とS3の温度測定を行い、対応するメカニズムを図1と図2に示すように調べました。 25°Cから125°Cまで、S1の抵抗は温度とともに減少しますが、S3の抵抗はほとんど変化しません。実験のコンダクタンスと温度は、図11に示すように、モッツの可変範囲ホッピングモデル[28]に適合しています。これは、S1の主な導電メカニズムが、誘電体酸化物の局所的な酸素空孔欠陥を介した電子ホッピングであることを示しています[29]。 TiO x 中に酸素分圧を下げる場合 スパッタリングプロセス、S1に示すように、初期TiO x の酸素空孔含有量 層が増加し、膜抵抗が減少します[30]。 TEの電圧は、主にHfO 2 に印加されます。 層と酸素空孔の塊は、導電性フィラメントを形成するように動機付けられます。その後、新しい酸素空孔もTiO x で動機付けられます 層が、酸素空孔間の接続は弱いです。したがって、電子はTiO x で伝導をホッピングします。 が支配的であり、1μAの抵抗スイッチング電流が低くなります。

a 抵抗はS1の温度によって変化します。 b 対応する導電メカニズムの概略図

a 抵抗はS3の温度によって変化します。 b 対応する導電メカニズムの概略図

a におけるS1のコンダクタンスの温度依存性 LRSと b HRS
ただし、図10に示すように、TiO x 中に酸素含有量を増やした後 スパッタリングプロセス、HRSおよびLRSは、温度によってほとんど変化しません。これは、濃縮された酸素空孔からなる導電性フィラメントを介した電子輸送によって引き起こされる、金属のような輸送メカニズムに関連している可能性が最も高いです。 S1のRRAMデバイスと比較して、初期TiO x の酸素空孔が少ない S3の層は、電子がホッピング伝導するのに十分ではありません。さらに、TiO x の抵抗が増加するため フィルムの場合、電圧バイアスは両方のHfO 2 に適用されます 層とTiO x 同時にレイヤー。電気的初期化は、HfO 2 で動機付けられた多くの酸素空孔につながります およびTiO x レイヤー。これらの酸素空孔は、2つの誘電体層の両方で強力な導電性フィラメントを形成し、豊富な拡張電子が2つの隣接する酸素空孔を通って流れ、抵抗スイッチングプロセス中に高い動作電流を引き起こします。
原則として、酸素含有量を注意深く制御して、酸素空孔に関連する他の酸化物抵抗変化型メモリ(OxRRAM)で低電力性能を実現することができます。酸化物層の要件は、デバイスが故障した場合の電気ホッピング伝導のために、初期状態で十分な酸素空孔が存在する必要があることです。ただし、過剰な酸素空孔は、不安定な耐久特性を引き起こし、デバイスの性能を低下させます。したがって、動作電流を制限し、消費電力を削減するには、適切な酸素空孔が必要です。
表3は、Pt / HfO 2 の主要なパラメータの一部を比較しています。 / TiO x / Ptデバイスと他の最近のレポート。このデバイスには、1.12μWの抵抗変化型スイッチング電力が低く、さまざまなRRAMデバイス間で100 HRS / LRS比を超えるという重要なメリットがあります。
<図>結論
この作業では、1μAの抵抗スイッチング電流がPt / HfO 2 で実証されました。 / TiO x / Pt構造デバイス。伝導メカニズムの場合、電子ホッピング伝導は、TiO x の低酸素含有量で支配的です。 動作電流を制限し、消費電力を削減する層。 TiO x の高酸素含有量では、金属のような輸送が支配的です。 層、および2つの誘電体層の「ソフトブレークダウン」は、高い動作電流と高い消費電力を引き起こします。 TiO x の適切な酸素含有量 フィルムはRRAM電流を制限し、低電力特性に寄与することができます。これは、大きな動作電流と高電力の問題に対するソリューションを提供し、将来の組み込み不揮発性メモリとモノのインターネット(IoT)アプリケーションの可能性を示しています。
略語
- 1T1R:
-
1トランジスタ1抵抗
- ALD:
-
原子層堆積
- ANN:
-
人工ニューラルネットワーク
- BE:
-
下部電極
- CF:
-
現在の形成
- HRS:
-
高抵抗状態
- HRTEM:
-
高分解能透過型電子顕微鏡
- IoT:
-
モノのインターネット
- I-V:
-
電流-電圧
- LRS:
-
低抵抗状態
- オン/オフ比:
-
HRS / LRS
- OxRRAM:
-
酸化物抵抗変化型メモリ
- プリセット:
-
電源をリセット
- Pset:
-
電力を設定する
- RIE:
-
反応性イオンエッチング
- RRAM:
-
抵抗変化型メモリ
- TE:
-
上部電極
- XPS:
-
X線光電子分光法
- σ / μ :
-
相対標準偏差
ナノマテリアル
- 空気
- Nano書記素、シリコンベースの柔軟な透明メモリ
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- コンプライアンスフリーのZrO2 / ZrO2 − x / ZrO2抵抗変化型メモリと制御可能な界面マルチステートスイッチング動作
- 純粋なCMOSロジックプロセスによる自己抑制抵抗スイッチング負荷を備えたRRAM統合4TSRAM
- 抵抗変化型メモリのモデリングとシミュレーションに関する集合的研究
- BaTiO3 / Nb:SrTiO3エピタキシャルヘテロ接合における強誘電場効果による非対称抵抗スイッチング効果
- PtCoナノ触媒での酸素還元反応:(Bi)硫酸陰イオン中毒
- 確率的空孔モデルによる接触抵抗変化型メモリの変動性の研究
- 構造用カラーマイクロファイバーを使用した光スイッチングパターンの製造
- 新しい方法は酸化チタンからコンピュータメモリを作る



