フェムト秒ファイバーレーザーアプリケーションに向けた短周期超格子キャッピング構造を備えた1550nm InAs / GaAs量子ドット飽和吸収体ミラーの開発
要約
低次元III–V InAs / GaAs量子ドット(QD)は、900〜1310 nmの波長範囲で動作する半導体可飽和吸収体ミラー(SESAM)にうまく適用され、広い帯域幅、波長の柔軟性、そして低飽和フルエンス。ただし、QD構造のエピタキシー成長に対する大きな障害があるため、1550nm付近のより長い波長範囲で動作する高性能QD-SESAMを取得することは非常に困難です。この研究では、初めて、1550nmの発光範囲用に設計されたInAs / GaAs QDシステム、キャッピング層(CL)からQDまでの非常に弱いキャリア緩和プロセスが主に放出性能が悪いため、短周期超格子を開発しました(In 0.20 Ga 0.80 As / In 0.30 Ga 0.70 As) 5 QDのCLとして使用され、従来のInGaAsCLと比較して1550nmで約10倍の発光を実現しました。開発されたQD構造に基づいて、高性能QD-SESAMが成功裏に達成され、13.7 MW / cm 2 という非常に小さな飽和強度を示しました。 同時に1.6%の大きな非線形変調深度により、優れた長期動作安定性を備えた1550nmフェムト秒モードロックファイバーレーザーの構築が可能になります。
はじめに
1550 nmモードロックフェムト秒パルスレーザーは、高いピークパワー、低い熱効果、および高いパルスエネルギーにより、光通信、超高速光学、および非線形光学で幅広い用途があります[1,2,3,4,5]。 。広い光帯域幅、高速応答時間、低損失特性を備えた可飽和吸収体(SA)は、このような超短パルスレーザーの重要な光学部品です[6、7、8、9]。さらに、SAの高い損傷しきい値は、モードロックレーザーの長期安定動作のために非常に望ましいです[10、11、12、13]。最近、グラフェン、トポロジカル絶縁体、黒リン、遷移金属ジカルコゲナイドなどの2次元(2D)材料が、モードロックフェムト秒パルスレーザーのSAとしての用途で大きな注目を集めています[14、15、16、17、18、 19、20、21]。ただし、損傷のしきい値が低く、作業の安定性が低いため、幅広い用途が大幅に妨げられています[22、23]。量子井戸(QW)ベースのSESAMは、再現性が高く、動作安定性に優れているため、モードロック超高速レーザーの商用候補と見なされていますが、動作帯域幅が狭く、変調深度が小さいことが、フェムト秒超短パルスの実現に対する大きな障壁となっています。パルス[24]。
最近、ボード動作帯域幅と高速キャリア回復時間[25,26,27,28,29,30,31]を備え、Stranski-Krastanowモードで成長した自己組織化InAs量子ドット(QD)が優れた選択肢として浮上しています。 SESAMがモードロックパルスレーザーを構築するため。約1550nmの動作波長を実現するために、通常、InPベースのInGaAsPQWが使用されます。 GaAsベースのInGaAsQDのバンドギャップは、一般に980〜1310 nmのスペクトル範囲をカバーするように設計でき、1310 nmを超えるより長い波長では、QDキャッピング層(CL)にはるかに高いインジウム含有量が必要です。四元InGaAsSb(InGaNAs)合金と非常に高いIn%(> 30%)InGaAs CLは、1550 nmの長波長に向けてQDバンドギャップを設計するために使用されています[32、33]。ただし、第4合金CLはエピタキシャル成長プロセスを大幅に複雑にし、InGaAs CLのIn含有量が高いと、QDの結晶および光学品質が低下し、より多くの非放射再結合中心が導入されます。 1550 nmの発光は、変成基板上に成長させたInAs / GaAs QDで得られましたが、信頼性と再現性の低さが、このような技術の深刻な問題として残っています[34]。以前の研究では、1550nmで動作する非対称InAs / GaAs QDを製造しました。これにより、2psのパルス幅でモードロックErドープガラス発振器が実現されました[24]。そして最近、InGaAsでキャップされたInAs / GaAs構造を備えた1550nmのQD-SESAMが製造され、これにより、2波長のパッシブQスイッチエルビウムドープファイバ(EDF)レーザーが実現されました[35]。ただし、これらのQD-SESAMの変調度が0.4%と小さいため、得られたレーザーの性能は制限されていました。したがって、このようなQD-SESAMの変調度を高めることを目的として、1550nmのInAs / GaAsQD構造を最適化するための新しい技術を検討することが非常に望ましいです。
この作業では、1550nmの範囲で動作するSESAM用に設計されたさまざまなInAs / GaAs QD構造を、それぞれInGaAs合金CLとInGaAs短周期超格子(SSL)CLで成長させ、それらの光学特性を徹底的に調査しました。フォトルミネッセンス(PL)分光法の特性は、室温(RT)で1550 nm付近の波長で非常に弱い発光を示します。これは、250 Kより低い温度では観察できません。この現象は、よく知られている温度依存性とは著しく対照的です。 QDシステムの動作、つまりPL強度は低温で強くなり、QD内の閉じ込められたキャリアの熱励起により、RTで非常に弱くなるか、観察できなくなります。 1550 nm InAs / GaAs QDで観察される異常現象は、CLからQDへの弱いキャリア緩和プロセスに起因する可能性があります。これは、QDのSSLCLを増やすことで大幅に減らすことができます。 SSL構造は、大きな振動状態密度の豊富なフォノンモードを提供し、CLからQDへのキャリア緩和を効果的に促進します。したがって、SSLでキャップされていないQDよりも10倍強い1550nmの発光が観察されます。 1550 nm QDの優れたキャリアダイナミクスにより、QD-SESAMは、13.7 MW / cm 2 という非常に小さい飽和強度として表される非常に飽和可能な吸収性能を備えています。 [24、35]で報告されている値の4倍である1.6%のより大きな非線形変調深度。 SSL CLを使用したQD-SESAMの高性能の恩恵を受けて、EDFレーザーの構築に成功し、パルス幅920fsで1556nmの安定したモードロックレーザーを実現しました。
メソッド
InAs / GaAs量子ドットのMBE成長
3つのInAs / GaAs QD構造は、分子線エピタキシー(MBE)の手法で成長しました。すべてのサンプルには3周期のドット層が含まれており、それぞれが2.9単分子層(ML)のInAsから自己組織化されています。図1に示すように、サンプル1と2では、InAsQDはGaAsと1nm In 0.18 で成長しました。 Ga 0.82 それぞれバッファ層(BL)として、すべて6nmの厚さのIn 0.33 でキャップされています Ga 0.67 レイヤーとして。サンプル3の場合、2.9MLのInAsQDも1nmの厚さのIn 0.18 で成長しました。 Ga 0.82 BLと同じですが、In 0.20 の5つの期間で構成される10nmの厚さのSSLでキャップされています Ga 0.80 As(1 nm)およびIn 0.30 Ga 0.70 (1 nm)層として。 InAsQDの成長温度と成長速度はそれぞれ510°Cと0.01ML / sでした。 QD-SESAMは、31ペアのドープされていないGaAs(115 nm)とAl 0.98 を含む下部分布ブラッグ反射鏡(DBR)上に1つのドット層構造を成長させることによって製造されました。 Ga 0.02 (134 nm)層として。 GaAsとInGaAsの成長温度はそれぞれ565°Cと530°Cでした。
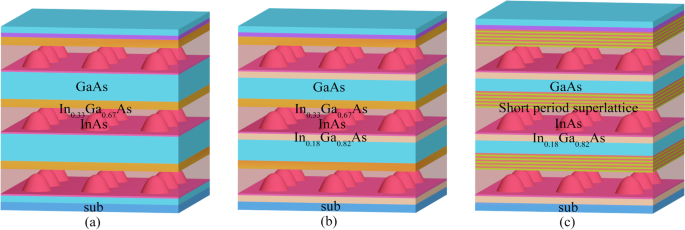
QD構造の概略図。 a の3つのテスト構造の概略図 サンプル1、 b サンプル2、および c それぞれサンプル3
特性評価方法
PL測定は、532 nmの固体レーザーを使用して、11〜300Kのさまざまな温度範囲で実行されました。これらのQDサンプルの結晶構造は、CuKα輝線を使用した高解像度X線回折で特徴づけられました。 QD構造の形態は、Nanoscope Dimension TM の非接触モードで、周囲条件で原子間力顕微鏡(AFM)の手法を使用して調べました。 3100 SPMAFMシステム。透過型電子顕微鏡(TEM)画像は、200 KeVJEOL-2010顕微鏡で取得されました。
結果と考察
図2a、b、およびcは、それぞれ、200 mWの励起電力で11〜300Kの範囲の温度で取得されたサンプル1、2、および3の温度依存PLスペクトルを示しています。これは、2つの特徴的なPLピーク、つまり短波長領域にある狭いピークと長波長領域にある広いピークを示しています。 11Kで約1170nm、300Kで約1280nmに位置する狭いピークはCLからの発光に由来し、300Kで約1550nmにある広いピークはQD発光に起因します。図2aに示すように、低温ではCL発光のみが観察され、InAsQDからの約1550nmの発光は、温度が250 Kまで上昇すると現れ始め、さらに温度が上昇すると徐々に強くなります。 。図2bに示すように、サンプル2でも同様の動作が観察されます。一般に、短波長発光(1300 nmなど)用に設計されたInAs / GaAs QD構造の場合、低温でのPLスペクトルは、QDからの発光が支配的であり、CLまたは湿潤層からの発光はほとんど観察されません。これは、QD構造のエネルギーレベルが低く、低温でのQDからのキャリアの熱逃げが少ないためです[36]。温度の上昇に伴い、QDからのキャリアの熱脱出が促進されるため、QDの発光強度は徐々に低下します。 1310nmアプリケーション用に設計されたInAs / GaAs QDとは著しく対照的に、1550 nmのサンプルは、完全に反対の温度依存発光挙動を示し、この新しいQDシステムの優れたキャリアダイナミクスを示しています。図2eに示すように、QDのバンドギャップはCLのバンドギャップよりもはるかに狭く、電子と正孔の最低エネルギーレベルはすべてQD構造内にあるため、光生成キャリアが存在することが好ましいと予想されます。過剰なエネルギーを緩和した後の量子ドットで。ただし、観察されたPLの結果は、CL発光がPLを支配し、QD発光が250 K未満の温度では見えないことです。これは、低温では、光生成キャリアが主にCLではなくCLに閉じ込められていることを示しています。 QD。この事実は、キャリア散乱プロセスに関与するフォノンが少なすぎて、CLからQDへのキャリアの緩和効率が低くなるという厳しいキャリア緩和ブロッキング効果によって説明できます。温度の上昇に伴い、より多くのフォノン集団が熱的に励起され、フォノンと光生成キャリアとの相互作用が徐々に強化され、CLからQDに散乱されるキャリアが増えます。 RTで現れる1550nmでのQD発光の最も強いPL強度は、CLからQDへのキャリアのエネルギー緩和プロセスがQDからCLへの熱脱出プロセスを支配していることを示しています。

材料の特性評価と概略バンド図。 a から11-300Kで測定されたPLスペクトル サンプル1、 b サンプル2、および c それぞれサンプル3。 d サンプル1、2、および3のそれぞれのGaAs(008)基板ピークとCL回折パターンを示す高解像度ω/2θスキャン。 e の概略バンド図 サンプル2と f それぞれサンプル3
サンプル1および2のPL特性は、1550nmアプリケーション用に設計されたInAs / GaAs QDシステムでは、非効率的なキャリア緩和特性が存在し、フォノン密度が大きいほど、QDまでのキャリア緩和に有利であることを示しています。本質的に、弱いキャリア緩和プロセスは、CLによって決定される電子バンド構造に根ざしています。バンドオフセットがCLの縦光学(LO)フォノンエネルギーよりもはるかに大きいQD材料と、CL内のキャリアは、単一のフォノンではなく複数のフォノンを放出することにより、QDレベルに緩和する必要があります。 CLおよびQDバンド構造のバンドオフセットがはるかに大きいため、1550nmのInAs / GaAs QDでは弱いキャリア緩和プロセスを排除できませんが、電子バンド構造を調整するだけでなく、複数のフォノン散乱プロセスを変更できます。フォノンバンド構造。 1550 nm QDのキャリア緩和を強化するというこの目標を達成するために、(In 0.20 Ga 0.80 As / In 0.30 Ga 0.70 As) 5 InGaAsCLを置き換えるCLとしてのSSL構造。 SSL CLは、SSLのブリルアンゾーンフォールディング効果により、より多くのフォノン振動モードとはるかに大きなフォノン密度を提供することが期待されています[37]。図1cに示すように、サンプル3は、サンプル2と同じ構造で成長しましたが、厚さ10nmのIn 0.20 を5回使用した点が異なります。 Ga 0.80 As / In 0.30 Ga 0.70 CLと同じSSL。図2dは、サンプル1、2、および3で得られたXRDパターンを示しています。すべてのサンプルは66.1°に強いピークを示しています。これは、立方晶GaAsの(008)面からの回折に割り当てることができます。 6nmの厚さのIn 0.33 に起因する明確な衛星ピーク Ga 0.67 サンプル1および2のCL構造は約64.0°で観察されるため、さらに検査すると、In 0.20 であることがわかります。 Ga 0.80 As / In 0.30 Ga 0.70 サンプル3のSSLは、約64.4°に衛星ピークを示し、In 0.33 よりも大きな角度にシフトします。 Ga 0.67 CLが平均In含有量の減少を示唆しているように[38、39]。 InAs / GaAsQDの光学特性に対するSSLCLの影響を理解するために、図2cに示すように、サンプル3の温度依存性PLスペクトルも測定されます。サンプル1および2と同様に、InAs / GaAsQDからの1550nmでの明らかなPL発光は、200 K未満の温度では観察できず、高温が高くなると発光は徐々に強くなります。サンプル3の1550nmでのQD発光ピークは、200 Kのはるかに低い温度(サンプル1および2では約250 K)で現れることに注意してください。 RTでのCL発光に対する相対強度はサンプル1および2よりもはるかに高く、PL強度はサンプル2よりも約10倍強力です。これらの結果は、SSLCLがCLからCLへのキャリア緩和を大幅に促進することを示しています。 QD、QDでの放射再結合が大幅に強化されます。 CLからQDへのキャリア緩和の強化の原因は、インジウム含有量が減少した高品質のSSLCLにあります。これにより、キャリア緩和動作が効果的に変調され、QDによるキャリアのキャプチャが強化されます。
マルチフォノン促進キャリア散乱プロセスをさらに洞察するために、さまざまなタイプのCLを備えたInAs / GaAsQDシステムのバンド構造を比較します。簡単にするために、CLバンドギャップとQDバンドギャップのエネルギー差は、PLピークエネルギーの差として推定できます。図2eとfに示すように、サンプル2と3の300KでのCLとInAsQD間のバンドギャップの差は、PL測定に従ってそれぞれ143と114meVと決定されます。バンドオフセットがCLとQDの伝導帯間のエネルギー差の約60%であると仮定すると[40]、電子はサンプル2とサンプル3のエネルギーレベルから散乱されるためにそれぞれ86と68meVを緩和する必要があります。 InAs量子ドットの最低エネルギーレベルに層をキャッピングします。 InGaAs合金のLOおよび縦音響(LA)モードのフォノンエネルギーは34および9 meVです[40、41]。複数フォノン散乱プロセスの場合、サンプル3の2つのLOフォノンの組み合わせにより、CLからQDへの電子の散乱を実現できますが、サンプル2には2つのLOフォノンと1つのLOまたは2つのLAフォノンが必要です。より多くのフォノンモードが複数のフォノン散乱過程に関与する場合、電子緩和率は大幅に低下します[42、43、44、45]。したがって、サンプル3の電子緩和率はサンプル2の電子緩和率よりも大きく、サンプル3のQDのPL強度が大幅に向上しています。実際には、SSL CLのIn含有量が減少し、フォノンボトルネック効果が弱まっています。キャリア緩和プロセスは、サンプル3のQDのPL強度が向上する主な理由です。
SSL CLによって引き起こされるキャリア緩和効果の向上をさらに検証するために、励起電力に依存するPLスペクトルを300 Kで取得しました。図3a、b、およびcに示すように、CL(ピーク1)およびInAsのPL強度QD(Peak 2)ピークは、励起パワーの増加とともに徐々に増加し、ピーク位置の明らかなシフトは観察できません。図3aおよびbに示すように、高い励起パワーでは、ピーク1の強度がサンプル1および2のピーク2の強度よりもはるかに強いのに対し、サンプル3は測定されたすべての励起ではるかに強いQD発光を示すことがはっきりと観察されます。パワーレンジ。励起パワーの関数としてのこれらのサンプルのピーク2とピーク1のPL強度比を図3dにまとめました。図3dに示すように、2000 mWの励起パワーでは、ピーク2とピーク1のPL強度比はサンプル1と2にそれぞれ対応する0.21と0.29であることがわかります。これは、多くのキャリアがInGaAs CLで再結合し、キャッピング層からInAs量子ドットへのキャリア緩和が非効率的なキャリア緩和率のために大幅に妨げられていることを示しています。サンプル1と比較して、サンプル2のピーク2とピーク1の層強度比は、In 0.18 によって引き起こされるより多くの核形成中心によって達成されるより高いドット密度に起因する可能性があります。 Ga 0.82 バッファ層として[24]。サンプル3のピーク2の強度は、2000 mWの励起パワーでピーク1の強度の約2.1倍であり、SSLでキャップされたInAsQDのキャリア緩和効率が大幅に向上していることを示しています。さらに、SSLキャッピング層の平均In含有量は約25%であり、サンプル1および2のCLでは33%未満ですが、サンプルのピーク1の発光波長(〜1337 nm)がわかります。 3は、サンプル1および2の場合よりもわずかに長くなっています(約1310 nm)。結果の主な理由は、6 nmと比較してはるかに厚い(10 nm)SSL層での量子閉じ込め効果の低下であると考えました。 InGaAsキャッピング層。

電力に依存するPL測定。 a から20〜2000mWで測定された室温の電力依存PLスペクトル サンプル1、 b サンプル2、および c それぞれサンプル3。 d ピーク2 /ピーク1の強度無線とサンプル1、2、および3のポンプパワーのそれぞれ。
SSLでキャップされたInAs / GaAs QDで得られた優れた光学特性に基づいて、フェムト秒パルス生成用のQD-SESAMとしてのアプリケーションをさらに示します。 1550 nmSSLキャップInAs / GaAs QD-SESAMは、吸収層としてのSSLキャップInAs / GaAs QDの1層と、31周期の非ドープGaAs(115 nm)およびAl 0.98で構成された下部DBRミラーで構成されます。 Ga 0.02 (134 nm)層として。 QD-SESAMの詳細な構造は、図4に示す断面TEM画像で示されています。吸収層のQDの平均ドット密度は4.4×10 10 と推定されます。 cm -2 、およびドットの平均高さと横方向のサイズは、図4のAFM画像に見られるようにそれぞれ7.5と40 nmです。SESAMは、典型的なバランスの取れたツイン検出器のセットアップ[46]と13.7MWの飽和強度を特徴としています。 / cm 2 そして、1.6%の非線形変調深度が達成されます。図4に示すように、EDFレーザーキャビティにQD-SESAMを挿入して、パッシブモードロックレーザーを構築しました。標準の23.75mシングルモードファイバと0.75m EDFを利得媒体として使用すると、得られるキャビティの長さは24.5mになります。 980 nmで発光する半導体DFBレーザーダイオード(LD)がポンプ源として機能し、980/1550 nm波長分割マルチプレクサー(WDM)を使用して、ポンプエネルギーをファイバーレーザーキャビティに結合します。偏光に依存しないアイソレータ(PI-ISO)と偏光コントローラ(PC)を使用して、光の一方向の透過を確保し、キャビティ内のモードロック状態を最適化します。 1550 nm光サーキュレータ(CIR)のポート1はPCに接続され、ポート2はQD-SESAMにリンクされ、このCIRのポート3は10/90出力カプラー(OC)に接続されます(10%出力および90%の入力)。
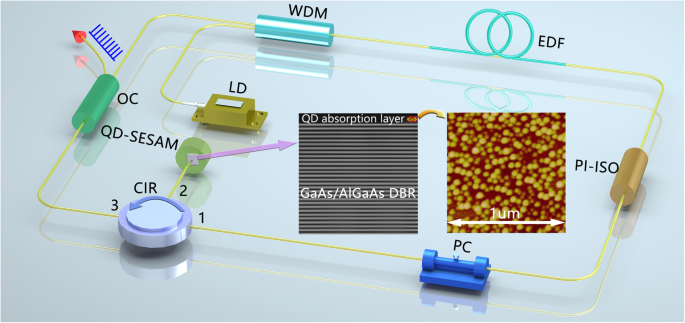
1550 nmQD-SESAMを使用したモードロックファイバーレーザーの実験セットアップ。挿入図:QD-SESAMおよび1×1μm 2 の断面TEM画像 1550nm量子ドットのAFM画像
モードロック動作は、ポンプ出力が50mWを超える場合に実現できます。図5aに示すように、このモードロックレーザーの出力パワーは、ポンプパワーの増加に伴って直線的に増加し、スロープ効率は線形フィッティング処理によって決定されて約4.82%です。図5bに示すように、3.2nmの3dB帯域幅を持つ従来のソリトンの典型的なスペクトルが観察されました。中心波長は1556nmです。繰り返し率8.16MHzのRFスペクトルを図5cに示します。これは、キャビティ長24.5mに対応します。信号対雑音比は約51dBであり、SSLキャッピングQD-SESAMを使用して安定したモードロック動作を実現する大きな可能性を示しています。長時間の安定モードロック測定は、50 mWのしきい値ポンプ出力で動作し、1週間以上の安定した連続動作が達成されました。図5dは、ガウスフィッティングプロファイルでフィッティングされた自己相関トレースであり、約920fsの実際のパルス持続時間を示しています。比較のために、15.7 MW / cm 2 の飽和強度を示すサンプル2のような構造に基づくQD-SESAMを使用します。 非線形変調深度は0.4%で、モードロックレーザーは2.7ps幅のパルスを生成します[47]。 QD-SESAMベースのSSLキャップQDで達成されたパルス持続時間の大幅な短縮は、変調深度の増加に起因する可能性があり、SSLキャッピング層によって引き起こされるキャリア緩和効率の向上が飽和強度の低下の原因であると考えました。さらに、モードロックファイバーレーザーを構築するために他の5つのSSLキャップQD-SESAMが選択され、すべてのモードロックレーザーは長期安定性を示し、SESAMの高い再現性と信頼性が実証されています。

開発したファイバーレーザーのモードロックの特徴。 a 出力電力対ポンプ電力。 b 光スペクトルを出力します。 c モードロックファイバーレーザーのRFスペクトル。 d 自己相関トレース
結論
結論として、1550nmアプリケーション用に設計されたInAs / GaAs QDは、QDのキャッピング層としてそれぞれInGaAs合金とSSLの層を使用したMBE技術によって成長しました。温度依存および電力依存のPL分光法の特性評価により、In 0.33 を変更することにより、CLおよびQD構造の伝導バンドオフセットが86meVから68meVに変更されることが明らかになりました。 Ga 0.67 合金CLとして(In 0.20 Ga 0.80 As / In 0.30 Ga 0.70 As) 5 したがって、SSL CL、およびより効率的な複数フォノンが関与するキャリア散乱が達成され、QD構造でより多くのキャリアが放射的に再結合し、1550nmでの発光が大幅に改善されます。 SSLでキャップされたInAs / GaAs QDで成長したQD-SESAMは、13.7 MW / cm 2 の大幅に強化された飽和強度を示します。 QD-SESAMで構築された1556nmで動作するモードロックファイバーレーザーでは、1.6%の非線形変調深度と920fsのパルス持続時間が達成されます。 QDのCLとしてSSL設計で開発されたQD-SESAMは、高性能超高速レーザーへの新しい道を開くでしょう。
データと資料の可用性
現在の研究中に生成および/または分析されたデータセットは、合理的な要求に応じて、対応する著者からの制限なしに完全に利用可能です。
略語
- 2D:
-
二次元
- AFM:
-
原子間力顕微鏡
- BL:
-
バッファ層
- CIR:
-
サーキュレーター
- CL:
-
キャッピングレイヤー
- DBR:
-
分布ブラッグ反射鏡
- EDF:
-
エルビウムドープファイバ
- LA:
-
縦音響
- LD:
-
レーザーダイオード
- LO:
-
縦光学
- MBE:
-
分子線エピタキシー
- ML:
-
単層
- OC:
-
出力カプラー
- PC:
-
偏光コントローラー
- PI-ISO:
-
偏光に依存しないアイソレータ
- PL:
-
フォトルミネッセンス
- QD:
-
量子ドット
- QW:
-
量子井戸
- RT:
-
温度
- SA:
-
可飽和吸収体
- SESAM:
-
半導体可飽和吸収体ミラー
- SSL:
-
短周期超格子
- TEM:
-
透過型電子顕微鏡
- WDM:
-
波長分割多重方式
ナノマテリアル
- 半極性InxGa1-xN / GaN多重量子井戸を備えた紫外線GaNベースのフォトニック準結晶ナノピラミッド構造からの多色発光
- マイクロピラーのInAs二重層量子ドットに基づく1.3μmの明るい単一光子源
- 自己組織化InAs / InGaAs量子ドット超格子における空間的に局在化した励起子の検出:光起電効率を改善する方法
- 変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
- コア/シェルCdSe / ZnS量子ドットフィルムの光励起発光に対する可逆的電気化学的制御
- ナノワイヤ/量子ドットハイブリッドナノ構造アレイ太陽電池の光起電力性能
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- メソテトラキス(p-スルホン酸-フェニル)ポルフィリンによるシステイン被覆CdSe / ZnS量子ドット発光の刺激
- 高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
- 水溶性青色発光Mn合金CdTe量子ドットの合成と性質
- タルボットキャビティと統合されたテーパー量子カスケードレーザーアレイ



