選択的エピタキシャル成長と選択的ウェットエッチング法を統合することによる高品質でひずみ緩和されたGeSnマイクロディスクの製造
要約
GeSnは、オンチップフォトニックおよびナノ電子デバイスの製造に有望な材料です。このようにして、エピタキシー、アニーリング、イオン注入、エッチングなど、GeSn専用の処理技術が開発されました。この作業では、GeSn合金をエッチングすることなく、新しいアプローチによって、吊り下げられ、ひずみが緩和された、高品質のGeSnマイクロディスクが実現されます。 GeSn合金は、低温での分子線エピタキシーによって、事前にパターン化されたGe(001)基板上に成長しました。 GeSnサンプルの微細構造を決定するために、透過型電子顕微鏡法と走査型電子顕微鏡法を実施した。異なる直径のGeペデスタルを備えたマイクロディスクは、選択的なウェットエッチング時間を制御することによって製造され、マイクロラマンの結果は、残りのGeペデスタルの異なる寸法を備えたマイクロディスクが異なる程度のひずみ緩和を有することを示している。マイクロディスクの圧縮ひずみは、適切な条件下でほぼ完全に緩和されます。この研究で紹介する半導体処理技術は、さまざまなSi互換フォトニクス、3D-MOSFET、および微小電気機械デバイスアプリケーション向けの革新的なGeSnおよびその他の材料ベースのマイクロ/ナノ構造を製造するための代替方法となります。
はじめに
相補型金属酸化膜半導体(CMOS)互換のIV族材料であるゲルマニウムスズ(GeSn)は、エレクトロニクスおよびオプトエレクトロニクスへの応用で近年大きな注目を集めています。より多くのSnをGeに合金化すると、キャリア移動度が向上するだけでなく、バンドギャップが間接遷移から直接遷移に変化します[1、2]。理論的研究[3,4,5]およびフォトルミネッセンスベースの実験研究[6,7,8]は、緩和されたGeSn合金の間接から直接への遷移が6.5%以上のSn含有量で発生することを示しています。しかし、GeにおけるSnの低い(1%)平衡溶解度[9、10]、およびGeとα-Sn間の大きな格子不整合(〜15%)は、欠陥のないGeSn合金を実現するための大きな課題をもたらします。置換Snの数原子%。低温分子線エピタキシー(MBE)[11,12,13,14,15]、化学蒸着(CVD)[16,17,18,19,20]、および固相エピタキシー[21、22]は非常に必要とされています。
ひずみ緩和Ge仮想基板またはGe基板上に成長させたGeSn合金の場合、最高品質のGeSnは、仮像または完全ひずみ状態で達成されることが期待され、ミスフィットや貫通転位の形成を回避できます。それにもかかわらず、そのようなGeSn合金は圧縮歪みがあり(1%Snあたり約0.15%)、このエピタキシー誘起歪みは、バンドギャップ変換のためにSnとGeを合金化する効果を打ち消します。結果として、Ge(001)[23]上の仮像GeSnエピ層の17%というはるかに高いSn含有量は、直接バンドギャップを達成するために必要であり、エピタキシーと低い材料品質に対する非常に高い課題につながります。したがって、GeSnエピ層の結晶の品質を犠牲にすることなくひずみを操作することは非常に重要な問題になります。部分的に懸架された微細構造を形成するためのGeSnエピ層の下の応力誘導Ge仮想基板またはGe基板の選択的除去は、GeSn膜の圧縮ひずみを克服するための有望な技術です。たとえば、中央に支柱を備えた吊り下げられたGeSnマイクロディスクが製造されました[24、25、26、27、28]。この構造は、自由表面での弾性変形によってGeSn層の圧縮ひずみを緩和するだけでなく、ささやきのようにGeSnと周囲の媒体(空気)との間の強い屈折率コントラストにより、マイクロディスクのエッジ近くに光学モデルを閉じ込めることができます。 -ギャラリーモード[16、25]。これまで、成長後の光リソグラフィーと二次元GeSn膜のトップダウンエッチングによってGeSnマイクロディスクを準備する方法は1つしか報告されていません[16、24、29、30]。ただし、このプロセスは、成長後のエッチングプロセス中に熱の不一致の影響を受ける可能性があり、GeSnマイクロディスクの材料品質が低下する可能性があります。最近、P.Ponath etal。高度に結晶性の c の選択的領域成長を報告しました -軸指向のBTO [31]は、GeSn微細構造の製造に影響を与えました。最後のステップで、事前にパターン化されたSiO 2 にGeSnマイクロディスクを直接堆積する。 / Ge基板を作成し、犠牲SiO 2 に続いてGe基板を選択的にエッチング除去します。 層の除去、浮遊GeSnマイクロディスクは、従来の複雑な成長後エッチングプロセスなしで製造できます。そのような方法は、可能であれば、前述の問題を回避し、したがって、より高品質でひずみが緩和されたGeSn微細構造を得ることができる。さらに、これは、特に層の正確な厚さ制御を必要とする複雑なデバイス構造の3次元統合の場合に、高精度で優れたアスペクト比で任意のパターンを実現できる非常に有望な方法でもあります。
この論文では、GeSnマイクロディスク構造が新しい方法でうまく製造されました。選択的エピタキシャル成長と選択的ウェットエッチングの簡単なステップを組み合わせてGeSnマイクロディスクを作成するのは初めてです。 GeSnエピ層の厚さ、Sn濃度、および結晶品質は、高分解能透過型電子顕微鏡(HRTEM)および二次イオン質量分析(SIMS)によって特徴づけられました。走査型電子顕微鏡(SEM)とマイクロラマン分光法(μ-ラマン)を使用して、製造されたGeSnマイクロディスクの微細構造への洞察を得ました。室温(RT)μ-Ramanの結果は、残りのGeペデスタルの寸法が異なるマイクロディスクのひずみ緩和の程度が異なることを示しています。マイクロディスクの圧縮ひずみは、適切な条件下でほぼ完全に緩和されます。 GeSn自体をエッチングする必要なしにマイクロディスクを製造するこの方法は、リラックスした高品質のGeSnおよびその他の材料のナノ構造を得るのに有益です。
メソッド
資料
GeウェーハはAXT社から購入しました。アセトン、イソプロピルアルコール、フッ化水素酸、エチルアルコール、過酸化水素、アンモニア水溶液、および水酸化カリウムは、Sinopharm Chemical Reagent(中国)から供給されました。脱イオンH 2 O(18.2MΩ・cm)は限外ろ過システム(Milli-Q、Millipore、マサチューセッツ州マールボロ)から入手しました。
パターン化されたGe基板の準備
Ge(001)ウェーハ(n型、0.025〜0.031Ωcm)を最初にアセトンとイソプロピルアルコールに3分間浸し、次に希釈フッ化水素酸溶液(HF:H 2 )を使用して化学的に洗浄しました。 O =1:20)RTで20秒間。これに続いて、脱イオン化されたH 2 を実行してリンスしました。 O(DI–H 2 O)。洗浄手順は重要です。特に、自然酸化物層を剥がし、Ge表面がきれいで、次のSiO 2 と密接に接触していることを確認するためのHF処理が重要です。 層。この場合、リフトオフプロファイルは、Si / SiO 2 の堆積によって実現されます。 複合層。次に、乾燥したN <sub> 2 を吹き付けることにより、ウェーハを乾燥させた。 プラズマ化学気相成長法(PECVD)の超高真空(UHV)チャンバーにすばやくロードし、300°Cで20分間アニーリングして、完全にガスを放出します。次に、300 nm SiO 2 図1aに示すように、層はPECVDによって同じ温度で堆積され、続いてRTでマグネトロンスパッタリングによって50nmのドープされていない多結晶Siが堆積されました。 Si / SiO 2 の円形開口部 複合層は、標準的なフォトリソグラフィー技術(図1b)と2段階のエッチングプロセス(図1c、d)を使用してパターン化されます。
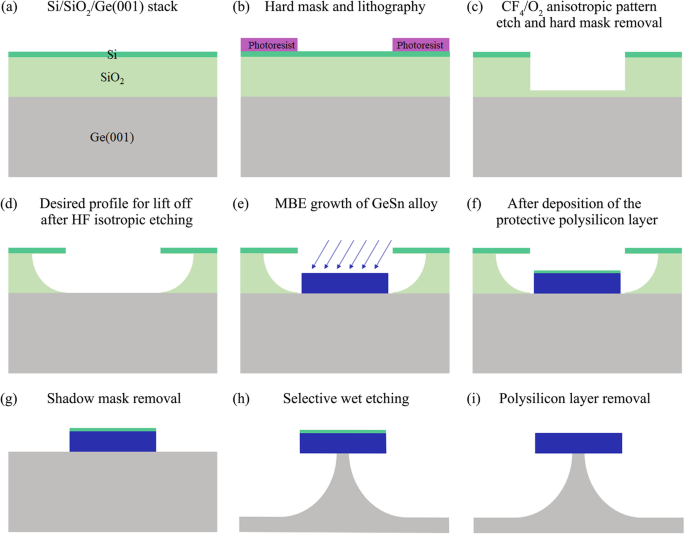
吊り下げられたGeSnマイクロディスクの製造のための断面概略図
詳細には、パターン化する前に、Si / SiO 2 / Geウェーハ、ウェーハはアセトン、エチルアルコール、およびDI-H 2 で洗浄されました。 O、次にN 2 でブロー乾燥 そして90°Cのオーブンでプリベークしました。その後、スピンコーターを用いてAZ5214フォトレジストを4000r /分の速度で30秒間スピンコーティングし、次にホットプレート上に置き、90℃で2分間ソフトベーキングした。次に、製版機(Heidelberg、uPG501)を使用して、Si / SiO 2 上に円形のパターンアレイを作成しました。 / Geスタック。円形のパターンは互いに5μm離れて固定されていますが、直径は3〜5μmの範囲です。次に、パターンを下部のSiO 2 に転写しました。 2段階のエッチングによる層。 CF 4 の混合ガスを用いた反応性イオンエッチングによる異方性ドライエッチング およびO 2 Si / SiO 2 をエッチングするために最初に採用されました 層を形成し、約20nmのSiO 2 で停止しました 左。次に、フォトレジストを溶解し、RTで希釈HFを使用してウェットエッチングを行い、左側のSiO 2 を除去しました。 層は、円形の開口部にゲルマニウムを露出させると同時に、定義されたポリシリコンエッジの下で横方向にエッチングして、リフトオフに必要なプロファイルであるオーバーハングを作成します。
GeSnの成長とマイクロディスクの製造
GeSn薄膜堆積の場合、ベース圧力が2×10 -10 の固体ソースMBEシステム(Riber SSC) Torrが使用されました[32]。 MBEシステムでのGeとSnの蒸発には、電子ビーム蒸発器と高純度固体源を使用した熱分解BNエフュージョンセルが装備されています。水晶モニターを使用して、堆積速度を較正した。パターン化された基板をUHVシステムにロードする前に、基板をO 2 で洗浄しました。 ドライエッチングによって誘発された有機残留物を除去するためのプラズマ。アセトン、イソプロピルアルコール、および希釈HFでリンスした後、GeSn成長のために基板をMBEチャンバーに移しました。 450°Cで15分間熱脱離した後、基板をその場で150°Cまで冷却し、GeSn合金層を0.5Ås -1 のGe成長速度で成長させました。 ドーパント源としての制御されたSnフラックス。この成長温度は、Sn表面の偏析を効率的に抑制するのに十分なほど低い。酸化を防ぐために、10nmのGeキャップ層が最終的に同じ温度で堆積されました。
成長後、公称Sn濃度が4%および10%のGeSn合金がマイクロディスクの製造に使用されます。次に、マグネトロンスパッタリングを使用して、RTでサンプルの上部に追加の30 nm厚のポリシリコン層を堆積し、GeSn層を次のエッチングから保護しました。次に、犠牲SiO 2 希釈されたHF(1:1)を使用して層を除去しました。これにより、重なっているポリシリコン層とその上に堆積したGeSn膜も除去されます。図2に見られるように、孤立した円形のGeSnメサがSiO 2 の後に現れました。 レイヤーが削除されました。ただし、円形メサの周囲はそれほど滑らかではないため、光学的閉じ込め効果には適していません。予期しない状況は、下部のSiO 2 のエッジにGeSnが堆積することによって引き起こされます。 底部のSiO 2 の不十分な横方向のエッチングから生じる層 異常な角度(30°)の堆積。続いて、選択的ウェットエッチングの簡単なステップにより、RTで円形メサがアンダーカットされ、GeSnマイクロディスク構造が浮遊します。選択的エッチャント(APM)は、H 2 で構成されます。 O 2 (31 wt%)、NH 4 OH(28 wt%)、およびDI-H 2 体積比が2:0.5:80のO [30]。最後に、上部の保護ポリシリコン層がKOHによって除去されました。プロセスステップの概略図を図1e–iに示します。
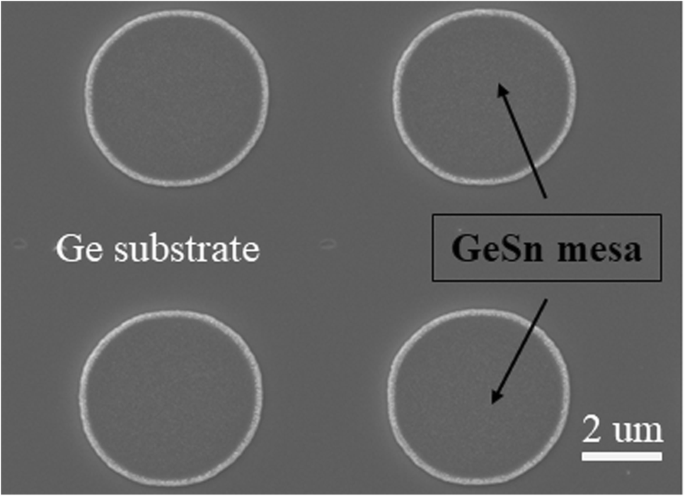
シャドウマスクを取り外した後の、直径5μmの孤立したGeSn円形メサの上面SEM画像
GeSnマイクロディスクを製造する私たちの方法では、Sn濃度が異なるGeSn材料のエッチング速度が異なるため、最終的な選択的ウェットエッチングが重要です。 Ge 1-x に対するGeのエッチング選択性 Sn x Sn濃度によっても異なります。 GeSn中のSnの濃度が高いほど、SnO y の表面被覆率が高くなります。 開発されます[33]。これにより、GeSnのウェットエッチング速度が低下し、GeSnよりもGeのエッチング選択性が高くなります。以前の研究では、H 2 O 2 ベースのウェットエッチング(H 2 O 2 :NH 4 OH:H 2 O =2:0.5:80)、この作業と同じように、Ge 0.928 よりもGeのエッチング選択性を達成します。 Sn 0.072 9:1の[30]。
結果と考察
図3aは、上部ポリシリコン層のない直径5μmのGeSn円形メサの断面TEM顕微鏡写真を示しています。図3b、cは、それぞれGeSn / Ge界面とGeSn層の中間領域に対応する、領域AとBの高分解能TEM(HRTEM)顕微鏡写真です。 GeSn層の膜厚は、シャドウマスクの厚さより約250 nm低くなっています(図3a)。図3bに見られるように、欠陥は主に30nmの厚さのGeSn / Ge界面に局在し、次の単結晶GeSn成長をもたらします。領域BのHRTEM画像は、GeSn層の明確な格子縞を示しています。これは、合金が高度に結晶性であり、領域Bの高速フーリエ変換(FFT)パターンが図3cに示すようにGeSnの回折パターンとよく一致していることを示しています。また、GeSn合金のSn濃度を確認するために、図3aの挿入図に示すようにSIMS測定を完了しました。 Sn濃度は9.8±0.5%であり、公称値の約10%と一致しています。それとは別に、Sn原子の分布は、成長したままのGeSn膜の深さプロファイルで非常に均一です。
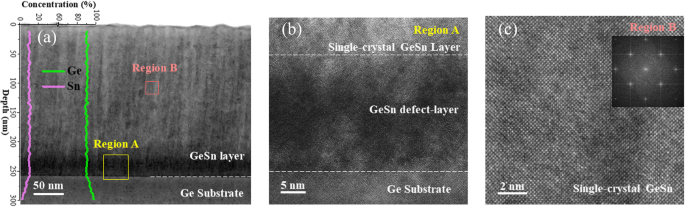
a 上部ポリシリコン層のない直径5μmのGeSn円形メサの断面TEM画像。挿入図:GeSn層のSIMS深度プロファイル。 b GeSn / Geインターフェースの高分解能TEM画像(領域A)。 c GeSn層の中央領域(領域B)の高分解能TEM画像。挿入図:領域BのFFTパターン
サンプルの表面構造はSEMによって研究されました。図4aは、直径5μmのGe 0.96 の上面SEM画像を示しています。 Sn 0.04 RTでのAPM溶液による510秒の選択的ウェットエッチング後の円形メサ。化学物質の老化の影響を避けるために、実験の直前にエッチャントが調製されることに言及する必要があります。 SEM画像は、Ge基板だけでなくGeSnメサの一部もエッチングされていることを示しています。 Ge 0.96 のディスク構造の形成の失敗 Sn 0.04 合金はSnの濃度が低いため、GeSnよりもGeのエッチング選択性が低くなります。 Ge 0.96 とは対照的 Sn 0.04 サンプルでは、Sn濃度が9.8%と高い直径5μmのGeSn円形メササンプルも、RTでAPMによってエッチングされました。図4bに示すように、c。 c、マイクロディスク構造はGe 0.902 で正常に形成されました Sn 0.098 510秒のウェットエッチング後の合金。以前は、Han etal。 [30]は、部分的に吊り下げられたGe 0.928 を製造したと報告しました。 Sn 0.072 H 2 を使用して約1.2μmのアンダーカットを備えたマイクロディスク(寸法5μm) O 2 7:1の選択性を備えたベースのウェットエッチング。しかし、選択的ウェットエッチング後、エッチャント液が除去されると、浮遊構造と基板の間に強い引力の毛細管力が発生し、解放されたマイクロディスク構造が基板と接触するため、ディスクのエッジが曲がって破損します。 24]。しかし、この現象は、Geペデスタルの下をほぼ完全に除去するために選択的エッチングを延長しても、私たちの実験では発生しません。これは、エッチング選択性が高く、GeSn層が約250nmと厚いことで説明できます。興味深いことに、ペデスタルは、選択的ウェットエッチングプロセス中の方向に依存する横方向のエッチング速度によって引き起こされる可能性のある、さまざまな方向の予期しないファセットを示しています。
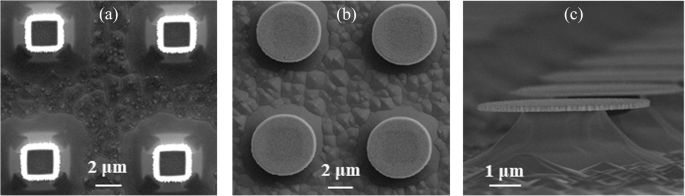
選択的ウェットエッチング後のSEM画像。 a 直径5μmGe 0.96 Sn 0.04 510秒のエッチング後の円形メサ。 b 、 c 直径5μmGe 0.902 Sn 0.098 510秒のエッチング後の円形メサ
さらに、選択的エッチング時間を制御することにより、異なる直径のGeペデスタルを備えたマイクロディスクを製造した。図5aは、APMでのエッチング時間の関数としての残りのGeペデスタルの直径を示しています。エラーバーは、同じサンプル内の5つの異なるマイクロディスクのデータからの標準偏差を表します。同様の線の傾向は、Geのエッチング速度がGe 0.902 でほぼ等しいことを示しています。 Sn 0.098 直径が3μmと5μmの異なるディスクであり、参考文献のエッチング速度の値と一致しています。 [30]。さらに、GeSnマイクロディスクを立てるためのGeペデスタルの最小直径は約300nmです。吊り下げられたGeSnマイクロディスクは、Geペデスタルが小さくなると、強い引力の毛細管力によって引き下げられます。
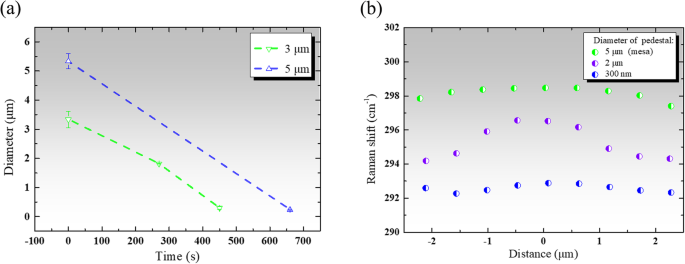
a 3μm(緑の破線)および5μm(青の破線)の直径Ge 0.902 の選択的ウェットエッチング時間の関数としてのGeペデスタルの直径 Sn 0.098 ディスク。 b 5μmGe 0.902 の直径に沿って実行されたラマンシフトラインスキャン測定 Sn 0.098 メサ(緑の点)と直径2μmのGeペデスタル(紫の点)と直径300 nmのGeペデスタル(青の点)のマイクロディスク
GeSnマイクロディスクの弾性ひずみ分布を調査するために、約600nmのスポットサイズで励起するために633nmレーザーを使用して、直径5μmのディスク上でRTでμ-Ramanを実行しました。レーザー出力は、熱の影響を最小限に抑えるために最大出力(15 mw)のわずか1%であり[34]、GeSnフィルムへの励起レーザーの侵入深さは約50nmです[26]。ラマンシフトは、スペクトルをローレンツ関数でフィッティングすることによって測定されました。
図5bは、Ge 0.902 の1次元ラマンラインスキャンを示しています。 Sn 0.098 微細構造。 (1)アンダーカットのない直径5μmのメサの場合、Ge-Ge LOフォノンモードに関連するラマンピークは、メサの中心から端に向かってより低い波数に向かって明らかにシフトし、大きなラマンシフトは次のことを示しています。 GeSnメサには大きな圧縮ひずみがあります。 (2)直径2μmのGeペデスタルを備えた直径5μmのマイクロディスクの場合、Ge-Ge LOフォノンモードに関連するラマンピークは、ディスクの中心から端に向かって明らかに低い波数にシフトし、アンカリングによるひずみ勾配を示します。比較的大きなGe台座に。また、直径2μmのペデスタルを備えた5μmのGeSnマイクロディスクは、その周辺に一定量の圧縮ひずみを維持しています。 (3)5μmGe 0.902 の直径に沿って測定されたGe-Geピーク位置 Sn 0.098 直径300nmのGeペデスタルを備えたマイクロディスクは一貫性を保ち、ラマンシフトが明らかに減少しています。したがって、狭いGeペデスタル(直径約300 nm)のディスクは完全にリラックスしていると予想されます。
図6に、直径5μmのGe 0.902 の典型的なラマン散乱スペクトルを示します。 Sn 0.098 直径300nmのGeペデスタルを備えたマイクロディスク。ディスクの場合、ラマンスペクトルは292.4 cm -1 の周波数で非対称ピークを示します。 Ge-GeLOモードに対応します。比較のために、直径5μmのメサと参照バルクGe(001)基板について記録されたラマンスペクトルもプロットされています。アンダーカット後、ラマンシフトをクリアすることに注意してください(-6.3cm -1 )半導体合金のラマン周波数シフトは主にひずみと組成に影響されるため、Ge-Geピークの9.8%Snマイクロディスクで観察できます。以前のラマン研究[33、35、36、37]は、GeSnのGe-GeLOフォノンモードのラマンシフトがSn濃度 x の関数として表現できることを示しています。 Sn 面内二軸ひずみε ∥ 次の式。 (1):

5μmGe 0.902 のラマンスペクトルの比較 Sn 0.098 直径300nmのGeペデスタル、5μmのGe 0.902 を備えたマイクロディスク Sn 0.098 直径メサと参照としてのバルクGe基板。挿入図:ラマンスペクトルの拡大図。 Ge-Snのピークは、260 cm -1 付近でも観察できます。 、Geペデスタルの直径を小さくするとダウンシフト
ここでω GeSn およびω Ge はそれぞれGeSnとバルクGeのGe-GeLOフォノンモードのピーク位置であり、AとBは係数です。
メサとディスクのGe-GeLOラマンピークは、-1.4 cm -1 のシフトを示しています。 および− 7.7cm -1 バルクGeピークと比較して(300.1 cm -1 )。以前の実験結果[37]から係数をとることにより、面内二軸染色の値ε ∥ 成長したままのGeSnメサの場合は-1.18%と計算されます。作製したマイクロディスクの場合、面内二軸染色ε ∥ はほぼ0に等しく、マイクロディスクのほぼ完全なひずみ緩和を確認します。 Ge 1- x の最近の理論計算によると Sn x 電子バンド構造[38]、成長したままのGe 0.902 Sn 0.098 層は、バンドギャップエネルギーが約0.56 eVの間接バンドギャップ材料であり、完全に緩和されたGe 0.902 Sn 0.098 マイクロディスクは、バンドギャップエネルギーが0.50eVの直接バンドギャップ材料です。
結論
結論として、GeSnマイクロディスクは、選択的エピタキシャル成長と選択的ウェットエッチングプロセスを組み合わせることにより、正常に製造されました。 HRTEMとSEMを実行して、GeSn合金が高度に結晶性であり、GeSnマイクロディスク構造が単純な選択的ウェットエッチングによって容易に形成されることを確認しました。 μ-Raman測定は、GeSnマイクロディスクのひずみ緩和がGeペデスタルの直径を小さくすると大きくなることを示しています。これは、小さいGeペデスタルからの機械的制約が同時に減少するためです。そして最後に、このより費用効果の高い方法によって、高品質で完全にひずみを緩和するGeSnマイクロディスクが実現されました。製造プロセスは、横方向の量子サイズ効果が重要になるまでGeSnメササイズを小さくし、将来のSi互換フォトニックおよび電子用にGeSn量子ドット、GeSnナノメッシュ、GeSnナノワイヤなどの他のGeSnナノ構造を取得するための非常に有望な方法でもあります。デバイスアプリケーション。
データと資料の可用性
この研究の結果を裏付けるデータは、合理的な要求に応じて対応する著者から入手できます。
略語
- APM:
-
過酸化アンモニア混合物(ウェットエッチャント)
- FFT:
-
高速フーリエ変換
- HRTEM:
-
高分解能透過型電子顕微鏡
- MBE:
-
分子線エピタキシー
- PECVD:
-
プラズマ化学気相成長法
- RT:
-
室温
- SEM:
-
走査型電子顕微鏡
- SIMS:
-
二次イオン質量分析
- μ-ラマン:
-
マイクロラマン分光法
ナノマテリアル
- Java 抽象クラスと抽象メソッド
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 異なる粒子サイズのアベルメクチンナノデリバリーシステムの製造、特性評価、および生物活性
- 銀ナノ構造の合成方法と応用における最近の進歩
- ポリオール媒介プロセスによるZnOナノクリップの製造と特性評価
- CA / TPUヘリカルナノファイバーの製造とそのメカニズム分析
- 新規SrTiO3 / Bi5O7Iナノコンポジットの製造と光触媒特性
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解
- イオンビームエッチングによる非最密コロイドナノ粒子アレイの制御可能な製造
- レーザーエッチングとレーザー彫刻



