GaAs1-xBix合金の原子分解能EDX、HAADF、およびEELS研究
要約
半導体中の合金原子の分布は、材料の特性に大きな影響を与える可能性のあるランダムな分布から逸脱することがよくあります。この研究では、走査型透過電子顕微鏡技術を使用して、いくつかの明確にMBEで成長させたGaAs 1-x におけるBiの分布を分析します。 Bi x 合金。原子分解能HAADF画像の統計的定量化、および数値シミュレーションを使用して、原子的に急激な(001)GaAs-GaAsBi界面でのBi含有カラムからのコントラストとCuPtタイプの秩序化の開始を解釈します。単色化EELSマッピングを使用して、相分離ドメインを示すサンプルでバルクプラズモンエネルギーのレッドシフトを調べます。これは、局所的なGaAsBiユニットセルの体積膨張を調査し、標準的なX線ベースの格子ひずみ測定を補完する簡単な方法を示唆しています。また、オフカット基板上に成長した単一バリアントのCuPt秩序化GaAsBiサンプルは、原子スケールの組成EDXマッピングで特徴付けられ、秩序パラメーターが推定されます。最後に、垂直方向のBi組成変調を備えたGaAsBi合金が、低い基板回転速度を使用して合成されます。原子的には、分解されたEDXおよびHAADFイメージングは、通常のCuPtタイプの秩序が[001]成長軸に沿って3つの格子定数の周期でさらに変調されることを示しています。これらの異なるGaAsBiサンプルは、この合金で達成できるさまざまなBi分布を例示し、Bi原子の取り込みメカニズムと、Bi含有III-V半導体をさらに開発する方法に光を当てています。
はじめに
ビスマイドGaAs 1-x Bi x 合金は膨大な量の研究を経験しており、ビスマスを含むIII-V族半導体の新しいクラスを代表しています[1]。ビスマスは最大の安定した無毒の元素であり、組み込むと大幅なGaAsバンドギャップの減少をもたらします。グループV副格子のBiを置換すると、中程度の格子ひずみを持つGaAsBiで90 meV / Bi%のバンドギャップボウイングを実現できます[1,2,3]。大きなスピン軌道相互作用は、格子へのBiの取り込みのもう1つの注目すべき効果です。これにより、GaAs 1-x での価電子帯吸収とAuger-Meitner再結合を抑制できる可能性があります。 Bi x 濃度 x > 10%[4]。バンドギャップ感度の低下と相まって、これらの特性により、ビスマイドは、長波赤外線レーザー、光検出器、多接合太陽電池などのアプリケーションの魅力的な候補になります[1、5、6、7]。
Bi原子は典型的なGaAs成長温度で脱離する傾向があるため、GaAsマトリックスにBiを組み込むには、従来とは異なる成長条件が必要です[8、9、10]。通常、400°C未満の基板温度と、ほぼ化学量論的なグループIII / V比が必要です。これらの条件の近くで容易に発生する可能性があり、成長する層の厚さとその組成の不均一性に関連する表面のGaまたはBi液滴の形成を回避するように注意する必要があります[11、12、13、14]。より高濃度のBiを組み込むために必要な低温は、分子線エピタキシー(MBE)を合成の好ましい方法にしますが、有機金属気相エピタキシーを使用して進歩が見られました[15、16、17]。 GaAsBi合金は、これらの低い成長温度で驚くほど高いフォトルミネッセンス(PL)強度を示します。これは、Bi界面活性剤効果と、低温GaAsで通常形成されるAs関連の点欠陥の密度の低下に起因します[18、19]。価電子帯(VB)の交差防止の写真では、組み込まれた個々のBi原子が、拡張されたGaAs VBの下に共鳴状態を生成し、光学バンドギャップの減少を引き起こします[2、20、21]。第一原理計算はまた、近くの相互作用するBi原子で構成されるクラスターが、孤立したBi原子よりも大幅に大きく狭くなるバンドギャップを生成できることを示しています[22]。これらの異なるBi構成は、強力なVB摂動を生成し、局所的な電子欠陥状態を導入する可能性があります。研究によると、大きなBi原子によって生成された格子ひずみにより、クラスターが空孔V Ga に結合する可能性が高くなります。 およびV As [23]。豊富な成長条件は、Bi Ga の形成に有利に働くはずです。 GaAsBiに深いホールトラップを引き起こすと予測されるヘテロアンチサイト欠陥[23、24]。顕著な励起子局在化効果は、GaAsBi合金の温度依存性PLで一般的に観察され、そのようなBi関連クラスターおよび欠陥錯体に起因します[25、26]。
他の多くの三元III-V半導体合金と同様に、GaAsBiは自発的秩序化の傾向を示します[27]。いわゆるCuPt B Bi原子の濃度が毎秒{111} Bタイプの平面で変調されるタイプの順序付けは、高解像度(走査型)透過型電子顕微鏡(STEM / TEM)を使用して観察されています[13、17、28]。 CuPt B III–V合金のタイプの変調は、表面再構成のダイナミクスによって駆動され、表面二量体の列で構成される(2×1)再構成を伴います[27、29、30、31、32、33]。平坦な(001)GaAs基板上に堆積すると、{111}面の4つの異なるセットのうちの2つで秩序化が発生します。単一のBタイプの順序付けサブバリアントは、隣接する基板を利用することでさらに選択できます。実際、最近の研究では、これがGaAsBiにも当てはまることが示されているため、大きなCuPt B タイプドメインは、低角度のオフカットウェーハを使用して{111} B面の単一セットで実現されています[34]。 GaInP 2 でのCuPtタイプの順序付け この合金では、大きな秩序パラメーターを持つ高品質の結晶を実現できるため、おそらく最も研究されています。長距離秩序は、閃亜鉛鉱点群の対称性を四面体T d から変更します 三角C 3v [35、36] 。 対称性の低下による顕著な影響には、バンドギャップの狭まり、フォトルミネッセンスの偏光、複屈折、異方性ひずみなどがあります[37、38、39]。これらの影響の大きさは、長距離秩序パラメーターηに依存します。 、順序付けられた格子面間の元素分布の範囲を示します。 CuPt B で -注文したAB 1-x C x 合金( x の場合 <=0.5)、格子はB元素が豊富なAB 1-(x-η / 2) C x-η / 2 およびCリッチAB 1-( x +η / 2) C x +η / 2 <111> B方向に沿った単分子層。秩序パラメーターη =0ランダム合金では、濃度 x の完全に秩序化された合金では0 したがって、ηです。 =2 x 。
明らかに、そのような秩序化された合金内のBiの分布はランダム合金とは異なり、合金の特性をさらに推定する際にはこれを考慮する必要があります[17、40]。希薄GaAsBi合金におけるCuPt秩序効果の理解はまだ初期段階であり、より体系的な研究が必要です。この記事では、高度な収差補正STEM法を使用して、いくつかの明確に成長したGaAsBi合金のBi分布のモードを分析します。分析は、統計的STEM Zコントラスト画像処理と画像シミュレーション、および原子分解X線エネルギー分散型分光法(EDX)を使用して実行されます。単色電子エネルギー損失分光法(EELS)は、バルクプラズモンエネルギーシフトを使用してGaAsBiの局所的なユニットセルの体積変化を調査するために使用されます。
結果と考察
最初のGaAs 1-x Bi x ここに示すサンプルS1は、ドープされたGaAs層と固有の420nmビスマイドを備えたp-i-nヘテロダイオードです。サンプル中のビスマス濃度は、X線回折(ここには示されていません)と室温PLを使用して4.5%Biであると決定され、1.10 eVのバンドギャップを示しています(SI図S1)。 PLバンドエッジの測定値は、参考文献[1、2、4]を使用してBi%に変換されます。 GaAs-GaAsBi界面近くの[110]ゾーン軸に沿った断面原子分解能HAADFSTEM画像を図1aに示します。 [001]成長軸および他の関連する結晶学的方向は、図1bにマークされており、図1aにも適用されます。重いBi原子は、プローブ電子をGaまたはAs原子よりもはるかに強い角度に散乱させるため、内部収集角度が大きいHAADF検出器(ここでは90 mrad)は、薄いサンプルのBi分布を良好に強調します。 <110>方向に沿って見た結晶は、成長[001]軸に平行に配向された原子の「ダンベル」の集まりとして表示されます。原子番号(Z)が類似しているため、Ga(31)とAs(33)は、HAADF画像を調べるだけでは簡単に区別できません。ただし、Biを含むグループVのカラムは、著しく高いコントラストを示します。図1aとインターフェース近くの拡大領域に見られるように、グループVのカラムはGaカラムの上のダンベルの上半分に配置されています。これは、[110]ゾーン軸に沿ってGaAsBiをイメージングする場合に予想されます。サンプルを直交[\(\ overline {1} \)10]方向に沿って見ると、グループV / IIIダンベルの極性が逆になることに注意してください。 CuPtタイプの順序付けは{111} Bタイプの平面で発生し、[110]ゾーン軸に沿ったイメージングによってのみ確認できるため、これらの面内直交方向も区別できます。図1bは、CuPt B がはっきりしている、フィルムの奥深くにある低倍率のHAADF画像を示しています。 -タイプの順序。順序付けられたドメインは、{111} B平面の2つのセット、つまり(\(\ overline {1} \)11)と(1 \(\ overline {1} \)1)の間でランダムに交互になっているように見えます。これらはB + と呼ばれます およびB - 慣例によるサブバリアント。画像のフーリエ変換は左上の挿入図に示されています。 4つの主要なブラッグスポットは[111] *タイプであり、4つの1/2 [111] *タイプの超格子スポットはCuPt B を示します。 {111} B平面の2つのセットで同様の大きさの順序付け。相分離したGaAsBi領域は、図1bで、画像下部の暗いストライプとして表示されます。このドメインは、Biが不足しているGaAsのようなものであるため、ビスマイドよりも暗く見えます。 GaAsBi合金の準安定性により、スピノーダル分解と相分離が多くの記事で報告されています[11、12、13、14、41、42]。 B + をより明確に描写するため およびB - サブバリアントの順序、図。 1c、dは、1/2 [111] *超格子反射ペアを使用して画像を形成することによって表されます。逆格子空間の各超格子ペアにマスクが適用され、逆フーリエ変換されて実空間に戻されます。これらの画像の(111)平面の明るい領域は、秩序がより顕著であること、つまり、秩序パラメーターが局所的に変化していることを示しています。集束イオンビームによるサンプル前処理によるTEMサンプル表面の厚さの変動もあります。サンプル前処理では、アモルファス表面層と溶融したGa原子凝集体が表面に残る可能性があり、これにより弱い画像強度変調が発生する可能性があります。ただし、GaはBi原子よりも高角度ではるかに弱く散乱するため、Bi分布の分析に大きな影響を与えることはありません。図1dの矢印は、逆相境界が順序付けられた領域を示しています。そのような境界を越えて、B + (B − )ドメインは、すべてのBi-richプレーンをAs-richプレーンに切り替えることにより、その位相を変更します。逆相境界の順序付けは、転位の滑りによって、またはB + 間のランダムな交代によって形成される可能性があります。 およびB - 成長中のドメイン[43]。ここでは後者が当てはまるようです。
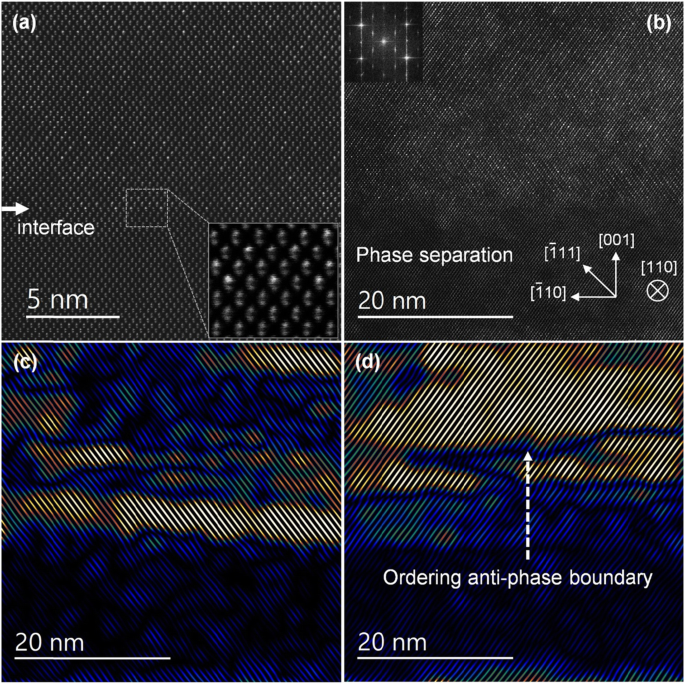
a サンプルS1GaAs-GaAsBi界面領域の断面HAADF画像。インターフェイスの拡大された挿入図が右下に表示されます。結晶学的方向は図1bと同じです。 b インターフェイスから離れたサンプルのHAADF画像。細長い自発的に相分離したGaAsのようなドメインが中央に見られます。挿入図は、画像のフーリエ変換を示しています。 c ( b )1/2 [\(\ overline {1} \)11] *超格子反射のペアを使用します。明るい色は、よりはっきりとした順序を示します。 d ( b )½[1 \(\ overline {1} \)1] *リフレクションのペアを使用
次に、図1aに示すHAADF画像の定量化は、原子柱散乱断面積(SCS)の空間分布を考慮することによって実行されます(方法を参照)。 StatSTEMアルゴリズムは、2次元ガウス分布の列を適合させるために使用され、特定の列のSCSは、そのガウス分布の下での体積として定義されます[44、45]。これは、実験画像のカラム強度の直接積分とは対照的に、パラメトリックモデルベースの定量化です。 <110> GaAsBiのように、カラム強度がオーバーラップする傾向がある場合、パラメトリックモデルアプローチはより信頼性が高くなります。定量化された図1aのSCSの分布は、5つのガウス分布で暫定的に適合された図2bのヒストグラムとしてプロットされています。次に、SCSの空間分布が、各列に配置された同じ配色の正方形を使用したガウス分布の重ね合わせで構成されるモデル構造に図2aにプロットされます。 Ga列とAs列のSCSは強く重なり、ヒストグラムにメインピークを生成します。これは、これらの原子のZ数が類似していることと、実験的に導入された追加の広がりによるものです(方法を参照)。このメインピーク内の下部ガウス成分(濃い青色)または上部(明るい青色)をプロットすると、ダンベルの極性から確認できるように、たとえばGaAsバッファ層のAsカラムの約60%が正しく識別されていることがわかります。 。比較のために、下部のGaAsバッファ層のみのSCS定量化を補足図S2に示します。これは、視野内のGa列とAs列をより適切に区別するために、現在2つ以上のガウス分布が必要であることを示唆しており、それらの平均SCSが10%も異なることを示しています。この違いは、以下に示すシミュレーションと、Beyer etal。で見つかった結果と一致しています。 [17]、ここで、[010] GaAsBiのGaおよびAs積分カラム強度分布が分離されました。強く散乱するBi原子の存在により、SCSが約5.5×10 5 を超える値に拡張されます。 e - Å 2 (SI図S2を参照)。これにより、図2bの右側の肩が生じます。 Bi含有量の高い列を暫定的に区別するために3つのガウス分布が装備されています。原子的に急激なGaAs-GaAsBi界面を図2aに見ることができます。よく調べると、かなりの数のBi原子を含む列の最初のグループV(001)層が、境界面に沿って2つおきのダンベルに配置されていることがわかります。これは、エピタキシャル成長の初期にCuPtタイプの秩序化が始まったことを示唆しています。界面の原子配置の描写は、図2bの挿入図に示されています。これは、最初のグループV(001)平面に沿った2列ごとにBi原子(オレンジ)との界面に沿った原子の配置を再現します。図2aの最初の〜4–5(001)原子面は、CuPt B + の素因を示していません。 またはB − サブバリアント。より顕著な単一バリアントの順序付けは、〜6番目(001)のグループV原子層から出現し、その後、他のサブバリアントに切り替わります。アンチサイト欠陥なしBi Ga インターフェースでのSCS分布によって示されます。これは、Biに関連付けられた色のグループIII列に正方形として表示されます。いくつかのBi Ga の可能性 ただし、アンチサイトは図の右上隅にあります。グループIIIとグループVの両方の列は、その領域の単一のダンベルにBiのようなSCSを示しています。これは、欠陥ペアBi Ga の存在も示している可能性があります。 -Bi As 。 SCSの決定に関与するBi原子の数をよりよく理解するために、公称20〜25 nmの厚さのサンプルでは、<110>列に50〜60個の原子があることに注意してください。したがって、2〜3個のBi原子は、現在4.5%のBiを含むランダム合金のV族カラムで見つかる可能性が最も高くなります。この数は、順序付けられたBiリッチ平面で高くなり、SCSが最大の列で最大6〜7に達する可能性があります[40]。 StatSTEM分析を補足するために、マルチスライスHAADF画像シミュレーションをモデルGaAsBi <110>スーパーセル構造で次に示します(詳細については、メソッドを参照してください)。

a 図1aのSCSの分布。各原子カラムの色付きの四角は、図2bのSCS配色に準拠しています。 b 図1aのSCSのヒストグラム、5つのガウス分布。挿入図は、インターフェース領域の描写を示しています。 Ga原子列は濃い青、As-明るい青、Biを含む列はオレンジ色です。 c 図2dに示すGaAsBi構造のシミュレートされたHAADF画像。列内のBi原子の数は、各グループV列の右側にあるオレンジ色の括弧内に示されています。適合したSCS値は各列の左側に表示され、スーパーセル内の最大のSCS値に正規化されます。 d モデルGaAsBi <110>構造は、Bi位置(オレンジ)、水色-As、濃い青-Ga原子を強調するために横方向に回転しました。矢印は入射ビームの方向を示しています
異なるサンプル深度でのBi原子からのHAADF画像強度への寄与は、チャネリングと大まかに呼ばれるもののために非線形になる可能性があります[46、47、48、49]。したがって、原子スケールでのドーパントの定量化は、組成の真の変動をドーパント構成の変動と区別する際に考慮する必要があります[50、51]。チャネリングの振る舞いを説明するために、<110> GaAsのAsカラム上に配置した場合のサンプル深度による平均プローブ強度の変化を数値的にシミュレートし、補足図S3に示します(方法を参照)。 HAADFシミュレーションに使用された厚さ17nmのモデルGaAsBi構造を図2dに示します。これは、As列(As-水色、Ga-濃い青)内のBi原子(オレンジ)の位置を強調するために横に回転しています。矢印は入射ビームの方向を示しています。図2cに示すシミュレーション画像は、実験との比較のためにStatSTEMアルゴリズムを使用して適合されています。得られたSCS値は、最大のSCS(6 Bi原子)を持つ列のSCS値に正規化され、有効数字2桁に丸められました。これらの正規化された値は、各列の左側に表示されます。各グループVの列のBi原子の数は、列の右側の括弧内に示されています。以前の調査結果との合理的な一致では、AsとGaのSCS値の差は約8%であることがわかります。純粋なAsカラムと1つのBi原子を含むAsカラムのSCSの違いは、異なる位置にあるBi原子では2〜4%の範囲です。異なるBi構成は、異なる組成、たとえば4と5原子、または5と6原子に対して誤って解釈される可能性があり、ほぼ同じSCS値を与えることがはっきりとわかります。底面に向かうカラム内のBi原子は、SCSへの寄与がますます少なくなっています。ここで調べた2つのBi原子を次々に持ついくつかの構成は、SCS値に大きく寄与するようです。 CuPt B の場合、[110]カラムに沿った2つのBi原子の配置が実際に見られることが期待できます。 GaAsBi合金での順序付けは、実際にC 3v の構造単位を生成します。 点群の対称性、つまり、最も近い1Asおよび3Bi原子を持つGa原子。同一のGaカラムでも、SCSに最大0.02までの変動が見られることに注意してください。これは、それらの直接の環境、例えば、近くの強く散乱する柱が、多重散乱のために、または拡張されたプローブテールを介してそれらに結合することによって、追加の強度に寄与することを示唆している[52]。最近導入されたより優れたスケーリングアルゴリズムは、量子力学的マルチスライス計算を高速化し、前述の効果をより詳細に調査する可能性を開きます[53、54]。
サンプルS1のSTEM分析を終了するために、電子エネルギー損失分光法(EELS)を使用してバルクプラズモンエネルギーをマッピングします。次に説明するように、プラズモンエネルギーシフトは、ユニットセルの体積変化に関連し、したがって合金のひずみに関連します。 GaAsは約16eVに1つの主要なプラズモンピークを示し、たとえばCdTeとは異なり、バンド間遷移による複雑な干渉特性を示しません[55]。測定されたプラズモンエネルギー変化を解釈するための最初の近似として、自由電子が半導体の価電子である自由電子電子ガスのDrude-Lorenzモデルを採用します[56]。このモデルのバルクプラズモンエネルギーは、\({E} _p =\ hslash {\ left(N {e} ^ 2 / Vm {\ epsilon} _0 \ right)} ^ {1/2} \)として与えられます。 N はユニットセル内の価電子の数、 e は電子の電荷、 V はユニットセルの体積、 m は電子の質量であり、ε 0 は自由空間の誘電率です。単純なドルーデ-ローレンツモデルは、一般に、半導体のプラズモンエネルギーを数パーセント以内で予測し、より良い一致が求められる場合は、バンド構造の影響を補正する必要があります[56]。 InGaAsおよびIII族窒化物半導体合金に示されているように、ユニットセル体積の変化は、プラズモンエネルギーシフトを決定する主要な量です[57、58]。同様に、GaAsマトリックス内の等電子Bi原子の置換は、主にユニットセルの体積 V を拡張するように機能します。 、したがって、プラズモンエネルギーを赤方偏移します。以下では、測定されたGaAsおよびGaAsBiのピークエネルギーを使用して、ユニットセルの体積の比率を介してGaAsBi層の局所的なひずみ状態の変化を推測します。
HAADF画像に示されている相分離したGaAsBiドメインを含む領域が選択されます。図3.同時に取得されたHAADF画像に付随する各ピクセルからEELSスペクトルが収集されました(生のスペクトルについては方法とSI図S4を参照)。 HAADF画像の破線は、真性GaAsBiとp型(下)およびn型(上)のGaAs層の間の界面を示しています。界面境界線は、低倍率のSTEM画像(ここには示されていません)から決定されました。保護Pt層は、上部n-GaAsの上の高コントラスト材料として表示されます。 HAADF画像では、GaAs層とGaAsBi内の相分離ドメインが暗く表示されます。右側のEELS図の垂直線プロファイルは、すべてのEELSデータポイントを水平方向にビニングすることによって取得されました。これは、相対的なバルクプラズモンピークエネルギーシフト、E GaAsBi を示しています。 -E GaAs 、下部のp-GaAsバッファ層内のGaAsプラズモンエネルギー(16.23 eVと測定)を基準にしています。プラズモンのピークは、GaAsBi層のエネルギーを下げるために平均0.08eVシフトすることがわかります。 〜0.01 eV以内の小さな変動は、定量化ノイズレベルにあります。上部のGaAs(薄層)と下部(2つの交差するドメイン)の近くの相分離ドメインは、GaAsプラズモンエネルギー値に戻り、無視できるほどのBi濃度が含まれていることを示しています。 GaAs層のドーパント濃度(オーダー10 17 cm -3 ) N と比較して重要ではありません / V プラズモンエネルギーに影響を与えるべきではありません。ここで、GaAs 1-x の2つの限定的なケースを検討します。 Bi x ユニットセルボリューム V ; 1つは格子が完全に緩和され、もう1つはGaAs基板に完全に歪んでいます。完全に緩和された場合、ユニットセルは格子定数 a の立方体です。 x で≈5.684Å =4.5%Bi [1]。プラズモンエネルギーと V の間の上記の平方根関係を使用する 、GaAsに対するエネルギーシフトは\(\ Delta {E} _p ^ {GaAs Bi} =16.23 \ left({\ left({V} _ {GaAs} / {V} _ {GaAs Bi} \ right) } ^ {1/2} -1 \ right)=-0.132 \ mathrm {eV} \)、これは測定されたものより明らかに大きいです。 GaAsBi合金の緩和傾向に基づいて、最上部のn-GaAs層の成長中に短時間の熱アニーリングも経験したことを考慮すると、この420 nmの厚さの膜では格子の約30%が緩和されると推定されます。したがって、平均的なGaAsBiユニットセルは、完全に緩和されたシナリオでは過大評価され、上記で得られたより大きな\(\ Delta {E} _p ^ {GaAsBi} \)を説明します。もう一方の限界では、ビスマイド格子は、GaAsの面内格子定数( a )に等しい面内格子定数で完全に歪んでいると見なされます。 =5.653Å)。次に、-0.080eVのエネルギーシフトを取得するために必要な面外格子定数が a で求められます。 z =5.709Å。これは賢明な a z 値であり、GaAs基板に圧縮歪みを加えたGaAsBiのXRD-RSM測定と比較できます[1、34、59]。緩和により、実際の格子定数はこれら2つの限定的な場合の間にあると予想されます。これは、そのような準安定合金のX線ベースの技術を補完する格子ひずみに関する情報を提供できる有望な特性評価方法を示しています。

マークされたGaAsおよびGaAsBi層を備えたp-i-nサンプルS1の断面HAADF画像(左)。 GaAsBi内の暗い領域は、相分離したドメインです。ラインプロファイル(右)は、EELSバルクプラズモンのピークエネルギーシフト E を示しています。 GaAsBi - E GaAs 、GaAsバッファ層に対して。プロファイルは、左側で同時に取得されたHAADF画像と密接に位置合わせされています。 EELSデータピクセルは水平方向に完全にビニングされているため、空間的に平均化された値を示します。スケールバーは100nmで、EELSプロファイルの垂直軸にも適用されます
2番目のGaAsBiサンプルS2は、オフカットGe基板上に堆積されたGaAsバッファ層上で成長しました(方法を参照)。 Ge-GaAsBiヘテロエピタキシーは、以前の研究で分析されました。これは、ラージドメインの単一バリアントCuPt B も示しています。 GaAsBiでの注文[34]。この作業では追加のデータが提示され、Bi原子の順序付けに関する説明を完全にするために使用されます。このサンプルの総ビスマス濃度は、PLで測定すると約5.8%です(SI図S1)[34]。このエピタキシーで採用されているGaAsバッファー層と組み合わせたオフカットは、GaAsBiでの逆相ドメインの形成を回避するのに役立ちます。これは、非極性Ge上で直接成長させる場合に除去するのが依然として面倒です[60,61,62]。図4aは、HAADF画像でGaAsBi層が目に見えて明るいGaAs-GaAsBi界面領域を示しています。平坦なGaAs基板上に堆積された以前のGaAsBi膜とは対照的に、ここでは、単一のCuPt B オフカットのため、順序付けサブバリアントが選択されています。これはHAADF画像で見ることができ、右上のフーリエ変換の挿入図は、1/2 [\(\ overline {1} \)11] *超格子スポットのペアを示しています。図4bは、図1c、dと同様に、超格子反射のペアにマスクを適用することによって形成されました。これは、フィルム内ではるかに均一で大規模なドメインの順序付けを示しています。このサンプルから原子分解されたEDX画像を取得して、秩序パラメーターηを推定しました。 組成分析に基づいています。 EDX化学マッピングは、高エネルギーおよび遅延イオン化エッジを定量化するときに信号対雑音比が悪化する傾向がある代替のコア損失EELS定量化よりも優れていることがよくあります[56、63、64、65]。 STEMのスキャン方向が変更され、順序付けられた(\(\ overline {1} \)11)平面が水平に整列しました。図4c–eは、ウィーナーフィルター処理されたX線元素マップを示しています。毎秒(\(\ overline {1} \)11)平面でのBi原子の順序は明確であり、As原子位置に従います。 EDX組成の定量化では、同じ実験条件を使用して、サンプルの異なる領域からそれぞれ512×512ピクセルの2つのデータセットを取得しました。サブリージョンが整列され、生の信号が合計されて合計10フレームになりました。 As-KとBi-Mの水平方向に合計された生データの垂直線プロファイルを図4fに示します。 Biが豊富な面とBiが不足している面(111)のビスマス組成を定量化するために、原子面を中心とした幅3Åの積分ウィンドウを使用しました。バックグラウンドを差し引いてすべての(111)面で平均化した後、BiX線カウントがBiリッチ面で約3倍多いことを示しています。次に、PLおよびXRD-RSM測定によって得られたサンプル中の5.8%Biの総濃度を使用して、Bi X線カウントを組成に合わせて線形にスケーリングします。これは、BiがBiリッチ平面で最大9%に達することを示しています。したがって、秩序パラメーターはηであると推定できます(「はじめに」を参照)。 =0.07。この総Bi濃度の完全に秩序化されたビスマイドは、秩序パラメーターη=0.116を持つことに注意してください。 HAADF分析と同様に、個々のカラムのEDX定量化は、コア電子のイオン化ポテンシャルが高度に局所化されているため、チャネリング効果の影響を受けます。 Al x の他の著者によって示されているように Ga 1-x 合金の場合、これにより、ドーパントの構成が異なるため、最大5%のX線カウントの標準偏差が生じる可能性があります[50]。偏差を考慮すると、X線カウントは、厚すぎないサンプルのドーパントの数に比例してスケーリングすることがわかります。本研究の構成エラーは、各(111)平面で約11原子列、合計約130列を効果的に平均化することによって最小限に抑えられます。さらに、電子プローブテールと多重散乱は、EDX画像で信号の非局在化を引き起こす可能性があります[52]。前のセクションのHAADF画像シミュレーションは、Ga SCS値の変動を示しており、EDX定量化におけるこれらの影響の予想される大きさを示唆しています。このような希薄合金では本質的にBiX線の数が少ないため、現在、ショットノイズが主な精度制限要因であるように見えます。

a オフカット(001)Ge上に成長させたGaAsバッファ層との界面近くのGaAsBiサンプルS2のHAADF画像。右上のフーリエ変換は、(\(\ overline {1} \)11)平面の単一セットでの順序付けを示すピークのペアを示しています。 b ( a から形成された画像 )超格子1/2 [\(\ overline {1} \)11] *ブラッグスポットのペアを使用します。 c – e 示されているように、Bi-M、As-K、およびGa-KX線放射を伴うGaAsBiサンプルのウィーナーフィルター処理されたEDX画像。 EDXデータでは、結晶学的方向が回転して、順序付けられた(\(\ overline {1} \)11)平面が水平に整列することに注意してください。 f 水平方向に合計された垂直方向のX線は、生のAs-KおよびBi-M信号のプロファイルをカウントします。 2つの整列されたデータセットを組み合わせてプロファイルを取得します
ここで調査したい最後のGaAsBiサンプルS3は、いわゆる垂直組成変調(VCM)を作成するための条件下で合成されました(方法を参照)[66]。サンプルS1およびS2とは対照的に、VCMは、通常のMBEチャンバー内の基板に到達する本質的に不均一な元素フラックスプロファイルに結合された、より遅い基板回転速度(RPM)を利用することによってS3で達成されます。サンプル領域内のIII / V元素比は、RPMと膜成長速度を制御して、目的のVCM期間を取得することで振動させることができます。 M.A。で十分に説明されているように、Bi濃度に関する垂直スパイラルはこの方法でGaAsBiで取得できます。 スティーブンス etal。 [66]。 GaAsBiサンプルS3の断面HAADF画像を図5aに示します。これは、5 RPM、300 nm / hの成長速度で回転した(001)GaAs基板上で成長したものです。調査中のサンプル領域の総ビスマス組成は、室温PLを使用して2.8%Biであると決定されました(SI図S1)。 VCMは、明確に定義された超格子のような外観で表示されます。 CuPt B への傾向 この画像には順序も表示されており、ここでは追加の垂直変調が発生します。右上の挿入図は、画像のフーリエ変換を示しています。矢印は、ストライプのペアを示しています。これは、2番目の平面ごとに[\(\ overline {1} \)10]方向に沿ったBiコンテンツの変調により、 [001]に沿った(111)タイプの順序付けられた平面。

a VCMGaAsBiサンプルS3のHAADF画像。成長[001]方向に沿ったBi濃度の変調、およびCuPt B が表示されます。 バイエンリッチプレーン内での注文。挿入図は、CuPt B を彷彿とさせるフーリエ変換を示しています。 VCMによって変調された順序。 b サンプルのウィーナーフィルター処理された元素EDX画像と、各元素、Bi-green、As-Blue、およびGa-redの正規化されたX線カウントを組み合わせたもの。 c 3×3のビニングされた生のAs-KおよびBi-M信号から抽出され、5nmウィンドウ内で水平方向に合計された垂直X線カウントプロファイル
サンプルは、原子スケールの元素EDXマッピングを使用して調査されました。図5bは、Bi-M(緑)、As-K(青)、およびGa-K(赤)の正規化および色分けされたX線信号を重ね合わせたものです。対応する元素ウィーナーフィルターマップをSI図S5に示します。 Biリッチ領域間のピークツーピーク距離は1.7nmであり、これはVCM周期が約3格子定数であることを示しています。ピーク位置は、単一のBi-rich(001)平面上に整列しません。このオフセットは、高濃度のBi原子が2〜3グループV(001)の原子平面に分散していることを反映しており、HAADF画像でより明確になっています(図5a)。図5cは、3×3のビニングされた生のEDXデータから5nm幅のウィンドウに水平方向に合計されたカウントの垂直Bi-MおよびAs-Kラインプロファイルをプロットすることによる4VCM期間を示しています。信号ノイズにもかかわらず、As-K X線カウントプロファイルはBi-Mプロファイルに反比例しているようで、Biが豊富な領域で小さな落ち込みを示しています。置換元素とホスト元素のX線信号間のこのような相関関係は、希薄合金の将来の原子スケールEDX分析で利用される可能性があります。
結論
この研究では、STEM技術を使用して、Bi分布モードに関する3つの異なるバルクGaAsBiサンプルを調査しました。散乱断面積の定量化は、従来の(001)GaAs上に成長したGaAs-GaAsBiヘテロダイオードに適用され、原子的に急激な界面と初期のCuPt B を示しています。 -タイプの注文開始。凍結フォノン熱散乱近似内の数値マルチスライス画像シミュレーションを使用して、GaAsBiHAADF画像を調査しました。チャネリングにより、構成上のBiの変化が見かけの組成上の変化に変換される可能性があることが示されました。したがって、列ごとのBi原子カウントを実行するには、数値画像分析が必要になります。 EDXマッピングは、オフカット基板上に成長した単一バリアントの秩序化された希薄GaAsBiサンプルで提示されました。元素EDX定量化における構成エラーを回避するために、X線信号は(111)原子平面の多くの列にわたって平均化され、秩序パラメーターはηであると推定されました。 =このサンプルでは0.07。原子分解能のHAADFとEDXは、遅い基板回転速度を使用して合成されたVCMGaAsBiフィルムの分析にも使用されました。このサンプルは、CuPt B に加えて、3つの格子定数の周期を持つ[001]軸のBi含有量変調を示しました。 注文。最後に、単色化EELSを使用したバルクプラズモンエネルギーマッピングが、GaAs-GaAsBiヘテロダイオードで実行されました。希薄なGaAsBiのプラズモンエネルギーシフトはユニットセルの体積変化に関連しているため、これはGaAsBi合金の局所的なひずみ状態を調べるためのXRDベースの手法を補完する簡単な方法を提供します。
メソッド
この研究では、3つの異なるサンプル、サンプルS1、S2、およびS3を調べました。これらはすべて、固体ソースMBEによって成長しました。最初のサンプルS1は、GaAsBi p-i-n です。 XRD(ここには示されていません)および室温PL(SI図S1)によって評価された、約4.5 Bi%を含む固有の420 nmGaAsBi層を備えたヘテロ接合。 n型とp型のGaAs層は、それぞれ100nmと80nmの厚さで、5×10 17 にドープされています。 cm -3 それぞれSiとBeを使用した濃度。サンプルは、金属GaおよびBiソースと2ゾーンバルブ付きヒ素クラッカーを備えたSVT-A MBEリアクターを使用して、n型(001)GaAs基板上で成長しました。 GaAs層は、600 ° で330nm / hの成長速度を使用して堆積されました。 C基板温度、ヒ素過圧を供給。 GaAsBi層は、100 nm / hの速度、10回転/分(RPM)の基板回転、360 ° を使用して成長しました。 C(熱電対の読み取り値)、As / Ga BEP約1.08、Biフラックス〜10 -7 トル。 (2×1)表面再構成は、GaAsBi堆積中にRHEEDを使用して見られました。 2番目のサンプルS2は、PL(SI図S1)およびXRD [34]で測定した場合、1.0eVのバンドギャップと約5.8Bi%の厚さ280nmのGaAsBiで構成されていました。このサンプルは、 p 上に堆積された約300nmのGaAsバッファ層上で成長しました。 -タイプ(001)<110>に向かって6°オフカットのGe基板。バッファーの最初の50nmは、移動が促進されたエピタキシーによって堆積されました。残りの300nmのGaAsバッファーは600°Cで合成されました。 GaAsBi膜は350°Cで成長し、AsとGaのBEP比は1.063〜1.1の範囲で、Bi / Ga比は0.35〜0.37でした。基板をRPMで15回転させた。 3番目の最後のサンプルであるS3は、Veeco GENxplor MBEチャンバーを使用して、SVT-Aリアクターと同じタイプのソースとヒ素クラッカーを使用して成長させました。サンプルは、PL(SI図1)およびXRD(ここには示されていません)で測定した場合、約2.8%のBiを含む500nmのGaAsBiで構成されています。この層は、580°Cで成長させた80 nmのGaAsバッファー層の上に、310°Cで成長させました(バンドエッジ吸収測定、kSA Bandit)。ビスマイドの成長速度は0.5単分子層/秒、As / Ga BEP比は約1.35、Biフラックスは約8×10-8Torrでした。基板を5RPMで回転させました。
透過型電子顕微鏡サンプルは、FEI Helios Nanolab 650デュアルビーム顕微鏡を使用した集束イオンビーム(FIB)リフトアウト技術によって断面形状で準備されました。 EELS Log-ratio法で測定した場合、サンプルは20〜25 nmの厚さに研磨され、顕微鏡にロードする前にアルゴン-酸素プラズマ洗浄または脱気されました。 HAADFイメージングは、200kVで動作する冷電界放出二重収差補正JEOLJEM-ARM200CFを使用して実行されました[67]。 HAADF検出器の内部収集セミアングルは90mradに設定され、22mradのプローブ収束セミアングルが使用されました。 HAADF画像分析は、Matlab用のStatSTEMアドオンを使用して実行されました[44]。単一幅の2Dガウス関数は、バックグラウンド減算後に原子列に適合されました。 HAADF画像シミュレーションは、15個の凍結フォノン構成、0.02Å平方ピクセルサイズの透過関数、およびスーパーセルサイズ〜20×15Åを使用するmuSTEMソフトウェアを使用して実行されました[68、69]。上記の実験的なSTEMプローブパラメータは、焦点ぼけC1 =0、C3 =0.002 mm、C5 =1 mmの球面収差係数、および完全にコヒーレントな電子プローブで使用されました。カークランドマルチスライスコードを使用して、電子プローブ強度とサンプル深度の平均を計算し、10個の凍結フォノン構成で平均しました[68]。強度の平均は、1Å幅のウィンドウで原子カラム全体で取得されます。 X線エネルギー分散型分光法は、0.98ステラジアン立体角ウィンドウレスシリコンドリフト検出器JEOLJED-2300を使用して実行されました。プローブ電流は、EDX特性評価とピクセル滞留時間0.2ミリ秒のために200pAに設定されました。 EDX画像のサイズは512×512ピクセルで、データセットごとに合計5フレームが蓄積されました。ウィーナーフィルタリングは、視覚化のために両方のEDX画像に適用され、サンプルドリフト補正は図5EDXデータで使用されました。軸上電子エネルギー損失スペクトルイメージングは、100 kVで動作する修正単色化NionHermes-200(ChromaTEM)を使用して実行されました。プローブ収束セミアングルは10mrad、EELSコレクションセミアングル35 mrad、0.02 eV EELSエネルギー分散、および0.005sEELS露光時間に設定されました。ビームがサンプル上に配置されたZLPのFWHMは、0.11eVと測定されました。 Gatan DM 3.01画像解析ソフトウェアは、ZLPを中央に配置し、削除するために取得後に使用されました。スペクトル画像は、垂直方向に4倍にビニングされ、水平方向に完全にビニングされました。相互相関ベースの「ピークによるSIの整列」アルゴリズムは、プラズモンピークシフトを決定するためにGatan DM3.01ソフトウェア内で採用されました。室温のPL測定は、420mmの焦点距離のモノクロメーターと熱電冷却されたInGaAs光検出器を使用して実行されました。波長532nm、推定出力密度5 kW / cm 2 で発光するダイオード励起固体レーザー 励起源として使用されました。
データと資料の可用性
現在の研究中に使用および/または分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- BEP:
-
ビーム当量圧力比
- EELS:
-
電子エネルギー損失分光法
- FFT:
-
高速フーリエ変換
- HAADF:
-
高角度環状暗視野
- MBE:
-
分子線エピタキシー
- PL:
-
フォトルミネッセンス
- STEM:
-
走査型透過電子顕微鏡法
- SCS:
-
散乱断面積
- VCM:
-
垂直合成変調
- EDX:
-
X線エネルギー分散型分光法
ナノマテリアル



