GaNキャップ層の厚さが変化するInGaN / GaN多重量子井戸の光学特性に関する調査
要約
さまざまなGaNキャップ層の厚さを持つ3つのInGaN / GaN MQWサンプルを、有機金属化学蒸着(MOCVD)によって成長させ、光学特性を調査しました。キャップ層を厚くすると、InGaN量子井戸層のIn組成の蒸発を防ぐのにより効果的であることがわかりました。さらに、量子閉じ込めシュタルク効果(QCSE)は、GaNキャップ層の厚さを増やすことで強化されます。さらに、エレクトロルミネッセンス測定結果と比較して、室温フォトルミネッセンス測定の異常を説明するために、さまざまなキャップの厚さによって引き起こされる3つのサンプルの局在状態と欠陥の違いに焦点を当てます。 GaNキャップ層が薄すぎると、InGaN QW層の局在状態の不均一性が悪化し、GaNキャップ層が厚すぎると、GaNキャップ層でより多くの欠陥が発生することがわかりました。
はじめに
InGaN / GaN多重量子井戸(MQW)構造は、可視発光ダイオード(LED)およびレーザーダイオード(LD)でアクティブ領域として広く使用されており、大きな成功を収めています[1,2,3,4]。 InGaN / GaN MQWの品質を向上させることは、高性能のGaNベースのLEDおよびLDを実現するために技術的に重要です。以前の研究では、高温成長GaN(HT-GaN)量子障壁(QB)が、InGaN / GaN量子井戸の結晶品質と光度を改善するのに有益であることがわかりました[5、6]。 In-N結合強度が弱いため、InGaN量子井戸(QW)層の成長温度は一般にGaN QBよりも低く、高いIn含有量が得られます。これにより、高温でのGaN QBの成長中に、インジウム原子がInGaNQWから蒸発する可能性があります。 InGaNQWとGaNQBの間に低温成長GaNキャップ(LT-GaNキャップ)層を挿入すると、In組成の脱離を効果的に低減できることが証明されており、InGaNQW層の厚さの均一性とIn組成の分布を改善できます。 [7,8,9]。しかし、GaNキャップ層の成長温度が低下すると、吸着原子の移動能力が弱くなり、GaN材料が劣化します。さらに、低温成長したGaNキャップ層の厚さが増すにつれて欠陥の数が増えることが報告されており、これはインジウム原子分布の均一性とInGaN量子井戸の光度の改善に有利ではありません[10]。以前の多くの報告では、さまざまなGaNキャップの厚さの活性領域での発光特性に対する局在状態の影響に焦点が当てられていませんでした。この作業では、X線回折(XRD)、エレクトロルミネッセンス(EL)、およびフォトルミネッセンス(PL)を使用して、InGaN / GaNの構造と発光特性に対する低温成長GaNキャップ層の厚さの影響を報告します。 MQW、および温度依存PL実験による発光特性における局在状態の役割を詳細に説明します。
メソッド
3つのInGaN / GaN MQWサンプルは、有機金属化学蒸着(MOCVD)によってc面サファイア基板上に成長しました。すべてのサンプルには、ドープされていないGaNバッファ層(1.2μm)、Siドープされたn-GaN層(1μm)、2周期のInGaN / GaN MQW活性領域、およびMgドープされたp-GaNからなる同じ構造が含まれています。層(40 nm)。 InGaN / GaN活性領域を成長させる過程で、InGaNQWの成長条件は互いに同じでした。インジウムの蒸発を防ぐために、薄いLT-GaNキャップ層をInGaN QWと同じ温度(710°C)で成長させました。LT-GaNキャップ層の成長時間は、サンプルAで150秒、300秒、500秒でした。それぞれBとC;次に、GaN QBの成長温度を810°Cまで上げて、GaN QBの材料品質を改善しました。また、HT-GaN QBの成長時間は、これらのサンプルで同じでした。 X線回折(XRD)を使用して、これら3つのサンプルの構造パラメーターを決定しました。エレクトロルミネッセンス(EL)と室温フォトルミネッセンス(PL)を実行して、活性領域の光学特性を特徴付けました。
ELスペクトルは、Ocean Optics HR2000高分解能分光計を使用して直流(DC)で測定され、出力電力はSiフォトダイオードを使用して検出され、ELスペクトルピークエネルギーとFWHMはモノクロメーターと光電子増倍管によって検出されます。 PL測定の場合、λ =325 nmの連続波He-Cdレーザーを励起源として使用し、入射光パワーは3 mW、スポットサイズは0.5 mm 2 。 30Kから300Kまでの温度依存PL測定を記録し、励起源として5mWの発光パワーを持つ405nmのGaN半導体レーザーを使用して、発光特性に対する局在状態の影響を分析しました。サンプルはフリーフロー液体ヘリウムで冷却され、温度依存測定にはCTICryogenicsのクローズドサイクル冷蔵庫が使用されました
結果と考察
図1aは、これらのサンプルのω-2θスキャンによって取得された(0002)面の回折パターンを示しています。これらのサンプルの衛星ピークをはっきりと見ることができ、これらのMQWに微細な周期構造と鋭い界面が存在することを示しています。表1に示すように、SmartLab StudioIIとGlobalFitプログラム(SmartLab回折計によって生成されたデータを分析するための高度な並列テンパリングベースフィッティング法を提供)を使用して、平均In組成、QBおよびQWの厚さを取得します。 QWのIn組成は、LT-GaNキャップ層の厚さが増すにつれて増加することがわかりました。これは、キャップ層が厚いほど、In組成の蒸発を防ぐのに効果的であることを示しています。図1bは、サンプルCの逆格子空間マッピング(RSM)を示しています。メインのGaNピークとサテライトピークは一列に並んでおり、すべてのサンプルでIn含有量が最も高いQW層が完全に歪んでいることを示しています。したがって、発光特性に対する圧電フィールドの影響を考慮する必要があります。
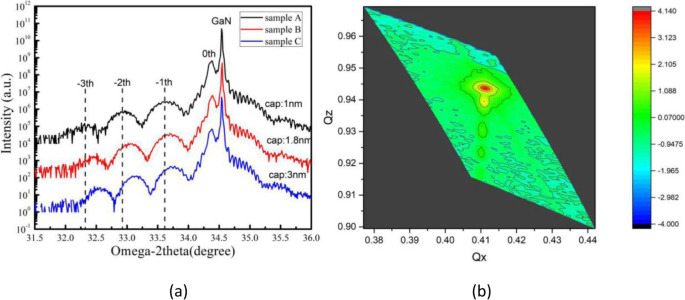
a サンプルA、B、およびCのGaN(0002)プランのXRDω-2θスキャン曲線。 b サンプルCの逆格子空間マッピング
図2は、5 mAの電流でのサンプルA、B、およびCのELスペクトルを示しています。ピーク波長は、サンプルA、B、Cでそれぞれ453.6 nm、456.3 nm、466.7nmです。 XRD測定の結果から、LT-GaNキャップ層の厚さが増加すると、QWのIn組成が増加すると、ELピークエネルギーの赤方偏移が誘発されます。また、LT-GaNキャップ層の厚さが増すとEL強度が低下することもわかりました。より厚いGaNバリア層(LT-GaNキャップ層とHT-GaN QBの合計の厚さ)は、p-GaNから活性領域までの正孔の距離を増加させ、その結果、正孔注入効率が低下することが知られています。 EL強度の低下に[11、12]。さらに、In組成の増加は、InGaN QW層の圧電場を強化するため、エネルギーバンドの傾きが悪化し、ピーク発光の赤方偏移と発光効率の低下をもたらします。これは、量子閉じ込めシュタルクとして知られています。効果(QCSE)[13、14、15]。 EL、ピークエネルギー、および異なる注入で変化するELのFWHMに対するQCSEの影響を検証するために、図3に示します。注入電流が増加するにつれて、放出ピークエネルギーの青方偏移は、バンド充填効果とQCSEに起因する可能性があります。電子遮蔽効果によって補償されます[16、17、18]。 In組成が最も多いサンプルCは、ポテンシャル井戸が最も深く、圧電場が最も強いため、バンド充填効果と電荷遮蔽効果が最も重要であり、ELピークエネルギーの青方偏移の量はサンプルCで最大です(166 meV)。 )。サンプルAのバンド充填効果と電荷遮蔽効果が最も弱いため、高い注入電流(50 mA)では熱効果によるバンドギャップの縮小が徐々に支配的になり、ピークエネルギーの赤方偏移が生じます。サンプルAの場合、図3bに示すように、注入電流の増加に伴ってFWHMが増加します。これは、バンド充填効果によって引き起こされるELスペクトルの広がりが常に支配的であることを示しています。 InGaN QWの分極電界の電荷スクリーニングにより、注入電流の増加に伴ってELスペクトル帯域幅が狭くなることが報告されています[19]。したがって、サンプルBおよびCの場合、より低い注入電流でバンド充填効果が顕著になり、ELスペクトルが広がります。注入電流がさらに増加すると、分極電界プロセスのキャリアスクリーニングが徐々に引き継がれるため、FWHMは低下します。さらに、サンプルBとCのFWHMの上昇から下降への転換点に対応する電流はそれぞれ約10mAと20mAであることがわかりました。これは、サンプルCの圧電場が最も強いことも意味します。
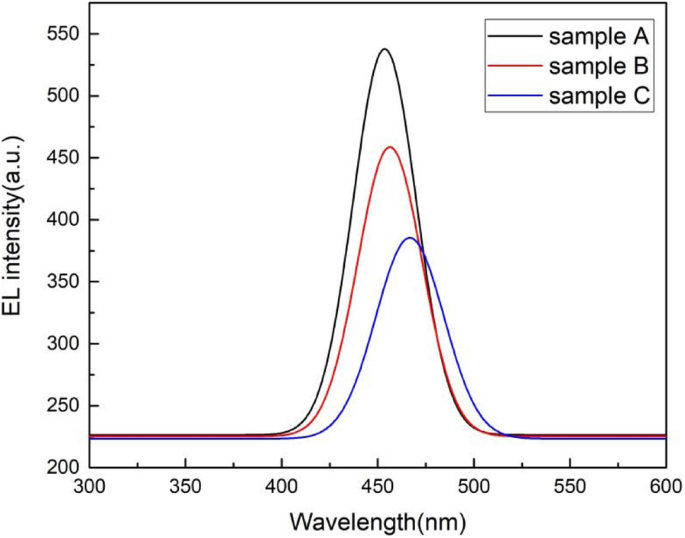
5 mA電流下でのサンプルA、B、およびCのELスペクトル
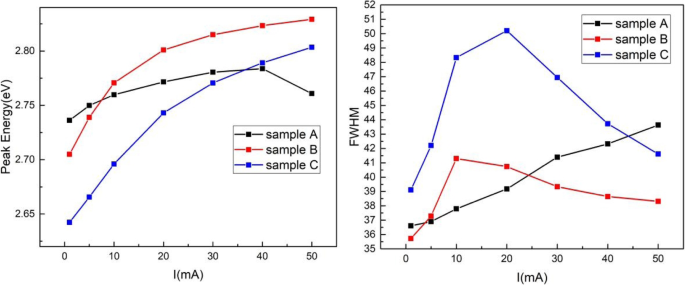
( a )ELピークエネルギーおよび( b )サンプルA、B、およびCの注入電流の関数としてのEL半値全幅(FWHM)
図4aは、5 mW 405 nmのGaN半導体レーザー励起パワーでのサンプルA、B、およびCの室温PLスペクトルを示しています。ピーク波長は、サンプルA、B、Cでそれぞれ473.1 nm、472.9 nm、478.2nmです。図4aのサンプルBとCのPL強度は比較的弱いため、フォトルミネッセンス実験を実行するための励起源として325nmのHe-Cdレーザーも使用します。図4aとbのPL実験結果は互いに一致しており、図4aから得られた実験結果の不確実性を排除しています。図2のEL測定結果と比較すると、図4aにいくつかの異常が見られました。(1)サンプルAのIn組成はサンプルBより少ないが、サンプルAのピーク波長はサンプルBよりわずかに長い。 (2)サンプルBとCのPL強度は互いに類似しており、サンプルAの光度はサンプルBとCよりもはるかに高い。これらの異常を説明するための関連する理由を見つけるために、温度依存PL(TDPL )を3つのサンプルに対して実行し、温度の関数としてのPLピークエネルギーを図5に示します。サンプルBの場合、放出ピークエネルギーは温度の上昇とともに単調に減少します。一般的に言えば、温度によるバンドギャップの収縮が大きくなると、発光エネルギーが赤方偏移します。ただし、温度が70Kから190Kに上昇すると、サンプルAに顕著な青方偏移があります。TDPLの異常な発光青方偏移を説明するために、局所励起子の熱再分布が導入されました。局在化状態の潜在的な最小値からより高いエネルギー状態への熱移動[5、20、21]。サンプルCの場合、PLピークエネルギーは50Kから175Kの範囲でほとんど変化せず、バンドギャップ収縮効果と励起子局在化効果が互いに相殺されていることを示しています。
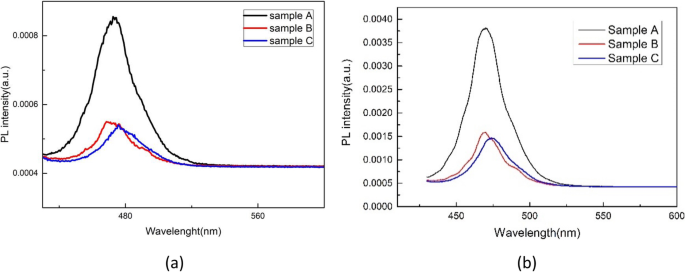
405 nm GaN半導体レーザー( a )を使用したサンプルA、B、およびCの室温PLスペクトル )および325 nmHe-Cdレーザー( b )。ピーク波長は、( a から得られた473.1nm、472.9 nm、および478.2nmです。 )および( b から得られた470.5nm、470.1 nm、および475.2 nm )それぞれサンプルA、B、Cの場合
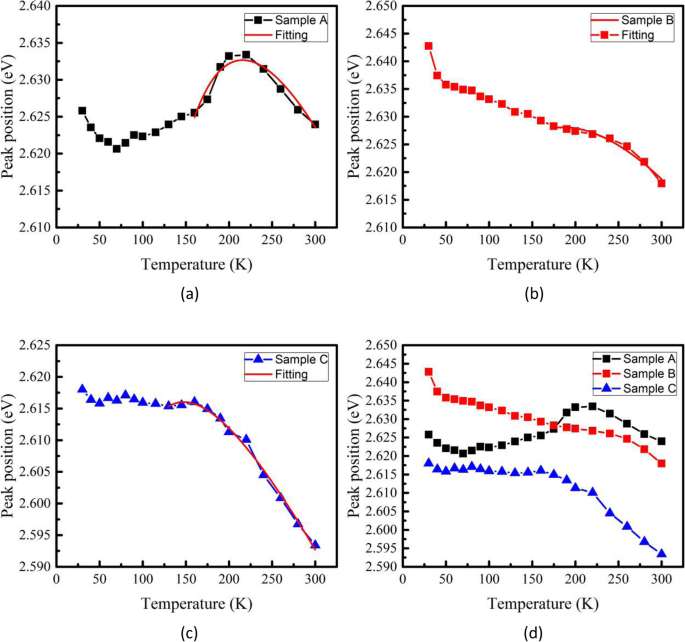
( a の赤い線 )、( b )、および( c )は、式(1)に基づくフィッティング曲線です。 (1)およびフィッティングパラメータσ は、サンプルA、B、およびCでそれぞれ36.96 meV、18.89 meV、および23.77meVです。 ( d )温度の関数としてのPLピークエネルギーの実験データを示しています
励起子局在化効果を考慮して、バンドテールモデルを次の式に修正して、温度依存の発光ピークエネルギーを記述することができます[22、23]:
$$ {E} _0(T)={E} _0(0)\ hbox {-} \ frac {\ alpha {T} ^ 2} {T + \ beta} \ hbox {-} \ frac {\ sigma ^ 2 } {{\ mathrm {k}} _ BT} $$(1)ここで E 0 (0)は、T =0、αでのバンドギャップです。 およびβ Varshiniのパラメータです。 k B ボルツマン定数です。第3項σ はローカライズされた分布の標準偏差であり、ローカリゼーション効果の程度、つまりσの値が大きいことを表します。 ローカリゼーション状態のより強い不均一性を意味します。 InGaNのIn組成の変動が、バンドテールの形成の主な理由である可能性があります。バンドテールの状態は、量子ドットと同様に、最小の局所ポテンシャルエネルギーで形成されます。これらの自己形成量子ドットにおける電子正孔対の再結合は、局所的な励起子再結合と見なすことができます[24、25]。このモデルは、強い縮退と準平衡からの逸脱の可能性があるため、低温では適用できません[20]。フィッティングパラメータσ は、サンプルA、B、およびCでそれぞれ36.96 meV、18.89 meV、および23.77 meVです。これは、キャップ層が最も薄いサンプルAの局在状態が最も不均一であることを意味します。一般に、局在化状態は、InGaN合金のさまざまなサイズとQW厚さの変動を伴うInリッチクラスターに由来します。したがって、LT-GaNキャップ層を薄くしても、成長したGaNQB層の温度を上げるときにインジウムの蒸発を効果的に防ぐことはできないと合理的に考えています。インジウム組成のランダム蒸発のプロセスは、In含有量とInGaNQWの厚さの変動をもたらします。サンプルBの場合、1.8 nmの厚さのGaNキャップ層は、Inを脱着から保護して、より均一なInGaNQW層を形成するのに十分な厚さです。不均一な局在状態は通常、より深い電位状態を保持し、発光ピークエネルギーの赤方偏移をもたらします。そのため、サンプルAのピーク波長は図4から観察したサンプルBよりも長くなっています。さらに、InGaN QW層のIn組成の増加は、大きなサイズのInクラスターの形成も促進します。これが励起子局在化効果の理由です。インジウム含有量が最も高いサンプルCでは、サンプルBよりもわずかに強いです。
図6は、サンプルAおよびCの温度の関数としての積分PL強度を示しています。これは、次の式[5、26]によって適切に適合させることができます。
$$ I(T)=\ frac {1} {1 + {\ sum} _ {\ mathrm {i}} {C} _i \ exp \ left(-\ frac {E_i} {k_BT} \ right)} $ $(2)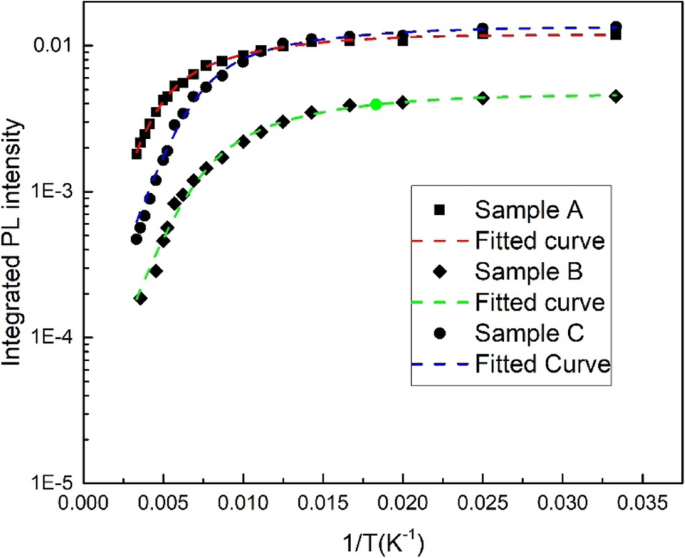
サンプルA、B、およびCの逆温度の関数としての統合PL強度
ここで C i は非放射再結合中心の密度に対応する定数であり、 E i 非放射再結合中心の活性化エネルギーを表します。フィッティングパラメータ C i および E i 表2に示しました。温度依存PL測定中、サンプルBのグレーティングスペクトロメータの光電子増倍管電圧がサンプルAおよびCよりも低く設定されていることがわかります。したがって、サンプルBの積分PL強度は最低ですが、フィッティング結果には影響しません。
<図>C 2 サンプルBとCの場合、サンプルAよりも大きく、より厚いLT-GaNキャップ層でより多くの欠陥が形成されていることを示しています。 LTキャップ層の厚さが増すにつれてLTキャップ層の欠陥が増えることが観察されています[6、10]。電子と正孔の波動関数が障壁に浸透するため、量子井戸の隣のLT-GaNキャップ層の欠陥がPL強度に及ぼす影響は重要です。 79.67 meV( E の有効エネルギー a2 サンプルA)の場合、QWからの正孔の放出と、それに続くバリア欠陥によるトラップおよび非放射再結合に関連しています。これは、Olaizolaのレポート[6]と一致しています。また、図7に示すように、サンプルA、B、およびCのマイクロPL画像を比較しました。マイクロPL画像のダークスポットは、InGaN / GaN活性領域での非放射再結合に起因する可能性があります。サンプルAと比較して、サンプルBとCでより大きなサイズのダークスポットが明らかに観察され、より厚いLT-GaNキャップ層により多くの欠陥が存在することを示しています。一般に、熱アニーリングは、LTキャップ層に続いて実装され、InGaN層のインジウムクラスターを減らし、結晶品質を向上させます。キャップ層が厚すぎると、熱アニーリングの効果が弱まり、より多くの金属インジウム析出物の形成がGaNキャップ層拡散の吸着原子を妨げ、LTキャップ層により多くの欠陥を導入します。 LT-GaNキャップ層が厚いInGaN / GaN MQWでより多くの欠陥とより強いQCSEが現れることは、発光強度を改善するのに不利です。それでは、なぜCのPL強度がBに匹敵するのでしょうか。実際、ローカリゼーション状態も発光効率の向上に重要な役割を果たします。キャリアは局所的な状態に捕捉され、放射的に再結合することができます。励起子の局在効果が強いほど、欠陥に捕捉されないキャリアが多くなります。これは、サンプルBとCのPL強度が互いに類似しており、サンプルAの光度がサンプルBとCよりもはるかに高いことを説明しているようです。
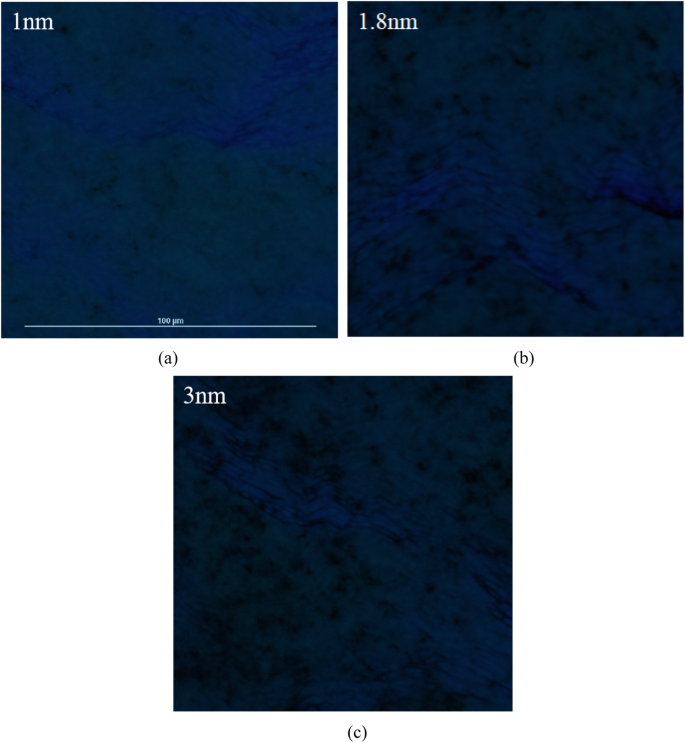
さまざまなLT-GaNキャップ層の厚さ( a )のサンプルA、B、およびCのマイクロPL画像 )1 nm、( b )1.8 nm、および( c )3.0 nm
結論
要約すると、光学特性に対するGaNキャップ層の厚さの影響を調査した。 XRD測定から得られた結果は、In組成物を脱着から保護するために、より厚いキャップ層がより効果的であることを示しています。 GaNキャップ層の厚さが増すと、QCSEが向上し、正孔注入効率が低下します。異なるGaNキャップ層の厚さによって引き起こされるさまざまな程度の励起子局在化効果は、3つのサンプルのPLピーク波長と強度の異常を説明します。 LTキャップ層が薄すぎると、InGaN QW層の局在状態の不均一性が悪化し、LTキャップ層が厚すぎると、GaNキャップ層でより多くの欠陥が発生します。したがって、LT-GaNキャップ層の厚さを最適化することは、InGaN活性層の均一性と発光強度を促進するための重要な問題です。
データと資料の可用性
現在の研究中に使用および/または分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- MOCVD:
-
有機金属化学蒸着
- QCSE:
-
量子閉じ込めシュタルク効果
- MQW:
-
複数の量子井戸
- QB:
-
量子バリア
- LED:
-
発光ダイオード
- LD:
-
レーザーダイオード
- HT:
-
高温
- LT:
-
低温
- EL:
-
エレクトロルミネッセンス
- TDPL:
-
温度依存のフォトルミネッセンス
- XRD:
-
X線回折
- FWHM:
-
半値全幅
ナノマテリアル
- 構造的および光学的性質を改善するためのH2 / NH3混合ガス中のGaNベースの多重量子井戸の原子転位
- 半極性InxGa1-xN / GaN多重量子井戸を備えた紫外線GaNベースのフォトニック準結晶ナノピラミッド構造からの多色発光
- グラファイトナノプレートレットを備えた多層カーボンナノチューブに基づくハイブリッド複合材料の電気的性質
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- 後部に黒色シリコン層を備えた結晶シリコン太陽電池の調査
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- 赤外領域におけるAlドープZnO膜の光学的性質とそれらの吸収への応用
- CsX水溶液との陰イオン交換反応によるCsPbBr3ナノ結晶の光学特性の調整



