4H-SiCPiNダイオードの特性に及ぼす紫外線照射の影響
要約
本論文では、高電圧4H-SiC PiNの静的特性に及ぼす紫外線(UV)照射の影響を調査した。紫外線照射前後の4H-SiCPiNダイオードのフォワードオン状態特性に大きな変化は見られません。しかし、UV照射によりブロッキング電圧が大幅に増加することがわかります。これは、表面の負電荷密度の増加に伴う正電荷の収集による空乏領域幅の拡大に起因します。深層過渡分光法は、UV照射によって誘発された深層欠陥がトラップされた負電荷に対して支配的な役割を果たし、したがって4H-SiCPiNダイオードのブロッキング電圧の増加につながることを明らかにしています。
はじめに
炭化ケイ素(SiC)は、その広いバンドギャップ、高い臨界電界強度、高い電子飽和速度、および優れた熱伝導率により、次世代の高出力および高温電子デバイスの有望な候補材料として期待されています[1 、2、3、4]。 SiCデバイスは、特に高電圧と電流レベル、および200°Cを超える温度で動作する必要がある要件において、現在シリコンで使用されているデバイスの多くを置き換えるために開発されています。ユニポーラデバイスと比較して、SiCバイポーラデバイスは、近年の導電率変調効果により、超高電圧アプリケーションのためにかなりの関心を集めています。典型的なバイポーラデバイスとして、高電圧4H-SiC PiNダイオードが実証されています。これは、高度なスマートグリッド、エネルギー貯蔵、パルスパワーなどの高電圧整流器アプリケーションの潜在的な選択肢です[5、6、7、8]。 SiCパワーデバイスの製造プロセスでは、ドライエッチングやスパッタ蒸着などのいくつかのプラズマプロセスが広く使用されています。電気的劣化を引き起こすSiCデバイスのプロセスによる損傷に関するいくつかの研究が報告されています[9、10]。さらに、以前の研究では、UV照射により、高エネルギーイオン衝撃とプラズマ光電子放出によってSiC金属-酸化物-半導体電界効果トランジスタ(MOSFET)の性能が大幅に低下することが明らかになっています[11、12]。最近、4H-SiC金属-酸化物-半導体(MOS)へのパルスUVレーザー照射が、界面近くの酸化物トラップを誘発し、デバイスの性能ドリフトと信頼性の低下を引き起こす可能性があることが報告されています[13]。しかし、私たちの知る限り、SiC PiNデバイスへのUV照射はこれまで調査されておらず、SiCPiNデバイスの特性への影響を理解する必要があります。
この研究では、184.9 nmの波長のUV照射を使用して、4H-SiCPiNダイオードの順方向および逆方向のブロッキング特性に対するUV照射の影響を調査しました。 SiC PiNダイオードの絶縁破壊電圧に対する表面電荷の蓄積の影響は、Technology Computer-Aided Design(TCAD)シミュレーションを使用して提示されます。 SiO 2 照射前後の/ SiC状態密度は、SiC MOSのディープレベルトランジェントスペクトロスコピー(DLTS)システムによって特徴づけられました。 DLTSは、MOSコンデンサの界面状態密度(Dit)分布と深い欠陥を研究するために広く使用されています[14、15]。
メソッド
この論文で報告されている4H-SiCPiNダイオードの概略構造を図1に示します。1×10 18 にドープされた厚さ2μmのバッファ層 cm -3 ドーピング濃度が2×10 14 の厚さ60μmのn-ドリフト層 cm -3 4°オフ軸の高濃度にドープされたn型4H-SiC(0001)基板上で連続的に成長させました。次に、最上層は厚さ2μm、ドーピング濃度2×10 19 のp +アノードでした。 cm -3 。エピタキシャル成長後、高さ2.5 µm、直径300 µmの円形分離メサ構造が、p +アノード層を介してn-ドリフト層に反応する誘導結合プラズマを使用してパターン化されました。エッチングガスとマスク材料はSF 6 でした。 / O 2 それぞれ、プラズマ化学気相成長法によって堆積されます。メサの分離に続いて、1×10 17 のダブルAlインプラント cm -3 ベースのジャンクションターミネーションエクステンション(JTE)は、メサエッジ付近の電界の混雑を緩和するために形成されました。インプラントは、Ar中で1650°Cで30分間アニーリングすることによって活性化されました。犠牲的なSiO 2 層を1100°Cで1時間成長させ、HFに浸して、熱酸化用の新しい表面を提供しました。次に、乾燥したO 2 での熱酸化 周囲温度は、1100°Cで3時間、SiO 2 を使用して実行されました。 層の厚さは約40nmで、その後、Ar環境で1100°Cで1時間アニーリングします。接触材料は、アノードがNi / Ti / Al、カソードがNiでした。これらの金属は、高品質のオーミック接触を得るために、それぞれ800°Cと1000°Cで2分間アニーリングしました。線形伝達長法によって特徴づけられる比接触抵抗は、1×10 -5 でした。 Ωcm 2 および3.75×10 -5 Ωcm 2 NinタイプおよびNi / Ti / Alpタイプのオーミックコンタクト用。厚いAlを含む上層金属がアノードとカソードに堆積されました。高電圧測定中の表面スパークを回避するために、二酸化シリコン層と厚いポリイミド層が前面にパターン化されました。さらに、SiC-MOSコンデンサは高品質のn型(7×10 15 )で製造されました。 cm -3 )高濃度にドープされた4H-SiC基板上のエピタキシー層。 40 nmの熱酸化物は、SiCPiNの標準プロセスに基づいて成長しました。ゲート電極と裏面オーミックコンタクトは、それぞれAlとNiで形成されました。

4H-SiCPiNダイオードの概略断面図
4H-SiC PiNダイオードとSiC-MOSコンデンサに、バイアスストレスなしで72時間、空気中の波長184.9nmの水銀ランプを使用してUV光を照射しました。 UV照射前後の4H-SiCPiNの電気的特性は、WentworthプローブとAgilentB1505A半導体特性評価システムによって評価されました。次に、SiC-MOSコンデンサのインターフェース状態と固定電荷は、PhysTechフーリエ変換DLTSシステムによって特徴付けられました。適用された逆バイアス V R および充填パルス電圧 V P それぞれ15Vと2Vでした。サンプリング期間 t w V からのバイアスパルスの R V へ P 1.5秒でした。
結果と考察
SiCPiNの静的特性に及ぼすUV照射の影響を図1および2に示します。 2と3では、照射前後に測定された特性がデバイス1(D1)とデバイス2(D2)で比較されています。円形SiCPiNダイオードの直径は3.5mmで、アクティブエリアは約10 mm 2 。 SiC PiNの順方向電圧降下は、100 A / cm 2 の電流密度で約3.95Vです。 UV照射前の2つのデバイスの両方。図2から明らかなように、2つのデバイスの順方向オン状態特性に大きな変化はなく、UV照射後に3.95Vから4.0Vに変化します。 60μmの厚さのnドリフトエピ層上に製造されたデバイス1とデバイス2の達成されたブロッキング電圧は、1μA未満のリーク電流でそれぞれ7kVと7.2kVです。 PiNダイオードのブロッキング効率は、60μmの厚さのドリフト層の理論値9.7 kVの約70%であり、不純物の活性化が不正確であると、最適なJTE注入ウィンドウから逸脱する可能性があることに注意してください。 UV照射後、デバイス1のブロッキング電圧は7から9.2 kVに著しく増加し、2.2 kVの改善が見られ、理想的な平行平面の値に近づいています。これに対応して、UV照射後のデバイス2で1.7kVの改善が達成されました。

UV照射前後の4H-SiCPiNダイオードの状態特性の順方向
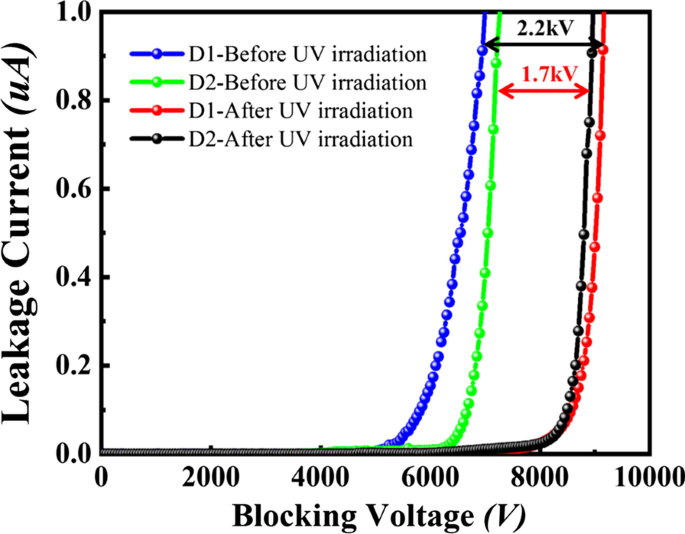
UV照射前後の4H-SiCPiNダイオードの逆特性
表面トラップが端子領域の電界分布に大きな影響を及ぼし、SiCパワーデバイスの逆ブロッキング特性に影響を与えることはよく知られています。池口ほか光子エネルギー≥5eVの高エネルギーUV照射は、既存の歪んだC–C二重結合をアクティブな電子トラップに変換し、正の V <によって観察される負に帯電した界面欠陥の生成につながる可能性があることを示しています。 / i> FB C / V曲線のシフト[11、12]。一方、UV照射によって生成された電子は、ディープトラップ界面欠陥によって捕捉される可能性があり、したがって、固定電荷密度の増加に伴って負に帯電する可能性があります。図4は、さまざまな表面負電荷を持つダブルインプラントJTE SiCPiNダイオードのインプラント濃度に対するシミュレートされたブロッキング特性の依存性を示しています。特にJTEインプラント濃度が最適ウィンドウから外れている場合、JTE領域の表面電荷が逆ブロッキング性能に大きな影響を与えることが明らかにわかります。所与の二重インプラント終端構造について、表面の負電荷の増加として、ターゲットブロッキング値のより広い最適ウィンドウを達成することができた。 JTE構造は、1×10 11 未満の界面電荷に対する感度が低いことは明らかです。 cm −2 ブロッキング電圧に明らかな変化はありません。表面電荷密度が5×10 11 を超える場合 cm −2 、絶縁破壊電圧は劇的に増加します。驚いたことに、絶縁破壊電圧は、2×10 16 のインプラントウィンドウで理論値をほぼ達成しています。 cm -3 〜8×10 17 cm -3 1×10 13 の表面電荷密度で cm −2 。

電荷なしを含む表面負電荷のシミュレートされた絶縁破壊電圧対JTEインプラント濃度、1×10 11 cm −2 、5×10 11 cm −2 、1×10 12 cm −2 、5×10 12 cm −2 、および1×10 13 cm −2 それぞれ
図5は、ブロッキング特性での電界プロファイルに対する負の表面電荷蓄積の影響を比較しています。 4H-SiCPiNダイオードの空乏領域の変化に伴う電界分布を図5aに示します。負電荷が5×10 12 に増加したとき cm −2 SiO 2 で SiCPiNの/ SiC(JTE構造領域)界面では、Nドリフト層の正電荷が界面表面に集められ、空乏領域が大幅に拡大します[16]。図5bは、表面の負電荷密度が1×10 11 のJTE / nドリフト領域接合部の下の電界カットラインを示しています。 および5×10 12 cm −2 。 1×10 11 の低い表面電荷の場合 cm −2 、最大値が2.5 MV / cmで、絶縁破壊電圧が約8 kVのエッジ終端領域に、激しい電界の混雑が見られます。電荷密度が5×10 12 に増加すると cm −2 、ピーク電界は2.2 MV / cmに低下し、エッジ終端領域での電界の密集は比較して抑制されます。その間、電界分布はより均一になり、絶縁破壊電圧は明らかに増加します。したがって、表面の負電荷は、空乏の拡大を引き起こし、電界の混雑を緩和し、結果として絶縁破壊電圧を改善する可能性があります。

表面の負電荷密度が1×10 11 のSiCPiNのシミュレートされた電界分布 cm −2 および5×10 12 cm −2 : a 空乏領域の進展に伴う電界分布 b JTE / n-ドリフト領域接合部の下の電界カットライン。インプラント濃度は6×10 16 で使用されます cm -3
照射によって誘発された電子欠陥の生成の物理的メカニズムをさらに検証するために、SiO 2 のより良い電気的特性評価 詳細を調べるには、/ SiCインターフェースが必要です。 4H-SiC SiC-MOSコンデンサのDLTSスペクトルは、図6に示すように、UV照射の前後で15〜2 Vの枯渇で特徴付けられました。DLTSスペクトルから、2つのピークが4H-SiCMOSコンデンサの両方で観察されました。 UV照射後、それぞれ210Kと490Kに位置します。負のDLTSピークは、P1およびP2レベルが電子トラップであることを示しています。広くて有意なP2レベルは、ピーク振幅の有意な増加を示しています。これは、UV照射によって電子トラップの濃度が増加することを意味します。さらに、DLTS信号は充填時間に比例して増加し、点欠陥ではなく界面欠陥などの拡張欠陥に特徴的なトラップ充填速度を示すことがわかります。挿入図は、界面状態密度と活性化エネルギーE T の分布を示しています。 。インターフェイスの状態密度は、\(D _ {{{\ text {it}}}} =\ varepsilon _ {{{\ text {sic}}}} C _ {{{\ text {ACC}}}} AN _ {{によって計算されます。 \ text {D}}} \ Delta C / \ left [{C_ {R} ^ {3} kT} \ right] \)[17]。この図から、界面欠陥が E からのバンドギャップにエネルギーバンドを生じさせることがわかります。 C − 0.65eVから E C − 1.25eVとその密度は2×10 12 から大幅に増加しました cm −2 eV -1 〜6×10 12 cm −2 eV -1 UV照射後。過渡容量測定、高分解能透過型電子顕微鏡法、密度汎関数理論計算を組み合わせた、Dong etal。この界面欠陥は、界面で負に帯電した過剰なスプリット格子間炭素に起因することが示唆されました[18]。 210 kのP1ピークは、 E の電子トラップに対応します。 C − 0.41eV。その濃度は、UV照射後に本質的な変化を示さず、SiCエピ層の欠陥を示すために暫定的に割り当てられたP1トラップです。ただし、その原子配置はまだ不明であり、将来の調査で明らかにする必要があります。
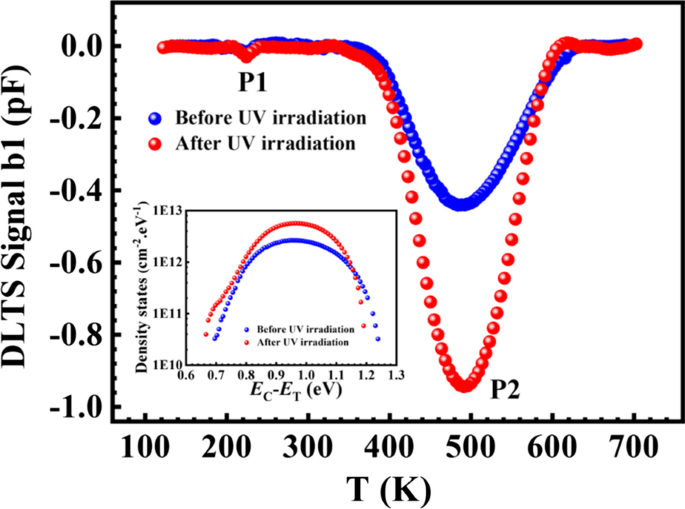
UV照射前後の4H-SiCPiNダイオードのDLTSスペクトル。挿入図は D を示しています UV照射前後の4H-SiCPiNダイオードの分布
結論
4H-SiCPiNダイオードの電気的特性に及ぼすUV照射の影響を調査しました。電気実験の結果から、UV照射後の順方向電流のわずかな変化が観察されます。しかし、UV照射はブロッキング電圧の著しい増加を示します。 UV照射により、PiNダイオードの界面に深いレベルの欠陥が発生し、バンドギャップの深いアクセプターレベルが増加することがわかります。これらの深いレベルの欠陥は、電子捕獲の中心として機能し、SiO 2 の負電荷の大幅な増加につながります。 / SiCインターフェース。 N dirft層の正電荷は界面表面に集められ、より均一な電界分布で空乏領域の拡張をさらに促進し、ブロッキング電圧の増加をもたらします。
データと資料の可用性
すべてのデータは制限なしで利用できます。
ナノマテリアル



