自己整流スイッチ特性を備えたTaO / HfOxおよびTaO / AlO xRRAMの保持モデル
要約
自己整流型TaO / HfO x の保持動作モデル -およびTaO / AlO x ベースの抵抗変化型メモリ(RRAM)が提案されています。トラッピングタイプのRRAMは、高抵抗状態(HRS)と低抵抗状態(LRS)を持つことができます。 SETプロセス中のLRSは内部抵抗層によって制限されるため、LRSの劣化は通常HRSの劣化よりも深刻です。ただし、TaO / AlO x の場合 要素は層状に積み重ねられ、LRSの保持を改善できます。外挿法によって推定されたLRS保持時間は、室温で5年以上です。 TaO / HfO x の両方 -およびTaO / AlO x ベースのRRAM構造には同じTaOのキャッピング層があり、両方のタイプの構造の活性化エネルギーレベルは0.38eVです。さらに、追加のAlO x TaO / AlO x のスイッチング層 構造は、保持を大幅に強化できるより高いO拡散バリアを作成し、TaO / AlO x 構造はまた、偏った条件下で非常に安定したLRSを示します。
背景
NANDフラッシュテクノロジーはスケーリングの限界に直面しているため、フィルムスタックが低く、製造歩留まりが高く、クロスカップリングの問題がない垂直抵抗変化型メモリ(VRRAM)設計は、高密度メモリアプリケーションの有望な候補です[1,2,3 ]。 3次元(3D)垂直構造を備えた1TnRアーキテクチャは、非常にコンパクトな高密度アレイの超低ビットコストを実現するのに役立ちます[4、5、6]。いくつかの研究者は、抵抗スイッチングメカニズムをフィラメントタイプから欠陥トラップ、空孔変調、またはインターフェースタイプの導電パスモデルに変更することにより、低電流レベルでRRAMを動作させることを提案しています[7、8、9]。ただし、保持の失敗と酸素空孔の移動の中心となる問題はまだ解決されていません[3、10]。いくつかのフィラメントタイプの保持研究では、保持損失を説明するために多くの異なるモデルが提案されています[11、12、13]。スイッチングメカニズムの変更は、保持を改善する可能性のある別の方向も示しています[11]。以前の調査では、TaO / HfO x デバイスは、約40の良好な非線形性値、1000サイクルを超える耐久性値、および85°Cのデータ保持を示すことができます[6、7]。それにもかかわらず、そのような低い動作電流レベルで安定した保持を得ることは依然として困難です。この手紙では、アレニウス法を用いた2つの異なる欠陥トラップタイプのデバイスの保持損失を実現するための保持モデルが提案されています。抽出された活性化エネルギーは、AlO x による保持の改善を説得力を持って説明していません。 層。オリジナルはあいまいでしたが、最も可能性の高い解釈は、密な結合が保持を容易にするというものです。
メソッド
TaO / HfO x の製造において およびTaO / AlO x 本研究用のデバイスでは、下部電極(BE)は、8インチの物理蒸着(PVD)によって堆積されたTiN金属で構成されています。熱酸化物/ Si基板。各BEは、従来のリソグラフィおよびエッチングプロセスでパターン化およびエッチングされました。各TiNBEが塩素ベースのガスでエッチングされた後、残りのフォトレジスト(PR)とエッチング残留物は、O 2 を適用したリモートプラズマシステムを使用して除去されました。 およびH 2 180°CでO。 PR除去プロセス中に、各TiN BEの表面にTiONの薄い酸化層が形成された。次に、HfO x の抵抗スイッチング層 およびAlO x HfCl 4 を用いた原子層堆積(ALD)によって調製されました -H 2 OおよびTMA-H 2 それぞれO前駆体。 2つの抵抗素子HfO x およびAlO x 300および250°Cで堆積されました。次に、抵抗スイッチング層の上部に、低温プラズマ酸化(LTPO)を介してPVDによってTaO層が堆積されました[14]。この製造により、Ta金属が超低速(0.2Å/秒)で堆積します。安定したプラズマ酸化は、ArとO 2 の混合物で実行されました。 ガス。このTaO層は、内部の自己コンプライアンス抵抗として機能し、以前の抵抗スイッチング膜と比較して比較的漏れがありました[7]。上部電極もPVD-TiNでした。 TaO / HfO x の断面図と厚さ情報 およびTaO / AlO x メモリデバイスをそれぞれ図1a、bに示します。 TaO / HfO x の膜厚 透過型電子顕微鏡法によってチェックされた(示されていない)。セルがパターン化された後、低温酸化物が250°Cで不動態化のために堆積されました。最後に、従来のバックエンドプロセスを適用して、コンタクトおよび金属パッド構造の製造を完了しました。

a の厚さ情報を含むセルの概略プロット TaO / HfO x デバイスと b TaO / AlO x デバイス。両方のプロットは、PVDがLTPOプロセスでTaO層を堆積し、下部のTiON界面層がフォトレジスト除去中のプラズマ酸化によって形成されたデバイスを示しています
結果と考察
電気的測定は、HP4156C半導体パラメーターアナライザーを使用して実行されました。設定およびリセット電流密度( J )対電圧( J – V )TaO / HfO x の曲線 およびTaO / AlO x デバイスをそれぞれ図2a、bに示します。両方の初期抵抗状態( R 初期 )TaO / HfO x の およびTaO / AlO x デバイスはHRSでした。バージンメモリデバイスは、正のバイアスでLRSにプログラムされ、スイープバックされました。次に、負の電圧を印加することにより、各セルをLRSからHRSに切り替えました。両方の J–V プロットには、0.1、0.56、25μm 2 の3つのセルサイズが含まれています 。 J–V プロット、異なる領域を持つデバイスからのすべての曲線は互いに類似しており、TaO / HfO x の両方を示しています およびTaO / AlO x デバイスは、(i)初期状態で同じ電流密度、(ii)同様のセット電圧とリセット電圧、および(iii)LRSとHRSで同じ電流密度を持っていました。さらに、定電流密度の特性は、抵抗対面積( R )によって明確に示されます。 – A )図2c、dのプロット。両方の R の強い面積依存性 初期 そしてLRSは電流密度の制御によって観察することができます。セル面積とコンプライアンス電流の規模に関係なく、両方のデバイスで同じオン/オフ抵抗比が維持されます。この定電流密度スイッチの特性は、メモリセルが電界によって均一にプログラムまたは消去されることを意味します。これらのデバイスは、空孔の変調に強く関係するトラッピングタイプのスイッチング特性を持っていると考えられています[8]。トラッピングタイプのRRAMの場合、セットプロセス中に急激な電流ジャンプは観察されませんでしたが、フィラメントタイプのRRAMでは一般的に急激な電流ジャンプが観察されました。本研究では、HfO x を使用したさまざまなスイッチング層でさまざまなスイッチング電圧が観察されました。 またはAlO x 。 TaO / AlO x の設定電圧範囲 デバイスのサイズは4〜4.5 Vで、TaO / HfO x よりも大きくなっています。 デバイス(3〜4 V)。 TaO / AlO x のリセット電圧範囲 デバイスのVは-1.5〜-2.5 Vで、TaO / HfO x よりも大きくなります。 デバイス(-0.5〜-1.5 V)。 AlO x システムは、HfO x よりも、セットおよびリセットスイッチを完了するためにより多くのエネルギーを消費します。 システムは消費します。スイッチの設定中、スイッチング層HfO x およびAlO x それぞれ約3Vと3.5Vの電圧でソフトブレークダウンを実現します。どちらのタイプのデバイスでも、スイッチング層にフィラメントが形成される前に、電流はTaO層の内部抵抗によって制限されます。トラッピング型RRAMの自己コンプライアンスプロセス中に、スイッチング層の内部に過剰な酸素空孔が生成されます[7]。これらの酸素空孔は、負のバイアスリセットプロセス中に再結合されます。フィラメントタイプのRRAMとは異なり、HRSはリセット操作後の初期抵抗状態(IRS)よりも常に低くなります[15、16、17]。要約すると、欠陥トラッピングは、酸素イオンと空孔の再結合によって空孔を変調し、スイッチング層の抵抗変動を制御するプロセスです。 HfO x との比較 スイッチング層、欠陥トラップにより、AlO x の電圧と電力が高くなります スイッチの設定とリセットの両方でレイヤーを作成します。
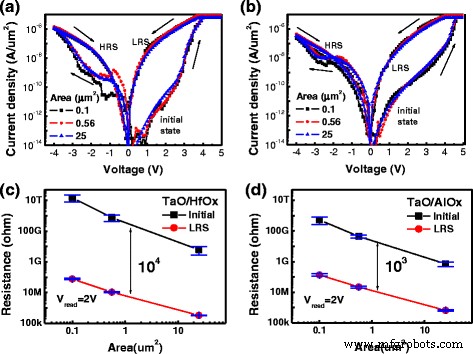
a の電圧プロットによる電流密度 TaO / HfO x セルサイズが異なるデバイス。 b TaO / AlO x セルサイズが異なるデバイス。 c の抵抗対面積のプロット TaO / HfO x デバイスと d TaO / AlO x 端末。両方のプロットには、読み取り電圧=2 VのIRSとLRSが含まれています。各データポイントは、10個のデバイスの平均と対応する標準偏差を提供します
スイッチング動作を調査した後、トラッピングタイプのメモリユニットのHRSおよびLRS保持動作を調査しました。 TaO / HfO x の85°Cおよび1Vでの抵抗変動と時間の関係のプロット およびTaO / AlO x デバイスを図3a、bに示します。どちらのプロットでも、LRSの変動はHRSの変動よりも顕著です。 TaO / AlO x の抵抗安定性 TaO / HfO x よりも高い 。これらの図は、HRSが両方のタイプのデバイスのIRSに向かってドリフトする傾向があることを示しています。 IRSは、図3a、bで破線でマークされています。デバイスの未使用状態に戻る抵抗の傾向は、TaO / AlO x の図3cに示されています。 図3dでは、TaO / HfO x 。これを実現するために、 I–V に示すように、両方のタイプのデバイスは最初に室温でLRSにプログラムされました。 スイープ(黒い線)。次に、TaO / AlO x およびTaO / HfO x デバイスは、オーブンで150°Cで48時間、120°Cで120時間それぞれ焼き付けられました。どちらの場合も、 I–V 焼き付け後のスイープは、最初のスイープと同様でした。この手順により、トラップ型デバイスのLRSは、高温環境で時間の経過とともに元の状態に戻りました。酸素原子の顕著な動きを特徴とするフィラメントタイプのデバイスとは異なり、トラッピングタイプのデバイスは、短い距離で分離された酸素イオンと空孔のペアを持っています。初期状態にドリフトする抵抗の傾向は、主にALDのプロセス温度によって制御される元の結晶化度に関連しています。その結果、両方のタイプのデバイスのLRSは、負のバイアスまたは熱エネルギーによってHRS(またはIRS)にリセットできます。この特性はフィラメント状RRAMとは異なります。
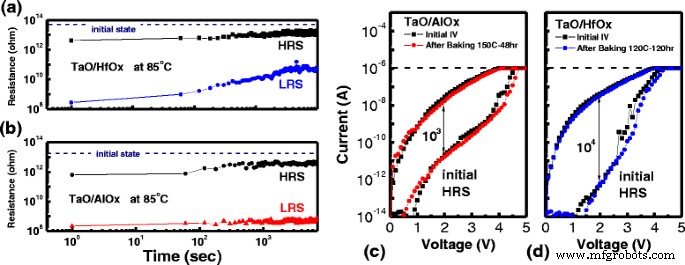
a の時間に対する抵抗変動のプロット TaO / HfO x および b TaO / AlO x デバイス。両方のプロットには、85°Cでの読み取り電圧=1VでのHRSとLRSの変動が含まれています。 I の後 – V 各バージンデバイスのスイープが設定され、デバイスがベイクされてから、LRSに再度プログラムされました: c TaO / AlO x (150°Cで48時間); d TaO / HfO x (120°Cで120時間)
不揮発性メモリの標準的な保持テストでは、データ保持は室温と高温の両方でテストされます。デバイスは、実際のアプリケーションで使用できるように、室温と高温の両方でデータを保持できる必要があります。活性化エネルギー( E a )保持プロットでのアレニウス法による抽出は、データ保持を評価するための一般的な方法です[18、19]。図3aに示されているように、LRSの変動はHRSの変動よりも顕著です。したがって、抵抗比( R 比率 )30〜150°Cの範囲の温度でのLRSとベーキング時間の関係を分析しました。 TaO / AlO x からの保持時間抽出の一例 デバイスを図4aに示します。抵抗劣化率は、log( R の線形フィッティングの傾きによって計算できます。 比率 )-log(時間)スケール。約10 3 の最大オン/オフ抵抗比を考慮することにより TaO / AlO x の場合 デバイス、図3cに示すように、保持時間は10 3 LRS変動を計算できる回数。 30〜150°Cの範囲の測定温度での推定LRSデータ保持を図4bに示します。各データポイントは、両方のデバイスタイプの18を超えるデバイスからの情報を表します。 TaO / AlO x の場合 デバイス、データ保持率は10 6 と高い s150°Cおよび2×10 8 s(約5年)室温で。それらの時間はほぼ10 1.5 TaO / HfO x の倍の長さ 端末。最も興味深い点は、TaO / HfO x の両方であるということです。 およびTaO / AlO x デバイスは同じ E を表示します a =0.38 eV、抽出された勾配から計算。同じ E a これは、両方のタイプのデバイスがLRS劣化プロセスで同様の化学反応を起こすことを意味します。この E a TaO界面付近での酸素イオンの放出や、AlO x での酸素拡散プロセスなど、熱的に活性化されるすべての速度論的プロセスに関与しています。 およびHfO x レイヤー。ただし、HfO x の酸素自己拡散係数 およびAlO x 層は高温(> 1000°C)では異なります。正確な測定値は文献[20、21]に記載されています。低温(<200°C)での酸素拡散係数は、HfO x の厚さにも依存します。 誘電体[22]。スイッチング層での拡散プロセスが化学反応を支配する場合、 E a HfO x の拡散係数が異なるため、値は異なるはずです。 およびAlO x レイヤー。この作品の両方のタイプのデバイスは同じ E を示しました a =0.38 eV;これは、両方のタイプのデバイスがスイッチング層の上部に同じTaOのキャッピング層を持っていたという事実に関連していました。 LRSの劣化は、空孔とイオンの再結合のプロセスです。つまり、TaO層がこの化学反応を制御し、ほとんどの空孔はTaOとスイッチング層の間の界面近くに密集しています。これらの欠員は、TaO /スイッチングレイヤインターフェイスに留まることを好みます。この現象は、Zhong et al。によって報告されているように、熱力学的安定性の観点からサポートされる可能性があります。 [23]。 TiN / Ta / HfO x のシミュレーションで / TiNスタック、酸素イオンはTa / HfO x に留まることが好ましい TaとHfOの間に低いエネルギー差が存在したため、インターフェース x [23]。彼らのシミュレーションでは、現在の実験と同様に、TaO抵抗層がほとんどの酸素イオンをトラップし、この空孔再結合プロセスを支配しました。 LRSの劣化は、図4cに図式化されています。酸素イオンは、ベーキングプロセス中に前の熱平衡状態に戻り、保持損失が発生します。 Ta / HfO x の違いに注意してください。 Zhongらによって提案されたデバイス。およびTaO / HfO x この研究ではデバイスですが、両方の研究で、TaO層は金属Ta堆積とLTPOプロセスの数サイクルによって形成されました[14]。 LTPOプロセスのため、金属が豊富なTaO / HfO x インターフェースは、酸素イオンリザーバーと見なすことができます。酸素イオンと空孔の再結合プロセスでは、原子のパッキング密度が重要な役割を果たします。 AlO x で得られる優れたLRS保持特性 スイッチング層は、AlO x の高い原子密度によって説明できます。 層。 Al–Oの結合長がHf–Oの結合長よりも短いことはよく知られています[24、25]。 AlO x の短い結合 高いクーロン相互作用により酸素イオンの移動度が低下し、その結果、高い酸素空孔拡散障壁が生じます。このバリアにより、TaO / AlO x での保持時間が長くなります。 TaO / HfO x よりもデバイス 1つ。
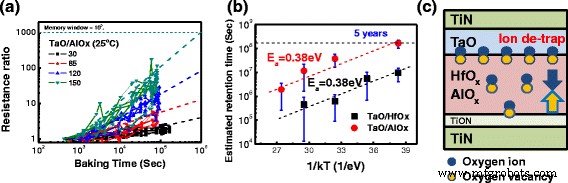
a TaO / AlO x のさまざまな温度での抵抗変動率とベーキング時間の関係 デバイス。平均初期抵抗は179MOhm、読み取り電圧は2 Vで、LRS抵抗劣化率は、log( R の線形フィッティング法によって計算されました。 比率 )–log(T)スケール。 b 推定保持時間(1000×)対1 / kTプロット。各ポイントには、2 Vの読み取り電圧で取得された18個のデバイスからのデータが含まれています。抽出された活性化エネルギーは、TaO / AlO x の両方で0.38eVでした。 およびTaO / HfO x デバイス。 c HfO x のさまざまな酸素拡散障壁の保持概略図 またはAlO x TaOキャッピング層付き
さらに、フィラメントタイプのデバイスの保持損失モデルは、欠陥トラップタイプのデバイスのそれとは異なります。フィラメント型RRAMの保持挙動はフィラメントの破裂に関連しており、空孔の拡散方向は横方向です[11、19、24]。欠陥トラップRRAMでは、欠陥の拡散方向は縦方向であり、外部電界に平行です。したがって、保持動作はバイアスの方向と大きさの影響を受ける可能性があります。図5a、bは、2つのデバイスの抵抗比によるバイアス上の保持を示しています。抵抗比は、LRSの抵抗に対するストレスデバイスの抵抗として定義されます。正のバイアスはLRSの維持に役立ちますが、負のバイアスは劣化プロセスを加速します。これらのバイアス上の特性は、酸素イオンと空孔のペアの局所的な電場と外部電場との間の相互作用によって説明することができます。外部フィールドの方向が設定された方向と同じ(正)の場合、保持時間が延長されます。外部フィールドがリセット方向(負)の場合、劣化の原因になります。 ±100mVの低電界では、オンバイアス劣化は両方のタイプのデバイスの非バイアス劣化と同じです。この±100mVのバイアスは、TiON-HfO x の帯域オフセットによってカバーされる可能性があります。 、TiON-AlO x 、およびTiN-TaOジャンクション。 TaO / AlO x 500 mVの高い正のバイアス下にあるデバイスは、明らかな劣化を示していません。
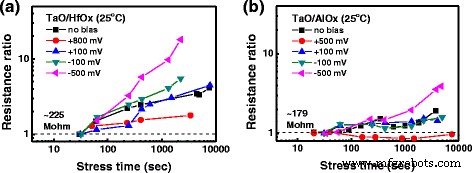
a のオンバイアス抵抗比とストレス時間の関係 TaO / HfO x および b TaO / AlO x 室温のデバイス
結論
要約すると、2種類の自己整流型RRAMデバイスをスイッチの特性で比較し、保持動作を分析しました。 TaO / AlO x デバイスは、TaO / HfO x よりも高いスイッチング電圧と、より堅牢なLRS熱安定性を示しました。 デバイスはしました。 AlO x による堅牢な保持のメリット スイッチング層は、活性化エネルギーではなく、高い酸素拡散障壁によるものです。保持損失の活性化エネルギーは、TaO抵抗層のイオンデトラッププロセスに関連しています。 AlO x の高い原子密度 フィルムはLRSの保持を改善する可能性があります。保持損失の概略モデルが提案されており、バイアス上の保持結果がこのモデルをサポートしていました。このモデルは、将来の高密度メモリアプリケーション向けの低電流、長期保持、自己整流型RRAMデバイスの開発に役立つ可能性があります。
ナノマテリアル
- チタンの特性と用途
- スイッチ付き回路
- 粘り強さと忍耐力でリードする
- C の switch…case (C の Switch ステートメント) と例
- 高度な農薬活性を備えたスマートナノマテリアルおよびナノコンポジット
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- CuSナノ粒子でコーティングされた着色および導電性CuSCN複合材料の容易な合成
- 陽極TaOxナノチューブアレイの生体適合性の向上
- 窒化処理を施したHfO2ベースのRRAMの伝導メカニズムと耐久性の向上



