自己組織化InAs / InGaAs量子ドット超格子における空間的に局在化した励起子の検出:光起電効率を改善する方法
要約
この論文は、量子井戸の基礎となるInGaAsストレインリリーフに近接したマルチスタックInAs量子ドットの非定型温度依存フォトルミネッセンス特性の実験的および理論的調査について報告します。 InAs / InGaAs / GaAs QDヘテロ構造は、固体分子線エピタキシー(SS-MBE)によって成長し、フォトルミネッセンス(PL)、分光エリプソメトリー(SE)、およびピコ秒時間分解フォトルミネッセンスによって調査されました。サンプルのPLスペクトルには、特徴的な二重発光ピークが見られます。励起電力依存および温度依存のPL測定から、これらの放出ピークは、2つの異なるサイズの母集団を持つInAs量子ドットからの基底状態遷移に関連付けられています。発光測定は、PL技術により、10〜300Kの範囲の温度の関数として実行されました。低温PLは、低エネルギー側に現れ、深いレベルでの再結合に起因する異常な放出を示しています。 PLピークエネルギーは、局在化したキャリアと非局在化したキャリア間の競合プロセスの結果として異常な動作を示します。通常のフォトルミネッセンスの振る舞いを説明するために、局在状態のアンサンブルモデルを提案します。定量的研究は、量子井戸の連続状態が、熱的に活性化されたキャリアの再分布のための通過チャネルとして機能することを示しています。局在深度と、調査した太陽電池のヘテロ構造の適用に対するその影響を決定しました。このモデルは、理論計算に基づいて、InAs / InGaAs / GaAs QDsSCの特性を改善できる可能性の概要を示しています。
背景
自己組織化量子ドット(QD)は、3次元のキャリア閉じ込めの性質とδのような状態密度により、オプトエレクトロニクスでの可能なアプリケーションについて広く研究されてきました。最近、価電子帯と伝導帯の吸収によって余分な光キャリアを導入する中間帯太陽電池(IBSC)を実現するためにQD構造が提案されました[1]。 GaAsよりもエネルギーバンドギャップが小さいQDを備えたGaAsベースのIBSCは、GaAsエネルギーギャップよりも低いエネルギーで光子を吸収できるタンデム構造を形成し、エネルギー変換効率を高めます[2]。 QD中間バンドの形成には、高密度QDの最密多層構造が必要です[3、4]。ただし、InAs QDの結晶品質は、QD層数が増加し、内部圧縮ひずみの蓄積により層間隔が減少するにつれて低下します。過度のひずみは、QDから表面に向かってねじれる転位と欠陥を引き起こします。したがって、InAs / GaAs QD SCの性能も、QD層の数が増えるにつれて低下します[5]。これらの問題を克服するために、InAs / GaAs材料システム用のGaAsN、GaAsP、およびGaPバッファ層を使用したひずみ補償成長技術が実証されています[6、7、8]。これらの問題を克服する別の手法は、InAs / GaAsQD層を薄いInGaAs歪み低減層で覆うことです。 InAs / GaAs QDと比較すると、この層は、InAsとInGaAsの間に小さな格子不整合が存在するため、光応答に赤方偏移を引き起こします。温度依存のフォトルミネッセンス研究は、マルチスタックInAs / GaAs QD SCに関する有用な情報を提供します。これは、かなり実用的かつ理論的に興味深いものです。古典的に、半導体材料のバンドギャップは、温度の上昇とともに単調に減少します。 InAs / GaAs QDなどの特殊な材料は、量子ドットの集合内の熱的に活性化されたキャリア移動メカニズムにより、低温でのPLの異常を示しています。ただし、これらの異常は、Ilahi et al。によって示されているように、InAs / InGaAs / GaAsQDヘテロ構造での成長後の混合プロセス後に徐々に消えます。 [9]。本研究のものと同様のヘテロ構造は、サヤリらによって光起電用途におけるそれらの効率について調査された。 [10]。 Passler、Vina、Varshniモデルなど、過去数十年の間に多くのモデルが提案されてきました。信頼性の高いデバイスを製造するには、このような種類のInAs / InGaAs / GaAs QDヘテロ構造の温度挙動を十分に理解する必要があります。これは、最適なモデルを使用することによるものです。ここでは、励起子バンドギャップの観測されたS字型の温度依存性をよりよく理解するために、熱再分布係数に補正されたPassler古典モデルを使用します。私たちの研究は、高効率の光起電力デバイスを製造するための非常に技術的に重要なエネルギー材料であるInAs / InGaAs / GaAs QDヘテロ構造におけるキャリアの局在化と移動について、自己矛盾のない正確な画像を生み出します。
実験の詳細
図1は、私たちの研究で調査したInAs / InGaAs / GaAsQDヘテロ構造の概略図を示しています。ヘテロ構造は、InAs / In 0.11 の5つのスタックで構成されています Ga 0.89 As / GaAs QD層は、80nmの真性GaAs層で挟まれています。エピタキシャル層はエピレディn + 上に成長しました -Riber MBE 32Pシステムで固体分子線エピタキシー(SS-MBE)を使用したGaAs(100)基板。酸化物の脱着に続いて、250 nm n + ドーピング密度が2×10 18 のドープされたGaAsバッファ cm -3 520°Cで成長させた後、ドーピング密度が10 17 の1000nmのnドープGaAsベース層を成長させました。 cm -3 。次に、基板温度を下げて500°Cで安定させ、真性領域を堆積させます。図1に示すように、繰り返される層は、InAsカバレッジの2.5単分子層(ML)、厚さ5nmのIn 0.11 で構成されます。 Ga 0.89 Asおよび33nmの厚さのGaAs。 QDの形成は、高エネルギー電子(RHEED)の回折パターンを監視することによってその場で制御されました。厚さ5nmのIn 0.11 の目的 Ga 0.89 発光スペクトルと吸収スペクトルを赤方偏移するのと同様に、33nmの厚さのGaAsがスペーサー層として機能します。 InAs、In 0.11 の成長率 Ga 0.89 As、およびGaAs層は、RHEED鏡面スポット振動で測定すると、それぞれ0.08 ML / s、0.78 ML / s、0.7 ML / sでした。最後に、500 nmのpドープGaAsエミッタ層(2×10 17 cm -3 )続いて100 nm GaAs p + ドープされた接触層(5×10 18 cm -3 )ヘテロ構造の上に成長しました。シリコン(Si)とベリリウム(Be)は、それぞれn型とp型のドーパントとして使用されました。成長中、温度は高温計によって較正されました。
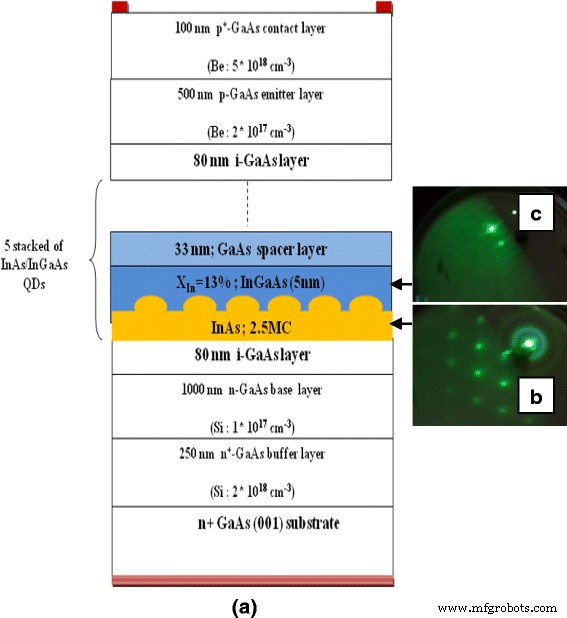
a (001)n + 上に成長した5層スタックInAs / InGaAs QDSCの概略層構造 -GaAs基板。 b 2.5 MLのInAsの成長(3次元成長)後にパターン化されたRHEED。 c 5 nm InGaAsの成長中にパターン化されたRHEED(2次元成長)[10]
分光エリプソメトリー(SE)は、J.A。を使用して、1〜6eVの室温で実行されました。 Woollam可変角度分光エリプソメーター(VASE)M-2000。 SE測定は、45°から60°の範囲の入射角で実行されました。 PL測定では、アルゴンイオン(Ar + )波長514.5 nmのレーザーを励起源として使用し、電子正孔対を生成しました。サンプルからの発光光は、高分解能分光計によって分散され、増幅器を内蔵した熱電冷却されたGe光検出器によって検出されました。励起パワー依存および温度依存のPL測定では、サンプルをクローズドサイクルの温度制御されたヘリウムクライオスタットに取り付けました。 PLスペクトルは、1.5〜350 mWの公称出力電力範囲と11〜300 Kの温度範囲で取得されました。時間分解PL測定は、可変温度(10〜240 K)の閉サイクルヘリウムで実行されました。クリオスタット。 514 nmの線は、モードロックされたTi:サファイアピコ秒パルスレーザーからの励起波長として使用されました。繰り返し速度は80 MHz、パルス幅は1.2psです。
結果と考察
図2は、エネルギー範囲1〜6eVの300KでのInAs / InGaAs / GaAs QDヘテロ構造の誘電関数の測定された実数部(a)と虚数部(b)を示しています。実数部と虚数部は異なるパターンに従います。光子エネルギーによる誘電関数の変化は、フィルム内の光子と電子の間の相互作用が1〜6eVのエネルギー範囲で生成されることを示しています。 2つの主要なスペクトル機能はE 1 です。 およびE 2 それぞれ〜3および〜4.5 eVでの臨界点(CP)構造[11、12]。さまざまなバンド間遷移のエネルギー位置を定量的に決定するために、疑似誘電関数の虚数部の2次微分スペクトルのゼロ交差を取得しました。得られたさまざまな遷移エネルギーを表1にまとめています。
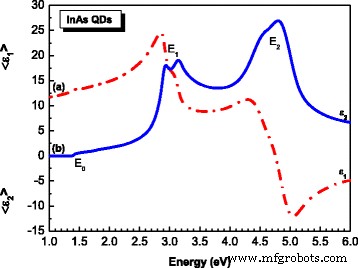
実数( ϵ 1 )(赤い破線 )および虚数( ϵ 2 )(青い実線 )SE測定から得られたInAs / InGaAsQDヘテロ構造の誘電関数の一部[10]
図3は、図2に示した疑似誘電関数の虚数部の2次エネルギー微分スペクトルを示しています。2.9および3.1 eVの2つのピークは、それぞれ E に対応しています。 1 および E 1 +Δ 1 、GaAsのバンド間遷移。ただし、約4.4eVと4.7eVの2つの近接したピークは、CP遷移 E が原因です。 0 ’および E 2 、それぞれ、InAsQDレイヤー[12]。 E の貢献に注意してください 1 +Δ 1 E に対するInAsのCPエネルギー(2.74 eV)[12] 1 2つのエネルギー値の差が小さいため、GaAsの1つ(2.91 eV)[11]を除外することはできません。低エネルギーでは、GaAsのバンドギャップはεで明確に区別できます。 約1.4eVのスペクトル。また、2番目のエネルギー微分スペクトル(図3)は、 E に対応する1.75eVでのバンド間遷移を示しています。 0 +Δ 0 GaAsのCPエネルギー[11]。 εは 2 材料品質のゲージおよび尺度です。最も高い値は、最も急激なインターフェースを意味します[13]。文献によると、ε 2 E の領域で得られた、約25の値。この場合の最大値は26.8です。 2 4.7 eV付近のバンドギャップは、SS-MBEによって成長したInAs / InGaAs / GaAsQDヘテロ構造を形成する高品質の材料を示しています。
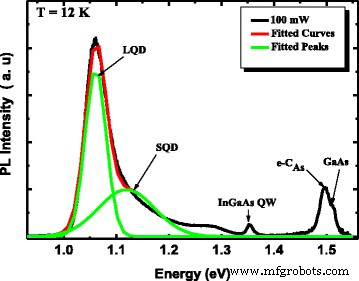
虚数部の二次微分スペクトル( ϵ 2 )InAs / InGaAsQDヘテロ構造の光子エネルギーの関数としての誘電関数の。 InAsQD層とGaAs層から生じる遷移エネルギーが示されています[10]
図4は、低温(12 K)で励起電力が100mWのInAs / InGaAs / GaAsQDヘテロ構造の活性領域のPLスペクトルを示しています。明らかに、スペクトルは高エネルギー側に位置する非対称形状を示し、ガウスフィッティングによって2つのサブバンドにデコンボリューションすることができます[14]。量子閉じ込めポテンシャルのドットサイズへの依存性を考慮すると、1.06 eVにある最も強いピークは、より大きなQD(LQD)の基底状態からの放出に起因し、1.11 eVでのより高いエネルギーピークは、小さいQD(SQD)の基底状態[15]。したがって、非常に低い励起パワーと低温では、非対称形状はドットの二峰性サイズ分布に起因する発光によるものであると推測されます[16]。さらに、InGaAs量子井戸層に由来するピーク、GaAs伝導帯の電子と炭素アクセプターレベルの正孔(e-C As )間の再結合 )[17]とGaAsのバンドギャップは、それぞれ1.35、1.49、1.51eV付近に見られます。この非対称形状への帰属を確認するために、10〜100mWの範囲のさまざまなレーザー出力でPL測定を実行しました。また、調査したものと同様のキャップのない構造でAFM測定を実行しました。図5から、ヘテロ構造が電力に依存しないPL形状を持っていることが明らかです。最高の励起スペクトルは別として、ヘテロ構造の高エネルギーPLピークのPL強度と線幅は大きく変化しません。また、2つのPLピーク間のエネルギー分離(図5)は約50meVです。予想どおり、AFM画像は、第5層のQDが、全体のQD密度が7×10 10 のバイモーダルサイズ分布を持っていることを示しています。 cm ^(− 2)。ヘテロ構造の低エネルギー側のピークが大きなQD(LQD)の基底状態に対応すると仮定すると、高出力での高エネルギーのピークは、比較的小さなQD(SQD)の基底状態の結果であるように見えると言えます。 。
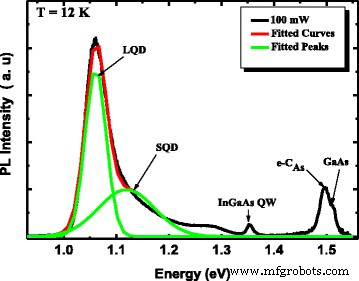
5層スタックInAs / InGaAs QDヘテロ構造から低温(12 K)で測定されたPLスペクトル。スペクトルの線形状分析は、QDPL信号が実線で示される2つのガウス形状のピークの畳み込みであることを証明します。

12Kで測定されたInAs / InGaAsQDヘテロ構造からの励起パワー依存の正規化されたPLスペクトル
PL再結合メカニズムの洞察を得るために、温度依存のPL測定が10〜300 Kのヘテロ構造で実行され、図6に示されています。図7は、LQDからの発光に関連する主要ピークのPLエネルギー位置を示しています。このピークは、従来のGaAlAsなどの他のIII–V三元合金と比較して、10〜100Kの異常な温度依存性を示しています[18]。この温度範囲(領域(i))では、約12meVの赤方偏移が観察されます。このシフトは、不均一に分布したLQDのアンサンブル内の局在化した状態を介した励起子の再結合によるものです。この温度範囲内で温度が上昇すると、キャリアが熱的に活性化され、アンサンブル内の小さいQDから大きいQDに移動し、最終的に放射的に再結合します。これにより、観察された現象は、構造内の大きなドットサイズの分散に起因する可能性が高くなります(AFM挿入図を参照)。 2つの再結合プロセス(局在化および非局在化キャリア)がPL信号に等しく関与する特徴的な温度は、 T として示されます。 loc / deloc 。次に、100〜120 K(領域(ii))の間で、ピークエネルギーが増加します。これは、より浅い状態からより高い状態へのキャリアの脱出によるものです。特徴的な温度は T で表されます エスケープ 。高温(領域(iii))でも、励起子は完全に非局在化され、バンド間の再結合が回復します。

100mWの励起パワーで測定されたInAs / InGaAsQDヘテロ構造からの温度依存PLスペクトル

さまざまな温度で測定された調査対象のInAs / InGaAsQDヘテロ構造のLQDPLピークエネルギー
InAs / InGaAs / GaAsマルチスタックQDの再結合プロセスをさらに理解するために、光カウント時間相関技術を使用して時間分解PLを研究しました。量子ドットの励起子崩壊寿命は温度に敏感であることが理論的に予測されました[19]。実験的測定により、寿命は実際に臨界温度未満の一定の温度であることが示されています[20]。 Markus etal。 [21]は、実験誤差の範囲内で、広範囲の温度にわたって約950psの一定の寿命を報告しました。
図8aは、1.06 eVに固定された検出エネルギーと励起エネルギー(λ)の17〜240KのPL減衰スペクトルを示しています。 exc =514 nm)。これらのスペクトルは、理論的には単指数関数によく適合しており、低温での減衰時間は約1000psです。 III-V半導体薄膜[22]と比較して、この遅い減衰時間は、局在状態の存在の兆候であり[23]、LQDピークでのキャリアの再結合は純粋に放射性のものである必要があります。実際、低温では、光生成された電子と正孔は、再結合する前に、時間をかけて励起子を形成し、エネルギーを緩和して浅い局在状態に捕捉されます。これらの現象により、減衰時間が遅くなります。 PL減衰時間に対する温度の影響が研究されており、図8b [24]に示すように2つの異なるレジームの存在が示されています。 PLバンドの低エネルギー(LQD(1.06 eV))に関連する減衰時間は140 Kまでほぼ一定(1000 ps)であり、その後、温度が上昇するにつれて減少します。

a 514nmの波長励起のサンプル温度に対するLQDピークの減衰時間。 b 514nmの励起波長で測定されたLQDピークの温度に対する典型的なフォトルミネッセンス減衰強度
理論的アプローチ
PLの異常な温度依存性を理解するために、Liらによって開発されたLSEモデルを使用してPLのピーク位置を調査しました。 [25、26]。実際、この定量的モデルは、ホウ素ベースのB(In)GaAs / GaAs [27、28]合金やInGaAs / GaAsなどのいくつかのIII-V材料で以前に観察された、局在状態の発光の異常なスペクトル特性について十分な説明を提供します。 MQW [29、30]。モデルは、局所化された状態が、次の式で与えられる状態密度に対してガウス型のエネルギー分布を持っていると仮定しました。
$$ \ rho(E)={\ rho} _o {e} ^ {-{\ left(\ frac {E- {E} _ {\ mathrm {ch}}} {2 {\ sigma} ^ 2} \右)} ^ 2} $$(1)ここでσ および E ch は、それぞれ、キャリアが転送するために克服しなければならないローカライズされた状態(ローカリゼーションの深さ)とバリアレベルの分布の広がりパラメータです。準定常状態では、局在励起子のダイナミクスは次の反応速度式で表すことができます。
$$ \ frac {dN \ left(E、T \ right)} {dt} =G(E)+ \ frac {\ gamma_c N \ hbox {'} \ left(E、T \ right)\ rho(E) } {\ Lambda}-\ frac {N \ left(E、T \ right)} {\ tau _ {\ mathrm {tr}}} {e} ^ {\ frac {E- {E} _a} {K_B T} }-\ frac {N \ left(E、T \ right)} {\ tau _ {\ mathrm {r}}} =0 $$(2)パラメータτ r 、τ tr 、γ c 、 K B 、Λ、および N 'は、それぞれ、キャリア再結合時間(放射寿命)、キャリア移動時間(非放射寿命)、再捕獲係数、ボルツマン定数、局在状態の総数、および熱的に活性化されて離れたキャリアの総数を表します。ローカライズされた状態。 G ( E )はキャリア生成の速度を表します。量\(\ frac {\ gamma_c N \ hbox {'} \ left(E、T \ right)\ rho(E)} {\ Lambda} \)は、ユニットごとにローカライズされた状態によって再キャプチャされたキャリアの数です。時間。右側の第3項は、局在化したキャリアの熱脱出率を示しています。最後の1つは、放射再結合によるキャリアの人口減少率を表しています。ローカライズされたキャリアのキャリア人口密度は、ローカライズされたキャリアの分布関数と状態密度に比例します。実際、式の解は次のようになります。 (2)式で表すことができます。 (3)。
$$ N \ left(E、T \ right)=\ frac {\ rho_o {e} ^ {-{\ left(\ frac {E- {E} _0} {2 {\ sigma} ^ 2} \ right) } ^ 2}} {\ left [\ frac {\ tau _ {\ mathrm {tr}}} {\ tau _ {\ mathrm {r}}} + exp \ left(\ frac {\ left(E- {E} _ {\ mathrm {ch}} \ right)} {K _ {\ mathrm {B}} T} \ right)\ right]} $$(3)ここで E 0 中心的なエネルギーです。数学的には、\(\ frac {\ partial N \ left(E、T \ right)} {\ partial t} =0 \)から決定される局所状態内のキャリア熱再分布によるピーク位置の温度依存性は次の式で与えられます。 :
$$ E(T)={E} _0- x(T){K} _B T $$(4)ここで x ( T )は非線形方程式の数値解です。 (5):
$$ x {e} ^ x =\ left [{\ left(\ frac {\ sigma} {K_b T} \ right)} ^ 2- x \ right] \ left(\ frac {\ tau _ {\ mathrm {r }}} {\ tau _ {\ mathrm {tr}}} \ right)exp \ left [\ frac {\ left({E} _0- {E} _ {\ mathrm {ch}} \ right)} {K_ { \ mathrm {B}} T} \ right] $$(5)
式5には、\(0
理想化された半導体材料のバンドギャップは、通常、Passlerの実験式[32]で表されることが知られています。熱再分配係数による補正を考慮に入れると、式(1)で記述されるLSEモデルを使用した発光のピーク位置の変動。 (7):
ここで、θ デバイ温度θに匹敵すると予想される特徴的な温度パラメータです。 D 。 T の場合>> θ 、αは一次導関数\({\ frac {dEg(T)} {dT}} _ {T \ to \ infty} \)の大きさの限界を表していることがわかります。指数「p」は、基礎となる電子-フォノンスペクトル関数の形状に関連しています[33]。このモデルは、図9で確認された実験的進化への良好な適合を提供します。適合パラメータは、表2に要約されています。
LQDピークの温度依存性フォトルミネッセンスの変化(黒い四角 )経験的なPasslerの法則(青い実線)を使用して適合 )およびLSEモデルに対する修正されたPassler関係の真理(赤い実線 )
PLのピークエネルギーは、図10に示す熱再分布に強く依存します。これは、極低温の範囲が急速に増加していることを示しています。熱再分配の最大値は、エネルギー進化における赤方偏移の最大値(〜50–100 K)に対応します。 PL温度が高い領域では、熱再分布は指数関数的に減少し、150 Kから非局在化プロセスを開始し、バンドからバンドへの遷移に戻るため、キャンセルされる傾向があります。また、古典曲線と修正曲線を重ね合わせた場合にもこれを観察できます(図9)。指数「p」は、縦音響(LA)フォノンの寄与が縦光学(LO)の寄与よりも重要であることを示しています。 )フォノン。この寄与は、放出がフォノンを介して支援される高PL温度の領域で支配的であるように見えます。二峰性分布プロセスは、エネルギー E によって分離された非局在化電子と正孔状態によって表される量子ドット間の結合チャネルを開きます。 ch 。この結合チャネルの起源はまだ論争の的となっています[34,35,36]。ただし、結合チャネルは、2次元のWL状態と0次元のQD状態の間に存在する中間状態と見なすことができます[37]。したがって、QD状態のキャリアは、必要な活性化エネルギーが小さいため、WLよりも結合チャネルに熱的に励起されやすく、有限の距離内で隣接するQDに転送されると想像できます。フェルミディラック分布のフェルミディラックレベルのように見えます。このエネルギー E ch 活性化エネルギー E よりも小さい a アレニウス図から抽出(図11)。 E の理由 a 図12に概略的に示すように、キャリアが湿潤層(WL)に到達するには、より大きなエネルギーが必要であるという事実によって、キャリアがより大きくなることを説明できます。さらに、差の大きさΔ E = E ch − E 0 局在化したキャリアの発光の異常な温度依存性を決定する上でより重要な役割を果たします。 E という2つのケースに注意する必要があります ch − E 0 >>および E ch − E 0 <0、物理的な観点から存在しますが、通常は「正の」熱活性化エネルギーとして割り当てられます。私たちの場合、これは E ch E より4meV低い 0 局在化したキャリアは、より高いエネルギーの状態(または実空間のサイト)に熱的に活性化されます。 In 0.15 の単一のInAsQDレイヤーと比較して減少します。 Ga 0.85 下にある層を減らすひずみとして[10]。 σによって割り当てられた潜在的な変動の深さ QDのサイズ分布の不均一性の結果です。潜在的な深度は19meVであることがわかります。 InAs / In 0.11 のスタック数を増やすと、減少します。 Ga 0.89 As / GaAs量子ドット。その結果、ポテンシャルの深さが減少すると、Ilahiらによって研究されたInAs / InGaAs / GaAs量子ドットの1層と比較して構造効率が向上すると推測できます。およびHelmietal。 [10、36]。
数値的に決定された温度依存の熱再分布。特徴的な温度( T loc / deloc および T エスケープ )ローカリゼーション-非ローカリゼーションプロセスに関して示されています
調査したサンプルのアレニウスフィッティング。正規化された積分強度(黒丸 )には3つの活性化エネルギーがあります(赤い実線 )
局在化した電子/正孔(励起子)状態のQD分布の概略図( WL ぬれ層、 CH キャリア転送チャネル)

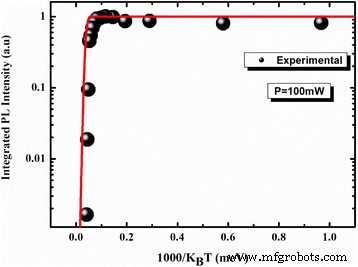
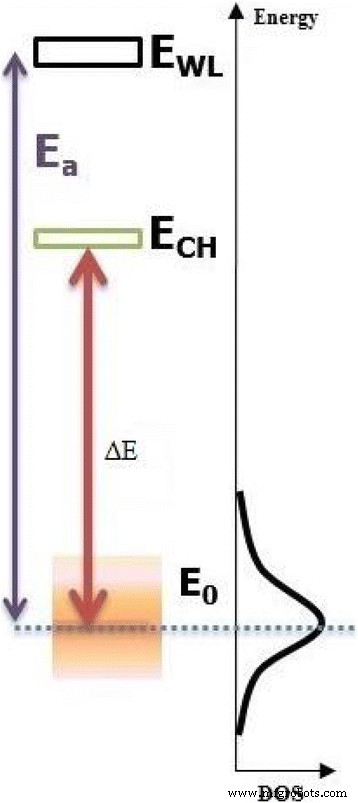
結論
結論として、QD上にInGaAs層をキャップし、GaAsスペーサー層を挿入することにより、InAsQDのマルチスタックを備えたGaAsベースのSCを製造することに成功しました。 3および4.5eVでのInAs / InGaAs / GaAs QDヘテロ構造の誘電関数スペクトルで観察された2つの主要なスペクトル特性は、 E に起因します。 1 および E 2 それぞれGaAsとInAsのCP構造。 GaAsマトリックス中のInAsQDのPLスペクトルは強く、非対称の形状を示します。これは、高品質のマルチスタックInAsQD構造の成長を示しています。 PLスペクトルへのより大きなQDと比較的小さなQDの寄与も示されています。発光測定は、開発されたLSEモデルを使用して、正常にモデル化および再解釈されました。理論的研究は、観測された温度依存スペクトルを定量的に解釈し、フィッティングパラメータに基づいて、マルチスタックInAs / InGaAs / GaAs量子ドットの複雑な自然放出メカニズムに光を当てました。この研究は、光起電用途で使用するためのInAs / GaAsQD構造の効率を改善する方法を示唆しています。これらの結果は、調査対象の構造の効率を向上させるために、ひずみ工学QDにおける温度依存のキャリアダイナミクスの理解を向上させるのに役立ちます。この作業に加えて、配向の影響と、マルチスタック構造のInAs / GaAsQDの数の増加が局在化の深さに及ぼす影響を研究します。
ナノマテリアル
- 角度を使用してエレクトロニクスの未来を改善する
- 単一の原子核の磁性を検出する
- プラスチック部品:自動車の効率化への道を開く
- マイクロピラーのInAs二重層量子ドットに基づく1.3μmの明るい単一光子源
- 変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
- コア/シェルCdSe / ZnS量子ドットフィルムの光励起発光に対する可逆的電気化学的制御
- ナノワイヤ/量子ドットハイブリッドナノ構造アレイ太陽電池の光起電力性能
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- 地球温暖化は太陽電池の効率を低下させます
- 加工の高能率化をリードするCNC 5軸フライス加工



