角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
要約
Ga面窒化ガリウム(GaN)(2 nm)/ AlGaN(22 nm)/ GaNチャネル(150 nm)/バッファ/ SiとAl 2 の表面分極 O 3 キャッピング層は、角度分解X線光電子分光法(ARXPS)によって調査されます。界面領域では、エネルギーバンドが上向きの曲げから下向きの曲げまで変化することがわかり、これは分極の変化に対応すると考えられています。上部のGaNとAl 2 の間に界面層が形成されます O 3 Al 2 中にGa–N結合の切断とGa–O結合の形成が発生したため O 3 原子層堆積(ALD)による堆積。この界面層は、GaN分極を排除し、分極によって引き起こされる負電荷を低減すると考えられています。さらに、この界面層は、エネルギーバンドを下向きに導く正電荷の導入に重要な役割を果たします。最後に、N 2 400°Cでのアニーリングは、界面層の成長を促進し、正電荷の密度を高めることが観察されています。
背景
窒化ガリウム(GaN)は、LED産業からパワーエレクトロニクス産業に至るまで、多くの分野で最も魅力的な半導体材料の1つと見なされています[1、2]。この人気は、シリコンに関する多くの利点によるものです。高い破壊電界、高い電子移動度、優れた熱安定性です[3、4]。 GaN高電子移動度トランジスタ(HEMT)は、高出力および高周波アプリケーション向けに広く研究されています[1、5、6]。 HEMTでは、ショットキーゲートが採用されている場合、このゲートインターフェースは大きなインターフェース状態をもたらし、大きなリーク電流と低いブレークダウンフィールドを悪化させます[7]。表面パッシベーション層およびゲート誘電体として誘導された絶縁体は、上記の問題を軽減するのに役立つ可能性があります[8、9、10]。
Al 2 O 3 Ga 2 と比較して、バンドギャップが大きく、誘電率が高く、ギブズの自由エネルギーが負であるため、このような絶縁体の用途に適しています。 O 3 、したがって、Al 2 O 3 表面状態を不動態化し、電界破壊場を改善する可能性があります[5]。しかし、界面層は必然的にGaN / Al 2 で形成されます。 O 3 Al 2 の堆積後の界面 O 3 [11、12]。この界面層は、しきい値電圧の信頼性と二次元電子ガス(2DEG)の特性と相関していると考えられており、バンドの曲がりを制御するために重要な役割を果たします[2、13、14、15、16]。
>界面層はいくつかの研究グループによって研究されてきましたが、界面層が果たす役割は深く活用されていません[12、17]。そのため、本論文では、角度分解光電子分光法(ARXPS)を用いて、バンドベンディングの緩やかな変化を検出し、界面層の原子構造を取得します[11]。さまざまな厚さのAl 2 O 3 原子層堆積(ALD)によってGaNサンプル上に堆積されます。 ALDは、GaNとAl 2 の間の熱反応を制限する、低温の層ごとの堆積技術を利用しています。 O 3 。したがって、ALDは、その高い適合性と均一性、厚さ制御の精度、高い膜品質、および低い欠陥密度のために、high-k誘電体を堆積するために業界で支持されています[4]。これにより、スムーズで欠陥の少ないAl 2 が可能になります。 O 3 / GaNインターフェース。 Al 2 の後 O 3 堆積では、400°Cの堆積後アニーリング(PDA)サンプルも準備され、界面層の反応を強化し、界面層の形成を促進します。 ARXPSの結果に基づいて、分極によって引き起こされた負電荷のために、バンドは最初にGaN基板から界面近くまで上向きに曲がっていることがわかります。ただし、検出角度の増加としてθ 、正電荷の形成のためにバンドは徐々に下向きに曲がります[5、11、12、13]。
メソッド
Ga面GaN / AlGaN / GaN-on-Si(111)ウェーハは、商業会社(Enkris.com)から購入しました。エピタキシャルウルツ鉱構造は、22nmのAlGaN層の上に2nmのGaN層を含み、2つのエピタキシャル層は150nmのi-GaN層上に成長します。バッファ層は、GaNエピ層とSi基板を接続する遷移層として機能します。 S1、S2、S3の3つのサンプルを用意します。すべてのサンプルを最初にアセトンで5分間減少させた後、イソプロピルアルコールに浸し、脱イオン(DI)水でリンスしました。次に、自然酸化物を希塩酸溶液(HCl:H 2 )に浸してエッチング除去しました。 O =1:10)〜1分間、続いて脱イオン水ですすいでください。 Al 2 O 3 トリメチルアルミニウム(TMA)とH 2 を使用して、ALDによってGaN上に堆積されます。 それぞれ金属前駆体および酸化剤としてのO。 Al 2 O 3 厚さは、サンプルS1では1 nm、サンプルS2とS3では3nmです。厚さはエリプソメーターで測定されます。さらに、S3はN 2 でPDAにかけられました 400°Cで5分間
ARXPS測定は、単色のマイクロフォーカスAlKα(1486.6 eV)X線源と半球型電子エネルギーアナライザーを備えたThermo Fisher Scientific ThetaProbeシステムで実行されました。結合エネルギー(BE)キャリブレーションは、純粋なNi、Au、Ag、およびCuの標準サンプルを使用して、Ni Fermiエッジ、Au 4 f を設定することにより実行されました。 7/2 、Ag 3 d 5/2 、およびCu 2 p 3/2 それぞれ0.00±0.02、83.98±0.02、368.26±0.02、および932.67±0.02eVにピークがあります。与えられた成分スペクトルのFWHMは、狭い範囲(±0.1eV)内でのみ変化することが許されていました。許容できる低い残差値を取得するために、最小数の成分スペクトルが使用されました[11]。 XPSスペクトルは、さまざまな検出角度(θ)で記録されました。 )、サンプルを傾けることなく、平行に平行にサンプルに対して27.5°から72.5°の範囲。正の帯電によって引き起こされる可能性のあるBEシフトを取り除くために、得られたXPSスペクトルはC 1 s を参照しました。 285.0eVでピーク。元素/結合比の決定を含む定量分析は、Avantageソフトウェアに組み込まれた相対感度係数とアルゴリズムを使用して達成されました[11]。
結果と考察
Ga 3 d さまざまな光電子検出角度でのS1〜S3のコアレベルのスペクトルを、それぞれ図1a〜cに示します。 S1の場合、各Ga 3 d スペクトルは、Ga–NおよびGa–O結合に対応する2つのピークに適合させることができます。 Ga–O結合は、ALDでの酸素剤曝露の結果としての酸化物形成によるものであり、酸素剤は最初の薄いAl 2 に浸透します。 O 3 レイヤー[3]。 S2およびS3の場合、Ga–N、Ga–O、およびO 2 s として示される3つのピークを識別できます。 、 それぞれ。 O 2 s ピークはGa–OおよびAl–O結合に起因し、検出角度が大きくなると明らかになります。この記事はこのピークに焦点を当てていないため、これ以上説明しません。図2は、θの関数としてのGa–NピークのBEを示しています。 S1〜S3の場合。 θから0.2eVの減少が得られます =S1の場合は27.5°〜72.5°。これは、上向きのバンドの曲がりを示唆しており、これは出版物[3、11]と一致しています。 S2の場合、BEは0.1 eVの減少を示し、実験誤差を考慮して、S1またはバンドベンディングのないフラットエネルギーバンドと比較して、界面付近で穏やかな上向きのバンドベンディングを示します。ただし、S3の場合、BEは0.2 eV増加します。これは、サンプルS1およびS2とは対照的であり、バンドを下向きに曲げることをお勧めします。図3は、Al 2 p を記録しています。 すべてのサンプルのスペクトルであり、BEに変化はありません。さらに、ピークはAl–O結合として示されているため、AlGaN層はGa–NBEの変動にほとんど影響を与えません。表1は、Ga 3 d のBEをまとめたものです。 およびAl2 p すべてのサンプルで異なる検出角度で、誤差は±0.1eVです。

XPS Ga 3 d a のコアレベルのスペクトル S1、 b S2、および c S3

検出角度θの関数としてのGa–NスペクトルピークのBE (通常と比較して)S2の場合。エラーバーは±0.1eV

XPS Al 2 p a のコアレベルのスペクトル S1、 b S2、および c S3であり、ピークはAl–O結合を示します。さらに、BEに大きな変動はありません
すべてのサンプルのGa–OとGa–Nのピークの比率を表2に示します。サンプルS1とS2の比率は約0.2であり、以前の結果と一致しています[3]。ただし、PDA治療後、比率は〜0.3に増加し、GaO x の増加を示します。 界面層。さらに、Ga / N比も表2に示されています。この比は、Ga 3 d の積分強度を比較することによって計算されます。 およびN1 s 原子感度係数のピーク[18]。サンプルS1とS2の場合、1.7前後の比率は、Gaが豊富な界面層を示しています。ただし、N 2 の後 アニーリングすると、比率は〜1.0に減少します。さらに、サンプリング深度も各角度について表2に示されています。光電子の指数関数的減衰のため、検出された電子の63%と95%は、表面からそれぞれ1λ(つまり、λは電子の非弾性平均自由経路(IMFP)を表す)と3λの距離内から発生します。したがって、XPSサンプリング深度は、サンプル表面の下の3λナノメートルとして定義されます。この場合、Al 2 O 3 はキャッピング層であり、Ga 3 d のλです。 Al 2 の光電子 O 3 〜3.4nmと推定されます。大まかな見積もりでは、さまざまな角度でのサンプリング深度は3λcosθとして与えられます。 。ただし、実際のGa–N BEサンプリング深度では、Al 2 の厚さを考慮する必要があります。 O 3 したがって、サンプリング深度は3λcosθと推定されます。 マイナスキャッピングAl 2 O 3 厚さ。 GaO x 層はGaNヘテロ構造の上にあり、この層の信号はすべての検出角度に含まれています。ただし、検出角度が大きくなると、Ga–N結合の信号強度が低下し、Ga–O / Ga–N比が大きくなります。 S2とS3を比較すると、Ga–O / Ga–N比の増加とGa / N比の減少は、Gaリッチ層が酸化されてGaOを形成していることを示しています x 。
<図>ここに示した実験データを説明するために、モデルを図4に模式的に提案します。GaN/ AlGaN / GaN基板のフェルミエネルギーレベルはXPS測定中に0eVとして較正されます[19]。伝導帯の最大値(CBM)、価電子帯の最大値(VBM)、およびコアレベルが示されています。 BEは、コアレベルとフェルミレベルのエネルギー差です。 ALD堆積では、酸素化剤からのOがGa–N結合のNに置き換わって、GaNを酸化し、周囲のN原子がN 2 を形成する可能性があります。 分子[20]は、Gaリッチ層と酸化ガリウム(GaO x )の形成につながります。 )界面層[11、18]。これは、表2の1より大きいGa / N比によってサポートされています。この比は、GaNの化学量論の変化を示しており、GaNの固有の自発分極効果は消失するはずです[21、22、23]。その結果、Ga-to-GaO x としてのGaリッチ層 遷移層は、図4に示すように、分極によって引き起こされる負電荷を排除し、平坦な伝導帯をもたらします[11]。
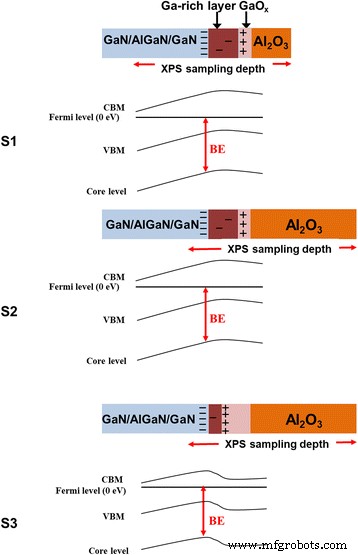
界面領域では、Ga–N結合のNをOで置き換えると、Gaが豊富な層とGaO x が生成されます。 層。 Gaリッチ層はGaNからGaOへの x として機能します 遷移層。 Ga–O形成は、GaNの分極を排除し、正電荷として機能します。その結果、伝導帯は上から下に徐々に曲がり、それに応じてBEが変化します
さらに、アニーリングプロセスでは、Gaに富む表面が酸化されてより厚いGaO x が形成されます。 層。酸化は速度論的に制限された反応であり、約2つの表面単分子層に制限されるため、バルクは強く乱されません[24]。したがって、Ga–N結合信号は、主に酸化されていない基礎となるバルクからのものであり、S3のGa / N化学量論比は1になります。 GaO x 層は正電荷を持ち込むことが報告されており、これは自然酸化物の伝導帯の最小値とGaNの間のエネルギー状態を持つ界面固定電荷であり、バンドを下向きに曲げます[4、11、13、14]。したがって、GaO x の近くの領域では、Gaリッチ層の伝導帯が減少し始めます。 層。より厚いGaO x より高密度の正電荷をもたらすことが期待されます。 S3のGa–OとAl–Oの一定のBEに関しては、正電荷がGaリッチ層/ GaO x の界面に位置する必要があることを示しています。 層。正電荷と分極によって誘発された負電荷は、図4に示すように、バンドベンディングを上向きバンドベンディングから下向きバンドベンディングに変更する内部電界を構築します。下向きバンドベンディングのため、BEは検出角度の増加とともに増加します。 。
GaO x 界面層は正電荷をもたらし、界面バリアの高さを増加させますɸ b 。 ɸ b は、フェルミ準位と表面または界面での伝導帯の最小値との間のエネルギー差として定義されます[25]。その結果、A 2 の後 O 3 堆積すると、2DEGの移動度が増加し、2DEGの電子密度が減少します[16、25、26]。
Al 2 の増加に伴い O 3 厚さ、XPS信号は、キャップされたAl 2 間のインターフェイス領域でより多く反射します O 3 GaN / AlGaN / GaNは、表2に示すXPSサンプリング深度によって検証されます。これは、S2ではバンドベンディングプロファイルの一部しか検出できなかったことを説明しています[27]。その結果、BEの変動は0.1 eVであり、S1の0.2eVよりも小さくなります。 S3の場合、界面層が厚くなると、正電荷の密度が増加し、バンドが下向きに曲がります。
結論
要約すると、Al 2 の界面分極 O 3 キャップされたGaN / AlGaN / GaNはARXPSによって調査されます。 Gaリッチ層とGaO x により、GaNの固有分極が排除されます。 層の形成。さらに、GaO x からのGa–O結合 層は正の界面固定電荷をもたらします。この偏光の変化により、バンドは界面領域で上向きの曲がりから下向きの曲がりまで変化します。
ナノマテリアル
- 5GおよびGaN:将来のイノベーション
- AlGaN / GaNHEMTの表面電位と2DEGに及ぼす表面状態とアルミニウムモル分率の影響
- サファイア上に成長させたエピタキシャルn型ドープGaN層の赤外反射率分析
- 多機能GaN / Feナノ粒子による内皮細胞の標的化
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- 後部に黒色シリコン層を備えた結晶シリコン太陽電池の調査
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解
- シリコン基板上のInGaN / GaN多重量子井戸におけるひずみ制御再結合
- c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性
- Ti3C2TxMXeneのその場高圧X線回折およびラマン分光法による研究



