表面エネルギーの減少によって駆動されるピットパターン化されたSi(001)基板の形態的進化
要約
ヘテロエピタキシャルアイランドの横方向の順序付けは、堆積前に基板を適切にピットパターン化することによって便利に実現できます。ピットの形状、方向、およびサイズを制御することは簡単ではありません。準安定であるため、堆積/アニーリング中に大幅に進化する可能性があるためです。この論文では、連続体モデルを利用して、初期の深さ/形状に応じて、Si(001)で期待できる典型的な準安定ピットの形態を調査します。進化は、フェーズフィールドフレームワークで定式化された表面拡散モデルを使用して予測され、表面エネルギー異方性に取り組みます。結果は、文献で報告されている典型的な準安定形状をうまく再現することが示されています。さらに、異なる深さのピットプロファイルの長い時間スケールの進化は、同様の速度論的経路に従うことが見出されています。このモデルは、平衡ウルフの形状が異なるファセットを特徴とする2つの材料が関与するヘテロエピタキシャル成長のケースを処理するためにも利用されます。これは、Ge / Si実験で証明されているように、堆積中のピットの回転など、形態に大きな変化をもたらす可能性があります。
背景
いくつかの半導体(Ge / SiやInGaAs / GaAsなど)の格子不整合ヘテロエピタキシーは、Stranski-Krastanow(SK)成長モードに従って3Dアイランドを形成する可能性があります。純粋な自己組織化によってこのようなドットを取得する可能性[1、2]は特に魅力的であり、幅広い関心を呼んでいますが、ランダムな核形成は、サイズと形状の分散とともに、アプリケーションを大幅に妨げる可能性があることがすぐにわかりました。
何十年にもわたる研究により、秩序だった構造の形成に向けてヘテロエピタキシャル成長を促進するためのさまざまな方法が開発されました[3–7]。その中で、ピットパターン基板の使用は、ヘテロエピタキシャルアイランドの高次化とサイズ制御の両方を達成するための最も用途の広い方法の1つであることが実証されています[8–15]。
ピットパターン基板は通常、ナノインプリントリソグラフィー[16–18]、電子ビームリソグラフィー[13、14]と反応性イオンエッチング(RIE)[19、20]またはウェットケミカルエッチング[21、 22]、およびナノインデンテーション[23、24]、すなわち、トップダウンアプローチによる。これらの方法では、ピットの順序付けられたパターンが高精度で設計され、適切な成長条件下で[14、25]、ほぼ完全な横方向の順序付けにつながります。
ピットの実際の形状はシステムのエネルギーに影響を与え、より一般的には島の核形成に影響を与えるため[26、27]、それらの形態を制御することが重要です。これは簡単なことではありません。結局のところ、ピットは基板に開けられた穴にすぎません。したがって、十分に高い温度では、毛細管現象[28]は形態学的進化を生み出し、最終的には完全な治癒につながると予想されます。実際、再現性のある長寿命の準安定形状を実現するために、最初のピット形成に続くアニーリングプロセスまたは基板材料のさらなる堆積がしばしば使用されます[8、26]。ピットの形状が安定した後でも、実際のヘテロエピタキシー中にさらなる進化を促進できることに注意してください[29、30]。
この作業では、表面拡散による表面エネルギーの減少によって駆動されるピットパターンの基板の進化を説明することを目指しています。適切なフェーズフィールドアプローチ[31]を採用し、実験的なものと互換性のある長さと時間スケールのシミュレーションを可能にします[32]。このモデルは、ヘテロエピタキシャルシステムの形態進化中の拡散が制限された速度論を説明するためにすでに採用されています[33–36]。さらに、現実的な異方性表面エネルギーを含む平衡への進化を適切に説明することが示されています[37–39]。
一般性を失うことなく、文献[8、10、14、30、40、41]で広く調査されているピットパターンのSi(001)表面の関連するケースに焦点を当てます。
作業は次のように構成されています。 「フェーズフィールドモデル」セクションでは、異方性表面エネルギーを含む表面拡散による進化を説明するために使用されるフェーズフィールドモデルを簡単に説明します。さらに、検討したアプローチで実際のSiWulff形状がどのように考慮されるかについて説明します。 「Si(001)ピットの平滑化」セクションでは、表面エネルギーの減少によって引き起こされるSi(001)ピットの予想される平滑化について、さまざまな初期構成を検討し、平衡に向けた運動経路の概要を説明します。 「Geの過成長による形状変化の模倣」のセクションでは、SiピットにGeの薄層を堆積する際の表面エネルギー駆動の形状変化に対応するヘテロエピタキシャル成長の特定のケースへのこの方法の適用を検討します。結論と意見は「結論」セクションに要約されています。
メソッド
フェーズフィールドモデル
フェーズフィールドモデルは、連続秩序パラメーターφを考慮します。 、φの間で変化 =1(実線)およびφ =0(真空)[31、32]。このアプローチは、エネルギー汎関数[37]、
に基づいています。 $$ \ begin {aligned} F =&\ int _ {\ Omega} \ gamma(\ hat {\ mathbf {n}})\ left(\ frac {\ epsilon} {2} | \ nabla \ varphi | ^ {2 } + \ frac {1} {\ epsilon} B(\ varphi)\ right)d \ mathbf {r} + \\&+ \ int _ {\ Omega} \ frac {\ beta} {2 \ epsilon} \ left( -\ epsilon \ nabla ^ {2} \ varphi + \ frac {1} {\ epsilon} B '(\ varphi)\ right)^ {2} d \ mathbf {r}、\ end {aligned} $$(1)\(\ Omega \ in \ mathbb {R} ^ {3} \)を使用して、φの定義域 ( r )および r =( x 、 y 、 z )。最初の項は、φで定義される拡散界面ドメイン内の相間の界面エネルギーに対応します。 、すなわち、固相の表面エネルギーに。 \(\ gamma(\ hat {\ mathbf {n}})\)は表面エネルギー密度であり、\(\ hat {\ mathbf {n}} \)は外向きの表面法線であり、ε 相間の界面の厚さ。 B (φ )=18 φ 2 (1- φ ) 2 φの最小値を持つ二重井戸ポテンシャルです =0およびφ 参照のように=1。 [31]。式の第2項。 (1)は、鋭い角の形成を回避するために強い異方性レジームで必要とされるウィルモア正則化です[37、38、42]。 β 角の丸めに対応するパラメータです。
φの進化 表面の拡散が制限された反応速度を再現し、縮退したカーン-ヒリアードモデルによって与えられます。つまり、
$$ \ frac {\ partial \ varphi} {\ partial t} =D \ nabla \ left [M(\ varphi)\ nabla \ mu \ right]、$$(2)ここでμ =δ F / δ φ は化学ポテンシャル、 D は拡散係数、 M (φ )=(36 / ε )φ 2 (1- φ ) 2 は表面に限定された移動度関数です。 μの方程式 読み取り
$$ \ begin {aligned} g(\ varphi)\ mu =\ delta F / \ delta \ varphi =&-\ epsilon \ nabla \ cdot \ left [\ gamma(\ hat {\ mathbf {n}})\ nabla \ varphi \ right] + \ frac {1} {\ epsilon} \ gamma(\ hat {\ mathbf {n}})B '(\ varphi)+ \\&-\ epsilon \ nabla \ cdot \ left [| \ nabla \ varphi | ^ {2} \ nabla _ {\ nabla \ varphi} \ gamma(\ hat {\ mathbf {n}})\ right] + \\&+ \ beta \ left(-\ nabla ^ {2} \ kappa + \ frac {1} {\ epsilon ^ {2}} B ^ {\ prime \ prime}(\ varphi)\ kappa \ right)、\ end {aligned} $$(3)κで =− ε ∇ 2 φ +(1 / ε ) B ' (φ )および g (φ )=30 φ 2 (1- φ ) 2 [33、37、38]。後者は、表面拡散による材料輸送の記述に影響を与えることなく、界面の厚さの2次収束を保証する安定化機能です[43、44]。平衡状態の界面に垂直な方向のプロファイルは、
によって十分に説明されます。 $$ \ varphi(\ mathbf {r})=\ frac {1} {2} \ left [1- \ tanh \ left(\ frac {3 d(\ mathbf {r})} {\ epsilon} \ right) \ right]、$$(4)ここで d ( r )は、フェーズ間のインターフェイスの中心までの符号付き距離です。この式は、φの初期条件を設定するために採用されています。 以下に指定されているように。固相の表面をφと呼びます。 〜0.5等値面。考慮される表面のすべての幾何学的特性は、φから導出できます。 、外向きのサーフェス法線など\(\ hat {\ mathbf {n}} =-\ nabla \ varphi / | \ nabla \ varphi | \)。
異方性表面エネルギー
異方性表面エネルギーを説明するために、[38、39]で紹介されているように、表面エネルギー密度\(\ gamma(\ hat {\ mathbf {n}})\)の定義を検討しました。
$$ \ gamma(\ hat {\ mathbf {n}})=\ gamma_ {0} \ left(1- \ sum_ {i} ^ {N} \ alpha_ {i} \ left(\ hat {\ mathbf {n }} \ cdot \ hat {\ mathbf {m}} _ {i} \ right)^ {w_ {i}} \ Theta \ left(\ hat {\ mathbf {n}} \ cdot \ hat {\ mathbf {m }} _ {i} \ right)\ right)。 $$(5)ここで、優先方向\(\ hat {\ mathbf {m}} _ {i} \)、つまり、表面エネルギー密度が最小になる方向は、相対的な深さとともに任意に設定できます。 α i 、γに関して 0 。パラメータ w i m の周りの\(\ gamma(\ hat {\ mathbf {n}})<\ gamma _ {0} \)の領域の拡張を制御します i 方向、つまり、それらは最小値の幅です(参照[38]も参照)。
Si結晶の特定の異方性を説明するために、最小エネルギー方向 m を設定します。 i 、〈001〉、〈113〉、〈110〉、〈111〉に対応します[45]。 α i 最小値の深さを決定する係数は、[39]
によって取得されます。 $$ \ alpha_ {i} =1- \ left(\ frac {\ gamma_ {i}} {\ gamma _ {\ langle 001 \ rangle}} \ right)\ left(1- \ alpha _ {\ langle 001 \ rangle} \ right)、$$(6)ここでα 〈001〉 =0.15が参照として設定され、さまざまなγ i 参考文献で報告されている前述の配向の表面エネルギー値に対応します。 [45]。一般性を失うことなく、γを設定します 0 =1。実際、異方性の最小値と強度の比率は、αによって制御できます。 i 式からの値。 (6)およびα 〈001〉 、γ 0 式の前因子の役割を果たします。 (2)したがって、進化の絶対的な時間スケールにのみ影響します。
式のエネルギー最小値の幅。 (5)は w に設定されています i w を除くすべての最小方向で=50 〈113〉 =100 [39]。このパラメータの定義によれば、鋭い角はウルフの形で予測されます。つまり、表面エネルギーの異方性は「強い」[38、42、46]。したがって、シミュレーションを実行するには、Willmoreの正則化が厳密に必要です。 β valueは、\(\ sqrt {\ beta} \)[37]に比例する半径を持つことが知られているコーナーの丸みを帯びた領域の拡張を設定します。シミュレーションを実行するために、βによるコーナーの丸めによって設定された長さスケール 数値解法の空間離散化の解像度よりも大きくなければなりません。ただし、大きすぎるβを使用すると、\(\ sqrt {\ beta} \)の順序で拡張されたWulff形状に存在する可能性のある小さなファセットが非表示になる可能性があることに注意してください。 値と、実際にウルフの形で存在する優先的な方向を含む小規模なファセット。この作業では、βを設定します =0.005。以下に指定するシミュレーションドメインのサイズに応じて、この値により、実行可能な空間離散化を採用できます。さらに、式に入るすべての優先方向。 (5)と(6)を再現。一方、角の丸みが伸びているため、0.07以下の縮尺の可能性のあるファセットは再現できません。
初期の形態とシミュレーションの設定
このセクションで定義されたフェーズフィールドモデルによって形態学的進化を調査するために、φの適切な初期条件 設定する必要があります。ここでは、(001)平面に刻まれた滑らかなピットジオメトリを検討します。参照フレームは\(\ hat {\ mathbf {x}} =\、[\!100] \)、\(\ hat {\ mathbf {y}} =\、[\!010] \)、および\(\ hat {\ mathbf {z}} =\、[\!001] \)。特に、半径 L の円形(001)面を考えます。 高さ h 0 − H 、高さ h で周囲の(001)平面にスムーズに接続されています 0 。このような形状は、φの初期条件として設定されます。 式を利用することによって。 (4) d を使用 ( r )表面からの符号付き距離Γ ( x 、 y )
によって定義されます $$ \ Gamma(x、y)=\ left \ {\ begin {aligned} h_ {0}-&H&\ qquad r \ leq L \\ h_ {0}-&H \ exp \ left [-\ frac {1} {2} \ frac {| \ mathbf {s}-\ bar {\ mathbf {s}} | ^ {2}} {\ sigma ^ {2}} \ right]&\ qquad r> L \ end {整列} \ right。 $$(7)\(r =\ sqrt {x ^ {2} + y ^ {2}} \)と
$$ \ mathbf {s} =(x、y)、\ qquad \ bar {\ mathbf {s}} =\ frac {R} {r}(x、y)。 $$(8)R = H / 4 L はアスペクト比パラメータとして定義され、σ は、ピットの底とそれを囲む平坦な領域との間の連続接続の延長を制御するパラメータです。このパラメータはここでσに設定されます = L / 2。
図1では、φに採用された初期条件 が示されています。図1aはΓを示しています ( x 、0) R の値が異なるプロファイル 。図1bは、φの定義を示しています。 式によって。 (4)3D平行六面体ドメイン。特に、このパネルは、ドメイン全体の中心を通過する断面を示しています。左の部分は、固相に対応する領域、つまりφが存在する領域を示しています。> 0.5、初期のピット形態に対応する表面を明らかにします。右の部分はφの値を示しています 3Dドメイン全体、つまりバルクフェーズとそれらの間の連続遷移内。

フェーズフィールドモデルの初期条件。固体膜の(001)表面の滑らかなピットに似ています。 a Γ ( x 、0)式からのプロファイル。 (7)異なる R に対して取得 値。 b φの定義 数値シミュレーションに採用された3D領域で。これは、式(1)から得られます。 (4) d を使用 ( r )Γからの符号付き距離 ( x 、 y ) R を使用 =0.5。左側は、φの固相です。> 0.5が表示されます。右側は、φを示すカラーマップです。 3Dドメインで報告されます
数値シミュレーションは、方程式を統合するために実行されます。 (2)と(3)。これらは、有限要素法(FEM)ツールボックスAMDiS [47、48]を使用して実行され、半陰的積分スキームとインターフェースでのメッシュ細分化[33、38、49]が使用されます。周期境界条件は、\(\ hat {\ mathbf {x}} \)および\(\ hat {\ mathbf {y}} \)方向に沿って設定されます。フラックスなし(ノイマン)境界条件は、\(\ hat {\ mathbf {z}} \)方向に沿ってシミュレーションドメインの上部と下部に設定されます。進化の時間スケールは、係数1 / D でスケーリングされます。 、セット D に対応します =1。以下では、シミュレーションの時間を任意の単位で参照します。ピットのサイズは任意に L に設定されます =1、インターフェースの厚さはεに設定されています =0.2。
結果と考察
Si(001)ピットの平滑化
このセクションでは、ピットパターン化されたSi(001)基板の進化中の形態変化に関する結果を示します。上記のモデルでは、「異方性表面エネルギー」セクションのように異方性表面エネルギーを定義することにより、シリコンの特定のケースを説明できます。システムが連続体アプローチ(\(\ gtrsim 10 \)nm)[32]を採用するのに十分な大きさであり、形状を次のようにパラメータ化できる場合、次の結果は、あらゆるサイズの定性的な観点から有効であると予想されます。アスペクト比 R 図1aと同様。 L を設定することにより、実際の長さのスケールを考慮することができます。 対応する実単位のパラメータ L r 。次に、 D の実数値を考慮して、リアルタイムスケールを記述できます。 およびγ 0 L を掛けます r 長さ、つまり L によるスケーリング r / L L で 上記で指定された単一。
まず、進化の最初の段階に焦点を当てましょう。式で設定された初期条件。 (7)は、表面の優先配向を示さないプロファイルで構成されます。異方性表面エネルギーの減少によって引き起こされる表面拡散による進化を考慮すると、初期プロファイルのファセットが予想されます。これを図2に示します。ここでは、 R を使用した2つのプロファイルのファセットが示されています。 =図2aおよび R の0.25 図2bの=0.5が報告されています。カラースケールは、表面の値\(\ gamma(\ hat {\ mathbf {n}})\)を示します。これにより、ファセットを、式(1)の最小値に対応するほぼ均一な表面エネルギー密度を持つ領域として識別できます。 (5)、\(\ gamma(\ hat {\ mathbf {n}})\)の値が高いローカライズされた領域に囲まれています。ピットの初期アスペクト比に応じて、さまざまなファセットが形成されます。小さいRの場合、下部の(001)ファセットは、正方形の形状を想定して維持されます。ピットのエッジは、小さな三角形の{110}ファセットで接続された4つの{113}ファセットで囲まれています。アスペクト比が大きいほど、 R を考慮すると、ファセット面が大きくなります。 =0.5、(001)面に対してより高い勾配を持つ優先配向の出現を可能にします。特に、初期形状は、底部と平坦な領域に近い2つの{113}ファセットの間に形成される{111}ファセットの存在を可能にします。その間に、幅の広い{110}ファセットが形成されます。
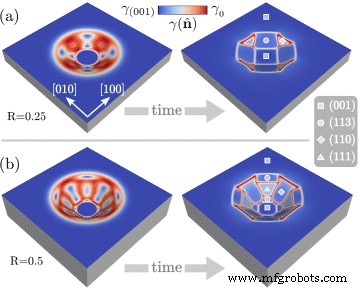
表面拡散と\(\ gamma(\ hat {\ mathbf {n}})\)に従って、「初期形態とシミュレーションのセットアップ」セクションで定義された初期プロファイルのファセットは、Siの表面エネルギーを再現します。 2つの異なる初期形態が考慮されます: a R =0.25および b R =0.5。ファセット形態では、ファセットのファミリーを識別するために記号が採用されています。カラースケールは、表面の\(\ gamma(\ hat {\ mathbf {n}})\)の値を示します
図2に報告された結果は、アスペクト比に従って、または一般に初期形態に従って、ファセットピットの形態を予測する可能性を示しています。ここで、平衡までの形態学的進化を検査する長い時間スケールのダイナミクスも調査します[38]。これを図3に示します。ここでは、これまでに検討した最も深いピット、つまり R に焦点を当てています。 =0.5であり、主な形態変化が示されています。特に、進化の過程で得られたさまざまな形態の斜視図と上面図が、それぞれ図3 a、bに報告されています。このシミュレーションの最初の段階では、最も急な{111}ファセットの消失と隣接する{113}ファセットの拡大を観察します。次に、後者がマージされ、{110}ファセットの縮小が始まります。これらは、三角形の形状をとった後、後の段階で消え、上面からピットに正方形の輪郭を与えることがわかります。また、{113}ファセットは最終的に消滅し、グローバルな平坦化が達成されます。このシミュレーションで得られたリアルタイムスケールは、文献のデータを使用して推定できます。特に、 D を考慮することができます アレニウスの法則により、参考文献からの前因子と活性化エネルギーを使用して決定されます。 [50]、熱ゆらぎも考慮されます。 γ 0 \(\ gamma(\ hat {\ mathbf {n}})\ sim 8.7 \)eV / nm 2 を持つように設定されています とき\(\ hat {\ mathbf {n}} =(001)\)[51]式から(5)、つまり、γ 0 =10.2 eV / nm 2 。他の材料に依存する表面拡散係数[28]、つまり表面での原子の体積と密度は、Siの場合を再現するように設定されています。これらの値によると、 L の高温T〜1100〜1200°Cでのプロセス全体の予想所要時間 r 数十ナノメートルは数時間のオーダーです。
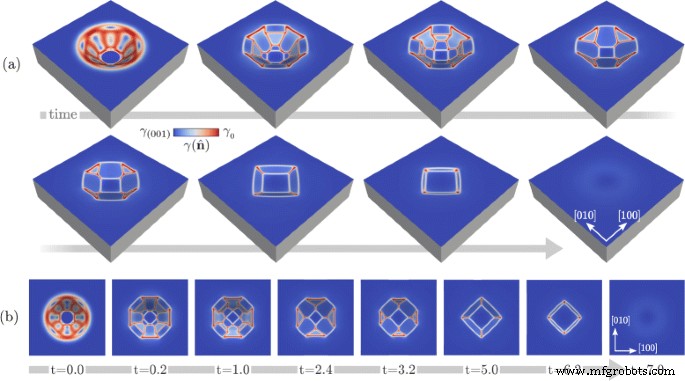
図2bのような初期形態を持つSiピットの平衡に向けた進化。 a 主な形態変化を示す斜視図。 b パネル a の形態の上面図 。パネル b で報告された時間 任意の単位で表されます。カラースケールは、表面の\(\ gamma(\ hat {\ mathbf {n}})\)の値を示します
進化の間に発生する特定の形態学的変化に加えて、2つの主要な特徴に注意する必要があります。第一に、進化は表面の予想される全体的な平坦化につながり、これは急なファセットが徐々に消えて浅いファセットに置き換わることで発生します。この振る舞いは、エネルギー最小化とアスペクト比の低下についての議論だけで推測できますが、ここでは、類似したファセットの存在を扱い、相対的なサイズが異なる完全な進化が提供されていることを指摘する価値があります。これは、進化の間に得られた形態が非平衡構成に対応し、グローバルなエネルギー最小値への経路を定義するという事実と一致しています。次に、予想されるファセットとそのエネルギーがわかっているにもかかわらず、進化の特定の時点での特定の形態は、グローバルなエネルギー最小化を考慮するだけでなく、ダイナミクスを考慮することによってのみ説明できます[38]。
図3に報告された結果が示す2つ目の重要なポイントは、中間段階についてです。進化中の形状が、 R で取得された初期プロファイルと同様の深さのジオメトリに近づくとき =0.25、つまり t で 〜3.2では、エネルギー最小化によって誘発される形態は、深さが大幅に異なる(この場合は2倍)初期構成から開始した場合でも、図2bで報告されているものと非常によく似ています。これは、最初の形態の最初の速いファセットの後に到達する、最終的な平坦化に向けた共通の速度論的経路の存在を示唆している。この議論は実際に確認され、図4のプロットにさらに示されています。ここでは、 R のピットを検討するときに、最初のファセット後の進化中の単調なエネルギー減衰が報告されます。 図1aのように、0.1、0.25、0.5、および0.75に等しい。図4aでは、任意の単位で表された時間スケールが考慮されています。図4bでは、同じエネルギー変化が時間スケールの適切なシフトで報告されており、構造の同様のアスペクト比に近づくと同様のエネルギー減衰が強調されています。 \(t ^ {*} _ {R} \)は、平面が得られる時間、つまり、図に示すようにシミュレーションごとに異なるグローバルエネルギー最小値に達する時間として定義されます。 4a。このプロットに示されているように、 R のエネルギー減衰はほぼ重なり合っています。 ≤0.5。 R を考慮した場合にのみ、ごくわずかな違いが見られます。 =0.75、そのエネルギー減衰の結果はまだ他の曲線に非常に近く、\(t \ gtrsim 5.0 \)の違いは基本的になくなります。初期構成からの大きな逸脱、つまり R の場合は、言及する価値があります。 ≫1、このような形状は、時間スケールと形態に異なる影響を与えることで、異なる方法で進化する可能性があります[52、53]。さらに、トポロジーの変化は、極端な場合、たとえば非常に深い海溝で発生することが知られており、平坦な(001)表面で全体的な平衡に達する可能性を妨げます[34、39、54]。

ピット形状の進化中にエネルギーが減少します。 a F ( t )進化の最終段階として得られた平坦な(001)表面のエネルギーによって正規化されます。異なる R を持つシミュレーションから得られたエネルギー減衰 初期プロファイル、つまり R から =0.1から R =0.75、が表示されます。時間は任意の単位で表されます。 b パネル a のような曲線 \(t_ {R} ^ {*} \)に一致するようにシフトされます。つまり、 R に応じてピットのグローバルな平坦化が達成される時間です。
これらのセクションで報告されたシミュレーションで得られた形状は、特に処理に熱力学的極限に近い条件が含まれる場合に、実験で観察されることが期待されます。図3で報告されている形態のいくつかは、実際にはピットパターン化されたSi(001)基板の輪郭に対応しています。たとえば、 t での図3のように、狭い{113}ファセットで囲まれた広い(001)表面でできた形態。 アスペクト比が0.05 < R のピットパターン化Si(001)基板を検討すると、約5.0が観察されます。 参照のように<0.1。 [10、30]。また、図3のシミュレーションの前述の段階でのファセットの相対的な拡張は、これらの実験作業で報告されたものと非常に似ています。シミュレーションと実験の間のこの一致は、ここで採用された表面拡散の理論的記述をさらに評価します。ただし、プロセスの一般的な機能に焦点を当てており、特定の実験とのより詳細な比較は、現在の作業の目的から外れています。
Geの異常成長による形状変化の模倣
冒頭で述べたように、ピットパターン化されたSiテンプレートの主な用途の1つは、自己組織化された島の成長の制御です[55]。これは、GeまたはSi 1 − c の配置を検討する場合に特に当てはまります。 Ge c Si(001)基板上の島[6]。前のセクションで採用した方法論を使用すると、表面エネルギーの特有の特徴に関連する形態学的変化を調べることができます。したがって、Siピットの実際の形態に似た適切な初期構成から開始し、別の材料を堆積するときに予想される表面エネルギー密度の違いを考慮することで、形態変化への対応する寄与を予測できます。
ケーススタディは、アスペクト比が0.1に近いSi(001)ピットパターン基板上でのGeの過成長で構成されています。 t での図3のプロファイル =5.0は初期形態と見なされます。次に、〈105〉方向に沿った最小値も含む表面エネルギーを設定します。この\(\ gamma(\ hat {\ mathbf {n}})\)の定義は、Ge / Si(001)システムで最も人気のある小さな傾斜の方向の存在を模倣しています[56–58]。 {105}ファセットの高い安定性は、表面再構成と、エピ層と基板の間の格子不整合に関連するひずみ効果との相互作用によるものです[59–61]。式(1)で使用する必要のある表面エネルギー密度の値。 (6)は参考文献から取られています。 [58]厚いGe層の限界で。 {1 1 10}など、(001)に近い表面エネルギーを持つ他のファセットはここでは無視されていることに注意してください。 〈105〉方向と[001]方向の角度が非常に小さいため、 w i 式(1)のエネルギー最小値を適切に記述するには、以前に採用されたものよりも大きいパラメーターが必要です。 (5)[38]。特に、 w を設定します {105} = w {001} =500。
図5では、\(\ gamma(\ hat {\ mathbf {n}})\)の新しい定義による表面拡散による進化が報告されています。図5aは、 z を拡大した表面の形態変化を示しています。 -軸は5倍です。最初の段階では、初期プロファイルに存在する{113}ファセットの間に{105}ファセットが形成されます。図5bにも示されているように、〈105〉方向のエネルギーは最小であるため、対応するファセットは伸び、{113}ファセットは縮みます。後の段階では、{105}ファセットで囲まれたピットは、下部に(001)面が残った状態でのみ形成されます。図5bのような上面図から、形態の変化により、ピットの輪郭が45°回転します。これは、実験でのSiパターン基板へのGeの堆積中[41]、または欠陥や不純物によるピットの自発的成長中[40]に実際に観察されます。 {105}ファセットの形成は、Geドットのさらなる成長のためのお気に入りの核形成サイトとしても機能することがわかっています[30]。図5に示されている進化は、ピットの輪郭の回転につながる形状の変化が、表面エネルギーの減少によってのみ達成できることを示しています。これは、熱力学的駆動力が表面の寄与によって支配される場合、つまり、Geの量が少ない場合の、平衡に近い状態での実際の状況であると予想されます。実際、プロセスを完全に説明するには、弾性効果、混合、および固相の成長を含める必要があります[32]。実験ではさらに浅いSiピットが採用されており、{11 n に沿って法線を持つファセットが示されていることにも言及する価値があります。 }方向、5 < n <10 [41](つまり、{1 1 10}ファセット)。これらのファセットで囲まれたピットジオメトリは、(001)平面に対してわずかに小さい勾配で、図4の初期構成として採用されたものに対応するため、同様の進化につながります。

t での図3のプロファイルの展開 =5.0、<105>方向を含む表面エネルギーの定義。 a {105}ファセットのみで囲まれたピットの形成に向けた進化の代表的な段階での表面プロファイル。 z -軸は5倍に拡大されます。 b 表面の\(\ gamma(\ hat {\ mathbf {n}})\)値を示す上面図。パネルの第2段階と最終段階 a 上部と下部にそれぞれ報告されます。図2のような記号は、ファセットのさまざまなファミリを識別するために採用されています
結論
この作業では、表面拡散に基づく連続体モデルを使用して、Si(001)基板に掘削されたピットの時間的進化を調査しました。よく知られているSiWulffの形状に基づくパラメータ化により、(強い)表面エネルギー異方性に適切に取り組むことにより、異なる材料の堆積が新しい安定ファセットを導入する場合を含め、実験と一致する典型的な準安定構成を予測しました。ピットの全体的な平坦化に向けた全体的な進化が示され、異なる初期深さのピットを検討する場合にも同じ速度論的経路をたどることがわかります。このモデルは、例として分析したものから大きく逸脱した初期構成についても予測できると考えています。結果として、現在のアプローチは、まだ未踏のピット形状に基づいて実験を設計するのに役立つ可能性があります。さらに、このモデルは一般的であり、表面エネルギーを再パラメータ化することで、さまざまな基板に簡単に適合させることができます。
ナノマテリアル



