青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
要約
8期間のIn 0.2 の機能 Ga 0.8 青色発光ダイオード(LED)の成長シーケンスの最初の2〜5個の量子障壁(QB)にシリコン(Si)をドープしたN / GaN量子井戸(QW)を調べます。 QWの構造のエピレイヤーは、20ペアのIn 0.02 で成長します。 Ga 0.98 低圧有機金属化学蒸着(LP-MOCVD)システムによるパターン化サファイア基板(PSS)上のストレインリリーフ層(SRL)として機能するN / GaN超格子。温度依存フォトルミネッセンス(PL)スペクトル、電流対電圧( I - V )曲線、光出力電力対注入電流( L -私 )曲線、およびエピ層の高分解能透過型電子顕微鏡(HRTEM)の画像が測定されます。結果は、4つのSiドープQBを備えたQWは、より大きなキャリア局在化エネルギー(41 meV)、より低いターンオン(3.27 V)およびブレークダウン(-6.77 V)電圧、およびより高い注入での青色LEDの光のより高い出力電力を有することを示しています他のサンプルよりも電流。 4 SiドープQBサンプルのQBのバリア高さが低いと、QWのソフト閉じ込め電位が発生し、ダイオードのターンオン電圧とブレークダウン電圧が低くなります。 HRTEM画像は、このサンプルがQWの比較的拡散性のインターフェースを持っているという証拠を示しています。 8つのQW間でのキャリアの均一な拡散と、各ウェルでのキャリアの優れた局在化が、光出力パワーの向上、特に4SiドープQBサンプルでの高い注入電流の原因となっています。結果は、8つのIn 0.2 の4つのQBを示しています。 Ga 0.8 Siドーピングを施したN / GaN QWは、量子閉じ込めシュタルク効果(QCSE)を低減するだけでなく、QW内のキャリアの分布と局在化を改善して、青色LEDの光学性能を向上させます。
背景
GaN量子障壁(QB)へのシリコン(Si)ドーピングは、分極場のクーロンスクリーニングを引き起こし、InGaN / GaN量子井戸(QW)における量子閉じ込めシュタルク効果(QCSE)の抑制を引き起こす可能性があります。 InGaN / GaN QWにおける励起子の放射再結合は、SiドープQBを介して大幅に強化できます[1,2,3,4]。インジウム(In)とスピノーダル相分離の組成変動は、GaNとInNの固有の固相混和性ギャップのために、三元合金InGaNで発生します。 Inリッチクラスターの形成は、強力なキャリア局在化として機能し、非放射再結合中心(NRC)のトラップを防ぎ、InGaN / GaN QWでの励起子の放射再結合を促進します[5、6、7、8、9、10]。 InGaN / GaN QWのインジウム組成の変動は、デバイスの動作、たとえば、内部量子効率(IQE)、外部量子効率(EQE)、および電流-電圧特性に大きな影響を与えます。デバイスの性能をよりよく説明するには、InGaN / GaNQWのインジウム変動を考慮に入れる必要があります[11]。 SiドープQBを備えたInGaN / GaN QWは、QW層のスパイラル成長[12]、InGaN / GaN QWの熱安定性の促進[13]により、材料ナノ構造の変更とナノスケールアイランドの形成の特性を示しています。 QBのドーピング濃度が増加するにつれてLEDの光出力電力と静電放電(ESD)挙動が改善され[14]、正孔キャリア輸送が容易にブロックされ、p型GaN(p-GaN)間のウェルで励起子が再結合します。 )およびドープされたバリア[15]など。
青色LEDの高注入電流(数十mA以上)下での高輝度および高EQEに適したInGaN / GaN QWの周期と厚さが報告されています[16、17、18]。レポートでは、パターン化されたサファイア基板(PSS)上に成長したInGaN / GaN QWの9周期は、EQEの発光パワーと垂下特性の大幅な改善を示しています[16]。青色LEDの最高の光学的および電気的性能は、アクティブ領域が注入電流42 A / cm 2 で12周期のInGaN / GaNQWで構成されている場合に実証されます。 [17]。 InGaN / GaN LEDのシミュレーション結果では、QBの厚さが24.5nmから9.1nmに減少した場合に、EQEの垂下が明らかに減少し、IQEが向上することが示されています[18]。 InGaN / GaN QWの適切な厚さとQB数でのSiドーピングは、高注入電流で動作するInGaN青色LEDの輝度と効率をさらに高めるために重要です。このレポートでは、8周期のIn 0.2 の光学的、電気的、および材料特性を示します。 Ga 0.8 成長シーケンスの最初の2〜5個のQBを備えたN / GaN QWは、青色LEDのSiドーピングを備えています。この結果は、キャリアの局在化、閉じ込めポテンシャル、および高注入電流下での青色LEDの発光挙動に関するQWのQCSEのメカニズムに関するより深い洞察を提供します。
実験方法
図1は、青色LEDサンプルの材料層構造の概略図を示しています。エピ層は、低圧有機金属化学蒸着(LP-MOCVD)システムの水平反応器によって(0001)配向(c面)PSS上に堆積されます。 PSSの通常のピラミッド構造の直径、高さ、間隔は、それぞれ2、1.5、1μmです。 PSSの厚さは3μmで、エピ層が成長する前に水素の雰囲気下で1150°Cに予熱されます。トリメチルガリウム(TMGa)、トリメチルインジウム(TMIn)、トリメチルアルミニウム(TMAl)、およびガス状NH 3 元素ガリウム(Ga)、In、アルミニウム(Al)、および窒素(N)の気相前駆体としてそれぞれ利用されます。シラン(SiH 4 )およびビス-シクロペンタジエニルマグネシウム(Cp 2 Mg)は、それぞれn型およびp型物質のドーパントSiおよびマグネシウム(Mg)の前駆体です。前駆体のキャリアガスは水素の混合物です(H 2 )および窒素(N 2 )化学的に非反応性の1:1の比率で。
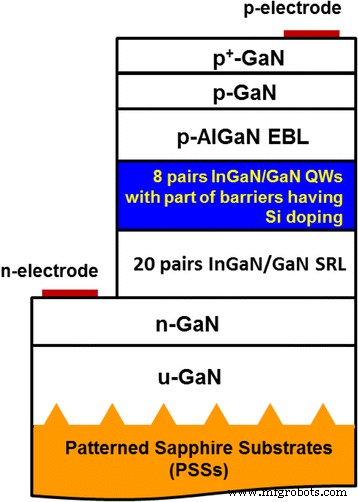
製造された青色LEDチップの層構造の概略図。エピタキシャル層の厚さのこれらの概略図は、明確にするために誇張されており、縮尺どおりではありません
ドープされていないGaN(u-GaN)バッファ層、次に厚さ3および3.3μmのSiドープされたn型GaN(n-GaN)がPSS上に成長します。 n-GaNのドーピング濃度は10 19 です。 cm -3 。 In 0.02 の20ペア Ga 0.98 続いて、厚さ2 / 2nmのN / GaN超格子がn-GaN上に堆積されます。これは、PSSのエピ層からのひずみの広がりを低減するために使用されるひずみ緩和層(SRL)の役割を果たします。
青色LEDのアクティブ層には、8周期のIn 0.2 が含まれています Ga 0.8 N / GaNQW。 QWとQBの厚さは2.5nmと8nmで、成長温度はそれぞれ750°Cと900°Cです。約3×10 17 の濃度のSiドーピング cm -3 成長シーケンスの最初の2つ、3つ、4つ、および5つのQBは、それぞれサンプルA、B、C、およびDと呼ばれます。 p型Al 0.16 Ga 0.84 N電子ブロッキング層(EBL)の厚さは20 nmで、Mgをドーピングして950°Cで成長します。 p-GaNウィンドウ層とp + -GaNコンタクト層は950°Cで厚さ100および20nmで成長し、ドーピング濃度は10 19 および10 20 cm -3 。
エピ層は、誘導結合プラズマ(ICP)システムによってn-GaN層に選択的にエッチングされ、メサ構造のLEDを形成します。インジウムスズ酸化物(ITO)の透明な接触層(TCL)がp + に堆積されます。 -電子ビーム蒸発器によるGaN表面。続いて、クロム/白金/金(Cr / Pt / Au)のマルチメタル接触電極層がp + に蒸着されます。 -良好なオーミック接触のためのGaNおよびn-GaN層。 LEDウェーハは、チップダイシングのために約120μmまでラップ仕上げおよび研磨されています。正方形のチップサイズが1mm 2 の標準的なメサタイプのLEDデバイス 生成されます。
電流対電圧( I - V )曲線と光出力電力( P out )対注入電流( L -私 )ダイオードの室温(RT)で20〜300mAの曲線が測定されます。 8周期のIn 0.2 の温度依存フォトルミネッセンス(PL)スペクトル Ga 0.8 N / GaNQWが調べられます。 PLの励起光源は、平均出力45 mWのHe-Cdレーザー(325 nm)です。高分解能透過型電子顕微鏡(HRTEM)画像は、EM-3000Fフィールドエミッション透過型電子顕微鏡(FE-TEM)から、加速電圧300 kV、分解能0.14nmで撮影されています。
結果と考察
図2は、10〜300Kのさまざまな温度でのサンプルのPLスペクトルをプロットしたものです。温度の上昇に伴うPLピーク強度の単調な減少を観察できます。これは、温度の上昇に伴う非放射再結合プロセスの上昇に起因します。すべてのPLスペクトルプロファイルは、図3に示すように、温度によるピーク最大エネルギーの変化を見つけるためにガウス線形関数によって適合されます。ドープされていないIn 0.2 のPLの発光ピーク最大エネルギー Ga 0.8 N / GaN QWは、室温で2.68eVです。これは、Siをドープした最初の2〜5個のQBを持つサンプルのPLピークエネルギーが、ドープされていないものと比較した場合に青方偏移を示すことを意味します。 Siドーピングを使用した最初の2〜5個のQBは、QWのQCSEを効果的に下げることができます。エピ層の構造にPSSとSRLを使用すると、In 0.2 のQCSEだけでなく、圧電(PZ)フィールドの部分を減らすことができることを指摘しておく必要があります。 Ga 0.8 N / GaNQW。

10〜300Kのさまざまな温度でのサンプルの温度依存PLスペクトル

サンプルの温度に対するPLピーク最大エネルギーの変動。 Varshni方程式を使用した最適な曲線は、太い黒の実線で示されています
図3には、すべてのサンプルのS字型曲線を示すPLピーク最大エネルギー対温度の変化を示すことができます。 S字型の曲線は、最初の赤、次に青、次に温度の上昇に伴う赤方偏移を示します。この振る舞いは、QWの強い局在励起子の温度依存性集団発光に起因します。以下に示すVarshniの実験式を使用して、S字型のバリエーションの青から赤へのシフトの範囲を適合させることができます[19、20、21]。
$$ {E} _ {\ mathrm {g}}(T)={E} _ {\ mathrm {g}}(0)-\ frac {\ alpha {T} ^ 2} {\ left(T- \ beta \ right)}-\ frac {\ sigma ^ 2} {k _ {\ mathrm {B}} T} $$(1)ここで E g (0)、α 、β 、およびσ はフィッティングパラメータです。 E g (0)は、絶対温度0KでのQWのバンドギャップエネルギーです。α およびβ は、材料に依存するパラメータである熱係数です。 σ はガウス広がりパラメータであり、バンドテール局在状態内のキャリアの熱分布の程度を物理的に反映します。式の第2項。 (1)は、半導体のバンドギャップエネルギーが温度の上昇とともに減少する傾向があることを示しており、原子振動の振幅の増加によるエネルギーギャップ収縮として知られています。第3項は、非縮退キャリア分布とガウスのような局所状態密度を仮定して、温度によるキャリア局在化の程度を特徴づけるために使用されます。強力なキャリア局在化は、電子と正孔の波動関数間の重なりが改善されるため、InGaNQWでの放射再結合とIQEの向上を実現する上で重要な側面です。 Varshniの式は、キャリア分布の強い縮退のため、低温でのPLピークエネルギーの赤方偏移の範囲には適用できません。サンプルの最適な結果は、図3の太い黒の実線の曲線で示されています。サンプルA、B、C、およびDの局在化エネルギーは、それぞれ24、28、41、および13meVです。サンプルCは、最大の局在化エネルギーσを持っています。 (41 meV)。 4つのSiドープQBを備えたQWでのキャリアの局在化は、他のQBよりも強力です。最小の局在化エネルギー(σ )値13meVのサンプルDで発生します。
電流-電圧( I - V )青色LEDの順方向および逆方向バイアス下での特性を図4に示します。この図では、サンプルA、B、C、およびDのターンオン電圧は順方向電流で3.41、3.47、3.27、および4.03Vです。それぞれ20mA。サンプルA、B、C、およびDの絶縁破壊電圧は、逆電流1μAでそれぞれ-8.85、-9.99、-6.77、および-11.55Vです。サンプルCのターンオン電圧とブレークダウン電圧は最小です。サンプルDのターンオン電圧とブレークダウン電圧は最大です。したがって、サンプルCではQBのバリア高さを低くすることが提案されています。最初の4つのQBにSiをドープしたサンプルでは、QWのソフト(滑らかな)閉じ込め電位が予想されます。ソフト閉じ込めポテンシャルプロファイルは、QWの伝導帯と価電子帯のオフセットが鋭いステップ関数として受け取られないことを意味します。つまり、長方形の閉じ込めポテンシャルではありません。滑らかな閉じ込め電位は、オージェ再結合を大幅に抑制し、InGaN / GaNQWの注入方向の最初のいくつかのウェルに十分なキャリアが蓄積するのを防ぐことができます[22、23、24]。滑らかな閉じ込め電位は、InGaN / GaNQWの成長方向に沿ってIn組成を直線的に減少させることによっても作成できます。これにより、QW間でのキャリアの拡散とホールの輸送が改善され、EQEと光出力電力の急速な低下が改善されます[25、26、27、28、29、30]。
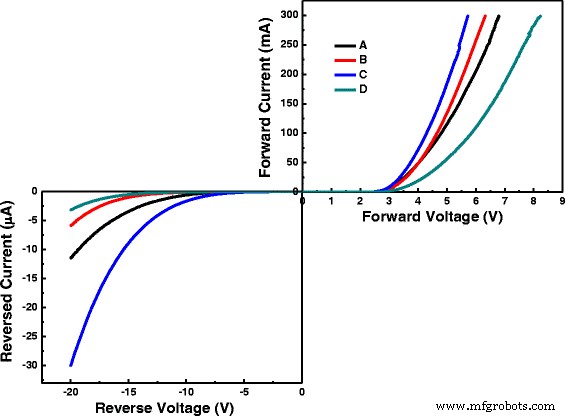
電流-電圧( I - V )ダイオードの順方向および逆方向バイアス下での曲線
図5は、光出力電力( P )の測定値を示しています。 out )LEDの注入電流( L -私 )チップテスターで0〜300mAにカーブします。 P の増加 out L の注入電流の上昇に伴い -私 曲線を観察することができます。最高と最低の P out 高注入電流の場合は、それぞれサンプルCとDに示されています。 P の飽和 out 注入電流で300mAは、サンプルCを除くすべてのサンプルで示されています。 P の飽和効果 out QWをオーバーフローする電流を指します。 QWをオーバーフローする電流が少ないのは、QWのソフト閉じ込め電位と、QWサンプル内の強力なキャリア局在化です。 Siドーピングを含む4つのQBを使用したサンプルでは、8つのQW間でのキャリアのより良い拡散と、QW内でのキャリアの強力な放射再結合が示されています。

光出力電力( P out )対注入電流( L -私 )0〜300mAのダイオードの曲線
サンプルの断面高分解能透過型電子顕微鏡(HRTEM)の暗視野、明視野、および拡大明視野画像を図1および2に示します。 6、7、および8。図6では、明るいコントラストと暗いコントラストがInGaNおよびGaNエピ層に対応しています。 8周期のQWと20対の超格子を観察できます。図7では、暗いコントラストの変化は、QWにおける局所的なIn含有量の変動とインジウムに富むクラスターの形成を表しています[31、32、33、34]。インジウムに富むクラスターは、キャリアの比較的深い局在状態として機能し、高い放射励起子再結合をもたらします。これらのインジウムに富むクラスターの周囲に格子歪みと積層欠陥欠陥が見られます。これは、図8aの赤い四角の拡大写真に示すように、InGaN層でひずみエネルギーが部分的に緩和されたことを示しています。拡大された明視野画像と比較すると、図8c、dに示すように、サンプルCおよびDのQWのより拡散的な(急激ではない)インターフェースが見られます。このエージェントは、ウェル/バリア界面でのIn原子とGa原子のよく知られた相互拡散に由来します。 QWの非常に弱い閉じ込めとキャリアの局在化がサンプルDで発生しました。これは、このサンプルの最悪のオプトエレクトロニクス挙動と一致しています。画像では、すべてのサンプルで貫通転位(TD)が形成されているわけではありません。 NRCは主にTDサイトで発生します。これらのサンプルでは、PSSとSRLを使用しているため、予想どおり、エピレイヤーの品質が向上しています[35、36、37]。 8周期QWにSiをドープした4つのQBは、閉じ込め電位を変更してInGaN / GaN QWのソフト閉じ込めポテンシャルを実現し、青色LEDの最高のオプトエレクトロニクス性能を実現するための好ましい条件です。
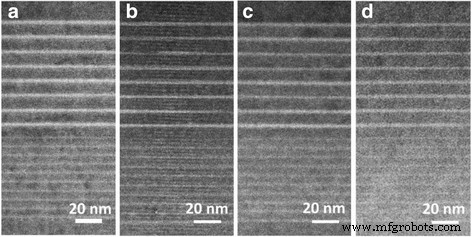
サンプルの暗視野画像。 a サンプルA。 b サンプルB。 c サンプルC。 d サンプルD
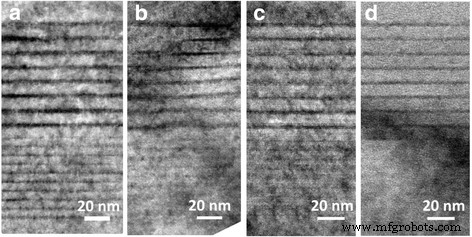
サンプルの明視野画像。 a サンプルA。 b サンプルB。 c サンプルC。 d サンプルD
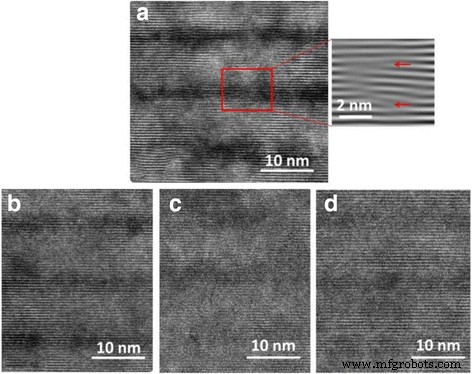
サンプルの拡大明視野画像。 a サンプルA。 b サンプルB。 c サンプルC。 d サンプルD
結論
温度依存のPLスペクトル、 I - V 曲線、 L -私 曲線、および8周期のIn 0.2 の青色LEDのHRTEM画像 Ga 0.8 Siドーピングを含む堆積シーケンスの最初の2〜5個のQBを持つN / GaNQWを調査しました。結果は、Siドーピングを含む最初の4つのQBを含むサンプルは、HRTEM画像のQWの拡散界面によって証明されるように、バリアの高さが比較的低く、キャリアの局在化エネルギーが大きいことを示しています。 QW内のより強いキャリア局在化を伴うQWのソフト閉じ込めポテンシャルは、このサンプルの8つのQW間でのキャリアのより均一な分布と、QW内のキャリアのより高い放射再結合をもたらします。オージェプロセスの減少とキャリアのリーク、およびQWの放射再結合の増加は、高注入電流下で4つのSiドープQBを備えた青色LEDで発生しました。結果は、In 0.2 の発光特性に対するキャリア局在化、閉じ込めポテンシャル、PZフィールド、および材料ナノ構造の影響の分析を通じて、Siドーピングを使用したQBの最適条件を提供します。 Ga 0.8 青色LEDのN / GaNQW。
略語
- Al:
-
アルミニウム
- Cp 2 Mg:
-
ビス-シクロペンタジエニルマグネシウム
- EBL:
-
電子遮断層
- EQE:
-
外部量子効率
- FE-TEM:
-
電界放出透過型電子顕微鏡
- Ga:
-
ガリウム
- HRTEM:
-
高分解能透過型電子顕微鏡
- ICP:
-
誘導結合プラズマ
- In:
-
インジウム
- IQE:
-
内部量子効率
- ITO:
-
インジウムスズ酸化物
- I - V :
-
電流対電圧
- L -私 :
-
光出力電力対注入電流
- LP-MOCVD:
-
低圧有機金属化学蒸着
- Mg:
-
マグネシウム
- N:
-
窒素
- n-GaN:
-
n型GaN
- NRC:
-
非放射再結合センター
- PL:
-
フォトルミネッセンス
- PSS:
-
パターン化されたサファイア基板
- PZ:
-
圧電
- QB:
-
量子障壁
- QCSE:
-
量子閉じ込めシュタルク効果
- QW:
-
量子井戸
- RT:
-
室温
- Si:
-
シリコン
- SiH 4 :
-
シラン
- SRL:
-
ストレインリリーフレイヤー
- TCL:
-
透明な接触層
- TMAl:
-
トリメチルアルミニウム
- TMGa:
-
トリメチルガリウム
- TMIn:
-
トリメチルインジウム
- u-GaN:
-
ドープされていないGaN
ナノマテリアル
- 5GおよびGaN:LDMOSからGaNへの移行
- 構造的および光学的性質を改善するためのH2 / NH3混合ガス中のGaNベースの多重量子井戸の原子転位
- AlGaN / GaNHEMTの表面電位と2DEGに及ぼす表面状態とアルミニウムモル分率の影響
- 半極性InxGa1-xN / GaN多重量子井戸を備えた紫外線GaNベースのフォトニック準結晶ナノピラミッド構造からの多色発光
- サファイア上に成長させたエピタキシャルn型ドープGaN層の赤外反射率分析
- アニーリングされたGaAsBi / AlAs量子井戸のビスマス量子ドット
- ビアホール長の変調による、通常はオフのGaNHEMTの制限されたマルチメサチャネル幅の突破
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解
- 堆積後エッチングを用いたディップドロップ法を使用した周期的ポリスチレンナノスフェアアレイの調製とInGaN / GaNLEDの光抽出効率を改善するその応用
- グラフェン量子ドットで装飾されたZnOナノロッド/ GaN膜アイソタイプヘテロ接合に基づく高性能紫外線光検出器



