MBEによりSi(111)上に成長させたナノウォールネットワーク、ナノカラム、コンパクト膜間のGaNの構造シフト
要約
GaNナノウォールネットワーク、ナノカラム、およびコンパクトフィルムの構造シフトは、プラズマ支援分子線エピタキシー(MBE)によってSi(111)上で正常に取得されました。予想通り、裸のSi上でNリッチ条件でGaNナノカラムの成長が観察され、Gaフラックスが改善されると成長はコンパクトフィルムにシフトしました。興味深いことに、GaNの成長前に40秒間のアルミニウム(Al)の事前堆積が実行された場合、GaNはナノウォールネットワークの形で成長します。結果は、事前に堆積されたAlが、それぞれ〜80および〜6.7nmの典型的な直径と高さの液滴の形で存在することを示しています。ナノウォールネットワークの成長モデルを提案し、成長メカニズムについて説明します。 GaNは、Al液滴のない領域で成長しますが、Al液滴の上の成長は妨げられ、その結果、ナノデバイス製造の障害を取り除く連続的なGaNナノウォールネットワークが形成されます。
背景
直接ワイドバンドギャップ半導体として、GaNおよび関連化合物は、発光ダイオード[1,2,3]、レーザーダイオード[4]、および高電子移動度トランジスタ[5、6]で大きな成功を収めています。ただし、サファイア、炭化ケイ素、または単結晶シリコン上のGaN膜のヘテロエピタキシーは、高密度の転位を引き起こします。それらのナノ構造は、転位や歪みがなく、表面積対体積比が大きいため、優れた性能を発揮すると考えられています[7、8]。 GaNナノカラムとナノワイヤーの研究は集中的に行われてきました[9、10、11、12]。 GaNナノカラム核形成はVolmer-Weber成長メカニズムによって自発的に発生します[13]が、窒素リッチ(Nリッチ)条件は核形成サイトが合体するのを防ぎます。 GaNナノワイヤまたはナノカラム上での電気デバイスの製造に多くの注意が払われてきました。 GaNナノワイヤはSiO 2 上に機械的に分散されました 個々のナノワイヤの両側にランダムに形成された/ Si基板とオーミック接触[14]。別のケース[15]では、ナノワイヤの片側を負極に接続されたステージに固定し、もう一方の側を走査型電子顕微鏡(SEM)によって正極に位置合わせして、科学研究用の電気デバイスを形成しました。
>あるいは、特別なナノ構造、すなわち面内導電性であるGaNナノウォールネットワークは、ナノデバイスの製造に複雑なプロセスが必要ないため、有望です。 2007年に、GaNナノウォールネットワークの成長は、マスクとして電子ビームリソグラフィーによってパターン化されたTi層を使用してKishinoのグループによって得られました[16]。数年前、サファイアとシリコン基板上でリソグラフィなしのGaNナノウォールネットワークの成長が成功裏に得られました[17、18、19]。 GaNナノウォールネットワークのバンドエッジ発光強度はGaNナノカラムと同様であり、黄色の発光は明らかではなく、GaNナノウォールネットワークの高品質を示しています。ナノカラムなどの分離されたナノ構造とは異なり、ナノウォールネットワークは面内導電性であり[18、20、21]、フィルムと同じくらい簡単にナノデバイスに製造することができます[22]。したがって、分離されたナノカラム上でのデバイス製造の障害は、ナノウォールネットワークの面内電気伝導によって取り除くことができます。ナノウォールネットワークの成長メカニズムを研究することは非常に重要です。転位によるナノウォールネットワークの自発的形成は、裸の c でのGaNナノウォールネットワークの成長メカニズムと見なされています。 -プレーンサファイア[23]。転位によるナノウォールネットワークの形成は制御が難しいため、Alバッファ層を備えたSi(111)基板上でのナノウォールネットワークの成長が行われています[18]。 Si(111)上のナノウォールの成長メカニズムは、裸のサファイア基板上のそれとは大きく異なります。ただし、Si(111)の成長メカニズムがナノウォールネットワークの成長の鍵であるにもかかわらず、研究は行われていません。
この研究では、ナノウォールネットワーク、ナノカラム、コンパクトフィルムなどのさまざまな構造でのGaNの成長を体系的に研究しています。上記のさまざまなGaN構造は、プラズマ支援分子線エピタキシー(MBE)を使用してSi(111)上に成長しました。結果は、Ga / N比を調整し、事前に堆積したAl液滴を追加することにより、GaN成長の構造シフトを達成できることを示しています。 GaNナノウォールネットワークの形態とフォトルミネッセンスは、電界放出型走査電子顕微鏡(FESEM)と、励起源としてHe-Cdレーザー(325 nm、200 mW)を使用したフォトルミネッセンススペクトラムアナライザーによって測定されました。原子間力顕微鏡(AFM)は、事前に堆積されたAl層の特性評価に利用されました。金属Al液滴を有するSi(111)上のGaNナノウォールネットワークの成長メカニズムが提案されています。
実験的
GaN構造は、N 2 を備えたRiber32 MBEシステムによってSi(111)基板上に成長しました。 RFプラズマ源(Veeco、RFS-N / TH)。成長チャンバーの圧力は3.0×10 − 10 にポンプで送られました 成長前のトル。 N 2 この実験では、純度99.9999%のガス、Ga、Alを使用しました。抵抗率>5000ΩcmのSi(111)基板(ドーピングなし、片面研磨、380±20μm、Sigma-Aldrich提供)を標準のRCAプロセスで洗浄した後、HF:H 2に浸漬しました。 O =1:50で数秒間、Si基板の表面の酸化シリコン層を除去し、水素終端表面を形成します。
GaNナノカラムの成長のために、N 2 のシャッター プラズマとGaソースを同時に開き、裸のSi(111)を973Kで加熱しました。N 2 の出力と圧力 この作業のすべてのサンプルで使用されているプラズマ源は、400Wおよび4.2×10 − 5 に固定されています。 それぞれトル。 GaNナノウォールネットワークが成長する前に、直径が約80 nmのAl液滴が、973 Kに加熱された裸のSi(111)上に堆積されました。Alソースは1323Kに保たれました。Al液滴の事前堆積。その結果、GaNの核形成と成長が異なり、ナノウォールネットワークの成長につながりました。ナノウォールネットワークの成長のためのGaフラックスは、ナノカラムと同じでした(φ Ga =1.2×10 − 7 1169 KでのTorr)。 GaN膜の成長のために、Gaフラックスは5.3×10 − 7 に増加しました。 Nフラックスを一定に保ったままのTorr。
結果と考察
N 2 のシャッター時 プラズマとGaが同時に開かれ、GaN(S 1 )図1aに示すように、裸のSi(111)上にナノカラムの形で成長しました。 Gaフラックスは1.2×10 − 7 でした 表1に示すように、TorrとSi(111)基板は973 Kに保たれました。GaNナノカラムの直径は52〜125 nmの範囲で、長さは約460nmであることが観察されています。 SEM画像から数えたナノカラムの密度は〜10 7 です。 mm − 2 。明らかに、図1bで観察されたナノカラムのほとんどは、基板に垂直ではありませんが、約30°の角度で傾斜しています。ナノカラムの上面は滑らかで、Bertnessのレポート[9]と一致しています。 (0 0 01) c の付着係数により、ナノカラムは自発的に核形成してから伝播すると考えられています。 -平面が{1100} m の平面よりも高い -飛行機。拡散長 L 吸収されたGa原子の )ナノカラムの成長に不可欠です。式で説明されているように。 (1)、拡散長 L 平均ジャンプ距離に依存します a 、Ga ab 脱着エネルギー Q des 、および表面拡散ジャンプの活性化エネルギー Q d [13] 。
$$ L =\ sqrt {2} a \ \ exp \ left(\ frac {Q _ {\ mathrm {d} \ mathrm {es}}-{Q} _ {\ mathrm {d}}} {2 kT} \右)$$(1)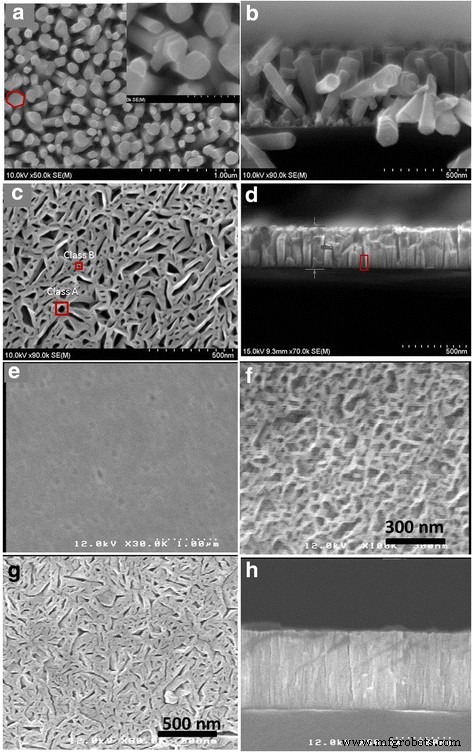
さまざまな条件で成長したサンプルのFESEM画像。 a 、 b GaNナノカラムに対応(サンプルS 1 )。 c 、 d GaNナノウォールネットワークに対応(サンプルS 2 )、 e コンパクトフィルムに対応(サンプルS 3 )、 f GaNナノウォールネットワークに対応(サンプルS 4 )成長の初期段階。 g 、 h 低温900Kで成長したGaNナノウォールネットワークに対応(サンプルS 5 )
原子的に平坦なナノカラム側壁は吸着サイトをほとんど提供しないため、Ga ab 拡散長 L m に -側壁の平面は、 c の平面よりもはるかに高くなっています -平面、結果としてGaNがナノカラムに垂直に成長します。この仮定が正しければ、Ga / N比が改善されると、強い成長率の異方性が変化します。確かに、GaN(S 3 )Gaフラックスが5.3×10 − 7 に増加すると、構造がナノカラムからコンパクトフィルムに変化しました(図1e)。 トル。したがって、ナノカラムまたはコンパクトフィルムの形でのGaNの成長は、Ш/ V比を調整することによって制御できます。
GaNナノカラムはフィルムよりも優れた性能を示しますが、分離されたナノカラムは電気接点の製造前に位置合わせする必要があるため、電気デバイスの製造は非常に困難です。したがって、面内導電性ナノ構造が好まれる。サンプルS 2 の成長用 、金属Alの事前堆積は、MBE成長チャンバー内で40秒間実行されました。次に、N 2 プラズマとGa源が同時に開かれた。 S 2 のGaフラックス 成長は、S 1 と同じ表1にまとめられています。 。図1cは、サンプルS 2。の上面FESEM画像を示しています。 GaNがAl / Si(111)上のナノウォールネットワークの形で成長することは非常に興味深いことです。直径50〜100 nmのナノウォールは重なり合って互いに絡み合い、面内の連続ネットワーク、つまりナノウォールネットワークを形成します。クラスAとクラスBという2つのクラスの穴が観察できます。クラスAとクラスBの穴の直径は、通常、それぞれ50〜100 nmと10〜49nmです。面内連続特性により、ナノウォールネットワークが面内導電性になり[18]、ナノデバイス製造の障害がある程度取り除かれます。ナノウォールの上面は比較的平坦であり、参考文献で報告されているファセット化されたGaNマトリックスとは異なります。 [13]。図1dの長方形で示されているように、上面画像に示されている穴が基板の近くまで伸びていることがわかります。
上記の穴がどのように生成されるのか不思議に思うかもしれません。サンプルS 5 を作成しました 900Kの低い成長温度で。他の成長パラメータはサンプルS 2 と同じです。 、表1に示すように、図1gから、サンプルS 5 また、小さな穴のあるナノウォールネットワークの形で成長しました。図1hは、S 5 の断面画像です。 、S 2。よりもコンパクトなレイヤーを示しています GaNナノウォールネットワークの成長の始まりを確認するために、別のサンプルS 4 を成長させました。 Alの事前堆積により短時間で。 S 4 のすべての成長パラメータ サンプルS 2 と同じです。 成長時間(20分と120分)を除きます。 S 4 の厚さ は約50nmで、その上面画像を図1fに示します。この段階で穴が形成されており、ガウンされたままのGaNは、GaNナノワイヤやアイランドではなく、面内の連続ネットワークであることが観察されます。サンプルの研究からS 1 、S 2 、S 4 、およびS 5 、Al層の事前堆積により、最初のGaNの成長挙動が、ナノカラムから面内連続ナノウォールネットワークに変化することは明らかです。
S 2 のすべての成長条件に注意してください ただし、Alの事前堆積はS 1 の堆積と同じです。 。次に、事前に堆積されたAlの構造はどのようなものであり、それがその後のGaNの成長にどのように影響するのか疑問に思うかもしれません。これらの答えを見つけるために、裸のSi(111)への40秒間のAlの事前堆積が、FESEMとAFMによって調査されます。図2aは、事前に堆積されたAlの上面画像を示しています。 Si基板上のAlは膜以外の液滴(白い点)の形で存在していることがわかります。密度が〜4×10 7 の金属Al液滴 mm − 2 有意な蓄積なしに比較的均一に分布します。最近、Al液滴はLiらによるMBEを使用して首尾よく成長しました。成長したままのGaNの品質を改善し、応力を低減します[24]。 Al液滴の形態をさらに研究するために、図2b、cに示すように、AFMを使用してそれらの3次元画像と関連パラメータを測定しました。 SEMの結果と一致して、液滴は図2bに示すように球形です。測定されたAl液滴の高さと直径は、それぞれ6.7nmと80nmです。 Poppitz etal。 [25]は、鉄ビーム支援MBEによる裸の6H-SiC(0001)上でのGaNナノウォールネットワークの成長を調査しました。彼らの結果は、高い基板温度と成長中の高エネルギーNイオン照射と組み合わせた非常にNに富む成長条件が、裸の6H-SiC(0001)上にナノウォールネットワークを形成する主な理由であることを示しています。パイオニアとして、Kesaria等。 [17]は、PA-MBEを使用して、裸のサファイア基板上のGaNナノウォールネットワークを調査しました。彼らの研究では、GaNナノウォールはエッジとらせん転位で核形成し、Nが豊富な雰囲気下で成長すると見なされています。
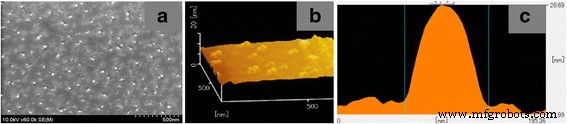
FESEM( a )およびAFM( b )Si基板上に事前に堆積されたAlの画像。 c AFMによる1つのAl液滴のパラメータ測定
私たちの場合、ナノウォールは金属Alの事前堆積を必要として成長するため、GaNナノウォールネットワークの成長メカニズムは異なるはずです。もちろん、私たちの知る限り、私たちの実験を含むすべてのGaNナノウォールネットワークは、Nが豊富な雰囲気下で成長しています。ナノウォールの合体を減らすには、Nリッチが必要です。ここで、ナノウォールネットワークの形成におけるAl液滴の役割に焦点を当てましょう。触媒として機能するAu液滴[26]と同様に、Al液滴が触媒として機能する場合、GaNはナノウォールネットワークではなくナノカラムまで成長するはずです。したがって、Al液滴の役割は、私たちの研究における触媒ではありません。 Al金属の溶融温度は933Kですが、成長中は基板温度が973Kに維持されます。したがって、GaN成長の開始時には、Al液滴は液滴です。以前の報告によると、Ga液滴を含むSi上のGaN(111)の場合[13]、Ga液滴はGa原子をその近傍に供給するリザーバーとして機能します。ただし、元のGa液滴サイトは中空の円であるため、Ga液滴自体がその上でのGaNの成長を妨げます。この場合、Al液滴の直径は約80 nmで、図1aのクラスAの穴のサイズと同様です。したがって、Al液滴は、それら上でのGaNの成長を妨げ、GaNナノウォールネットワークで観察されるクラスAの正孔の形成につながる可能性があります。サンプルのШ/ V比が同じであるためS 1 およびS 2 、Ga拡散長 L ナノウォールネットワークの成長のためのSiの場合、ナノカラムの場合と同じであると予想されます。裸のSi基板(Al液滴のない領域)の一般的なサイズは、図1aのナノカラム直径の値の範囲内で約80nmです。つまり、Gaの拡散長 L 裸のSi基板のサイズをカバーし、Al液滴のない領域、つまりGaNナノウォールネットワークでGaNの連続成長をもたらします。
上記の分析に基づいて、GaNナノウォールネットワークの成長モデルが提案され、図3に示されています。図3aに示すように、GaNは裸のSi基板上で核形成します。 Ga ab 以降 拡散長 L 裸のSi基板を覆うと、裸のSi基板全体でGaNが成長しますが、Al液滴上でのGaNの成長は妨げられます(図3b)。さらに、Nリッチ条件下では、図3cに示すように、GaNは垂直方向に成長する傾向があります。裸のSi基板は面内の連続ネットワークであるため、上記のGaNの成長は、図3dに示すように、ナノウォールネットワークと呼ばれる連続ネットワークでもあります。この仮定は、サンプルS 4 の上面画像によって確認されます。 図1f。サンプルS 2 のNリッチ条件のため 成長、横方向の成長は、穴がその後の成長で予約できるように制限されます。 GaNナノウォールネットワークの成長には、Al液滴とNリッチ条件の両方が不可欠であることに注意してください。
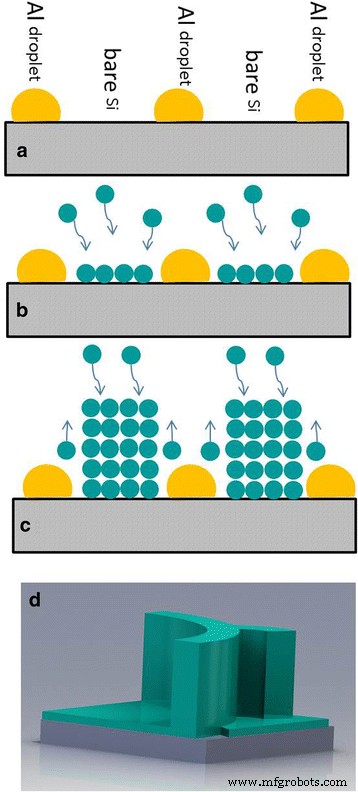
GaNナノウォールネットワークの成長モデル。 a Si基板上に事前に堆積されたAl液滴。 b 裸のSi上のGaNナノウォールネットワークの核形成。 c Nリッチ条件で垂直に成長したGaNナノウォールネットワークの断面図。 d GaNナノウォールネットワークの傾斜図
X線回折を利用して、図4に示すようにGaNナノウォールネットワークの結晶構造の特性評価を行いました。GaN(002)とGaN(004)の2つの回折ピークが、 Si基板。この結果は、GaNナノウォールネットワークが六角形であり、 C に沿って高度に配向していることを示しています。 軸。 XRDパターンに加えて、図4の挿入図に示すように、GaN(002)のωスキャンロッキングカーブも測定されました。半値全幅は52.2アークミンで、サファイアで成長した以前のレポートと同様です。基板[27]。電気的特性は、293 KでVander Pauw Hall測定システム(HL5500PC、Nanometrics)を使用して測定されました。GaNナノウォールネットワークの電気伝導率、ホール移動度、および電子濃度は、10.2 S / cm、31 cm です。 2 / Vs、および2.1×10 18 cm − 3 、 それぞれ。 GaN膜の場合、2.2×10 20 の電子濃度が高いため、電気伝導率は666.7 S / cmに増加します。 cm − 3 。膜中の高いキャリア濃度は、おそらく最適化されていないGa / N比によって生成された高い固有欠陥濃度に起因します。フィルムのホール移動度は、18.7 cm 2 です。 / Vs。

GaNナノウォールネットワークのX線回折パターン(S 2 )。挿入図は、サンプルS 2 のωスキャンロッキングカーブです。
図5は、励起源としてHe-Cdレーザーを使用したGaNナノウォールネットワークのフォトルミネッセンススペクトルを示しています。 Kesaria et al。の報告[17]によると、ベアサファイア基板上に成長したGaN膜、ナノウォールネットワーク、およびナノカラム間のカソードルミネッセンスの直接比較が行われました。彼らの結果は、ナノウォールネットワークのバンドエッジ発光がナノカラムのそれよりもわずかに高く、フィルムのそれよりもはるかに高いことを示しています。ナノウォールネットワークでは520〜620を中心とする幅広い欠陥放出が観察されますが、ナノカラムでは欠陥放出は観察できませんでした。図5では、363.7 nmを中心とする強いバンドエッジ発光が観察され、半値全幅は14.1nmです。 Kesaria et al。のレポート[17]とよく一致して、520〜620 nmの範囲で、点欠陥[28]に起因する幅広い緑黄色の発光が検出可能ですが、非常に弱く、GaNナノウォールの品質が高いことを示しています。通信網。したがって、成長メカニズムは異なりますが、裸のサファイア基板上とAl液滴を含むSi基板上で成長したGaNナノウォールネットワークの発光はほぼ同じです。

室温で測定されたGaNナノウォールネットワークのフォトルミネッセンス(PL)スペクトル
結論
この作業では、ナノカラム、ナノウォールネットワーク、およびコンパクトフィルム間のGaN成長の構造シフトが、MBEを使用してSi(111)基板上で正常に達成されました。 GaNナノカラムはNリッチ条件下で裸のSi基板上に成長し、コンパクトな膜は改善されたGaフラックスで成長しました。事前に堆積されたAl層を追加することにより、GaNの成長はナノカラムから面内連続ナノウォールネットワークにシフトします。事前に堆積されたAl層は、通常の高さと直径がそれぞれ6.7nmと80nmの液滴の形で存在します。ナノウォールネットワークの成長メカニズムについて説明します。 GaNは裸のSi基板上で連続的に成長しますが、Al液滴上でのGaNの成長は妨げられ、その結果、ナノウォールネットワークが形成されます。ナノウォールネットワークの成長には、Al液滴とNリッチ状態の両方が不可欠です。
ナノマテリアル



