イプシロンに近いゼロに近いインジウムスズ酸化物に基づく偏光非感受性表面プラズモン偏光電気吸収変調器
要約
テレコム波長で動作するCMOS互換のプラズモン変調器は、さまざまなオンチップアプリケーションにとって重要です。金属-誘電体界面で励起された横磁気(TM)モードの操作に依存して、これまでのデモンストレーションのほとんどは、特定の分極状態に対してのみ応答するように設計されています。この場合、偏光に敏感な変調器がランダムな偏光状態のファイバに統合されると、偏光に依存する損失が大きくなります。ここでは、シリコン導波路に巻き付けられた金属酸化物インジウムスズ酸化物(ITO)を利用したプラズモニック変調器を提案し、電界誘起によるITOの電気吸収を調整することにより、垂直および水平偏光ガイド光の両方に対する光変調能力を調査します。キャリア注入。 ITO /酸化物界面に電子が蓄積された電気的にバイアスされた変調器により、ガイド光の偏光状態に応じて、界面の上部または側面でイプシロンニアゼロ(ENZ)モードを励起できます。 ENZモードの局所的な特徴が高いため、デバイスの「オフ」状態で効率的な電気吸収を実現できます。これにより、提案する変調器の両方の偏光で大きな消光比(ER)が得られます。さらに、偏光に影響されない変調は、2つの異なる積層方向で酸化物の厚さを適切に調整し、垂直および水平偏光モードで動作するデバイスのER値を一致させることによって実現されます。最適化されたジオメトリ構成では、2つの偏光モードのER値の差、つまり0.01 dB /μmという小さなΔERが示され、同時に74%を超える結合効率が、波長の両方の偏光で得られます。 1.55μm。提案されたプラズモン結合変調器は、ランダムな偏光状態を持つファイバーからの光の誘導と処理に応用できる可能性があります。
背景
フォトニック集積回路(PIC)は、光通信、センシング、およびイメージングの分野でのアプリケーションの開発により、過去数十年で目覚ましい進歩を遂げました[1、2]。現在、高度なPICを製造するために、フォトニックデバイスのダウンスケールと消費電力の削減にかなりの注意が払われています。 Siフォトニクスは、将来の高速オン/オフチップ光相互接続の有望なソリューションと見なされています。典型的なSi導波路変調器は、材料の屈折特性または吸収特性のいずれかを電気的に変化させて、デバイスを通過する光の透過を変調します。 Siの弱いプラズマ分散効果とSi導波路の回折限界のために、Si MZI変調器は〜10 3 の大きなフットプリントに悩まされています。 –10 4 μm 2 。 Q共振が高いリング変調器は、通常、フットプリントが〜10 2 とコンパクトになります。 –10 3 μm 2 ただし、光帯域幅が低く、温度変化の影響を受けやすい傾向があります。プラズモニクスは、回折限界を超えて光学デバイスを小型化するアプローチを提供します[3]。あるいは、Siを活物質として使用する完全にCMOS互換のスロット変調器またはプラズモン変調器が最近実証され[4、5]、変調器内のライトフィールドの高い局在化を達成することができます。ただし、Si層(導波路/構造)での自由キャリア分散効果が小さいため、Siベースのプラズモン変調器の性能は依然として制限されています。
最近、インジウムスズ酸化物(ITO)、アルミニウム酸化亜鉛、ガリウム酸化亜鉛などの透明導体酸化物(TCO)が、電気的に調整可能な許容度により、統合型電気吸収(EA)変調器の魅力的な活物質として浮上しています[6 、7、8、9、10]。印加電圧バイアス、キャリア密度( N )の下でキャリア蓄積が形成されるSiベースの電界効果MOSデバイスと同様です。 ITO )バイアスをかけたITO /誘電体界面で調整できます。実数部Δn=0.092と虚数部Δk=0.27のITO蓄積層の屈折率の明らかな変化が、1310nmの自由空間波長で実験的に報告されています[10]。ITOの誘電率の実数部がマテリアルは、特定の N でほぼゼロに調整されます ITO 、「イプシロン-ゼロに近い」(ENZ)状態と呼ばれ、ガイドモードの強い閉じ込めにより最大の吸収損失があります[11]。 MOSコンデンサ構造を形成し、光場と活物質層のオーバーラップを強化するために、ITOの導波モードを強力に制限することを目的として、スロット導波路[9、12]とハイブリッドプラズモン導波路[10]が以前に採用されました。と誘電体層。ハイブリッドプラズモニック変調器を含む従来のプラズモニック変調器は、横磁気(TM)モードのみをサポートします。これは、表面電荷の生成には金属-誘電体界面に垂直な電界が必要であり、強い光場閉じ込めを備えたスロット導波路は横電界のみをサポートするためです( TE)低屈折率のスロット領域のモード。光ファイバ通信アプリケーションの場合、ファイバからの光は通常、ランダムな偏光状態を持っているため、偏光に敏感な光変調器に結合すると、信号対雑音比が低下します。プラズモンおよびスロットITO導波路の場合、偏波依存損失は非常に高くなる可能性があります。したがって、偏光回転子[13,14,15]などの偏波ダイバーシティシステムを回路に統合する必要があります。ただし、通常、サーカスでは大きな結合損失があります。したがって、偏光依存性が低いいくつかのITOベースのプラズモン変調器を考慮する必要があります。 TiN / HfO 2 のスタックを備えたコンパクトなEA変調器 ストリップ導波路上に堆積された/ ITO / CuはTEモードとTMモードの両方をサポートします[11]が、TEとTMの消光比の差は0.9 dB / umに達し、変調効率の4%になります。したがって、偏光に影響されないサブ波長の光ガイドと処理を実現するには、最小のΔERで両方の偏光モードをサポートするプラズモン変調器が望まれます。
この論文では、Au / SiO 2 でクラッドされたシリコン導波路のモード特性と光変調 / ITO多層は数値シミュレーションによって調査されました。両方の偏光について、Au / SiO 2 では高濃度のプラズモンモードがサポートされていました。 / ITO / Siスタックは、シリコンコアの上部または側壁にあります。変調にはITO層のキャリア分散効果が使用され、スタックによって形成されたMOSコンデンサ構造によって調整されます。このようなサブ波長導波路のキャリア蓄積とモードフィールド分布を調整することにより、0.01 dB /μm未満のΔER(2つの偏波モードの消光比の差)で1.43 dB /μmを超える変調消光比を実現できます。この結果は、フォトニック集積回路の偏光依存損失を低減するために有望です。
メソッド
本論文では、ITOは提案された変調器の活物質として適用されます。高速プラズモンスイッチングを実現するための有望なアプローチとして、フリーキャリア蓄積効果が提案されています。以前の研究では、ITOの屈折率は、MOSコンデンサ構造のITO /誘電体界面での電荷キャリアの蓄積によって大幅に変化する可能性があることが確認されています[6、16]。 ITOの誘電率は、Drudeモードで次のように扱うことができます
$$ \ varepsilon ={\ varepsilon} _ {\ infty}-\ frac {N_ {ITO} {e} ^ 2} {\ varepsilon_0 {m} ^ {\ ast}} \ bullet \ frac {1} {\ omega ^ 2 + i \ omega \ Gamma} $$(1)ここで、ε ∞ は高周波誘電率、Г は電子の減衰係数ωです。 は光の角周波数、 N ITO はITO材料の電子濃度 m *は有効質量 e は電子の電荷であり、ε 0 は自由空間の誘電率です。蓄積された電子の濃度は、ITO /誘電体界面で最大になり、界面からの距離が長くなるにつれて急速に減少することが示されています[11]。図1は、計算された実数部(ε)をプロットしたものです。 1 )および虚数部(ε 2 )特定の N での波長の関数としてのITOの誘電率 ITO 。 N によれば、それがわかります。 ITO =6.0×10 20 cm − 3 、ε 1 1.55μmでゼロに近づきます。物理的には、これは、入射光に対する誘電応答と金属応答を示す材料間の遷移を表します。この誘電率ポイントは、ENZポイントと呼ばれます。 ENZ材料は、光学フィールドと吸収層で非常に大きなエンハンスメントオーバーラップを引き起こします。一方、キャリア濃度の増加は、対応するεの増加も引き起こします。 2 、これはキャリア蓄積層の吸収損失を増加させます。後で、さまざまなITOEA変調器の光変調性能を比較します。
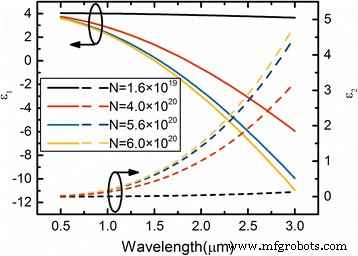
計算された実数部(ε 1 )および虚数部(ε 2 )平均電子濃度が異なる場合の波長の関数としてのITOの誘電率 N ITO 。波長のENZポイントは、εで定義されます。 1 ゼロを越える
TEガイドモードとTMガイドモードの両方をサポートおよび変調するプラズモン変調器を設計するには、少なくとも2つの金属-誘電体インターフェースが必要です。1つは x です。 y の方向と他の方向 方向。この場合、垂直方向と水平方向の両方のハイブリッドプラズモン導波路からなるプラズモン導波路が提案されます。図2に示すように、提案された変調器は、幅が W のSiコアで構成されています。 Si と H の高さ Si 、 D の厚さの透明な導電性ITO層 ITO 、SiO 2 側壁幅が W の中間層 p と H の高さ p 、および100 nmの厚さ(光の侵入深さよりもはるかに厚い)のAuクラッド層。 Si導波路は、電子ビームリソグラフィーおよび深掘り反応性イオンエッチング(DRIE)によって製造できるため、薄いITOおよびSiO 2 十分に開発されたパルスレーザー蒸着(PLD)法とPECVD法を使用して、導波路に層ごとにコンフォーマルに蒸着することができます。提案された変調器は、CMOSバックエンド互換です。 HSPP波は、SiO 2 間の低屈折率層に沿って励起されます。 挿入損失を効果的に低減できるITO層。これら2種類のプラズモン導波路のモード特性がまったく異なるため、光変調は本質的に異なりますが、モードフィールド分布とアクティブ層の位置を最適化することにより、偏光に依存しないように設計できます。
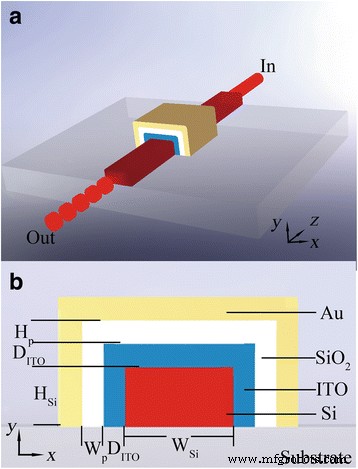
a 3Dビューと b ストライプ誘電体導波路と統合された提案されたEAプラズモン変調器の断面図
有限差分時間領域(FDTD)法を使用して、伝播特性を数値的にモデル化します。最小空間サイズが0.2nmの不均一メッシュが使用されています。完全一致層(PML)境界は、すべての境界で後方反射なしにフィールドを減衰させるために使用されます。このデバイスは、1.55μmの波長で動作するように設計されています。シリコンと二酸化ケイ素の屈折率はそれぞれ3.48と1.44であり、Auクラッドの誘電率は1.55μmで− 116.62 + 11.46iであると想定されています[17]。このデバイスでは、金属/絶縁体/シリコン(MIS)導波路は、回折の限界を超えた低損失や導波路内の強力な光閉じ込めなど、優れた伝搬特性を備えています。フルクラッドシリコンプラズモン導波路での以前の研究は、このタイプの導波路が両方の偏波のモード伝搬をサポートでき、伝搬定数の差が非常に小さいことを示しています[18]。
結果と考察
ITO層の平均電子濃度として定義されるNITO変動によって引き起こされるハイブリッドプラズモン導波路のこの変動を理解するために、電界分布 E x および E y EA変調器の場合を図3に示します。図3a、b、 N に示すように ITO =1.6×10 19 cm -3 、 E x TEモードのは、SiO 2 の2つの側壁に限定されます。 レイヤーと E y TMモードのはSiO 2 の上部に閉じ込められています 層は、光の回折限界を大幅に下回る強力な光閉じ込めと、「オン」状態として定義される比較的低い光伝搬損失[18、19]の両方の組み合わせを提供します。図3c、dに示すように、MOSコンデンサ構造に電圧を印加すると、キャリア蓄積層がSiO 2 に誘導されます。 / ITOインターフェイス、 N ITO =5.6×10 20 cm -3 。キャリア密度の増加により、両方のキャリア蓄積層の誘電率の実数部が減少します。これは、SiO 2 の誘電率よりも低くなります。 層の場合、光場はキャリア蓄積層に押し込まれます。一方、 N として、両方のキャリア蓄積層の誘電率の虚数部が増加したため ITO 増加すると、光伝搬損失はキャリア蓄積層の吸収損失の増加とともに増加し、ENZポイント、つまり「オフ」状態で最大に達します。
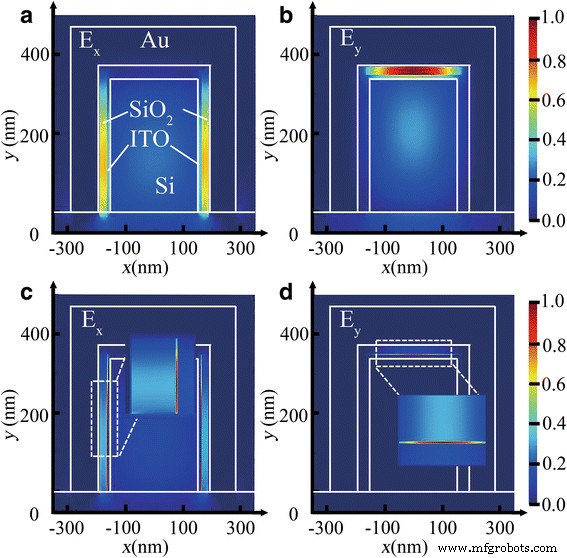
電界プロファイル E x および E y a の変調器の – b 「オン」状態、 N ITO =1.6×10 19 cm -3 、および c – d 「オフ」状態、 N ITO =5.6×10 20 cm -3 、 それぞれ。 a および c TEモード用です。 b および d TMモード用です。挿入図は、「オフ」状態のITO層の電界密度を拡大したものです。 W Si =310 nm、 H Si =340 nm、 H p =20 nm、 W p =25 nm
光変調器の場合、ERとIL(挿入損失)が2つの最も重要なパフォーマンスパラメータです。定義する
$$ \ mathrm {ER} =\ frac {P _ {\ mathrm {out}} \ left({V} _b ={V} _ {\ mathrm {OFF}} \ right)} {P _ {\ mathrm {out} } \ left({V} _b ={V} _ {\ mathrm {ON}} \ right)} $$(2)$$ \ mathrm {IL} =\ frac {P _ {\ mathrm {in}}-{ P} _ {\ mathrm {out}} \ left({V} _b ={V} _ {\ mathrm {ON}} \ right)} {P _ {\ mathrm {in}}} $$(3)ここで P out ( P in )は、デバイスの出力(入力)での光パワーであり、 V b は「オン」状態( V )での印加電圧です。 オン )および「オフ」状態( V オフ )。さらに、光伝搬損失(α )はαとして定義されます =4 πκ/λ 、λ は動作波長であり、κ は、ハイブリッドプラズモンモードの複素有効指数の虚数部です。計算によると、α 主にキャリア蓄積層の光吸収に依存します。ハイブリッドプラズモン導波路の光場は、ほとんどが低誘電率層(SiO 2 )に閉じ込められています。 およびITO層);したがって、伝搬損失は、SiO 2 の変化に伴って変化します。 層。 SiO 2 の影響を調査する 変調性能に関する層の寸法、SiO 2 の関数としてのERおよびΔER 図4に示すように、層について説明しました。図4によると、TEモードのERは、 W の増加とともに徐々に減少します。 p ガイドモードとキャリア蓄積層の重なりが減少したため、キャリア蓄積層での吸収がわずかになりました。 W のとき、ΔERは最小になります p H より少し厚い p 、断面が長方形のSiコアと、2つの側壁の光吸収によるものです。
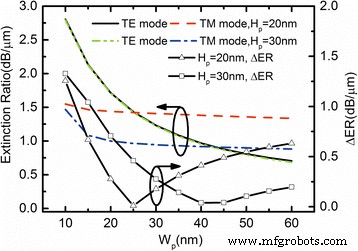
EAモジュレーターのERおよびΔERと W p H で p =20および30nm
図5は、 N が異なるEA変調器の波長の関数としてのERとΔERをプロットしたものです。 ITO 。 EA変調器のERとΔERは波長の増加とともに増加し、特定の波長で最大に達し、次にERは波長の増加とともに減少し、ΔERは減少し、波長の増加とともに特定の波長で最小に達することがわかります。 N ITO 最大ERは、ENZポイントと N の近くにあります。 ITO 最大ERは、ENZポイントにあります(例: N )。 ITO =6.0×10 20 cm − 3 、両方のモードの最大ERは、1.50μmの波長で1.65および1.56 dB /μmであり、最小のΔERは、動作波長である1.55μmの波長で0.009 dB /μmです。 EAアプリケーションの場合、最大αの条件 到達した状態は、「オフ」状態、およびαの状態として定義できます。 はるかに小さい場合は、「オン」状態として定義できます。さらに、EA偏波非影響変調器の場合、最小ΔERに達する条件に十分注意する必要があります。
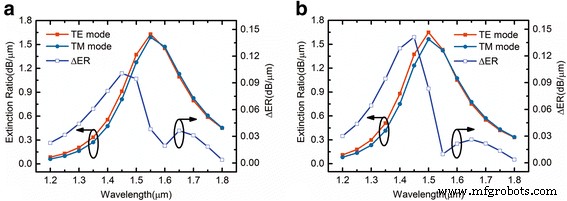
a のEA変調器の波長の関数としてのERおよびΔER N ITO =5.6×10 20 cm -3 および b N ITO =6.0×10 20 cm -3
N ITO キャリア蓄積層の変化は、さまざまな印加電圧によって変化し、その結果、吸収と電界分布が変化します。 EA変調性能に対する搬送波蓄積層の影響を理解するために、提案された変調器のERとΔERが動作波長で計算されます。図6に示すように、EAモジュレーターのERとΔERは N とともに増加します。 ITO 増加し、特定の N で最大に達します ITO 、次に N で減少します ITO さらに増加します。 TEモードとTMモードの最大ERは、それぞれ1.62と1.59 dB /μmです。 ΔERは、 N の増加とともに最初に増加します。 ITO 最大値に達した後、減少します。 ENZポイントでは、両方のモードのERが最大に近く、ΔERは0.01 dB /μm未満であることがわかります。
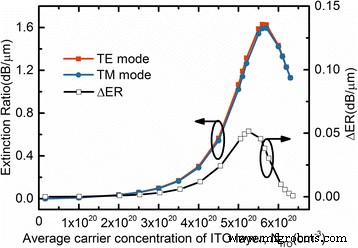
N の関数としてのERとΔER ITO EAモジュレーター用。 H Si =340 nm、 W Si =310 nm、 H p =20 nm、 W p =25 nm、 D ITO =10 nm、 H Au =100 nm
デバイスの性能を実証するために、長さ14μmのEA変調器に対して3D-FDTDシミュレーションが実行されました。 TE偏光とTM偏光の両方を備えた1.55μmの光がSi入力導波路に入射し、変調器を介して伝搬し、最後に出力Si導波路に結合されます。図7a、bは、 y に沿った横方向の電界分布を示しています。 -「ON」状態と「OFF」状態でSi導波路の中央をカットします。図7c、dは、 x に沿った横方向の磁場分布を示しています。 -「ON」状態と「OFF」状態でSi導波路の中央をカットします。 「オフ」状態の場合、0.009 dB /μmの優れたΔERにより、TEモードとTMモードの両方の出力のライトは、14μmの長さの変調長でバランスが取れています。

E のフィールド分布 x TEモードの場合 a – b および E y c – d y に沿ったTMモードの場合 -カットして x -Si導波路の中央でカットします。 a および c 「オン」状態です。 b および d 「オフ」状態です。 H Si =340 nm、 W Si =310 nm、 H p =20 nm、 W p =25 nm、 D ITO =10 nm、 H Au =100 nm
PICで使用するHSPP変調器の設計では、Si導波路幅 W (高さ H = H Si =340 nm)が最適化されました。 TEモードとTMモードの両方がサポートされる範囲内で導波路幅を変化させることにより、結合実効(CE)が計算されます。図7から、これら2つの導波路のモードの不一致により、結合界面で反射光が観察され、結合損失が発生します。 n が大きいSiストライプ導波路間のモードの不一致 eff プラズモン結合導波路が大きくなり、結合効率が低下します。図8は、プラズモン結合導波路( H )間のCE(2つの導波路と光源の界面の後ろの平面に記録されたパワーフラックスの無線として定義)を示しています。 p =20nmおよび W p =25 nm)およびTEモードとTMモードの両方の幅の関数としてのSi導波路。 W が増加すると、ΔCE(2つの偏波モードの結合効率の差)が減少し、入力Si導波路の特定の幅で最小に達し、入力Si導波路の幅の上昇潮流とともに増加します。結果として、最小ΔCEは5.63%(「オン」状態)および6.38%(「オフ」状態)です。したがって、結合効率はほとんど偏光に影響されず、「オン」状態でTEモードで80.46%、TMモードで74.83%になります。
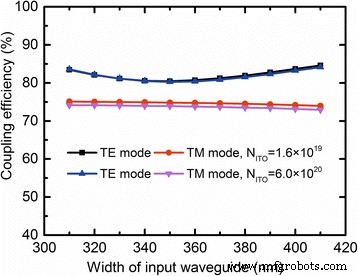
「オン」状態と「オフ」状態でのTEモードとTMモードの両方の幅の関数としてのプラズモン結合導波路とSi導波路の間のCE。 H Si =340 nm、 W Si =310 nm、 H p =20 nm、 W p =25 nm、 D ITO =10 nm、 H Au =100 nm
結論
要約すると、EA偏波非感受性プラズモン導波路変調器を提示しました。導波路構造は、両方の x のハイブリッド導波路で構成されています。 および y 二重偏波モードが存在する方向。ハイブリッドプラズモニック導波路はMOSコンデンサを形成し、ドープされたSi電極が金属電極よりも低い電圧でバイアスされると、誘電体-ITO界面でキャリアの蓄積が発生します。光変調は、キャリア密度を調整することによって調査されます。 1.55μmの波長で0.009dB /μmの最小ΔERがシミュレーションによって示されています。このΔERは、私たちが知っているように記録上最低です。さらに、両方の偏波で74%を超える結合効率が、給電シリコン導波路を使用して得られます。これらのITOEAプラズモン導波路変調器は、超小型フォトニック集積回路の重要な構成要素になる可能性があります。今後の作業では、製造を容易にするために、許容誤差の大きい非対称コーティングの形状の最適化を検討する必要があります。
ナノマテリアル
- 局在表面プラズモン共鳴に基づく金ナノバイオセンサーは、ヒトブルセラ症を診断することができ、迅速で手頃な方法を導入します
- 偏位したトランケートされたAgナノプリズム二量体への局在表面プラズモン共鳴依存性
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- メタマテリアルにおける表面プラズモンポラリトンと磁気双極子共鳴の結合効果
- 誘電体ナノプリズムに基づくプラズモンセンサー
- 薄膜トランジスタ用の酸化インジウムナノフィルムの原子層堆積
- AgNWs電極を備えたテクスチャ表面に基づくPEDOT:PSS / n-Si太陽電池の高性能
- ハイブリッド全誘電体-グラフェンメタ表面に基づく制御可能な複屈折を備えた偏光変換器
- バルクディラック半金属-絶縁体-金属導波路におけるテラヘルツ表面プラズモンポラリトンの閉じ込めの強化
- インジウムスズ酸化物被覆シリカ上での単結晶GaNナノワイヤの直接成長
- 酸化マンガンに基づくスーパーキャパシタ



