高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
要約
この作業では、270 nmのピーク波長で発光するほぼ効率の低下のないAlGaNベースの深紫外線発光ダイオード(DUV LED)が報告されています。 DUV LEDは、特別に設計された超格子p型電子ブロッキング層(p-EBL)を利用しています。超格子p-EBLは、p-EBLでの高い正孔濃度を可能にし、それに応じて、多重量子井戸(MQW)への正孔注入効率を高めます。 MQW領域内の正孔濃度の向上は、放射再結合を促進する方法で電子とより効率的に再結合し、電子漏れ電流レベルを低下させることができます。その結果、提案されたDUV LED構造の外部量子効率が100%向上し、ほぼ効率の低下のないDUVLED構造が実験的に得られました。
背景
200 nm〜280 nmの波長領域の紫外線ビームは、浄水システムでの潜在的な用途が見出されています[1、2]。 DC駆動電圧が低く、浄水システムとの互換性が高いことを考慮して、AlGaNベースの深紫外線発光ダイオード(DUV LED)が優れた候補として選択されています。大量の水を処理するには、高出力のUVC光源を提供するための浄化システムが必要であることは言及する価値があります。ただし、現時点では、発光波長が280nmより短いAlGaNベースのDUVLEDの外部量子効率(EQE)は満たされていません[3]。貧弱なEQEの主な制限要因は、Alに富む量子井戸の大きな貫通転位密度(TDD)に部分的に起因します[2、3]。 TDDが10 9 のオーダーになると、内部量子効率(IQE)は急速に低下します。 cm −2 [3]。 TDDを10 8 のオーダーに減らしても cm −2 IQEを60〜80%にすることができる場合、効率低下の影響により、注入電流密度が80 A / cm 2 を超えると、裸のUVC LEDのEQEが5%未満になる可能性があります。 [4]。 FDTD計算[5]によると、裸のUVC LEDチップの光抽出効率(LEE)は約10%であることに注意してください。 III族窒化物ベースのLEDの効率低下の主要な解釈の1つは、p型正孔注入層への電子の波及効果です[6]。 AlリッチAlGaNp型正孔注入層は、1×10 17 よりもさらに低い自由正孔濃度を持っています。 cm -3 [7]、より深刻な電子漏れレベルを引き起こす傾向があります。 Mehnke etal。は、p型正孔注入層で発生する寄生発光を測定しており、寄生発光は電子漏れに起因していると考えられます[8]。複数の量子井戸(MQW)からの電子の逃げ道を減らすために、量子障壁に単一のスパイク層を挿入することで電子捕獲率を上げることができます[9]。スパイク層は量子障壁よりも高いAl組成を持っているため、スパイク層の分極誘起電場は電子のドリフト速度を十分に低下させることができます。したがって、改善されたキャプチャ効率は、DUVLEDが[0001]方向に沿って成長した場合にのみ有効になります。電子捕獲率を高める別の効果的な方法は、量子障壁と量子井戸の間の伝導帯オフセットを増やすことです。これは、Al組成を適切に増やすことで実現できます[10]。等級付けされたAl組成[11]。前述のように、Alリッチp型AlGaN正孔注入層の自由正孔濃度は低く、MQW領域への正孔注入能力が低くなります。正孔注入の不良も電子漏れの原因と考えられています[12]。 p型電子ブロッキング層(p-EBL)を横切る正孔熱電子放出を増加させるための有望な方法は、電界リザーバーを採用することによって正孔にエネルギーを与えることです[13]。階段状のAl組成を持つp-AlGaNベースの正孔注入層がDUVLEDに利用される場合、正孔輸送も有利になります[14]。階段状のAl組成は、AlGaN層の段階的なAl組成にさらに置き換えて、正孔濃度を高めることができます[15、16、17]。正孔注入層のエンジニアリングに加えて、代替のp-EBLも、正孔ブロッキング効果を低減するために提案されています。たとえば、Al組成の低い薄いAlGaN層を挿入します[18]。 p-EBL候補の非常に重要な構造は、超格子p-EBLです。 GaNベースの青色LEDに対するGaN / AlGaN超格子の影響を調査するために多大な研究努力がなされてきました[19、20、21]。それにもかかわらず、青色LED用のAlGaN p-EBLのAlN組成は20%未満であるため、青色LEDのホールブロッキング効果はDUVLEDの場合ほど深刻ではありません。したがって、EQEの改善は20%未満であり、青色LEDにGaN / AlGaN超格子p-EBLを採用した場合でも、効率の低下は明らかです。 DUV LEDはAlリッチp-EBLを採用しているため、さらに困難な正孔注入の問題が発生します[1]。 Alリッチp-EBLによる正孔ブロッキング効果を解決するために、DUV LED用の超格子p-EBL、たとえばAlInGaN / AlGaN超格子p-EBL [22]やAlGaN / AlGaN超格子p-EBL [23]も提案されています。ただし、この段階では、高効率でほぼ効率の低下のないEQEを取得するのに役立つ超格子p-EBLの実験的証明がDUVLEDに欠けています。したがって、この作業は、EQEを強化し、DUV LEDの効率低下を大幅に抑制する、特別に設計されたAlGaN / AlGaN超格子p-EBLの有効性を実験的に示しています。強化されたEQEは、MQW領域への正孔注入の改善に起因し、電子漏れレベルの低減は、効率の低下を著しく抑制するのに役立ちます。詳細なメカニズムは、この作業で後で説明します。
メソッド/実験
この作業の2つのDUVLEDアーキテクチャ(図1に示すLED AとB)は、有機金属化学蒸着(MOCVD)システムによってAlNテンプレート上で成長します。厚さ4μmのAlNテンプレートは、Hydride Vapor Phase Epitaxy(HVPE)法を使用して、[0001]配向のサファイア基板上に成長させます。 20期間のAlN / Al 0.50 を成長させます Ga 0.50 AlNテンプレート上のN超格子。これは、その後成長するエピ層のひずみ緩和層として機能します。厚さ2μmのn-Al 0.60 Ga 0.40 電子濃度が1x 10 18 のN層 cm -3 電子を提供するために成長します。 DUVフォトンは、5周期のAl 0.45 によって生成されます。 Ga 0.55 N / Al 0.56 Ga 0.44 厚さ3nmのAl 0.45 を持つN個のMQW Ga 0.55 N個の量子井戸と12nmの厚さのAl 0.56 Ga 0.44 N個の量子障壁。次に、MQWは厚さ10nmのAlGaNベースのp-EBLでキャップされます。私たちの実験では、LEDAとB用にそれぞれ2種類のp-EBLを設計して成長させます。 LEDAはAl 0.60 を持っています Ga 0.40 Nベースのp-EBLおよびLEDBには、5周期の1 nm Al 0.45 があります。 Ga 0.55 N / 1 nm Al 0.60 Ga 0.40 Nベースのp-EBL。超格子p-EBLループはAl 0.45 から始まることに注意してください。 Ga 0.55 最後のAl 0.56 を成長させた後のN薄層 Ga 0.44 N量子バリア。そうすることにより、最後の量子バリア/超格子p-EBLの界面は、負の分極によって誘発されるシート電荷を生成することによって分極されます。これは、最後の量子バリアでの電子蓄積を枯渇させ、電子漏れをさらに抑制します。次に、p-EBLの後に50nmのp-Al 0.40 が続きます。 Ga 0.60 N / 50 nmp-GaNホールサプライヤー。最後に、p-GaN層は、厚さ10nmの高濃度Mgドープp + でコーティングされています。 -GaN層。 DUV LEDウェーハは、N 2 で800°Cの温度で熱的にその場でアニールされます。 H–Mg結合を分割するために、周囲温度で15分間。その場合、穴の濃度はおおよそ1×10 17 と推定されます。 cm -3 および3×10 17 cm -3 それぞれ、Alリッチp-AlGaN層とp-GaN層の場合。
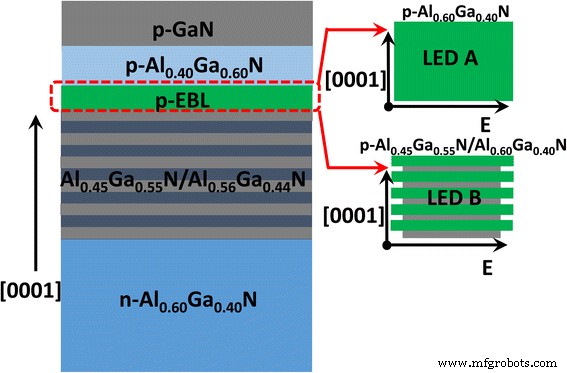
調査対象のLEDの概略構造構造。 2つのp-EBLのスケッチされたエネルギーバンド図も提供されています。LEDAにはp-Al 0.60 があります。 Ga 0.40 NベースのEBLおよびLEDBにはp-Al 0.45 があります Ga 0.55 N / Al 0.60 Ga 0.40 N超格子EBL。 p-Al 0.45 Ga 0.55 N / Al 0.60 Ga 0.40 N超格子EBLは、薄いp-Al 0.45 を開始するように特別に設計されています。 Ga 0.55 p-Al 0.45 のインターフェースとなるN層 Ga 0.55 N / Al 0.56 Ga 0.44 N最後の量子障壁は負の分極界面電荷を持っています。 E エネルギーレベルを意味します。
DUV LEDウェーハは、標準的な微細加工プロセスに従ってDUVLEDチップに製造されます。メサは誘導結合プラズマ(ICP)エッチングを行うことで得られ、メサのサイズは650×320μm 2 です。 。 Ti / Al金属スタックがn-Al 0.60 に堆積されます Ga 0.40 次にN 2 でアニールされるN層 900°Cの温度で1分間。 Ni / Au電流拡散はメサ表面にコーティングされ、O 2 でアニールされます。 550°Cの温度で5分間。最後に、Ti / Al合金とNi / Au電流拡散層にTi / Al / Ni / Au金属を同時に堆積させ、それぞれn電極と反射p電極として機能させます。 DUV LEDチップはフリップチップデバイスであり、DUVフォトンは積分球によってサファイア側から収集されます。
強化されたEQEと抑制された効率低下の詳細な原因をより明確にするために、APSYSパッケージを使用して数値計算が実行されます[13、18]。キャリア再結合イベントとキャリア損失の計算に使用される重要な物理パラメータには、Shockley-Read-Hall(SRH)再結合寿命、オージェ再結合係数、AlGaN / AlGaN界面のエネルギーバンドオフセット比、および[0001]の分極レベルが含まれます。 ]配向のIII族窒化物構造。10ns、1×10 -30 に設定されています。 cm 6 s -1 、それぞれ50:50、および40%[13、18]。厚さ50nmの吸収性p-GaN層を備えた裸のDUVLEDチップのLEEは10%に設定されています[5]。
結果と考察
LED AとBについて、異なる電流密度レベルで実験的に測定されたエレクトロルミネッセンス(EL)スペクトルを図2aに示します。 ELスペクトルは、自己発熱の影響を避けるために、0.1%のデューティサイクルでパルス状態で収集されます。図2aは、両方のDUV LEDデバイスのピーク発光波長が〜270nmであることを示しています。自己発熱効果がないため、ピーク発光波長はテストした電流範囲内で安定しています。 LED BのEL強度は、LED AのEL強度よりも強力です。図2bは、注入電流密度の関数としての光パワーとEQEを示しています。これは、EQEが約90%向上していることを示しています。さらに、電流密度レベル110 A / cm 2 でのLEDAおよびBの効率低下レベルは〜24および〜4%です。 、それぞれ[droop =( EQE max − EQE J )/ EQE max 、 EQE max および EQE J J の電流密度での最大EQEとEQEを示します ]。図2cは、注入電流密度の観点から数値計算された光パワー密度とEQEを示しています。数値計算された結果と実験的に測定された結果は互いによく一致しており、LED BはEQEが向上し、効率の低下レベルが大幅に低下しています。図2bと2cの一致により、物理モデルと計算用に設定したパラメータが十分に検証されます。
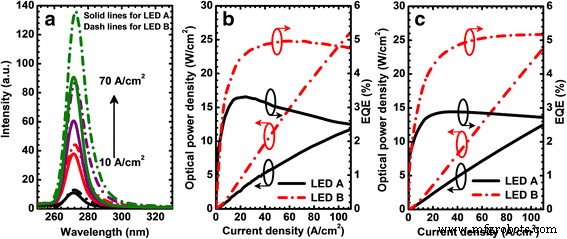
a 10、30、50、および70 A / cm 2 の電流密度で測定されたELスペクトル 。 b 測定された光パワーとEQE。 c LEDAとBのそれぞれの計算された光パワーとEQE
2つのDUVLEDは、p-EBLのみが異なります。したがって、LED Bの光学性能を改善する上での超格子p-EBLの役割を調査する必要があります。図3aは、電流密度50 A / cm <でのLEDAおよびBのMQW領域全体の正孔濃度プロファイルを示しています。 sup> 2 。 LEDBのMQW内の正孔濃度レベルはLEDAのそれよりも高いことが示されています。報告されているように、p-EBLは電子漏れレベルを低減すると同時に正孔注入を妨げます[24]。正孔ブロッキング効果を低減するための有用なアプローチは、p-EBL領域内の正孔濃度を増加させることであり、これは価電子帯障壁の高さを減少させるのに役立ちます[25]。次に、図3bは、p-EBLとp-Al 0.40 の正孔濃度レベルを示しています。 Ga 0.60 50 A / cm 2 の電流密度でのLEDAおよびBのN層 。 LED Bの超格子p-EBLの平均正孔濃度は、LEDAのそれよりも2桁高くなっています。超格子p-EBLの正孔濃度が高いのは、正孔輸送が優れているためです。興味深いことに、図3bをさらに調べると、p-EBL / p-Al 0.40 での正孔濃度がわかります。 Ga 0.60 LED AのNインターフェースは低くなります。これは、LEDBの超格子p-EBLを介したよりスムーズな正孔注入効率も反映しています。

数値計算された正孔濃度プロファイル a MQWおよび b LEDAとBのそれぞれのp型正孔注入層。 c 10、30、50、および70 A / cm 2 の電流密度で片対数スケールで実験的に測定されたELスペクトル LEDAおよびBの場合。 d LED AおよびBのp型正孔注入層で数値的に計算された電子濃度レベル。数値的に計算されたデータは、50 A / cm 2 の電流密度で収集されます。
前述のように、LEDの効率は電子漏れレベルと密接に関連しています。したがって、寄生発光に関する詳細情報を示すために、LED AおよびBの測定されたELスペクトルを片対数スケールで示します(図3cを参照)。寄生発光のピーク発光波長は約425nmに集中しており、これはMgドーパントに関連する深いレベルから生じる可能性があります[26]。 LEDBの寄生発光の強度はLEDAのそれよりも強く、より多くのキャリアが深いレベルで再結合すると推測されます。私たちの実験では、両方のDUV LEDアーキテクチャのp型正孔注入層は設計されておらず、正孔注入層の正孔濃度レベルは同じでなければなりません。したがって、MQW領域から逃げる電子は、LEDAよりもLEDBの正孔注入層に高い濃度を持っていることがわかります。私たちの提案は、p-の電子濃度プロファイルを示す図3dによってさらに裏付けられています。 50 A / cm 2 の電流密度でLEDAおよびB用の型正孔注入層 。これは、LED B用の超格子p-EBLのおかげで、電子漏れ電流が大幅に減少したことも意味します。
次に、50 A / cm 2 の電流密度レベルで収集されたLEDAおよびBの放射再結合率の計算されたプロファイルを図4に示します。 。提案された超格子p-EBLのおかげで、LEDBの放射再結合率はLEDAの放射再結合率よりも強いと推測されます。これは、MQW領域への正孔注入をさらに促進し、その間に電子漏れレベルを抑制します。
>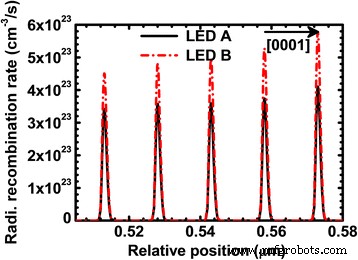
LEDAおよびBの放射再結合率の数値計算されたプロファイル。データは50A / cm 2 の電流密度レベルで収集されます。
図5aと5bは、両方のDUVLEDデバイスのp-EBL付近のエネルギーバンドを示しています。エネルギーバンドは、50 A / cm 2 の電流密度で計算されます。 。張らによって報告されているように。 [27]、最後の量子障壁/ p-EBL界面で強い分極によって誘発された正電荷は、電子を著しく引き付け、高い局所電子濃度を生じさせる可能性があります。局所的な電子濃度が高いと、実効伝導帯の障壁の高さが低くなる可能性があります(Ø e )LED Aの場合は〜295 meVであるp-EBLの場合。この作業でバルクAlGaNベースのp-EBLが特定の超格子p-EBLに置き換えられた場合(つまり、超格子p-EBLループは薄いAlGaN層から始まります)最後のAlGaN量子バリアよりもエネルギーバンドギャップが小さい場合)、最後の量子バリアの伝導帯は上向きになり(図5bを参照)、これにより最後の量子バリアでの電子の枯渇が促進され、が増加します。 Ø e 〜391 meVに達し、熱電子放出によってより小さな電子脱出を可能にします[28]。さらに、超格子p-EBLは、正孔のバンド内トンネリングプロセスを促進し、その結果、p-EBLの正孔濃度も高くなります(図3bを参照)。LEDのp-EBLの正孔濃度が向上します。実効価電子帯障壁の高さを下げる傾向があります(Ø h )[25]、つまりØの値 h LED AとBの電流密度が50A / cm 2 の場合、それぞれ〜324 meVと〜281meVです。 。さらに小さいØ h 次に、LED Bの場合、正孔の熱電子放出が優先されます。超格子p-EBLが電子のバンド内トンネリングも引き起こす可能性があることは注目に値します。幸いなことに、MQWの正孔濃度が改善されると、放射再結合によって電子をよりよく消費できるようになります。これは、電子の漏れを軽減するのにも役立ちます[12]。図5cによると、正孔注入がより有利になり、MQW領域で発生する放射再結合プロセスによって生成される再結合電流がさらに強くなるため、LEDBの方がLEDAよりも順方向電圧が小さくなります。
>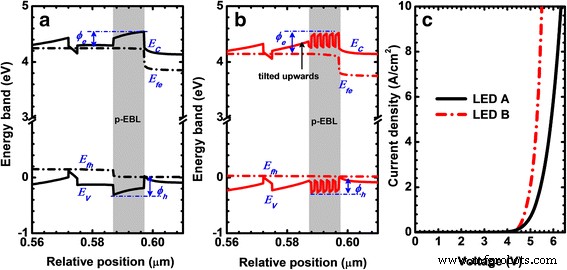
a 付近の数値計算されたエネルギーバンドプロファイル LED A用のバルクAlGaNベースのp-EBL、 b LED B用の超格子p-EBL、および c LEDAおよびBに適用されたバイアスの観点から測定された電流密度。 a のデータ および b 50 A / cm 2 の電流密度で計算されます 。 E C 、E V 、Ø e 、およびØ h 伝導帯、価電子帯、および伝導帯と価電子帯の有効障壁高さをそれぞれ示します
結論
要約すると、この研究は、DUV LED用の特定の超格子p-EBLを報告しました。これは、正孔注入効率の向上とパッシブp型正孔注入層への電子漏れの減少の両方を維持できます。したがって、数値的にも実験的にも、改善されたEQEと著しく抑制された効率の低下が得られます。提案されたDUVLED構造は、高効率DUV LEDを実現するために非常に有望であり、この作業によって明らかにされたデバイスの物理学は、III族窒化物ベースのオプトエレクトロニクスコミュニティにより多くの理解をもたらします。
略語
- APSYS:
-
半導体デバイスの高度な物理モデル
- DUV:
-
深紫外線発光ダイオード
- EL:
-
エレクトロルミネッセンス
- EQE:
-
外部量子効率
- HVPE:
-
Hydride Vapor Phase Epitaxy
- ICP:
-
誘導結合プラズマ
- IQE:
-
内部量子効率
- LEE:
-
光抽出効率
- MOCVD:
-
有機金属化学蒸着
- MQW:
-
複数の量子井戸
- p-EBL:
-
p型電子ブロッキング層
- TDD:
-
貫通転位密度
ナノマテリアル
- 電子増倍管の発光層の設計
- 高性能シリコン/有機ハイブリッド太陽電池用の溶媒処理を備えた高導電性PEDOT:PSS透明正孔輸送層
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- CdSe QD / LiF電子輸送層を備えた高効率の逆ペロブスカイト太陽電池
- 柔軟なひずみセンサー用の高い伸縮性を備えた導電性TPUナノファイバー複合材料
- PEDOT:PSSを正孔輸送層として処理する高極性アルコール溶媒を使用した高輝度ペロブスカイト発光ダイオード
- 平面ペロブスカイト太陽電池用の低温処理SnO2電子輸送層のUV処理
- AlGaNベースの深紫外線発光ダイオード用のp-AlGaN / n-AlGaN / p-AlGaN電流拡散層について
- 高エネルギー変換効率のための接触モード摩擦電気ナノ発電機の理論的システム
- 異なる温度でのAlGaN深紫外線発光ダイオードのエレクトロルミネッセンス特性に及ぼす量子井戸幅の影響
- 静電容量が強化されたスーパーキャパシタ電極用の原子層堆積によって製造されたTiO2ナノメンブレン



