収差補正HAADF-STEMによるエピタキシャルGaAsBi中のBi分布の分析
要約
GaAs / GaAs 1 − x のBi含有量 Bi x 340°Cに近い基板温度で分子線エピタキシーによって成長した/ GaAsヘテロ構造は、収差補正された高角度環状暗視野技術によって調査されます。高角度環状暗視野走査透過電子顕微鏡画像の低倍率での分析は、EDX分析によって裏付けられ、平面欠陥のない層と、界面およびGaAsBi層内の不均一なBi分布を明らかにしました。高倍率では、qHAADF分析により、低BiフラックスでのGaAsBi / GaAs界面での不均一な分布とBi偏析、およびBi含有量の高い領域での歪んだダンベル形状が確認されました。より高いBiフラックスでは、Biギャザリングのサイズが大きくなり、閃亜鉛鉱{111}に沿ってファセットされ、マトリックスと界面の周りに均一に分散したほぼ等軸のBiリッチ粒子になります。 FFT分析では、一部のクラスターで2つの相が共存していることを確認します。閃亜鉛鉱型GaAs 1 − x に囲まれた菱面体晶の純粋なBi(rh-Bi)です。 Bi x マトリックス。クラスターは、局所的な格子緩和に影響を及ぼし、XRD分析とよく一致して、部分的に緩和されたGaAsBi / GaAsシステムにつながる可能性があります。
背景
現在、GaAsBiベースの半導体は、温度安定性と中赤外線デバイスとして注目されています[1]。 GaAs格子に少量のBiを加えると、バンドギャップが大幅に減少し、最も興味深いオプトエレクトロニクス効果の1つになります[2、3]。ただし、Ga-Bi結合エネルギーが弱く、混和性ギャップが大きく、GaBiとGaAsの格子定数の差が大きいため、GaAsに少量のBiを組み込むことは困難です。したがって、GaAsBiは、効率的なBiの取り込みのために、非平衡動的プロセスの下で成長させる必要があります。合成に成功したとしても、Biの分布が不均一になることがあり、非放射再結合中心の密度が高くなり、レイジング操作の効率に影響を及ぼします。 Biのサイズが大きく、電気陰性度が低いと、エピタキシャル成長中に相分離[4]、表面液滴[5、6]、原子秩序[7,8,9]、ナノスケール液滴[10]、またはBiクラスターが生成される傾向があります。 Biクラスターの存在は、Ciatto etalによって以前に検出されました。 X線吸収分光法(XAS)、原子間力顕微鏡法、およびX線回折(XRD)技術の組み合わせによる[11]。次に、数人の著者が、さまざまな透過型電子顕微鏡技術を使用して、アニールされたGaAsBiサンプルにBiクラスターが存在することを報告しました[4、12、13]。さらに、Kunzer etal。 [14]従来の電子スピン共鳴(ESR)により、組み込まれたBiの約10%がGaAsBi層のGaサイトを占めていたことが確認されました。したがって、デバイスへのGaAsBiの適用を成功させるには、Biの取り込みと欠陥の形成を理解して制御することが重要です。新しいBiベースの材料の開発は、特性評価ツールの進歩に関連していることは言及する価値があります。この意味で、収差補正顕微鏡における高角度環状暗視野走査透過電子顕微鏡法(HAADF-STEM)技術は、サブオングストロームレベルの情報を取得する上で重要な役割を果たします[15、16]。この手法では、画像の強度は平均原子番号( Z )にほぼ比例します。 )投影された原子カラムで、AsとGaに対するBiの原子番号の大きな違いにより、希薄なGa(AsBi)ヘテロ構造にうまく適用できます。さらに、HAADF画像の明るい特徴は、高分解能透過型電子顕微鏡(HRTEM)は、コントラストの反転と非局在化がないため、整列した結晶の原子柱に関連付けることができます。また、GaAsBiサンプルの収差補正HAADF画像は、試料の厚さへの依存性が低く、As / Bi組成への依存性がほぼ線形であることを示しています[12]。さらに、Molinaらによって開発された定量的HAADF(qHAADF)画像分析アルゴリズムを適用することによって。 [17]、III-V三元半導体材料[12、16、18]、ひいてはGaAsBi化合物のHAADF強度と原子カラム組成を効果的に相関させることができます。さらに、高解像度のHAADF-STEM画像は、結晶品質に関する情報を提供します[19、20、21、22]。
この作業では、収差補正されたHAADF-STEMイメージングと相補型エネルギー分散型X線(EDX)を通じて、GaAs / GaAs 1 − x のBi分布を調査します。 Bi x 分子線エピタキシー(MBE)により、340°Cに近い基板温度で成長した/ GaAsヘテロ構造。また、ナノスケールおよびマイクロスケールでのBi収集の効果についても研究しました。この目的のために、qHAADFアプローチ、高解像度画像のフーリエ高速変換(FFT)分析、およびXRD技術を使用しました。
メソッド
GaAs / GaAs 1 − x からなる一連の2つのサンプルを研究します Bi x 2インチn + 上の固体ソースMBEによって成長した/ GaAsヘテロ構造 GaAs:Biセル温度S1(460°C)とS2(505°C)によって与えられる異なるBiフラックスを持つSi(001)ウェーハ。使用したシステムは、平均静止バックグラウンド圧力が〜5×10 − 10 のVGV80MBEマシンでした。 mbar。構造は、名目上、130 nm GaAsバッファー、130 nm GaAsBi層、5 nm GaAsスペーサー層、そして130 nmGaAsキャップで構成されています。成長前に、基板を400°Cで20分間ガス放出し、次に表面酸化物を600°Cで除去しました。 GaAsバッファーとキャップは、As 2 の下で約580°Cで成長させました。 一方、GaAsBi層とGaAsスペーサー層は化学量論に近いAs 4 の下で約340°Cで成長しました。 フラックス。したがって、GaAsBi層は、GaAsキャップの成長中に、〜580°Cで〜20分間その場でアニールされました。これらの成長条件下では、表面に金属液滴は観察されなかった。基板温度は、光学温度計を使用して推定され、結果は既知の温度での表面再構成遷移に対して較正されました。 GaAsBiを成長させる前に、サンプル表面をBiフラックスに20秒間さらしました。このステップの目的は、Bi表面層を確立し、GaAsBi成長の開始時にBiの取り込みを強化することでした。
HAADF-STEMの試験片は、機械的研削とAr + によって断面で準備されました。 精密イオン研磨システム(PIPS)を使用したイオンミリング、ビーム傾斜は-3°および+ 4°、ビームエネルギーは2.8〜3.0kV。粉砕の最終段階で、イオンエネルギーを1.5 kVに下げて、表面品質を向上させました。研究前のサンプルは、試料表面への電子ビーム堆積の影響を減らすためにプラズマ洗浄されました[23]。 HAADF-STEM画像、ゼロ損失電子エネルギー損失スペクトル(EELS)、およびエネルギー分散型X線スペクトルのラインスキャンは、Titan 3 を使用して200kVで実施されました。 60〜300kVのテミス。タイタン 3 Themisには、コールドフィールドエミッションガン(FEG)、Csプローブコレクター、および電子モノクロメーターが装備されており、HAADFイメージングでの原子分解能が可能です。この顕微鏡には、元素分析用のSuper-XクワッドEDX検出器も含まれており、原子の位置と組成に関する情報を同時に提供します。 TEM標本のトポグラフィー研究用の二次電子(SE)画像は、FEI NOVA NANOSEM450顕微鏡を2kVで使用して実行されました。
2.42 keVのBi-Mラインは、BrukerEspiritソフトウェアによるBi組成の定量測定に使用されました。標本の厚さは、デジタル顕微鏡写真(GATAN™)ソフトウェアを使用して、空間的に分解されたゼロロスEELS信号の分析から決定されました[23]。カラムごとのBi分布は、デジタル顕微鏡写真で実行できるqHAADFソフトウェアを使用して研究されています。このソフトウェアを使用すると、HAADF-STEM画像の強度ピークを検出することにより、原子カラム周辺の選択した領域の積分強度を測定およびマッピングできます[17]。 ω-2θ(0 0 4)XRDスペクトルは、Cu-Kα 1 を使用してBrukerD8 DiscoverX線回折計で測定されました。 放射線。スキャンは、Bede RadsMercuryソフトウェアを使用してシミュレートされました。
結果と考察
図1は、サンプルS1(a)およびS2(b)の[110]ゾーン軸で撮影された低倍率のHAADF-STEM画像と、でマークされた領域から[001]方向に沿って撮影された厚さ勾配補正強度プロファイルを示しています。 HAADF-STEM画像(緑色の長方形)。両方のサンプルの調査領域で、貫通転位または積層欠陥は検出されませんでした。 HAADFでは、得られる強度は平均原子番号に比例します。したがって、サンプルの厚さが一定の場合、画像のコントラストが明るいほど、Biの含有量が多くなります( Z Bi =83、 Z Ga =31および Z As =33)。これにより、GaAsBi / GaAsヘテロ構造におけるBi分布の研究が可能になります。図1aで観察できるように、サンプルS1のGaAsBi層では、Bi含有量が少ないため、明確なコントラストの変化は検出されません。サンプルの厚さが厚い他の領域でも、クラスター化の明確な証拠は示されていません。ただし、BiおよびAsクラスターは、Bi含有量が1.44%と低いGaAsBiサンプルでも、低温で成長したものの、文献で報告されています[11]。 Bi含有量が高いサンプルS2に関して、図1bは、比較的均一なサイズと分布を持つ層のコントラストが明るいいくつかの領域を示しています。 GaAsBi層と界面に沿って規則的に分布しているこれらの領域は、HAADF強度が高いため、Bi含有クラスターとして直接解釈できます。より良い視覚化のために、対応するローパスフィルター処理された画像が同じ画像の挿入図として示されています。黄色はBi含有量の高い領域に対応し、黒は低い領域に対応します(温度スケール)。構造欠陥を引き起こさないGaAsBiでのBiクラスターの形成は、他の著者によって以前に報告されています[7、24、25]。 GaAsマトリックスにBi(Asの原子体積の1.6倍)を組み込むと、歪みのために置換エネルギーが増加し、As原子の溶解度が低下し、Bi原子の集合が可能になる場合があります。電界放出ガン走査型電子顕微鏡(FEG-SEM)を使用したサンプルの研究は、Biクラスターが層内に埋め込まれていることを確認するために実行されました。そのために、低電圧で取得された二次電子のトポグラフィー画像(ここには示されていません)を、同じ領域から取得されたSTEM画像と比較しました。

a GaAs / GaAsBi / GaAs界面を示すサンプルS1の断面HAADF-STEM画像。 b サンプルS2の断面HAADF-STEM画像は、GaAsBi層に、Biリッチ領域に関連するGaAsBi層に沿って分布する輝点が観察されます。ローパスフィルターを適用した後の領域の温度カラースケールを使用した詳細は、より良い視覚化のために同じ画像の挿入図として含まれています。 c HAADF-STEM画像の緑色の長方形でマークされた領域から[001]方向に沿って取得された厚さ勾配補正強度プロファイル、サンプルS1の青色の線、サンプルS2の黒色の線、界面でわずかに異なる動作を示しています
サンプル中のBi分布に関する詳細情報を取得するために、厚さ勾配を修正した成長方向に沿った強度プロファイルを図1cに示します。図1a、bのHAADF-STEM画像から取得したプロファイルは、両方のサンプルで同様の動作を示しています。ほぼ急激な界面、同様の長さ(〜140 nm)のGaAsBi層です。 GaAsBi / GaAs界面に関しては、HAADF強度は最大値から約10 nmで〜0に低下し(プロファイルの灰色の破線の長方形を参照)、BiフラックスがなくてもGaAsキャップ層全体にBiがいくらか組み込まれていることを示しています。プロファイルには、平衡化時間に関する情報も示されています。プロファイルから観察できるように、低Bi含有量のサンプル(S1)では、GaAs / GaAsBi界面は、高Bi含有量のサンプル(S2)よりも急激です。これは、2つのサンプルの異なるBi取り込み係数によって説明される可能性があります。 S1は、S2と同じ温度で成長しますが、Bi含有量ははるかに少なくなります。したがって、S1はおそらく、ほぼ単一のBiが組み込まれた速度論的に制限された条件下で成長します[26]。これは、Bi表面層がこの温度でのBi原子の表面寿命よりも短い時間枠で平衡化することを意味します。一方、S2はおそらくBiの取り込み係数が低い[27]。この場合のBi表面層は、平衡化するのにBi原子の表面寿命よりも長くかかり、Bi取り込みの安定化が遅くなります。
HAADF-STEM強度プロファイルとヘテロ構造のBi分布との相関関係を確認するために、サンプルのSTEM-EDXBi組成マップを同時に取得しました。これらは、低(a)および高(b)Biフラックスでのサンプルについて図2に示されています。約130nmの領域のポイントEDXスペクトルを積分することによって決定された、成長方向に沿った対応するBi組成プロファイルは、それぞれ青と黒の線で図2cに示されています。これらの組成プロファイルは、低倍率のHAADF分析によってGaAs / GaAsBi / GaAs界面で検出されたのと同じ傾向を示しています。 GaAsBi層の平均Bi原子分率は、対応するEDXスペクトルから定量化されました。サンプルS1とS2ではそれぞれ1.2±0.4%と5.3±0.4%であり、両方のサンプルでGaAsBi層のBiが不均一に分布していることを示しています。 。

サンプルS1( a )のBi分布を表すSTEM / EDX元素マップ )およびS2( b )。図1bで白い長方形でマークされたクラスターに対応するBi、Ga、およびAs元素マップの詳細は、高いBi領域がある場所でAsおよびGa信号の低下を示しています。 c サンプルS1(青い線)とS2(黒い線)のEDXマップから約130 nmの領域を統合した後に抽出された、[001]方向に沿ったBiコンテンツプロファイル。図1cに示す低倍率の強度プロファイルでも同様の特徴が観察されました
Biクラスターの存在は、立体障害効果によるものです。この場合、Bi原子の原子サイズが大きいために表面張力が増加する可能性があるため、構造内の応力を低減するために、Bi原子がGaの取り込みをブロックし、その結果、ネットにGa空孔が生じる可能性があります。図2bの白い四角で囲まれたクラスターのGaとAsの組成マップは、高いBi信号がある場合に両方の信号がどのように落ちるかを示すために含まれています。これは、この特定のクラスターでは、BiがグループIIIとグループVの両方の副格子を占めている可能性があることを示唆しています。これは、クラスターがTEMサンプルの準備中に形成された表面的なクラスターではないことも示しています。
原子レベルでのBi分布の詳細な研究を行うために、[110]投影で高倍率の収差補正HAADF-STEM画像を撮影しました。このIII-V半導体合金では、ダンベルの2つの最大強度ピークがIII族とV族の原子カラムに対応しています。原子カラムの強度をそれらの組成と適切に相関させるために、バックグラウンドレベルが実験的なHAADF-STEM画像から削除されました。次に、強度ピークの自動位置特定が実行され、グループV原子カラムの周囲の積分領域が慎重に選択されます。統合された強度は、qHAADFアプローチを使用して、すべてのダンベルについて測定およびマッピングされます。 Bi含有量を定量化する手順は、参考文献に公開されている手順と同様でした。 [28]。この作品では、すべてのダンベルの積分強度指数( R )は、グループV列の積分強度間の比率として計算されました( I As − Bi )画像全体とGaAs層のV族カラムの平均積分強度( I As )、 R として =( I (As − Bi) )/ 私 As 。
図3aは、Bi含有量の少ないサンプル(S1)から採取したGaAs / GaAsBi界面の高倍率HAADF-STEM画像を示しています。 HAADF画像の色付きの正規化された統合強度マップを図3bに示します。 1(濃い青)から1.27(赤)の範囲の色付きのドットは、グループVの列のBi含有量を示しています。観察できるように、 R の小さな変動 平均値からの値は、両方のレイヤーにあります。得られた結果のばらつきを比較するために、相関係数 Cv を計算しました。 (標準偏差と平均 R の比率として定義されます 値)GaAs(基板)、GaAsBi層、GaAsキャップ層。 Cv GaAsBi / GaAs界面で観察された変動は、参照として使用されたGaAs基板で見られた変動よりも大きいため、値はそれぞれ1.3、2.6、および2.6%でした。 R のこれらのバリエーションは 値は、Biカラム組成の変化に関連しています。ゼロ以外の原因 Cv 基板の要因は、局所的な厚さの変動、検出器のノイズ(0.6%として材料がない領域で測定)、または顕微鏡の特性評価中に表面サンプルに堆積した炭化水素が原因である可能性があります。

a サンプルS1の界面GaAsBi / GaAsの断面[110] HAADF-STEM画像。 GaAs層の歪みのない領域と、高倍率でのBiリッチ領域の歪みのあるアニオンカチオンダンベルの詳細が、同じ画像の挿入図として含まれています。 b R を表すカラーマップ 図3aのHAADF画像のグループV列周辺の値。緑色は、EDXで測定したGaAsBi層の平均Bi組成に対応しています。 HAADF-STEM画像ではBiが均一に分布していますが、強度マップには、GaAsBi層のナノクラスタリングの可能性が高い領域(赤い点)とBi含有量が比較的少ない列(青い点)が示されています。 c R 全体の成長方向に沿ったプロファイル 強度マップ、約10nmでぼやけたGaAsBi / GaAs界面を示す
このqHAADF分析は、強度
HAADF-STEM技術は、サンプルS2で低倍率で検出されたクラスターの構造および組成分析も可能にします。これらのクラスターは、ほぼ均一に分布しており、GaAsBi層の表面の約20〜30%を占めています。見つかったクラスターのBi組成、形状、サイズを知るために、収差補正HAADF-STEM画像を[110]投影で撮影し、EDX元素マップとグループVカラム周辺の強度マップ比を実行しました。さまざまな結晶相を特定するために、クラスター内およびクラスターの近くのさまざまな領域の高解像度画像で高速フーリエ変換(FFT)研究が実施されました。
図4aは、直径約12nmの透明なBiクラスターを備えたGaAsBi / GaAsインターフェースの高解像度[110] HAADF-STEM画像を示しています。画像の赤い長方形は、FFT調査が実行された領域を表しています。ローパスフィルタリングは、データのノイズ量を減らすだけでなく、生の画像で観察される周期的な特徴を取り除き、Biクラスターのエッジを強調することはよく知られています。 Werner etal。によって記述された手順に従ったフィルタリングされたHAADF-STEM画像。 [29]は、図4bに示されています。理解できるように、最も明るい領域の{111}および(001)ファセットがはっきりと観察できます。ただし、強度分布は、粒子内に2つの異なる組成ボリュームが存在することを示しています。Biが豊富な領域に囲まれた台形の形状のBiが豊富なボリュームです。同様のクラスター形状がウッドらで観察されました。 5周期のGaAs 1 − x Bi x / GaAs 1 − y Bi y 構造[10]。
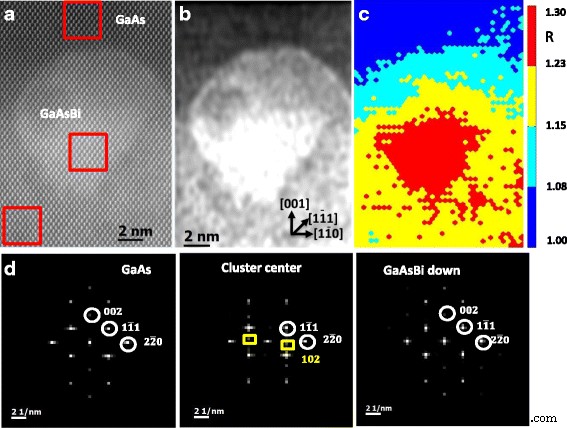
a サンプルS2の界面GaAsBi / GaAsの断面[110] HAADF-STEM画像。GaAsBi/ GaAs界面の隣にある約12nmのサイズのBiクラスターをキャプチャしています。 b HAADF-STEM画像の低フィルタリング画像は、GaAsBi層のコントラストが異なる2つの領域を示しています。Biリッチゾーンは{111}面と(001)面に沿ってファセットされ、下部のBiリッチ面に囲まれています。 c R を表すカラーマップ クラスター周辺の段階的なBi分布を表すグループV列周辺の値。 d 図1aで赤い長方形でマークされた選択された領域からの対応するフーリエ変換。 rh-Bi位相に関連する{102}平面に一致する追加のスポットが、最もコントラストの高いクラスター領域で検出されます
強度 R によるqHAADF分析 図4cに示すマップは、ほぼ等軸の粒子形状と、クラスターの中心でピークに達するBi濃度勾配を示しています。
ウーら[4]は、HRTEM顕微鏡写真を研究し、閃亜鉛鉱型Biリッチから閃亜鉛鉱型{111}面で核形成された閃亜鉛鉱型Bi(rh-Bi)への形成と相転移をモデル化するGaAsBi層の異なる結晶構造の存在を報告しました。この意味で、高解像度HAADF-STEM画像からのFFTの輝点は、結晶面からの回折点として解釈できることに言及する価値があります。次に、GaAsの亜鉛ブレンド構造の従来のパターンの余分なスポットは、追加の相として解釈する必要があります。クラスター内のさまざまな結晶構造の存在を調べるために、図4dは、図1aで赤い四角でマークされた3つの異なる領域に対応するFFTを示しています。右から左に、GaAsキャップ層の均一な領域、GaAsBi層の最も明るいゾーン、および同じGaAsBi層のコントラストの低い別の領域を示しています。白い円は、ミラー指数002、\(1 \ overline {1} 1 \)および\(2 \ overline {2} 0 \)の回折ピークの位置を示します。観察できるように、クラスターの中央にのみ、閃亜鉛鉱の{220}面にほぼ平行な{102}面に関連する、黄色の四角でマークされた明確なスポットが表示されます。これは、新しいrh-Bi相が核形成したことを示唆しています。 GaAsBi閃亜鉛鉱層。 FFTは、{111}面に関連する回折ピークの広がりも示しています。この観察された非対称ピークは、クラスター内のrh-Bi相と閃亜鉛鉱相の間の{111}面のせん断による微小ひずみの原因である可能性があります。
クラスター組成の詳細な研究では、電子がクラスターが埋め込まれた電子透過性の試料を通過するときに、クラスターに関する情報だけでなく、マトリックスからの情報も伝達することに言及する価値があります。したがって、実際のクラスター構成を推定するには、参考文献で説明されているのと同じ手順に従います。 [25]。結果はまた、GaAsBi / GaAs界面に近いクラスターは、サイズが小さく(12 nm)、Bi含有量が高い(≈30%)傾向があることも指摘しました。これは、おそらくキャップ層が成長する。ただし、GaAsBi層の内側にあるクラスターのほとんどはサイズが大きく(16 nm)、Bi含有量は劣っています(≈22%)。さらに、GaAsBi層では、Bi含有量が優れ(35%)、サイズが大きい(23 nm)クラスターが検出されました。さらに、前述のように、一部のクラスターのコアは純粋なrh-Biで構成されています。
エピタキシャル膜のひずみ状態を調べるために、高分解能X線ω-2θ曲線を記録しました。図5は、サンプルS1(a)とS2(b)のGaAsBi / GaAs層の(004)XRDスキャンを青で示し、シミュレートされたフィットをオレンジで示しています。両方のサンプルで、0°アーク秒にある最も鋭く最も高い強度のピークはGaAs基板に対応し、負のアーク秒にある広く低い強度のピークは歪んだGaAsBi層に対応します。ピーク間の角度は、両方の層間の格子不整合の量に関連しています。 S2のスペクトルのGaAsピークの右側の肩は、引張ひずみ下のGaAs層を示しています。これは、S2GaAsBi層のひずみ緩和を意味します。サンプルS1のXRDスペクトルは、EDXおよびHAADF測定によって得られたBiの割合と厚さを使用してよく適合しました。サンプルS1のXRDスペクトルにひずみ緩和の兆候はありません。サンプルS2のXRDスペクトルは、適合させるのにより問題がありました。図5bは、HAADF-STEM分析によって決定された5.8%の均一なGaAsBi層によってモデル化されたデータを示しています。これは、Biリッチクラスターを無視し、XRD曲線のフィッティングによって決定された6%のGaAsBi層の緩和です。クラスターが残りのGaAsBiマトリックスとコヒーレントでない場合、これは合理的です。このモデルはレイヤーを正確に表していない。基板-GaAsBi分割はデータを説明するのに十分ですが、〜250°アーク秒での引張GaAsピークは表示されません。引張GaAsピークは、層内で緩和が起こったことを示唆しています。圧縮層を緩和すると、面外格子定数が減少します。これは、モデル化された平均Bi含有量5.8%が実際の平均を過小評価していることを意味します。これは、層内のBiが豊富なクラスターの観察と一致しています。逆格子空間マッピング(図示せず)では、〜22–35%のGaAsBiに対応するピークは観察されませんでした。これは、クラスターがGaAsBiマトリックスとコヒーレントではない可能性があることを示しています。 S2XRDスペクトルのそれ以上のモデリングは試みられませんでした。

サンプルS1( a )のX線回折データ(青い線)とシミュレートされたフィット(オレンジ色の線) )およびサンプルS2( b )。 0°アーク秒でのGaAsピークと負のアーク秒で位置するGaAsBiフィルムピークを強調する垂直の破線。図5bの右側のGaAsピークの肩は、引張ひずみ下のGaAsキャップ層を示しています
結論
ac-HAADF-STEM分析は、GaAs / GaAsBi / GaAsヘテロ構造の構造と組成に関する有用な情報を提供し、その結果はEDX、FFT、およびXRDの調査とよく一致しています。低倍率のHAADF-STEM画像の分析により、不均一なBi分布と非急激なGaAsBi / GaAs界面の検出が可能になりました。高倍率では、qHAADF分析により、低Biフラックス(S1)でのGaAsBi / GaAs界面での明確なBi偏析、およびグループVサブネット内のBi原子のAs置換位置により、Biの割合が高い領域でのダンベル形状の歪みが明らかになりました。 。より高いBiフラックス(S2)では、Biギャザリングのサイズが大きくなり、マトリックス全体と界面の周りにほぼ等軸のクラスターが均一に分散します。この研究では、研究対象のクラスターrh-Biと閃亜鉛鉱のせん断{111}面に、2つの異なる結晶相が共存し、局所的な格子緩和に影響を与え、部分的に緩和されたGaAsBi / GaAsシステムにつながることがXRD分析とよく一致していることが明らかになりました。
略語
- Ac-HAADF-STEM:
-
収差補正された高角度環状暗視野走査透過電子顕微鏡法
- EDX:
-
エネルギー分散型X線
- EELS:
-
電子エネルギー損失スペクトル
- ESR:
-
従来の電子スピン共鳴
- FEG:
-
コールドフィールドエミッションガン
- FFT:
-
フーリエ高速変換
- HRTEM:
-
高分解能透過型電子顕微鏡
- IMEYMAT:
-
InstitutoUniversitariodeInvestigaciónenMicroscopíaElectrónicayMateriales
- MBE:
-
分子線エピタキシー
- qHAADF:
-
定量的HAADF画像分析アルゴリズム
- SEM:
-
走査型電子顕微鏡
- XAS:
-
X線吸収分光法
- XRD:
-
X線回折
ナノマテリアル



